Мощные полевые транзисторы в современном электроприводе
(Окончание. Начало в № 6’2001)
Краткий обзор мощных полевых транзисторов фирмы Philips Semiconductors
При предварительном выборе типа приборов для разработчика наиболее важны следующие параметры:
- V(BR)DSS — минимальное напряжение пробоя;
- ID — ток стока длительный;
- IDM — ток стока импульсный;
- RDS(ON) — сопротивление открытого (выключенного) канала;
- WDSS — допустимая энергия одиночного импульса;
- VGS(th) — пороговое (неотпирающее) напряжение затвор-исток;
- VGS — отпирающее напряжение затвор-исток.
Остальные характеризующие и предельно-допустимые параметры, знание которых необходимо для проектирования и расчета электрических и тепловых режимов, можно найти на Web-сайте
http://semiconductors.philips.com.
Схемотехника силовой части преобразователей энергии
Выбор схемы силовой части преобразователя энергии определяется типом двигателя и требованиями к системе электропривода. Самая простая однотактная схема импульсного регулятора (рис. 6) обеспечивает возможность регулирования напряжения якоря двигателя постоянного тока для стабилизации частоты вращения и ограничения тока в нереверсивном электроприводе при низких требованиях к быстродействию. В такой схеме ток якоря не может изменить направление, поэтому торможение обеспечивается только выбегом. Дроссель для уменьшения пульсаций тока якоря обычно не требуется. Хорошие динамические свойства полевого транзистора позволяют реализовать такую частоту переключения, при которой собственная индуктивность якоря двигателя достаточна для сглаживания пульсаций тока.
Самая простая однотактная схема импульсного регулятора (рис. 6) обеспечивает возможность регулирования напряжения якоря двигателя постоянного тока для стабилизации частоты вращения и ограничения тока в нереверсивном электроприводе при низких требованиях к быстродействию. В такой схеме ток якоря не может изменить направление, поэтому торможение обеспечивается только выбегом. Дроссель для уменьшения пульсаций тока якоря обычно не требуется. Хорошие динамические свойства полевого транзистора позволяют реализовать такую частоту переключения, при которой собственная индуктивность якоря двигателя достаточна для сглаживания пульсаций тока.
При выключенном транзисторе (в паузе) ток якоря замыкается через блокирующий диод. При включении транзистора на этапе рассасывания диода необходимо ограничивать скорость нарастания тока. Для этого можно использовать, например, простую LRD-цепь (рис. 7). Величина индуктивности определяется напряжением питания Ес и допустимой скоростью нарастания тока dI/dt по выражению Lі Ес /(dI/ dt).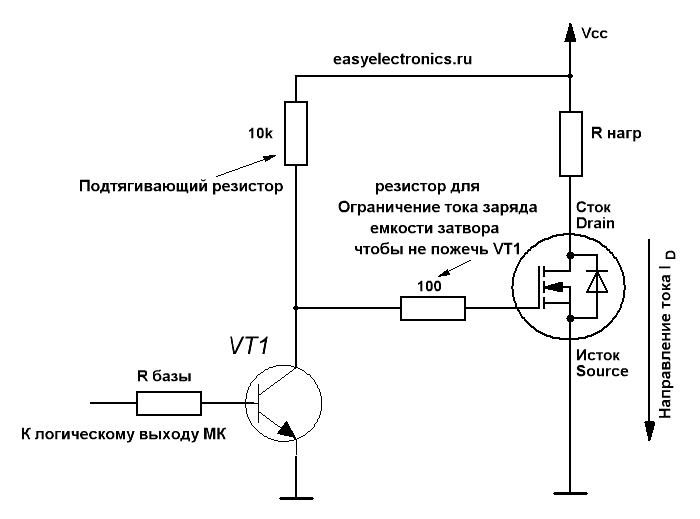
Таблица 6. Транзисторы на 75…100 В для автомобильной электроники
| Тип | Корпус | V GS B | Технология | V DSMAX, B (25 °C) | I DMAX, A (25 °C) | R DS(ON), Ом (25 °С) |
| BUK7528-100A | SOT78 | 10 | N-channel | 100 | 47 | 0,028 |
| BUK9628-100A | SOT404 | 5 | N-channel | 100 | 47 | 0,028 |
| BUK95180-100A | SOT78 | 5 | N-channel | 100 | 11 | 0,180 |
Таблица 7.
| Тип | Корпус | V GS B | Технология | V DSMAX, B (25 °C) | I DMAX, A (25 °C) | R DS(ON), Ом (25 °С) |
| BUK7508-55A | SOT78 | 10 | N-channel | 55 | 75 | 0,008 |
| BUK9506-55A | SOT78 | 5 | N-channel | 55 | 75 | 0,0063 |
| BUK9520-55 | SOT78 | 5 | N-channel | 52 | 0,02 | |
| BUK9675-55 | SOT404 | 5 | N-channel | 55 | 19,7 | 0,075 |
Таблица 8. Силовые ключи со встроенной логикой и защитой для автомобильной электроники
| Тип | Корпус | V DSMAX, B (25 °C) | V IS, B | V DMAX, A (25 °C) | R DS(ON), Ом (25 °C) | Число выводов |
| BUK223-50Y | SOT78 | 50 | 5 | 12 | 0,03 | 5 |
| BUK100-50DL | SOT78 | 50 | 5 | 15 | 3 | |
| BUK127-50DL | SOT223 | 50 | 5 | 7 | 0,2 | 3 |
Нереверсивное управление двигателем при высоких требованиях к быстродействию электропривода обеспечивает полумостовая схема (рис. 8).
8).
Рис. 8
Схему, в которой два силовых ключа соединены последовательно по отношению к источнику питания, называют «стойка». В такой схеме ток якоря в импульсе и паузе замыкается через транзисторы, что обеспечивает возможность создания тока в обоих направлениях. Роль блокирующих выполняют встроенные диоды. Ограничение скорости нарастания тока в процессе выключения диодов может выполняться так же, как и в предыдущей схеме. На рисунке показан другой возможный вариант включения LRD-цепи. При таком включении нет «просадки» напряжения на питающих шинах. Это может быть полезно, если от данных шин питаются и другие потребители. Верхний и нижний транзисторы стойки переключаются сигналами от драйверов противофазно. Из-за конечной скорости процессов включения и выключения транзисторов могут появляться короткие интервалы времени, когда оба транзистора открыты и через них протекает «сквозной» ток, величина которого в определенной мере ограничивается индуктивностью. Для уменьшения массы и габаритов дросселя обычно вводится задержка включения одного транзистора на время выключения другого.
При рекуперативном торможении двигателя накопленная кинетическая энергия преобразуется в электрическую, которая передается через шины питания другим потребителям и в источник. Это может привести к повышению напряжения питания. В такой ситуации для ограничения напряжения в схему вводят балластный (тормозной) резистор, подключаемый через силовой ключ при торможении, как показано штрихами на рис. 9.
Рис. 9
Драйвер верхнего транзистора стойки должен быть гальванически изолирован от остальных цепей. Зачастую подключить общую точку цепи управления непосредственно к истоку нижнего ключа невозможно. Из-за большой скорости изменения тока и паразитной индуктивности шины питания между общими точками силовой цепи и цепи управления возникает большая разность потенциалов. Для устранения влияния этой помехи необходима гальваническая развязка и для драйвера нижнего ключа.
В низковольтных маломощных системах, когда напряжение питания меньше предельно допустимого напряжения затвора, можно существенно упростить драйвер стойки, если использовать комплиментарную пару из
p-канального и n-канального транзисторов (показано на рисунке справа).
Полумостовые схемы с разделительными конденсаторами, подобные рассмотренным выше, используются в инверторах малой и средней мощности.
В реверсивных электроприводах необходимо изменять не только направление тока, но и полярность напряжения нагрузки. Те же свойства должен иметь и источник энергии для двигателей переменного тока. Это обеспечивают мостовые схемы, показанные ниже.
В таких схемах используются цепи ограничения скорости нарастания тока и ограничения напряжения, аналогичные рассмотренным ранее (на рисунке не показаны).
Для построения быстродействующего реверсивного электропривода постоянного тока используют мостовую однофазную схему импульсного регулятора (рис. 10), состоящую из двух стоек.
Рис. 10
При соответствующем управлении ключами схема позволяет изменять направление тока и полярность напряжения якоря двигателя. Такая же схема используется и для построения мощных однофазных регулируемых инверторов напряжения и тока.
Рис. 11
Трехфазная мостовая схема, состоящая из трех стоек (рис. 11), используется в системах регулируемого электропривода переменного тока на базе синхронных и асинхронных двигателей с частотным управлением, а также для построения коммутаторов бесконтактных двигателей постоянного тока. В зависимости от способа управления ключами выходное трехфазное напряжение такой схемы может иметь как прямоугольную форму, так и квазигармоническую (при использовании широтно-импульсной модуляции фазных напряжений). Для электроприводов малой мощности трехфазные мостовые схемы изготавливают и в виде модулей. Например, PHN603S представляет собой мост со встроенными блокирующими диодами Шоттки в 24-выводном корпусе.
Для шаговых двигателей обычно требуется создание однополярных токов в фазных обмотках (фазах) и переключение этих токов в определенной последовательности (коммутация). В целях осуществления коммутации достаточно использовать простую однотактную схему для каждой фазы. Характерной особенностью большинства шаговых двигателей является относительно большая величина индуктивности фазы.
обмоткой балластного резистора. Это уменьшает электромагнитную постоянную времени фазной обмотки при сохранении величины тока. Однако в данном случае для силовых шаговых двигателей в несколько раз возрастает потребляемая мощность, и необходима большая площадь теплоотводящего радиатора. Существенно уменьшить габариты и массу коммутатора позволяет модифицированная однотактная схема, в которой коммутируются оба вывода фазной обмотки (рис. 12).
Рис. 12
VT2 коммутирует фазу по сигналам от контроллера, датчик тока ДТ выдает информацию о величине фазного тока, и контроллер вырабатывает сигнал ШИМ, переключающий VT1 для поддержания тока требуемой величины. Диоды обеспечивают ограничение ЭДС самоиндукции фазы при запертых транзисторах. Схема существенно сложнее однотактной, но обеспечивает возможность форсирования при малых дополнительных потерях. Регулирование фазного тока делает привод малочувствительным к колебаниям напряжения питания и позволяет реализовать электрическое дробление шага двигателя.
Регулирование фазного тока делает привод малочувствительным к колебаниям напряжения питания и позволяет реализовать электрическое дробление шага двигателя.
Выбор типа транзисторов
Основными факторами, определяющими выбор типа транзистора, являются надежность системы, возможность реализации предполагаемых алгоритмов управления электроприводом, коэффициент полезного действия преобразователя энергии, затраты.
Для обеспечения надежности необходимо, чтобы при функционировании системы при всех возможных нагрузках и воздействиях не превышались предельно допустимые электрические режимы транзистора и температура кристалла. На самом деле, пока не выбран тип транзистора, неизвестны и точные значения электрических нагрузок. Если же назначить чрезмерно большой запас, компенсируя незнание, это приведет к неоправданно большим затратам. Дело в том, что стоимость силовых транзисторов составляет заметную долю стоимости всех компонентов и растет с ростом предельно допустимых значений напряжения и тока. Упомянутые трудности зачастую значительно смягчаются дискретностью ряда допустимых значений.
Упомянутые трудности зачастую значительно смягчаются дискретностью ряда допустимых значений.
Наибольшее напряжение сток-исток транзистора практически равно напряжению источника питания. Для обеспечения надежности принято вводить запас по предельно допустимому напряжению. Изучение рекомендаций, руководств пользователя, параметров и гарантий на преобразователи энергии и вторичные источники питания различных фирм показывает, что отношение максимального напряжения к предельно допустимому находится в пределах 0,65…0,75. При таком коэффициенте запаса обеспечивается и возможность защиты шин питания от неповторяющихся всплесков напряжения варисторами. Зона разброса порогового напряжения варистора оказывается между значениями максимального и предельно допустимого напряжений.
Выбор транзистора по допустимому току стока должен обеспечить выполнение двух требований: максимальный ток нагрузки должен быть меньше допустимого тока стока, а температура перехода (кристалла) — меньше предельно допустимой.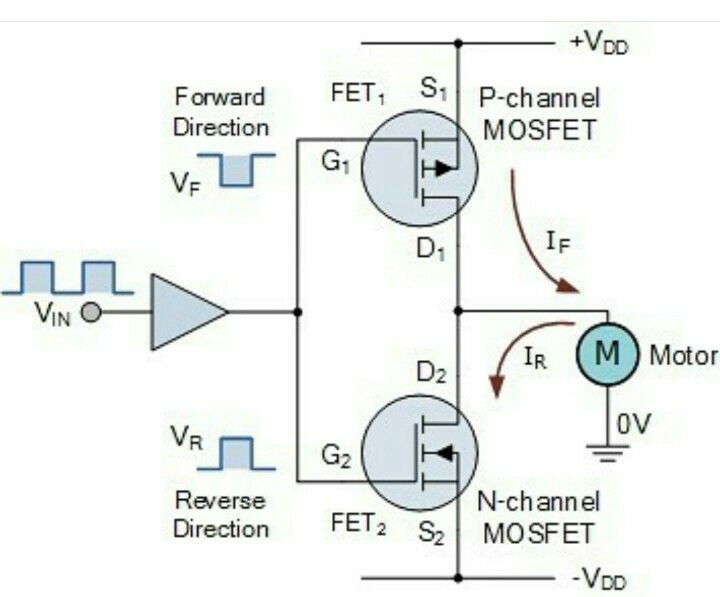 В системах электропривода ток нагрузки может существенно изменяться во времени. Требования должны выполняться в наиболее тяжелом режиме по току нагрузки, даже если такой режим кратковременен. Это обусловлено тем, что электромеханическая постоянная времени двигателя и механизма практически всегда значительно больше, чем тепловая постоянная времени транзистора. Обычно наибольшая величина тока нагрузки достаточно точно ограничивается регулятором тока системы электропривода.
В системах электропривода ток нагрузки может существенно изменяться во времени. Требования должны выполняться в наиболее тяжелом режиме по току нагрузки, даже если такой режим кратковременен. Это обусловлено тем, что электромеханическая постоянная времени двигателя и механизма практически всегда значительно больше, чем тепловая постоянная времени транзистора. Обычно наибольшая величина тока нагрузки достаточно точно ограничивается регулятором тока системы электропривода.
В конечном итоге выбор типа транзистора основан на выборе наибольшей температуры перехода. От этой температуры зависит интенсивность отказов, которая быстро возрастает при приближении значения температуры к предельно допустимому. С другой стороны, запас по температуре увеличивает стоимость транзистора (из-за большего предельно допустимого тока) и требует теплоотвода больших размеров. При предельно допустимой температуре перехода +175 °С (типовое значение для современных приборов) рекомендуемая максимальная температура составляет +100…150 °С.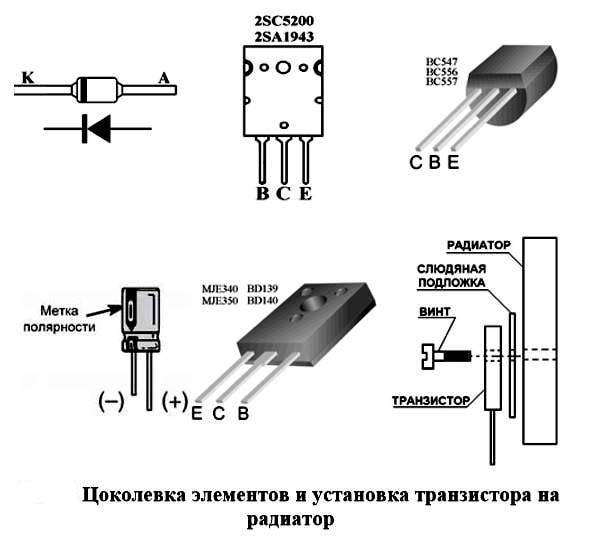 Для расчета теплового режима необходимо знать параметры транзистора и теплоотвода. Поэтому на данном этапе приходится рассчитывать несколько вариантов и выбирать наиболее рациональный. Заметим, что при определении параметров теплоотвода в зависимости от конструктивных требований возможны два подхода: расчет размеров и формы теплоотвода при заданном тепловом сопротивлении или расчет теплового сопротивления при заданных массогабаритных ограничениях.
Для расчета теплового режима необходимо знать параметры транзистора и теплоотвода. Поэтому на данном этапе приходится рассчитывать несколько вариантов и выбирать наиболее рациональный. Заметим, что при определении параметров теплоотвода в зависимости от конструктивных требований возможны два подхода: расчет размеров и формы теплоотвода при заданном тепловом сопротивлении или расчет теплового сопротивления при заданных массогабаритных ограничениях.
В зависимости от свойств электропривода и источника питания при наибольшем токе нагрузки напряжение нагрузки может быть близким к напряжению питания или заметно меньшим. В первом случае переключение силовых транзисторов происходит с коэффициентом заполнения, близким к единице. При этом для расчета используют статическое тепловое сопротивление переход-корпус. Во втором случае коэффициент заполнения существенно меньше единицы, и для расчета следует использовать переходное тепловое сопротивление. Семейство графиков переходного теплового сопротивления изготовитель приводит для всех типов мощных полевых транзисторов (см. пример выше для PSMN004-55W).
пример выше для PSMN004-55W).
В обоих случаях действующее значение тока стока ID можно принять равным максимальному току нагрузки IHMAX и вычислять статическую мощность потерь в транзисторе по формуле PD = I2HMAX ґRDS. Сопротивление открытого транзистора зависит от температуры перехода. В формулу следует подставить значение сопротивления при выбранной максимальной температуре. Типовая зависимость сопротивления от температуры приводится изготовителем.
Мощность потерь, определяющая нагрев транзистора, равна сумме статической и динамической составляющих. Последнюю можно определить после выбора частоты и времени переключения транзисторов, однако обычно динамические потери для полевых транзисторов в 5…10 раз меньше статических, и их можно учесть, умножив расчетную мощность PD на 1,1…1,2.
После теплового расчета следует уточнить допустимый ток стока в соответствии с температурой корпуса транзистора (график приведен выше в примере) и сопоставить его с максимальным током нагрузки.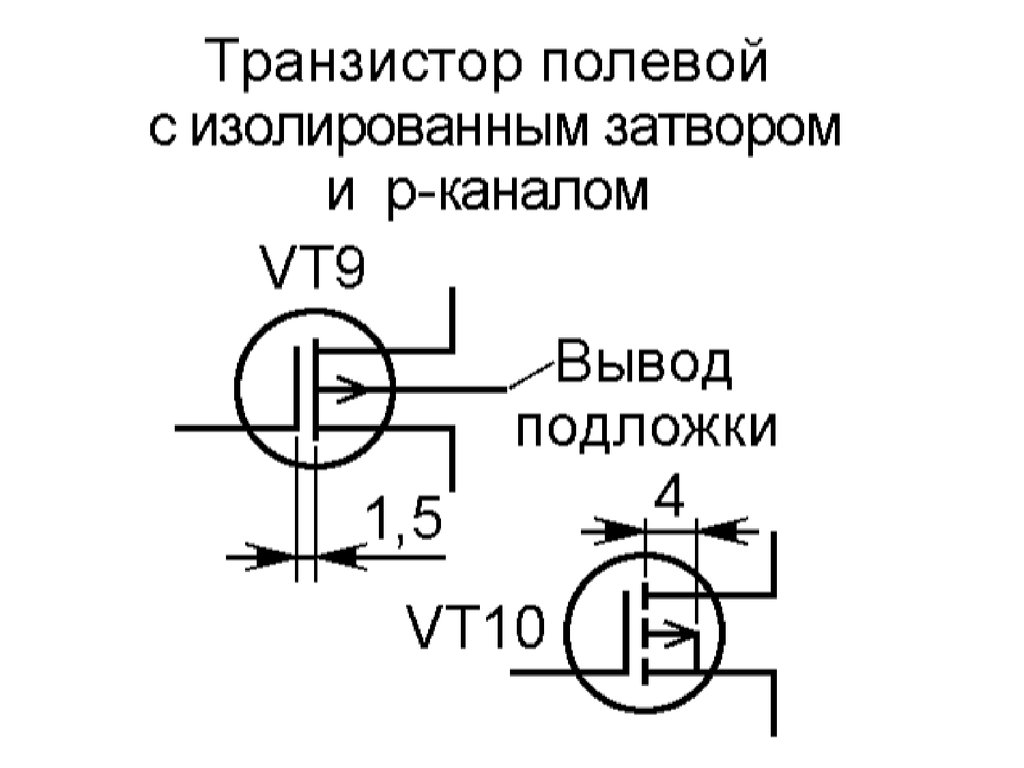
Для увеличения допустимого тока и уменьшения теплового сопротивления корпус — теплоотвод можно включить несколько транзисторов одного типа параллельно. Благодаря положительному температурному коэффициенту сопротивления сток — исток происходит частичное выравнивание токов через параллельно соединенные каналы, и дополнительные элементы для равномерного распределения нагрузки не используются. Значительный разброс сопротивлений при нормальной температуре все-таки не позволяет полностью выровнять токи. Для исключения перегрузки одного из транзисторов при проектировании вводят коэффициент запаса по току порядка 1,2…1,3.
Параллельное соединение мощных быстродействующих приборов (рис. 13) может приводить к возникновению паразитных высокочастотных колебаний. Для исключения этого, а также для уменьшения влияния разброса заряда переключения в цепи затворов рекомендуется использовать параллельное включение резисторов (см. рис. 13).
Рис. 13
Из-за многих неопределенностей при расчете выбранный тип транзистора обычно с запасом удовлетворяет исходным требованиям.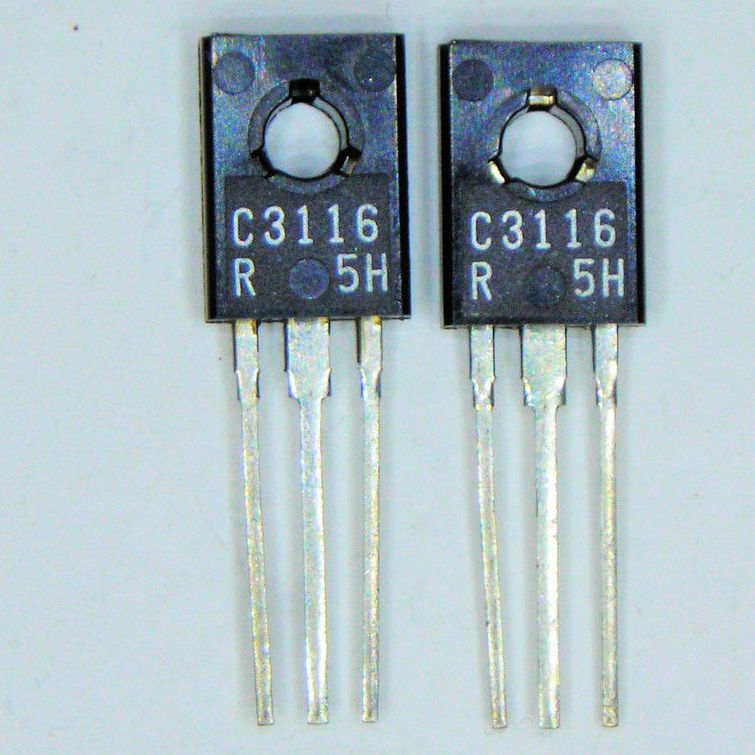 За этот запас приходится платить, и более высокая надежность не всегда компенсирует затраты. Нередко система в целом допускает кратковременные отключения преобразователя энергии. В этом случае можно устранить излишний запас, сохраняя уровень надежности. Для этого используют непосредственный контроль температуры перехода и отключение преобразователя энергии при приближении к опасной температуре. Philips Semiconductors выпускает ряд типов приборов со встроенной логикой контроля температуры кристалла, состояния нагрузки и отключения при ее перегреве или коротком замыкании. Состояние встроенной логики доступно для внешних устройств как логический сигнал «флаг» (см. BUK106-50L).
За этот запас приходится платить, и более высокая надежность не всегда компенсирует затраты. Нередко система в целом допускает кратковременные отключения преобразователя энергии. В этом случае можно устранить излишний запас, сохраняя уровень надежности. Для этого используют непосредственный контроль температуры перехода и отключение преобразователя энергии при приближении к опасной температуре. Philips Semiconductors выпускает ряд типов приборов со встроенной логикой контроля температуры кристалла, состояния нагрузки и отключения при ее перегреве или коротком замыкании. Состояние встроенной логики доступно для внешних устройств как логический сигнал «флаг» (см. BUK106-50L).
Выбор алгоритма и частоты переключения
Алгоритм переключения характеризует последовательность включения-выключения транзисторов и величину управляющих сигналов, от которой зависит скорость переключения. Для наиболее распространенных мостовых схем следует оценивать два уровня алгоритма: управление транзисторами стойки и управление стойками. При этом мы исходим из того, что от алгоритма управления зависят затраты на ограничение сквозного тока, сложность управляющего устройства, амплитуда и частота пульсаций напряжения нагрузки. По этим признакам можно предварительно выбрать алгоритм, не рассматривая на этом этапе конкретные решения по устройству управления.
При этом мы исходим из того, что от алгоритма управления зависят затраты на ограничение сквозного тока, сложность управляющего устройства, амплитуда и частота пульсаций напряжения нагрузки. По этим признакам можно предварительно выбрать алгоритм, не рассматривая на этом этапе конкретные решения по устройству управления.
Для стойки возможны три способа управления:
- переключение одного транзистора при запертом другом;
- противофазное переключение обоих транзисторов одновременно;
- противофазное управление с задержкой включения.
В первом случае ток нагрузки в паузе замыкается через блокирующий диод. Прямое падение напряжения на нем обычно заметно больше, чем на открытом полевом транзисторе. Поэтому второй способ управления дает меньшие статические потери энергии. Однако при этом возрастают динамические потери и требуется цепь ограничения сквозного тока. Третий способ дает минимум затрат на ограничение сквозного тока, но усложняет требования к устройству управления.
Для однофазной мостовой схемы (независимо от способа управления «внутри» стойки) наиболее распространены следующие способы управления:
- противофазное переключение стоек;
- переключение одной стойки при фиксированном состоянии другой;
- симметричное переключение стоек (при нулевом выходном напряжении обе стойки переключаются синфазно с коэффициентом заполнения, равным 0,5; для изменения выходного напряжения коэффициент заполнения одной стойки увеличивается, а другой уменьшается, причем временные диаграммы сигналов управления стойками симметричны относительно друг друга).
Первый способ приводит к наименьшим затратам на устройство управления, последний — к наибольшим, поскольку (в зависимости от способа переключения внутри стойки) требует до четырех независимых каналов ШИМ.
Наибольшая амплитуда пульсаций выходного напряжения в первом случае равна напряжению питания, во втором и третьем — половине напряжения питания. Частота пульсаций в первом и втором случаях равна частоте переключения стойки, в третьем — в два раза больше.
Амплитуда управляющих сигналов влияет на величину динамических потерь в ключах. Чем она больше, тем быстрее заряжаются/разряжаются паразитные емкости транзисторов, тем меньше время переключения и динамические потери. Однако при этом растет уровень электромагнитных помех, генерируемых преобразователем, и частотный спектр этих помех расширяется в область высоких частот. Увеличение амплитуды приводит и к росту затрат на управляющее устройство. В конечном итоге амплитуду выбирают после определения частоты переключения и способа управления как компромисс между потерями энергии, помехами и затратами.
Частота и амплитуда пульсаций определяют величину переменной составляющей тока нагрузки и, следовательно, дополнительные потери в меди двигателя. С ростом частоты эти потери уменьшаются, но увеличиваются динамические потери в силовых ключах. Выбор значения частоты диктуется стремлением минимизировать суммарные потери. Кроме того, частота влияет на уровень электромагнитного излучения и акустических шумов. Однако эти факторы чрезвычайно сложно рассчитать, поэтому их учитывают уже по результатам натурных испытаний.
Однако эти факторы чрезвычайно сложно рассчитать, поэтому их учитывают уже по результатам натурных испытаний.
Таким образом, алгоритм и частота переключений определяются с учетом всех названных факторов и требований к электроприводу в целом. В современных системах электропривода, использующих импульсные регуляторы и инверторы на мощных полевых транзисторах, при не слишком малой электромагнитной постоянной времени двигателя частота переключения составляет 4…16 кГц, а время переключения — 0,2…1 мкс. Для электроприводов с высокомоментными быстродействующими двигателями с малой электромагнитной постоянной времени (менее 1 мс) частота пульсаций обычно составляет 20…50 кГц, что легко достижимо при симметричном управлении, когда частота переключения стоек вдвое меньше.
Справочник мощных импортных полевых транзисторов.
Особенностью справочника является то, что импортные полевые транзисторы взяты из прайсов интернет-магазинов. |
 | ||||||
|---|---|---|---|---|---|---|---|
| MOSFET транзисторы обладают следующими достоинствами: малая энергия, которую нужно затратить для открывания транзистора. Этот параметр хоть и растет с увеличением частоты, но все равно остается гораздо меньшей, чем у биполярных транзисторов. У MOSFET транзисторов не времени обратного восстановления , как у биполярных и «хвоста», как у IGBT транзисторов, в связи с чем могут работать в силовых схемах на более высоких частотах. Кроме того, у MOSFET нет вторичного пробоя, и поэтому они более стойки к выбросам самоиндукции. | ||||||
| | |||||||
| Отечеств. | Корпус | Тип | Imax, A | Импортн. | Корпус | ||
| Ограничения по длительному току, накладываемые корпусом: ТО220 не более 75А, ТО247 не более 195А. В реальных условиях отвода тепла эти цифры в несколько раз меньше. | |||||||
| Полевые транзисторы на напряжение до 40В: | |||||||
| КП364 | ТО-92 | n | 0.02 | кп364 — полевой транзистор 40В 0.1А, характеристики | |||
| КП302 | ТО-92 | n | 0.04 | транзистор кп302 на 40В 0.1А | |||
| 2П914А | ТО-39 | n | 0.1(0.2) | BSS138 2SK583 | sot23 TO-92 | полевой транзистор 2п924 на 40В 0.1А | |
| КП601 | ТО-39 | n | 0.4 | полевой транзистор кп601 на 40В 0.15А | |||
КП507 | ТО-92 | p | 0. 6 61.1 | TP2104 | TO-92, sot23 sot23 | полевой транзистор кп507на 40В 0.3А | |
| n | 1.6 | BSP295 | sot223 | импортный полевой smd транзистор BSP295 | |||
| n | 2 | RTR020N05 | sot23 | полевой транзистор для поверхностного монтажа на 40В 2А с защитным стабилитроном в затворе | |||
| n | 4 | NTR4170 | sot23 | ||||
| n | 5 | PMV60EN | sot23 | ||||
| n | 6 | BSP100 | sot223 | ||||
| КП921А | TO-220 | n | 10 | мощный полевой транзистор КП921 на 40В 10А для применения в быстродействующих переключающих устройствах | |||
| КП954Г | TO-220 | n | 20(18) | FDD8424 | TO-252 | мощный полевой транзистор КП954 на 40В 20А для источников питания | |
| n | 34 | BUZ11 | TO-220 | импортный MOSFET транзистор BUZ11 на 40В 34А | |||
| 2П7160А | TO-258 | n | 46(42) | IRFR4104 | TO-252 | характеристики мощного MOSFET IRF4104 | |
| n | 100 | IRF1104 | TO-220 | MOSFET транзистор IRF1104 на 40В 100А | |||
| n | 162 | IRF1404 | TO-220 | MOSFET транзистор IRF1404 на 40В 162А. Подробные характеристики см. в datasheet Подробные характеристики см. в datasheet | |||
| n | 210 | IRF2204 | TO-220 | импортный полевой транзистор IRF2204 на 40В 210А | |||
| n | 280 | IRF2804 | TO-220 | импортный полевой транзистор IRF2804 на 40В 280А | |||
| n | 350 | IRFP4004 | TO-247 | мощный полевой транзистор с изолированным затвором IRFP4004 с током до 195А | |||
| MOSFET транзисторы на напряжение до 60-75В: | |||||||
| n | 0.2 0.5 | 2N7000 BS170 | TO-92, sot23 | smd маломощный полевой транзистор BS170 на 60В 0.2А для поверхностного монтажа | |||
| КП804А | ТО-39 | n | 1 | ||||
| КП505 А-Г | ТО-92 | n | 1. 4 42.7 | IRFL014 | sot223 | импортный полевой транзистор irfl014 на 60В 0.1А для поверхностного монтажа | |
| КП961Г | ТО-126 | n | 5 | транзистор КП961Г на 60В 0.5А | |||
| КП965Г | ТО-126 | n | 5 | транзистор КП965Г на 60В 0.5А | |||
| КП801 (А,Б) | ТО-3 | n | 5 | ||||
| КП739 (А-В) | ТО-220 | n | 10 | IRF520 | ТО-220 | импортный полевой транзистор IRF520, характеристики | |
| КП740 (А-В) | ТО-220 | n | 17 | STP16NF06 | TO-220 | на 60В 15А | |
| КП7174А | ТО-220 | n | 18 | ||||
| КП784А | ТО-220 | p | 18 | ||||
| КП954 В,Д | ТО-220 | n | 20 | STP20NF06 | TO-220 | мощный полевой транзистор КП954 на 60В 20А | |
| 2П912А | ТО-3 | n | 25 | полевой транзистор 2П912А на 60В и ток 25А | |||
| КП727(А,Б) | ТО-220 | | n p | 30 31 | STP36NF06 IRF5305 | ТО-220 | мощный полевой транзистор КП727А на 60В 30А |
| КП741 (А,Б) | ТО-220 | n | 50 | IRFZ44 | TO-220 | мощный полевой транзистор irfz44 на 60В и ток 50А. Подробные характеристики см. в datasheet. Подробные характеристики см. в datasheet. | |
| КП723(А-В) | ТО-220 | n | 50 | STP55NF06 | TO-220 | отечественный мощный полевой транзистор КП723 на 60В и ток до 50А | |
| КП812(А1-В1) | ТО-220 | n | 50 | отечественный MOSFET транзистор КП812 на 60В и ток до 50А | |||
| 2П7102Д | ТО-220 | n | 50 | MOSFET транзистор 2П7102 на 60В и ток до 50А | |||
| КП775(А-В) | ТО-220 | n | 50(60) | STP60NF06 | TO-220 | полевой транзистор КП775 на напряжение до 60В и ток до 50А | |
| КП742(А,Б) | ТО-218 | n n n p | 80 80 82 74 | SPB80N08 IRF1010 IRF2807 IRF4905 | TO-220, D2PAK ТО-220 ТО-220 ТО-220 | полевой транзисторы irf1010, irf2807, irf4905 на 60В и ток до 80А | |
| n | 140 169 | IRF3808 IRF1405 | ТО-220 ТО-220 | MOSFET транзистор irf3808 на 60В и ток до 140А | |||
| n | 210 | IRFB3077 | ТО-220 | полевой транзистор irfb3077 на 75В и ток 210А | |||
| n | 350 | IRFP4368 | ТО-247 | мощный полевой транзистор irfp4368 на напряжение 75В ток до 195А | |||
| MOSFET на напряжение до 100-150В: | |||||||
| КП961В | ТО-126 | n | 5 | ||||
| КП965В | ТО-126 | p | 5(6. 8) 8) | IRF9520 | ТО-220 | p-канальный импортный полевой транзистор IRF9520 на напряжение до 100В, ток до7А | |
| КП743 (А1-В1) | ТО-126 | n | 5.6 | ||||
| КП743 (А-В) | ТО-220 | n | 5.6 | IRF510 | ТО-220 | mosfet транзистор IRF510 на напряжение до 100В, ток до 6А. | |
| КП801В | ТО-3 | n | 8 | IRFR120 | DPAK | ||
| КП744 (А-Г) | ТО-220 | n | 9.2 | IRF520 | TO-220 | импортный полевой транзистор IRF520 на напряжение до 100В и ток до 9А | |
| КП922 (А,Б) | ТО-3 | n | 10 | BUZ72 | TO-220 | mosfet транзистор BUZ72 с током до 10А | |
| КП745 (А-В) | ТО-220 | n | 14 | IRF530 | ТО-220 | транзистор IRF530 на напряжение до 100В и ток до 14А | |
| КП785А | ТО-220 | p | 19 | IRF9540 | ТО-220 | импортный p-канальный полевой транзистор IRF9540 на ток до 19А | |
| 2П7144А | ТО-220 | p | 19 | мощный p-канальный полевой транзистор 2П7144 на 100В и ток до 19А | |||
| КП954Б | ТО-220 | n | 20 | IRFB4212 | TO-220 | параметры мощного MOSFET транзистора IRFB4212 | |
| 2П912А | ТО-3 | n | 20 | мощный n-канальный полевой транзистор 2П912 на напряжение 100В и ток до 20А | |||
| КП746(А-Г) | ТО-220 | n | 28 | IRF3315 | ТО-220 | импортный полевой транзистор IRF3315 на ток до 28А | |
| 2П797Г | ТО-220 | n | 28 | IRF540 | ТО-220 | импортный полевой транзистор IRF540 на ток до 28А | |
| КП769(А-Г) | ТО-220 | n | 28 | мощный полевой транзистор КП769 на напряжение до 100В и ток до 28А | |||
КП150 | ТО-218 | n | 33 34 38 | IRF540NS BUZ22 | TO-220, D2PAK TO-220 | мощный полевой транзистор irf540 на 100В и ток 34А | |
| КП7128А,Б | ТО-220 | p | 40 | IRF5210 | ТО-220 | mosfet транзистор irf5210 на 100В и ток до 40А | |
| КП771(А-Г)
| ТО-220
|
| n | 40 42 47 | IRF1310 PHB45NQ10 | ТО-220 TO-247, D2PAK | отечественный полевой транзистор КП771 на 100В 40А и его импортный аналог irf1310 |
| n | 57 | STB40NF10 IRF3710 | smd ТО-220 | мощный полевой транзистор irf3710 на 100В 57А | |||
| n | 72 | IRFP4710 | ТО-247 | mosfet транзистор irf4710 на 100В и ток до 72А | |||
| n | 171 | IRFP4568 | ТО-247 | полевой тразистор irf4568 на 150В 171А | |||
| n | 290 | IRFP4468 | ТО-247 | мощный полевой транзистор irf4468 на 100В 195А | |||
| Полевые транзисторы на напряжение до 200В: | |||||||
| КП402А | ТО-92 | p | 0.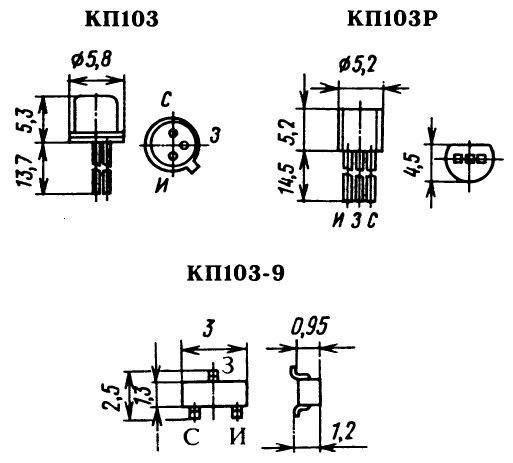 15 15 | BSS92 | TO-92 | ||
| КП508А | ТО-92 | p | 0.15 | ||||
| КП501А | ТО-92 | n | 0.18 | BS107 | TO-92 | ||
| КП960В | ТО-126 | p | 0.2 | ||||
| КП959В | ТО-126 | n | 0.2 | ||||
| КП504В | ТО-92 | n | 0.2 | BS108 | ТО-92 | ||
| КП403А | ТО-92 | n | 0.3 | ||||
| КП932А | ТО-220 | n | 0.3 | ||||
| КП748 (А-В) | ТО-220 | n | 3.3 | IRF610 | ТО-220 | mosfet транзистор IRF610 с напряжением до 200В и на ток до 3А | |
| КП796В | ТО-220 | p | 4.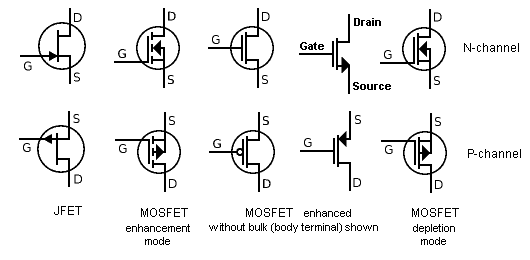 1 1 | BUZ173 | TO-220 | ||
| КП961А | ТО-126 | n | 5 | IRF620 | TO-220 | полевой транзистор IRF620 на 200В 5А | |
| КП965А | ТО-126 | p | 5 | ||||
| КП749 (А-Г) | ТО-220 | n | 5.2 | ||||
| КП737 (А-В) | ТО-220 | n | 9 | IRF630 | ТО-220 | mosfet транзистор irf630 на ток до 9А и напряжение до 200В | |
| КП704 (А,Б) | ТО-220 | n | 10 | mosfet на 200В 10А | |||
| КП750 (А-В) | ТО-220 | n | 18 | IRF640 IRFB17N20 | TO-220 | mosfet транзистор IRF640 (200В 18А) | |
| КП767 (А-В) | ТО-220 | n | 18 | ||||
| КП813А1,Б1 | ТО-220 | n | 22 | BUZ30A IRFP264 | TO-220 TO-247 | мощный полевой транзистор irf264 на 200В 20А | |
| КП250 | ТО-218 | n | 30(25) | IRFB4620 | TO-220 | ||
| 2П7145А,Б | КТ-9 | n | 30 | IRFB31N20 | TO-220 | мощный полевой транзистор 2П7145 (200В 30А) | |
| КП7177 А,Б | ТО-218 | n | 50(62) | IRFS4227 | D2PAK | характеристики MOSFET транзистора на 200В 50А | |
| n | 130 | IRFP4668 | TO-247 | мощный импортный полевой транзистор irfp4668 на 200В 130А | |||
| Полевые транзисторы на напряжение до 300В: | |||||||
| КП960А | ТО-126 | p | 0. 2 2 | ||||
| КП959А | ТО-126 | n | 0.2 | ||||
| КП796Б | ТО-220 | p | 3.7 | ||||
| 2П917А | ТО-3 | n | 5 | ||||
| КП768 | ТО-220 | n | 10 | ||||
| КП934Б | ТО-3 | n | 10 | ||||
| КП7178А | ТО-218 ТО-3 | n | 40 | ||||
| Полевые транзисторы до 400В: | |||||||
| КП502А | ТО-92 | n | 0.12 | ||||
| КП511А,Б | ТО-92 | n | 0.14 | ||||
| КП733А | ТО-220 | n | 1. 5 5 | ||||
| КП731 (А-В) | ТО-220 | n | 2 | IRF710 | ТО-220 | mosfet транзистор IRF710 | |
| КП751 (А-В) | ТО-220 | n | 3.3 | BUZ76 IRF720 | ТО-220 TO-220 | mosfet транзистор IRF720, характеристики | |
| КП931 В | ТО-220 | n | 5 | IRF734 | ТО-220 | mosfet транзистор IRF734 | |
| КП768 | ТО-220 | n | 5.5 | IRF730 | ТО-220 | mosfet транзистор IRF730 | |
| КП707А1 | ТО-220 | n | 6 | ||||
| КП809Б | ТО-218 ТО-3 | n | 9.6 | ||||
| КП934А | ТО-3 | n | 10 | IRF740 | ТО-220 | mosfet транзистор IRF740 | |
| КП350 | ТО-218 | n | 14 | BUZ61 | TO-220 | mosfet транзистор BUZ61 | |
| 2П926 А,Б | ТО-3 | n | 16.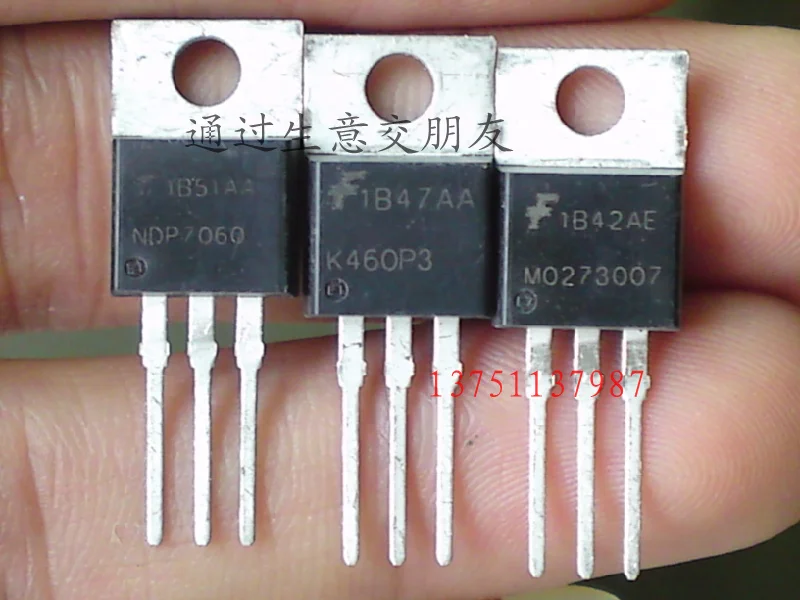 5 5 | ||||
| n | 18.4 | STW18NB40 | TO-247 | импортный полевой транзистор на 400В 18А | |||
| КП707А | ТО-3 | n | 25 | IRFP360 | TO-247 | mosfet на 400В 25А | |
| Полевые транзисторы на напряжение до 500В: | |||||||
| КП780 (А-В) | ТО-220 | n | 2.5 | IRF820 | ТО-220 | mosfet транзистор IRF820 | |
| КП770 | ТО-220 | n | 8 | IRF840 | TO-220 | mosfet транзистор IRF840 | |
| КП809Б,Б1 | ТО-218 ТО-3 | n | 9.6 | 2SK1162 | ТО-3Р | mosfet транзистор 2SK1162 | |
| КП450 | ТО-218 | n | 12 | IRFP450 | TO-247 | мощный полевой транзистор 500В 14А | |
| КП7182А | ТО-218 | n | 20 | IRFP460 | ТО-247 | ||
| КП460 | ТО-218 | n | 20(23) | IRFP22N50 | TO-247 | мощный полевой транзистор IRF22N50 на 500В 20А | |
| КП7180А,Б | ТО-218 ТО-3 | n | 26(31) | IRFP31N50 STW30NM50 | TO-247 TO-247,TO-220 | мощный полевой транзистор 500В 31А | |
| n | 32 | SPW32N50 | TO-247 | мощный полевой транзистор на 500В 32А | |||
| n | 46 | STW45NM50 IRFPS40N50 | TO-247 S-247 | мощный полевой транзистор на 500В 46А | |||
| Полевые транзисторы на напряжение до 600В: | Раздел: высоковольтные полевые транзисторы.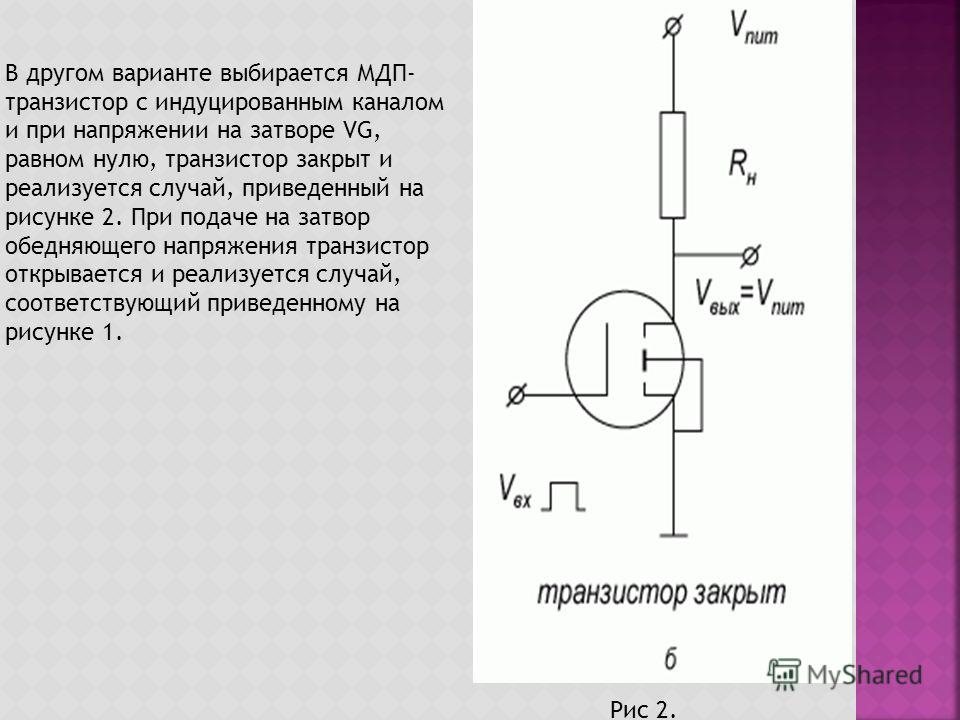 | ||||||
| КП7129А | ТО-220 | n | 1.2 | SPP02N60 | TO-220 | высоковольтный полевой транзистор SPP02N60 на 600В | |
| КП805 (А-В) | ТО-220 | n | 4(3) | SPP03N60 | TO-220 | высоковольтный MOSFET транзистор SPP03N60, характеристики | |
| КП709(А,Б) | ТО-220 | n | 4 | IRFBC30 | ТО-220 | высоковольтный MOSFET транзистор IRFBC30, характеристики | |
| КП707Б1 | ТО-220 | n | 4 | SPP04N60 | ТО-220 | мощный высоковольтный полевой транзистор SPP04N60 на 600В | |
| КП7173А | ТО-220 | n | 4 | ||||
| КП726 (А,Б) | smd ТО-220 | n | 4.5 | ||||
| КП931Б | ТО-220 | | n | 5(6. 2) 2)7 | IRFBC40 SPP07N60 | TO-220 TO-220 | MOSFET транзистор 600В 5А |
| КП809В | ТО-218 ТО-3 | n | 9.6 | IRFB9N65A | TO-220 | мощный высоковольтный полевой транзистор IRFB9N65 на 600В | |
| 2П942В | ТО-3 | n | 10 | SPP11N60 | ТО-220 | MOSFET транзистор 600В 10А | |
| КП953Г | ТО-218 | n | 15 | ||||
| КП707Б | ТО-3 | n | 16.5 | SPP20N60 SPW20N60 | ТО-220 TO-247 | MOSFET транзистор 600В 15А | |
| n | 30 | STW26NM60 | TO-247 | полевой транзистор 600В 30А | |||
| КП973Б | ТО-218 | n | 30 | IRFP22N60 IRFP27N60 | TO-247 | MOSFET транзистор 600В 30А | |
| n | 40 | IRFPS40N60 | S-247 | MOSFET транзистор 600В 40А | |||
| n | 47 | SPW47NM60 FCh57N60 | TO-247 | MOSFET транзистор 600В 47А | |||
| n | 60 | IPW60R045 | TO-247 | MOSFET транзистор 600В 47А | |||
| Полевые транзисторы на напряжение до 700В: | |||||||
| КП707В1 | ТО-220 | n | 3 | ||||
| КП728 (Г1-С1) | ТО-220 | n | 3. 3 3 | ||||
| КП810 (А-В) | ТО-218 | n | 7 | ||||
| КП809Е | ТО-218 ТО-3 | n | 9.6 | мощный высоковольтный полевой транзистор на 700В | |||
| 2П942Б | ТО-3 | n | 10 | MOSFET транзистор 700В 10А | |||
| КП707В | ТО-3 | n | 12.5 | мощный полевой транзистор 700В 12А | |||
| КП953В | ТО-218 | n | 15 | MOSFET транзистор 700В 15А | |||
| КП973А | ТО-218 | | n | 30 39 | IPW60R075 | TO-247 | полевой транзистор (IRF) 650В 25А |
| n | 60 | IPW60R045 | TO-247 | полевой транзистор (IRF) 650В 38А | |||
| Полевые транзисторы на напряжение до 800В: | |||||||
| n | 1. 5 5 | BUZ78 IRFBE20 | ТО-220 TO-220 | высоковольтный MOSFET транзистор IRFBE20, характеристики | |||
| КП931А | ТО-220 | n | 5 | IRFBE30 | ТО-220 | высоковольтный MOSFET транзистор IRFBE30, характеристики | |
| КП705Б,В | ТО-3 | n | 5.4 | SPP06N80 | ТО-220 | высоковольтный MOSFET транзистор SPP06N80, характеристики | |
| КП809Д | ТО-218 ТО-3 | n | 9.6 | STP10NK80 | TO-220 | мощный полевой транзистор 800В 10А | |
| 2П942А | ТО-3 | n | 10 | STP12NK80 | TO-247 | MOSFET транзистор 800В 10А | |
| КП7184А | ТО-218 | n | 15 | SPP17N80 | ТО-220 | мощный полевой транзистор 800В 15А | |
| КП953А,Б,Д | ТО-218 | n | 15 | MOSFET транзистор 800В 15А | |||
| КП971Б | ТО-218 | n | 25(55) | SPW55N80 | TO-247 | MOSFET транзистор 800В 25А | |
| MOSFET транзисторы на напряжение до 900-1000В: | |||||||
| 2П803А,Б | n | 4. 5(3.1) 5(3.1) | IRFBG30 | TO-220 | высоковольтный полевой транзистор IRFG30 на 900В | ||
| КП705А | ТО-3 | n | 5.4(8) | IRFPG50 2SK1120 | TO-247 TO-218 | мощный высоковольтный полевой транзистор 2SK1120 на 1000В | |
| КП971А | ТО-218 | n | 25(36) | IPW90R120 | TO-247 | высоковольтный mosfet 900В 30А | |
Мощный полевой транзистор в Украине. Цены на Мощный полевой транзистор на Prom.ua
Работает
Окснер Э.С. Мощные полевые транзисторы и их применение. Перевод с английского.
Доставка по Украине
412 грн
Купить
MaxBook
Работает
Транзистор полевой IRLZ44N
Доставка по Украине
31 грн
Купить
Электро Радио Груп — 1-й магазин электрики и радиоэлектроники
Работает
Транзистор полевой IRL3803 N-ch 30V 120A TO220
Доставка из г. Днепр
Днепр
44 грн
Купить
Інтернет-магазин «Електроніка»
Работает
Транзистор полевой AO3400A N-ch 30V 5.7A SOT23
Доставка из г. Днепр
5.90 грн
Купить
Інтернет-магазин «Електроніка»
Работает
Транзистор полевой BS107P N-ch 200V 0.12A TO92
Доставка из г. Днепр
27.20 грн
Купить
Інтернет-магазин «Електроніка»
Работает
Транзистор полевой FDD7N60NZ N-ch 600V 7.4A DPAK
Доставка из г. Днепр
43.50 грн
Купить
Інтернет-магазин «Електроніка»
Работает
Транзистор полевой FDS3890 Dual N-ch 80V 4.7A SO8
Доставка из г. Днепр
83.70 грн
Купить
Інтернет-магазин «Електроніка»
Работает
Чип IRFZ44N IRFZ44 TO220, Транзистор полевой
Доставка из г. Львов
72 — 115 грн
от 3 продавцов
125 грн
114 грн
Купить
ІНТЕРНЕТ-МАГАЗИН «ЗАКУПИСЬ»
Работает
IRFB4227PBF INFINEON TO-220AB 65A 200V транзистор полевой N-канальный
Доставка из г. Днепр
Днепр
от 176.54 грн
Купить
ТОВ СIБАРIС ГРУП
Работает
IRF640N IR TO-220AB 18A 200V транзистор полевой N-канальный
Доставка из г. Днепр
от 22.28 грн
Купить
ТОВ СIБАРIС ГРУП
Работает
IRF3205PBF Infineon TO-220AB 110A 55V транзистор полевой N-канальный
Доставка из г. Днепр
от 28.28 грн
Купить
ТОВ СIБАРIС ГРУП
Работает
IRFZ48NPBF IR TO-220AB 64A 55V транзистор полевой N-канальный
Доставка из г. Днепр
от 24.85 грн
Купить
ТОВ СIБАРIС ГРУП
Работает
IRFP150NPBF IR TO-247AC 42A 100V транзистор полевой N-канальный
Доставка из г. Днепр
от 96.41 грн
Купить
ТОВ СIБАРIС ГРУП
Работает
Транзистор IRFPS37N50A , транзистор 2N1671A
Доставка из г. Днепр
от 110 грн
Купить
ТОВ «ЕЛЕКТРОЛОГІСТИК»
Работает
Транзистор MPS750 , транзистор IRF640N , транзистор IRF3205 , IRF640N
Доставка из г. Днепр
от 10 грн
Купить
ТОВ «ЕЛЕКТРОЛОГІСТИК»
Смотрите также
Работает
Транзистор полевой FDS8958A P-ch + N-ch 30V -5/7A SO8
Доставка из г. Днепр
Днепр
14.90 грн
Купить
Інтернет-магазин «Електроніка»
Работает
Транзистор полевой FQP10N60C N-ch 600V 9.5A TO220F
Заканчивается
Доставка по Украине
31 грн
Купить
Інтернет-магазин «Електроніка»
Работает
IRFP360PBF VISHAY TO-247AC 23A 400V транзистор полевой N-канальный
Доставка из г. Днепр
от 100.27 грн
Купить
ТОВ СIБАРIС ГРУП
Работает
Транзистор полевой FQP50N06 N-ch 60V 50A TO220
Доставка из г. Днепр
25.60 грн
Купить
Інтернет-магазин «Електроніка»
Работает
Чип 2N7002 100ШТ N7002 7002 SOT-23 Транзистор полевой 60В 0.2А
Доставка по Украине
61 грн
55 грн
Купить
ІНТЕРНЕТ-МАГАЗИН «ЗАКУПИСЬ»
Работает
IRFP450PBF IR TO-247AC 14A 500V транзистор полевой N-канальный
Доставка из г. Днепр
от 84.41 грн
Купить
ТОВ СIБАРIС ГРУП
Работает
Транзистор полевой FQP6N90C N-ch 900V 6A TO220
Доставка из г. Днепр
Днепр
48.10 грн
Купить
Інтернет-магазин «Електроніка»
Работает
Транзистор полевой FQPF2N60C N-ch 600V 2A TO220F
Доставка из г. Днепр
14 грн
Купить
Інтернет-магазин «Електроніка»
Работает
IRLML6402TRPBF Infineon SOT-23 -3.7A -20V транзистор полевой P-канальный
Доставка из г. Днепр
от 4.43 грн
Купить
ТОВ СIБАРIС ГРУП
Работает
Транзистор полевой FQPF4N90C N-ch 900V 4A TO220F
Доставка из г. Днепр
31 грн
Купить
Інтернет-магазин «Електроніка»
Работает
AOT9N70 AOS TO-220 9A 700V транзистор полевой N-канальный
Доставка из г. Днепр
от 37.28 грн
Купить
ТОВ СIБАРIС ГРУП
Работает
Транзистор полевой IRF1010NPBF N-ch 55V 85A TO220
Доставка из г. Днепр
60.40 грн
Купить
Інтернет-магазин «Електроніка»
Работает
IRF640PBF VISHAY TO-220AB 18A 200V транзистор полевой N-канальный
Доставка из г. Днепр
от 50. 56 грн
56 грн
Купить
ТОВ СIБАРIС ГРУП
Работает
Транзистор полевой IRF1324PBF N-ch 24V 195A TO220
Доставка из г. Днепр
114.90 грн
Купить
Інтернет-магазин «Електроніка»
Мощные радиочастотные VDMOS-транзисторы фирмы Microsemi и модули на их основе
Радиочастотные полевые транзисторы с изолированным затвором класса VDMOS объединяют достоинства полевых транзисторов с вертикальным каналом и приборов DMOS, изготовляемых методом двойной диффузии. Широкую номенклатуру VDMOS выпускает американская компания Microsemi, с вошедшей в нее фирмой Advanced Power Technology (APT). В статье описаны приборы этих компаний с выходной мощностью от нескольких Вт до 2кВт на частоте от 10 до 200МГц и усилители мощности на их основе.
Введение
После освоения в СССР в конце 1970-х годов серийного производства первых в мире мощных полевых транзисторов с горизонтальным каналом КП901–КП904 [1, 2] во многих странах бурное развитие получили мощные полевые транзисторы с V- и U-образной структурой и вертикальным расположением канала. Первыми советскими приборами этого типа были транзисторы КП905, КП907, КП908, КП909, КП913 и др. [3, 5–7]. Их рабочая частота достигала 1–2 ГГц, и на них были отработаны принципы построения радиочастотных усилителей мощности [6, 7].
Первыми советскими приборами этого типа были транзисторы КП905, КП907, КП908, КП909, КП913 и др. [3, 5–7]. Их рабочая частота достигала 1–2 ГГц, и на них были отработаны принципы построения радиочастотных усилителей мощности [6, 7].
К сожалению, дно и стенки V-образной канавки, получаемой методом анизотропного травления, имели неидеальную структуру полупроводника, что вело к локализации электрического поля под ней и вызывало снижение максимального рабочего напряжения стока.
В конце 1970-х и особенно в 1980-х годах большое развитие получили приборы с двойной диффузией — DMOS. Они, по сути, являются гибридом полевого транзистора с горизонтальным каналом и транзистора с вертикальной структурой. Приборы класса DMOS имеют три важных преимущества по сравнению с приборами с V- и U-образной канавками: отсутствие дефектных областей, улучшенное качество затвора и повышенная подвижность носителей в канале. В то же время они характерны большой емкостью структуры и меньшей рабочей частотой.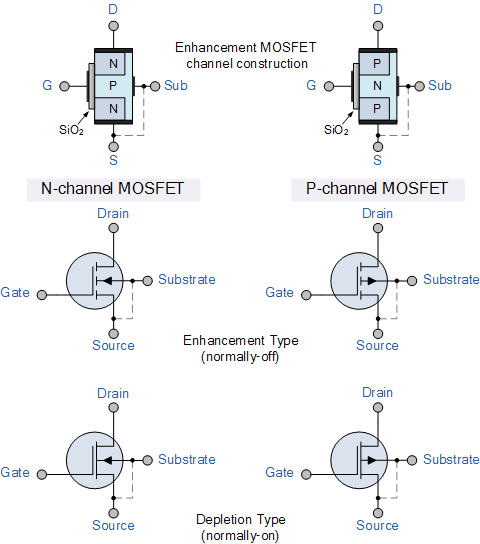 Две серии таких приборов (с выходной мощностью 300 Вт) созданы Воронежским ФГУП и «НИИ электронной техники» [4].
Две серии таких приборов (с выходной мощностью 300 Вт) созданы Воронежским ФГУП и «НИИ электронной техники» [4].
Мощные VDMOS фирмы Microsemi
Мощные полевые транзисторы за рубежом сейчас производит множество фирм, например ST Microelectronics, Mictosemi, IXYS, International Rectifiers, Philips и др. Компания Microsemi (www.microsemi.com) выпускает мощные радиочастотные полевые транзисторы VDMOS (Vertical Diffusion Metal Oxide Seniconductor), в которых объединены достоинства приборов с вертикальной структурой и DMOS-транзисторов.
Структура VDMOS-транзистора показана на рис. 1. Как нетрудно заметить, V- или U-образная канавка у прибора отсутствует, что заметно упрощает технологию его изготовления. Линии тока истока сначала от его металлических областей проходят через тонкий канал под поликристаллическим горизонтальным затвором и затем, переходя в вертикальное положение, собираются стоком в его N-области и низкоомной подложке типа N+.
Параметры ряда серийных VDMOS даны в таблице 1.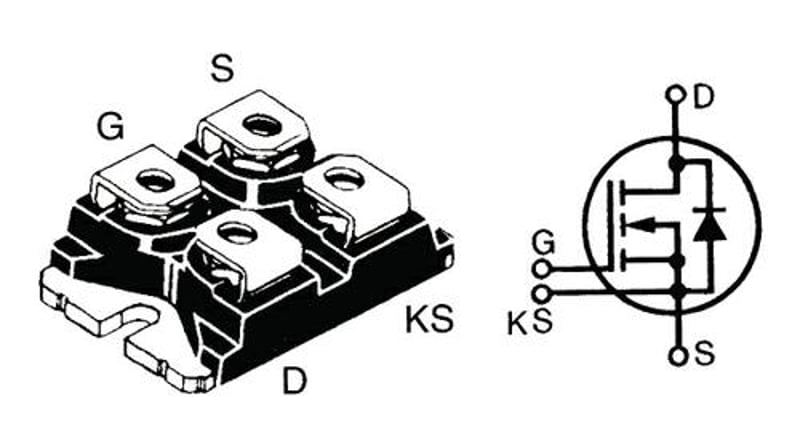 В основном это высоковольтные приборы. По сравнению с приборами LDMOS (ST Microelectronics и Philips [5]) значения рабочей частоты приборов ниже (до 200МГц), но зато они имеют выдающиеся энергетические показатели — выходную мощность до 750Вт и максимальное напряжение на стоке 1200В. Некоторые приборы хорошо приспособлены для применения в усилителях мощности с низковольтным питанием от 12 до 50В).
В основном это высоковольтные приборы. По сравнению с приборами LDMOS (ST Microelectronics и Philips [5]) значения рабочей частоты приборов ниже (до 200МГц), но зато они имеют выдающиеся энергетические показатели — выходную мощность до 750Вт и максимальное напряжение на стоке 1200В. Некоторые приборы хорошо приспособлены для применения в усилителях мощности с низковольтным питанием от 12 до 50В).
VDMOS-транзисторы имеют различное корпусное исполнение, обусловленное реализуемыми схемотехническими решениями. Основные типы корпусов, применяемые при производстве мощных VDMOS транзисторов компании Microsemi, представлены на рис. 2. Характерной особенностью всех представленных корпусов является то, что они имеют малую высоту, это позволяет размещать их на достаточно тонкой печатной плате или теплоотводящей пластине.
Знакомство с силовыми VDMOS-транзисторами компании Microsemi начнем с прибора ARF1519. В качестве основных параметров приборов производитель указывает напряжение питания усилителя мощности, выходную мощность и частоту выходного сигнала.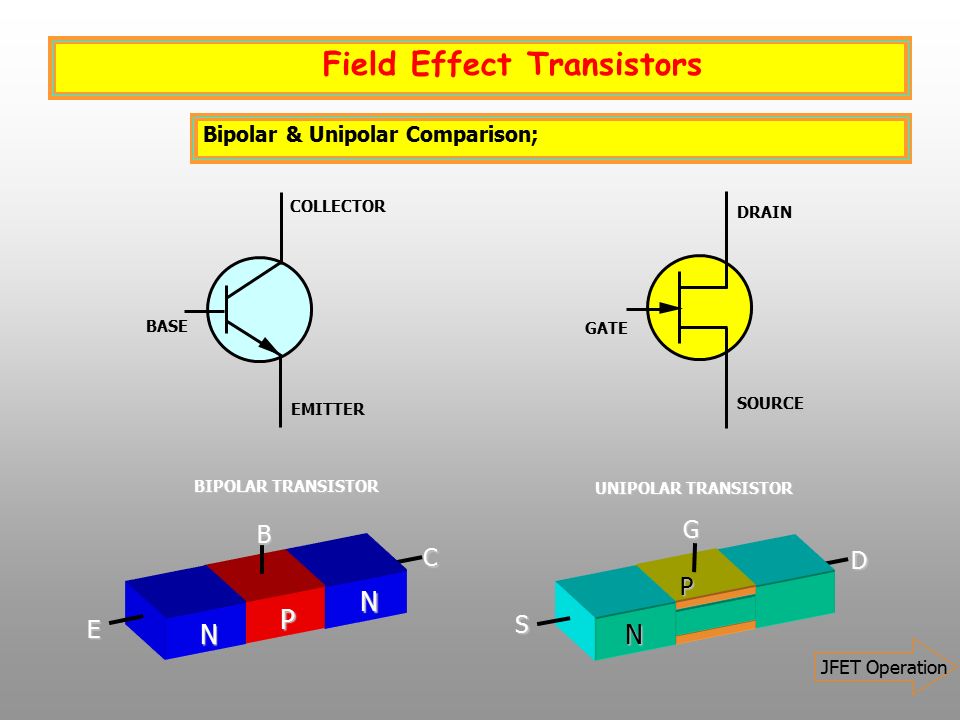 У этого прибора они равны 250В, 750Вт и 25МГц соответственно. При работе резонансного усилителя в классе C напряжение на стоке достигает значений в 3–4 раза выше напряжения питания. Поэтому максимальное рабочее напряжение у этого транзистора нормируется на уровне 1000В. Из приведённых технических характеристик видно, что компонент ARF1519 Microsemi является высоковольтным мощным транзистором с умеренной (для такого класса приборов) максимальной рабочей частотой. В то же время отметим, что она на порядок выше, чем рабочая частота сопоставимого по мощности и напряжению на стоке силового (ключевого) транзистора.
У этого прибора они равны 250В, 750Вт и 25МГц соответственно. При работе резонансного усилителя в классе C напряжение на стоке достигает значений в 3–4 раза выше напряжения питания. Поэтому максимальное рабочее напряжение у этого транзистора нормируется на уровне 1000В. Из приведённых технических характеристик видно, что компонент ARF1519 Microsemi является высоковольтным мощным транзистором с умеренной (для такого класса приборов) максимальной рабочей частотой. В то же время отметим, что она на порядок выше, чем рабочая частота сопоставимого по мощности и напряжению на стоке силового (ключевого) транзистора.
Выходные и передаточные характеристики транзистора ARF1519 показаны на рис. 3. Уровень остаточного напряжения на стоке включенного транзистора достаточно высок: до 15–20В при максимальном рабочем токе. Семейство передаточных характеристик имеет характерную термостабильную точку: в ней кривые пересекаются. Пороговое напряжение транзистора лежит в диапазоне от 2 до 3В.
Постоянный ток стока у VDMOS-транзистора ARF1519 нормируется на уровне 20А, а импульсный ток может превышать 40А. Естественно, такой сильноточный прибор имеет большую ёмкость. Зависимость ёмкости от напряжения «сток-исток» UDS характеризуется резкой нелинейностью (рис. 4). Средние значения ёмкостей: входная — 4600пФ, выходная — 310пФ, проходная — 90пФ. Столь большие значения ёмкости указывают на то, что импедансы входа и выхода у транзистора очень малы, и поэтому особое значение приобретает согласование импедансов транзистора с импедансами источника входного сигнала и нагрузки (обычно 50Ом).
Естественно, такой сильноточный прибор имеет большую ёмкость. Зависимость ёмкости от напряжения «сток-исток» UDS характеризуется резкой нелинейностью (рис. 4). Средние значения ёмкостей: входная — 4600пФ, выходная — 310пФ, проходная — 90пФ. Столь большие значения ёмкости указывают на то, что импедансы входа и выхода у транзистора очень малы, и поэтому особое значение приобретает согласование импедансов транзистора с импедансами источника входного сигнала и нагрузки (обычно 50Ом).
Степень нагрева транзистора определяется значением его термического импеданса Rth (°C/Вт). Зависимость термического импеданса транзистора ARF1519 от длительности импульса тока стока представлена на рис. 5 и позволяет оценить степень допустимого увеличения тока стока от длительности импульса тока при заданном периоде повторения сигнала.
Основные квалификационные параметры транзистора оцениваются при его работе в составе тестовых схем усилителей мощности. Такие схемы SPICE-модели транзисторов для их расчета и моделирования компания Microsemi приводит практически для всех своих транзисторов. На рис. 6 представлена тестовая схема для транзистора ARF1519. Там же приведена спецификация компонентов этой схемы и чертеж варианта монтажа схемы на печатной плате.
На рис. 6 представлена тестовая схема для транзистора ARF1519. Там же приведена спецификация компонентов этой схемы и чертеж варианта монтажа схемы на печатной плате.
Выбор ARF1519 в качестве первого транзистора для ознакомления с продукцией Microsemi не случаен: тестовая схема для него, показанная на рис. 6, — самая простая и наглядная. Это обычный однотактный каскад усилителя мощности на транзисторе, включенном с общим истоком. Для согласования выходного сопротивления генератора входного сигнала (50Ом) с низким входным импедансом полевого транзистора служит обычный ВЧ-трансформатор с большим коэффициентом трансформации (10:1). В стоке транзистора установлен последовательный резонансный контур с емкостной цепью согласования с нагрузкой (тоже 50Ом). Усилитель работает в классе C и развивает на частоте 13,56МГц мощность 750Вт (!). В схеме усилителя нет никакой «экзотики».
Низковольтные сильноточные VDMOS
Теперь рассмотрим транзистор VRG154, предназначенный для применения в устройствах с малым напряжением питания (от 12 до 50В). Максимальное напряжение на стоке этого прибора 170В, непрерывный ток коллектора 60A, а импульсный может достигать удвоенных значений. При этом прибор способен развивать мощность 600Вт на частоте 80 МГц при напряжении питания усилителя мощности 50 В и КПД 75%. Максимальная рассеиваемая на стоке мощность у этого прибора 1350 Вт!
Максимальное напряжение на стоке этого прибора 170В, непрерывный ток коллектора 60A, а импульсный может достигать удвоенных значений. При этом прибор способен развивать мощность 600Вт на частоте 80 МГц при напряжении питания усилителя мощности 50 В и КПД 75%. Максимальная рассеиваемая на стоке мощность у этого прибора 1350 Вт!
Выходные и передаточные характеристики транзистора VRG154 представлены на рис. 7. Выходные характеристики (рис. 7а) демонстрируют малые значения напряжения «сток-исток» при больших (до 60A) токах стока. Именно это обстоятельство позволяет применять эти транзисторы в схемах с низковольтным напряжением питания и рекордно большой выходной мощностью.
На рис. 8 показаны графики зависимости емкостей транзистора от напряжения «сток-исток». Этот мощный прибор имеет большую и резко нелинейную зависимость ёмкости.
Зависимость выходной мощности от входной на частоте 30 и 55МГц для транзистора VRG154 показана на рис. 9. Видно, что выходная мощность транзистора при этих значениях частоты может превышать 1000Вт.
Зависимость теплового импеданса от длительности импульса в импульсном режиме работы дана на рис. 10. Подобные графики зависимости приводятся практически для всех мощных полевых транзисторов фирмы Microsemi.
Тестовая схема однотактного генератора, в которой испытывается транзистор VRG154, показана на рис. 11. Для согласования импедансов используются сложные LC-цепи (двухъячейчатые фильтры) на входе и на выходе с настройкой их с помощью триммеров. Напряжение питания усилителя мощности составляет 50В.
В схеме двухтактного усилителя мощности (рис. 12) пара транзисторов VRG154 способна при напряжении питания 40В отдавать на выходе мощность 1кВт. Для стабилизации напряжения смещения мощных полевых транзисторов и температурной компенсации используется специальный термочувствительный стабилизатор напряжения смещения на интегральной микросхеме IC1. Согласование импедансов источника входного сигнала и входа усилителя обеспечивается с помощью ВЧ-трансформаторов T1. Для согласования выходного импеданса с импедансом нагрузки применены цепи на отрезках линий передачи их коаксиального кабеля [13].
Для согласования выходного импеданса с импедансом нагрузки применены цепи на отрезках линий передачи их коаксиального кабеля [13].
Сверхвысоковольтные VDMOS с напряжением на стоке более 1000 В
Транзистор ARF1505 (рис. 13) — это сверхвысоковольтный мощный полевой транзистор с максимальным напряжением на стоке 1200В, током стока 25А и рассеиваемой мощностью 1500Вт.
Для обеспечения стабильной работоспособности такого мощного транзистора необходимо жестко закрепить его на поверхности радиатора или теплоотводящей пластины. Способ крепления и размеры корпуса этого транзистора представлены на рис. 14.
Графики зависимости емкости от напряжения «сток-исток» у этого прибора нелинейные (рис. 15). При напряжении «сток-исток» 1В они превышают 10 000 пФ, но с ростом этого напряжения быстро падают. В технических данных на этот транзистор указаны следующие средние значения емкостей:
• входная — 5400пФ;
• выходная — 400пФ;
• проходная — 160пФ.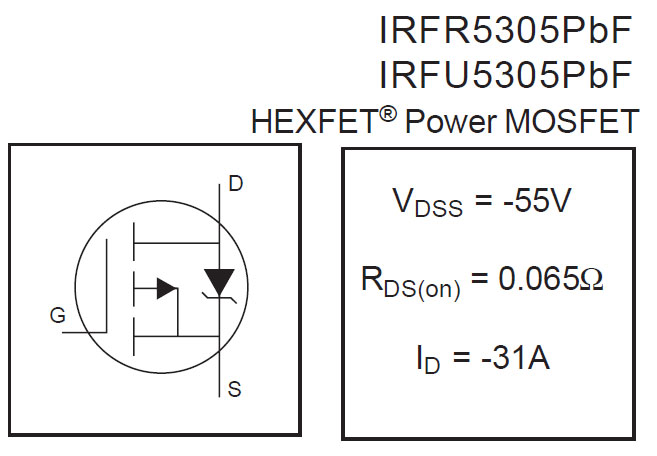
Выходные ВАХ транзистора ARF1505 показаны на рис. 16. Пороговое напряжение отсечки у этих приборов от 3 до 6В. Для сверхвысоковольтного прибора видимые на рис. 16 уровни остаточного напряжения малы. Температурный диапазон работы транзистора лежит в пределах от -55 до +175°C.
Тестовая схема усилителя мощности на частоту 27МГц с напряжением питания 300В показана на рис. 17. Схема проста и от простейших схем отличается отрезком линии передачи во входной цепи. На рис. 17 справа показана конструкция этого усилителя на печатной плате. Выходная мощность усилителя — 750Вт при коэффициенте полезного действия 75% и коэффициенте усиления 17 дБ. Усилитель работает в классе C.
Мощные VDMOS с частотой выходного сигнала более 100 МГц
Представительную, хотя и не очень многочисленную группу VDMOS составляют транзисторы с повышенной (100МГц и выше) частотой выходного сигнала. Их данные приведены в таблице 2.
Одним из таких приборов является высокочастотный транзистор VRF151, изображённый на рис. 18. Свои рабочие параметры он реализует при напряжении питания 50В.
18. Свои рабочие параметры он реализует при напряжении питания 50В.
Почти аналогичный транзистор VRF150 имеет мощность выходного сигнала 150Вт на немного более низкой частоте — 150 МГц. А транзистор VRF141 позволяет получать мощность 150Вт на частоте 175МГц при более низком напряжении питания — 28 В. VRF151 имеет рабочее напряжение на стоке до 170В, ток стока 16A, рассеиваемую на стоке мощность до 300Вт и температурный диапазон работы от -65 до +150°C. Выходные и передаточные характеристики прибора показаны на рис. 19.
Высокочастотные мощные полевые транзисторы имеют на порядок меньшие показатели емкости, чем их менее высокочастотные собратья. Это видно на представленном рис. 20. Средние значения емкостей составляют: входная — 375пФ, выходная — 200пФ и проходная емкость — 12пФ. Эти, вполне умеренные значения емкостей расширяют частотный диапазон работы транзисторов до частот примерно 200МГц.
Графики зависимости выходной мощности от мощности входного сигнала показаны на рис. 21 при двух значениях напряжения питания тестовой схемы — 50 и 40В. Вид этих графиков типовой, и каких-либо особенностей они не имеют.
21 при двух значениях напряжения питания тестовой схемы — 50 и 40В. Вид этих графиков типовой, и каких-либо особенностей они не имеют.
Для ВЧ- и СВЧ-транзисторов часто указывают параметры вносимых ими искажений. На рис. 22 представлены кривые интермодуляционных искажений для транзистора VRF151.
Тестовая схема однотактного усилителя мощности на частоту 175МГц показана на рис. 23.
Ряд транзисторов этой группы выпускается в более дешевых пластмассовых корпусах, рассчитанных на меньшую мощность. Например, это транзистор ARF449 (рис. 24).
Он тестируется в схеме на частоте 81,36МГц. Зависимость мощности выходного сигнала от мощности входного сигнала для усилителя мощности на транзисторе ARF449 показана на рис. 25.
На рис. 26 представлена тестовая схема усилителя мощности на транзисторе ARF449, работающего в классе C. Усилитель обеспечивает мощность выходного сигнала 90Вт, КПД 75% и коэффициент усиления 13дБ.
Сдвоенный мощный низковольтный VDMOS транзистор VRF141G
Для создания двухтактных СВЧ-усилителей мощности с низковольтным 28В питанием (напряжение 28В) служит сдвоенный мощный низковольтный VDMOS VRF141G (рис. 27). Под маркой MRF141G этот прибор выпускает и другой производитель высокочастотных компонентов — компания Motorola. Усилители мощности на этих транзисторах обеспечивают мощность 300Вт на частоте 175 МГц при напряжении питания 28В.
27). Под маркой MRF141G этот прибор выпускает и другой производитель высокочастотных компонентов — компания Motorola. Усилители мощности на этих транзисторах обеспечивают мощность 300Вт на частоте 175 МГц при напряжении питания 28В.
Выходные ВАХ и передаточные характеристики одного транзистора VRF141G показаны на рис. 28, а зависимость емкостей этих приборов от напряжения «сток-исток» приведена на рис. 29. Это типичные характеристики для мощных низковольтных VDMOS полевых транзисторов.
Типовой является и характеристика зависимости параметров емкостей (для одного транзистора) от напряжения «сток-исток».
На рис. 30 представлена тестовая схема двухтактного усилителя мощности на сдвоенном мощном VDMOS VRF141G. Входной фазоинвертор и устройство согласования входного импеданса с импедансом источника входного сигнала выполнены по схеме широкополосного трансформатора на трех отрезках коаксиального кабеля. Выходной трансформатор также построен на трех отрезках коаксиального кабеля. Приняты меры по ослаблению проникновения гармоник выходного сигнала в цепь источника питания с напряжением 28В. Усилитель обеспечивает КПД в 50% и типовой коэффициент усиления 14дБ на частоте 175МГц.
Приняты меры по ослаблению проникновения гармоник выходного сигнала в цепь источника питания с напряжением 28В. Усилитель обеспечивает КПД в 50% и типовой коэффициент усиления 14дБ на частоте 175МГц.
Мощные высоковольтные сверхскоростные VDMOS транзисторы со встроенными драйверами
Особенно высокими энергетическими показателями обладают мощные высоковольтные VDMOS со встроенным драйвером управления затвором (табл. 3). По существу, это гибридные микросхемы, содержащие мощные транзисторы с драйверами и ряд бескорпусных компонентов внутри единого корпуса. Применение встроенного драйвера (или двух драйверов в приборах с двумя мощными транзисторами) обеспечивает время переключения мощных приборов в единицы нс, что позволяет использовать их в усилителях класса D (работающих в ключевом режиме) с частотой выше 10МГц с высоким КПД до 90%.
На рис. 31 показан одиночный (N = 1) мощный высоковольтный транзистор DRF1200 со встроенным драйвером управления затвором. Драйвер требует дополнительного напряжения питания 15–18В. Входное напряжение драйвера 3В. Прибор DRF1201 содержит два параллельно включенных VDMOS транзистора, что увеличивает ток стока до 26A.
Драйвер требует дополнительного напряжения питания 15–18В. Входное напряжение драйвера 3В. Прибор DRF1201 содержит два параллельно включенных VDMOS транзистора, что увеличивает ток стока до 26A.
Функциональная схема драйвера показана на рис. 32. Драйвер построен на основе скоростного триггера Шмитта и двухтактной схемы быстрого заряда-разряда входной емкости мощного полевого транзистора, куда входят комплементарные полевые транзисторы средней мощности.
На рис. 33 представлена схема, в которой тестируется прибор. По существу, это схема ключа на мощном полевом транзисторе с резистивной нагрузкой RL.
На рис. 34 приведены осциллограммы процессов переключения ключа на транзисторе DRF1200 с драйвером. Напряжение питания ключа 800В, сопротивление нагрузки 51Ом. Время выключения ключа в 3,4нс — это очень малое значение для такого мощного ключа. Сопротивление «сток-исток» включенного транзистора 0,9Ом. Максимальное напряжение на стоке полевого транзистора — 1000В, максимальная рассеиваемая транзистором мощность — 360Вт. Типовые значения емкостей: входная — 2000пФ, выходная — 165пФ, проходная — 75пФ.
Типовые значения емкостей: входная — 2000пФ, выходная — 165пФ, проходная — 75пФ.
Печатная плата тестовой схемы ключа на транзисторе DRF1200 показана на рис. 35. Благодаря тестированию во временной, а не в частотной области, конструкция платы заметно упрощена. Разумеется, прибор можно использовать и в частотной области для построения усилителей мощности с частотой до 30МГц. Транзистор DRF1200 предназначен для построения усилителей мощности класса E и преобразователей с импульсным регулированием.
Выпускаются также мощные двойные (N = 2) высоковольтные VDMOS DRF1301 (рис. 36) для двухтактных устройств. Их применение может упростить построение некоторых устройств мощной усилительной и преобразовательной техники.
Для демонстрации возможностей мощных VDMOS со встроенными драйверами фирма Microsemi выпускает ряд генераторов мощных синусоидальных сигналов с выходной мощностью от 600 до 2500Вт. Два из них показаны на рис. 37.
Прибор VDMOS DRF1400 содержит полумост из двух высоковольтных транзисторов с драйверами затвора [13]. Он предназначен для построения усилителей, работающих в классе D (в ключевом режиме) (рис. 38). Их транзисторы управляются прямоугольными импульсами с широтно-импульсной модуляцией. Когда верхний транзистор открыт, нижний — закрыт. И наоборот.
Он предназначен для построения усилителей, работающих в классе D (в ключевом режиме) (рис. 38). Их транзисторы управляются прямоугольными импульсами с широтно-импульсной модуляцией. Когда верхний транзистор открыт, нижний — закрыт. И наоборот.
На рис. 39 показаны платы, образующие тестовый генератор c усилителем класса D на приборе DRF1400. Усилитель обеспечивает на рабочей частоте 13,56 МГц выходную мощность 1,7кВт при КПД 87%.
Моделирование устройств на VDMOS в системе MATLAB+Simulink
Сложность расчета и построения мощных высокоскоростных устройств и трудности их экспериментальной отладки делают важным математическое моделирование таких устройств. В последние годы одной из основных систем для такого моделирования является матричная система MATLAB с пакетом блочного имитационного моделирования Simulink [9–11].
В последней реализации этой системы MATLAB+Simulink R2012 a имеются пакеты расширения SimPowerSystem и SimElectronics, библиотеки моделей которых содержат мощные MOSFET и средства их контроля, в том числе расчета температуры внутренней области и рассеиваемой мощности.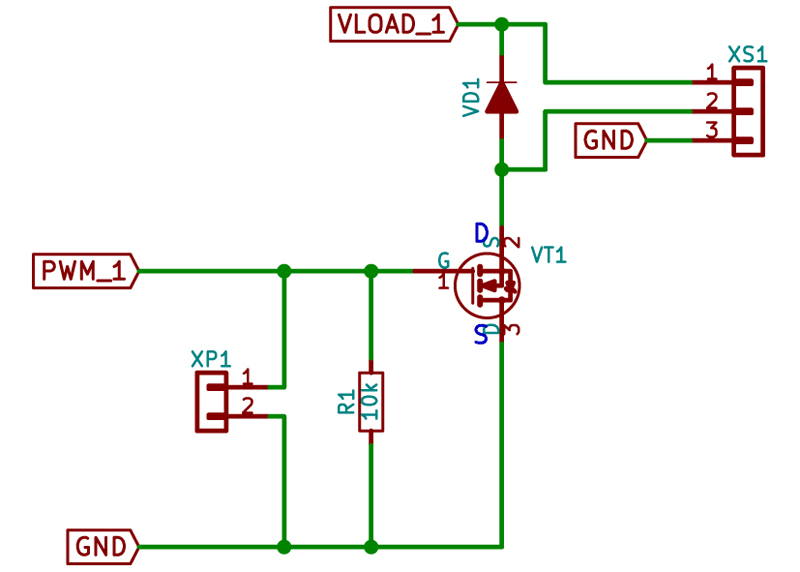 При этом есть как упрощенные модели, так и SPICE-совместимые. Встроенный пример моделирования характериографа позволяет легко подобрать параметры MOSFET c ВАХ нужного вида.
При этом есть как упрощенные модели, так и SPICE-совместимые. Встроенный пример моделирования характериографа позволяет легко подобрать параметры MOSFET c ВАХ нужного вида.
Для примера рассмотрим моделирование мощного усилителя звуковой частоты с широтно-импульсным регулятором. Диаграмма модели усилителя представлена на рис. 40. В правой ее части показано окно установки входного сигнала — две синусоиды с частотами 2000 и 2500Гц и амплитудой 15В. В диаграмме использован блок Feedback Controller широтно-импульсного регулятора из пакета расширения SimElectronics. Преобразование идет на частоте 1МГц.
Субмодель мостового регулятора на двух полумостах с мощными MOSFET представлена блоком MOSFETS&Filters. Сделав на этом блоке двойной щелчок правой клавишей мыши, можно вывести диаграмму моделей ключей: она показана на рис. 41 сверху. Там же показаны диаграммы субмоделей LC-фильтров, которые гасят пульсации сигнала, связанные с широтно-импульсным характером регулирования.
Эта модель с помощью виртуального осциллографа строит временные диаграммы работы усилителя (рис. 42 сверху) и спектр мощности частот входного и выходного сигналов. Он показан на рис. 42 снизу. Для получения этих данных модель запускают на исполнение кнопкой с изображением черного треугольника в панели инструментов диаграммы модели (рис. 40).
42 сверху) и спектр мощности частот входного и выходного сигналов. Он показан на рис. 42 снизу. Для получения этих данных модель запускают на исполнение кнопкой с изображением черного треугольника в панели инструментов диаграммы модели (рис. 40).
Входной сигнал в виде двух синусоид дает характерные биения, в результате чего он напоминает сигнал модуляции. Он позволяет оценить динамику и динамический диапазон усилителя. На осциллограммах (рис. 42) представлены выходной сигнал, сигнал ошибки и входной сигнал широтно-импульсного регулятора. Нетрудно заметить, что на глаз входной и выходной сигнал имеют одинаковую форму и отличаются только масштабом.
Заключение
Мощные полевые радиочастотные транзисторы класса VDMOS удачно сочетают достоинства VMOS-транзисторов с приборами класса DMOS. Несколько уступая приборам VMOS по значениям максимальной рабочей частоты, они заметно превосходят их по основным энергетическим параметрам — выходной мощности, рабочим напряжениям и токам стока. Обширная номенклатура выпускаемых фирмой Microsemi полевых транзисторов класса VDMOS позволяет строить на них усилители с мощностью выходного сигнала от единиц Вт до 1–2,5 кВт на частоте от 10 до 150 МГц. Такие усилители применяются в телевизионной, спутниковой, радиолокационной, медицинской аппаратуре и аппаратуре для связи, успешно заменяя применяемые ранее устройства на электронных лампах и биполярных транзисторах.
Обширная номенклатура выпускаемых фирмой Microsemi полевых транзисторов класса VDMOS позволяет строить на них усилители с мощностью выходного сигнала от единиц Вт до 1–2,5 кВт на частоте от 10 до 150 МГц. Такие усилители применяются в телевизионной, спутниковой, радиолокационной, медицинской аппаратуре и аппаратуре для связи, успешно заменяя применяемые ранее устройства на электронных лампах и биполярных транзисторах.
Литература
1. Бачурин В. В., Дьяконов В. П., Сопов О. В. Мощные высокочастотные и сверхвысокочастотные МДП-транзисторы // Электронная промышленность. 1979. № 8.
2. Бачурин В. В., Дьяконов В. П., Сопов О. В. Мощный высокочастотный МДП-транзистор КП904 // Электронная промышленность. 1979. № 5.
3. Бачурин В. В., Бычков С. С., Дьяконов В. П., Прушинский А. К. Мощный кремниевый сверхвысокочастотный МДП-транзистор КП908 // Электронная промышленность. 1980. № 1.
4. Асессоров В., Кожевников В., Дикарев В., Цоцорин А. Мощные ВЧ и СВЧ полевые транзисторы для аппаратуры средств радиосвязи // Компоненты и технологии. 2006. № 5.
2006. № 5.
5. Захаров В. Мощные СВЧ-транзисторы фирмы Philips Semicomductor // Компоненты и технологии. 2003. № 6.
6. Дьяконов В. П. Мощные полевые транзисторы: история, развитие и перспективы. Аналитический обзор // Силовая электроника. 2011. № 3.
7. Бачурин В. В., Ваксембург В. Я., Дьяконов В. П. и др. Схемотехника устройств на мощных полевых транзисторах: Справочник. М.: Радио и связь, 1994.
8. Дьяконов В. П., Максимчук А. А., Ремнев А. М., Смердов В. Ю. Энциклопедия устройств на полевых транзисторах. М.: СОЛОН-Р, 2002.
9. Дьяконов В. П. Физическое моделирование схем на полевых транзисторах в Simulink и SimElectronics // Компоненты и технологии. 2011. № 11.
10. Дьяконов В. П. Моделирование в MATLAB+Simulink электронных компонентов, систем и устройств // Компоненты и технологии. 2011. № 4.
11. Дьяконов В. П. MATLAB и Simulink для радиоинженеров. М.: ДМК-Пресс, 2011.
12. Ред Э. Справочное пособие по высокочастотной схемотехнике. М.: Мир, 1990.
13. Gui Shoi. 13.56 MHz. Class-D Half Bridge, RF Generator with EDF1400. Application Note 1817. Microsemi. March 2012.
13.56 MHz. Class-D Half Bridge, RF Generator with EDF1400. Application Note 1817. Microsemi. March 2012.
Скачать в PDF
|
Навигация: Главная Случайная страница Обратная связь ТОП Интересно знать Избранные Топ: Марксистская теория происхождения государства: По мнению Маркса и Энгельса, в основе развития общества, происходящих в нем изменений лежит… Процедура выполнения команд. Рабочий цикл процессора: Функционирование процессора в основном состоит из повторяющихся рабочих циклов, каждый из которых соответствует… Характеристика АТП и сварочно-жестяницкого участка: Транспорт в настоящее время является одной из важнейших отраслей народного… Интересное: Национальное богатство страны и его составляющие: для оценки элементов национального богатства используются. Наиболее распространенные виды рака: Раковая опухоль — это самостоятельное новообразование, которое может возникнуть и от повышенного давления… Уполаживание и террасирование склонов: Если глубина оврага более 5 м необходимо устройство берм. Варианты использования оврагов для градостроительных целей… Дисциплины: Автоматизация Антропология Археология Архитектура Аудит Биология Бухгалтерия Военная наука Генетика География Геология Демография Журналистика Зоология Иностранные языки Информатика Искусство История Кинематография Компьютеризация Кораблестроение Кулинария Культура Лексикология Лингвистика Литература Логика Маркетинг Математика Машиностроение Медицина Менеджмент Металлургия Метрология Механика Музыкология Науковедение Образование Охрана Труда Педагогика Политология Правоотношение Предпринимательство Приборостроение Программирование Производство Промышленность Психология Радиосвязь Религия Риторика Социология Спорт Стандартизация Статистика Строительство Теология Технологии Торговля Транспорт Фармакология Физика Физиология Философия Финансы Химия Хозяйство Черчение Экология Экономика Электроника Энергетика Юриспруденция |
⇐ ПредыдущаяСтр 4 из 11Следующая ⇒ В настоящее время полевой транзистор является одним из наиболее перспективных силовых приборов. Силовые полевые транзисторы имеют вертикальную структуру. Каналы могут располагаться как вертикально, так и горизонтально. IGBT – гибридный полупроводниковый прибор. В нем совмещены два способа управления электрическим током, один из которых характерен для полевых транзисторов (управление электрическим полем), а второй – для биполярных (управление инжекцией носителей электричества). Обычно в IGBT используется структура МДП-транзистора с индуцированным каналом n-типа. Структура этого транзистора отличается от структуры ДМДП-транзистора дополнительным слоем полупроводника р-типа.
Обратим внимание на то, что для обозначения электродов IGBT принято использовать термины «эмиттер», «коллектор» и «затвор». Добавления слоя р-типа приводит к образованию второй структуры биполярного транзистора (типа p-n-p). Таким образом, в IGBT имеется две биполярные структуры – типа n-p-n и типа p-n-p. УГО и схема выключения IGBT показаны на рисунке: Типичный вид выходных характеристик показаны на рисунке: 9 SIT-транзистор со статической модуляцией. Сравнительные характеристики силовых полупроводниковых приборов. SIT – полевой транзистор с управляющим p-n переходом со статической индукцией. Является многоканальным и имеет вертикальную структуру. Схематическое изображение SIT и схема включения с общим истоком показаны на рисунке: Области полупроводника р-типа имеют форму цилиндров, диаметр которых составляет единицы микрометров и более. Эта система цилиндров играет роль затвора. Каждый цилиндр подсоединен к электроду затвора (на рисунке «а» электрод затвора условно не показан). Пунктиром обозначены области p-n-переходов. Реальное число каналов может составлять тысячи. Каждый из рассмотренных приборов имеет свою область применения. Ключи на тиристорах применяются в устройствах, работающих на низких частотах (килогерцы и ниже). Основным недостатком таких ключей являются низкое быстродействие. Основной областью применения тиристоров являются низкочастотные устройства с большой коммутируемой мощностью вплоть до нескольких мегаватт, не предъявляющих серьезных требований к быстродействию. Мощные биполярные транзисторы применяются в качестве высоковольтных ключей в устройствах с частотой коммутации или преобразования, находящейся в диапазоне 10-100 кГц, при уровне выходной мощности от единиц Вт до нескольких кВт. Оптимальный диапазон коммутируемых напряжений 200-2000 В. Полевые транзисторы (MOSFET) применяются в качестве электронных ключей для коммутации низковольтных высокочастотных устройств. Оптимальные значения коммутируемых напряжений не превышают 200 В (максимальное значение до 1000 В), при этом частота коммутации может находится в пределах от единиц кГц до 105 кГц. Биполярные транзисторы с изолированным затвором (IGBT) применяются на частотах менее 20 кГц (некоторые типы приборов применяются на частотах более 100 кГц) при коммутируемых мощностях выше 1 кВт. Коммутируемые напряжения не ниже 300-400 В.Оптимальные значения коммутируемых напряжений свыше 2000 В. IGBT и MOSFET требуют для полного включения напряжения не выше 12-15 В, для закрытия приборов не требуется подавать отрицательное напряжение. Они характеризуются высокими скоростями переключения.
10 Магнитное поле и его характеристики. Магни́тное по́ле — силовое поле, действующее на движущиеся электрические заряды и на тела, обладающие магнитным моментом, независимо от состояния их движения; магнитная составляющаяэлектромагнитного поля. Основные характеристики магнитного поля. Магнитная индукция B — это векторная величина определяющая силу действующую на заряженную частицу со стороны магнитного поля. Измеряется в теслах Тл. B = Ф/S магнитная постоянная. µ— относительная магнитная проницаемость — табличная величина (для вакуума = 1) Магнитный поток Ф — скалярная физическая величина числено равная произведению магнитной индукции на площадь поверхности ограниченной замкнутым контуром. Измеряется в веберах Вб. . Магнитный поток через контур максимален,если плоскость контура перпендикулярна магнитному полю. Тогда магнитный поток рассчитывается по формуле: Φmax = B · S Магнитный поток через контур равен нулю, если контур располагается параллельно магнитному полю. Напряженность H – это векторная величина независящая от магнитных свойств среды. Магнитная проницаемость. Магнитная индукция зависит не только от силы тока, проходящего по проводнику или катушке, но и от свойств среды, в которой создается магнитное поле. Величиной, характеризующей магнитные свойства среды, служит магнитная проницаемость. ⇐ Предыдущая12345678910Следующая ⇒ Индивидуальные и групповые автопоилки: для животных. Схемы и конструкции… Кормораздатчик мобильный электрифицированный: схема и процесс работы устройства… Опора деревянной одностоечной и способы укрепление угловых опор: Опоры ВЛ — конструкции, предназначенные для поддерживания проводов на необходимой высоте над землей, водой… Поперечные профили набережных и береговой полосы: На городских территориях берегоукрепление проектируют с учетом технических и экономических требований, но особое значение придают эстетическим… |
Эффект Спирито у полевых транзисторов / Хабр
Данный текст посвящён особенности использования полевых транзисторов в линейном режиме, и эффекту, из-за которого живучесть полевиков в этом самом режиме (и без того весьма паршивая) дополнительно снижается при больших напряжениях “сток-исток”. Этот эффект был обнаружен профессором неаполитанского университета Паоло Спирито, и получил его имя. Изучая особенности работы с полевыми транзисторами я обнаружил, что информации на русском языке по эффекту Спирито довольно мало, поэтому решил заполнить этот пробел.
Этот эффект был обнаружен профессором неаполитанского университета Паоло Спирито, и получил его имя. Изучая особенности работы с полевыми транзисторами я обнаружил, что информации на русском языке по эффекту Спирито довольно мало, поэтому решил заполнить этот пробел.
Прежде всего — небольшое введение: важной характеристикой транзисторов является “область безопасной работы”, или SOA (safe operation area). Особенно важна эта характеристика для полевых транзисторов, так как их возможности работы в линейном и ключевом режимах очень сильно различаются: мелкий полевик размером с ноготок способен прокачать через себя десятки ампер в ключевом режиме, и выгореть при токе в пару десятков миллиампер в режиме линейном. Доходит до того, что молодым схемотехникам говорят, что “в линейном режиме полевые транзисторы использовать нельзя”. Примерный вид этой характеристики приведён на рисунке 1:
Как можно заметить, SOA состоит из нескольких участков:
Диагональный участок слева задаётся сопротивлением полностью открытого транзистора.
 В данном случае — 0,84 Ома. То есть, больше тока при таком напряжении транзистор не пропустит чисто физически
В данном случае — 0,84 Ома. То есть, больше тока при таком напряжении транзистор не пропустит чисто физическигоризонтальный участок сверху — задаётся максимально допустимым током через транзистор. В данном случае — чуть меньше двухсот ампер
вертикальный участок справа — задаётся максимально допустимым напряжением “сток-исток”. В данном случае — 900 вольт.
Наконец, пачка диагональных участков с метками времени справа определяются максимальной энергией, которую способен поглотить транзистор без вреда для себя. Как можно заметить, транзистор, который спокойно пропускает ток почти в двести ампер в открытом состоянии, может выйти из строя уже при двухстах миллиамперах в линейном режиме.
Иногда на этих участках наблюдается излом (см. рис. 2). Этот самый излом и вызван эффектом Спирито: при более высоких напряжениях между стоком и истоком энергия, при которой транзистор выходит из строя, резко снижается. Кстати, если присмотреться, на рис. 1 тоже есть похожий излом (сравните графики для 10 мс и 100 мс).
1 тоже есть похожий излом (сравните графики для 10 мс и 100 мс).
Понятие SOA относится не только к полевым транзисторам, изначально оно появилось, как характеристика транзисторов биполярных. Основным фактором, ограничивающим SOA прямого смещения у биполярных транзисторов, является температурная нестабильность, обусловленная отрицательным температурным коэффициентом сопротивления. Попросту говоря — с ростом температуры транзистора его электрическая проводимость растёт. В результате, если ток в схеме ограничивается именно транзистором, то, по мере его нагрева, через него начинает протекать всё бОльший ток, который в свою очередь нагревает транзистор ещё сильнее… и так до тех пор, пока он не сгорит, либо пока ток не начнёт ограничиваться другим элементом схемы. У полевых транзисторов такой проблемы, на первый взгляд, нет: с ростом температуры его сопротивление в открытом режиме возрастает. Это позволяет ставить параллельно несколько транзисторов — они сами разделят между собой нагрузку. Более того — каждый полевой транзистор по сути состоит из множества мелких микротранзисторов, которые включены параллельно, и точно так же балансируют между собой нагрузку. Но, как говорил незабвенный Василий Иванович Чапаев, “есть нюанс” (рис. 3):
Более того — каждый полевой транзистор по сути состоит из множества мелких микротранзисторов, которые включены параллельно, и точно так же балансируют между собой нагрузку. Но, как говорил незабвенный Василий Иванович Чапаев, “есть нюанс” (рис. 3):
Если внимательно посмотреть на графики на рис. 3, то можно заметить, что одни и те же 5-7 вольт на затворе при разной температуре по разному открывают транзистор: например, при 25 градусах Цельсия и 6 вольтах на затворе транзистор пропускает чуть больше 20 ампер, а при 125 градусах Цельсия и том же напряжении на затворе — почти 35 ампер. При повышении напряжения на затворе этот эффект быстро пропадает. То есть, при небольшом напряжении на затворе, когда транзистор почти закрыт, он ведёт себя так, будто имеет отрицательный температурный коэффициент сопротивления. Напомню, что по внутренней структуре полевой транзистор можно представить, как множество параллельных микротранзисторов, у которых есть некоторый разброс характеристик. И когда мы подаём на затвор транзистора небольшое напряжение — некоторые из микротранзисторов приоткрываются чуть сильнее. Соответственно, через них течёт чуть бОльший ток, который нагревает их чуть сильнее, чем соседние микротранзисторы. За счёт повышения температуры микротранзистор приоткрывается ещё чуть сильнее, через него течёт ещё чуть больший ток… В итоге этот конкретный микротранзистор живёт только до тех пор, пока не нагреется до слишком высокой температуры. При этом соседние микротранзисторы могут быть заметно холоднее, зачастую полевик, сгоревший из-за работы вне SOA, остаётся в целом холодным. Почему эффект Спирито проявляется на больших напряжениях “сток-исток”? Ответ тоже очень прост — чтобы между стоком и истоком возникло это самое напряжение, транзистор должен быть почти закрыт.
Соответственно, через них течёт чуть бОльший ток, который нагревает их чуть сильнее, чем соседние микротранзисторы. За счёт повышения температуры микротранзистор приоткрывается ещё чуть сильнее, через него течёт ещё чуть больший ток… В итоге этот конкретный микротранзистор живёт только до тех пор, пока не нагреется до слишком высокой температуры. При этом соседние микротранзисторы могут быть заметно холоднее, зачастую полевик, сгоревший из-за работы вне SOA, остаётся в целом холодным. Почему эффект Спирито проявляется на больших напряжениях “сток-исток”? Ответ тоже очень прост — чтобы между стоком и истоком возникло это самое напряжение, транзистор должен быть почти закрыт.
Полевые транзисторы (современные)
В
В 1945 году у Шокли возникла идея создать твердотельное устройство.
полупроводников. Он предположил, что сильное электрическое поле
может вызвать поток электричества в близлежащем полупроводнике. Он попытался построить один, а затем попросил Уолтера Браттейна попытаться
построить его, но это не сработало.
Он попытался построить один, а затем попросил Уолтера Браттейна попытаться
построить его, но это не сработало.
Три года спустя Браттейн и Бардин построили первый работающий транзистор, германиевый транзистор с точечным контактом, который производился как серия «А». Шокли тогда сконструировал переходной (сэндвич) транзистор, который был изготовлен в течение нескольких лет после этого. Но в 1960 Bell ученый Джон Аталла разработал новую конструкцию, основанную на оригинальных теориях полевого эффекта Шокли. К концу 1960-х годов производители перешли от интегральные схемы переходного типа к устройствам с полевым эффектом. Сегодня, большинство транзисторов являются полевыми транзисторами. Вы используете миллионы из них сейчас.
МОП-транзисторы
Большинство современных транзисторов представляют собой полевые МОП-транзисторы. или металлооксидные полупроводниковые полевые транзисторы. Они были
разрабатывались в основном Bell Labs, Fairchild Semiconductor и сотнями
Кремниевой долины, японских и других компаний, производящих электронику.
или металлооксидные полупроводниковые полевые транзисторы. Они были
разрабатывались в основном Bell Labs, Fairchild Semiconductor и сотнями
Кремниевой долины, японских и других компаний, производящих электронику.
Полевые транзисторы названы так потому, что слабый электрический сигнал, поступающий через один электрод, создает электрическое поле через остальную часть транзистора. Это поле переключается с положительного на отрицательное, когда входящий сигнал делает и управляет вторым током, проходящим через остальные транзистора. Поле модулирует второй ток, чтобы имитировать первый — но он может быть существенно больше.
Как это работает
| mov» controller=»true» autoplay=»false» pluginspage=»http://www.apple.com/quicktime/download»/> |
Подробнее о том, как Полевые транзисторы работают |
На днище транзистора П-образный разрез (хотя это более плоско, чем настоящая буква «U») из полупроводника N-типа. с избытком электронов. В центре буквы U находится секция, известная как «основание», изготовлена из P-типа (положительно заряжена) полупроводник с малым количеством электронов. (На самом деле N- и P-типы можно перевернуть, и устройство будет работать точно так же, за исключением того, что дырки, а не электроны, будут вызывать ток.)
Три электрода прикреплены к верхней части этого
полупроводниковый кристалл: один к среднему положительному сечению и
по одному на каждое плечо U. Подавая напряжение на электроды
на U, ток будет течь через него. Сторона, где электроны
приходят называется источником, а сторона, где электроны
выходит называется сток.
Подавая напряжение на электроды
на U, ток будет течь через него. Сторона, где электроны
приходят называется источником, а сторона, где электроны
выходит называется сток.
Если ничего не произойдет, ток будет течь от с одной стороны на другую. Из-за того, как электроны ведут себя при соединение между полупроводниками N- и P-типа, однако ток не будет течь особенно близко к базе. Он путешествует только через тонкий канал по середине U.
Также к основанию прикреплен электрод,
клин из полупроводника P-типа посередине, отделенный от
остальная часть транзистора тонким слоем оксида металла, такого
как диоксид кремния (который играет роль изолятора).
Этот электрод называется «воротом». Слабое электрическое
сигнал, который мы хотели бы усилить, подается через гейт. Если
заряд, проходящий через затвор, отрицателен, он добавляет больше электронов
к базе. Поскольку электроны отталкиваются друг от друга, электроны
в U двигайтесь как можно дальше от базы. Это создает
обедненная зона вокруг базы целая область, где электроны
не может путешествовать. Канал посередине U через
ток, который может течь, становится еще тоньше. Добавить достаточно
отрицательный заряд на базу и канал полностью отщипнется,
остановка всего тока. Это как наступить на садовый шланг
чтобы остановить поток воды. (Ранее транзисторы управлялись
эту зону обеднения, используя то, как электроны движутся, когда два
полупроводниковые пластины помещаются рядом друг с другом, создавая то, что
называется соединением P-N.
В полевых МОП-транзисторах PN-переход заменен оксидом металла, что
Оказалось, что массовое производство микрочипов проще.
Если
заряд, проходящий через затвор, отрицателен, он добавляет больше электронов
к базе. Поскольку электроны отталкиваются друг от друга, электроны
в U двигайтесь как можно дальше от базы. Это создает
обедненная зона вокруг базы целая область, где электроны
не может путешествовать. Канал посередине U через
ток, который может течь, становится еще тоньше. Добавить достаточно
отрицательный заряд на базу и канал полностью отщипнется,
остановка всего тока. Это как наступить на садовый шланг
чтобы остановить поток воды. (Ранее транзисторы управлялись
эту зону обеднения, используя то, как электроны движутся, когда два
полупроводниковые пластины помещаются рядом друг с другом, создавая то, что
называется соединением P-N.
В полевых МОП-транзисторах PN-переход заменен оксидом металла, что
Оказалось, что массовое производство микрочипов проще. )
)
А теперь представьте, если заряд проходит через ворота положительный. Положительное основание притягивает много электронов внезапно территория вокруг базы, которая раньше была нейтральной зоной открывается. Канал для тока через U становится больше, чем было изначально, и может протекать гораздо больше электричества. через.
Переменный заряд на базе, следовательно, изменения сколько тока проходит через U. Входящий ток может использоваться в качестве крана для включения или выключения тока, когда он проходит через остальная часть транзистора.
С другой стороны, транзистор можно использовать в
и более сложным образом — как усилитель. Текущий
путешествие по U становится больше или меньше в идеальной синхронизации
с зарядом, поступающим в базу, т. е. имеет одинаковую
паттерн как исходный слабый сигнал. И, начиная со второго
ток подключен к другому источнику напряжения, он может быть
сделано, чтобы быть больше. Ток, проходящий через U, представляет собой
идеальная копия оригинала, только усиленная. Транзистор
используется таким образом для усиления стереозвука в динамиках и микрофонах,
а также для усиления телефонных сигналов, когда они путешествуют по
Мир.
е. имеет одинаковую
паттерн как исходный слабый сигнал. И, начиная со второго
ток подключен к другому источнику напряжения, он может быть
сделано, чтобы быть больше. Ток, проходящий через U, представляет собой
идеальная копия оригинала, только усиленная. Транзистор
используется таким образом для усиления стереозвука в динамиках и микрофонах,
а также для усиления телефонных сигналов, когда они путешествуют по
Мир.
Сноска по Шокли
Шокли наблюдал за ростом Силиконовой долины, но мог не похоже, чтобы войти в Землю Обетованную, которую он предвидел. Он никогда удалось сделать полевые транзисторы, в то время как другие компании проектировался, рос и процветал. Фред Зейтц называл Шокли «The Моисей из Силиконовой долины».
Другие типы транзисторов:
— с точечным контактом
Транзистор
— Перекресток («Сэндвич»)
Транзистор
Ресурсы:
— The Way Things Work Дэвида Маколея
— Научная энциклопедия Ван Ностранда
—
Полевой транзистор
— Интервью с Уолтером Брауном, 3 мая 1999 г.
-PBS Online- -Сайт Кредиты- -Фото Кредиты- -Отзыв-
Авторское право 1999, ScienCentral, Inc и Американский институт физики. Нет часть этого веб-сайта может быть воспроизведена без письменного разрешения. Все права защищены.
Прогресс силового полевого транзистора на сверхширокозонном полупроводниковом материале Ga2O3
| [1] | Дж. Миллан, П. Годиньон, X. Перпина и др. Обзор мощных полупроводниковых устройств с широкой запрещенной зоной. IEEE Trans Power Electron, 2014, 29(5): 2155 doi: 10.1109/TPEL.2013.2268900 |
| [2] | Балига Б. Дж. Основы силовых полупроводниковых приборов. Нью-Йорк: Springer Science & Business Media, 2010 г., . |
| [3] | Т. |
| [4] | С. Фудзита. Полупроводниковые материалы с широкой запрещенной зоной: для их полного расцвета. Jpn J Appl Phys, 2015, 54(3): 030101 doi: 10.7567/JJAP.54.030101 |
| [5] | М. Хигашиваки, К. Сасаки, А. Курамата и др. Разработка силового устройства на основе оксида галлия. Phys Status Solidi A, 2014, 211(1): 21 doi: 10.1002/pssa.201330197 |
| [6] | М. Хигашиваки, К. Сасаки, Х. Мураками и др. Недавний прогресс в Ga 2 O 3 силовых устройств. Semicond Sci Technol, 2016, 31(3): 034001 doi: 10.1088/0268-1242/31/3/034001 |
| [7] | Н. |
| [8] | Э. Г. Виллора, К. Шимамура, Ю. Йошикава и др. Крупноразмерные β -Ga 2 O 3 монокристаллы и пластины. Дж. Рост кристаллов, 2004 г., 270 (3/4): 420 |
| [9] | KNH Aida, H Takeda, N Aota, et al. Выращивание монокристаллов β -Ga 2 O 3 методом выращивания с подачей пленки по краям. Jpn J Appl Phys, 2008, 47(11): 8506 doi: 10.1143/JJAP.47.8506 |
| [10] | М. Хигашиваки, К. Кониси, К. Сасаки и др. Зависящие от температуры вольт-фарадные и вольт-амперные характеристики Pt/Ga 2 O 3 (001) Диоды с барьером Шоттки, изготовленные на n-Ga 2 O 3 дрейфовые слои, выращенные методом газофазной эпитаксии галогенидов. |
| [11] | М. Хигашиваки, К. Сасаки, Т. Камимура и др. Режим обеднения Ga 2 O 3 полевые транзисторы металл-оксид-полупроводник на β -Ga 2 O 3 (010) подложки и температурная зависимость их характеристик прибора. Appl Phys Lett, 2013, 103(12): 123511 doi: 10.1063/1.4821858 |
| [12] | М. Хигашиваки, К. Сасаки, А. Курамата и др. Оксид галлия (Ga 2 O 3 ) металл-полупроводниковые полевые транзисторы на монокристаллических β -Ga 2 O 3 (010) подложках. Appl Phys Lett, 2012, 100(1): 013504 doi: 10.1063/1.3674287 |
| [13] | WS Hwang, A Verma, H Peelaers, et al. Высоковольтные полевые транзисторы с широкозонными β -Ga 2 O 3 наномембранами. |
| [14] | Z Hu, K Nomoto, W Li, et al. Режим улучшения Ga 2 O 3 вертикальный Транзисторы с напряжением пробоя > 1 кВ. IEEE Electron Device Lett, 2018, 39(6): 869 doi: 10.1109/LED.2018.2830184 |
| [15] | К.Д. Чабак, Дж.П. МакКэндлесс, Н.А. Мозер и др. Режим расширения с утопленным затвором β -Ga 2 O 3 МОП-транзисторы. IEEE Electron Device Lett, 2018, 39(1): 67 doi: 10.1109/LED.2017.2779867 |
| [16] | М. Х. Вонг, К. Сасаки, А. Курамата и др. Полевые МОП-транзисторы Ga 2 O 3 с напряжением пробоя более 750 В. IEEE Electron Device Lett, 2016, 37(2): 212-215 doi: 10.1109/LED.2015.2512279 |
| [17] | H Zhou, M Si, S Alghamdi, et al. |
| [18] | Q He, W Mu, B Fu и др. Выпрямитель с барьером Шоттки на основе (100) β -Ga 2 O 3 и его характеристики постоянного и переменного тока. Электронное устройство IEEE Lett, 2018, 39(4): 556 |
| [19] | К. Сасаки, Д. Вакимото, К. Т. Тиеу и др. Первая демонстрация Ga 2 O 3 траншейных МОП-диодов с барьером Шоттки. IEEE Electron Device Lett, 2017, 38(6): 783 doi: 10.1109/LED.2017.2696986 |
| [20] | К. Кониши, К. Гото, Х. Мураками и др. 1 кВ вертикальный Ga 2 O 3 диоды с барьером Шоттки в полевых условиях. |
| [21] | R Roy, Hill V G, Osborn E F. Полиморфизм Ga 2 O 3 и система Ga 2 O 3 –H 2 O. J Am Chem Soc, 1952, 74: 719 doi : 10.1021/ja01123a039 |
| [22] | Х Х Типпинс. Оптическое поглощение и фотопроводимость на краю полосы β -Ga 2 O 3 . Phys Rev, 1965, 140(1A): A316 doi: 10.1103/PhysRev.140.A316 |
| [23] | TC Lovejoy, E N Yitamben, N. Shamir, et al. Морфология поверхности и электронная структура объемного монокристалла β -Ga 2 O 3 (100). Appl Phys Lett, 2009, 94(8): 081906 doi: 10.1063/1.3086392 |
| [24] | М. Мохамед, С. Яновиц, И. Унгер и др. Электронная структура β -Ga 2 O 3 . |
| [25] | C Janowitz, V Scherer, M Mohamed, et al. Экспериментальная электронная структура In 2 O 3 и Ga 2 O 3 . New J Phys, 2011, 13(8): 085014 doi: 10.1088/1367-2630/13/8/085014 |
| [26] | О Уэда, Н Икенаг, К Коши и др. Структурная оценка дефектов в монокристаллах β -Ga 2 O 3 , выращенных методом выращивания с пленочной подачей по краям. Jpn J Appl Phys, 2016, 55(12): 1202BD |
| [27] | Ф. Меццадри, Г. Калестани, Ф. Боски и др. Кристаллическая структура и сегнетоэлектрические свойства пленок epsilon-Ga 2 O 3 , выращенных на (0001)-сапфире. Инорг хим, 2016, 55(22): 2079 |
| [28] | X Xia, Y Chen, Q Feng и др. |
| [29] | М. Сломски, Н. Блюменшайн, П. П. Пасков и др. Анизотропная теплопроводность β -Ga 2 O 3 при повышенных температурах: влияние добавок Sn и Fe. J Appl Phys, 2017, 121(23): 235104 doi: 10.1063/1.4986478 |
| [30] | K Hoshikawa, E Oh, T Kobayashi, et al. Выращивание монокристаллов β -Ga 2 O 3 вертикальным методом Бриджмена в атмосферном воздухе. J Cryst Growth, 2016, 447: 36 doi: 10.1016/j.jcrysgro.2016.04.022 |
| [31] | С. Йошиока, Х. Хаяши, А. Кувабара и др. Структуры и энергетика Ga 2 O 3 полиморфы. |
| [32] | Дж. Оман, Г. Свенссон, Дж. Альбертссон. Повторное исследование бета-оксида галлия. Acta Crystallogr C, 1996, 52(6): 1336 doi: 10.1107/S0108270195016404 |
| [33] | А. Джанотти, К. Г. Ван де Валле. Кислородные вакансии в ZnO. Appl Phys Lett, 2005, 87(12): 122102 doi: 10.1063/1.2053360 |
| [34] | Т. Осима, К. Каминага, А. Мукаи и др. Формирование полуизолирующих слоев на полупроводниковых монокристаллах β -Ga 2 O 3 термическим окислением. Jpn J Appl Phys, 2013, 52(5R): 051101 doi: 10.7567/JJAP.52.051101 |
| [35] | Дж. Б. Варли, Дж. Р. Вебер, А. Джанотти и др. Кислородные вакансии и донорные примеси в β -Ga 2 O 3 . |
| [36] | З. Хайнал, Дж. Миро, Г. Кисс и др. Роль дефектных состояний кислородных вакансий в проводимости тогда-типа β -Ga 2 O 3 . J Appl Phys, 1999, 86(7): 3792 doi: 10.1063/1.371289 |
| [37] | Дж. Г. М. Флейшер, Х. Мейкснер. Индуцированные h3 изменения электропроводности тонкопленочных систем β -Ga 2 O 3 . Appl Phys A, 1992, 54: 560 doi: 10.1007/BF00324340 |
| [38] | F B C K A F M F C Кол. Разложение метана на поликристаллических толстых пленках Ga 2 O 3 исследовано методом термодесорбционной спектроскопии с масс-спектрометром. Fresenius J Ana Chem, 1997, 358: 187 doi: 10.1007/s002160050379 |
| [39] | MFT Schwebel, H Meixner, CD Kohl. |
| [40] | К. Х. М. Огита, Ю. Наканиши, Ю. Хатанака. Ga 2 O 3 тонкая пленка для датчика кислорода при высокой температуре. Appl Surf Sci, 2001, 175: 721 |
| [41] | Z Guo, A Verma, X Wu и др. Анизотропная теплопроводность в монокристалле β -оксида галлия. Appl Phys Lett, 2015, 106(11): 111909 doi: 10.1063/1.4 8 |
| [42] | М. Хандверг, Р. Митданк, З. Галазка и др. Температурно-зависимая теплопроводность в легированных и нелегированных магнием β -Ga 2 O 3 объемных кристаллах. Semicond Sci Tech, 2015, 30(2): 024006 doi: 10.1088/0268-1242/30/2/024006 |
| [43] | М. 2 |
| [44] | Ван Х. Исследование силовых полупроводниковых приборов для высокочастотных преобразователей мощности высокой плотности. Технологический институт Вирджинии, 2007 г. |
| [45] | Джессен Г., Чабак К.Д., Грин А. и др. На пути к реализации Ga 2 O 3 для применения в силовой электронике. 75-я конференция IEEE по исследованию устройств (DRC), 2017 г. |
| [46] | Н. Ма, Н. Танен, А. Верма и др. Внутренние пределы подвижности электронов в β -Ga 2 O 3 . Appl Phys Lett, 2016, 109(21): 212101 doi: 10.1063/1.4968550 |
| [47] | Т. |
| [48] | М. Хигашиваки, А. Курамата, Х. Мураками и др. Современные технологии силовых устройств на основе оксида галлия. J Phys D Appl Phys, 2017, 50(33): 333002 doi: 10.1088/1361-6463/aa7aff |
| [49] | C Tang, J Sun, N Lin, et al. Электронная структура и оптические свойства легированного металлом Ga 2 O 3 : исследование основных принципов. RSC Adv, 2016, 6(82): 78322 doi: 10.1039/C6RA14010F |
| [50] | Х. Пилерс, К. Г. Ван де Валле. Зона Бриллюэна и полосовая структура β -Ga 2 O 3 . |
| [51] | Х фон Венкстерн. Полуторные оксиды группы III: рост, физические свойства и устройства. Adv Electron Mater, 2017, 3(9): 1600350 doi: 10.1002/aelm.v3.9 |
| [52] | К. Сасаки, М. Хигашиваки, А. Курамата и др. Ga 2 O 3 , выращенный МЛЭ, и его применение в силовых устройствах. J Crys Growth, 2013, 378: 591 doi: 10.1016/j.jcrysgro.2013.02.015 |
| [53] | М. Х. Вонг, Ю. Морикава, К. Сасаки и др. Характеристика температуры канала в полевых транзисторах металл-оксид-полупроводник Ga 2 O 3 с помощью электрических измерений и теплового моделирования. Appl Phys Lett, 2016, 109(19): 193503 doi: 10.1063/1.4966999 |
| [54] | Вонг М. Х., Такеяма А., Макино Т. |
| [55] | А.Дж. Грин, К.Д. Чабак, Э.Р. Хеллер и др. Прочность на пробой β -Ga 2 O 3 MOSFET, выращенных методом MOVPE, легированных оловом, составляет 3,8 МВ/см. IEEE Electron Device Lett, 2016, 37(7): 902 doi: 10.1109/LED.2016.2568139 |
| [56] | М. Х. Вонг, Ю. Наката, А. Курамата и др. Режим расширения Ga 2 O 3 МОП-транзисторы с имплантированными ионами кремния истоком и стоком. Appl Phys Express, 2017, 10: 041101 doi: 10.7567/APEX.10.041101 |
| [57] | Вонг М., Гото К., Курамата А. и др. Первая демонстрация вертикальной планарной структуры Ga 2 O 3 MOSFET с токовой апертурой. |
| [58] | Песня Б., Верма А.К., Номото К. и др. Вертикальное ребро Ga 2 O 3 Мощные полевые транзисторы с коэффициентом включения/выключения >10 9 . Конференция по исследованию устройств IEEE (DRC), 2017 г. |
| [59] | А.Дж. Грин, К.Д. Чабак, М. Балдини и др. β -Ga 2 O 3 МОП-транзисторы для работы на радиочастотах. IEEE Electron Device Lett, 2017, 38(6): 790 doi: 10.1109/LED.2017.2694805 |
| [60] | С. Кришнамурти, З. Ся, С. Баджадж и др. Дельта-легированный β — полевой транзистор на основе оксида галлия. Appl Phys Express, 2017, 10(5): 051102 doi: 10.7567/APEX.10.051102 |
| [61] | Z Xia, C Joishi, S Krishnamoorthy, et al. Дельта-легированные β -Ga 2 O 3 полевые транзисторы с наращенными омическими контактами. |
| [62] | Хванг А.В.С., Протасенко В., Рувимов С. и соавт. Наномембрана β -Ga 2 O 3 высоковольтные полевые транзисторы. Конференция по исследованию устройств IEEE (DRC), 2013 г. |
| [63] | С. Ан, Ф. Рен, Дж. Ким и др. Влияние переднего и заднего затворов на полевые транзисторы β -Ga 2 O 3 с нанопоясом. Appl Phys Lett, 2016, 109(6): 062102 doi: 10.1063/1.4960651 |
| [64] | Дж. Бэ, Х.В. Ким, И.Х. Канг и др. Высоковольтные квазидвумерные β -Ga 2 O 3 полевые транзисторы с полевой пластиной из нитрида бора. Appl Phys Lett, 2018, 112(12): 122102 doi: 10.1063/1.5018238 |
| [65] | H Zhou, K Maize, G Qiu, et al. |
| [66] | H Zhou, S Alghamdi, SW Si, et al. Al 2 O 3 / β -Ga 2 O 3 (-201) улучшение поверхности раздела за счет предварительной обработки и отжига после осаждения. IEEE Electron Device Lett, 2016, 37(11): 1411 doi: 10.1109/LED.2016.2609202 |
| [67] | Т. Камимура, Д. Кришнамурти, А. Курамата и др. Эпитаксиально выращенная кристаллическая прослойка Al 2 O 3 на β -Ga 2 O 3 (010) и ее подавленная плотность межфазных состояний. Jpn J Appl Phys, 2016, 55(12): 1202B5 |
| [68] | М. Хаттори, Т. Осима, Р. Вакабаяши и др. |
| [69] | К. Цзэн, И. Цзя, Ю. Сингизетти. Плотность межфазных состояний в осажденном атомарном слое SiO 2 / β -Ga 2 O 3 MOSCAP. IEEE Electron Device Lett, 2016, 37(7): 906 doi: 10.1109/LED.2016.2570521 |
| [70] | К Цзэн, У Сингисетти. Зависимая от температуры квазистатическая вольт-фарадная характеристика границы SiO 2 / β -Ga 2 O 3 при различных ориентациях кристаллов. Appl Phys Lett, 2017, 111(12): 122108 doi: 10.1063/1.49 |
| [71] | H Dong, W Mu, Y Hu, et al. C-V и J-V исследование HfO 2 /Al 2 O 3 двухслойные диэлектрики MOSCAPs на (100) β -Ga 9 2 O 2 | 0 AIP Adv, 2018, 8(6): 065215 doi: 10.
| [72] | М. А. Бхуян, Х. Чжоу, Р. Цзян и др. Улавливание заряда в Al 2 O 3 / β -Ga 2 O 3 на основе МОП-конденсаторов. IEEE Electron Device Lett, 2018, 39(7): 1022 doi: 10.1109/LED.2018.2841899 |
| [73] | Ю. Яо, Р. Ф. Дэвис, Л. М. Портер. Исследование различных металлов в качестве омических контактов к β -Ga 2 O 3 : сравнение и анализ электрических характеристик, морфологии и других физических свойств. Дж Электрон Матер, 2016, 46(4): 2053 |
| [74] | Н. А. Мозер, Дж. П. МакКэндлесс, А. Креспо и др. Высокая плотность импульсного тока β -Ga 2 O 3 МОП-транзисторы подтверждены аналитической моделью с поправкой на заряд интерфейса. Appl Phys Lett, 2017, 110(14): 143505 doi: 10.1063/1. |
| [75] | К. Сасаки, К. Т. Тиу, Д. Вакимото и др. Вертикальные траншейные МОП-транзисторы Ga 2 O 3 с режимом обеднения, изготовленные из гомоэпитаксиальных пленок Ga2O3, выращенных методом газофазной эпитаксии галогенидов. Appl Phys Express, 2017, 10(12): 124201. doi: 10.7567/APEX.10.124201 |
| [76] | К. Цзэн, Дж. С. Уоллес, К. Хеймбургер и др. Ga 2 O 3 МОП-транзисторы с использованием технологии легирования истока/стока на стекле. IEEE Electron Device Lett, 2017, 38(4): 513-516 doi: 10.1109/LED.2017.2675544 |
Field-Effect and Bipolar Power Transistor Physics
Select country/regionUnited States of AmericaUnited KingdomAfghanistanÅland IslandsAlbaniaAlgeriaAmerican SamoaAndorraAngolaAnguillaAntigua and BarbudaArgentinaArmeniaArubaAustraliaAustriaAzerbaijanBahamasBahrainBangladeshBarbadosBelgiumBelizeBeninBermudaBhutanBoliviaBonaire, Sint Eustatius and SabaBosnia and HerzegovinaBotswanaBrazilBritish Indian Ocean TerritoryBritish Virgin IslandsBruneiBulgariaBurkina FasoBurundiCambodiaCameroonCanadaCanary IslandsCape VerdeCayman IslandsCentral African RepublicChadChileChinaChristmas IslandCocos (Keeling) IslandsColombiaComorosCongoCook IslandsCosta RicaCroatiaCubaCuraçaoCyprusCzech РеспубликаДемократическая Республика КонгоДанияДжибутиДоминикаДоминиканская РеспубликаЭквадорЕгипетСальвадорЭкваториальная ГвинеяЭритреяЭстонияЭфиопияФолклендские (Мальвинские) островаФарерские островаФедеративные Штаты МикронезияФиджиФинляндияФранцияФранцузская ГвианаФранцузская ПолинезияГабонГамбияГрузияГерманияГа naGibraltarGreeceGreenlandGrenadaGuadeloupeGuamGuatemalaGuernseyGuineaGuinea-BissauGuyanaHaitiHondurasHong KongHungaryIcelandIndiaIndonesiaIranIraqIrelandIsle of ManIsraelItalyJamaicaJapanJerseyJordanKazakhstanKenyaKiribatiKuwaitKyrgyzstanLaoLatviaLesothoLiberiaLibyaLiechtensteinLuxembourgMacaoMacedoniaMadagascarMalawiMalaysiaMaldivesMaliMaltaMarshall IslandsMartiniqueMauritaniaMauritiusMayotteMexicoMoldovaMonacoMongoliaMontenegroMontserratMoroccoMozambiqueMyanmarNamibiaNepalNetherlandsNew CaledoniaNew ZealandNicaraguaNigerNiueNorfolk IslandNorth KoreaNorthern Mariana IslandsNorwayOmanPakistanPalauPanamaPapua New GuineaParaguayPeruPhilippinesPitcairnPolandPortugalPuerto RicoQatarRéunionRomaniaRwandaSaint BarthélemySaint HelenaSaint Kitts and NevisSaint LuciaSaint Martin (French part)Saint Pierre and MiquelonSaint Vincent and the GrenadinesSamoaSan MarinoSao Tome and PrincipeSaudi ArabiaSenegalSerbiaSeychellesSierra LeoneSingaporeSint Maarten (Dutch part)SlovakiaSloveniaSolomon IslandsS omaliaSouth AfricaSouth Georgia and the South Sandwich IslandsSouth KoreaSouth SudanSpainSri LankaSudanSurinameSvalbard and Jan MayenSwazilandSwedenSwitzerlandSyriaTaiwanTajikistanTanzaniaThailandTimor LesteTogoTokelauTongaTrinidad and TobagoTunisiaTurkeyTurkmenistanTurks and Caicos IslandsTuvaluUgandaUkraineUnited Arab EmiratesUruguayUS Virgin IslandsUzbekistanVanuatuVatican CityVenezuelaVietnamWallis and FutunaWestern SaharaYemenZambiaZimbabwe
Варианты покупкиЭлектронная книга 72,95 $
Налог с продаж рассчитывается при оформлении заказа
Бесплатная доставка по всему миру
Минимальный заказ отсутствует
Описание
Полевой и биполярный силовые транзисторы. . Он касается биполярных устройств, а также силовых полевых транзисторов. В книге содержится актуальная информация о прогрессе, достигнутом в разработке силовых транзисторов. Этот том состоит из трех частей. Часть I исследует общие соображения и рассматривает теорию поверхности полупроводников как основу для понимания поверхностных явлений. Также обсуждается влияние высокой концентрации носителей заряда на свойства полупроводника. Часть II посвящена биполярным транзисторам и основным структурам силовых транзисторов. В части III обсуждаются переходные полевые и поверхностные полевые транзисторы. Эта книга предназначена для инженеров-электриков, проектирующих схемы силовых транзисторов, физиков и проектировщиков устройств, а также для студентов университетов. Читатель должен иметь некоторое представление о физике малосигнальных транзисторов, так как презентация предназначена для студентов старших курсов или аспирантов первого года обучения.
. Он касается биполярных устройств, а также силовых полевых транзисторов. В книге содержится актуальная информация о прогрессе, достигнутом в разработке силовых транзисторов. Этот том состоит из трех частей. Часть I исследует общие соображения и рассматривает теорию поверхности полупроводников как основу для понимания поверхностных явлений. Также обсуждается влияние высокой концентрации носителей заряда на свойства полупроводника. Часть II посвящена биполярным транзисторам и основным структурам силовых транзисторов. В части III обсуждаются переходные полевые и поверхностные полевые транзисторы. Эта книга предназначена для инженеров-электриков, проектирующих схемы силовых транзисторов, физиков и проектировщиков устройств, а также для студентов университетов. Читатель должен иметь некоторое представление о физике малосигнальных транзисторов, так как презентация предназначена для студентов старших курсов или аспирантов первого года обучения.
СОДЕРЖАНИЕ
-
Предисловие
Благодарности
Выбранный список символов
Часть I Общие соображения
Глава 1 Полупроводнические Пороговое напряжение для сильной инверсии
1. 5 Пороговое напряжение в неравновесных условиях
5 Пороговое напряжение в неравновесных условиях
1.6 Заряд канала при сильной инверсии в неравновесном состоянии
1,7 МОС емкости
1,8 Кремниевые поверхностные сборы и состояния
1.9 Радиационные эффекты
1.10 Перераспределение примесей на окисленной кремниевой поверхности
1.11 Поверхностная подвижность
СПИСОК
Глава 2 Свойства полупроводника в концентрациях высокогожигателя
2.1. Рассеяние носителей
2.3 Подвижность в зависимости от концентрации примесей
2.4 Время жизни носителей при высоких уровнях инжекции
2.5 Влияние концентрации носителей на сужение энергетической запрещенной зоны кремния
2.6 Концентрация собственных носителей при высоких уровнях легирования
Ссылки
Глава 3 Лавинный пробой
3.1 Расчет напряжения лавинного пробоя
3.2 Лавинный пробой p-i-n диода
3.3 Плоский (одномерный) переход Пробой температуры
Ссылки
Глава 4 Методы улучшения лавинного пробоя
4. 1 Полевая пластина
1 Полевая пластина
4.2 Рассеянное защитное кольцо
4.3 Эквипотенциальное кольцо и стопор канала
4.4 Пластина резистивного поля
4.5 Кольцо ограничения поля
4.6 Скос соединения
4.7 Метод травления истощением
4.8 Травление подложки в сравнении с положительным скосом
4.9 Контроль заряда обедненной области с помощью ионной имплантации
Ссылки
Ссылки
NTD)
5.2 Ионная имплантация
5.3 Сухое травление
5.4 Контроль срока службы неосновных носителей
5.5 Стабильность поверхности и пассивация устройства
Ссылки
Часть II Биполярные силовые транзисторы
Глава 6 Структуры силовых транзисторов. Модели биполярных транзисторов
6.1 Структуры силовых транзисторов
6.2 Модели биполярных транзисторов
Ссылки
Глава 7 Коэффициент усиления по току при высокой концентрации носителей
7.1 Эффективность эмиттера в зависимости от концентрации эмиттера
7.2 Расширение базы при больших токах в выключенном состоянии
7. 3 Усиление тока эмиттера
3 Усиление тока эмиттера
при больших токах
7.5 Зависимость усиления по току от температуры
7.6 Методы улучшения усиления
Ссылки
Глава 8 Вольт-амперные характеристики силовых транзисторов
8.1 Область насыщения
8.2 Область квазинасыщения
8.3 Напряжение пробоя коллектор-эмиттер
Ссылки
Глава 9 Частотная характеристика. Переходный процесс переключения. Микроволновые транзисторы
9.1 Биполярные силовые транзисторы Частотная характеристика
9.2 Биполярные силовые транзисторы Переходные процессы при переключении
9.3 Биполярные микроволновые транзисторы
Ссылки
Глава 10 Тепловые свойства транзисторов. Нестабильности
10.1 Температура перехода
10.2 Схема теплового эквивалента транзистора
10.3 Тепловой разгон
10.4 Принцип наименьшей генерации энтропии. Текущее формирование филаментов. Горячие точки
10,5 Секундный пробой
10.6 Безопасная рабочая зона (SOA)
10.7 Стабильные горячие точки
Справочные материалы
Часть III Полевые (униполярные) транзисторы
Глава 11 Полевые транзисторы с переходом (JFET)
11. 1 JFET Токи-напряжения 900 Характеристики4 11.2 Модель инкрементальной схемы JFET
1 JFET Токи-напряжения 900 Характеристики4 11.2 Модель инкрементальной схемы JFET
11.3 Избыточный ток утечки затвора и пробой стока
11.4 Выходная мощность JFET
11.5 JFET с триодными (ненасыщающими) характеристиками
11.6 Структуры JFET
Ссылки
Размерный ток, протекающий в канале
12.3 Пороговое напряжение короткоканального МОП-транзистора
12.4 Влияние обратного смещения на пороговое напряжение
12.5 Управление порогом МОП-транзистора
12.6 Инкрементные параметры транзистора MOS
12,7 Модель инкрементной цепи транзистора MOS
12,8 Частота отсечения FT
12,9 МОС Транзисторы с триоделейными характеристиками
12.10 Разрушение напряжения в МОС Транзисторы
12.11 Hot-Electron Effects
СПИСАМИ
4 Глава. Соображения по проектированию
13.1 MOST как усилитель мощности
13.2 Силовой МОП-транзистор как коммутатор
13.3 Структуры силового MOST
13.4 Соображения по проектированию силового DMOST
13,5 емкость затвора большинства с областью дрейфу
13,6 Dest Diest Traste Deffice Hairdown
13,7 D-большее второе расщепление
13,8 Влияние температуры на характеристики транзистора MOS-SAFE (SOA)
Ссылки
Индекс
Детали Продукт
9107Детали продукта
998
5
Продукты.
 страницы: 336
страницы: 336О авторе
Adolph Blicher
Оценки и обзоры
Напишите обзор
. Биохимический датчик на транзисторах с эффектом высокой эффективности
Обработанный раствором маломощный органический полевой транзистор биохимический датчик с высокой эффективностью
Скачать PDF
Скачать PDF
- Артикул
- Открытый доступ
- Опубликовано:
- Вэй Тан
ORCID: orcid.
 org/0000-0003-1134-3730 1 ,
org/0000-0003-1134-3730 1 , - Ин Фу 2 ,
- Yukun Huang 1 ,
- Yuanzhe Li 2 ,
- Yawen Song 1 ,
- Xin Xi 1 ,
- Yude Yu 3 ,
- Yuezeng Su 1 ,
- Фэн Янь ORCID: orcid.org/0000-0001-7385-6334 2 и
- …
- Сяоцзюнь Го ORCID: orcid.org/0000-0003-3946-9458 1
npj Гибкая электроника том 6 , Номер статьи: 18 (2022) Процитировать эту статью
1562 доступа
1 Цитаты
1 Альтметрический
Сведения о показателях
Предметы
- Электротехника и электроника
- Электроника, фотоника и физика устройств
Abstract
Разработка биосенсоров на органических полевых транзисторах (OFET) для настраиваемого обнаружения биомаркеров многих заболеваний могла бы стать недорогим и удобным инструментом как для биологических исследований, так и для клинической диагностики. В этой работе были выведены принципы проектирования преобразователя OFET для биосенсоров, чтобы связать отношение сигнал/шум ( SNR ) к параметрам производительности устройства. Показано, что крутые подпороговые колебания ( SS ), надлежащее пороговое напряжение ( В th ), достаточно хорошая стабильность напряжения смещения и механическая прочность являются ключевыми предпосылками для реализации биосенсоров OFET с высокой эффективностью крутизны ( г м / I D ) для больших SNR . Сочетая канал с низкой плотностью ловушек и диэлектрический слой затвора с высокой k /низкой k , низкотемпературные (<100 °C) гибкие OFET, обработанные раствором, могут соответствовать требованиям к производительности, чтобы максимизировать г м / I D . Биосенсор OFET с расширенной структурой затвора был дополнительно реализован для обнаружения миР-21 без меток, с достижением предела обнаружения ниже 10 пМ с высокой селективностью при низком рабочем напряжении (<1 В).
В этой работе были выведены принципы проектирования преобразователя OFET для биосенсоров, чтобы связать отношение сигнал/шум ( SNR ) к параметрам производительности устройства. Показано, что крутые подпороговые колебания ( SS ), надлежащее пороговое напряжение ( В th ), достаточно хорошая стабильность напряжения смещения и механическая прочность являются ключевыми предпосылками для реализации биосенсоров OFET с высокой эффективностью крутизны ( г м / I D ) для больших SNR . Сочетая канал с низкой плотностью ловушек и диэлектрический слой затвора с высокой k /низкой k , низкотемпературные (<100 °C) гибкие OFET, обработанные раствором, могут соответствовать требованиям к производительности, чтобы максимизировать г м / I D . Биосенсор OFET с расширенной структурой затвора был дополнительно реализован для обнаружения миР-21 без меток, с достижением предела обнаружения ниже 10 пМ с высокой селективностью при низком рабочем напряжении (<1 В).
Введение
Быстро растет потребность в повсеместном восприятии различных биомаркеров (ионов или биомолекул) в крови, биологических жидкостях, выделениях, экскрементах и тканевых клетках человека для персонализированной медицинской диагностики и здравоохранения 1,2 . Чтобы понять это, биосенсорные устройства должны иметь широкие возможности настройки, чтобы соответствовать различным системным требованиям с точки зрения биосовместимости, стоимости и форм-фактора (компактный, тонкий, гибкий или удобный), при этом производя выходной сигнал с достаточно высоким отношением сигнал-к-м. коэффициент шума ( SNR ) при строгом ограничении мощности. Наиболее доступным и удобным способом были бы электрические измерения, позволяющие избежать использования дополнительных громоздких, энергоемких и дорогих оптических компонентов. Преобразователи, изготовленные путем интеграции интерфейса датчика с полевым транзистором (FET), широко изучались, поскольку FET может преобразовывать воспринятый сигнал в усиленный выходной сигнал для потенциально больших СНР 3 . Кроме того, с помощью переключателей FET мультиплексное обнаружение в одной реакции удобно реализовать для высокопроизводительного анализа нескольких аналитов. Органический полевой транзистор (OFET), состоящий из органических полупроводников (OSC) и полимерных диэлектрических слоев, демонстрирует несколько конкурентных преимуществ по сравнению с неорганическими аналогами для таких биосенсорных приложений 4,5 . Использование процессов печати решений и универсальных структур может облегчить интеграцию различных сенсорных интерфейсов или датчиков на уровне устройства с большой свободой 6 . Благодаря низкой температуре обработки и превосходной внутренней механической гибкости полных органических стеков действительно гибкая сенсорная электроника может быть изготовлена с использованием обычной тонкой пластиковой фольги с низким модулем Юнга с гораздо меньшими усилиями по управлению напряжением 7 . В прошлом OFET изучались для обнаружения различных биомолекул, включая ферменты, ДНК и белки 8,9,10,11 .
Кроме того, с помощью переключателей FET мультиплексное обнаружение в одной реакции удобно реализовать для высокопроизводительного анализа нескольких аналитов. Органический полевой транзистор (OFET), состоящий из органических полупроводников (OSC) и полимерных диэлектрических слоев, демонстрирует несколько конкурентных преимуществ по сравнению с неорганическими аналогами для таких биосенсорных приложений 4,5 . Использование процессов печати решений и универсальных структур может облегчить интеграцию различных сенсорных интерфейсов или датчиков на уровне устройства с большой свободой 6 . Благодаря низкой температуре обработки и превосходной внутренней механической гибкости полных органических стеков действительно гибкая сенсорная электроника может быть изготовлена с использованием обычной тонкой пластиковой фольги с низким модулем Юнга с гораздо меньшими усилиями по управлению напряжением 7 . В прошлом OFET изучались для обнаружения различных биомолекул, включая ферменты, ДНК и белки 8,9,10,11 . В качестве широко используемого подхода зонды иммобилизуются на воротах или их расширенной части для захвата молекул-мишеней. После захвата молекул результирующее изменение потенциала на затворе записывается или преобразуется в изменение выходного тока через OFET для дальнейшей обработки. Эти работы хорошо доказали, что способность OFET быть разработана для различных функций биосенсора с помощью инженерии материалов и конструкций устройств. Однако для многих устройств требовались вакуумные процессы и неорганические диэлектрические слои, что принесло бы в жертву техническую компетентность OFET.
В качестве широко используемого подхода зонды иммобилизуются на воротах или их расширенной части для захвата молекул-мишеней. После захвата молекул результирующее изменение потенциала на затворе записывается или преобразуется в изменение выходного тока через OFET для дальнейшей обработки. Эти работы хорошо доказали, что способность OFET быть разработана для различных функций биосенсора с помощью инженерии материалов и конструкций устройств. Однако для многих устройств требовались вакуумные процессы и неорганические диэлектрические слои, что принесло бы в жертву техническую компетентность OFET.
Несмотря на то, что низкотемпературные процессы на основе растворов могут предложить привлекательные характеристики высокой настраиваемости при низких затратах, они имеют трудности с точным контролем толщины слоя, особенно для очень тонких пленок, а также с формированием высококачественных полупроводниковых/диэлектрических пленок и интерфейсов. . С такими ограничениями достижимая производительность устройства сильно ограничена. В прошлом были предприняты значительные усилия по улучшению подвижности носителей в каналах OSC за счет дизайна молекул материала и методов обработки, контролируемых кристаллизацией 9.0797 12,13 . Однако для обнаружения биохимическими датчиками очень низких концентраций анализируемого вещества в различных портативных, носимых или имплантируемых устройствах необходим большой SNR с низким рабочим напряжением и мощностью 14,15,16 . Тем не менее, недостаточно исследований по оптимальной конструкции OFET для такой добротности с учетом взаимодействия между структурами устройства и пакетами материалов при ограничениях обработки.
В прошлом были предприняты значительные усилия по улучшению подвижности носителей в каналах OSC за счет дизайна молекул материала и методов обработки, контролируемых кристаллизацией 9.0797 12,13 . Однако для обнаружения биохимическими датчиками очень низких концентраций анализируемого вещества в различных портативных, носимых или имплантируемых устройствах необходим большой SNR с низким рабочим напряжением и мощностью 14,15,16 . Тем не менее, недостаточно исследований по оптимальной конструкции OFET для такой добротности с учетом взаимодействия между структурами устройства и пакетами материалов при ограничениях обработки.
В этой работе изложены принципы проектирования OFET для преобразователей биохимических датчиков с большой эффективностью крутизны ( г m / I D ) для больших SNR с низким рабочим напряжением. Крутой подпороговый размах ( SS ), правильное пороговое напряжение ( В th ) и стабильность работы являются ключевыми параметрами для определения оптимальной производительности. Основываясь на принципах проектирования, низковольтные ОПТ затем изготавливаются на пластиковой подложке в процессах низкотемпературного растворения для получения требуемой производительности за счет формирования интерфейса канала с низкой плотностью состояний ловушки на высокочастотном интерфейсе.0057 k /low- k двухслойный затворный изолятор. Чтобы проверить его эффективность трансдукции, пластиковая сенсорная метка реализуется путем инкапсуляции OFET с сенсорным электродом и эталонным электродом для обнаружения микроРНК. miRNAs являются ключевыми биомаркерами для многих заболеваний, а обнаружение miRNA без меток электрохимическими способами обеспечит недорогие и удобные инструменты как для биологических фундаментальных исследований, так и для клинической диагностики 17 . Однако miRNAs имеют низкий уровень заряда из-за их короткой собственной длины молекулы, и, таким образом, их трудно обнаружить при очень низкой концентрации. Эта работа демонстрирует возможность использования OFET для распознавания микроРНК.
Основываясь на принципах проектирования, низковольтные ОПТ затем изготавливаются на пластиковой подложке в процессах низкотемпературного растворения для получения требуемой производительности за счет формирования интерфейса канала с низкой плотностью состояний ловушки на высокочастотном интерфейсе.0057 k /low- k двухслойный затворный изолятор. Чтобы проверить его эффективность трансдукции, пластиковая сенсорная метка реализуется путем инкапсуляции OFET с сенсорным электродом и эталонным электродом для обнаружения микроРНК. miRNAs являются ключевыми биомаркерами для многих заболеваний, а обнаружение miRNA без меток электрохимическими способами обеспечит недорогие и удобные инструменты как для биологических фундаментальных исследований, так и для клинической диагностики 17 . Однако miRNAs имеют низкий уровень заряда из-за их короткой собственной длины молекулы, и, таким образом, их трудно обнаружить при очень низкой концентрации. Эта работа демонстрирует возможность использования OFET для распознавания микроРНК. При оптимальной производительности устройства датчик демонстрирует относительное изменение выходного сигнала на 20% по сравнению с фоном при обнаружении миР-21 (миРНК-биомаркера рака молочной железы) при 10 пМ при рабочем напряжении менее одного вольта.
При оптимальной производительности устройства датчик демонстрирует относительное изменение выходного сигнала на 20% по сравнению с фоном при обнаружении миР-21 (миРНК-биомаркера рака молочной железы) при 10 пМ при рабочем напряжении менее одного вольта.
Результаты и обсуждение
Принципы проектирования
На рис. 1а показана структура биохимического датчика на основе OFET, состоящего из преобразователя OFET с чувствительным электродом с расширенным затвором (SE) и электродом сравнения (RE). SE с иммобилизованным зондом предназначен для захвата мишеней аналита в растворе с помощью определенной комбинации мишень/зонд. Для измерения постоянное напряжение смещения ( В Ref ) применяется к RE, индуцируя начальный потенциал на затворе OFET ( V GS0 ) через раствор и, в свою очередь, ток канала в OFET ( I D0 ). Как показано на рис. 1b, V GS0 можно выразить следующим образом: }$$
(1)
где В Хим – напряжение между РЭ и ЧЭ, которое можно принять равным сумме постоянного В Хим0 и межфазного падения потенциала ( В инт0 ) 18 . Падение межфазного потенциала В int0 , возникающее из-за диполя на границе электрод/электролит, модулируется захваченными заряженными биомолекулами и может быть измерено с использованием метода разомкнутой цепи 19 . Когда СЭ регистрирует определенную концентрацию мишеней аналита в растворе, захваченные отрицательно (или положительно) заряженные мишени будут вызывать изменение межфазного падения потенциала (Δ V int ), и, таким образом, Δ V GS . Соответственно изменение выходного тока (Δ I D ) может быть измерено последующей схемой считывания для оцифровки, как показано на рис. 1а.
Падение межфазного потенциала В int0 , возникающее из-за диполя на границе электрод/электролит, модулируется захваченными заряженными биомолекулами и может быть измерено с использованием метода разомкнутой цепи 19 . Когда СЭ регистрирует определенную концентрацию мишеней аналита в растворе, захваченные отрицательно (или положительно) заряженные мишени будут вызывать изменение межфазного падения потенциала (Δ V int ), и, таким образом, Δ V GS . Соответственно изменение выходного тока (Δ I D ) может быть измерено последующей схемой считывания для оцифровки, как показано на рис. 1а.
a Схема конструкции биосенсора для обнаружения аналита в растворе электролита. Биосенсор состоит из преобразователя OFET и чувствительного электрода с расширенным затвором, иммобилизованного зондами. (4) Согласно (4) отношение сигнал-шум зависит от относительного изменения выходного тока по отношению к фоновому уровню (∆ I / I ). В результате, для улучшения предела обнаружения было бы важно максимизировать Δ I D / I D0 преобразователя OFET для определенной концентрации аналитов. Δ I D / I D0 можно описать как $$\frac{{\Delta I_{{{\mathrm{D}}}}}}{{I_{{{{\ mathrm{D}}}}0}}} = \frac{{g_{{{\mathrm{m}}}}\Delta V_{{{{\mathrm{GS}}}}}}}{{I_{ {{{\mathrm{D}}}}0}}} = — \frac{{g_{{{\mathrm{m}}}}}}{{I_{{{{\mathrm{D}}}} 0}}} \cdot \Delta V_{{{{\mathrm{int}}}}} = — \left( {\frac{{\ln 10}}{{SS}}} \right) \cdot \Delta V_{{{{\mathrm{int}}}}}$$ (5) где г м — крутизна и СС — подпороговое колебание. Следовательно, для максимизации Δ I D / I D0 увеличение эффективности крутизны ( g m / I D0 ) важно для достижения конкретных целей иммобилизации, так как оно эффективно электрод затвора (увеличение Δ V int ). Как показано на рис. 1c, когда OFET работает в сенсорной системе, полученная передаточная кривая путем свипирования V Ref будет иметь сдвиг по сравнению с исходной I D – V GS кривая OFET. Такой сдвиг обусловлен наличием межфазного потенциала между поверхностью электрода затвора и водным раствором 21 . Для обеспечения работы ОПТ в подпороговом режиме с малым V Ref , также требуется надлежащее околонулевое пороговое напряжение ( V th ). В соответствии с приведенным выше анализом сделан вывод, что крутой SS , надлежащее пороговое напряжение и стабильность работы при электрическом смещении и механическом воздействии являются ключевыми предпосылками для разработки маломощных преобразователей биохимических датчиков OFET больших СНР . Для удовлетворения требований, описанных выше, конструкция OFET, сочетающая в себе канал с низкой плотностью состояний ловушки и диэлектрический слой затвора с высокой k / низкой k , реализована для достижения крутости SS и почти нулевой V th , при этом используется достаточно толстый диэлектрический слой для обработки больших площадей. Как показано на рис. 2а, устройства были изготовлены в виде конструкции с нижним затвором и нижним контактом на пластиковой подложке из полиэтиленнафталата (ПЭН). Электроды затвора и истока/стока были сформированы путем термического испарения серебра (Ag) через теневые маски. Диэлектрик затвора состоял из низко- k слой поли(винилциннамата) (PVCN) и слой поли(винилиденфторида-трифторэтилена-хлорфторэтилена) (P(VDF-TrFE-CFE)) с высокой общей толщиной около 420 нм, как показано на изображение поперечного сечения, полученное с помощью сканирующей электронной микроскопии (СЭМ) (рис. a Схема OFET в структуре нижнего затвора с нижним контактом, изготовленной на подложке из полиэтиленнафталата (PEN), сочетающей в себе канал с низкой плотностью состояний ловушек (DOS) и канал с высокой плотностью k / low- k Диэлектрический слой затвора . Полноразмерное изображение Измеренная репрезентативная передача ( I D — V GS ) и выход ( I D — V DS ). Участок из DS ). на рис. 2d, на котором показаны хорошо работающие полевые транзисторы с крутым SS около 80 мВ·dec −1 , почти нулевой V th (0,3 В) и соотношение ON/OFF более 10 5 . Операционная стабильность при непрерывном переключении и постоянном напряжении смещения была охарактеризована и показана на рис. 2f. Устройство демонстрирует почти идентичные передаточные характеристики после 120 переключений между выключением и включением. Механическую стабильность гибкого OFET-устройства, инкапсулированного CYTOP, оценивали путем измерения его электрических характеристик при изменении угла изгиба. На рис. 3а показана измерительная система для оценки устойчивости устройства OFET в условиях изгиба. Исследуемый угол изгиба ( θ ) и радиус ( R ) для OFET при испытании на изгиб показаны на дополнительном рис. 1. На рисунке 3b показаны передаточные характеристики OFET-устройства до и после изгиба под разными углами, представляя незначительное ухудшение в подпороговом характеристики даже при большом угле изгиба около 73˚. Соответствующие выходные характеристики (дополнительный рис. 2) также не показывают явных изменений после изгиба примерно на 51°, в то время как после агрессивного изгиба примерно на 73° наблюдалось лишь небольшое ухудшение тока включения. В связи с этим контактное сопротивление ( R C ) во время испытания на изгиб дополнительно оценивали с использованием метода конвейерной линии (TLM). a Фотография измеренного устройства при испытании на изгиб со схемой угла изгиба ( θ ) и радиус ( R ). Полноразмерное изображение Для проверки концепции устройства, разработанного датчика OFET для биосенсора, в этой работе в качестве примера используется обнаружение miR-21, который является одним из потенциальных биомаркеров-кандидатов для первичного рака молочной железы 26 . a Иллюстрация схемы иммобилизации разработанных зондов одноцепочечной ДНК на чувствительном электроде с расширенным затвором для специфического обнаружения миР-21 посредством гибридизации ДНК/миРНК. Изображение полного размера Для проверки процедуры реакции гибридизации miR-21 метили флуоресцентными красителями (FAM) для измерения флуоресценции. Как показано на рис. 4b, иммобилизованное оцДНК золото, инкубированное с 1X фосфатно-солевым буфером (PBS 1X), не показывает флуоресценции. После инкубации поверхности электрода с раствором miR-21, меченым FAM, наблюдается слабая флуоресценция при концентрации miR-21 10 мкМ, в то время как очевидная флуоресценция возникает при концентрации 1 нМ. При увеличении концентрации до 100 мкМ сигнал становится сильным. Результаты подтверждают реакцию гибридизации между мишенями миР-21 и зондами оцДНК. Отдельный OFET вырезали из изготовленного образца большой площади, а затем инкапсулировали на подложку PEN-носителя с SE с расширенным затвором и RE Ag/AgCl, чтобы завершить сенсорную метку для использования, как показано на Рис. a Фотоизображения изготовленных OFET на PEN-подложке и сенсорных меток, состоящих из инкапсулированного OFET и контактов для измерительного электрода с расширенным затвором и электрода сравнения. b Измеренная I D – V Ref кривая путем сканирования V Ref после помещения датчика в раствор электролита, демонстрирующая очевидный сдвиг в отрицательном направлении по сравнению с I D – V GS Кривая нетронутого OFET. Изображение полного размера Полноразмерная таблица Таким образом, производные принципы проектирования преобразователя OFET для биосенсоров строят отношения между SNR и ключевые параметры производительности OFET, в том числе g m / I D , SS , V th и устойчивость к напряжению смещения. Сочетая канал с низкой плотностью состояний ловушек и диэлектрик затвора с высокой k /низкой k структура, OFET, изготовленные на подложке PEN с низкотемпературными процессами на основе растворов, могут соответствовать оптимальным требованиям к конструкции, демонстрируя крутизну SS , почти -ноль В th , а также достаточно хорошую устойчивость к сдвиговым напряжениям и механическую прочность. Биосенсоры OFET с расширенной структурой ворот были дополнительно сконструированы для обнаружения без метки миР-21, потенциального биомаркера первичного рака молочной железы. В целом пластиковые пленки из полиэтиленнафталата (PEN) толщиной 125 мкм (Teonex Q65HA) были приобретены у DuPont Teijin Films. Поли(винилциннамат) (ПВХН, M w = 40 кДа), полистирол (PS, M w = 524 кДа), перфторбензотиол (ПФБТ) и 6-гексантол-ПФБТ были приобретены у Sigma-Aldrich. Поли(винилиденфторид-трифторэтилен-хлорфторэтилен) (56/36,5/7,5 мол. Устройства OFET в структуре с нижним затвором и нижним контактом были изготовлены на пластиковой ПЭН-фольге, ламинированной на стеклянном носителе. После завершения подготовки устройства OFET поддерживающая его PEN-пленка была осторожно отделена от стеклянного носителя. Впоследствии из него вырезали отдельные CYTOP-пассивированные OFET для установки на другую удерживающую подложку PEN с предварительно изготовленными серебряными межсоединениями и контактными площадками, напечатанными методом трафаретной печати. Чувствительный электрод с расширенным затвором, состоящий из хрома (10 нм) и золота (100 нм), был нанесен с помощью магнетронного напыления, который был дополнительно герметизирован силиконовым герметиком для определения чувствительной области 9 мм 2 . Перед иммобилизацией зондов поверхность электродов очищали плазмой O 2 в течение 10 мин. Затем на золотой электрод добавляли 10 мкл 5’-SH-модифицированного раствора оцДНК для захвата (10 –4 M, растворенного в PBS 1X) и инкубировали при 4 °C во влажных условиях в течение ночи, после чего тщательно промывали PBS. 1Х раствор. После иммобилизации зондов электрод обрабатывали 10 мкл водного раствора MCH (1 мМ) в течение 1 ч для удаления неспецифически связанных олигонуклеотидов и блокирования экстраактивной поверхности золота с последующим поднятием с помощью раствора PBS 1X. Поляризованная оптическая микрофотография кристаллического TIPS-пентацена была сделана с помощью микроскопа (XPF-300C, Caikon). Флуоресцентные изображения были получены с помощью инвертированной флуоресцентной микроскопии (IX71, Olympus Life Science). Изображение поперечного сечения, полученное с помощью сканирующей электронной микроскопии (СЭМ), было получено на сканирующем электронном микроскопе Zeiss Ultra Plus с полевой эмиссией при электрическом напряжении 5 кВ. Испытание гибкого ОПТ на циклический изгиб проводили на растягивающей машине при радиусе изгиба 10 мм со скоростью 5 с/цикл. Метка датчика была подключена к чувствительным электродам с расширенным затвором и электроду сравнения (Ag/AgCl) медными проводами. Данные, подтверждающие результаты этого исследования, можно получить у соответствующего автора по обоснованному запросу. Саката, Т. Полевые транзисторы с биологически связанными затворами соответствуют диагностике in vitro. САУ Омега 4 , 11852–11862 (2019). КАС
Статья
Google ученый Ли, М.Ю., Ли, Х.Р., Парк, С.Х., Хан, С.Г. и О, Дж.Х. Химические датчики на основе органических транзисторов для носимой биоэлектроники. Согл. хим. Рез. 51 , 2829–2838 (2018). КАС
Статья
Google ученый Сю, Ю.-К., Хсу, У.-Э. и Лин, К.-Т. Обзор биосенсоров на полевых транзисторах: устройства и клиническое применение. ECS J. Solid State Sci. Технол. 7 , Q3196–Q3207 (2018 г.). КАС
Статья
Google ученый Zang, Y., Huang, D., Di, C.A. и Zhu, D. Органические транзисторы, разработанные для гибких сенсорных приложений. Доп. Матер. 28 , 4549–4555 (2016). КАС
Статья
Google ученый Маглиуло М., Маноли К., Маккиа Э., Палаццо Г. и Торси Л. Адаптация функциональных промежуточных слоев в биосенсорах на органических полевых транзисторах. Доп. Матер. 27 , 7528–7551 (2015). КАС
Статья
Google ученый Хан, Х.У. и др. Обнаружение ДНК без меток in situ с использованием сенсоров на органических транзисторах. КАС
Статья
Google ученый Цзян С., Ченг С. и Натан А. Гибкие сенсорные интерфейсы сверхнизкого энергопотребления для E-skin. Проц. IEEE 107 , 2084–2105 (2019). Лай, С., Барбаро, М. и Бонфильо, А. Адаптация характеристик биосенсора на основе OFET. Сенсорные приводы B Chem. 233 , 314–319 (2016). КАС
Статья
Google ученый Song, J. et al. Влияние структуры биорецепторного слоя на обнаружение основного белка миелина с помощью биосенсоров на основе органических полевых транзисторов. Доп. Функц. Матер. 28 , 1802605 (2018). Артикул
Google ученый Minamiki, T. et al. Точное и воспроизводимое обнаружение белков в воде с помощью органического транзисторного биосенсора с расширенным затвором. Артикул
Google ученый Минами Т. и др. Селективное обнаружение нитратов ферментативным сенсором на основе органического полевого транзистора с расширенным затвором. Биосенс. Биоэлектрон. 81 , 87–91 (2016). КАС
Статья
Google ученый Ван К., Донг Х., Цзян Л. и Ху В. Органические полупроводниковые кристаллы. Хим. соц. Ред. 47 , 422–500 (2018). КАС
Статья
Google ученый Гу, X., Шоу, Л., Гу, К., Тони, М. Ф. и Бао, З. Осаждение полупроводниковых полимеров, управляемое мениском. Нац. коммун. 9 , 534 (2018). Артикул
Google ученый Мозер, Н. Даутуэйт, М., Куцос, Э., Йейтс, Д. К., Митчесон, П. Д. и Джорджиу, П. Массив ISFET с тепловым питанием для измерения pH на теле. IEEE Trans. Биомед. Цепи Сист. 11 , 1324–1334 (2017). Артикул
Google ученый Раджан, Н. К., Брауэр, К., Дуан, X. и Рид, М. А. Предел обнаружения биосенсоров на полевых транзисторах: эффекты модификации поверхности и зависимость от размера. Заяв. физ. лат. 104 , 084106 (2014). Артикул
Google ученый Kilic, T., Erdem, A., Ozsoz, M. & Carrara, S. Биосенсоры микроРНК: возможности и проблемы среди традиционных и коммерчески доступных методов. Кайсти, М. и др. Обнаружение гибридизации немеченой ПНК-ДНК без промывки в режиме реального времени с использованием дискретного фетального датчика. Науч. Респ. 7 , 15734 (2017). Томпсон, М. и др. Безметочное обнаружение нуклеиновых кислот и белковых микрочипов с помощью сканирования нанозондом Кельвина. Биосенс. Биоэлектрон. 20 , 1471–1481 (2005). КАС
Статья
Google ученый Ляо, В. и др. Измерение pH и характеристики низкочастотного шума низкотемпературных (400 ° C) p-канальных КНИ Шоттки ISFET. IEEE Electron Device Lett. 38 , 1146–1149 (2017). Ишиге Ю., Симода М. и Камахори М. Иммобилизация ДНК-зондов на поверхности золота и ее применение для полностью электрического обнаружения гибридизации ДНК с использованием датчика на полевых транзисторах. КАС
Статья
Google ученый Сюй, С. и др. Надежное определение кинетики связывания гибридизации ДНК в режиме реального времени с использованием многоканального графенового биосенсора. Нац. коммун. 8 , 14902 (2017). КАС
Статья
Google ученый Huang, Y. et al. Масштабируемая обработка низковольтных органических полевых транзисторов с использованием легкого покрытия с мягким контактом. IEEE Электронное письмо об устройстве. 40 , 1945–1948 (2019). КАС
Статья
Google ученый Тан, В., Фэн, Л., Ю, П., Чжао, Дж. и Го, X. Высокоэффективный полностью обработанный раствором низковольтный органический транзистор с малой толщиной микрометра. Артикул
Google ученый Ли, У. Х., Чой, Х. Х., Ким, Д. Х. и Чо, К. Статья, посвященная 25-летию: стабильность смещения органических транзисторов, зависящая от микроструктуры. Доп. Матер. 26 , 1660–1680 (2014). КАС
Статья
Google ученый Миттал С., Каур Х., Гаутам Н. и Манта А. К. Биосенсоры для диагностики рака молочной железы: обзор биорецепторов, биопреобразователей и стратегий усиления сигнала. Биосенс. Биоэлектрон. 88 , 217–231 (2017). КАС
Статья
Google ученый Qian, S. et al. Наночастицы Au, функционализированные бороновой кислотой, для селективного усиления сигнала микроРНК в волоконно-оптической системе обнаружения поверхностного плазмонного резонанса. КАС
Статья
Google ученый Ян, С.-Т., Пурхассан-Могхаддам, М., Ву, Л., Бай, П. и Тьерри, Б. Сверхчувствительное обнаружение прогностических раковых биомаркеров миРНК на основе поверхностного рассеяния света, усиленного плазмоном. ACS Sens. 2 , 635–640 (2017). КАС
Статья
Google ученый Дорвель, Б. Р. и др. Кремниевые нанопроволоки с диэлектриками из оксида гафния с высокой вязкостью k для чувствительного обнаружения малых олигомеров нуклеиновых кислот. ACS Nano 6 , 6150–6164 (2012 г.). Лу, Н. и др. КМОП-совместимые кремниевые полевые транзисторы с нанопроволокой для сверхчувствительного обнаружения микроРНК без меток. Малый 10 , 2022–2028 (2014). КАС
Статья
Google ученый Гангули А., Ватанабэ Ю., Хванг М.Т., Хуанг Дж.-К. и Башир, Р. Надежное обнаружение микроРНК без меток с использованием одного миллиона массивов ISFET. Биомед. Микроустройства 20 , 45 (2018). Артикул
Google ученый Li, J., Sun, Z. & Yan, F. Обрабатываемые в растворе низковольтные органические тонкопленочные транзисторы с высоковольтным релаксорным ферроэлектрическим полимером k в качестве изолятора затвора. Доп. Матер. 24 , 88–93 (2012). Ссылки на скачивание Эта работа выполнена при финансовой поддержке Национального фонда естественных наук Китая в рамках гранта (61334008, 61804094 и 61974091), Национального научного фонда для выдающихся молодых ученых в рамках гранта 617 и Исследовательского гранта. Совет (RGC) Гонконга, Китай (проект № C5015-15G). Школа электронной информации и электротехники, Шанхайский университет Цзяо Тонг, Шанхай, 200240, Китай Вэй Тан, Юкун Хуан, Явен Сун, Синь Си, Юэцзэн Су и Сяоцзюнь Го , кафедра прикладной физики Гонконгский политехнический университет, Гонконг, Китай Ин Фу, Юаньчжэ Ли и Фэн Ян Государственная ключевая лаборатория интегрированной оптоэлектроники, Институт полупроводников, Китайская академия наук, Пекин, 100083, Китай Yude Yu Авторы Посмотреть публикации автора Вы также можете искать этого автора в
PubMed Google Scholar Просмотр публикаций автора Вы также можете искать этого автора в
PubMed Google Scholar Просмотр публикаций автора Вы также можете искать этого автора в
PubMed Google Академия Посмотреть публикации автора Вы также можете искать этого автора в
PubMed Google Scholar Посмотреть публикации автора Вы также можете искать этого автора в
PubMed Google Scholar Просмотр публикаций автора Вы также можете искать этого автора в
PubMed Google Scholar Посмотреть публикации автора Вы также можете искать этого автора в
PubMed Google Scholar Просмотр публикаций автора Вы также можете искать этого автора в
PubMed Google Scholar Просмотр публикаций автора Вы также можете искать этого автора в
PubMed Google Scholar Посмотреть публикации автора Вы также можете искать этого автора в
PubMed Google Scholar X. Переписка с
Фэн Янь или Сяоцзюнь Го. Авторы не заявляют об отсутствии конкурирующих интересов. Примечание издателя Springer Nature остается нейтральной в отношении юрисдикционных претензий в опубликованных картах и институциональной принадлежности. Открытый доступ Эта статья находится под лицензией Creative Commons Attribution 4. Перепечатка и разрешения Скачать PDF Электроника | Energy Ахмад Р. Изобретение транзисторов в середине 20-го века положило начало революции в электронике. Транзисторы используют напряжение «затвора» для переключения полупроводника между состояниями ВКЛ и ВЫКЛ. Несмотря на то, что транзисторы являются прорывной технологией из-за их зависимости от внешнего затвора, они по своей природе питаются от внешнего источника и являются энергоемкими, особенно с увеличением плотности упаковки этих устройств. Таким образом, транзистор с автономным питанием, использующий возобновляемый источник энергии, потенциально может изменить правила игры. Исследовательские группы Моники Лира-Канту и Густау Каталана из Каталонского института нанонауки и нанотехнологий (ICN2), Испания, продемонстрировали полевой транзистор на солнечной энергии, или «соларистор». Используя ферроэлектрическую пленку в наиболее часто используемой архитектуре солнечных элементов органических фотоэлектрических элементов (объемный гетеропереход), исследователи смогли переключать фототок устройства между состояниями ВКЛ и ВЫКЛ, используя поглощенные фотоны в качестве затвора. Предыдущие попытки использовали ферроэлектрические пленки в качестве поглощающего слоя в солнечных элементах. Однако, поскольку эти пленки обычно представляют собой полупроводники с широкой запрещенной зоной и, следовательно, плохо поглощают видимый спектр, фототоки сильно ограничены, что приводит к общей низкой эффективности преобразования энергии. Группа Лира-Канту обратилась к концепции объемного органического гетероперехода для поглощения фотонов. Эти поглотители обработаны раствором, имеют оптимальную ширину запрещенной зоны в видимой области и в настоящее время вызывают интенсивный исследовательский интерес для приложений в тонкопленочных органических фотоэлектрических элементах (OPV). Использование этих органических поглотителей привело к высоким фототокам в диапазоне 5–10 мА см 9 . Обычное устройство OPV размещает эти поглотители между слоями, извлекающими электроны и дырки. В настоящее исследование исследователи также включили широкозонную сегнетоэлектрическую полупроводниковую пленку типа n на электроде, извлекающем электроны. Высокая ширина запрещенной зоны (3,6 эВ) сегнетоэлектрической пленки означает, что этот слой прозрачен для большей части солнечного спектра, гарантируя, что максимальный поток фотонов достигнет органического поглотителя. Поляризация сегнетоэлектрика путем подачи постоянного напряжения на один из электродов эффективно настраивала смещение полосы на переходе, собирающем электроны, что приводило к эффективному сбору (ВКЛ) или блокировке (ВЫКЛ) фотоэлектронов. Как сообщалось в недавнем выпуске Advanced Functional Materials , прозрачный проводящий оксид, изготовленный из легированного фтором оксида олова, служил катодом, а компактная тонкая пленка Pb(Zr x Ti 1– x В качестве сегнетоэлектрического слоя использовали )O 3 (PZT). «Этот фототранзистор или соляристор нового поколения является примером прозрачного, компактного и светосильного оптоэлектронного устройства, в котором есть все необходимые ингредиенты для преобразования арены оксидной электроники. Более того, устройство изготавливается с использованием недорогих и масштабируемых технологий обработки растворов в условиях окружающей среды, что прокладывает путь для будущей разработки печатных и гибких устройств. Приложения окружают нас повсюду, от прозрачной электроники (фототранзисторы, фотосегнетоэлектрические запоминающие устройства), прозрачных дисплеев и датчиков до многого другого», — говорит Лира-Канту. Роберт Хой и Джудит Макманус-Дрисколл из Кембриджского университета, изучающие сложные функциональные материалы и наноструктуры, считают, что эта работа обещает будущее фотоэлектрического сообщества и рынка. Конструкции соляристора следующего поколения могли бы выиграть от замены органического поглотителя объемного гетероперехода, где фототок ограничен, на поглотители из коллоидных квантовых точек или гибридных перовскитов, которые обещают гораздо более высокие фототоки (22–30 мА см –2 ). Важно отметить, что, поскольку в этих соляристорах используются компоненты, обработанные раствором, в ближайшем будущем может появиться возможность печатать их в промышленных масштабах на гибких подложках экономичным способом, потенциально делая их активными компонентами устройств Интернета вещей (IoT). Первоначально опубликовано в выпуске MRS Bulletin за май 2018 года. Ожидается, что мировой рынок полевых транзисторов будет расти в среднем на 5,5% в течение прогнозируемого периода (2022-2027). Растущее использование электронных устройств, таких как телевидение, мобильные устройства, электромобили и т. · Кроме того, такие функции, как безопасность, информационно-развлекательная система, навигация и эффективность использования топлива в автомобильных компонентах, а также безопасность, автоматизация, полупроводниковое освещение, транспорт и управление энергопотреблением в промышленных компонентах, вероятно, будут стимулировать исследуемый рынок. Транзистор можно использовать в качестве усилителя для регулирования скорости электродвигателей, таких как двигатели вентиляторов переменного тока, или в качестве полупроводникового переключателя для управления исполнительными механизмами, такими как топливные форсунки. · По данным МЭА, в 2021 году мировые продажи электромобилей достигли 6,6 млн. На долю электромобилей пришлось 9% от всех продаж автомобилей по всему миру. · Растущие требования к контролю мощности в цепях и миниатюризации стимулируют рынок полевых транзисторов. Полупроводники NXP, например, уменьшили размер упаковки своих транзисторов на 55%, сохранив при этом те же характеристики мощности. Diodes Incorporated также представила автомобильные МОП-транзисторы DMTh5008LFDFWQ и DMTH6016LFDFWQ, упакованные в DFN2020. · Полевые транзисторы (FET) в схемах смесителя регулируют низкие интермодуляционные искажения. Из-за коротких конденсаторов связи полевые транзисторы используются в усилителях низкой частоты. Поскольку это устройство, управляемое напряжением, оно используется в качестве переменного резистора напряжения в операционных усилителях. Из-за статического электричества полевые транзисторы могут быть повреждены. · COVID-19 также повлиял на глобальную цепочку поставок крупных электронных брендов. Полевой транзистор, или полевой транзистор, представляет собой активное устройство с тремя выводами, которое управляет протеканием тока с помощью электрического поля. Он имеет высокое входное сопротивление, что делает его полезным в различных схемах. Исследование охватывает полевые транзисторы по типу, применению, конечному пользователю и географическому положению. Объем отчета может быть
настроены в соответствии с вашими требованиями. · Рынок полевых транзисторов находится под влиянием растущих технических усовершенствований автомобильной промышленности. Для автомобилей с традиционными двигателями внутреннего сгорания требуется всего несколько электрических компонентов. · В связи с более широким внедрением электромобилей и гибридных транспортных средств автомобильная промышленность является одним из растущих сегментов индустрии полевых транзисторов. Ожидается, что она будет иметь значительную долю. Такие инновации, как автономные автомобильные технологии, рекуперативное торможение и интеграция различных датчиков, повысили спрос на полевые транзисторы. Кроме того, правительственные правила, требующие передовых систем помощи водителю (ADAS), способствовали росту сегмента. Электронные компоненты в автомобильной промышленности имеют жизненно важное значение для безопасности и подвергаются воздействию высокого напряжения и экстремальных условий. · В декабре 2021 года компания STMicroelectronics выпустила полевые МОП-транзисторы STPOWER на основе карбида кремния (SiC), улучшающие силовые электронные устройства для силовых агрегатов электромобилей (EV) и других приложений, где плотность мощности, энергоэффективность и надежность имеют решающее значение для достижения цели. критерии. · Рынок электромобилей очень конкурентен, и новые производители постоянно раздвигают границы инноваций. Porsche, например, построил свой Taycan с системой на 800 В, хотя многие современные электромобили используют батареи на 400 В. В результате известные производители автомобильных компонентов разработали предложения полевых транзисторов для автомобильного рынка. · В марте 2021 года компания Alpha & Omega Semiconductor Limited, разработчик, пионер и глобальный поставщик силовых полупроводников, силовых ИС и цифровых решений для питания, представила SiC MOSFET на 1200 В, одобренные AEC-Q101, в оптимизированном корпусе TO-247-4L. · В мае 2022 года в Мексике BMW планировал добавить электромобили. BMW инвестирует один миллиард долларов в Мексику, и сборочный завод может стать следующим эксклюзивным предприятием автопроизводителя по производству электромобилей. Увеличение производства электромобилей стимулирует рынок полевых транзисторов. Чтобы понять основные тенденции, загрузите образец
Отчет · Северная Америка является одним из наиболее важных рынков сбыта полевых транзисторов из-за того, что в этом регионе есть твердотельные автомобильные и другие отрасли. · Полупроводниковая промышленность и производство полевых транзисторов в значительной степени зависят от Соединенных Штатов в плане производства, проектирования и исследований. Значимость региона подпитывает спрос на экспорт электронного оборудования и увеличивает секторы конечных пользователей, в которых используется большое количество полевых транзисторов, таких как бытовая электроника и автомобили. · Полупроводниковый бизнес (включая дискретные) является одним из наиболее значительных экспортных секторов в Соединенных Штатах. По данным Международной торговой ассоциации (ITA), большая часть полупроводников (более 82%) поступает от прямого экспорта из США и продаж принадлежащими США дочерними компаниями в других странах. К ним относятся исследования и разработки в США, разработка интеллектуальной собственности, проектирование и другие виды деятельности с высокой добавленной стоимостью. · Нынешняя пандемия COVID-19 привела к закрытию заводов. Обе фабрики закрылись в результате недавней вспышки COVID-19. Китай использует около 40-50% мирового производства полупроводников для внутреннего и экспортного производства. В результате полупроводниковые компании в Соединенных Штатах имеют значительные доходы от Китая. · Кроме того, закрытие заводов или неполная загрузка производственных мощностей могут привести к сокращению заказов и, как следствие, к сокращению или задержке продаж. В краткосрочной перспективе могут пострадать компании, производящие полупроводники, со значительным объемом продаж Apple, Qualcomm Inc. и Broadcom Inc. В целом, мощные производители электроники и полупроводников, такие как Texas Instruments, являются движущей силой отрасли полевых транзисторов в этом районе с конечными потребителями из многих секторов, таких как бытовая электроника и автомобильные запчасти. Чтобы понять тенденции географии, загрузите образец
Отчет Мировой рынок полевых транзисторов сильно фрагментирован, и многие производители полевых транзисторов предлагают этот продукт. Компании постоянно инвестируют в продукты и технологии, чтобы способствовать устойчивому развитию окружающей среды и предотвращать экологические опасности. Компании также приобретают другие компании, которые специально занимаются этими продуктами, чтобы увеличить долю рынка. 1. ВВЕДЕНИЕ 1.1. 4. ОБЗОР РЫНКА 4.1 Обзор рынка 4.2 Привлекательность отрасли – анализ пяти сил Портера 4.2.1 Угроза новых участников 4.2.2. Торговая мощность покупателей/потребителей 4.2.3 Торговая мощность поставщиков 4.2.4 Угрожайте. 4.2.5 Интенсивность конкурентного соперничества 4.3 Анализ цепочки создания стоимости отрасли 4.4 Оценка влияния COVID-19 на рынок 5. ДИНАМИКА РЫНКА 5.1 Рыночные факторы 5.1.1 Растущий спрос на энергосберегающие и энергоэффективные устройства в автомобильной и электронной промышленности Рынок 5.2 Ограничения рынка 5. 6. MARKET SEGMENTATION 6.1 By Type 6.1.1 JFET — Junction Field Effect Transistors 6.1.1.1 P — Type 6.1.1.2 N — Type 6.1.2 MOSFET — Metal-Oxide-Semiconductor Field Effect Transistor 6.1.2.1 P — Type 6.1.2.2 N — Type 6.2 By Application 6.2.1. .6 Others 6.3 By End-User 6.3.1 Automotive 6.3.2 Consumer electronics 6.3.3 IT/Telecom 6.3.4 Power Generating Industries 6.3.5 Other End Users 6.4 Geography 6.4.1 North America 6. 6.4.3 Asia-Pacific 6.4.4 Латинская Америка 6.4.5 Средний восток и Африка 7. Конкурсной пейзаж .0005 7.1.1 Nexperia 7.1.2 Infineon Technologies AG 7.1.3 Vishay Intertechnology, Inc. 7.1.4 Taiwan Semiconductor Manufacturing Company Ltd 7.1.5 STMicroelectronics 7.1.6 Semiconductor Components Industries, LLC 7.1.7 Sensitron Semiconducto 7.1.8 Shindengen America Inc 7.1.9 NATIONAL INSTRUMENTS CORP. ALL 7.1.10 Texas Instruments 7.1.11 Solitron Devices, Inc. 7.1.12 NTE Electronics, Inc. 7.1.13 Alpha и Omega Semiconductor Limited 7.1.14 Broadcom. 7. 7.1.16 Toshiba Corporation 7.1.17 NXP Semiconductors. 7.1.18 Mitsubishi Electric Corporation *Список не исчерпывающий 8. Анализ инвестиций 9. Будущие тенденции ** С учетом доступности 9309. Вы хотите проверить раздел мудро
прайс-лист? Рынок полевых транзисторов изучается с 2020 по 2027 год. Рынок полевых транзисторов будет расти со среднегодовым темпом роста 5,5% в течение следующих 5 лет. Северная Америка демонстрирует самый высокий среднегодовой темп роста в 2021–2026 годах. Азиатско-Тихоокеанский регион будет иметь наибольшую долю в 2021 году. Nexperia, Infineon Technologies AG, Vishay Intertechnology, Inc., Taiwan Semiconductor Manufacturing Company Ltd, STMicroelectronics — крупнейшие компании, работающие на рынке полевых транзисторов. Пожалуйста, введите действительный адрес электронной почты! Пожалуйста, введите корректное сообщение! Скачать бесплатный образец сейчас Имя Г-н/г-жаг-жа.Доктор-миссис. Фамилия Ваш адрес электронной почты Отправляя, вы подтверждаете, что согласны с
наша политика конфиденциальности Скачать бесплатный образец сейчас Ваш адрес электронной почты Отправляя, вы подтверждаете, что согласны с
наша политика конфиденциальности Сообщение Отправляя, вы подтверждаете, что согласны с нашей конфиденциальностью
политика Спасибо за покупку. В Ref — напряжение смещения на электроде сравнения (Ag/AgCl). В GS — результирующее напряжение затвор-исток на OFET. I D – ток стока, измеряемый электронной системой последующего считывания. b Диаграмма потенциала на упрощенной модели электрохимической ячейки с металлом с расширенным затвором в качестве межфазного материала для восприятия. Захваченные на эту поверхность заряженные молекулы создают сдвиг потенциала (Δ V int ) на границе раствор/металл и, таким образом, равен Δ V GS , видимый с OFET. c Иллюстрация смещения кривой передачи от кривой I D – V GS датчика OFET к кривой I D – V
В Ref — напряжение смещения на электроде сравнения (Ag/AgCl). В GS — результирующее напряжение затвор-исток на OFET. I D – ток стока, измеряемый электронной системой последующего считывания. b Диаграмма потенциала на упрощенной модели электрохимической ячейки с металлом с расширенным затвором в качестве межфазного материала для восприятия. Захваченные на эту поверхность заряженные молекулы создают сдвиг потенциала (Δ V int ) на границе раствор/металл и, таким образом, равен Δ V GS , видимый с OFET. c Иллюстрация смещения кривой передачи от кривой I D – V GS датчика OFET к кривой I D – V8 датчика OFET 90 протестировано в растворе путем свипирования В Ref , и индуцированное значительное изменение выходного тока по сравнению с фоновым уровнем (∆ I D0 ) в подпороговом режиме даже при небольшом сдвиге порогового напряжения (∆ В th ).  2} \справа]$$
2} \справа]$$ Другими словами, г м / I D0 является важным показателем качества для оценки чувствительности датчиков OFET с расширенным затвором. Поскольку максимум g m / I D0 возникает в подпороговом режиме и пропорционален обратному значению SS 7 , то преобразователи из нерж. высокая г м / I D для больших SNR .
Другими словами, г м / I D0 является важным показателем качества для оценки чувствительности датчиков OFET с расширенным затвором. Поскольку максимум g m / I D0 возникает в подпороговом режиме и пропорционален обратному значению SS 7 , то преобразователи из нерж. высокая г м / I D для больших SNR . Операционная стабильность является еще одной проблемой, которую следует учитывать, поскольку для взаимодействия между зондами и целевыми биомолекулами часто требуется определенное время ожидания (например, десятки минут) 22 . Как показано на рис. 1с, когда OFET смещен в подпороговом режиме, даже небольшое смещение В th вызовет значительное изменение выходного тока (Δ I D ), вызывая ложноположительные или ложноотрицательные результаты. Подобно электрическому напряжению смещения, поскольку гибкое устройство неизбежно подвержено некоторому состоянию изгиба, следует также обратить внимание на механическую прочность при напряжении изгиба.
Операционная стабильность является еще одной проблемой, которую следует учитывать, поскольку для взаимодействия между зондами и целевыми биомолекулами часто требуется определенное время ожидания (например, десятки минут) 22 . Как показано на рис. 1с, когда OFET смещен в подпороговом режиме, даже небольшое смещение В th вызовет значительное изменение выходного тока (Δ I D ), вызывая ложноположительные или ложноотрицательные результаты. Подобно электрическому напряжению смещения, поскольку гибкое устройство неизбежно подвержено некоторому состоянию изгиба, следует также обратить внимание на механическую прочность при напряжении изгиба.
Изготовление устройства и характеристики
 2б). Оба слоя были нанесены методом центрифугирования с последующим низкотемпературным отжигом. Поверхности электродов истока/стока обрабатывали перфторбензолтиолом (ПФБТ) перед нанесением слоя органического полупроводника (ОПП). Слой OSC был нанесен методом лезвийного покрытия из смешанного раствора 6,13-бис(триизопропилсилилэтинил)пентацена (TIPS-пентацен) и полистирола (PS) 9.0797 23 . Каналы с хорошо кристаллической структурой могут быть сформированы, как показано на рис. 2c, для получения интерфейса OSC/диэлектрика с низким уровнем ловушки для крутой SS при малой диэлектрической емкости затвора (20,1 нФ·см -2 ). Наконец, методом капельного литья был нанесен пассивирующий слой CYTOP для защиты канала от окружающего воздуха. Подробности процесса изготовления описаны в разделе «МЕТОДЫ». Максимальная температура обработки поддерживается ниже 100 °C.
2б). Оба слоя были нанесены методом центрифугирования с последующим низкотемпературным отжигом. Поверхности электродов истока/стока обрабатывали перфторбензолтиолом (ПФБТ) перед нанесением слоя органического полупроводника (ОПП). Слой OSC был нанесен методом лезвийного покрытия из смешанного раствора 6,13-бис(триизопропилсилилэтинил)пентацена (TIPS-пентацен) и полистирола (PS) 9.0797 23 . Каналы с хорошо кристаллической структурой могут быть сформированы, как показано на рис. 2c, для получения интерфейса OSC/диэлектрика с низким уровнем ловушки для крутой SS при малой диэлектрической емкости затвора (20,1 нФ·см -2 ). Наконец, методом капельного литья был нанесен пассивирующий слой CYTOP для защиты канала от окружающего воздуха. Подробности процесса изготовления описаны в разделе «МЕТОДЫ». Максимальная температура обработки поддерживается ниже 100 °C. b Изображение поперечного сечения, полученное с помощью сканирующей электронной микроскопии (СЭМ), показывающее стопку материалов OFET. Масштабная линейка составляет 200 нм. c Поляризованная оптическая микрофотография, показывающая контактно-индуцированную кристаллизацию вдоль канала с серебряными электродами исток/сток, модифицированными перфторбензолтиолом. Масштабная линейка составляет 50 мкм. D Измеренный типичный трансфер ( I D — V GS ) и вывод ( I D — V DS ) Характеристики с благоустроенными полями и полями. крутой подпороговый размах около 80 мВ·дек –1 (W/L = 2000 мкм/70 мкм). e Эффективность извлеченной крутизны ( g m / I D ) как функция напряжения затвор-исток ( V GS ) с максимальным значением 28,8 V − 1 , превышающим значения ранее зарегистрированных биосенсоров OFET с расширенным затвором.
b Изображение поперечного сечения, полученное с помощью сканирующей электронной микроскопии (СЭМ), показывающее стопку материалов OFET. Масштабная линейка составляет 200 нм. c Поляризованная оптическая микрофотография, показывающая контактно-индуцированную кристаллизацию вдоль канала с серебряными электродами исток/сток, модифицированными перфторбензолтиолом. Масштабная линейка составляет 50 мкм. D Измеренный типичный трансфер ( I D — V GS ) и вывод ( I D — V DS ) Характеристики с благоустроенными полями и полями. крутой подпороговый размах около 80 мВ·дек –1 (W/L = 2000 мкм/70 мкм). e Эффективность извлеченной крутизны ( g m / I D ) как функция напряжения затвор-исток ( V GS ) с максимальным значением 28,8 V − 1 , превышающим значения ранее зарегистрированных биосенсоров OFET с расширенным затвором. f Слева: измеренные I D – V GS кривые на каждом интервале 10 th при непрерывном сканировании V GS 1 раз от ВЫКЛ. до ВКЛ. Справа: измеренные кривые I D – V GS при постоянном напряжении смещения ( V GS = V DS = — 0,1 В) с измеренным нормализованным током дренажного потока по исходному значению ( I D (T)/ I D (0)) для 4 ч.
f Слева: измеренные I D – V GS кривые на каждом интервале 10 th при непрерывном сканировании V GS 1 раз от ВЫКЛ. до ВКЛ. Справа: измеренные кривые I D – V GS при постоянном напряжении смещения ( V GS = V DS = — 0,1 В) с измеренным нормализованным током дренажного потока по исходному значению ( I D (T)/ I D (0)) для 4 ч. Исходя из значения SS , эффективная плотность подщелевых ловушек оценивается как 4,3 × 10 10 эВ −1 · см −2 , аналогично предыдущей работе с использованием одного слоя диэлектрика с низким значением k затвора 24 , а также превосходят те, которые используются в биосенсорах OFET с расширенным затвором (дополнительная таблица 1). Измеренное г м / I D по сравнению с V GS представлен на рис. Таблица 1). Максимум g m / I D при В GS = 0,35 В позволяет использовать OFET в сенсорной системе, как показано на рис. 1а, для высокой чувствительности и низкой детекции биомолекул. предел обнаружения на низком уровне В Ref (<1 В).
Исходя из значения SS , эффективная плотность подщелевых ловушек оценивается как 4,3 × 10 10 эВ −1 · см −2 , аналогично предыдущей работе с использованием одного слоя диэлектрика с низким значением k затвора 24 , а также превосходят те, которые используются в биосенсорах OFET с расширенным затвором (дополнительная таблица 1). Измеренное г м / I D по сравнению с V GS представлен на рис. Таблица 1). Максимум g m / I D при В GS = 0,35 В позволяет использовать OFET в сенсорной системе, как показано на рис. 1а, для высокой чувствительности и низкой детекции биомолекул. предел обнаружения на низком уровне В Ref (<1 В). При напряжении смещения при В GS вблизи порогового напряжения в течение 3000 с наблюдается незначительный сдвиг В th (менее 0,01 В). Относительное изменение тока (Δ I D (t)/ I D (0)) составляет менее 15% после постоянного напряжения смещения в течение более 4 часов. Такая конструкция устройства имеет интерфейс OSC/диэлектрик с малой ловушкой и работает с низкой плотностью заряда и слабым перпендикулярным электрическим полем при низком напряжении, приписываемом толстому диэлектрическому слою затвора 25 . По сравнению с реализованным низковольтным устройством, использующим сверхтонкий диэлектрик с высокой емкостью, эти факторы снижают вероятность захвата заряда при напряжении смещения и, таким образом, позволяют достичь высокой стабильности работы устройства. Большой г м / I D , собственно V th и высокая стабильность работы делают устройство перспективным преобразователем для обнаружения биомолекул.
При напряжении смещения при В GS вблизи порогового напряжения в течение 3000 с наблюдается незначительный сдвиг В th (менее 0,01 В). Относительное изменение тока (Δ I D (t)/ I D (0)) составляет менее 15% после постоянного напряжения смещения в течение более 4 часов. Такая конструкция устройства имеет интерфейс OSC/диэлектрик с малой ловушкой и работает с низкой плотностью заряда и слабым перпендикулярным электрическим полем при низком напряжении, приписываемом толстому диэлектрическому слою затвора 25 . По сравнению с реализованным низковольтным устройством, использующим сверхтонкий диэлектрик с высокой емкостью, эти факторы снижают вероятность захвата заряда при напряжении смещения и, таким образом, позволяют достичь высокой стабильности работы устройства. Большой г м / I D , собственно V th и высокая стабильность работы делают устройство перспективным преобразователем для обнаружения биомолекул.
Оценка механической стабильности
 Это реализуется путем взятия общего нормированного сопротивления во включенном состоянии ( R ON · Вт) из выходных характеристик OFET-устройств с различной длиной канала в линейном режиме и последующей экстраполяцией линейной аппроксимации на нулевую длину канала для получения Р С . Как показано на дополнительном рисунке 3, изогнутые OFET с длиной канала в диапазоне от 50 до 110 мкм демонстрируют хорошие выходные характеристики с явным насыщением тока стока за пределами точки отсечки. Соответственно, соответствующие нормализованные по ширине R ON ·W можно рассчитать и нанести на график как функцию длины канала для OFET при различных условиях изгиба (дополнительный рисунок 4). Как показано на рис. 3с, R C , извлеченная с помощью ТЛМ при наиболее значительном угле изгиба 73˚, составляет примерно 0,3 ~ 0,38 МОм·см. Хотя такие R C слабо зависят от напряжения смещения затвора, оно остается практически неизменным во время измеренных состояний изгиба (рис.
Это реализуется путем взятия общего нормированного сопротивления во включенном состоянии ( R ON · Вт) из выходных характеристик OFET-устройств с различной длиной канала в линейном режиме и последующей экстраполяцией линейной аппроксимации на нулевую длину канала для получения Р С . Как показано на дополнительном рисунке 3, изогнутые OFET с длиной канала в диапазоне от 50 до 110 мкм демонстрируют хорошие выходные характеристики с явным насыщением тока стока за пределами точки отсечки. Соответственно, соответствующие нормализованные по ширине R ON ·W можно рассчитать и нанести на график как функцию длины канала для OFET при различных условиях изгиба (дополнительный рисунок 4). Как показано на рис. 3с, R C , извлеченная с помощью ТЛМ при наиболее значительном угле изгиба 73˚, составляет примерно 0,3 ~ 0,38 МОм·см. Хотя такие R C слабо зависят от напряжения смещения затвора, оно остается практически неизменным во время измеренных состояний изгиба (рис. 3d). Далее были проведены электрические измерения гибкого устройства при изгибающем напряжении. Для этого к устройству применяли цикл нагружения, многократно изгибая его до радиуса = 10 мм и сразу отпуская в исходное состояние со скоростью 12 раз в минуту. На рисунке 3e показано, что гибкое устройство OFET сохраняло хорошо функционирующие передаточные характеристики во время напряжения изгиба. Даже после 3500 полных циклов изменение подпорогового качания не превышало 5 мВ·дек -1 , в то время как сдвиг порогового напряжения был менее 0,03 В (рис. 3f), что свидетельствует о незначительном изменении подпороговых характеристик во время выполненного напряжения изгиба. Эти результаты показывают, что разработанный низковольтный OFET может выдерживать неизбежный изгиб во время использования и сохранять свои электрические характеристики для надлежащего преобразования сигнала.
3d). Далее были проведены электрические измерения гибкого устройства при изгибающем напряжении. Для этого к устройству применяли цикл нагружения, многократно изгибая его до радиуса = 10 мм и сразу отпуская в исходное состояние со скоростью 12 раз в минуту. На рисунке 3e показано, что гибкое устройство OFET сохраняло хорошо функционирующие передаточные характеристики во время напряжения изгиба. Даже после 3500 полных циклов изменение подпорогового качания не превышало 5 мВ·дек -1 , в то время как сдвиг порогового напряжения был менее 0,03 В (рис. 3f), что свидетельствует о незначительном изменении подпороговых характеристик во время выполненного напряжения изгиба. Эти результаты показывают, что разработанный низковольтный OFET может выдерживать неизбежный изгиб во время использования и сохранять свои электрические характеристики для надлежащего преобразования сигнала. Масштабная линейка 5 мм. b Передаточные характеристики OFET (W/L = 1500 мкм/90 мкм) при различных углах изгиба. c Измеренное общее сопротивление в открытом состоянии, нормализованное по ширине канала ( R ON · Вт) для гибких OFET с различной длиной канала ( L ch ), изогнутых под углом 73˚. d Извлеченное контактное сопротивление ( R C ) при различных В GS для различных углов изгиба на основе метода линии передачи (TLM). e Передаточные характеристики после различных циклов изгиба (радиус изгиба = 10 мм) и ( f ) результирующее изменение подпорогового колебания ( SS ) и порогового напряжения (∆ В th ).
Масштабная линейка 5 мм. b Передаточные характеристики OFET (W/L = 1500 мкм/90 мкм) при различных углах изгиба. c Измеренное общее сопротивление в открытом состоянии, нормализованное по ширине канала ( R ON · Вт) для гибких OFET с различной длиной канала ( L ch ), изогнутых под углом 73˚. d Извлеченное контактное сопротивление ( R C ) при различных В GS для различных углов изгиба на основе метода линии передачи (TLM). e Передаточные характеристики после различных циклов изгиба (радиус изгиба = 10 мм) и ( f ) результирующее изменение подпорогового колебания ( SS ) и порогового напряжения (∆ В th ). Иммобилизация и гибридизация зонда
 Схема иммобилизации зондов на СЭ с расширенными воротами представлена на рис. 4а. Зонд тиолированной одноцепочечной ДНК (оцДНК) был разработан для соответствия миР-21 для специфического обнаружения. Основываясь на хорошо зарекомендовавшей себя химии тиол-золота, зонды одноцепочечной ДНК и 6-меркапто-1-гексанол (MCH) смогли эффективно самосбориться на поверхности золотого электрода за счет прочного связывания SH-золота. Зонды одноцепочечной ДНК работают как рецепторы для захвата мишеней миРНК, в то время как MCH, как блокирующий слой, снижает взаимодействие миРНК-золото и, таким образом, улучшает дискриминацию при гибридизации 27,28 . В результате мишени miR-21 были селективно захвачены на SE с расширенными воротами посредством гибридизации ДНК/миРНК согласно закону спаривания оснований Watson-Crick 29 .
Схема иммобилизации зондов на СЭ с расширенными воротами представлена на рис. 4а. Зонд тиолированной одноцепочечной ДНК (оцДНК) был разработан для соответствия миР-21 для специфического обнаружения. Основываясь на хорошо зарекомендовавшей себя химии тиол-золота, зонды одноцепочечной ДНК и 6-меркапто-1-гексанол (MCH) смогли эффективно самосбориться на поверхности золотого электрода за счет прочного связывания SH-золота. Зонды одноцепочечной ДНК работают как рецепторы для захвата мишеней миРНК, в то время как MCH, как блокирующий слой, снижает взаимодействие миРНК-золото и, таким образом, улучшает дискриминацию при гибридизации 27,28 . В результате мишени miR-21 были селективно захвачены на SE с расширенными воротами посредством гибридизации ДНК/миРНК согласно закону спаривания оснований Watson-Crick 29 . b Флуоресцентные изображения золота, иммобилизованного оцДНК, инкубированного с раствором PBS 1X, и растворами, содержащими флуоресцентные красители, меченные miR-21, в различных концентрациях: 10 пМ, 1 нМ и 100 мкМ соответственно.
b Флуоресцентные изображения золота, иммобилизованного оцДНК, инкубированного с раствором PBS 1X, и растворами, содержащими флуоресцентные красители, меченные miR-21, в различных концентрациях: 10 пМ, 1 нМ и 100 мкМ соответственно. Внедрение сенсора miRNA
 5а. Процессы инкапсуляции подробно описаны в разделе «МЕТОДЫ». После того, как SE с расширенным затвором и RE были помещены в раствор PBS 1X, была измерена кривая I D – V Ref путем развертки V ref AT A V DS = — 0,5 В, что представляет собой очевидный сдвиг в негативное направление по сравнению с I D — V GS Curve of Priste, as a as as as as as a as a as a as a a a a a as a a a a a a a a as a a a a a a a a a a a a a a a a a a a a a a has d — v
5а. Процессы инкапсуляции подробно описаны в разделе «МЕТОДЫ». После того, как SE с расширенным затвором и RE были помещены в раствор PBS 1X, была измерена кривая I D – V Ref путем развертки V ref AT A V DS = — 0,5 В, что представляет собой очевидный сдвиг в негативное направление по сравнению с I D — V GS Curve of Priste, as a as as as as as a as a as a as a a a a a as a a a a a a a a as a a a a a a a a a a a a a a a a a a a a a a has d — v На рис. 5в показаны измеренные кривые I D – V Ref с использованием того же датчика при изменении концентрации мишеней miR-21 от 0 до 1 мкМ. Значения V th были извлечены из кривых I D – V Ref при токе стока 1 нА. Измеренное В th смещение (Δ V TH ) при различных концентрациях miR-21, рассчитанных с использованием V TH в 0 м miR-21 в виде пустого (Δ V TH = V TH . miRNA − V th Blank ), показана на рис. 5г. Раствор, содержащий несоответствующую микроРНК из 3 оснований в гораздо более высокой концентрации (100 мкМ), также был протестирован для сравнения. Результаты показывают, что Δ V th для самой низкой измеренной концентрации miR-21 (10 пМ) составляет 16,9.± 5 мВ, что намного выше, чем значение (0,2 ± 5 мВ) для микроРНК с несоответствием по 3 основаниям высокой концентрации (100 мкМ), что указывает на высокую селективность.
На рис. 5в показаны измеренные кривые I D – V Ref с использованием того же датчика при изменении концентрации мишеней miR-21 от 0 до 1 мкМ. Значения V th были извлечены из кривых I D – V Ref при токе стока 1 нА. Измеренное В th смещение (Δ V TH ) при различных концентрациях miR-21, рассчитанных с использованием V TH в 0 м miR-21 в виде пустого (Δ V TH = V TH . miRNA − V th Blank ), показана на рис. 5г. Раствор, содержащий несоответствующую микроРНК из 3 оснований в гораздо более высокой концентрации (100 мкМ), также был протестирован для сравнения. Результаты показывают, что Δ V th для самой низкой измеренной концентрации miR-21 (10 пМ) составляет 16,9.± 5 мВ, что намного выше, чем значение (0,2 ± 5 мВ) для микроРНК с несоответствием по 3 основаниям высокой концентрации (100 мкМ), что указывает на высокую селективность. Кроме того, предел обнаружения (LOD) использовался для интерпретации обнаруживаемости датчика. Он определяется как концентрация, которая приводит к отклику сенсора, равному трехкратному стандартному отклонению отрицательного контрольного образца (Δ V th означает ± 3σ), где Δ V th означает — средний отклик, σ — относительное стандартное отклонение 30 . В соответствии с этим определением LOD был оценен в 4,5 пМ, приняв ответ миРНК с несовпадением 3 оснований в качестве образца отрицательного контроля. Обратите внимание, что ответ при 10 пМ выходит за пределы LOD (рис. 5d), что подтверждает высокую способность биосенсора OFET к восприятию при такой низкой концентрации. Измеренное относительное изменение тока (∆ I D / I D0 ) при В Ref = −0,1 В для различных концентраций miR-21 показано на рис. 5e. Для низкой концентрации 10 пМ ∆ I D / I D0 20% может быть получено для достаточно большого SNR для обработки последующей считывающей электроникой для оцифровки.
Кроме того, предел обнаружения (LOD) использовался для интерпретации обнаруживаемости датчика. Он определяется как концентрация, которая приводит к отклику сенсора, равному трехкратному стандартному отклонению отрицательного контрольного образца (Δ V th означает ± 3σ), где Δ V th означает — средний отклик, σ — относительное стандартное отклонение 30 . В соответствии с этим определением LOD был оценен в 4,5 пМ, приняв ответ миРНК с несовпадением 3 оснований в качестве образца отрицательного контроля. Обратите внимание, что ответ при 10 пМ выходит за пределы LOD (рис. 5d), что подтверждает высокую способность биосенсора OFET к восприятию при такой низкой концентрации. Измеренное относительное изменение тока (∆ I D / I D0 ) при В Ref = −0,1 В для различных концентраций miR-21 показано на рис. 5e. Для низкой концентрации 10 пМ ∆ I D / I D0 20% может быть получено для достаточно большого SNR для обработки последующей считывающей электроникой для оцифровки. Следовательно, датчик способен достигать предела обнаружения ниже 10 пМ для целевых микроРНК с хорошей селективностью при низком рабочем напряжении (<1 В). Общая производительность показывает компетентность по сравнению с предыдущей работой на основе Si-FET в таблице 1 с точки зрения предела обнаружения, рабочего напряжения и статической мощности 31 . Рис. 5. Характеристики низковольтного OFET-датчика миРНК.
Следовательно, датчик способен достигать предела обнаружения ниже 10 пМ для целевых микроРНК с хорошей селективностью при низком рабочем напряжении (<1 В). Общая производительность показывает компетентность по сравнению с предыдущей работой на основе Si-FET в таблице 1 с точки зрения предела обнаружения, рабочего напряжения и статической мощности 31 . Рис. 5. Характеристики низковольтного OFET-датчика миРНК.  После иммобилизации зондов оцДНК на сенсорном электроде наблюдается небольшой сдвиг назад из-за отрицательно заряженных зондов. c Измерено I D – V Ref кривые для концентрации мишеней miR-21 в диапазоне от 0 до 1 мкМ. d Извлеченный V th сдвиг (Δ V th ) кривых при различных концентрациях миР-21 с результатами теста на несоответствие миРНК из 3 оснований в качестве фонового уровня. Пунктирные линии показывают предел обнаружения (LOD), полученный из трехкратной планки погрешности стандартного измерения пустого шума. Столбики погрешностей указывают на стандартные отклонения. e Измеренное относительное изменение тока от фонового уровня (∆ I D / I D0 ) при В Ref = с- 0,1 В для различных концентраций ми. Столбики погрешностей указывают на стандартные отклонения.
После иммобилизации зондов оцДНК на сенсорном электроде наблюдается небольшой сдвиг назад из-за отрицательно заряженных зондов. c Измерено I D – V Ref кривые для концентрации мишеней miR-21 в диапазоне от 0 до 1 мкМ. d Извлеченный V th сдвиг (Δ V th ) кривых при различных концентрациях миР-21 с результатами теста на несоответствие миРНК из 3 оснований в качестве фонового уровня. Пунктирные линии показывают предел обнаружения (LOD), полученный из трехкратной планки погрешности стандартного измерения пустого шума. Столбики погрешностей указывают на стандартные отклонения. e Измеренное относительное изменение тока от фонового уровня (∆ I D / I D0 ) при В Ref = с- 0,1 В для различных концентраций ми. Столбики погрешностей указывают на стандартные отклонения. Сравнение производительности биосенсора OFET для обнаружения miRNA с предыдущей работой на основе кремниевого FET 31 .
Сравнение производительности биосенсора OFET для обнаружения miRNA с предыдущей работой на основе кремниевого FET 31 .  Результаты демонстрируют, что датчик может достичь предела обнаружения ниже 10 пМ для целевых микроРНК с хорошей селективностью при низком рабочем напряжении (<1 В). Общая производительность конкурентоспособна по сравнению с предыдущей работой на основе Si-FET с точки зрения предела обнаружения, рабочего напряжения и статической мощности. Эта работа проложит путь к разработке недорогих и удобных биосенсоров на основе OFET, имеющих большие SNR для настраиваемого обнаружения биомаркеров заболеваний как в биологических исследованиях, так и в клинической диагностике.
Результаты демонстрируют, что датчик может достичь предела обнаружения ниже 10 пМ для целевых микроРНК с хорошей селективностью при низком рабочем напряжении (<1 В). Общая производительность конкурентоспособна по сравнению с предыдущей работой на основе Si-FET с точки зрения предела обнаружения, рабочего напряжения и статической мощности. Эта работа проложит путь к разработке недорогих и удобных биосенсоров на основе OFET, имеющих большие SNR для настраиваемого обнаружения биомаркеров заболеваний как в биологических исследованиях, так и в клинической диагностике. Методы
Материалы и реагенты
 %) терполимер (П(ВДФ-ТрФЭ-ХФЭ)) синтезирован методом суспензионной полимеризации 32 . 6,13-бис(триизопропилсилилэтинил)пентацен (TIPS-пентацен) (FN4023) был предоставлен компанией Merck Chemicals Ltd. CYTOP (CTL-809M) был получен от Asahi Glass. Серебряные (Ag) пасты были получены от Hisense Electronics, Куньшань, Китай. Силиконовый герметик был приобретен в компании Shanghai Qianru Building Materials. Раствор фосфатно-солевого буфера (PBS 1X, pH = 7,2) был получен от Thermo Fisher Scientific. Последовательности одноцепочечной ДНК-зонда (5′-SH-CCCCCCTCAACATCAGTCTGATAAGCTA-3′), полностью комплементарной микроРНК-мишени (5′-UAGCUUAUCAGACUGAUGUUGA-3′), некомплементарной микроРНК с несоответствием по 3 основаниям (5′-UAGCCUAUCAAACUGAUGAUGA-3′ ), и флуоресцентно окрашенная миР-21 (5′-FAM-UAGCUUAUCAGACUGAUGUUGA-3′), используемые в этом исследовании, были синтезированы Sangon Biotech (Shanghai) Co. Ltd., Китай.
%) терполимер (П(ВДФ-ТрФЭ-ХФЭ)) синтезирован методом суспензионной полимеризации 32 . 6,13-бис(триизопропилсилилэтинил)пентацен (TIPS-пентацен) (FN4023) был предоставлен компанией Merck Chemicals Ltd. CYTOP (CTL-809M) был получен от Asahi Glass. Серебряные (Ag) пасты были получены от Hisense Electronics, Куньшань, Китай. Силиконовый герметик был приобретен в компании Shanghai Qianru Building Materials. Раствор фосфатно-солевого буфера (PBS 1X, pH = 7,2) был получен от Thermo Fisher Scientific. Последовательности одноцепочечной ДНК-зонда (5′-SH-CCCCCCTCAACATCAGTCTGATAAGCTA-3′), полностью комплементарной микроРНК-мишени (5′-UAGCUUAUCAGACUGAUGUUGA-3′), некомплементарной микроРНК с несоответствием по 3 основаниям (5′-UAGCCUAUCAAACUGAUGAUGA-3′ ), и флуоресцентно окрашенная миР-21 (5′-FAM-UAGCUUAUCAGACUGAUGUUGA-3′), используемые в этом исследовании, были синтезированы Sangon Biotech (Shanghai) Co. Ltd., Китай. Изготовление устройств
 PVCN растворяли в хлорбензоле с концентрацией 10 мг/мл и наносили центрифугированием при 3000 об/мин на подложку в качестве выравнивающего слоя с последующей УФ-сшивкой (UV Curer KW-4AC, CHEMAT) в течение 20 мин и затем нагреванием при 100 °C в течение 1 ч. Затем серебряные (Ag) затворные электроды толщиной 40 нм были нанесены путем термического испарения с использованием маски из нержавеющей стали. Затем высокая k P(VDF-TrFE-CFE) (растворенный в метилэтилкетоне, 40 мг/мл) и low-k PVCN (растворенный в хлорбензоле, 10 мг/мл) были последовательно покрыты центрифугированием с образованием толстой диэлектрик с двухслойным затвором. Электроды истока/стока Ag (S/D) были получены с использованием тех же процессов, что и для формирования электродов затвора, определяя ширину канала 2000 мкм и длину канала 70 мкм соответственно. Устройства с одинаковой шириной канала (1500 мкм) и рядом длин каналов (50, 70, 90 и 110 мкм) также использовали для оценки механической стабильности. Перед нанесением полупроводникового слоя образец погружали в раствор ПФБТ (5 мМ в изопропаноле) на 15 мин для формирования самоорганизующихся монослоев на электродах S/D.
PVCN растворяли в хлорбензоле с концентрацией 10 мг/мл и наносили центрифугированием при 3000 об/мин на подложку в качестве выравнивающего слоя с последующей УФ-сшивкой (UV Curer KW-4AC, CHEMAT) в течение 20 мин и затем нагреванием при 100 °C в течение 1 ч. Затем серебряные (Ag) затворные электроды толщиной 40 нм были нанесены путем термического испарения с использованием маски из нержавеющей стали. Затем высокая k P(VDF-TrFE-CFE) (растворенный в метилэтилкетоне, 40 мг/мл) и low-k PVCN (растворенный в хлорбензоле, 10 мг/мл) были последовательно покрыты центрифугированием с образованием толстой диэлектрик с двухслойным затвором. Электроды истока/стока Ag (S/D) были получены с использованием тех же процессов, что и для формирования электродов затвора, определяя ширину канала 2000 мкм и длину канала 70 мкм соответственно. Устройства с одинаковой шириной канала (1500 мкм) и рядом длин каналов (50, 70, 90 и 110 мкм) также использовали для оценки механической стабильности. Перед нанесением полупроводникового слоя образец погружали в раствор ПФБТ (5 мМ в изопропаноле) на 15 мин для формирования самоорганизующихся монослоев на электродах S/D. После такой обработки его тщательно промывали изопропанолом и продували сухим газом N 2 с последующим отжигом при 100 ˚C на горячей плите в течение 1 мин. Раствор, смешанный с полупроводником и полимером, готовили путем смешивания растворов TIPS-пентацена и полистирола (растворенных в хлорбензоле, 10 мг·мл -1 ) в соотношении 3:1 по объему. Полупроводниковая пленка была сформирована методом мягкого контакта с вращающимся стальным листом в качестве направляющей мениска при скорости покрытия 20 мм/с с последующим отжигом при 100 °C в течение 30 мин 23 . Наконец, раствор CYTOP (10 мкл) заливали каплями для пассивации канала и отжигали при 80 °C в течение 30 минут.
После такой обработки его тщательно промывали изопропанолом и продували сухим газом N 2 с последующим отжигом при 100 ˚C на горячей плите в течение 1 мин. Раствор, смешанный с полупроводником и полимером, готовили путем смешивания растворов TIPS-пентацена и полистирола (растворенных в хлорбензоле, 10 мг·мл -1 ) в соотношении 3:1 по объему. Полупроводниковая пленка была сформирована методом мягкого контакта с вращающимся стальным листом в качестве направляющей мениска при скорости покрытия 20 мм/с с последующим отжигом при 100 °C в течение 30 мин 23 . Наконец, раствор CYTOP (10 мкл) заливали каплями для пассивации канала и отжигали при 80 °C в течение 30 минут. Инкапсуляция сенсорной метки
 Процесс склеивания был разработан путем переворачивания устройства OFET и прикрепления к подложке с помощью серебряной пасты с последующим отжигом при 80 ° C в течение 10 мин. Наконец, с помощью робота-дозатора был дозирован силиконовый герметик для герметизации устройства.
Процесс склеивания был разработан путем переворачивания устройства OFET и прикрепления к подложке с помощью серебряной пасты с последующим отжигом при 80 ° C в течение 10 мин. Наконец, с помощью робота-дозатора был дозирован силиконовый герметик для герметизации устройства. Подготовка чувствительного электрода
 Полученные сенсорные электроды сразу же использовали для воздействия 10 мкл полностью комплементарных мишеней (миР-21 или окрашенная FAM-миР-21) и некомплементарных мишеней (миРНК с несоответствием по 3 основаниям), разведенных до желаемых концентраций в растворах PBS 1X для гибридизации, соответственно. , затем тщательно промыть раствором PBS 1X.
Полученные сенсорные электроды сразу же использовали для воздействия 10 мкл полностью комплементарных мишеней (миР-21 или окрашенная FAM-миР-21) и некомплементарных мишеней (миРНК с несоответствием по 3 основаниям), разведенных до желаемых концентраций в растворах PBS 1X для гибридизации, соответственно. , затем тщательно промыть раствором PBS 1X. Характеристика и измерение
 Электрические характеристики OFET и биосенсоров были выполнены с использованием анализатора полупроводниковых параметров (система Keithley 4200). Все измерения проводились при комнатной температуре на воздухе.
Электрические характеристики OFET и биосенсоров были выполнены с использованием анализатора полупроводниковых параметров (система Keithley 4200). Все измерения проводились при комнатной температуре на воздухе. Доступность данных
Ссылки
 Доп. Матер. 22 , 4452–4456 (2010).
Доп. Матер. 22 , 4452–4456 (2010). Заяв. физ. лат. 104 , 243703 (2014).
Заяв. физ. лат. 104 , 243703 (2014). , Родригес-Мансано, Дж., Ланде, Т. С. и Георгиу, П. Масштабируемый массив датчиков и памяти ISFET с автоматической калибровкой датчика для встроенного обнаружения ДНК в реальном времени. IEEE Trans. Биомед. Цепи Сист. 12 , 390–401 (2018).
, Родригес-Мансано, Дж., Ланде, Т. С. и Георгиу, П. Масштабируемый массив датчиков и памяти ISFET с автоматической калибровкой датчика для встроенного обнаружения ДНК в реальном времени. IEEE Trans. Биомед. Цепи Сист. 12 , 390–401 (2018). Биосенс. Биоэлектрон. 99 , 525–546 (2018).
Биосенс. Биоэлектрон. 99 , 525–546 (2018). Япония. Дж. Заявл. физ. 45 , 3776–3783 (2006).
Япония. Дж. Заявл. физ. 45 , 3776–3783 (2006). 0057 k полимерный диэлектрический слой затвора. Доп. Электрон. Матер. 2 , 1500454 (2016).
0057 k полимерный диэлектрический слой затвора. Доп. Электрон. Матер. 2 , 1500454 (2016). ACS Sens 3 , 929–935 (2018).
ACS Sens 3 , 929–935 (2018). Благодарности
Информация об авторе
Авторы и организации
Contributions
 G., Y.Y. и F.Y. задумал идею. В.Т. и К.Г. разработал эксперименты, проанализировал данные и написал статью. Ю.Х. изготовил органический полевой транзистор и участвовал в изготовлении метки. Ю.Ф. и Ю.Л. выполнили подготовку биосенсоров и их характеристики. ХХ выполнили СЭМ-изображение. Ю.С. и Ю.С. помогли проанализировать данные и отредактировать статью. Х.Г. и Ф.Ю. курировал проект. Все авторы обсудили результаты и внесли свой вклад в подготовку статьи. В.Т. и Ю.Ф. в равной мере внесли свой вклад в эту работу.
G., Y.Y. и F.Y. задумал идею. В.Т. и К.Г. разработал эксперименты, проанализировал данные и написал статью. Ю.Х. изготовил органический полевой транзистор и участвовал в изготовлении метки. Ю.Ф. и Ю.Л. выполнили подготовку биосенсоров и их характеристики. ХХ выполнили СЭМ-изображение. Ю.С. и Ю.С. помогли проанализировать данные и отредактировать статью. Х.Г. и Ф.Ю. курировал проект. Все авторы обсудили результаты и внесли свой вклад в подготовку статьи. В.Т. и Ю.Ф. в равной мере внесли свой вклад в эту работу. Авторы переписки
Заявление об этике
Конкурирующие интересы
Дополнительная информация
Дополнительная информация
ДОПОЛНИТЕЛЬНЫЙ МАТЕРИАЛ
Права и разрешения
 0 International License, которая разрешает использование, совместное использование, адаптацию, распространение и воспроизведение на любом носителе или в любом формате при условии, что вы укажете соответствующую ссылку на первоначальный автор(ы) и источник, предоставьте ссылку на лицензию Creative Commons и укажите, были ли внесены изменения. Изображения или другие сторонние материалы в этой статье включены в лицензию Creative Commons для статьи, если иное не указано в кредитной строке материала. Если материал не включен в лицензию Creative Commons статьи, а ваше предполагаемое использование не разрешено законом или выходит за рамки разрешенного использования, вам необходимо получить разрешение непосредственно от правообладателя. Чтобы просмотреть копию этой лицензии, посетите http://creativecommons.org/licenses/by/4.0/.
0 International License, которая разрешает использование, совместное использование, адаптацию, распространение и воспроизведение на любом носителе или в любом формате при условии, что вы укажете соответствующую ссылку на первоначальный автор(ы) и источник, предоставьте ссылку на лицензию Creative Commons и укажите, были ли внесены изменения. Изображения или другие сторонние материалы в этой статье включены в лицензию Creative Commons для статьи, если иное не указано в кредитной строке материала. Если материал не включен в лицензию Creative Commons статьи, а ваше предполагаемое использование не разрешено законом или выходит за рамки разрешенного использования, вам необходимо получить разрешение непосредственно от правообладателя. Чтобы просмотреть копию этой лицензии, посетите http://creativecommons.org/licenses/by/4.0/. Об этой статье
Полевой транзистор на солнечной энергии
 Кирмани
24 мая 2018 г.
Кирмани
24 мая 2018 г. Важно отметить, что соляристор был реализован как двухэлектродная вертикальная многослойная архитектура, что значительно уменьшило сложность межсоединений традиционной трехэлектродной транзисторной архитектуры в плоскости.
Важно отметить, что соляристор был реализован как двухэлектродная вертикальная многослойная архитектура, что значительно уменьшило сложность межсоединений традиционной трехэлектродной транзисторной архитектуры в плоскости. 0797–2 .
0797–2 . Органический поглотитель состоял из смеси полимера P3HT (донор) и фуллерена PCBM в качестве акцептора. В качестве транспортера дырок и металлического анода использовали соответственно V 2 O 5 и серебро.
Органический поглотитель состоял из смеси полимера P3HT (донор) и фуллерена PCBM в качестве акцептора. В качестве транспортера дырок и металлического анода использовали соответственно V 2 O 5 и серебро. «В этом отчете представлена новая архитектура устройства для фотопереключения, которую проще реализовать с помощью фотогальванических материалов, чем стандартную архитектуру фототранзистора. Сообщество фотогальваники в настоящее время переживает возрождение в открытии материалов благодаря недавнему успеху перовскитов гибридного галогенида свинца. Архитектура, представленная Lira-Cantú et al. может позволить этим новым материалам проникнуть в сообщество фотопереключателей, облегчив их исследование», — говорят Хой и Дрисколл в электронном письме.
«В этом отчете представлена новая архитектура устройства для фотопереключения, которую проще реализовать с помощью фотогальванических материалов, чем стандартную архитектуру фототранзистора. Сообщество фотогальваники в настоящее время переживает возрождение в открытии материалов благодаря недавнему успеху перовскитов гибридного галогенида свинца. Архитектура, представленная Lira-Cantú et al. может позволить этим новым материалам проникнуть в сообщество фотопереключателей, облегчив их исследование», — говорят Хой и Дрисколл в электронном письме. .
. Рынок полевых транзисторов | Рост, тенденции, влияние COVID-19 и прогнозы (2022
Рынок полевых транзисторов | Рост, тенденции, влияние COVID-19 и прогнозы (2022–2027) Обзор рынка
Период обучения: 2020-2027 гг. Базисный год: 2021 Самый быстрорастущий рынок: Северная Америка Самый большой рынок: Азиатско-Тихоокеанский регион CAGR: 5,5 % Нужен отчет, отражающий, как COVID-19 повлиял на этот рынок и его рост?
Обзор рынка
 д., способствует развитию рынка. А полевые транзисторы широко используются в интегральных схемах (ИС) благодаря их компактным размерам. Прогнозируется, что другие факторы, такие как растущее сокращение размеров электронных компонентов и принятие различных государственных мер по созданию современной инфраструктуры распределения электроэнергии и генерации, будут способствовать развитию рынка.
д., способствует развитию рынка. А полевые транзисторы широко используются в интегральных схемах (ИС) благодаря их компактным размерам. Прогнозируется, что другие факторы, такие как растущее сокращение размеров электронных компонентов и принятие различных государственных мер по созданию современной инфраструктуры распределения электроэнергии и генерации, будут способствовать развитию рынка.
 Китай является одним из крупнейших производителей и экспортеров различных материалов для электроники, таких как полевые транзисторы, конденсаторы, диоды, выпрямители, усилители и т.д. остановить производство готовых электронных изделий, таких как телевизоры, смартфоны и адаптеры для мобильных телефонов, что приведет к разрыву спроса и предложения в электронных продуктах.
Китай является одним из крупнейших производителей и экспортеров различных материалов для электроники, таких как полевые транзисторы, конденсаторы, диоды, выпрямители, усилители и т.д. остановить производство готовых электронных изделий, таких как телевизоры, смартфоны и адаптеры для мобильных телефонов, что приведет к разрыву спроса и предложения в электронных продуктах. Объем отчета
По типу Полевые транзисторы JFET P — Тип N — Тип MOSFET -METLE -OXID -SECIDE -SECEDONTOUNTOUNTEROR. 
По приложениям Аналоговые переключатели АМПЛИФИФИРЕЙ.0019 Phase Shift Oscillator Current Limiter Digital Circuits Others By End-User Automotive Consumer электроника ИТ/Телекоммуникации Энергетика Other End Users Geography North America Europe Asia-Pacific Latin America Middle-East и Африка  Кликните сюда.
Кликните сюда. Ключевые тенденции рынка
Ожидается, что автомобильный сегмент будет стимулировать рост рынка
 Производители отреагировали на это созданием новой линейки полевых транзисторов для автомобильных приложений.
Производители отреагировали на это созданием новой линейки полевых транзисторов для автомобильных приложений. . Он предназначен для бортовых зарядных устройств электромобилей (EV), инверторов электропривода и внешних зарядных станций, которые требуют высокой эффективности и надежности. Для автомобильного TO-247-4L с типичным приводом затвора 15 В SiC MOSFET на 1200 В обеспечивают низкое сопротивление в открытом состоянии.
. Он предназначен для бортовых зарядных устройств электромобилей (EV), инверторов электропривода и внешних зарядных станций, которые требуют высокой эффективности и надежности. Для автомобильного TO-247-4L с типичным приводом затвора 15 В SiC MOSFET на 1200 В обеспечивают низкое сопротивление в открытом состоянии. Ожидается, что в Северной Америке будет зарегистрирован значительный рост
 On Semiconductor Corporation, Diodes Incorporated и D3 Semiconductor LLC входят в число компаний, базирующихся в этом районе.
On Semiconductor Corporation, Diodes Incorporated и D3 Semiconductor LLC входят в число компаний, базирующихся в этом районе. По данным организации World Semiconductor Trade Statistics (WSTS), на этот регион приходится примерно 22% полупроводниковой промышленности.
По данным организации World Semiconductor Trade Statistics (WSTS), на этот регион приходится примерно 22% полупроводниковой промышленности. Спрос подпитывается потребительским спросом во всем регионе.
Спрос подпитывается потребительским спросом во всем регионе. Конкурентная среда
Основные игроки

СОДЕРЖАНИЕ
 2.1 Из-за статического электричества полевые транзисторы могут быть повреждены
2.1 Из-за статического электричества полевые транзисторы могут быть повреждены 4.2 Europe
4.2 Europe5
 1.15 MACOM
1.15 MACOM Часто задаваемые вопросы
Каков период изучения этого рынка?
Какова скорость роста рынка полевых транзисторов?
Какой регион имеет самые высокие темпы роста на рынке Полевой транзистор?
Какой регион имеет наибольшую долю на рынке Полевые транзисторы?

Кто является ключевыми игроками на рынке полевых транзисторов?
80% наших клиентов ищут отчеты на заказ. Как ты
хотите, чтобы мы подогнали вашу?
Спасибо!