MOSFET или IGBT?
Сначала рассмотрим различия в целом. В настоящий момент все производители инверторов (ММА) выпускаются по двум полупроводниковым технологиям IGBT и MOSFET. Не буду вдаваться в подробности, скажу только то, что в схемотехнике этих аппаратов используются разные полупроводниковые транзисторы IGBT и MOSFET. Основое различие между этими транзисторами — различный ток коммутации. Большим током обладают транзисторы IGBT.
Для изготовления стандартного инвертора понадобится 2–4 IGBT транзистора (в зависимости от рабочего цикла), a MOSFET — 10–12, т. к. они не могут пропускать через себя большие токи, поэтому их приходится делить на такое большое количество транзисторов. Вот собственно в чем и отличие.
Тонкость в том, что транзисторы очень сильно греются и их необходимо установить на мощные алюминиевые радиаторы. Чем больше радиатор, тем больше съем тепла с него, а, следовательно, его охлаждающая способность. Чем больше транзисторов, тем больше радиаторов охлаждения необходимо установить, следовательно, увеличиваются габариты, вес и т. д. MOSFET здесь однозначно проигрывает.
На практике схемотехника MOSFET не позволяет создать аппарат на одной плате: т.е аппараты, которые сейчас есть в продаже, собраны в основном на трех платах. IGBT аппараты всегда идут на одной плате.
Основные недостатки MOSFET
- соединение трех плат;
- худший теплообмен;
- каскадный выход транзисторов из строя при неисправности одного транзистора;
- меньший КПД (относительно IGBT).
Проще говоря, IGBT более современная технология, чем MOSFET.
Недостатки MOSFET
Что лучше MOSFET или IGBT?
Некоторые компании идут в ногу со временем и при производстве сварочных инверторов используют IGBT транзисторы американской фирмы «Fairchaild», частота переключения которых составляет 50 кГц, т. е. 50000 раз в секунду. IGBT технологию выбрали неспроста, ведь рабочий диапазон температур у них с сохранением параметров гораздо больше, чем у MOSFET, т. е. при нагреве у MOSFETa падают качественные характеристики.
В конструкции САИ (Ресанта) используется одна маленькая плата, которая устанавливается вертикально, а также 4 IGBT транзистора (работают обособленно друг от друга, т. е. не выгорают все, если выгорел один как у MOSFET) и 6 диодов-выпрямителей (а не 12 как у MOSFET), соответственно отказоустойчивость ниже. Это ещё один «плюс» IGBT.
Можно напомнить покупателю о том, что в современных сварочных инверторов используется только 4 обособленных транзистора, а не 12 каскаднозависимых как у MOSFET. Всякое в жизни бывает, но, чтобы не произошло в случае выхода из строя одного транзистора (если не гарантийный случай), замена покупателю обойдется где-то в районе 400 р., а не 12×110 р. = 1320 р. Думаю, что разница приличная.
Как отличить: Визуально аппараты IGBT в большинстве своём отличаются от MOSFET вертикальным расположением силовых разъёмов, т. к. плата одна и обычно устанавливается вертикально. У MOSFET аппаратов выходы обычно расположены горизонтально, т. к. платы в конструкции горизонтально закреплены. Нельзя точно утверждать, что это верно на 100%. Точнее можно сказать, сняв кожух с аппарата.
Многие компании пытаются «выиграть баллы» на транзисторах. Так, например, компания «Aiken» в настоящий момент выпустила на рынок аппараты (по технологии MOSFET) с наклейками на боковых панелях «Используются транзисторы TOSHIBA» а также «Используются транзисторы Mitsubishi». Пытаются выползти на громких и знакомых брендах. На практике это не подтвердилось. Так на крупнейшей Международной инструментальной выставке России Moscow International Tool Expo (MITEX-2011), которая проходила в ноябре 2011г. в «Экспоцентре» (г. Москва), я попросил представителей стенда данной компании разобрать их САИ с наклейкой «Используются транзисторы Mitsubishi» и продемонстрировать данные транзисторы. В итоге сварочные инверторы разобрали, но данных транзисторов не обнаружили. Сами сотрудники компании «Aiken» были в шоке, обнаружив безымянные транзисторы.
Использование MOSFET транзисторов в электромобилях / Статьи и обзоры / Элек.ру
Три технологических фактора, оказывающих влияние на рынок, одновременно создают возможность для SiC MOSFET стать основным типом силовых ключей в электромобилях с батарейным питанием (BEV). Совершенствование тяговых приводов BEV, в которых применение SiC технологии позволяет снизить потери инвертора до ~78% в цикле EPA, предлагает разработчикам таких систем увеличение пробега или снижение цены батареи при заданном пробеге.
Компания Cree/Wolfspeed серийно выпускает SiC пластины с 1991 года, диоды — с 2001 и MOSFET — с 2011 года. Рынок силовых SiC модулей постоянно растёт и сейчас его оборот превышает $200 млн.
Развитие SiC технологии
Прогресс технологии карбида кремния, идущий по пути увеличения диаметра, объема выпуска, повышения качества и снижения стоимости SiC, достиг точки, когда массовое производство 150-мм пластин основано на использовании карбидокремниевых заготовок, как показано на рис. 1. В 2016 календарном году компания Wolfspeed произвела почти 18 тонн 150-мм SiC-пластин [1] для рынков LED-, RF- и силовых приборов с прогнозом дальнейшего роста. Также были продемонстрированы опытные образцы SiC-пластин диаметром 200 мм как пример дальнейшего увеличения диаметра. Качество SiC-пластин непрерывно улучшалось на протяжении нескольких лет, в 2016 году средняя величина MPD (Micropipe Density) упала до 0,2/см2. Это позволяет выпускать кристаллы SiC MOSFET большой площади, удовлетворяющие требованиям автомобильного стандарта AEC-Q-101.

Удельное сопротивление канала на единицу площади SiC MOSFET, появившихся в 2011 году, продолжает улучшаться. Например, первое поколение SiC MOSFET (серия CMF Wolfspeed [2]), изготовленное в 2011 году, имело удельное значение RDS(ON) при +25 °C около 8 мОм•см2, возрастающее до 11 мОм*см2 при +150 °С. У второго поколения (C2M), появившегося в 2013 году, эта величина существенно снижена, и наконец, SiC MOSFET 1200 В третьего поколения (C3M [3]), выпущенные в 2017 году, характеризуются очередным резким снижением RDS(ON), особенно при рабочей температуре. Как показано на рис. 2, у SiC MOSFET 1200В (C3M0075120K) удельное значение RDS(ON) составляет всего 4,4 мОм*см2 при +150 °C, что на 60% ниже, чем у исходного CMF-транзистора.
Все три генерации имеют планарную структуру DMOS, при этом в третьем поколении использован более компактный шаг ячейки и оптимизирован процесс легирования в дрейфовой области для снижения сопротивления MOSFET во всем температурном диапазоне. Пиковые электрические поля в структурах SiC MOSFET такие же или меньшие, чем у компонентов предыдущих поколений, поэтому показатели надежности остались на прежнем уровне.
SiC технология для автомобилей
Мировой рост рынка BEV, обеспечивающий соответствие современным стандартам по экономичности и снижению выбросов CO2, требует применения новых полупроводниковых технологий в инверторе привода. Напряжение питания инвертора BEV находится в диапазоне 400–900 В в зависимости от мощности привода, типа батареи и наличия повышающего конвертера. Поскольку инвертор привода управляет мотором, его рабочая частота обычно не превышает 20 кГц. Преимущество использования более высоких частот здесь состоит только в уходе от слышимого диапазона аудиошумов. Следовательно, основные потери инвертора — это потери проводимости, особенно при малых нагрузках BEV.

Как правило, выбором в таком случае становится кремниевый IGBT, однако присущее ему пороговое напряжение насыщения (из-за его «биполярной» структуры) на малой нагрузке нельзя уменьшить, даже при параллельном включении большого количества IGBT. Карбид кремния имеет в 10 раз более высокую напряженность электрического поля (~3 МВ/см), чем Si, поэтому униполярная SiC MOSFET-структура хорошо подходит для реализации силовых транзисторов 650, 900 и 1200 В благодаря следующим основным особенностям:
- SiC MOSFET не имеют напряжения насыщения, в отличие от Si IGBT; при параллельном включении чипов SiC MOSFET можно снизить сопротивление открытого канала до ≤ 1–2 мОм;
- SiC MOSFET могут реализовать проводимость в третьем квадранте (в отличие от Si IGBT) за счет использования тельного диода в «мертвое» время (время Tdt очень малое у SiC-структур) и последующего открывания канала SiC. MOSFET в третьем квадранте, что дает такие же низкие потери в состоянии обратной проводимости, как и при прямой проводимости. Комбинация использования тельного диода в течение «мертвого» времени и синхронного выпрямления исключает необходимость во внешнем антипараллельном диоде, что позволяет снизить габариты и стоимость при минимальном влиянии на эффективность на частотах до 50 кГц;
- применение SiC MOSFET может снизить потери инвертора в типовом приводном цикле BEV EPA до ~78 %.
Результаты
Компания Wolfspeed разрабатывает силовые модули SiC MOSFET с низким сопротивлением канала RDS(ON) для применения в приводе BEV. Базовую технологию можно масштабировать в пределах от 650–900 до 1200 В путем простой модификации эпитаксиальной дрейфовой зоны (блокирующий слой) и краевых областей. Топология при этом остается одинаковой для всех приборов в указанном диапазоне напряжения, что обеспечивает простоту интеграции в силовые модули.
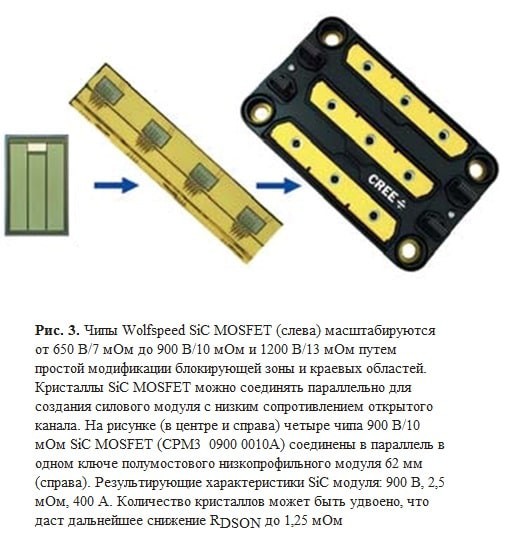
На рис. 3 иллюстрируется традиционный метод подключения проводников с помощью ультразвуковой сварки к верхней контактной поверхности на примере третьего поколения кристаллов SiC MOSFET. Эта технология может быть использована в модулях 650, 900 или 1200 В при небольшом изменении топологии чипов. Кристаллы 900 В с низким сопротивлением канала (10 мОм у CPM3-0900-0010A) уже доступны. Были использованы при разработке версии модулей 900 В, проверка статических и динамических потерь которых уже проведена. Специалисты компании Ford сравнили измеренные параметры полумостового модуля SiC 900 В с сопротивлением 2,5 мОм (четыре MOSFET-кристалла на ключ) с параметрами 700 В-инвертора на базе Si IGBT в двигателе мощностью 90 кВт и выявили среднее снижение потерь на 78% в стандартном приводном цикле EPA.
В последнее время большое внимание уделяется технологии спекания чипов SiC, позволяющей исключить использование сварных проводников при сборке. Одним из основных достоинств является увеличение так называемого прерывающегося срока службы (IOL), поскольку усталостные процессы в сварных соединениях проводников или соединениях кристаллов часто становятся причиной отказов. Другие потенциальные преимущества состоят в лучшем (двухстороннем) охлаждении, лучшем распределении тепла и более высокой стойкости к короткому замыканию. Пример Delphi демонстрирует использование пяти двухсторонних спеченных SiC MOSFET (650 В, 7 мОм) в параллель в одиночном ключе (1,7 мОм), как показано на рис. 4. Спекание кристаллов проводилось по верхней и нижней стороне с металлизацией Ni:Au.
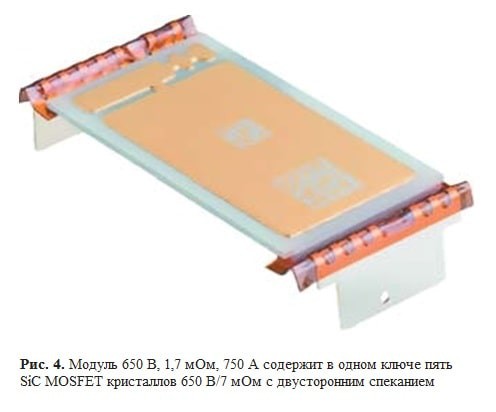
Характеристики модуля оказались впечатляющими: сопротивление RDS(ON) — 1,7 мОм, 750 A, 25 °C немного увеличивается до 2,3 мОм при +175 °C, как показано на рис. 5 (верхний сегмент). Также первый прототип модуля был испытан на термоциклирование путем подачи DC-тока 520 A в каждой фазе (сквозной ток), что дает целевой градиент температуры dTJ 100 K (изменение от +50 до +150 °C). Тестовый цикл продолжался 25 с (испытывалось шесть модулей, все три фазы под током) с перерывом в 10 сек.; прямое напряжение измерялось после 36 000 циклов. Ни на одном из модулей увеличение не превысило 5% за 36 000 циклов, как показано на рис. 5 (нижний сегмент). Параллельно с разработкой модулей 650 и 900 В ведется работа над 1200-В SiC MOSFET. У чипа площадью 32 мм2 сопротивление RDS(ON) составляет 13 мОм при комнатной температуре и 23 мОм при +175 °С.
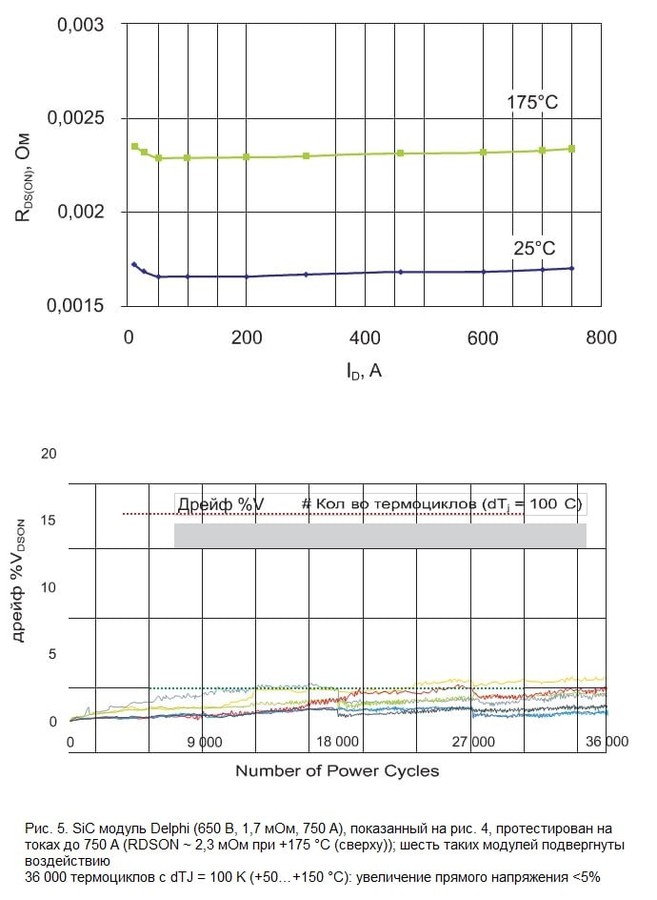
Заключение
Сочетание SiC-пластин большего диаметра (150–200 мм) с улучшенным качеством материалов и достижений технологии SiC MOSFET (понижение на 60% удельного сопротивления RDS(ON) при +150 °C для модулей 1200 В в те- чение 2011–17 гг.) позволило получить сверхнизкое (< 15 мОм) сопротивление в коммерческих карбидокремниевых ключах. Модули SiC MOSFET 900 В с RDS(ON) 10 мОм представлены на рынке с января 2017 года.
Совершенствование тяговых приводов BEV с использованием SiC-технологий, позволяющих снизить потери инвертора до ~78% в приводном цикле EPA, может предложить разработчикам систем BEV увеличение пробега или снижение цены батареи при заданном пробеге. Сегодня развитие SiC-технологий направлено на улучшение производительности и надежности карбидокремниевых транзисторов, что было продемонстрировано на примере чипов MOSFET 650 В, 7 мОм, использованных при производстве модулей с двусторонним спеканием с сопротивлением канала 1,7 мОм. Модули предназначены для применения в автомобильных приводных инверторах, которые уже показали очень хорошие характеристики термоциклирования и впечатляюще низкие потери проводимости.
- Авторы: Джефф Касади (Jeff Casady), Монти Б. Хейес (Monty B. Hayes).
- Перевод: Евгений Карташов, Валерия Смирнова.
Использованная литература
- Balkas E., et al. Status on WBG Materials. ECPE SiC & GaN User Forum. Nuremberg, Germany, Mar. 8–9, 2017.
- Palmour J. et al. SiC MOSFET and Power Module Status and Market Development. WIPDA, Fayetteville, AR (USA). Nov. 20, 2016.
- Casady J. et al. Advances in ultra-low RDSON SiC power MOSFETs. IWBGPEAW. Stockholm, Sweden, May 22–23, 2017. www.wolfspeed. com/media/dow nloads/959/C3M0075120K.
- Pala V. et al. Record-low 10mΩ SiC MOSFETs in TO-247, Rated at 900V. APEC, Long Beach, CA (USA), Mar. 20–24, 2016.
- Ming Su et al. Prospects for the Application of SiC Power Devices in Hybrid Electric Vehicle Drive Systems. WIPDA, Fayetteville, AR (USA), Nov. 20, 2016.
- Casady J. et al. First Automotive Reliability Assessment and Drive-Train Performance of Large-Area 900V, 10 mOhm SiC MOSFETs. APEC, Tampa, FL (USA), Mar 29, 2017.
- Casady J. et al. Ultra-low (1.25mΩ) On- Resistance 900V SiC 62 mm Half-Bridge Power Modules Using New 10 mΩ SiC MOSFETs. PCIM Europe. Nuremberg, Germany, May 10–12, 2016.
Источник:
Что выбрать: MOSFET или IGBT -инвертор?
Не нужно на 100% разбираться в премудростях электротехники, чтобы высказать мнение по теме. Заголовок «MOSFET или IGBT?» напоминает старое соревнование форматов: VHS или DVD? Кто же победит? И пусть скажут, сравнение не корректное. Но, DVD формат великолепный, качество звука и изображения замечательные, а мы все так привыкли к старому доброму VHS…
Для тех, кто не понимает о чем идет речь, поясним. На сегодняшний день существует две технологии изготовления сварочных инверторов,
- первая основана на базе полевых транзисторов с изолированным затвором (MOSFET) и пользуется успехом на правах «старого, работающего и проверенного варианта»
- вторая — на базе биполярных транзисторов с изолированным затвором (IGBT). Это инновационная технология, новое поколение и тому подобное.
Возникает закономерный вопрос: что же выбрать старое, проверенное временем, или относительно новое, но более технологичное?
Попробуем привести пару доводов и, как говорится, ближе к «телу»…
Что не говори, а IGBT занимают меньший объем и при этом позволяют получить более высокую силу тока на выходе, они меньше нагреваются. Разве это не аргумент в пользу IGBT? Возражения же заключаются в том, что схемы IGBT покамест не идеально продуманы и т.д., разработчикам не было времени на это и они звучат «натянуто».
Конечно, если покупать инвертор для бытовой сварки, то не так уж важно, какие у него транзисторы внутри. Вообще не важно, что внутри. Главное, чтобы электрод поджигался нормально, дуга не прыгала туда-сюда, чтобы электрод не залипал. Так же, желательно, чтобы инвертор работал при пониженном напряжении в сети, не боялся забросов напряжения, чтобы желтая лампа перегрева редко зажигалась.
Если речь идет о небольших объемах бытовых работ, то практически любой инвертор в этом станет вашим надежным другом и товарищем, та же Ресанта или Сварог, или Фубаг, или отечественный Форсаж и т.д. и т.п.
Но что, если нужен профессиональный аппарат, когда варить придется целый день. Наше мнение, здесь лучше IGBT. Почему? Возьмем для примера сварочный аппарат РICO 180— это же прелесть, а не сварочник! Приведем в качестве примера его систему охлаждения. Она интеллектуальная и включается только тогда, когда транзисторы нагреваются. А в РICO даже после 15 и более минут сварки на небольших токах вентилятор не шелохнется. Это значит, что схемы холодные, корпус аппарата холодный. И все это IGBT, они греются менее интенсивно, чем MOSFET и на более высоких токах. Ну и что мне с этого, скажете Вы? Очень просто. Чем меньше работает вентилятор, тем лучше! Особенно если Вы работаете в запыленных помещениях. Основной враг инвертора — это пыль. Она является основной причиной досрочного выхода инверторов из строя. Соответственно, чем меньше пыли затягивается в сварочный аппарат, тем лучше! А это значит, чем дольше не включаются кулеры, тем лучше! Получить это можно только с
Несомненный плюс так же состоит в том, что достигается высокая мощность при еще более малом весе. Каждый грамм играет роль, если приходится целый день носить инвертор на плече.
Минус в свое время был в дороговизне ремонта IGBT и невозможности подчас найти запчасти. Но время идет, техника совершенствуется, а то, что было раньше дорогим и недоступным, становится обыденным и легкозаменяемым! Так что наше мнение, будущее за новыми технологиями. А Вы как думаете? Стоит с этим согласиться?
Сегодня уже ни для кого не секрет кто выиграл в битве «VHS или DVD».
Linear MOSFETs — The virtual drink — LiveJournal

Одним из главных элементов в конструкции электронной нагрузки являются регулирующие транзисторы, которые будут выполнять основную работу – рассеивать потребляемую нагрузкой энергию в виде тепла. Транзисторы будут MOSFET. Почему именно такие? Потому что они не подвержены вторичному тепловому пробою, благодаря чему имеют более широкую область безопасной работы (ОБР), а также имеют отрицательный температурный коэффициент тока стока, что обеспечивает выравнивание токов через соединенные параллельно транзисторы. Это мы знаем с детства. Но всегда ли это так?
Самыми распространенными мощными MOSFET-транзисторами, пожалуй, являются транзисторы фирмы International Rectifier (IR) и их клоны, выпускаемые другими фирмами. Это транзисторы с так называемой вертикальной структурой и носящие фирменное наименование HEXFET. В дальнейшем здесь будут иметься в виду именно такие транзисторы, для упрощения называемые просто MOSFET.
В datasheet на MOSFET обычно приводят график зависимости сопротивления канала от температуры [1]. На нем мы видим (рис. 1), что сопротивление с ростом температуры увеличивается. Это соответствует сложившимся представлениям.

Рис. 1. Зависимость Rds(on) от температуры для IRF530A.
Однако для MOSFET свойственен и другой эффект – уменьшение порогового напряжения Vgs(th) при повышении температуры. Этот эффект будет конкурировать с эффектом увеличения Rds(on). К сожалению, в datasheet обычно не приводят график зависимости порогового напряжения от температуры. Некоторые производители (например, Supertex) указывают температурный коэффициент для Vgs(th) в таблице параметров. Его значение составляет порядка -2…-5 мВ/°C. В документе APT0002 [2] от фирмы Advanced Power Technology приведен график типичной зависимости Vgs(th) от температуры (рис. 2).

Рис. 2. Типичная зависимость Vgs(th) от температуры.
Совместное действие двух этих эффектов приводит к тому, что ток стока может как уменьшаться с ростом температуры, так и увеличиваться. Все зависит от того, какой эффект сильнее выражен, а это, в свою очередь, зависит от технологии производства транзистора. В datasheet на MOSFET часто приводится семейство передаточных характеристик, снятых при разной температуре кристалла. По этому семейству можно судить о поведении тока стока с ростом температуры. В качестве примера ниже приведено семейство передаточных характеристик для транзистора IRF530A [1] (рис. 3).

Рис. 3. Семейство передаточных характеристик транзистора IRF530A.
Как видим, все графики имеют общую точку пересечения ZTC, которая показана синим цветом. Для этого транзистора точка ZTC лежит в районе 12 А, что близко к максимально допустимому тока стока. Левее этой точки будет преобладать эффект уменьшения Vgs(th) с ростом температуры, поэтому ток стока будет с ростом температуры увеличиваться. В точке ZTC температурный коэффициент тока стока будет равен нулю, ток не будет зависеть от температуры. Правее этой точки ток стока будет падать с ростом температуры.
Из семейства передаточных характеристик можно получить только диапазон изменения тока для разных значений Vgs. Например, для Vgs = 4 В диапазон изменения Id выделен на рис. 3 красным отрезком. Сам график зависимости тока стока от температуры при фиксированном значении Vgs в datasheet тоже не приводятся. Такую зависимость для IRF530A я решил снять самостоятельно. Для этого установил транзистор IRF530A на небольшой радиатор, к которому прикрепил датчик температуры (рис. 4). Почему здесь фигурирует именно IRF530A? Да просто много таких транзисторов оказалось под рукой, результат для других похожих транзисторов будет близкий.

Рис. 4. Макет для снятия зависимости Id от температуры.
С помощью одного лабораторного БП задал фиксированное значение Vgs = 4 В, с помощью другого БП задал напряжение Vds. Это напряжение выбрал не слишком большим (тоже 4 В), чтобы ограничить выделяемую мощность. Иначе нагрев был бы слишком быстрым, температура датчика не успевала бы установиться. В результате ток стока получился меньше, чем на графиках из datasheet, которые снимались при Vds = 40 В. Но общей картины это не меняет. Получившийся график весьма близок к прямой линии (рис. 5). На опыте убедился, что ток стока MOSFET действительно увеличивается с ростом температуры, причем весьма заметно.

Рис. 5. График зависимости Id от температуры.
Для других значений Vgs поведение графика будет аналогичным. На основе семейства передаточных характеристик (рис. 3) можно построить семейство графиков зависимости Id от температуры для разных значений Vgs. Точка пересечения передаточных характеристик на рис. 3 – это точка нулевого температурного коэффициента (ZTC) тока стока. Левее этой точки графики зависимости Id от температуры будут иметь положительный наклон, правее – отрицательный. Для иллюстрации ниже приведено семейство графиков из AN-4161 фирмы Fairchild [3] (рис 6). Они не относятся к транзистору IRF530A, но имеют качественно такое же поведение. В области малых токов наклон у графиков положительный, по мере увеличения тока он уменьшается, пока не станет равным нулю. Это горизонтальный график, соответствующий точке ZTC. При дальнейшем увеличении тока наклон становится отрицательным. Наклон графиков кажется небольшим, это обусловлено тем, что по вертикальной оси выбран слишком большой масштаб тока, а графики для малых токов не показаны вовсе. На самом деле, в области малых токов наклон весьма большой, в полном температурном диапазоне ток стока может меняться в 10 раз и более.

Рис. 6. Семейство графиков зависимости Id от температуры.
Для современных мощных MOSFET точка перегиба ZTC лежит в области довольно высоких токов, это могут быть десятки ампер, а иногда эта точка лежит даже выше максимально допустимого тока стока. В линейном режиме на таких больших токах транзисторы используются редко, поэтому в основном работа происходит в области, где температурный коэффициент тока стока положительный. При этом никакого выравнивания тока для параллельно соединенных транзисторов происходить не будет. Для более нагретого транзистора ток стока будет выше. Для выравнивания тока, как и в случае биполярных транзисторов, требуются резисторы в цепях истоков. С учетом большого начального разброса пороговых напряжений, для эффективного выравнивания токов MOSFET требуются резисторы чуть ли не на порядок большего номинала, чем для биполярных транзисторов. Именно по этой причине рекомендуется для MOSFET использовать активное выравнивание токов, когда каждый транзистор управляется отдельным ОУ [2] (рис. 7).

Рис. 7. Выравнивание Id для параллельного соединения MOSFET.
Как один из примеров, если MOSFET используются в выходном каскаде УМЗЧ, работающего в режиме AB, то для термостабилизации тока покоя потребуется источник напряжения смещения с отрицательным температурным коэффициентом, как и для биполярных транзисторов [4]. Только значение этого коэффициента здесь менее определенное, что требует его практического подбора.
Данные выводы относятся исключительно к линейному режиму работы. Когда MOSFET работает в ключевом режиме, в открытом состоянии напряжение на затворе значительно превышает пороговое, поэтому эффект зависимости порогового напряжения от температуры не действует. Наблюдается только эффект увеличения сопротивления канала при повышении температуры, что будет вызывать уменьшение тока. В ключевом режиме, действительно, будет иметь место эффект выравнивания тока между несколькими соединенными параллельно транзисторами.
Раз у MOSFET есть участок, где зависимость тока стока от температуры имеет положительный наклон, в этих транзисторах может наблюдаться термическая неустойчивость. Внутри каждый MOSFET транзистор имеет множество ячеек, фактически, это отдельные транзисторы, которые соединены параллельно. Если с повышением температуры ток через ячейку будет расти, образуется термическая положительная обратная связь, и ток растет еще больше. Это может привести к перегреву отдельных ячеек (образованию «горячих точек»), что грозит выходом транзистора из строя. Такой эффект наблюдается в биполярных транзисторах и может приводить к вторичному тепловому пробою. Оказывается, очень похожие эффекты могут наблюдаться и в MOSFET.
Термическая неустойчивость возможна в случае, если при повышении температуры выделяемая мощность будет расти быстрей, чем рассеиваемая мощность:
dP(выделяемая)/dT > dP(рассеиваемая)/dT
Выделяемая мощность зависит от напряжения сток-исток и тока стока:
P(выделяемая) = Vds * Id
Рассеиваемая мощность зависит от разности температур и теплового сопротивления кристалл-окружающая среда Rth:
P(рассеиваемая) = (Tперехода – Tокр. среды)/Rth
Напряжение сток-исток – величина постоянная, а ток стока имеет зависимость от температуры. После преобразования формул получаем следующее неравенство:
dId/dT > 1/(Vds * Rth)
Если неравенство выполняется, транзистор становится термически неустойчивым. Видно, что неустойчивость возможна при большом значении dId/dT (при большом положительном наклоне зависимости тока стока от температуры). И чем выше напряжение сток-исток и тепловое сопротивление, тем нестабильность проявляется раньше.
Значение dId/dT в datasheet обычно не приводят. Но на основе семейства графиков зависимости Id от температуры можно построить график зависимости dId/dT от Id для какого-то заданного значения температуры. Обычно для определения ОБР берут максимально допустимую температуру кристалла. Ниже показаны графики зависимости dId/dT от Id для двух разных MOSFET [5] (рис. 8).

Рис. 8. Зависимость Id/dT от Id для двух разных MOSFET.
График зависимости dId/dT от Id имеет выраженный максимум, который находится в области относительно небольших токов. Дальше значение уменьшается, достигая нуля в точке ZTC, затем становится отрицательным. Для транзисторов разных типов максимум может иметь разную величину. Если dId/dT достигает такой величины, что выполняется приведенное выше неравенство, для транзистора будет иметь место термическая неустойчивость, называемая эффектом Спирито (Spirito effect). Механизм этого эффекта очень схож с явлением вторичного теплового пробоя для биполярных транзисторов. Зона термической неустойчивости будет находиться в области малых токов и высоких напряжений, что сделает ОБР для MOSFET более узкой, подобно ОБР биполярных транзисторов.
Явление вторичного теплового пробоя заметно ограничивает ОБР для биполярных транзисторов. Ниже в качестве примера показан график ОБР для биполярного транзистора TIP41C [7] (рис. 9), который имеет такой же корпус, как у IRF530A, и схожие максимальное напряжение и мощность. На графике красной линией показано ограничение, связанное с максимальной рассеиваемой мощностью. Видно, что в области высоких напряжений коллектор-эмиттер ОБР более узкая (розовая область) из-за явления вторичного теплового пробоя. Примерно такую же форму имеет ОБР для других биполярных транзисторов. Они все допускают значительно меньший ток коллектора в области высоких напряжений, чем это диктуется мощностью.

Рис. 9. ОБР биполярного транзистора TIP41C.
Если посмотреть на ОБР транзистора IRF530A [1] (рис. 10), можно заметить, что она ограничена лишь максимально допустимым током, напряжением и рассеиваемой мощностью. Для импульсных режимов (штриховые линии) ОБР еще больше расширяется во все стороны, кроме напряжения.

Рис. 10. ОБР MOSFET транзистора IRF530A.
Как видим, IRF530A – хороший транзистор, как и похожие на него IRF530, IRF540, IRFP150, IRFP250, IRFZ34, IRFZ44 и т.д. Все эти транзисторы относятся к 3-му поколению HEXFET, они устарели и в настоящее время не выпускаются. На смену им пришло 5-е поколение HEXFET, такие транзистры имеют дополнительный индекс «N». Можно сравнить некоторые параметры IRF530 и IRF530N [8]:
Параметр IRF530 IRF530N Максимальное напряжение сток-исток Vds, В: 100 100 Максимальный постоянный ток стока Id, А: 14 17 Сопротивление канала Rds(on), Ом: 0.16 0.09 Крутизна передаточной характеристики, См 5.1 12 Тепловое сопротивление кристалл-корпус, °C/Вт: 1.7 2.15 Рассеиваемая мощность, Вт: 88 70
Как видим, для работы транзистора в ключевом режиме параметры в основном улучшились. Немного меньшая рассеиваемая мощность компенсируется почти вдвое меньшим сопротивлением канала. Но повышенная крутизна и низкое значение Rds(on) наверняка приведут к увеличению dId/dT. Увеличение плотности ячеек на кристалле и уменьшение размеров самого кристалла [9] стали причиной увеличения теплового сопротивления. Все эти факторы будут негативно сказываться при использовании транзистора в линейном режиме. Если посмотреть на график ОБР транзистора IRF530N (рис. 11), то можно заметить, что ОБР несколько сузилась.

Рис. 11. ОБР MOSFET транзистора IRF530N.
К тому же, исчез график для режима работы на постоянном токе. Причем такого графика нет и для многих других современных MOSFET. Может показаться, что этот график не приводится из-за своей тривиальности – достаточно построить область, ограниченную Id(max), Vds(max) и P(max). Но это не так. Для IRF530N видим, что даже график для импульсного режима работы с длительностью импульса 10 мс проходит ниже, чем ожидаемый график для DC. Причем в области высоких напряжений виден характерный загиб, связанный с эффектом Спирито. Хотя надо отметить, что этот эффект здесь проявляется весьма слабо, транзисторы HEXFET 5-го поколения вполне пригодны для линейного режима работы.
Если посмотреть ОБР для более современного MOSFET с большой крутизной и низким Rds(on), то эффект Спирито будет выражен более явно [10] (рис. 12). Например, для IRL3713 даже было выпущено обновление datasheet с таким примечанием: «Updated Fig8-SOA curve with Spirito effect on page 4».

Рис. 12. ОБР MOSFET транзистора IRL3713.
Чтобы обойти ограничения, связанные с ОБР, напрашивается очевидное решение – взять транзистор с большим запасом по току. Благо, сейчас доступны транзисторы просто с фантастическими параметрами. Например, вместо IRF530N можно взять IRFB4321, для которого Vds(max) = 150 В и Id(max) = 85 А. Транзистор выглядит совершенно неубиваемым. Но что мы видим на ОБР [11] (рис. 13)? Например, при напряжении сток-исток 40 В этот транзистор допускает ток стока всего 200 мА, в то время как более старый и маломощный IRF530 допускает ток больше 1 А!

Рис. 13. ОБР MOSFET транзистора IRFB4321.
Эффект Спирито в какой-то мере наблюдается у всех MOSFET, но для транзисторов старых поколений с планарной структурой он практически незаметен. А вот в современных транзисторах с V-образной канавкой затвора (Trench-MOSFET) данный эффект выражен очень сильно. Такие транзисторы имеют высокую крутизну, малое значение Rds(on) и высокое значение dId/dT. В результате ОБР для таких транзисторов намного более узкая, чем этого можно ожидать.
Долговременная работа вблизи границ ОБР на практике трудно реализуема, так как очень сложно удержать температуру корпуса 25°C для транзистора, рассеивающего максимальную мощность. Именно для таких условий приводится график ОБР – температура кристалла равна максимальной (обычно 175°C), а температура корпуса при этом равна 25°C. На практике следует ограничивать мощность рассеяния не значением из datasheet, а возможностями охлаждения. Но для повреждения прибора достаточно даже кратковременного выхода за пределы ОБР. Об этом говорят и графики ОБР для импульсных режимов. Характерный загиб, связанный с эффектом Спирито, присутствует и на них. Результат действия эффекта термической неустойчивость показан ниже, это фото кристалла современного Trench-MOSFET, разрушенного постоянным током при напряжении сток-исток порядка 50 В [6] (рис. 14).

Рис. 14. Разрушенный кристалл Trench-MOSFET.
С определением актуального графика ОБР не все обстоит так просто даже для самих производителей. В Application Note AN-1155 [12] от International Rectifier приводится методика определения ОБР для радиационно-стойких MOSFET. Оказывается, эффект Спирито дает слишком консервативную ОБР, не подтверждающуюся при испытаниях реальных образцов. Поэтому в datasheet попадают графики, построенные с учетом не только теории, но и результатов испытаний. Фирма International Rectifier поместила на сайте обновления для ОБР своих транзисторов [13]. На этих ОБР добавлены графики для режима DC, чего в обычных datasheet нет. Причем эти графики ведут себя достаточно нетривиально. Жаль, что там нет графиков для распространенных MOSFET, по поводу их ОБР для постоянного тока остается только догадываться.
Совершенствуя MOSFET-транзистры, производители заботятся в основном о ключевом режиме. Далеко не все новые транзисторы подходят для линейного режима работы. Какой из этого можно сделать вывод – не использовать в линейных схемах MOSFET? Или начинать искать на свалках MOSFET старых поколений? Но не так все страшно, выпускается множество MOSFET, которые прекрасно подходят для линейного режима работы. Хотя при этом надо учитывать некоторые ограничения, связанные с линейным режимом [17 – 23]. Как узнать в лицо транзистор, который подходит для линейного режима? Прежде всего, по ОБР. Но можно косвенно судить и по другим параметрам. Например, крутизна 130 См для IRFB4321 против 12 См для IRF530N должна настораживать. Есть мнение, что чем большее значение Rds(on) имеет транзистор, тем лучше он подходит для работы в линейном режиме. В этом что-то есть, высоковольтные транзисторы с высоким Rds(on) имеют самую широкую ОБР. Вообще говоря, для линейного режима подходит любой MOSFET, если не нарушать его ОБР. Вот только по максимальному току и напряжению насчет ОБР сказать ничего нельзя.
Некоторые фирмы выпускают специальные модели MOSFET транзисторов, предназначенные специально для работы в линейном режиме. Например, APL602 фирмы Advanced Power Technology [14] (рис. 15) или IXTP15N50L2 фирмы Ixys [15]. Они обладают довольно высоким Rds(on), но особых отличий, скажем, от HEXFET 5-го поколения у них нет.

Рис. 15. Linear MOSFET APL602.
Еще выпускаются MOSFET транзисторы с горизонтальной структурой (lateral MOSFET) [16]. Их отличительная черта – подложка кристалла является истоком, поэтому его вывод находится посередине корпуса. У таких транзисторов точка нулевого температурного коэффициента тока стока лежит очень низко (около 100 мА), поэтому практически во всем диапазоне рабочих токов такие транзисторы обладают термической стабильностью. Но это редкие и дорогие приборы, предназначенные в основном для аудио.
По поводу линейного режима работы MOSFET хочется сделать еще одно замечание. Не следует в линейный мир перетаскивать из импульсного мощные драйверы затворов. Если транзистор работает в ключевом источнике с частотой 100 кГц, то пиковый ток затвора вполне может достигать нескольких ампер. Это является нормальным и даже необходимым для получения высокого КПД. Но если мощный MOSFET работает в линейном режиме в качестве усилителя синусоидального сигнала с частотой 100 кГц, то типичный пиковый ток затвора не будет превышать единиц миллиампер. Особенно, если транзистор используется как истоковый повторитель. С таким током справится обычный ОУ без всяких дополнительных каскадов. Единственное, что надо учесть, это емкостной характер нагрузки, но для этого есть известные схемотехнические приемы. Отдельная ситуация – высоколинейные усилители для аудио. Поскольку входная емкость MOSFET обладает большой нелинейностью, требуется мощный драйвер затворов, иначе коэффициент гармоник может оказаться слишком высоким.
Возвращаясь к электронной нагрузке, можно еще раз взглянуть на прототип – Agilent 6060. Там применяются транзисторы IRF540 (без буквы «N»), ток выравнивается с помощью индивидуальных ОУ для каждого MOSFET, затворами управляют обычные ОУ вез всяких мощных драйверов.
Литература:
1. IRF530A datasheet
2. Advanced Power Technology Inc. – New 500V Linear MOSFETs for a 120 kW Active Load
3. Fairchild – AN-4161 Practical Considerations of Trench MOSFET Stability when Operating in Linear Mode
4. Mitch Hodges – Using HEXFETs in High Fidelity Audio
5. Breglio, G.; Frisina, F.; Magri, A. and Spirito, P. – Electro-Thermal Instability in Low Voltage Power MOS: Experimental Characterization, IEEE ISPSD 1999, p. 233.
6. Jeffrey A. Ely – Are Trench FETs Too Fragile for Linear Applications? Power Electronics Technology, January 2004
7. TIP41C datasheet
8. IRF530N datasheet
9. International Rectifier Design Tips DT95-2 – IR’s new fifth generation power MOSFETs
10. IRL3713 datasheet
11. IRFB4321 datasheet
12. Application Note AN-1155 – Linear Mode Operation of Radiation Hardened MOSFETs
13. International Rectifier SOA Update
14. APL602 datasheet
15. IXTP15N50L2 datasheet
16. Semelab – Lateral MOSFET design recommendations for audio amplifiers
17. Jonathan Dodge – How to Make Linear Mode Work
18. ON Semiconductor AND8199/D – Thermal Stability of MOSFETs
19. Infineon Application Note – Automotive MOSFETs in Linear Applications: Thermal Instability
20. Carl Blake – Evaluating the Reliability of Power MOSFETs
21. STM Technical note TN1156 – Irradiated HV Power MOSFETs working in linear zone
22. Renesas – Using Trench Power MOSFETs in Linear Mode
23. Infineon Application Note – Linear Mode Operation and Safe Operating Diagram of Power –MOSFETs
— Infineon Technologies
Хорошо продуманный выбор полевого МОП-транзистора определяет общую производительность. Благодаря своей простоте и надежности революционная технология Infineon является лучшим выбором, поскольку она обеспечивает улучшенные форм-факторы и способствует общему снижению стоимости системы. Еще один положительный побочный эффект — общее снижение потребления энергии. Это помогает минимизировать выбросы CO 2 и, следовательно, снижает затраты, а также выгодно для конечного потребителя.MOSFET-транзистор CoolMOS ™ от Infineon предлагает обширные возможности для бытовых, промышленных и автомобильных приложений, таких как освещение, телевидение, аудио, серверы / телекоммуникации, солнечная энергия, зарядка электромобилей, преобразователь постоянного тока в постоянный, бортовые зарядные устройства и многое другое.
ПриложенияDC-DC можно классифицировать по их потребности в чрезвычайно быстром переключении с низкими потерями или более надежном переключении на умеренных частотах.
Разработчики извлекают выгоду из сверхнизких коммутационных потерь технологии силовых полевых МОП-транзисторов Infineon OptiMOS ™ в источниках питания с частотой выше 100 кГц.Низковольтный полевой МОП-транзистор OptiMOS ™ от Infineon предлагает высокую эффективность и новые возможности в приложениях с жестким переключением. Это помогает разработчикам систем увеличить удельную мощность и снизить затраты при высочайшем уровне надежности.
В приложениях, где требуется высокая лавинная защита, например, в управлении двигателем, разработчики извлекают выгоду из высоконадежного силового MOSFET StrongIRFET ™. Полевые МОП-транзисторы могут обеспечить высочайшую энергоэффективность для таких конечных приложений, как силовые и садовые инструменты, легкие электромобили, дроны и электронные велосипеды, которые требуют высокого уровня энергоэффективности, но ограничены в доступном пространстве.Инновационные полевые МОП-транзисторы
Infineon обеспечивают отличные характеристики и дополнительно снижают затраты. Эти устройства — лучший выбор для высокопроизводительных преобразователей постоянного тока в постоянный.
Конструкции, требующие высочайшего качества и улучшенных функций защиты, выигрывают от сертифицированных для автомобилей Infineon n-канальных и p-канальных МОП-транзисторов, которые выходят за рамки отраслевых стандартов AEC-Q101, обеспечивая самые надежные МОП-транзисторы в отрасли.
Infineon предлагает полный спектр n-канальных и p-канальных силовых полевых МОП-транзисторов и систем, обеспечивающих инновации и производительность в ваших приложениях, включая импульсные источники питания (SMPS), вычисления, управление двигателями и приводы, потребительские, мобильные устройства, световые решения, автомобильную и Больше.
,МОП-транзистор
Скачать СоглашениеВАЖНО — ПРОЧИТАЙТЕ ПЕРЕД ЗАГРУЗКОЙ, КОПИРОВАНИЕМ, УСТАНОВКОЙ ИЛИ ИСПОЛЬЗОВАНИЕМ.
ЗАПРЕЩАЕТСЯ ЗАГРУЗИТЬ, КОПИРОВАТЬ, УСТАНОВИТЬ ИЛИ ИСПОЛЬЗОВАТЬ ДАННЫЙ КОНТЕНТ ДО тех пор, пока ВЫ ( «ЛИЦЕНЗИАТ») ВНИМАТЕЛЬНО ПРОЧИТАЙТЕ СЛЕДУЮЩИЕ УСЛОВИЯ. ПО ЗАГРУЗКА, КОПИРОВАНИЕ, УСТАНОВКУ ИЛИ ИСПОЛЬЗОВАНИЕ СОДЕРЖИМОГО, ВЫ СОГЛАШАЕТЕСЬ С УСЛОВИЯ НАСТОЯЩЕГО СОГЛАШЕНИЯ. ЕСЛИ ВЫ НЕ ХОТИТЕ СОГЛАСИТЬСЯ, НЕ СКАЧАТЬ, КОПИРОВАТЬ, УСТАНОВИТЬ ИЛИ ИСПОЛЬЗОВАТЬ КОНТЕНТ.
Если вы соглашаетесь с настоящим Соглашением от имени компании, вы заявляете и гарантируете, что имеете право связывать такую компанию с настоящим Соглашением, и ваше согласие с этими условиями будет рассматриваться как соглашение такой компании.В этом случае «Лицензиат» в данном документе относится к такой компании. Настоящее Соглашение представляет собой юридический договор между Лицензиатом и компанией Semiconductor Components Industries, LLC, компанией с ограниченной ответственностью штата Делавэр (d / b / a ON Semiconductor), основным местом деятельности которой является 5005 E. McDowell Road, Phoenix, Arizona 85008, USA, ( «ON SEMICONDUCTOR») и его аффилированные и дочерние компании («ON Semiconductor»).
1. Доставка контента. Лицензиат соглашается с тем, что он получил копию Контента, включая Программное обеспечение (т.е. удобочитаемый и редактируемый код («исходный код»), исполняемый код («объектный код»), таблицы данных, спецификации, схемы, примечания к приложениям, инструменты проектирования и разработки, материалы оценочной платы (например, спецификация, гербер, руководство пользователя, схемы, процедуры тестирования и т. д.), проектные модели, эталонные проекты, справочные руководства и другие связанные материалы (совместно именуемые «Контент») с целью предоставления Лицензиату возможности использовать Контент, а затем включить функциональность такого Контента только для использования с ON Semiconductor Products.Лицензиат соглашается с тем, что поставка любого Программного обеспечения не является продажей, и Программное обеспечение предоставляется только по лицензии.
2. Лицензия.
2,1 Предоставление лицензии.
a) ON Semiconductor настоящим предоставляет Лицензиату полностью оплаченную, бесплатную, неисключительную, непередаваемую и не подлежащую сублицензированию лицензию на изменение Программного обеспечения, если это необходимо для включения продуктов Лицензиата («Продукты Лицензиата»), использующих Программное обеспечение. для работы или взаимодействия только с продуктами, проданными Лицензиату компанией ON Semiconductor или от ее имени («Продукты ON Semiconductor»).
b) Кроме того, ON Semiconductor настоящим предоставляет Лицензиату полностью оплаченную, бесплатную, неисключительную, непередаваемую лицензию на: (i) использование Содержимого, в том числе измененного Лицензиатом, с Продуктами Лицензиата исключительно для цель предоставления таким Продуктам Лицензиата возможности работать или взаимодействовать только с продуктами ON Semiconductor; (ii) копировать Контент по мере необходимости для такого использования; и (iii) распространять только Программное обеспечение и модифицированное Программное обеспечение в формате, который может быть исполнен машиной, а не читаемым человеком, третьим сторонним конечным пользователям Лицензиата («Клиент (ы)») для использования такими Клиентами строго совместно с Продуктами Лицензиата и исключительно для того, чтобы позволить таким Продуктам Лицензиата работать или взаимодействовать с Продуктами ON Semiconductor.

