Маркировка полевых SMD — транзисторов | SMD — поверхностный монтаж
Маркировка полевых SMD — транзисторов | SMD — поверхностный монтаж | Компоненты |Справочник| Маркировка SMD — диодов |
| Маркировка SMD — конденсаторов |
| Маркировка SMD — резисторов |
| SMD — транзисторы |
| Приборы, маркировка которых начинается с символа: | |||||||||
| Цоколевка SMD — компонентов: | ||||
МОП — транзисторы
|
| Резисторы | Конденсаторы | Индуктивности | Динамики | Разъемы | Кабели |
| Диоды | Стабилитроны | Варикапы | Тиристоры | Транзисторы | Оптроны |
| Микросхемы | SMD | ||||
Транзисторы с каналом N SMD
Channel kind
depleted enhanced
Transistor kind
dual gate FETKY, HEXFET HEXFET
Вид упаковки
бобина бобина, лента
Время включения
13. 7нс
17нс
21.5нс
8.8нс
7нс
17нс
21.5нс
8.8нс
Время выключения
15нс 20нс 51.2нс
Выход
N-MOSFET
Выходной ток
4.4А 59А 850мА
Заряд затвора
1.3нC
10.4нC
10.5нC
100нC
106.7нC
107нC
108нC
10нC
11.5нC
11.9нC
110нC
11нC
12.2нC
12.7нC
12.8нC
120нC
12нC
13.2нC
13.3нC
13.6нC
130нC
133.3нC
13нC
14.5нC
142нC
143нC
14нC
15.6нC
150нC
15нC
16.7нC
160нC
16нC
17.3нC
17.4нC
170нC
17нC
180нC
186нC
18нC
19.3нC
19.7нC
190нC
19нC
2.3нC
2.4нC
2.
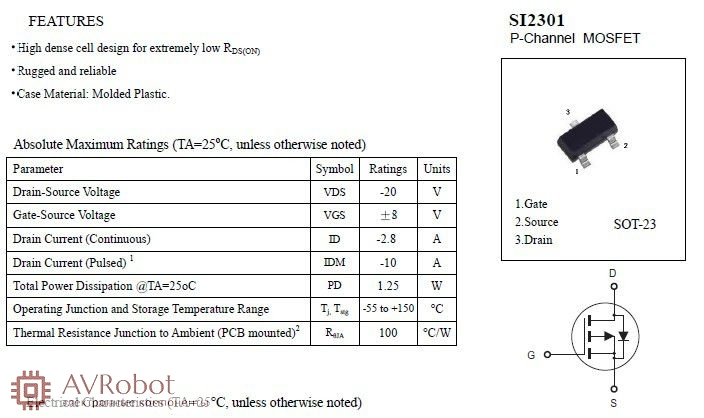
Корпус
CanPAK™ M, MG-WDSON-2
CanPAK™ MN, MG-WDSON-2
CanPAK™ MX, MG-WDSON-2
CanPAK™ MZ, MG-WDSON-2
CanPAK™ S, MG-WDSON-2
CanPAK™ SJ, MG-WDSON-2
CanPAK™ SQ, MG-WDSON-2
D2PAK
D2PAK-7
DE475
DFN4
DFN8
DirectFET
DPAK
DPAK, PG-TO252-3
Micro8
PG-DSO-8
PG-HSOF-8-1
PG-TDSON-8
PG-TDSON-8 FL
PG-TISON-8
PG-TISON-8-4
PG-TO252
PG-TO252-3
PG-TO263
PG-TO263-3
PG-TO263-7
PG-TSDSON-8
PG-VSON-4
PMPAK3x3
PMPAK5x6
PowerFLAT™(5×5)
PQFN
PQFN2X2
PQFN3.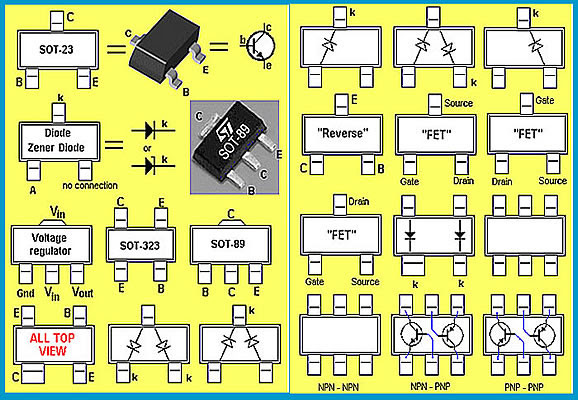
Монтаж
SMD THT
Мощность
 5Вт
12.8Вт
120Вт
125Вт
128Вт
12Вт
13.5Вт
13.9Вт
130Вт
135Вт
136Вт
1378мВт
138Вт
139Вт
13Вт
140Вт
143Вт
144Вт
14Вт
15.5Вт
15.6Вт
150Вт
151Вт
156Вт
15Вт
160Вт
163Вт
167Вт
169Вт
16Вт
170Вт
171Вт
17Вт
18.5Вт
180Вт
188Вт
18Вт
190Вт
195.3Вт
195Вт
1Вт
2.1Вт
2.3Вт
2.5Вт
2.6Вт
2.7Вт
2.8Вт
200Вт
200мВт
208.3Вт
208Вт
20Вт
210Вт
214Вт
21Вт
220Вт
225мВт
227Вт
22Вт
230Вт
230мВт
231Вт
245Вт
250Вт
250мВт
25Вт
26.
5Вт
12.8Вт
120Вт
125Вт
128Вт
12Вт
13.5Вт
13.9Вт
130Вт
135Вт
136Вт
1378мВт
138Вт
139Вт
13Вт
140Вт
143Вт
144Вт
14Вт
15.5Вт
15.6Вт
150Вт
151Вт
156Вт
15Вт
160Вт
163Вт
167Вт
169Вт
16Вт
170Вт
171Вт
17Вт
18.5Вт
180Вт
188Вт
18Вт
190Вт
195.3Вт
195Вт
1Вт
2.1Вт
2.3Вт
2.5Вт
2.6Вт
2.7Вт
2.8Вт
200Вт
200мВт
208.3Вт
208Вт
20Вт
210Вт
214Вт
21Вт
220Вт
225мВт
227Вт
22Вт
230Вт
230мВт
231Вт
245Вт
250Вт
250мВт
25Вт
26. 6Вт
260Вт
260мВт
26Вт
27.8Вт
272Вт
277.8Вт
278Вт
27Вт
28.4Вт
280мВт
28Вт
29.7Вт
290Вт
290мВт
294Вт
29Вт
2Вт
3.1Вт
3.2Вт
3.3Вт
3.4Вт
3.57Вт
3.5Вт
3.6Вт
3.7Вт
3.8Вт
300Вт
300мВт
307Вт
30Вт
31.25Вт
310Вт
31Вт
320Вт
325мВт
32Вт
33.3Вт
33.8Вт
330Вт
33Вт
34.7Вт
34Вт
350Вт
350мВт
357Вт
35Вт
36.7Вт
360мВт
36Вт
370Вт
375Вт
37Вт
380Вт
38Вт
39Вт
3Вт
4.2Вт
4.5Вт
400мВт
40Вт
41Вт
42Вт
43Вт
44.
6Вт
260Вт
260мВт
26Вт
27.8Вт
272Вт
277.8Вт
278Вт
27Вт
28.4Вт
280мВт
28Вт
29.7Вт
290Вт
290мВт
294Вт
29Вт
2Вт
3.1Вт
3.2Вт
3.3Вт
3.4Вт
3.57Вт
3.5Вт
3.6Вт
3.7Вт
3.8Вт
300Вт
300мВт
307Вт
30Вт
31.25Вт
310Вт
31Вт
320Вт
325мВт
32Вт
33.3Вт
33.8Вт
330Вт
33Вт
34.7Вт
34Вт
350Вт
350мВт
357Вт
35Вт
36.7Вт
360мВт
36Вт
370Вт
375Вт
37Вт
380Вт
38Вт
39Вт
3Вт
4.2Вт
4.5Вт
400мВт
40Вт
41Вт
42Вт
43Вт
44. 6Вт
44Вт
45Вт
460мВт
46Вт
47Вт
48Вт
490мВт
500мВт
50Вт
50мВт
52Вт
53.6Вт
530мВт
53Вт
540мВт
54Вт
55Вт
56.8Вт
56Вт
57Вт
59Вт
5Вт
6.25Вт
60Вт
62.5Вт
625мВт
63Вт
65Вт
66Вт
67Вт
68Вт
69Вт
6Вт
7.5Вт
700мВт
70Вт
71Вт
72Вт
73Вт
740мВт
74Вт
75Вт
78Вт
79Вт
7Вт
8.3Вт
800мВт
80Вт
82Вт
83.3Вт
830мВт
83Вт
86Вт
87Вт
88Вт
89.2Вт
89Вт
8Вт
9.5Вт
9.6Вт
90Вт
91Вт
92Вт
94Вт
95Вт
96Вт
98Вт
99Вт
9Вт
6Вт
44Вт
45Вт
460мВт
46Вт
47Вт
48Вт
490мВт
500мВт
50Вт
50мВт
52Вт
53.6Вт
530мВт
53Вт
540мВт
54Вт
55Вт
56.8Вт
56Вт
57Вт
59Вт
5Вт
6.25Вт
60Вт
62.5Вт
625мВт
63Вт
65Вт
66Вт
67Вт
68Вт
69Вт
6Вт
7.5Вт
700мВт
70Вт
71Вт
72Вт
73Вт
740мВт
74Вт
75Вт
78Вт
79Вт
7Вт
8.3Вт
800мВт
80Вт
82Вт
83.3Вт
830мВт
83Вт
86Вт
87Вт
88Вт
89.2Вт
89Вт
8Вт
9.5Вт
9.6Вт
90Вт
91Вт
92Вт
94Вт
95Вт
96Вт
98Вт
99Вт
9ВтНапряжение затвор-исток
-2. 1В
-3.5В
-3В
1.6В
12В
16В
1В
2.4В
2.5В
20В
2В
30В
4В
800мВ
±12В
±16В
±20В
±25В
±30В
±6В
±8В
1В
-3.5В
-3В
1.6В
12В
16В
1В
2.4В
2.5В
20В
2В
30В
4В
800мВ
±12В
±16В
±20В
±25В
±30В
±6В
±8В
Напряжение коллектор-эмиттер
1.2кВ
Напряжение сток-исток
-55В 1.7кВ 100В 10В 120В 12В 150В 18В 190В 1кВ 200В 20В 240В 24В 250В 25В 300В 30В 34В 350В 35В 400В 40В 42В 450В 500В 50В 55В 560В 600В 60В 650В 65В 700В 70В 75В 7В 800В 80В 8В 900В 90В
Номинальный ток
330мА
Полярность
полевой
Принципиальная схема
посмотрите
Серия
C3M™ Z-FET™
Сопротивление в открытом состоянии
0. 0011Ом
0.00159Ом
0.0017Ом
0.0028Ом
0.0041Ом
0.0046Ом
0.005Ом
0.0065Ом
0.006Ом
0.0075Ом
0.0081Ом
0.0085Ом
0.009Ом
0.0105Ом
0.011Ом
0.012Ом
0.0135Ом
0.013Ом
0.0145Ом
0.014Ом
0.0155Ом
0.015Ом
0.0165Ом
0.018Ом
0.01Ом
0.021Ом
0.022Ом
0.024Ом
0.025Ом
0.028Ом
0.02Ом
0.031Ом
0.032Ом
0.034Ом
0.035Ом
0.036Ом
0.03Ом
0.041Ом
0.042Ом
0.045Ом
0.04Ом
0.054Ом
0.05Ом
0.075Ом
0.082Ом
0.085Ом
0.08Ом
0.093Ом
0.095Ом
0.09Ом
0.117Ом
0.11Ом
0.12Ом
0.15Ом
0.18Ом
0.19Ом
0.
0011Ом
0.00159Ом
0.0017Ом
0.0028Ом
0.0041Ом
0.0046Ом
0.005Ом
0.0065Ом
0.006Ом
0.0075Ом
0.0081Ом
0.0085Ом
0.009Ом
0.0105Ом
0.011Ом
0.012Ом
0.0135Ом
0.013Ом
0.0145Ом
0.014Ом
0.0155Ом
0.015Ом
0.0165Ом
0.018Ом
0.01Ом
0.021Ом
0.022Ом
0.024Ом
0.025Ом
0.028Ом
0.02Ом
0.031Ом
0.032Ом
0.034Ом
0.035Ом
0.036Ом
0.03Ом
0.041Ом
0.042Ом
0.045Ом
0.04Ом
0.054Ом
0.05Ом
0.075Ом
0.082Ом
0.085Ом
0.08Ом
0.093Ом
0.095Ом
0.09Ом
0.117Ом
0.11Ом
0.12Ом
0.15Ом
0.18Ом
0.19Ом
0. 1Ом
0.23Ом
0.24Ом
0.25Ом
0.26Ом
0.27Ом
0.28Ом
0.2Ом
0.35Ом
0.3Ом
0.4мОм
0.4Ом
0.56Ом
0.65Ом
0.7мОм
0.7Ом
0.8мОм
0.8Ом
0.95мОм
0.95Ом
0.97мОм
0.9мОм
1.05мОм
1.1мОм
1.25мОм
1.2мОм
1.2Ом
1.3мОм
1.3Ом
1.45мОм
1.4мОм
1.4Ом
1.59мОм
1.5мОм
1.5Ом
1.65мОм
1.6мОм
1.6Ом
1.75мОм
1.76Ом
1.7мОм
1.85мОм
1.8мОм
1.8Ом
1.95мОм
1.9мОм
10.4мОм
10.5мОм
10.7мОм
10.8мОм
10.9мОм
1000мОм
100мОм
104мОм
105мОм
10мОм
10Ом
11.5мОм
11.7мОм
11.
1Ом
0.23Ом
0.24Ом
0.25Ом
0.26Ом
0.27Ом
0.28Ом
0.2Ом
0.35Ом
0.3Ом
0.4мОм
0.4Ом
0.56Ом
0.65Ом
0.7мОм
0.7Ом
0.8мОм
0.8Ом
0.95мОм
0.95Ом
0.97мОм
0.9мОм
1.05мОм
1.1мОм
1.25мОм
1.2мОм
1.2Ом
1.3мОм
1.3Ом
1.45мОм
1.4мОм
1.4Ом
1.59мОм
1.5мОм
1.5Ом
1.65мОм
1.6мОм
1.6Ом
1.75мОм
1.76Ом
1.7мОм
1.85мОм
1.8мОм
1.8Ом
1.95мОм
1.9мОм
10.4мОм
10.5мОм
10.7мОм
10.8мОм
10.9мОм
1000мОм
100мОм
104мОм
105мОм
10мОм
10Ом
11.5мОм
11.7мОм
11. 8мОм
11.9мОм
110мОм
115мОм
117мОм
11мОм
12.1мОм
12.3мОм
12.4мОм
12.6мОм
120мОм
125мОм
12мОм
12Ом
13.4мОм
13.5мОм
13.8мОм
13.9мОм
130мОм
13мОм
13Ом
14.3мОм
14.4мОм
14.5мОм
140мОм
145мОм
14мОм
14Ом
15.5мОм
15.8мОм
150мОм
15мОм
15Ом
16.5мОм
160мОм
165мОм
16мОм
16Ом
17.5мОм
17мОм
18.9мОм
180мОм
185мОм
18мОм
19.6мОм
190мОм
195мОм
199мОм
19мОм
1кОм
1мОм
1Ом
2.1мОм
2.2мОм
2.3мОм
2.4мОм
2.5мОм
2.5Ом
2.6мОм
2.7мОм
2.
8мОм
11.9мОм
110мОм
115мОм
117мОм
11мОм
12.1мОм
12.3мОм
12.4мОм
12.6мОм
120мОм
125мОм
12мОм
12Ом
13.4мОм
13.5мОм
13.8мОм
13.9мОм
130мОм
13мОм
13Ом
14.3мОм
14.4мОм
14.5мОм
140мОм
145мОм
14мОм
14Ом
15.5мОм
15.8мОм
150мОм
15мОм
15Ом
16.5мОм
160мОм
165мОм
16мОм
16Ом
17.5мОм
17мОм
18.9мОм
180мОм
185мОм
18мОм
19.6мОм
190мОм
195мОм
199мОм
19мОм
1кОм
1мОм
1Ом
2.1мОм
2.2мОм
2.3мОм
2.4мОм
2.5мОм
2.5Ом
2.6мОм
2.7мОм
2. 7Ом
2.8мОм
2.8Ом
2.9мОм
200мОм
20мОм
20Ом
210мОм
21мОм
225мОм
22мОм
230мОм
235мОм
23мОм
24.5мОм
24мОм
25.2мОм
250мОм
25мОм
25Ом
26.5мОм
26мОм
27мОм
28.5мОм
280мОм
28мОм
290мОм
299мОм
29мОм
2мОм
2Ом
3.1мОм
3.2мОм
3.2Ом
3.3мОм
3.4мОм
3.5мОм
3.5Ом
3.6мОм
3.7мОм
3.8мОм
3.9мОм
300мОм
30мОм
30Ом
310мОм
31мОм
32мОм
330мОм
33мОм
340мОм
34мОм
35мОм
35Ом
36.3мОм
360мОм
36мОм
37мОм
380мОм
399мОм
39мОм
3мОм
3Ом
4.
7Ом
2.8мОм
2.8Ом
2.9мОм
200мОм
20мОм
20Ом
210мОм
21мОм
225мОм
22мОм
230мОм
235мОм
23мОм
24.5мОм
24мОм
25.2мОм
250мОм
25мОм
25Ом
26.5мОм
26мОм
27мОм
28.5мОм
280мОм
28мОм
290мОм
299мОм
29мОм
2мОм
2Ом
3.1мОм
3.2мОм
3.2Ом
3.3мОм
3.4мОм
3.5мОм
3.5Ом
3.6мОм
3.7мОм
3.8мОм
3.9мОм
300мОм
30мОм
30Ом
310мОм
31мОм
32мОм
330мОм
33мОм
340мОм
34мОм
35мОм
35Ом
36.3мОм
360мОм
36мОм
37мОм
380мОм
399мОм
39мОм
3мОм
3Ом
4. 1мОм
4.2мОм
4.3мОм
4.4мОм
4.5мОм
4.6мОм
4.7мОм
4.8мОм
4.9мОм
40.7мОм
400мОм
40мОм
420мОм
425мОм
42мОм
42Ом
43мОм
44мОм
450мОм
45мОм
45Ом
460мОм
46мОм
48мОм
4мОм
4Ом
5.1мОм
5.1Ом
5.2мОм
5.3мОм
5.4мОм
5.5мОм
5.6мОм
5.7мОм
5.8мОм
5.9мОм
500мОм
500Ом
50мОм
520мОм
52мОм
53мОм
54мОм
550мкОм
55мОм
560мОм
57.5мОм
5мОм
5Ом
6.1мОм
6.2мОм
6.3мОм
6.5мОм
6.6мОм
6.7мОм
6.8мОм
6.9мОм
600мОм
60мОм
60Ом
62мОм
63мОм
650мОм
65мОм
660мОм
66мОм
6мОм
6Ом
7.
1мОм
4.2мОм
4.3мОм
4.4мОм
4.5мОм
4.6мОм
4.7мОм
4.8мОм
4.9мОм
40.7мОм
400мОм
40мОм
420мОм
425мОм
42мОм
42Ом
43мОм
44мОм
450мОм
45мОм
45Ом
460мОм
46мОм
48мОм
4мОм
4Ом
5.1мОм
5.1Ом
5.2мОм
5.3мОм
5.4мОм
5.5мОм
5.6мОм
5.7мОм
5.8мОм
5.9мОм
500мОм
500Ом
50мОм
520мОм
52мОм
53мОм
54мОм
550мкОм
55мОм
560мОм
57.5мОм
5мОм
5Ом
6.1мОм
6.2мОм
6.3мОм
6.5мОм
6.6мОм
6.7мОм
6.8мОм
6.9мОм
600мОм
60мОм
60Ом
62мОм
63мОм
650мОм
65мОм
660мОм
66мОм
6мОм
6Ом
7. 2мОм
7.3мОм
7.5мОм
7.5Ом
7.6мОм
7.7мОм
7.9мОм
700Ом
70мОм
725мОм
75мОм
78мОм
7мОм
7Ом
8.1Ом
8.2мОм
8.3мОм
8.4мОм
8.5мОм
8.7мОм
8.8мОм
8.9мОм
800мОм
80мОм
82мОм
830мОм
85мОм
8мОм
8Ом
9.1мОм
9.2мОм
9.3мОм
9.4мОм
9.5мОм
9.7мОм
9.8мОм
9.9мОм
900мОм
90мОм
950мОм
95мОм
970мкОм
99мОм
9мОм
2мОм
7.3мОм
7.5мОм
7.5Ом
7.6мОм
7.7мОм
7.9мОм
700Ом
70мОм
725мОм
75мОм
78мОм
7мОм
7Ом
8.1Ом
8.2мОм
8.3мОм
8.4мОм
8.5мОм
8.7мОм
8.8мОм
8.9мОм
800мОм
80мОм
82мОм
830мОм
85мОм
8мОм
8Ом
9.1мОм
9.2мОм
9.3мОм
9.4мОм
9.5мОм
9.7мОм
9.8мОм
9.9мОм
900мОм
90мОм
950мОм
95мОм
970мкОм
99мОм
9мОм
Тепловое сопротивление переход-корпус
1.04К/Вт
1.05К/Вт
1.09К/Вт
1.11К/Вт
1.14К/Вт
1.1К/Вт
1.2К/Вт
1.32К/Вт
1.38К/Вт
1.42К/Вт
1.4К/Вт
1.64К/Вт
1.66К/Вт
1. 69К/Вт
1.6К/Вт
1.73К/Вт
1.75К/Вт
1.7К/Вт
1.83К/Вт
1.87К/Вт
1.89К/Вт
1.8К/Вт
1.9К/Вт
1045мК/Вт
13К/Вт
1К/Вт
2.12К/Вт
2.2К/Вт
2.3К/Вт
2.4К/Вт
2.65К/Вт
2.73К/Вт
2.7К/Вт
2К/Вт
3.12К/Вт
3.15К/Вт
3.1К/Вт
3.2К/Вт
3.3К/Вт
3.4К/Вт
3.5К/Вт
3.75К/Вт
3К/Вт
4.1К/Вт
4.28К/Вт
4.3К/Вт
4.7К/Вт
400мК/Вт
450мК/Вт
470мК/Вт
500мК/Вт
510К/Вт
510мК/Вт
570мК/Вт
600мК/Вт
610мК/Вт
650мК/Вт
7.6К/Вт
750мК/Вт
770мК/Вт
850мК/Вт
900мК/Вт
920мК/Вт
950мК/Вт
69К/Вт
1.6К/Вт
1.73К/Вт
1.75К/Вт
1.7К/Вт
1.83К/Вт
1.87К/Вт
1.89К/Вт
1.8К/Вт
1.9К/Вт
1045мК/Вт
13К/Вт
1К/Вт
2.12К/Вт
2.2К/Вт
2.3К/Вт
2.4К/Вт
2.65К/Вт
2.73К/Вт
2.7К/Вт
2К/Вт
3.12К/Вт
3.15К/Вт
3.1К/Вт
3.2К/Вт
3.3К/Вт
3.4К/Вт
3.5К/Вт
3.75К/Вт
3К/Вт
4.1К/Вт
4.28К/Вт
4.3К/Вт
4.7К/Вт
400мК/Вт
450мК/Вт
470мК/Вт
500мК/Вт
510К/Вт
510мК/Вт
570мК/Вт
600мК/Вт
610мК/Вт
650мК/Вт
7.6К/Вт
750мК/Вт
770мК/Вт
850мК/Вт
900мК/Вт
920мК/Вт
950мК/Вт
Тепловое сопротивление переход-среда
100К/Вт
120К/Вт
45К/Вт
50К/Вт
60К/Вт
62. 5К/Вт
5К/Вт
Технология
CoolMOS™ CoolMOS™ CE OptiMOS™ OptiMOS™ 2 OptiMOS™ 3 OptiMOS™ 5 OptiMOS™ FD SIPMOS™
Тип канала
обогащенный
Тип транзистора
IGBT logic level N-JFET N-MOSFET N-MOSFET x2 N/P-MOSFET x2 МОП n-канал. x2 МОП n-канальный полевой n-канальный полевой n-канальный, TrenchMOS
Ток коллектора
5А
Ток стока
-3.4А
0.115А
1.1А
1.2А
1.4А
1.5А
1.6А
1.7А
1.8А
1.9А
10.1А
10.3А
10.4А
10.6А
10.9А
100А
100мА
103А
104А
105А
106А
108А
10А
10мА
11.3А
11.4А
11.5А
110А
112А
114А
115мА
116А
117А
119А
11А
12. 1А
12.4А
12.5А
12.7А
120А
120мА
123А
124А
127А
12А
13.1А
13.3А
13.4А
13.5А
13.6А
13.8А
130А
131А
135А
13А
14.4А
140А
140мА
145А
14А
15.2А
150А
150мА
155А
156А
15А
15мА
16.1А
16.6А
160А
161А
162А
166А
16А
17.5А
170А
170мА
173А
17А
180А
180мА
184А
185А
18А
190А
190мА
192А
195А
198А
19А
1А
1мА
2.1А
2.2А
2.3А
2.4А
2.5А
2.6А
2.7А
2.8А
2.9А
20.2А
20.
1А
12.4А
12.5А
12.7А
120А
120мА
123А
124А
127А
12А
13.1А
13.3А
13.4А
13.5А
13.6А
13.8А
130А
131А
135А
13А
14.4А
140А
140мА
145А
14А
15.2А
150А
150мА
155А
156А
15А
15мА
16.1А
16.6А
160А
161А
162А
166А
16А
17.5А
170А
170мА
173А
17А
180А
180мА
184А
185А
18А
190А
190мА
192А
195А
198А
19А
1А
1мА
2.1А
2.2А
2.3А
2.4А
2.5А
2.6А
2.7А
2.8А
2.9А
20.2А
20. 7А
20.8А
200А
200мА
20А
21.3А
210А
213А
216А
21А
21мА
22.4А
220А
220мА
22А
23.5А
230А
230мА
23А
240А
246А
24А
250мА
255А
25А
260А
260мА
26А
270А
27А
280А
280мА
28А
293А
295А
29А
2А
3.1А
3.2А
3.3А
3.4А
3.5А
3.6А
3.7А
3.8А
3.9А
300А
300мА
30А
30мА
31.2А
31А
320А
324А
32А
33А
340А
343А
34А
350мА
35А
360мА
362А
36А
37А
380А
38А
397А
39А
3А
4.
7А
20.8А
200А
200мА
20А
21.3А
210А
213А
216А
21А
21мА
22.4А
220А
220мА
22А
23.5А
230А
230мА
23А
240А
246А
24А
250мА
255А
25А
260А
260мА
26А
270А
27А
280А
280мА
28А
293А
295А
29А
2А
3.1А
3.2А
3.3А
3.4А
3.5А
3.6А
3.7А
3.8А
3.9А
300А
300мА
30А
30мА
31.2А
31А
320А
324А
32А
33А
340А
343А
34А
350мА
35А
360мА
362А
36А
37А
380А
38А
397А
39А
3А
4. 1А
4.2А
4.3А
4.4А
4.5А
4.6А
4.7А
4.9А
4/0.9А
400А
400мА
40А
40мА
41А
426А
429А
42А
43А
44А
450мА
45А
46А
47А
48А
49А
4А
5.1А
5.2А
5.3А
5.4А
5.5А
5.6А
5.7А
5.8А
500мА
50А
50мА
51А
52А
53А
540мА
54А
55А
56А
57А
58А
59А
5А
5мА
6.1А
6.2А
6.3А
6.5А
6.5мА
6.6А
6.7А
6.8А
6.9А
600мА
60А
60мА
61А
62А
63А
64А
65А
660мА
66А
67А
680мА
68А
69А
6А
7.
1А
4.2А
4.3А
4.4А
4.5А
4.6А
4.7А
4.9А
4/0.9А
400А
400мА
40А
40мА
41А
426А
429А
42А
43А
44А
450мА
45А
46А
47А
48А
49А
4А
5.1А
5.2А
5.3А
5.4А
5.5А
5.6А
5.7А
5.8А
500мА
50А
50мА
51А
52А
53А
540мА
54А
55А
56А
57А
58А
59А
5А
5мА
6.1А
6.2А
6.3А
6.5А
6.5мА
6.6А
6.7А
6.8А
6.9А
600мА
60А
60мА
61А
62А
63А
64А
65А
660мА
66А
67А
680мА
68А
69А
6А
7. 1А
7.3А
7.5А
7.6А
7.7А
7.8А
700мА
70А
71А
72А
73А
74А
750мА
75А
76А
77А
79А
7А
8.1А
8.2А
8.3А
8.5А
8.7А
800мА
80А
81А
82А
83А
84А
85А
86А
87А
880мА
88А
890мА
89А
8А
9.1А
9.2А
9.3А
9.4А
9.5А
9.7А
9.9А
900мА
90А
90мА
91А
92А
93А
94А
950мА
95А
960мА
96А
97А
98А
99А
9А
1А
7.3А
7.5А
7.6А
7.7А
7.8А
700мА
70А
71А
72А
73А
74А
750мА
75А
76А
77А
79А
7А
8.1А
8.2А
8.3А
8.5А
8.7А
800мА
80А
81А
82А
83А
84А
85А
86А
87А
880мА
88А
890мА
89А
8А
9.1А
9.2А
9.3А
9.4А
9.5А
9.7А
9.9А
900мА
90А
90мА
91А
92А
93А
94А
950мА
95А
960мА
96А
97А
98А
99А
9А
Производитель
ADVANCED POWER ELECTRONICS ALPHA & OMEGA SEMICONDUCTOR CREE DIODES INCORPORATED Fairchild Semiconductor INFINEON (IRF) INFINEON TECHNOLOGIES IXYS MICROCHIP (SUPERTEX) MICROCHIP TECHNOLOGY NXP ON SEMICONDUCTOR ST MICROELECTRONICS TAIWAN SEMICONDUCTOR TEXAS INSTRUMENTS TOSHIBA VISHAY
Туннельные полевые транзисторы: проектирование, моделирование и применение
Биография
Арун Самуэль Т. С. получил степень бакалавра в области электроники и техники связи в Инженерном колледже Сайеда Аммала (2004 г.) и степень магистра в области вычислительной техники и связи в Национальном инженерном колледже ( 2006). Ему присвоена степень доктора философии. в области наноэлектронных устройств (2014 г.) Инженерного колледжа Тиагараяр, Тамилнад, Индия, при Университете Анны в Ченнаи. В настоящее время он является адъюнкт-профессором в Национальном инженерном колледже, Ковилпатти, Индия. Он является пожизненным членом Инженерного института (IE) Индии и членом IEEE. Область его научных интересов включает моделирование и симуляцию многозатворных транзисторов и туннельных полевых транзисторов.
С. получил степень бакалавра в области электроники и техники связи в Инженерном колледже Сайеда Аммала (2004 г.) и степень магистра в области вычислительной техники и связи в Национальном инженерном колледже ( 2006). Ему присвоена степень доктора философии. в области наноэлектронных устройств (2014 г.) Инженерного колледжа Тиагараяр, Тамилнад, Индия, при Университете Анны в Ченнаи. В настоящее время он является адъюнкт-профессором в Национальном инженерном колледже, Ковилпатти, Индия. Он является пожизненным членом Инженерного института (IE) Индии и членом IEEE. Область его научных интересов включает моделирование и симуляцию многозатворных транзисторов и туннельных полевых транзисторов.
Профессор Ён Со Сон — доцент кафедры компьютерных наук (CS) Корейской военной академии. Его текущие исследовательские интересы включают надежность полупроводников (эффект самонагрева и характеристики удержания), полупроводниковый искусственный интеллект, машинное обучение (ML) для демографии и экономики, флэш-память NAND и флэш-память NOR, низкотемпературное логическое устройство для ЦП, логическое устройство с низким энергопотреблением ( Tunnel FET, TFET) для сотовых телефонов и ноутбуков, а также логическое устройство на основе германия (Ge) (2030 ~ 2050), которое является одним из многообещающих кандидатов на замену существующей технологии ЦП на основе кремния (Si).
Доктор Шубхам Тайал — доцент кафедры электроники и коммуникационных технологий Университета SR, Варангал, Индия. У него более 6 лет академического/исследовательского опыта преподавания на уровнях UG и PG. Он получил докторскую степень. в области микроэлектроники и проектирования СБИС Национального технологического института, Курукшетра, M.Tech (дизайн СБИС) в Университете науки и технологий YMCA, Фаридабад, и B.Tech (электроника и техника связи) в MDU, Рохтак. Он является лауреатом международной премии Green ThinkerZ в номинации «Выдающийся молодой исследователь» 2020 года. Его исследовательские интересы включают моделирование и моделирование полупроводниковых устройств с несколькими затворами, совместное проектирование устройств и схем в цифровой/аналоговой области, машинное обучение и Интернет вещей.
П.Вимала получила степень бакалавра и медицины в области электроники и техники связи в Университете Анны, Ченнаи. Она защитила докторскую диссертацию. получила степень в области моделирования и моделирования полупроводниковых устройств в Университете Анны, Ченнаи, в 2014 году. В настоящее время она является адъюнкт-профессором Инженерного колледжа Даянанды Сагара, Бангалор, Индия. У нее более 100 публикаций, включая 47 проиндексированных журналов и более 30 проиндексированных конференций, 1 патент и 5 глав в книгах. Она является старшим членом IEEE, членом IETE, пожизненным членом ISTE и членом IEI. Ее исследовательские интересы были сосредоточены на моделировании и моделировании наноразмерных полупроводниковых устройств с использованием инструментов Sentaurus и Atlas TCAD Simulation.
В настоящее время она является адъюнкт-профессором Инженерного колледжа Даянанды Сагара, Бангалор, Индия. У нее более 100 публикаций, включая 47 проиндексированных журналов и более 30 проиндексированных конференций, 1 патент и 5 глав в книгах. Она является старшим членом IEEE, членом IETE, пожизненным членом ISTE и членом IEI. Ее исследовательские интересы были сосредоточены на моделировании и моделировании наноразмерных полупроводниковых устройств с использованием инструментов Sentaurus и Atlas TCAD Simulation.
Широмани Балмукунд Рахи получил степень бакалавра наук. (физика, химия и математика) в 2002 г., магистр наук. (Электроника) из Университета Дин Дьял Упадхьяя Горакхпур, Горакхпур, 2005 г., GATE (2009 г.), M. Tech. (микроэлектроника) Пенджабского университета в Чандигархе в 2011 году и степень доктора философии в 2018 году в Индийском технологическом институте, Канпур, Индия. Его интересы включают разработку IoT для интеллектуальных приложений для разработки устройств со сверхнизким энергопотреблением, таких как Tunnel FET, NC TFET с отрицательной емкостью FET, Nanosheet.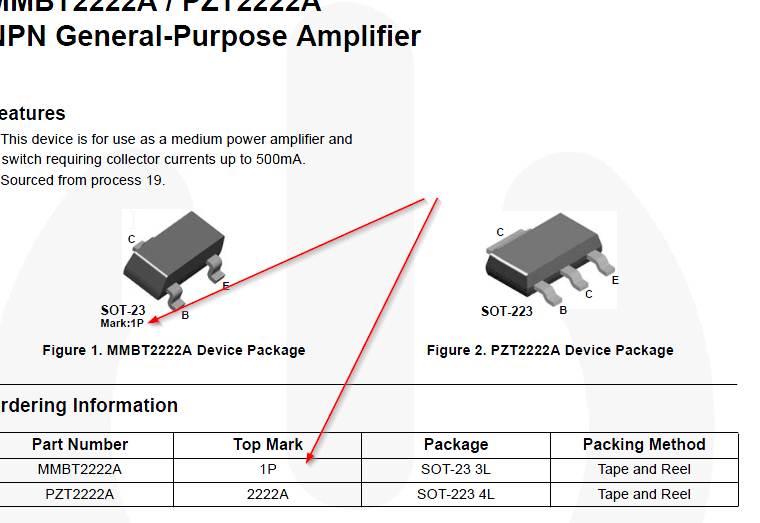
Сравнительный анализ однослойных полевых транзисторов MoS2 и WS2
1. Bhimanapati GR, et al. Последние достижения в области двумерных материалов помимо графена. АКС Нано. 2015;9:11509–11539. doi: 10.1021/acsnano.5b05556. [PubMed] [CrossRef] [Google Scholar]
2. Das S, Robinson JA, Dubey M, Terrones H, Terrones M. Помимо графена: прогресс в новых двумерных материалах и ван-дер-ваальсовых телах. Анну. Преподобный Матер. Рез. 2015; 45:1–27. doi: 10.1146/annurev-matsci-070214-021034. [Перекрестная ссылка] [Академия Google]
3. Yoon Y, Ganapathi K, Salahuddin S. Насколько хороши могут быть однослойные транзисторы MoS 2 ? Нано Летт. 2011; 11:3768–3773. doi: 10.1021/nl2018178. [PubMed] [CrossRef] [Google Scholar]
4. Majumdar K, Hobbs C, Kirsch PD. Сравнительный анализ полевого МОП-транзистора с дихалькогенидом переходного металла в пределе физического масштабирования. IEEE Electron Device Lett. 2014; 35:402–404. doi: 10.1109/LED.2014.2300013. [CrossRef] [Google Scholar]
[CrossRef] [Google Scholar]
5. Алам К., Лейк Р.К. Монослой MoS 2 транзистора выходят за рамки технологической дорожной карты. IEEE транс. Электронные устройства. 2012;59: 3250–3254. doi: 10.1109/TED.2012.2218283. [CrossRef] [Google Scholar]
6. English CD, Shine G, Dorgan VE, Saraswat KC, Pop E. Улучшение контактов транзисторов MoS 2 путем осаждения металла в сверхвысоком вакууме. Нано Летт. 2016;16:3824–3830. doi: 10.1021/acs.nanolett.6b01309. [PubMed] [CrossRef] [Google Scholar]
7. Smets, Q. et al. Ультрамасштабные полевые МОП-транзисторы MOCVD MoS 2 с шагом контактов 42 нм и током стока 250 мкА/мкм. Международная встреча IEEE по электронным устройствам 23.2.1–23.2.4 (2019).
8. Tosun M, et al. Инверторы с высоким коэффициентом усиления на комплементарных полевых транзисторах WSe 2 . АКС Нано. 2014; 8: 4948–4953. doi: 10.1021/nn5009929. [PubMed] [CrossRef] [Google Scholar]
9. Yu L, et al. Высокопроизводительные WSe 2 комплементарные оксидно-металлические полупроводниковые технологии и интегральные схемы. Нано Летт. 2015;15:4928–4934. doi: 10.1021/acs.nanolett.5b00668. [PubMed] [CrossRef] [Google Scholar]
Высокопроизводительные WSe 2 комплементарные оксидно-металлические полупроводниковые технологии и интегральные схемы. Нано Летт. 2015;15:4928–4934. doi: 10.1021/acs.nanolett.5b00668. [PubMed] [CrossRef] [Google Scholar]
10. Радисавлевич Б., Уитвик М.Б., Кис А. Интегральные схемы и логические операции на основе однослойного MoS 2 . АКС Нано. 2011;5:9934–9938. doi: 10.1021/nn203715c. [PubMed] [CrossRef] [Google Scholar]
11. Sanne A, et al. Радиочастотные транзисторы и схемы на основе CVD MoS 2 . Нано Летт. 2015;15:5039–5045. doi: 10.1021/acs.nanolett.5b01080. [PubMed] [CrossRef] [Google Scholar]
12. Yu L, et al. Проектирование, моделирование и изготовление схем MoS 2 , выращенных химическим осаждением из паровой фазы, с полевыми транзисторами E-режима для электроники большой площади. Нано Летт. 2016;16:6349–6356. doi: 10.1021/acs.nanolett.6b02739. [PubMed] [CrossRef] [Google Scholar]
13. Вахтер С., Полюшкин Д. К., Бетге О., Мюллер Т. Микропроцессор на основе двумерного полупроводника. Нац. коммун. 2017;8:14948. doi: 10.1038/ncomms14948. [Бесплатная статья PMC] [PubMed] [CrossRef] [Google Scholar]
К., Бетге О., Мюллер Т. Микропроцессор на основе двумерного полупроводника. Нац. коммун. 2017;8:14948. doi: 10.1038/ncomms14948. [Бесплатная статья PMC] [PubMed] [CrossRef] [Google Scholar]
14. Себастьян А., Паннон А., Радхакришнан С.С., Дас С. Синапсы Гаусса для вероятностных нейронных сетей. Нац. коммун. 2019;10:4199. doi: 10.1038/s41467-019-12035-6. [Бесплатная статья PMC] [PubMed] [CrossRef] [Google Scholar]
15. Das S. Двумерный электрострикционный полевой транзистор (2D-EFET): Устройство с крутым наклоном менее 60 мВ/декада и высоким током включения. науч. Отчет 2016; 6: 34811. doi: 10.1038/srep34811. [Статья PMC бесплатно] [PubMed] [CrossRef] [Google Scholar]
16. Schaibley, J. R. et al. Valleytronics в 2D материалах. Нац. Преподобный Матер. 1 , 16055 (2016).
17. Дас С., Додда А., Дас С. Биомиметический 2D-транзистор для аудиоморфных вычислений. Нац. коммун. 2019;10:3450. doi: 10.1038/s41467-019-11381-9. [Бесплатная статья PMC] [PubMed] [CrossRef] [Google Scholar]
18. Lee CW, Suh JM, Jang HW. Химические сенсоры на основе двумерных (2D) материалов для селективного обнаружения ионов и молекул в ЖИДКОСТИ. Передний. хим. 2019;7:708. doi: 10.3389/fchem.2019.00708. [Бесплатная статья PMC] [PubMed] [CrossRef] [Google Scholar]
Lee CW, Suh JM, Jang HW. Химические сенсоры на основе двумерных (2D) материалов для селективного обнаружения ионов и молекул в ЖИДКОСТИ. Передний. хим. 2019;7:708. doi: 10.3389/fchem.2019.00708. [Бесплатная статья PMC] [PubMed] [CrossRef] [Google Scholar]
19. Dodda A, et al. Стохастический резонанс в фотоприемнике MoS 2 . Нац. коммун. 2020;11:4406. doi: 10.1038/s41467-020-18195-0. [Бесплатная статья PMC] [PubMed] [CrossRef] [Google Scholar]
20. Джаячандран Д. и соавт. Маломощный биомиметический детектор столкновений на основе фотодетектора дисульфида молибдена с памятью. Нац. Электрон. 2020;3:646–655. doi: 10.1038/s41928-020-00466-9. [CrossRef] [Google Scholar]
21. Nasr, J.R. et al. Маломощные и ультратонкие MoS 2 фотоприемники на стекле. ACS Nano 14 , 15440–15449 (2020 г.). [PubMed]
22. Smithe KKH, English CD, Suryavanshi SV, Pop E. Внутренний электрический транспорт и прогнозы производительности синтетического монослоя MoS 2 устройства. 2D Матер. 2016;4:011009. doi: 10.1088/2053-1583/4/1/011009. [CrossRef] [Google Scholar]
2D Матер. 2016;4:011009. doi: 10.1088/2053-1583/4/1/011009. [CrossRef] [Google Scholar]
23. Dumcenco D, et al. Эпитаксиальный монослой большой площади MoS 2 . АКС Нано. 2015;9:4611–4620. doi: 10.1021/acsnano.5b01281. [Бесплатная статья PMC] [PubMed] [CrossRef] [Google Scholar]
24. Kang K, et al. Высокоподвижные полупроводниковые пленки толщиной в три атома с однородностью в масштабе пластины. Природа. 2015; 520: 656–660. doi: 10.1038/nature14417. [PubMed] [CrossRef] [Академия Google]
25. Smithe KKH, Suryavanshi SV, Munoz Rojo M, Tedjarati AD, Pop E. Низкая изменчивость в синтетических монослойных устройствах MoS 2 . АКС Нано. 2017; 11:8456–8463. doi: 10.1021/acsnano.7b04100. [PubMed] [CrossRef] [Google Scholar]
26. Xu H, et al. Высокопроизводительные полупроводниковые транзисторы MoS 2 для практического применения. Маленький. 2018;14:e1803465. doi: 10.1002/smll.201803465. [PubMed] [CrossRef] [Google Scholar]
27. Xuan Y, et al. Многомасштабное моделирование газофазных реакций при росте WSe 9 методом химического осаждения из паровой фазы металлоорганических соединений0021 2 . Дж. Крист. Рост. 2019;527:125247. doi: 10.1016/j.jcrysgro.2019.125247. [CrossRef] [Google Scholar]
Xuan Y, et al. Многомасштабное моделирование газофазных реакций при росте WSe 9 методом химического осаждения из паровой фазы металлоорганических соединений0021 2 . Дж. Крист. Рост. 2019;527:125247. doi: 10.1016/j.jcrysgro.2019.125247. [CrossRef] [Google Scholar]
28. Чубаров М. и соавт. Эпитаксиальный рост монослоев WS 2 одной ориентации на сапфире в масштабе пластины. arXiv e-prints , arXiv:2006.10952. Препринт на https://ui.adsabs.harvard.edu/abs/2020arXiv200610952C (2020)
29. Zhang F, Erb C, Runkle L, Zhang X, Alem N. Перенос двумерных наноструктур без травления. Нанотехнологии. 2018;29:025602. doi: 10.1088/1361-6528/aa9с21. [PubMed] [CrossRef] [Google Scholar]
30. Das S, Chen HY, Penumatcha AV, Appenzeller J. Высокопроизводительные многослойные транзисторы MoS 2 со скандиевыми контактами. Нано Летт. 2013;13:100–105. doi: 10.1021/nl303583v. [PubMed] [CrossRef] [Google Scholar]
31. Leonhardt A, et al. Материал-избирательное легирование 2D TMDC посредством инкапсуляции AlxOy. Приложение ACS Матер. Интерфейсы. 2019;11:42697–42707. doi: 10.1021/acsami.9b11550. [PubMed] [CrossRef] [Академия Google]
Приложение ACS Матер. Интерфейсы. 2019;11:42697–42707. doi: 10.1021/acsami.9b11550. [PubMed] [CrossRef] [Академия Google]
32. Бхойр М.С. и соавт. Источники изменчивости в объемных нанотранзисторах FinFET и TiTaN — многообещающая WFM с низкой изменчивостью для узлов CMOS 7/5 нм. В 2019 IEEE International Electronic Devices Meeting (IEDM) , 36.2.1–36.2.4 (2019).
33. Weber, O. et al. Высокая устойчивость к изменчивости порогового напряжения в нелегированных ультратонких полевых МОП-транзисторах FDSOI и ее физическое понимание. В 2008 г. IEEE International Electronic Devices Meeting , 1–4 (2008 г.).
34. Цуцуи Г., Сайтох М., Нагумо Т., Хирамото Т. Влияние флуктуаций толщины КНИ на изменение порогового напряжения в ультратонких КНИ МОП-транзисторов. IEEE транс. нанотехнологии. 2005;4:369–373. doi: 10.1109/TNANO.2005.846913. [CrossRef] [Google Scholar]
35. Самсудин К., Адаму-Лема Ф., Браун А.Р., Рой С., Асенов А. Комбинированные источники внутренних флуктуаций параметров в МОП-транзисторах UTB-SOI поколения менее 25 нм: исследование статистического моделирования. Твердотельный электрон. 2007; 51: 611–616. doi: 10.1016/j.sse.2007.02.022. [CrossRef] [Google Scholar]
Твердотельный электрон. 2007; 51: 611–616. doi: 10.1016/j.sse.2007.02.022. [CrossRef] [Google Scholar]
36. Min C, Kamins T, Voorde PV, Diaz C, Greene W. 0,18-мкм полностью обедненные кремниевые полевые МОП-транзисторы на изоляторе. IEEE Electron Device Lett. 1997;18:251–253. doi: 10.1109/55.585344. [CrossRef] [Google Scholar]
37. Liu H, Ye PD. MoS 2 Двухзатворный полевой МОП-транзистор с нанесенным атомным слоем Al 2 O 3 в качестве диэлектрика верхнего затвора. IEEE Electron Device Lett. 2012; 33: 546–548. doi: 10.1109/LED.2012.2184520. [CrossRef] [Google Scholar]
38. Guo J, Yang B, Zheng Z, Jiang J. Наблюдение аномального увеличения подвижности в многослойном транзисторе MoS 2 за счет синергии ультрафиолетового освещения и обработки озоновой плазмой. физ. E: Низкомерная система. Наноструктур. 2017; 87: 150–154. doi: 10.1016/j.physe.2016.12.004. [Перекрестная ссылка] [Академия Google]
39. Ю. З. и соавт. На пути к переносу собственного заряда в монослойном дисульфиде молибдена с помощью дефектов и инженерии интерфейса. Нац. коммун. 2014;5:5290. doi: 10.1038/ncomms6290. [PubMed] [CrossRef] [Google Scholar]
На пути к переносу собственного заряда в монослойном дисульфиде молибдена с помощью дефектов и инженерии интерфейса. Нац. коммун. 2014;5:5290. doi: 10.1038/ncomms6290. [PubMed] [CrossRef] [Google Scholar]
40. Chang H-Y, Zhu W, Akinwande D. Об оценке подвижности и контактного сопротивления для транзисторов на основе MoS2 или двумерных полупроводниковых атомных кристаллов. заявл. физ. лат. 2014;104:113504. doi: 10.1063/1.4868536. [CrossRef] [Google Scholar]
41. Das S, Appenzeller J. Куда течет ток в двумерных слоистых системах? Нано Летт. 2013;13:3396–3402. doi: 10.1021/nl401831u. [PubMed] [CrossRef] [Google Scholar]
42. Yang L, et al. Метод молекулярного легирования хлоридами двумерных материалов: WS 2 и MoS 2 . Нано Летт. 2014;14:6275–6280. doi: 10.1021/nl502603d. [PubMed] [CrossRef] [Google Scholar]
43. Nasr JR, Schulman DS, Sebastian A, Horn MW, Das S. Обман мобильности в наноразмерных транзисторах: нерассказанная история контакта. Доп. Матер. 2019;31:1806020. doi: 10.1002/adma.201806020. [PubMed] [CrossRef] [Академия Google]
Доп. Матер. 2019;31:1806020. doi: 10.1002/adma.201806020. [PubMed] [CrossRef] [Академия Google]
44. Rai A, et al. Стабильное легирование на воздухе и повышение собственной подвижности в монослойном дисульфиде молибдена за счет инкапсуляции аморфного субоксида титана. Нано Летт. 2015;15:4329–4336. doi: 10.1021/acs.nanolett.5b00314. [PubMed] [CrossRef] [Google Scholar]
45. Schulman DS, et al. Легкий электрохимический синтез двумерных монослоев для высокопроизводительных тонкопленочных транзисторов. Приложение ACS Mater. Интерфейсы. 2017;9:44617–44624. doi: 10.1021/acsami.7b14711. [PubMed] [CrossRef] [Академия Google]
46. Себастьян А. и др. Электрохимическая полировка двумерных материалов. АКС Нано. 2019;13:78–86. doi: 10.1021/acsnano.8b08216. [PubMed] [CrossRef] [Google Scholar]
47. Yun SJ, et al. Синтез монослойной пленки дисульфида вольфрама сантиметрового размера на золотой фольге. АКС Нано. 2015;9:5510–5519. doi: 10.1021/acsnano.5b01529. [PubMed] [CrossRef] [Google Scholar]
48. Cui Y, et al. Высокопроизводительные однослойные полевые транзисторы WS 2 на высококаппа-диэлектриках. Доп. Матер. 2015;27:5230–5234. doi: 10.1002/adma.201502222. [PubMed] [CrossRef] [Академия Google]
Cui Y, et al. Высокопроизводительные однослойные полевые транзисторы WS 2 на высококаппа-диэлектриках. Доп. Матер. 2015;27:5230–5234. doi: 10.1002/adma.201502222. [PubMed] [CrossRef] [Академия Google]
49. Овчинников Д., Аллен А., Хуанг Ю.С., Думченко Д., Кис А. Электрические транспортные свойства однослойного WS 2 . АКС Нано. 2014;8:8174–8181. doi: 10.1021/nn502362b. [PubMed] [CrossRef] [Google Scholar]
50. Аджи А.С., Солис-Фернандес П., Джи Х.Г., Фукуда К., Аго Х. Высокомобильные транзисторы WS 2 , реализованные на основе многослойных графеновых электродов и применение в высокочувствительных гибких фотодетекторах . Доп. Функц. Матер. 2017;27:1703448. doi: 10.1002/adfm.201703448. [Перекрестная ссылка] [Академия Google]
51. Schmidt M, et al. Извлечение подвижности в КНИ МОП-транзисторах с толщиной корпуса менее 1 нм. Твердотельный электрон. 2009;53:1246–1251. doi: 10.1016/j.sse.2009.09.017. [CrossRef] [Google Scholar]
52. Шульман Д.С., Арнольд А.Дж., Дас С. Контактная инженерия для двумерных материалов и устройств. хим. соц. 2018; 47:3037–3058. doi: 10.1039/C7CS00828G. [PubMed] [CrossRef] [Google Scholar]
Шульман Д.С., Арнольд А.Дж., Дас С. Контактная инженерия для двумерных материалов и устройств. хим. соц. 2018; 47:3037–3058. doi: 10.1039/C7CS00828G. [PubMed] [CrossRef] [Google Scholar]
53. Lee S, Tang A, Aloni S, Wong HS. Статистическое исследование снижения барьера Шоттки туннельных контактов до CVD-синтезированного MoS 2 . Нано Летт. 2016;16:276–281. doi: 10.1021/acs.nanolett.5b03727. [PubMed] [CrossRef] [Google Scholar]
54. Liu Y, et al. Расширение предела производительности транзисторов на основе дисульфида молибдена менее 100 нм. Нано Летт. 2016;16:6337–6342. doi: 10.1021/acs.nanolett.6b02713. [PubMed] [CrossRef] [Google Scholar]
55. Luo P, et al. Легирование и функционализация двумерных халькогенидов металлов. Наномасштаб Гориз. 2019;4:26–51. doi: 10.1039/C8NH00150B. [PubMed] [CrossRef] [Академия Google]
56. Zhu Y, et al. Монослойные дисульфидмолибденовые транзисторы с затворами толщиной в один атом. Нано Летт. 2018;18:3807–3813.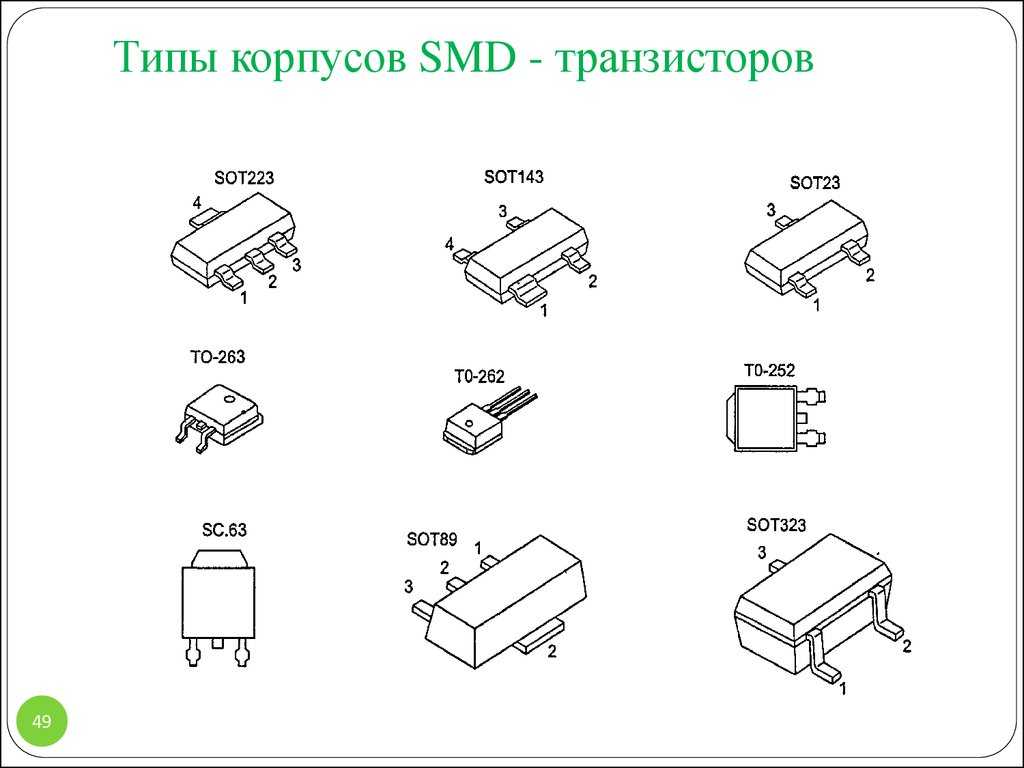 doi: 10.1021/acs.nanolett.8b01091. [PubMed] [CrossRef] [Google Scholar]
doi: 10.1021/acs.nanolett.8b01091. [PubMed] [CrossRef] [Google Scholar]
57. Ангел, К. Ионеску, А., Хефьене, Н. и Гиллон, Р. Характеристика самонагрева и метод извлечения теплового сопротивления и емкости в высоковольтных МОП-транзисторах. В ESSDERC’03. 33-я Европейская конференция по исследованиям твердотельных устройств, 2003 г. . 449–452 (2003).
58. Шин С. и соавт. Влияние изменчивости нанопроволоки на производительность и надежность полевых МОП-транзисторов III-V типа «затвор-все вокруг». В 2013 IEEE International Electron Devices Meeting , 7.5. 1–7,5. 4 (2013).
59. Ислам С., Ли З., Дорган В.Е., Бэ М.Х., Поп Э. Роль нагрева Джоуля в насыщении тока и переходных режимах графеновых транзисторов. Электронное устройство IEEE Lett. 2013; 34: 166–168. doi: 10.1109/LED.2012.2230393. [CrossRef] [Google Scholar]
60. Li, X. et al. Потенциал производительности и предел MoS 2 транзисторы. Adv Mater. 27 , 1547–1552 (2015). [PubMed]
[PubMed]
61. Yalon E, et al. Рассеивание энергии в монослойной электронике MoS 2 . Нано Летт. 2017;17:3429–3433. doi: 10.1021/acs.nanolett.7b00252. [PubMed] [CrossRef] [Google Scholar]
62. Taur, Y. & Ning, T. Fundamentals of Modern VLSI Devices 2nd ed. (Кембридж, издательство Кембриджского университета, 2009 г.).
63. Smithe KKH, English CD, Suryavanshi SV, Pop E. Транспорт в сильном поле и насыщение скорости в синтетическом монослое MoS 2 . Нано Летт. 2018;18:4516–4522. doi: 10.1021/acs.nanolett.8b01692. [PubMed] [CrossRef] [Google Scholar]
64. Гонг Ю., Карозо В., Ли Х., Терронес М., Джексон Т.Н. Испытание монослоя CVD WS 2 TFT с большим циклом изгиба на тонком гибком полиимиде. 2D Матер. 2016;3:021008. doi: 10.1088/2053-1583/3/2/021008. [CrossRef] [Google Scholar]
65. Инглиш, К.Д., Смит, К.К.Х., Сюй, Р.Л. и Поп, Э. Приближение баллистического транспорта в монослойных транзисторах MoS 2 с самовыравнивающимися 10-нм верхними затворами. 5.6.1–5.6.4 (2016).
5.6.1–5.6.4 (2016).
66. Liu H, et al. Статистическое исследование глубоких субмикронных двухзатворных полевых транзисторов на монослойных пленках дисульфида молибдена методом химического осаждения из газовой фазы. Нано Летт. 2013;13:2640–2646. doi: 10.1021/nl400778q. [PubMed] [CrossRef] [Google Scholar]
67. Лундстрем, М. Основы транспортных перевозок , 2-е изд. (Cambridge University Press, 2000).
68. Sze, S.M. & Ng, KK Physics of Semiconductor Devices , 3-е изд. (John Wiley & Sons, 2007).
69. Nathawat J, et al. Переходная динамика горячих носителей и насыщение собственной скорости в монослое MoS 2 . физ. Преподобный Матер. 2020;4:014002. doi: 10.1103/PhysRevMaterials.4.014002. [CrossRef] [Google Scholar]
70. Чубаров М., Чоудхури Т.Х., Чжан Х., Редвинг Дж.М. Рентгеновская дифракция в плоскости для характеристики монослойных и малослойных пленок дихалькогенидов переходных металлов. Нанотехнологии. 2018;29:055706.