BGA — это… Что такое BGA?
 | Проверить информацию. Необходимо проверить точность фактов и достоверность сведений, изложенных в этой статье. |
BGA (англ. Ball grid array — массив шариков) — тип корпуса поверхностно-монтируемых интегральных микросхем
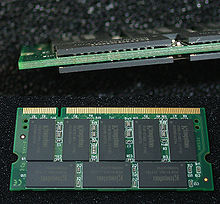 Здесь микросхемы памяти, установленные на планку, имеют выводы типа BGA
Здесь микросхемы памяти, установленные на планку, имеют выводы типа BGA  Разрез печатной платы с корпусом типа BGA. Сверху видно кремниевый кристалл.
Разрез печатной платы с корпусом типа BGA. Сверху видно кремниевый кристалл.BGA произошёл от PGA. BGA выводы представляют собой шарики из припоя, нанесённые на контактные площадки с обратной стороны микросхемы. Микросхему располагают на печатной плате, согласно маркировке первого контакта на микросхеме и на плате. Далее, микросхему нагревают с помощью паяльной станции или инфракрасного источника, так что шарики начинают плавиться. Поверхностное натяжение заставляет расплавленный припой зафиксировать микросхему ровно над тем местом, где она должна находиться на плате. Сочетание определённого припоя, температуры пайки, флюса и паяльной маски не позволяет шарикам полностью деформироваться.
Разновидности
- FBGA: LFBGA, TFBGA, VFBGA, WFBGA, UFBGA
- FLGA: TFLGA, VFLGA, WFLGA
- PBGA: PBGA, PBGA-H, PBGA-MD
- Extremely Thin
- Array Packages
Преимущества
Высокая плотность
BGA — это решение проблемы производства миниатюрного корпуса ИС с большим количеством выводов. Массивы выводов при использовании поверхностного монтажа «две-линии-по-бокам» (SOIC) производятся всё с меньшим и меньшим расстоянием и шириной выводов для уменьшения места, занимаемого выводами, но это вызывает определённые сложности при монтаже данных компонентов. Выводы располагаются слишком близко, и растёт процент брака по причине спаивания припоем соседних контактов. BGA не имеет такой проблемы — припой наносится на заводе в нужном количестве и месте.
Теплопроводность
Следующим преимуществом перед микросхемами с ножками является лучший тепловой контакт между микросхемой и платой, что в некоторых случаях избавляет от установки теплоотводов, поскольку тепло уходит от кристалла на плату более эффективно (также, в некоторых случаях, по центру корпуса создаётся одна большая контактная площадка-радиатор, которая припаивается к дорожке-теплоотводу).
Если BGA-микросхемы рассеивают достаточно большие мощности и теплоотвод по всем шариковым выводам недостаточен, то к корпусу микросхемы прикрепляется (иногда приклеивается) радиатор. В качестве примера можно привести видеоплаты для ПК, микросхемы „северных мостов“ на материнских платах ПК и тд.
Малые наводки
Чем меньше длина выводов — тем меньше наводки и излучение. У BGA длина проводника очень мала, и может определяться лишь расстоянием между платой и микросхемой, так что применение BGA позволяет увеличить диапазон рабочих частот и, для цифровых приборов (см. Цифровая обработка сигналов), увеличить скорость обработки информации.
Недостатки

Негибкие выводы
Основным недостатком BGA является то, что выводы не являются гибкими. Например, при тепловом расширении или вибрации некоторые выводы могут сломаться. Поэтому BGA не является популярным в военной технике или авиастроении.
Отчасти эту проблему решает залитие микросхемы специальным полимерным веществом — компаундом. Он скрепляет всю поверхность микросхемы с платой. Одновременно компаунд препятствует проникновению влаги под корпус BGA-микросхемы, что особенно актуально для некоторой бытовой электроники (например, сотовых телефонов). Также осуществляется и частичное залитие корпуса, по углам микросхемы, для усиления механической прочности.
Дорогое обслуживание
Другим недостатком является то, что после того как микросхема припаяна, очень тяжело определить дефекты пайки. Обычно применяют рентгеновские снимки или специальные микроскопы, которые были разработаны для решения данной проблемы, но они дороги. Относительно недорогим методом локализации неисправностей, возникающих при монтаже, является периферийное сканирование. Если решено, что BGA неудачно припаяна, она может быть демонтирована термо-воздушным феном или с помощью инфракрасной паяльной станции; может быть заменена новой. В некоторых случаях из-за дороговизны микросхемы шарики восстанавливают с помощью паяльных паст и трафаретов; этот процесс называют
См. также
Ссылки
BGA — Википедия. Что такое BGA
BGA (англ. Ball grid array — массив шариков) — тип корпуса поверхностно-монтируемых интегральных микросхем.
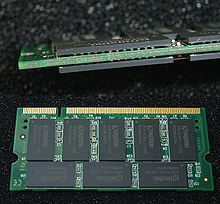 Здесь микросхемы памяти, установленные на планку, имеют выводы типа
Здесь микросхемы памяти, установленные на планку, имеют выводы типа  Разрез печатной платы с корпусом типа BGA. Сверху видно кремниевый кристалл.
Разрез печатной платы с корпусом типа BGA. Сверху видно кремниевый кристалл.BGA произошёл от PGA. BGA выводы представляют собой шарики из припоя, нанесённые на контактные площадки с обратной стороны микросхемы. Микросхему располагают на печатной плате, согласно маркировке первого контакта на микросхеме и на плате. Затем микросхему нагревают с помощью паяльной станции или инфракрасного источника, так что шарики начинают плавиться. Поверхностное натяжение заставляет расплавленный припой зафиксировать микросхему ровно над тем местом, где она должна находиться на плате и не позволяет шарикам деформироваться.
Разновидности
- FBGA: LFBGA, TFBGA, VFBGA, WFBGA, UFBGA
- FLGA: TFLGA, VFLGA, WFLGA
- PBGA: PBGA, PBGA-H, PBGA-MD
- Extremely Thin
- Array Packages
Преимущества
Высокая плотность
BGA — это решение проблемы производства миниатюрного корпуса ИС с большим количеством выводов. Массивы выводов при использовании поверхностного монтажа «две линии по бокам» (SOIC) производятся всё с меньшим и меньшим расстоянием и шириной выводов для уменьшения места, занимаемого выводами, но это вызывает определённые сложности при монтаже данных компонентов. Выводы располагаются слишком близко, и растёт процент брака по причине спаивания припоем соседних контактов. BGA не имеет такой проблемы — припой наносится на заводе в нужном количестве и месте.
Теплопроводность
Следующим преимуществом перед микросхемами с ножками является лучший тепловой контакт между микросхемой и платой, что в некоторых случаях избавляет от установки теплоотводов, поскольку тепло уходит от кристалла на плату более эффективно (также, в некоторых случаях, по центру корпуса создаётся одна большая контактная площадка-радиатор, которая припаивается к дорожке-теплоотводу).
Если BGA-микросхемы рассеивают достаточно большие мощности и теплоотвод по всем шариковым выводам недостаточен, то к корпусу микросхемы прикрепляется (иногда приклеивается) радиатор. В качестве примера можно привести видеоплаты для ПК, микросхемы «северных мостов» на материнских платах ПК и т. д.
Малые наводки
Чем меньше длина выводов, тем меньше наводки и излучение. У BGA длина проводника очень мала и может определяться лишь расстоянием между платой и микросхемой, так что применение BGA позволяет увеличить диапазон рабочих частот и, для цифровых приборов (см. Цифровая обработка сигналов), увеличить скорость обработки информации.
Недостатки

Негибкие выводы
Основным недостатком BGA является то, что выводы не являются гибкими. Например, при тепловом расширении или вибрации некоторые выводы могут сломаться. Поэтому BGA не популярен в военной технике или авиастроении.
Отчасти эту проблему решает залитие микросхемы специальным полимерным веществом — компаундом. Он скрепляет всю поверхность микросхемы с платой. Одновременно компаунд препятствует проникновению влаги под корпус BGA-микросхемы, что особенно актуально для некоторой бытовой электроники (например, сотовых телефонов). Также осуществляется и частичное залитие корпуса, по углам микросхемы, для усиления механической прочности.
Дорогое обслуживание
Другим недостатком является то, что после того как микросхема припаяна, очень тяжело определить дефекты пайки. Обычно применяют рентгеновские снимки или специальные микроскопы, которые были разработаны для решения данной проблемы, но они дороги. Относительно недорогим методом локализации неисправностей, возникающих при монтаже, является периферийное сканирование. Если решено, что BGA неудачно припаяна, она может быть демонтирована термовоздушным феном или с помощью инфракрасной паяльной станции; может быть заменена новой. В некоторых случаях из-за дороговизны микросхемы шарики восстанавливают с помощью паяльных паст и трафаретов; этот процесс называют
Невозможность замены
Если у ноутбука, например, в материнской плате центральный процессор имеет сокет такого форм-фактора, то в случае апгрейда или неисправности его замена невозможна. В этом случае нужно выпаивать старый процессор и запаивать новый, что экономически нецелесообразно (см. выше).
См. также
Ссылки
Монтаж BGA компонентов и микросхем под заказ в Санкт-Петерубрге
 Монтаж BGA компонентов характеризуется высокими требованиями к точности установки и качеству пайки, что связано с уникальностью их конструкции и отсутствием прямого доступа к местам пайки. BGA (от англ. BallGridArray) – это тип корпусов микросхем для поверхностного монтажа, снабженный матрицей шариковых выводов с повышенной плотностью.
Монтаж BGA компонентов характеризуется высокими требованиями к точности установки и качеству пайки, что связано с уникальностью их конструкции и отсутствием прямого доступа к местам пайки. BGA (от англ. BallGridArray) – это тип корпусов микросхем для поверхностного монтажа, снабженный матрицей шариковых выводов с повышенной плотностью.
Основные достоинства микросхем в BGA-корпусах:
- Выводы не подвержены деформации (изгибу).
- BGA-компоненты в процессе оплавления обладают эффектом самоцентрирования.
- Миниатюризация изделий — занимает меньше места на печатной плате, вместе с тем эффективно использует всю площадь под микросхемой.
- Низкопрофильность.
- Лучшие тепловые и электрические характеристики (сравнительно с большинством QFP-компонентов).
- Меньшее тепловое сопротивление между корпусом и печатной платой, малая индуктивность выводов.
Автоматический и ручной монтаж BGA
- Монтаж BGA, LGA, Flip Chip и CSP компонентов на линии автоматического монтажа. Используется при монтаже серийно выпускаемых изделий (обычно от 20-50 шт.).
- Монтаж BGA, LGA, Flip Chip и CSP компонентов с применением специализированного ремонтного центра Den-On RD-500S III, обеспечивающего качество автоматического монтажа при штучной установке. Используется при монтаже опытных партий или мелкосерийных изделий, когда применение полностью автоматического цикла экономически и/или технически не целесообразно.
Технический контроль. Реболлинг.
Отсутствие у таких микросхем конструктивных средств, обеспечивающих компенсацию механических напряжений, чревато появлением разрывов паяных соединений при малейшей деформации платы или при колебаниях температуры. Поэтому монтаж печатных узлов с BGA микросхемами зачастую нуждается в контроле качества с использованием специального оборудования — рентгеновских установок и специальных микроскопов.
Монтаж микросхем в корпусах BGA — одна из профессиональных услуг ПАНТЕС, которую мы предлагаем нашим партнерам по всей России (например, в таких городах как Москва, Киров, Казань, Новосибирск, Самара, Ростове-на-Дону, Нижний Новгород, Екатеринбург, Воронеж).
К услугам клиентов ПАНТЕС станция рентгеноскопического контроля DAGE, обеспечивающая мониторинг качества пайки BGA-компонентов (с предоставлением отчета) и неразрушающий контроль состояния различных электронных компонентов (BGA, CSP).
Помимо этого, специалисты компании квалифицированно выполнят демонтаж, реболлинг (восстановление шариков) BGA-корпусов, а также монтаж BGA микросхем на платы, где уже предустановленны другие электронные компоненты.
Монтаж многокристальных микросхем с использованием PoP технологии
 Технология Package-on-package (PoP, «корпус-на-корпусе») используется, как в производстве многослойных многокристальных микросхем, так и в поверхностном монтаже печатных плат. При этом методе монтажа один или несколько компонентов монтируются поверх друг друга. Основным преимуществом многокристальных корпусов является резкое увеличение степени интеграции. Это позволяет уменьшить размер и вес готового изделия и увеличить его функциональность. Другим преимуществом является уменьшение сложности и количества слоев в печатной плате и повышение качества изделия благодаря увеличению надежности.
Технология Package-on-package (PoP, «корпус-на-корпусе») используется, как в производстве многослойных многокристальных микросхем, так и в поверхностном монтаже печатных плат. При этом методе монтажа один или несколько компонентов монтируются поверх друг друга. Основным преимуществом многокристальных корпусов является резкое увеличение степени интеграции. Это позволяет уменьшить размер и вес готового изделия и увеличить его функциональность. Другим преимуществом является уменьшение сложности и количества слоев в печатной плате и повышение качества изделия благодаря увеличению надежности. А также это позволяет сократить длину проводников, что важно в системах с высокой скоростью передачи данных, для повышения помехозащищенности и увеличения быстродействия. Монтаж, основанный на PoP технологии, требует от производственного предприятия высокой технологичности. Данная технология успешно освоена на нашем производстве и предлагается как услуга контрактной сборки.
А также это позволяет сократить длину проводников, что важно в системах с высокой скоростью передачи данных, для повышения помехозащищенности и увеличения быстродействия. Монтаж, основанный на PoP технологии, требует от производственного предприятия высокой технологичности. Данная технология успешно освоена на нашем производстве и предлагается как услуга контрактной сборки.
Технология Underfill

 Технология Underfill применяется для микросхем с матрично-расположенных выводов (в том числе для BGA, CSP и т.д.) и предназначена для повышения надежности монтажа. Свободное пространство между выводами полностью заполняется компаундом с коэффициентом теплового расширения средним между платой и микросхемой. Благодаря этому компоненты (и паяные соединения) надежно защищены от ударных и вибрационных нагрузок (при этом дополнительно реализуется влагозащитная функция ).
Технология Underfill применяется для микросхем с матрично-расположенных выводов (в том числе для BGA, CSP и т.д.) и предназначена для повышения надежности монтажа. Свободное пространство между выводами полностью заполняется компаундом с коэффициентом теплового расширения средним между платой и микросхемой. Благодаря этому компоненты (и паяные соединения) надежно защищены от ударных и вибрационных нагрузок (при этом дополнительно реализуется влагозащитная функция ).
BGA — Википедия
Материал из Википедии — свободной энциклопедии
BGA (англ. Ball grid array — массив шариков) — тип корпуса поверхностно-монтируемых интегральных микросхем.
Здесь микросхемы памяти, установленные на планку, имеют выводы типа BGA Разрез печатной платы с корпусом типа BGA. Сверху видно кремниевый кристалл.BGA произошёл от PGA. BGA выводы представляют собой шарики из припоя, нанесённые на контактные площадки с обратной стороны микросхемы. Микросхему располагают на печатной плате, согласно маркировке первого контакта на микросхеме и на плате. Затем микросхему нагревают с помощью паяльной станции или инфракрасного источника так, что шарики начинают плавиться. Поверхностное натяжение заставляет расплавленный припой зафиксировать микросхему ровно над тем местом, где она должна находиться на плате и не позволяет шарикам деформироваться.
Разновидности
- FBGA: LFBGA, TFBGA, VFBGA, WFBGA, UFBGA
- FLGA: TFLGA, VFLGA, WFLGA
- PBGA: PBGA, PBGA-H, PBGA-MD
- Extremely Thin
- Array Packages
Преимущества
Высокая плотность
BGA — это решение проблемы производства миниатюрного корпуса ИС с большим количеством выводов. Массивы выводов при использовании поверхностного монтажа «две линии по бокам» (SOIC) производятся всё с меньшим и меньшим расстоянием и шириной выводов для уменьшения места, занимаемого выводами, но это вызывает определённые сложности при монтаже данных компонентов. Выводы располагаются слишком близко, и растёт процент брака по причине спаивания припоем соседних контактов. BGA не имеет такой проблемы — припой наносится на заводе в нужном количестве и месте.
Недостатки
Негибкие выводы
Основным недостатком BGA является то, что выводы не являются гибкими. Например, при тепловом расширении или вибрации некоторые выводы могут сломаться. Поэтому BGA не популярен в военной технике или авиастроении.
Отчасти эту проблему решает залитие микросхемы специальным полимерным веществом — компаундом. Он скрепляет всю поверхность микросхемы с платой. Одновременно компаунд препятствует проникновению влаги под корпус BGA-микросхемы, что особенно актуально для некоторой бытовой электроники (например, сотовых телефонов). Также осуществляется и частичное залитие корпуса, по углам микросхемы, для усиления механической прочности.
Дорогое обслуживание
Другим недостатком является то, что после того как микросхема припаяна, очень тяжело определить дефекты пайки. Обычно применяют рентгеновские снимки или специальные микроскопы, которые были разработаны для решения данной проблемы, но они дороги. Относительно недорогим методом локализации неисправностей, возникающих при монтаже, является периферийное сканирование. Если решено, что BGA неудачно припаяна, она может быть демонтирована термовоздушным феном или с помощью инфракрасной паяльной станции; может быть заменена новой. В некоторых случаях из-за дороговизны микросхемы шарики восстанавливают с помощью паяльных паст и трафаретов; этот процесс называют ребо́ллинг, от англ. reballing.
Невозможность замены
Если у ноутбука, например, в материнской плате центральный процессор имеет сокет такого форм-фактора, то в случае апгрейда или неисправности его замена без специального оборудования невозможна, так как в этом случае нужно выпаивать старый процессор и запаивать новый, не повредив плату, не задев и не перегрев установленные рядом элементы.
См. также
Ссылки
CORE — BGA и SMD монтаж
BGA и SMD монтаж
Ниже представлена блок схема одной из архитектур современного компьютера/ноутбука.

Как можно увидеть из схемы, весь компьютер состоит из нескольких основных центральных блоков (обведены красным): южный мост (ICh20),северный мост (P43), центральный процессор Intel и блок обработки графики (видеокарта). В «железе» эти блоки представляют собой большие, очень сложные интегральные микросхемы (ИС), с огромным количеством выводов.
Как видно на рисунке, выводы таких ИС — шарики припоя, нанесенные на корпус микросхемы, BGA (англ. Ball grid array — массив шариков) — тип корпуса поверхностно-монтируемых интегральных микросхем.
Установка такой микросхемы проходит в несколько этапов, микросхему располагают на печатной плате, согласно маркировке ответных контактных площадок на плате, далее зону установки микросхемы нагревают до температуры плавления припоя, силы поверхностного натяжения расплавленного припоя заставляют микросхему зафиксироваться четко над тем местом, где она должна находиться на плате.
Установленная ИС на плату:

Так выглядит ИС на плате в разрезе, видны шары припоя, на которых впаяна ИС и слои меди в плате:

Основное преимущество BGA монтажа – высокая плотность размещения контактов на ИС небольших размеров, вместе с этим это является и самым слабым местом — высокая чувствительность к механическим нагрузкам, будь то вибрационные, ударные, либо же, нагрузки, возникающие в процессе теплового расширения корпуса ИС и платы на которую она впаяна. Вследствии таких воздействий, контакт между шариками припоя и платой нарушается, и устройство перестает работать, проще говоря, шарики отрываются от контактных площадок. Стоит заметить, что некачественный монтаж микросхемы на заводе производителя или в ремонтной мастерской так же может стать причиной нарушения контактов и выхода из строя устройства. В интернете встречаются несколько названий такого дефекта: отвал, недопай, микротрещины в пайке (холодная пайка) и пр.
C помощью оптических приборов, можно собственными глазами увидеть, как выглядят такие дефекты: недопай, холодные трещины.
Устранение такого дефекта пайки возможно при наличии соответствующего оборудования. Проходит в 3 этапа:
1) Демонтаж ИС на специальной инфракрасной или термовоздушной паяльной станции.

2) Нанесение новых шаров припоя, с помощью трафарета и оснастки, с последующим оплавлении в ИК печи.


3) Завершающий этап – установка ИС на плату.

Весь процесс называется реболл, реболлинг, после такой процедуры, как правило, причина неисправности устраняется и устройство вновь готово к эксплуатации. Однако, не всегда реболл по настоящему устраняет дефект, даже если устройство заработало вновь, эффект этот кратковременен. Происходит такое по причине того что дефект кроется не в монтаже, а внутри самого чипа, в таком случае, микросхему нужно только менять.
Почему чип нужно именно менять, подробно описано в следующей статье.
Типы корпусов процессоров — это… Что такое Типы корпусов процессоров?
Типы корпусов процессоров
После изготовления кристалла с ядрами и дополнительными схемами (например кешем), перед отгрузкой потребителю, процессор упаковывется в защитный корпус. Тип корпуса выбирается в зависимости от назначения системы, в которой будет работать процессор.
DIP
Основная статья: DIP Процессор в корпусе CDIP-40
Процессор в корпусе CDIP-40  Процессор в корпусе PDIP-40
Процессор в корпусе PDIP-40DIP (Dual Inline Package) — корпус с двумя рядами контактов. Представляет собой прямоугольный корпус с расположенными на длинных сторонах контактами. В зависимости от материала корпуса выделяют два варианта исполнения:
- PDIP (Plastic DIP) — имеет пластиковый корпус;
- CDIP (Ceramic DIP) — имеет керамический корпус;
Некоторые процессоры, выполненные в корпусе DIP:
- 4004 — 16-контактный CDIP.
- Z80, КР1858ВМ1, КМ1858ВМ1 — 40-контактный DIP.
- 8080, 8085, КР580ВМ80А — 40-контактный DIP.
- 680x, 650x — 40-контактный DIP.
- M68k — 64-контактный DIP.
- 8088, 8086 — 40-контактный DIP.
QFP
Основная статья: QFP Процессор в корпусе TQFP-304
Процессор в корпусе TQFP-304QFP (Quad Flat Package) — плоский корпус с четырьмя рядами контактов. Представляет собой прямоугольный корпус с расположенными по краям контактами. В зависимости от материала корпуса выделяют два варианта исполнения:
- PQFP (Plastic QFP) — имеет пластиковый корпус;
- CQFP (Ceramic QFP) — имеет керамический корпус;
Существуют также другие варианты: TQFP (Thin QFP) — с малой высотой корпуса, LQFP (Low-profile QFP) и многие другие.
Некоторые процессоры, выполненные в корпусе QFP:
- Т34ВГ1 — 64-контактный PQFP.
- Am188ES — 100-контактный TQFP.
- NG80386SX — 100-контактный PQFP.
- Cx486SLC — 100-контактный CQFP.
- PowerPC 601 — 304-контактный TQFP.
PLCC/CLCC
 Процессор в корпусе PLCC-68
Процессор в корпусе PLCC-68PLCC (Plastic Leaded Chip Carrier) и СLCC (Ceramic Leaded Chip Carrier) представляют собой квадратный корпус с расположенными по краям контактами, предназначенный для установки в специальную панель (часто называемую «кроваткой»). В настоящее время широкое распространение получили микросхемы флэш-памяти в корпусе PLCC, используемые в качестве микросхемы BIOS на системных платах.
Некоторые процессоры, выполненные в корпусе PLCC:
- M68k — 68-контактный PLCC.
- N80C186 — 68-контактный PLCC.
- CS80C286 — 68-контактный PLCC.
- N80286 — 68-контактный PLCC.
Аббревиатура LCC используется для обозначения Leadless Chip Carrier, поэтому для того, чтобы избежать путаницы, в данном случае необходимо называть аббревиатуры PLCC и CLCC полностью, без сокращений.
LCC
LCC (Leadless Chip Carrier) представляет собой низкопрофильный квадратный керамический корпус с расположенными на его нижней части контактами, предназначенный для поверхностного монтажа.
Некоторые процессоры, выполненные в корпусе LCC:
- R80186 — 68-контактный LCC.
- R80286 — 68-контактный LCC.
- SAB80188R — 68-контактный LCC.
PGA
Процессор в корпусе CPGA Процессор в корпусе FCPGA Процессор в корпусе FCPGA2
Процессор в корпусе FCPGA Процессор в корпусе FCPGA2PGA (Pin Grid Array) — корпус с матрицей выводов. Представляет собой квадратный или прямоугольный корпус с расположенными в нижней части штырьковыми контактами. В современных процессорах контакты расположены в шахматном порядке. В зависимости от материала корпуса выделяют три варианта исполнения:
- PPGA (Plastic PGA) — имеет пластиковый корпус;
- CPGA (Ceramic PGA) — имеет керамический корпус;
- OPGA (Organic PGA) — имеет корпус из органического материала;
Существуют следующие модификации корпуса PGA:
- FCPGA (Flip-Chip PGA) — в данном корпусе открытый кристалл процессора расположен на верхней части корпуса.
- FCPGA2 (Flip-Chip PGA 2) — отличается от FCPGA наличием теплораспределителя, закрывающего кристалл процессора.
- μFCPGA (Micro Flip-Chip PGA) — компактный вариант корпуса FCPGA.
- μPGA (Micro PGA) — компактный вариант корпуса FCPGA2.
Для обозначения корпусов с контактами, расположенными в шахматном порядке иногда используется аббревиатура SPGA (Staggered PGA).
Некоторые процессоры, выполненные в корпусе PGA:
- 80386DX — 132-контактный CPGA.
- 80486DX, 80486SX — 168-контактный CPGA.
- Pentium — 296-контактный CPGA, 321-контактный CPGA или PPGA.
- Pentium Pro — 387-контактный SPGA.
- Pentium MMX, K6, 6×86 — 321-контактный CPGA или PPGA.
- Celeron — 370-контактный CPGA, PPGA, FCPGA или FCPGA2, 423-контактный FCPGA2, 478-контактный μPGA.
- Pentium III — 370-контактный FCPGA или FCPGA2.
- Pentium 4 — 423-контактный FCPGA2, 478-контактный μPGA.
- Athlon — 462-контактный керамический или органический FCPGA.
- Duron — 462-контактный керамический или органический FCPGA.
- Sempron — 462-контактный FCPGA, 754-контактный FCPGA2, 939-контактный FCPGA2, 940-контактный FCPGA2.
- Athlon 64 — 754-контактный FCPGA2, 939-контактный FCPGA2, 940-контактный FCPGA2.
- Opteron — 940-контактный FCPGA2, 1207-контактный FCPGA2.
BGA
Основная статья: BGABGA (Ball Grid Array) — представляет собой корпус PGA, в котором штырьковые контакты заменены на шарики припоя. Предназначен для поверхностного монтажа. Чаще всего используется в мобильных процессорах, чипсетах и современных графических процессорах. Существуют следующие варианты корпуса BGA:
- FCBGA (Flip-Chip BGA) — в данном корпусе открытый кристалл процессора расположен на верхней части корпуса, изготовленного из органического материала.
- μBGA (Micro BGA) и μFCBGA (Micro Flip-Chip BGA) — компактные варианты корпуса.
- HSBGA
Некоторые процессоры, выполненные в корпусе BGA:
LGA
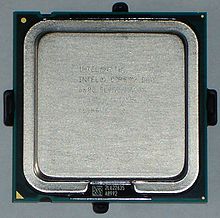 Процессор в корпусе FCLGA4
Процессор в корпусе FCLGA4LGA (Land Grid Array) — представляет собой корпус PGA, в котором штырьковые контакты заменены на контактные площадки. Может устанавливаться в специальное гнездо, имеющее пружинные контакты, либо устанавливаться на печатную плату. В зависимости от материала корпуса выделяют три варианта исполнения:
- CLGA (Ceramic LGA) — имеет керамический корпус;
- PLGA (Plastic LGA) — имеет пластиковый корпус;
- OLGA (Organic LGA) — имеет корпус из органического материала;
Существует компактный вариант корпуса OLGA с теплораспределителем, имеющий обозначение FCLGA4.
Некоторые процессоры, выполненные в корпусе LGA:
- UltraSPARC II — 787-контактный CLGA.
- Pentium II — 528-контактный PLGA (помещённый на печатную плату).
- Pentium III — 495-контактный OLGA (помещённый на печатную плату), 570-контактный OLGA (помещённый на печатную плату).
- Pentium 4, Pentium D, Core 2 Duo — 775-контактный FCLGA4.
- Opteron для Socket F и Socket G34
Картриджи
 Процессор в корпусе SECC
Процессор в корпусе SECC  Процессор в корпусе SECC2
Процессор в корпусе SECC2  Процессор Itanium 2 в корпусе PAC
Процессор Itanium 2 в корпусе PACПроцессорные картриджи представляют собой печатную плату с установленными на ней процессором и вспомогательными элементами. Существует несколько видов процессорных картриджей:
- SECC (Single Edge Contact Cartridge) — полностью закрытый картридж с теплоотводной пластиной, обеспечивающей тепловой контакт между корпусом картриджа и процессором.
- SECC2 (Single Edge Contact Cartridge) — картридж без теплоотводной пластины.
- SEPP (Single Edge Processor Package) — полностью открытая печатная плата.
- MMC (Mobile Module Connector) — картридж с открытым кристаллом процессора, предназначенный для мобильных компьютеров.
Некоторые процессоры, выполненные в картриджах:
См. также
Ссылки
BGA — это… Что такое BGA?
Bga — Cette page d’homonymie répertorie les différents sujets et articles partageant un même nom. {{{image}}} Sigles d une seule lettre Sigles de deux lettres > Sigles de trois lettres … Wikipédia en Français
BGA — can refer to:* Ball Grid Array, a type of surface mount packaging used for integrated circuits * Battle Ground Academy, a private school in Franklin, Tennessee, USA * Behavior Genetics Association * BGA, a bank in Honduras acquired by HSBC in… … Wikipedia
BGA — [Abk. für Ball Grid Array, dt. »Kugelgitteranordnung«,] das, die Ausführung der Kontakte eines Chips in Form winziger Kügelchen und deren Anordnung in Reihen. BGA Prozessoren werden mit diesen Kontaktkügelchen auf der Systemplatine festgelötet; … Universal-Lexikon
BGA — Проверить информацию. Необходимо проверить точность фактов и достоверность сведений, изложенных в этой статье. На странице обсуждения идёт дискуссия на тему: Защита от доступа к выводам. BGA (англ. Ball grid array массив шариков) тип корпуса … Википедия
BGA — Die Abkürzung BGA steht für: Bundesgesundheitsamt, eine inzwischen aufgelöste Einrichtung der Bundesrepublik Deutschland. Bundesverband des deutschen Groß und Außenhandels. Ball Grid Array, eine Gehäusebauform bei integrierten Schaltkreisen. das… … Deutsch Wikipedia
Bga — Die Abkürzung BGA steht für: Bundesgesundheitsamt, eine inzwischen aufgelöste Einrichtung der BRD. Bundesverband des deutschen Groß und Außenhandels. Ball Grid Array, eine Gehäusebauform bei integrierten Schaltkreisen. das eher in Japan… … Deutsch Wikipedia
BGA — Cette page d’homonymie répertorie les différents sujets et articles partageant un même nom. Sigles d’une seule lettre Sigles de deux lettres > Sigles de trois lettres Sigles de quatre lettres … Wikipédia en Français
BGA — Ball Grid Array (Academic & Science » Electronics) * Battle Ground Academy (Academic & Science » Universities) * Behavior Genetics Association (Medical » Human Genome) * British Go Association (Community » Sports) * Banco Ganadero, S. A.… … Abbreviations dictionary
BGA P — Banco Ganadero, S. A. Preferred (Business » NYSE Symbols) … Abbreviations dictionary
BGA — blue green algae … Medical dictionary
BGA — • Ball Grid Array • Bucaramanga, Colombia internationale Flughafen Kennung … Acronyms

