Ключевой режим работы биполярного транзистора
Характер переходных процессов в транзисторе зависит от схемы включения и внутреннего сопротивления источников сигнала. Наибольшее распространение нашла схема ОЭ, поскольку она позволяет получить усиление по току. На рис.5 приведена схема простейшего транзисторного ключа. На рис.6 показано семейство статических выходных характеристик транзистора в схеме с ОЭ, нагрузочная характеристика и расположение рабочих точек А и В. Имеются три характерные области работы транзистора:
о бласть
выключения (отсечки)I,
область активного режима II
и область насыщения III.
В ключевых схемах транзистор находится
в активном режиме лишь в переходном
состоянии. В области насыщения коллекторный
переход смещен в прямом направлении и
инжектирует носители в базу, граница
между областями II
и III
определяется условием
бласть
выключения (отсечки)I,
область активного режима II
и область насыщения III.
В ключевых схемах транзистор находится
в активном режиме лишь в переходном
состоянии. В области насыщения коллекторный
переход смещен в прямом направлении и
инжектирует носители в базу, граница
между областями II
и III
определяется условием
Если на базу подано запирающее (положительное для p-n-p-транзистора) напряжение Eб2, то ток базы равен Iб≈-Iкбо, а ток коллектора I’к=Iкбо К коллекторному переходу приложено напряжение:
Uк = EK– I‘к Rк≈ Eк
Рабочая точка на выходной характеристике находится в положении
Uк Eк; Uб Еб2 | (6) |
При подаче в цепь базы отпирающего тока Iб1 рабочая точка перемещается в положение B, в цепи коллектора протекает ток Iкн и напряжение коллектора становится равным
Uкн
Статические параметры ключа: остаточное напряжение Uкн во включенном состоянии (рис.6, точка В) и остаточный ток в выключенном (запертом) состоянии (точка А). В точке В токи электродов определяются параметрами внешних цепей:
Iб1 Еб1 Rб; Iкн Ек/ Rк; |
Для перевода в режим насыщениянеобходимо выполнить условие
или, что то же
где В=Iкн/Iбн – коэффициент усиления тока базы в режиме большого сигнала. Силу неравенства (8) характеризуют особым параметром – степенью насыщения S:
S=Iб1/Iбн (9)
Рассмотрим переходные процессы, происходящие при переключении ключа из состояния «выключено» в состояние «включено» и обратно. Временные диаграммы напряжений, токов накопленного заряда базы при включении и выключении транзисторного ключа приведены на рис.7.
В исходном состоянии транзистор закрыт
положительным напряжениемЕб2.
Процесс отпирания транзистора при
подаче на базу отрицательного напряжения Еб1можно
разделить на три этапа: задержка фронта,
формирование фронта и накопление заряда.
Этап задержки фронта обусловлен зарядом
входной емкости запертого транзистора
от значения Еб2 до напряжения
открывания транзистора U*
(для кремниевого транзистора U*
0,6B,
для германиевого U*
0,2B).
Этот процесс протекает с постоянной
времени
исходном состоянии транзистор закрыт
положительным напряжениемЕб2.
Процесс отпирания транзистора при
подаче на базу отрицательного напряжения Еб1можно
разделить на три этапа: задержка фронта,
формирование фронта и накопление заряда.
Этап задержки фронта обусловлен зарядом
входной емкости запертого транзистора
от значения Еб2 до напряжения
открывания транзистора U*
(для кремниевого транзистора U*
0,6B,
для германиевого U*
0,2B).
Этот процесс протекает с постоянной
времени
c=RбСвх (10)
Входную емкость обычно принимают равной сумме барьерных емкостей эмиттерного и коллекторного переходов:
Cвх = Сэ бар+ Ск бар (11)
Время задержки фронта tзф можно определять по формуле:
 (12)
(12)
В момент t1 открывается эмиттерный переход и начинается инжекция носителей в базу, транзистор переходит в активный режим. На этом этапе коллекторный ток возрастает до значения
| (13) |
где –
время жизни неосновных носителей в
базе: —
усредненная емкость коллекторного
перехода. Длительность фронтаtф
—
усредненная емкость коллекторного
перехода. Длительность фронтаtф
| (14) |
при S >> 1 формула (14) упрощается:
В конце этапа формирования фронта в базе транзистора накапливается заряд Qгр, а напряжение на переходе коллектор – база падает до нуля. После того, как транзистор начал работать в режиме насыщения, заметных внешних изменений в схеме ключа не происходит. Однако продолжается накопление заряда, причём на данном этапе заряд накапливается не только в базовом, но и в коллекторном слое. В конце этапа стационарный заряд
Qст = Iб1 | (16) |
где  – среднее время жизни носителей в
базовом и коллекторном слоях. Длительность
этого процесса составляет примерно 3
– среднее время жизни носителей в
базовом и коллекторном слоях. Длительность
этого процесса составляет примерно 3
 ,
накопленный заряд будет меньше
стационарного значения.
,
накопленный заряд будет меньше
стационарного значения.Процесс выключения транзистора начинается в момент t3 (рис.7), когда на базу подаётся запирающее напряжение. В момент переключения на обоих p—n-переходах сохраняются прямые смещения, близкие к U*. При этом коллекторный ток не меняется и остаётся равным Iкн. Базовый ток принимает значение:
Iб2 = —(Еб2+U*)/ Rб | (17) |
На первом этапе процесса выключения происходит рассасывание накопленного заряда током Iб2. Окончание этапа рассасывания характеризуется тем, что концентрация избыточных носителей на коллекторной границе базы падает до нуля и на коллекторном переходе восстанавливается обратное напряжение. Только после этого может начаться уменьшение коллекторного тока и формирование среза импульса. Длительность этого процесса называется временем рассасывания
| (18) |
Если запирающий ток настолько мал, что выполняются условия Iб2<< Iб1, Iб2<< Iбн
| (19) |
По
окончании этапа рассасывания начинается
последний этап переходного процесса –
запирание транзистора. Длительность
запирания обычно определяется процессом
заряда коллекторной ёмкости, протекающей
с постоянной времени  ,
длительность среза по уровнюIк= 0,1Iкн равна
,
длительность среза по уровнюIк= 0,1Iкн равна
| (20) |
Общая инерционность транзисторного ключа характеризуется временами включения tвкл и выключения tвыкл:
tвкл= tзф + tф; | (21) |
tвыкл= tр + tс; | (22) |
При практическом определении времён tзф, tф, tр, tс обычно используются уровни 0,1Iкн и 0,9Iкн
1.2 Ключевой режим работы биполярных транзисторов
Транзисторная импульсная и цифровая техника базируется на работе транзистора в качестве ключа. Замыкание и размыкание цепи нагрузки — главное назначение транзистора, работающего в ключевом режиме. По аналогии с механическим ключом (реле, контактором), качество транзисторного ключа определяется в первую очередь падением напряжения (остаточным напряжением) на транзисторе в замкнутом (открытом) состоянии, а также остаточным током транзистора в выключенном (закрытом) состоянии.
Важность рассмотрения свойств транзисторного ключа для уяснения последующего материала вытекает из того, что путем изменения состояний транзистора в последовательной цепи с резистором и источником питания осуществляются, по сути дела, формирование сигналов импульсной формы, а также различные преобразования импульсных сигналов в схемах и узлах импульсной техники. Транзистор применяют также в качестве бесконтактного ключа в цепях постоянного и переменного токов для регулирования мощности, подводимой к нагрузке.
Основой всех узлов и схем импульсной и цифровой техники является так называемая ключевая схема — каскад на транзисторе, работающем в ключевом режиме. Построение ключевой схемы подобно усилительному каскаду. Транзистор в ключевой схеме может включаться с общей базой, общим эмиттером и общим коллектором. Наибольшее распространение получила схема ОЭ. Этот вид включения биполярного транзистора и используется далее при рассмотрении ключевого режима его работы.

Рисунок 1.3 — Ключевая схема на транзисторе (а), графическое определение режимов открытого и закрытого состояний транзистора (б)
Ключевая схема на транзисторе типа р-п-рпоказана на рисунке 1.3,а. Транзистор Т выполняет функцию ключа в последовательной цепи с резисторомRKи источником питания.
Для удобства рассмотрения процессов в схеме в режимах открытого и закрытого состояний транзистора воспользуемся графоаналитическим методом, основанным на построении линии нагрузки а — бпо постоянному току (рисунок 1.3,б). Линия нагрузки описывается соотношениемUкэ= -(Ек—IкRк) и проводится так же, как для усилительного каскада. Точки пересечения линии нагрузки с вольт-амперными характеристиками транзистора определяют напряжения на элементах и ток в последовательной цепи.
Режим запирания (режим отсечки) транзистора осуществляется подачей на его вход напряжения положительной полярности (Uвх> 0), указанной на рисунке 1.3,абез скобок. Под действием входного напряжения эмиттерный переход транзистора запирается (Uбэ> 0) и его токIэ= 0. Вместе с тем через резисторRбпротекает обратный (тепловой) ток коллекторного переходаIк0. Режиму закрытого состояния транзистора соответствует точкаМз(рисунок 1.3,б).
Протекание через нагрузку теплового тока Iк0связано с тем, что транзистор в закрытом состоянии не обеспечивает полного отключения нагрузочного резистораRкот источника питания. Малое значениеIк0является одним из критериев выбора транзистора для ключевого режима работы.
Величину запирающего входного напряжения Uвх.зanвыбирают из расчета того, чтобы при протекающем через резисторRбтепловом токе было обеспечено выполнение условия
| (1.1) |
Напряжение U6эдля германиевых транзисторов составляет 0,5 — 2 В.
Режим открытого состояния транзистора достигается изменением полярности входного напряжения (Uвх< 0) и заданием соответствующего тока базы. Открытое состояние транзистора характеризует точкаМона линии нагрузки.
Определим необходимые условия для создания открытого состояния транзистора. С этой целью предположим, что при Uвх< 0 ток базыIбувеличивается постепенно.
Увеличению тока базы будет соответствовать увеличение тока коллектора и перемещение рабочей точки из положения Мзвверх по линии нагрузки. НапряжениеUкэтранзистора при этом постепенно уменьшается.
До некоторого граничного значения тока базы (Iб.гр) сохраняется известная пропорциональная зависимость междуIкиIб:
| (1.2) |
где βст— статический (усредненный) коэффициент передачи тока транзистора в схеме ОЭ (а не дифференциальный коэффициентβ, действительный для малого входного сигнала). Точка Мопри токе базыIб.грхарактеризует «полное» открытие транзистора. Через транзистор и резисторRкпротекает ток
| (1.3) |
где  Uкэ.откр — падение напряжения (остаточное
напряжение) на транзисторе в открытом
состоянии.
Uкэ.откр — падение напряжения (остаточное
напряжение) на транзисторе в открытом
состоянии.
Остаточное напряжение  Uкэ.откр,
являющееся существенным параметром
транзистора в импульсном режиме работы,
должно быть минимальным. В зависимости
от типа прибора напряжение
Uкэ.откр,
являющееся существенным параметром
транзистора в импульсном режиме работы,
должно быть минимальным. В зависимости
от типа прибора напряжение Uкэ.открлежит в пределах 0,05—1 В. Ввиду относительно
малого остаточного напряжения по
сравнению сЕкрасчет токаIкоткрытого транзистора проводится по
формуле
Uкэ.открлежит в пределах 0,05—1 В. Ввиду относительно
малого остаточного напряжения по
сравнению сЕкрасчет токаIкоткрытого транзистора проводится по
формуле
| (1.4) |
С учетом формулы (1.2) находят граничное значение тока базы Iб.гроткрытого транзистора, при котором наблюдается пропорциональная зависимость тока коллектора от тока базы:
| (1.5) |
Таким образом, точка Мона рисунке 1.3,бпредставляет собой точку пересечения линии нагрузки с начальным участком коллекторной характеристики транзистора приIб=Iб.гр.
При дальнейшем увеличении тока базы
(Iб>Iб.гр)
остаточное напряжение Uкэ.откр остается почти неизменным, так как
все коллекторные характеристики
транзистора приIб>Iб.грпрактически проходят через точкуМона рисунке 1.3,б. Режим работы открытого
транзистора приIб>Iб.грназывают насыщенным, а отношениеs=Iб/Iб.гр— коэффициентом насыщения транзистора.
Uкэ.откр остается почти неизменным, так как
все коллекторные характеристики
транзистора приIб>Iб.грпрактически проходят через точкуМона рисунке 1.3,б. Режим работы открытого
транзистора приIб>Iб.грназывают насыщенным, а отношениеs=Iб/Iб.гр— коэффициентом насыщения транзистора.
Режим насыщения широко используют для обеспечения открытого состояния транзистора. Его открытое состояние при этом становится более устойчивым к воздействию помех во входной цепи, а положение точки Моне зависит от изменения коэффициента передачи токаβсттранзистора, в частности, с понижением температуры. В режиме насыщения ток базы транзистора
| (1.6) |
где коэффициент sдля надежного насыщения транзистора в требуемом температурном диапазоне может составлять 1,5—3. Найденный ток базы обеспечивается параметрами входной цепи ключевой схемы:
| (1.7) |
Рассмотрим процессы, протекающие в ключевой схеме при наличии на ее входе управляющего импульса напряжения (рисунок 1.4,а). Это необходимо для выяснения свойств схемы при передаче импульсных сигналов. Примем входной импульс напряжения идеальной прямоугольной формы (длительности переднего и заднего фронтов импульса равны нулю).
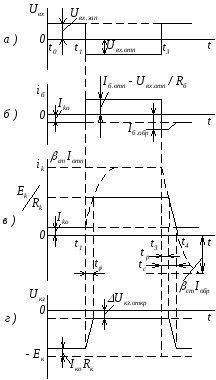
а— входной импульс напряжения;б— ток базы;в— ток коллектора;
г— напряжение на коллекторе
Рисунок 1.4 — Диаграммы напряжений и токов ключевой схемы
На интервале t0—t1, когда входной импульс напряжения отсутствует, транзистор заперт напряжениемUвх.запположительной полярности. ТокиIб,Iк. определяются тепловым током транзистораIк0(рисунок 1.4,б,в). Напряжение на транзистореUкэ= — (Ек—Iк0Rк) (рисунок 1.4,г).
С момента времени t1(рисунок 1.4,а) процессы в схеме
обусловливаются отпиранием транзистора
входным импульсом напряжения отрицательной
полярностиUвх.отп.
Это сопровождается изменением токаiки напряженияuкэтранзистора (рисунок 1.4,в, г). Как
видно из диаграмм, характер измененияiкиuкэпри отпирании транзистора отличается
от вызвавшего их скачкообразного
изменения входного напряжения. Отличие
обусловлено инерционностью транзистора
и проявляется в постепенных нарастании
токаiки
уменьшении напряженияuкэ.
В первом приближении можно принять, что
измененияiк(t)
иuкэ(t)
происходят по экспоненте. Тогда
инерционность транзистора может быть
учтена эквивалентной постоянной времениτв=τβ+τкв предположенииτк= к(э)Rк, где
к(э)Rк, где к(э)—интегральная (для большого сигнала)
емкость коллекторного перехода
транзистора в схеме ОЭ.
к(э)—интегральная (для большого сигнала)
емкость коллекторного перехода
транзистора в схеме ОЭ.
Если принять, что ток базы в интервале отпирания имеет прямоугольную форму с амплитудой Iб.отп ≈Uвх.отп/Rб>Iб.гр(рисунок 1.4,б), то вызванный им токiк(t) будет изменяться по закону
| (1.8) |
Коллекторный ток возрастает по экспоненциальному закону, стремясь к βстIб.отп>Eк/Rк(см. рисунок 1.4,в). Однако, достигнув предельного значенияIк≈Eк/Rк, токiкв дальнейшем не изменяется и формирование фронта импульсаiкзаканчивается.
Положив в формуле (1.8) iк=Iк, находим длительность фронта нарастания коллекторного тока транзистора:
| (1.9) |
С
учетом того, что | |
| (1.10) |
Из соотношения (1.10), следует, что длительность фронта импульса сокращается с увеличением коэффициента насыщения транзистора. Это объясняется тем, что большему коэффициенту sсоответствует больший отпирающий базовый ток, вследствие чего ток коллектора достигает установившегося значения за меньший интервал времени. Так, например, приτв= 5 мкс иs= 3 получаемtф= 2,03 мкс.
При s= 1 (транзистор при отпирании работает в активном режиме) соотношение (1.10) не может быть использовано для определенияtф. В этом случае уместно говорить об активной длительности фронта, определяемой относительно уровней 0,1 и 0,9 установившегося значения коллекторного тока (1.8):tф=τвln0,9/0,1 = 2,2 τв.
Характер изменения. uкэ(t) при отпирании транзистора (рисунок 1.4,г) подчиняется зависимостиuкэ(t) = -Ек +iк(t)Rк. В момент времениt3действие входного отпирающего импульса напряжения заканчивается. К базе транзистора прикладывается запирающее напряжениеUвх.зап (рисунок 1.4,а).
С приложением запирающего напряжения ток коллектора и напряжение uкэв течение некоторого интервала времени остаются неизменными, а транзистор по-прежнему открыт. Создается задержка в запирании транзистора. Это объясняется тем, что до момента времениt3транзистор находился в режиме насыщения и при поступлении запирающего сигнала ток коллектора еще поддерживается уходящими .из базы в коллектор избыточными носителями заряда (дырками). Только после ухода (рассасывания) избыточных носителей и перехода транзистора в активный режим ток коллектора начинает уменьшаться, а напряжение на коллекторе — возрастать (рисунок 1.4,в,г). Помимо ухода избыточных носителей заряда по цепи коллектора их рассасывание осуществляется и по цепи базы за счет протекания обратного токаIб.обр, вызванного запирающим напряжением. Обратный (инверсный) ток базы при этом ограничивается сопротивлениемRбвходной цепи:Iб.обр≈Uвх.зап/Rб.
Время, в течение которого происходит рассасывание избыточного заряда в базе, называется временем рассасывания tр(рисунок 1.4,в). Это время пропорционально коэффициенту насыщенияs. Следующий затем интервал спадания токаiкопределяет время заднего фронта (среза) tсколлекторного тока.
При определении tpиtcнеобходимо решать уравнение, описывающее изменение заряда в базе. Ввиду пропорциональности заряда в базе току коллектора (базы) процесс, протекающий в транзисторе после момента времениt3, выражается через токи транзистора в следующем виде:
| (1.11) |
где τβ’— эквивалентная постоянная времени, примерно равная времени жизни неосновных носителей заряда в базе в режиме насыщения, но меньше постоянной времениτβ, действительной для активного режима (τβ’≈τβ/2).
Выражение (1.11) является уравнением экспоненциальной кривой, показанной в интервале t3 — t4пунктиром (рисунок 1.4,в).
Положив в выражении (4.11) iк=Iк≈Eк/Rк=βстIб.гр, находим
| (1.12) |
При | |
| (1.13) |
После выхода транзистора из насыщения ток iк(t)уменьшается от значенияIк, также стремясь к —βстIб.гр(рисунок 1.4,в), т. е.
| (1.14) |
Положив в формуле (1.14) iк= 0, получаем
| (1.15) |
Длительности tф,tp,tcхарактеризуют быстродействие транзисторного ключа. Как следует из выражений (1.9), (1.12), (1.15), они зависят от частотных свойств используемого транзистора и параметров импульса базового тока. Порядок их величин составляет от долей единицы до единиц микросекунды.
В настоящее время широко используется (особенно в интегральных микросхемах) ключевой режим работы кремниевых транзисторов типа п-р-п.
По построению и характеру работы ключевая схема на транзисторе типа п-р-паналогична схеме рисунка 1.3,а. Отличие заключается в противоположных полярностях напряжения питанияЕки отпирающего напряженияUвх.отп, а также в противоположных направлениях токов базы, эмиттера, коллектора.
Кремниевые транзисторы, в частности типа п-р-п, имеют довольно малый тепловой токIк0. Влияние токаIк0в выходной и входной цепях закрытого транзистора пренебрежимо мало. По этой причине запирание этих транзисторов осуществимо приUвх.зап=Uбэ= 0. Эта особенность кремниевых транзисторов дает важное практическое преимущество — возможность исключить дополнительные источники запирающего напряжения в базовых цепях, необходимые для германиевых транзисторов.
Работа полупроводниковых приборов
В КЛЮЧЕВОМ РЕЖИМЕ
1. Общие сведения о работе полупроводниковых приборов
в ключевом режиме
Ключевыми схемами обеспечивается коммутация электрических цепей и с их помощью, в частности, могут формироваться импульсные сигналы. Эти схемы могут пребывать в двух состояниях: включенном и выключенном. В двух состояниях пребывают также используемые в них полупроводниковые приборы: в одном состоянии их сопротивление очень мало, а в другом – весьма велико. В таких схемах широкое применение получили как диоды, так и транзисторы. В диодном ключе переход из одного состояния в другое происходит под действием непосредственно коммутируемого (анодного) напряжения. Транзисторные ключи, в отличие от диодных, являются управляемыми. Состояния, в которых они пребывают, определяются не коммутирующим напряжением, а напряжением управления.
В зависимости от расположения в ключевой схеме полупроводникового прибора и нагрузки различаются последовательное и параллельное построения этих схем. Так, в выпрямителях используется последовательное построение ключевых диодных схем. Схема параллельного диодного ключа приведена на рис. 4.1. В такой схеме ток через нагрузку протекает при закрытом состоянии диода, а при открытом состоянии диод шунтирует нагрузку.

Рисунок 4.1. Схема параллельного диодного ключа
Рис. 4.2 иллюстрирует параллельное и последовательное построения ключевых схем на биполярном транзисторе. При параллельном построении (рис. 4.2.а) под действием управляющего напряжения uупртранзистор закрыт (его сопротивление велико), нагрузка Rнчерез резисторRкподключается к источнику питанияЕк, который является, по существу, источником входного электрического сигнала. При открытом состоянии транзистора его сопротивление становится незначительным, и он шунтирует нагрузку. В результате снимаемое с нагрузки выходное напряжениеuвыхблизко к нулю.
На схеме рис. 4.2,б транзистор и нагрузка Rнвключены последовательно. При открытом транзисторе через нагрузку, включенной последовательно с источником входного напряжения, каким является ЕКпротекает ток. При закрытом транзисторе ток в этой цепи не протекает, таким образом нагрузка отключается от источника входного сигнала.

Рисунок 4.2. Варианты построения ключевых схем
на биполярном транзисторе:
а – параллельное, б — последовательное
Основными параметрами ключевой схемы, кроме сопротивления использованных в них приборов в открытом и закрытом состояниях, являются также быстродействие, определяемое временами переключения из одного состояния в другое, а также остаточное напряжение в открытом состоянии. В идеальном ключе значения этих параметров равны нулю. Такая идеализация, в частности, принимается при построении временных диаграмм, иллюстрирующих работу выпрямителей и логических устройств.
2. Работа биполярного транзистора в ключевом режиме
Широко используемая ключевая схема на биполярном транзисторе типа n—p—n, прерывающая протекание тока через нагрузку, приведена на рис. 4.3. В отличие от схемы рис. 4.2,б, в цепь управления введено балластное сопротивлениеRБ. Режим работы транзистора в этой схеме определяется уравнением состояния, имеющий вид, аналогичный (2.3).
Uкэ(Iк) =Е-Iк Rн, (4.1)
где UкэиIк– напряжение коллектор-эмиттер и коллекторный ток транзистора. При этом напряжение коллектор-эмиттер является функцией коллекторного тока. Графическое решение этого уравнения, проводимого также, как и уравнения (2.3), представлено на рис. 4.4, где точки «а» и «б» соответствуют пребыванию транзистора в закрытом и открытом состояниях.
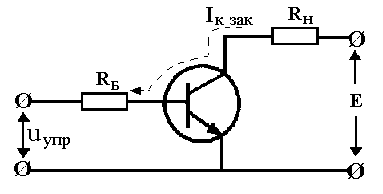
Рисунок 4.3. Ключевая схема на биполярном транзисторе
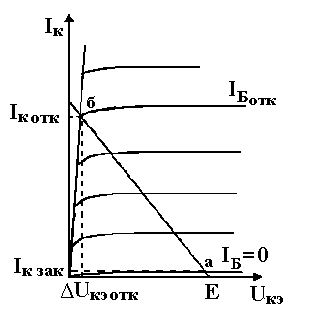
Рисунок 4.4. Графическое определение режимов
биполярного транзистора в ключевой схеме:
а – в закрытом состоянии, б – в открытом состоянии
Закрытое состояние транзистора достигается подачей на его базу управляющего напряжения отрицательной полярности. В этом состоянии в эмиттерной цепи ток отсутствует, а ток коллектора, Iк зак, соответствующийIБ = 0, будет протекать через базу. Цепь протекания токаIк закпоказана на рис. 4.3. Его направление в базовой цепи противоположно направлению базового тока открытого прибора. Транзисторы, предназначенные для работы в ключевом режиме, характеризуются практически нулевой величиной коллекторного тока, соответствующегоIБ = 0, в результате достигается весьма высокое их сопротивление в закрытом состоянии.
Открытое состояние транзистора достигается подачей на базу положительного напряжения, величина которого обеспечивает превышение определенного значения базового тока IБ отк, соответствующего точке «б» на рис.4.4, при которой открывается коллекторный переход. При токеIБ откчерез транзистор и резисторRнпротекает ток
Iк отк= (Е — ∆Uкэ отк)/Rн,
где ∆Uкэ отк– падение напряжения на открытом транзисторе (остаточное напряжение), величина которого должна быть минимальной.
Для обеспечения надежного пребывания транзистора в открытом состоянии, при котором устраняется влияние помех в цепи управления и температурных уходов параметров транзистора, ток базы должен превышать величину IБ отк. Параметром, характеризующим величину превышения базового тока в таком состоянии над током IБ отк, является отношение
s
=  ,
,
называемое коэффициентом насыщения транзистора. Его величина обычно находится в пределах от 1,5 до 2,5. Ограничение сверху коэффициента s связано с увеличением мощности входной цепи транзистора. В открытом состоянии величина падения напряжения∆Uкэ откостается практически неизменной, поскольку все вольт-амперные характеристики выходной цепи биполярного транзистора приIБ > IБ откпроходят через точку «б» рис. 4.4.
Величина коллекторного тока в точке «б» может быть определена как
Iк отк=βст IБ отк, (4.2)
где βст – статический (усредненный) коэффициент передачи тока транзистора в схеме ОЭ. Тогда ток базы в открытом состоянии транзистора
IБ = s (4.3)
(4.3)
зависит от значений параметров цепи управления
IБ = (Uупр – UБЭ) / RБ. (4.4)
Для работы в режиме электронного ключа наибольшее применение получили кремневые транзисторы типа n—p—n, характеризующиеся малой величиной нулевого тока. Закрытое состояние таких транзисторов может быть осуществлено даже приUупр = 0, т.е. без использования дополнительного источника запирающего напряжения, который для германиевых транзисторов необходим.
54.Работа биполярного транзистора в ключевом режиме.
Ключевой режим работы характеризуется тем, что транзистор находится в одном из двух состояний: в полностью открытом (режим насыщения), или полностью закрытом (состояние отсечки).
При работе транзистора в ключевом режиме его включают обычно в цепь по схеме с общим эмиттером.
Контакты цепи, которые необходимо коммутировать подключают соответственно к коллектору и эмиттеру транзистора. Управляющий сигнал подают в цепь базы.
При работе транзистора в ключевом режиме цепь между коллектором и эмиттером может быть либо замкнута, либо разомкнута.
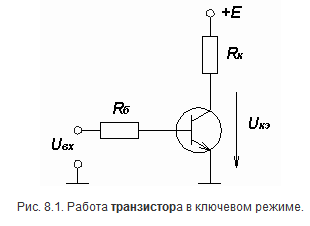
В ключевом режиме ток коллектора должен принимать только два значения:
а) 0- при разомкнутом состоянии;
б) определенное внешним U и внешним R.
Анализ работы транзистора в ключевом режиме проводят по выходным характеристикам транзистора.

При работе транзистора в активном усилительном режиме рабочая точка может находиться в любом месте участка нагрузочной прямой, а при работе в ключевом режиме, рабочая точка может иметь только два положения на нагрузочной прямой: крайнее нижнее соответствует минимальному току коллектора (Iко— тепловой ток). При этом транзистор закрыт и находится в режиме отсечки, когда и коллекторный и эмиттерный переходы смещены в обратном направлении.
В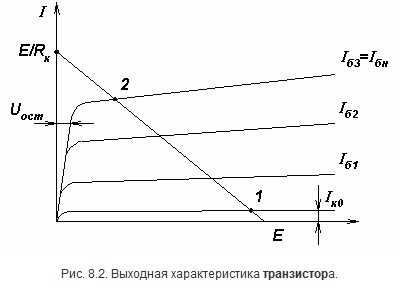 торое
положение — крайнее верхнее положение
рабочей точки на нагрузочной прямой.
Это положение соответствует открытому
состоянию транзисторного ключа.
транзистор работает в режиме насыщения.
Когда и коллекторный и эмиттерный
переходы смещены в прямом направлении.
При этом падение напряжения между
коллектором и эмиттером транзистора
минимально. Для реальных транзисторов
это так называемое остаточное напряжение
может составлять десятые доли вольт.
Это малое остаточное напряжение
практически не влияет на величину
коммутирующего тока.
торое
положение — крайнее верхнее положение
рабочей точки на нагрузочной прямой.
Это положение соответствует открытому
состоянию транзисторного ключа.
транзистор работает в режиме насыщения.
Когда и коллекторный и эмиттерный
переходы смещены в прямом направлении.
При этом падение напряжения между
коллектором и эмиттером транзистора
минимально. Для реальных транзисторов
это так называемое остаточное напряжение
может составлять десятые доли вольт.
Это малое остаточное напряжение
практически не влияет на величину
коммутирующего тока.
55.Вольтамперная характеристика р-n перехода и диода Шоттки.
Вольтамперная характеристика р-n перехода
В общем виде вольт-амперная характеристика (ВАХ) р-n перехода (рис. 1.10) представляется экспоненциальной зависимостью
 где
I0 — обратный ток. Этот ток имеет небольшие
величины (мкА или нА), но довольно сильно
увеличивается при повышении температуры.
Подробно I0 рассмотрим далее.
где
I0 — обратный ток. Этот ток имеет небольшие
величины (мкА или нА), но довольно сильно
увеличивается при повышении температуры.
Подробно I0 рассмотрим далее.
И з
(1.11) следует, что при прямом смещении (U
> 0) ток через р-п переход возрастает,
а при обратном смещении (U < 0) становится
малым, приближаясь к значению I0. Поскольку
φТ = 26 мВ, то при положительных напряжениях
U > 0,1В, в формуле (1.11) можно пренебречь
единицей по сравнению с экспонентой.
Таким образом, р-п переход характеризуется
свойством односторонней электропроводности,
т. е. хорошо проводит ток в прямом
направлении и плохо в обратном.
Следовательно, р-п переход обладает
выпрямляющим действием, что позволяет
использовать его в качестве выпрямителя
переменного тока.
з
(1.11) следует, что при прямом смещении (U
> 0) ток через р-п переход возрастает,
а при обратном смещении (U < 0) становится
малым, приближаясь к значению I0. Поскольку
φТ = 26 мВ, то при положительных напряжениях
U > 0,1В, в формуле (1.11) можно пренебречь
единицей по сравнению с экспонентой.
Таким образом, р-п переход характеризуется
свойством односторонней электропроводности,
т. е. хорошо проводит ток в прямом
направлении и плохо в обратном.
Следовательно, р-п переход обладает
выпрямляющим действием, что позволяет
использовать его в качестве выпрямителя
переменного тока.
Важным параметром р-п перехода является его дифференциальное сопротивление rд. Формулу для определения rд прямой ветви ВАХ получим из (1.11):
 При
I ›› I0 получим окончательно:
При
I ›› I0 получим окончательно:

C ростом тока дифференциальное сопротивление р-п перехода быстро падает. При токах порядка единиц и десятков миллиампер rД составляет десятки и единицы Oм.
При расчете выпрямительных устройств часто пользуются другим параметром р-п перехода — сопротивлением постоянному току Rст.
Из формулы (1.11) довольно просто получить зависимость Rст от рабочего тока:
 При
прямом смещении р-п перехода (при
протекании прямого тока) Rст всегда
больше сопротивления rд.
При
прямом смещении р-п перехода (при
протекании прямого тока) Rст всегда
больше сопротивления rд.
Тепловой баланс в полупроводниковой структуре устанавливается через некоторое время после включения тока и определяется теплопроводностью отдельных частей структуры. С целью повышения максимально допустимой мощности, выделяемой на р-п переходе, прежде всего следует улучшить теплообмен с окружающей средой. Более подробно вопрос теплового режима будет рассмотрен в гл. 3.
При прямом смещении р-п перехода его идеализированная ВАХ согласно (1.11) представляется однородной экспонентой. Однако реальная характеристика имеет несколько более сложную форму: состоит из нескольких участков с разными наклонами. Отличия реальной ВАХ от идеализированной определяются несколькими причинами.
Первая причина обусловлена процессами рекомбинации в i-области р-п перехода. Она имеет место при малых прямых смещениях. В этом случае ∆φ еще велика, следовательно, имеет место малый уровень инжекции, т. е. в i-область из эмиттера и базы попадает малое число носителей заряда. При таком малом положительном смещении ширина перехода l еще довольно большая — объем i-области еще достаточно велик, следовательно, в ней присутствует относительно много ловушек. Таким образом, за счет большого числа ловушек создаются очень благоприятные условия в i-области для рекомбинации малого числа инжектированных носителей.
В рассмотренном случае ВАХ формируется за счет тока рекомбинации, который тоже имеет экспоненциальную зависимость от напряжения, но более пологую, чем по (1.11). За счет такого пологого начального участка вид прямой ветви реальной ВАХ становится таким, как показано на рис. 1.11. На этом рисунке представлен параметр UП, называемый напряжением «пятки». Хотя на сегодняшний день и нет четкого определения для этого параметра, он часто используется для прикидочных расчетов радиоэлектронных устройств. Будем несколько условно считать, что UП — это напряжение на р-п переходе, при котором I = 0,1 мА. Нетрудно заметить, что чем больше ∆φ0 и l0 (чем шире ε3), тем должно быть больше и UП. Следовательно, у кремниевых р-п переходов UП больше, чем у германиевых, и меньше, чем у переходов из арсенида галлия (рис. 1.11). Следует отметить, что в формирование величины UП определенный вклад вносит и ток I0.
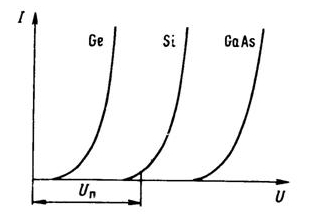
Другая причина отличия реальной ВАХ от формы (1.11) обусловлена падением напряжения на объемном сопротивлении базы. Эта причина проявляется при достаточно больших токах. Заметим, что сопротивление базы rб в реальных р-п переходах обычно составляет единицы или десятки Ом. Падение напряжения на этом сопротивлении Irб является той поправкой, которую следует ввести в формулу (1.11), чтобы учесть различие между напряжением на самом запорном слое р-п перехода и величиной внешнего напряжения U. С учетом такой поправки получаем

Падение напряжения на rб приводит к появлению на ВАХ участка, называемого омическим. При больших токах значение ∆φ0 становится небольшим, сопротивление обедненного слоя уменьшается и уже оказывается малосущественным, следовательно, в таком случае можно рассматривать р-п переход как простую двухслойную пластину, сопротивление которой приближенно равно сопротивлению ее высокоомного слоя rб (ρэ«ρб). Необходимо отметить, что учитывать падение напряжения на rб необходимо для значительного, иногда даже основного, рабочего участка ВАХ р-п перехода.
Еще одна причина отличия реальной ВАХ от идеализированной обусловлена модуляцией сопротивления базы при больших уровнях инжекции. Протекание больших токов определяется инжекцией большого числа носителей заряда из эмиттера в базу. В результате присутствия в базе большого числа неосновных носителей заряда ее объемное сопротивление уменьшится. Это обстоятельство делает необходимым учет влияния rб = f(I) в формуле (1.13) для больших уровней инжекции.
Обратная ветвь ВАХ р-п перехода определяется обратным током, который, как отмечалось выше, обычно довольно сильно возрастает при повышении температуры. Не останавливаясь здесь на анализе обратной ветви, рассмотрим влияние температуры на прямую ветвь ВАХ р-п перехода. Температурная зависимость прямой ветви ВАХ согласно (1.11) определяется изменениями I0 и φт . Заметим, что при больших токах необходимо согласно (1.13) также учитывать изменение rб. Влияние этих температурно-зависимых параметров на ВАХ приводит к тому, что при малых прямых напряжениях ток возрастает с повышением температуры, а при больших — уменьшается. В принципе существует даже точка (область), где величина тока практически не зависит от температуры. Однако эта термостабильная точка редко используется на практике, поскольку имеет место при достаточно больших уровнях инжекции. Для большинства же реальных устройств ток в р-п переходе несколько возрастает с повышением температуры (при постоянном напряжении).
На практике чаще всего принято оценивать влияние температуры на ВАХ р-п перехода, определяя изменение напряжения при постоянном токе. Для оценки изменения прямого напряжения при изменении температуры вводится температурный коэффициент напряжения (ТКН), характеризующий сдвиг ВАХ по оси напряжений. Обычно ТКН имеет отрицательный знак, что знаменует собой уменьшение напряжения на р-п переходе при постоянном токе с ростом температуры. Отметим, что ТКН зависит от тока и несколько уменьшается с его ростом. Для р-п переходов из кремния ТКН достигает — 3 мВ/град.
Для рассмотрения вольтамперной характеристики (ВАХ) барьера Шоттки
Для рассмотрения вольтамперной характеристики (ВАХ) барьера Шоттки воспользуемся диодным приближением. Вместо критерия для барьера Шоттки воспользуемся для перехода электронов из полупроводника в металл выражением:
(2.38)
Подставляя это выражение в (2.5) и (2.7), получаем:
 (2.39)
(2.39)
где v0 — тепловая скорость электронов, равная
ns — поверхностная концентрация в полупроводнике на границе с металлом
n0 — равновесная концентрация основных носителей в полупроводнике, равная.
В условиях равновесия VG = 0 ток из полупроводника в металл jп/п → М уравновешивается током из металла в полупроводник jМ → п/п = (1/4)qnsv0. При приложении напряжения этот баланс нарушается и общий ток будет равен сумме этих токов. Следовательно, вольтамперная характеристика барьера Шоттки будет иметь вид:
В более компактной форме ВАХ записывается в виде:

На рисунке 2.7 приведена вольт-амперная характеристика барьера Шоттки.

Рис. 2.7. Вольт-амперная характеристика барьера Шоттки
Вольт-амперная характеристика барьера Шоттки имеет ярко выраженный несимметричный вид. В области прямых смещений ток экспоненциально сильно растёт с ростом приложенного напряжения. В области обратных смещений ток от напряжения не зависит. В обеих случаях, при прямом и обратном смещении, ток в барьере Шоттки обусловлен основными носителями — электронами. По этой причине диоды на основе барьера Шоттки являются быстродействующими приборами, поскольку в них отсутствуют рекомбинационные и диффузионные процессы. Несимметричность вольт-амперной характеристики барьера Шоттки — типичная для барьерных структур. Зависимость тока от напряжения в таких структурах обусловлена изменением числа носителей, принимающих участие в процессах зарядопереноса. Роль внешнего напряжения заключается в изменении числа электронов, переходящих из одной части барьерной структуры в другую.
54.Работа биполярного транзистора в ключевом режиме.
Ключевой режим работы характеризуется тем, что транзистор находится в одном из двух состояний: в полностью открытом (режим насыщения), или полностью закрытом (состояние отсечки).
При работе транзистора в ключевом режиме его включают обычно в цепь по схеме с общим эмиттером.
Контакты цепи, которые необходимо коммутировать подключают соответственно к коллектору и эмиттеру транзистора. Управляющий сигнал подают в цепь базы.
При работе транзистора в ключевом режиме цепь между коллектором и эмиттером может быть либо замкнута, либо разомкнута.
В ключевом режиме ток коллектора должен принимать только два значения:
а) 0- при разомкнутом состоянии;
б) определенное внешним U и внешним R.
Анализ работы транзистора в ключевом режиме проводят по выходным характеристикам транзистора.
При работе транзистора в активном усилительном режиме рабочая точка может находиться в любом месте участка нагрузочной прямой, а при работе в ключевом режиме, рабочая точка может иметь только два положения на нагрузочной прямой: крайнее нижнее соответствует минимальному току коллектора (Iко— тепловой ток). При этом транзистор закрыт и находится в режиме отсечки, когда и коллекторный и эмиттерный переходы смещены в обратном направлении.
Второе положение — крайнее верхнее положение рабочей точки на нагрузочной прямой. Это положение соответствует открытому состоянию транзисторного ключа. транзистор работает в режиме насыщения. Когда и коллекторный и эмиттерный переходы смещены в прямом направлении. При этом падение напряжения между коллектором и эмиттером транзистора минимально. Для реальных транзисторов это так называемое остаточное напряжение может составлять десятые доли вольт. Это малое остаточное напряжение практически не влияет на величину коммутирующего тока.
55.Вольтамперная характеристика р-n перехода и диода Шоттки.
Вольтамперная характеристика р-n перехода
В общем виде вольт-амперная характеристика (ВАХ) р-n перехода (рис. 1.10) представляется экспоненциальной зависимостью
где I0 — обратный ток. Этот ток имеет небольшие величины (мкА или нА), но довольно сильно увеличивается при повышении температуры. Подробно I0 рассмотрим далее.
Из (1.11) следует, что при прямом смещении (U > 0) ток через р-п переход возрастает, а при обратном смещении (U < 0) становится малым, приближаясь к значению I0. Поскольку φТ = 26 мВ, то при положительных напряжениях U > 0,1В, в формуле (1.11) можно пренебречь единицей по сравнению с экспонентой. Таким образом, р-п переход характеризуется свойством односторонней электропроводности, т. е. хорошо проводит ток в прямом направлении и плохо в обратном. Следовательно, р-п переход обладает выпрямляющим действием, что позволяет использовать его в качестве выпрямителя переменного тока.
Важным параметром р-п перехода является его дифференциальное сопротивление rд. Формулу для определения rд прямой ветви ВАХ получим из (1.11):
При I ›› I0 получим окончательно:
C ростом тока дифференциальное сопротивление р-п перехода быстро падает. При токах порядка единиц и десятков миллиампер rД составляет десятки и единицы Oм.
При расчете выпрямительных устройств часто пользуются другим параметром р-п перехода — сопротивлением постоянному току Rст.
Из формулы (1.11) довольно просто получить зависимость Rст от рабочего тока:
При прямом смещении р-п перехода (при протекании прямого тока) Rст всегда больше сопротивления rд.
Тепловой баланс в полупроводниковой структуре устанавливается через некоторое время после включения тока и определяется теплопроводностью отдельных частей структуры. С целью повышения максимально допустимой мощности, выделяемой на р-п переходе, прежде всего следует улучшить теплообмен с окружающей средой. Более подробно вопрос теплового режима будет рассмотрен в гл. 3.
При прямом смещении р-п перехода его идеализированная ВАХ согласно (1.11) представляется однородной экспонентой. Однако реальная характеристика имеет несколько более сложную форму: состоит из нескольких участков с разными наклонами. Отличия реальной ВАХ от идеализированной определяются несколькими причинами.
Первая причина обусловлена процессами рекомбинации в i-области р-п перехода. Она имеет место при малых прямых смещениях. В этом случае ∆φ еще велика, следовательно, имеет место малый уровень инжекции, т. е. в i-область из эмиттера и базы попадает малое число носителей заряда. При таком малом положительном смещении ширина перехода l еще довольно большая — объем i-области еще достаточно велик, следовательно, в ней присутствует относительно много ловушек. Таким образом, за счет большого числа ловушек создаются очень благоприятные условия в i-области для рекомбинации малого числа инжектированных носителей.
В рассмотренном случае ВАХ формируется за счет тока рекомбинации, который тоже имеет экспоненциальную зависимость от напряжения, но более пологую, чем по (1.11). За счет такого пологого начального участка вид прямой ветви реальной ВАХ становится таким, как показано на рис. 1.11. На этом рисунке представлен параметр UП, называемый напряжением «пятки». Хотя на сегодняшний день и нет четкого определения для этого параметра, он часто используется для прикидочных расчетов радиоэлектронных устройств. Будем несколько условно считать, что UП — это напряжение на р-п переходе, при котором I = 0,1 мА. Нетрудно заметить, что чем больше ∆φ0 и l0 (чем шире ε3), тем должно быть больше и UП. Следовательно, у кремниевых р-п переходов UП больше, чем у германиевых, и меньше, чем у переходов из арсенида галлия (рис. 1.11). Следует отметить, что в формирование величины UП определенный вклад вносит и ток I0.
Другая причина отличия реальной ВАХ от формы (1.11) обусловлена падением напряжения на объемном сопротивлении базы. Эта причина проявляется при достаточно больших токах. Заметим, что сопротивление базы rб в реальных р-п переходах обычно составляет единицы или десятки Ом. Падение напряжения на этом сопротивлении Irб является той поправкой, которую следует ввести в формулу (1.11), чтобы учесть различие между напряжением на самом запорном слое р-п перехода и величиной внешнего напряжения U. С учетом такой поправки получаем
Падение напряжения на rб приводит к появлению на ВАХ участка, называемого омическим. При больших токах значение ∆φ0 становится небольшим, сопротивление обедненного слоя уменьшается и уже оказывается малосущественным, следовательно, в таком случае можно рассматривать р-п переход как простую двухслойную пластину, сопротивление которой приближенно равно сопротивлению ее высокоомного слоя rб (ρэ«ρб). Необходимо отметить, что учитывать падение напряжения на rб необходимо для значительного, иногда даже основного, рабочего участка ВАХ р-п перехода.
Еще одна причина отличия реальной ВАХ от идеализированной обусловлена модуляцией сопротивления базы при больших уровнях инжекции. Протекание больших токов определяется инжекцией большого числа носителей заряда из эмиттера в базу. В результате присутствия в базе большого числа неосновных носителей заряда ее объемное сопротивление уменьшится. Это обстоятельство делает необходимым учет влияния rб = f(I) в формуле (1.13) для больших уровней инжекции.
Обратная ветвь ВАХ р-п перехода определяется обратным током, который, как отмечалось выше, обычно довольно сильно возрастает при повышении температуры. Не останавливаясь здесь на анализе обратной ветви, рассмотрим влияние температуры на прямую ветвь ВАХ р-п перехода. Температурная зависимость прямой ветви ВАХ согласно (1.11) определяется изменениями I0 и φт . Заметим, что при больших токах необходимо согласно (1.13) также учитывать изменение rб. Влияние этих температурно-зависимых параметров на ВАХ приводит к тому, что при малых прямых напряжениях ток возрастает с повышением температуры, а при больших — уменьшается. В принципе существует даже точка (область), где величина тока практически не зависит от температуры. Однако эта термостабильная точка редко используется на практике, поскольку имеет место при достаточно больших уровнях инжекции. Для большинства же реальных устройств ток в р-п переходе несколько возрастает с повышением температуры (при постоянном напряжении).
На практике чаще всего принято оценивать влияние температуры на ВАХ р-п перехода, определяя изменение напряжения при постоянном токе. Для оценки изменения прямого напряжения при изменении температуры вводится температурный коэффициент напряжения (ТКН), характеризующий сдвиг ВАХ по оси напряжений. Обычно ТКН имеет отрицательный знак, что знаменует собой уменьшение напряжения на р-п переходе при постоянном токе с ростом температуры. Отметим, что ТКН зависит от тока и несколько уменьшается с его ростом. Для р-п переходов из кремния ТКН достигает — 3 мВ/град.
Для рассмотрения вольтамперной характеристики (ВАХ) барьера Шоттки
Для рассмотрения вольтамперной характеристики (ВАХ) барьера Шоттки воспользуемся диодным приближением. Вместо критерия для барьера Шоттки воспользуемся для перехода электронов из полупроводника в металл выражением:
Подставляя это выражение в (2.5) и (2.7), получаем:
(2.39)
где v0 — тепловая скорость электронов, равная
ns — поверхностная концентрация в полупроводнике на границе с металлом
n0 — равновесная концентрация основных носителей в полупроводнике, равная.
В условиях равновесия VG = 0 ток из полупроводника в металл jп/п → М уравновешивается током из металла в полупроводник jМ → п/п = (1/4)qnsv0. При приложении напряжения этот баланс нарушается и общий ток будет равен сумме этих токов. Следовательно, вольтамперная характеристика барьера Шоттки будет иметь вид:
В более компактной форме ВАХ записывается в виде:
На рисунке 2.7 приведена вольт-амперная характеристика барьера Шоттки.
Рис. 2.7. Вольт-амперная характеристика барьера Шоттки
Вольт-амперная характеристика барьера Шоттки имеет ярко выраженный несимметричный вид. В области прямых смещений ток экспоненциально сильно растёт с ростом приложенного напряжения. В области обратных смещений ток от напряжения не зависит. В обеих случаях, при прямом и обратном смещении, ток в барьере Шоттки обусловлен основными носителями — электронами. По этой причине диоды на основе барьера Шоттки являются быстродействующими приборами, поскольку в них отсутствуют рекомбинационные и диффузионные процессы. Несимметричность вольт-амперной характеристики барьера Шоттки — типичная для барьерных структур. Зависимость тока от напряжения в таких структурах обусловлена изменением числа носителей, принимающих участие в процессах зарядопереноса. Роль внешнего напряжения заключается в изменении числа электронов, переходящих из одной части барьерной структуры в другую.
2. ключевой режим работы транзистора
Модель БТ для «больших» сигналов строится на основе модели БТ Эбберса-Молла и представляет БТ в виде двух p—n переходов (диодов) и двух управляемых источников тока в коллекторной и эмиттерной цепях.
Токи через диоды определяются соотношениями согласно уравнению Шокли:
 (1)
(1)
Где  – тепловой потенциал (
– тепловой потенциал ( – постоянная Больцмана,
– постоянная Больцмана,  ,
,  – заряд электрона).
– заряд электрона).
Найдем токи коллектора и эмиттера из схемы:
 (2)
(2)
Решив это уравнение относительно токов коллектора и эмиттера, найдем уравнения статических характеристик:
Уравнение входной характеристики:
 ;
;
Уравнение выходной характеристики:

Под электронным ключом будем понимать элемент, который под воздействием управляющего сигнала (в виде тока или напряжения) осуществляет коммутацию элементов схемы (пассивных, активных, источников питания и пр.).
В работе электронного ключа следует рассматривать два основных режима: статический режим, определяемый положением рабочих точек на характеристиках электронного ключа в открытом и закрытом состояниях, и динамический режим – при переходе из открытого состояния в закрытое и наоборот.
Рассмотрим эти режимы на примере ключа на биполярном транзисторе.
Транзисторные ключи в настоящее время применяются для решения многих технических задач в преобразовательной технике, цифровой электронике и пр. Маломощные транзисторные ключи составляют основу дискретных и интегральных цифровых схем, которые решают различные математические и логические задачи.
Транзисторный ключ (ТК) на БТ строится на основе включения транзистора по схеме с ОЭ, см. рис.
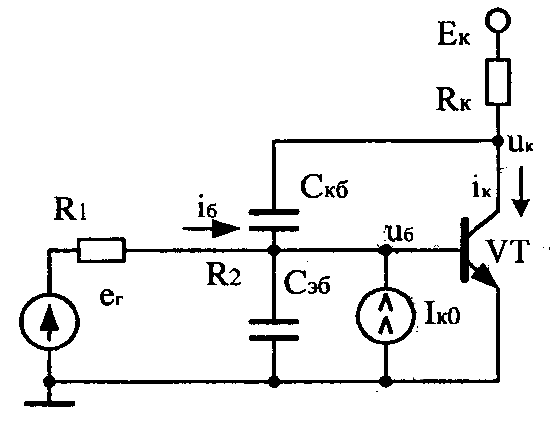
На
схеме простейшего ТК обозначены барьерные
емкости транзистора и источник тока,
отражающий тепловой ток коллектора  ,
которые в режиме отсечки примерно равен
току базы.
,
которые в режиме отсечки примерно равен
току базы.
Далее показаны входные и выходные характеристики ТК, позволяющие определить положение рабочей точки в закрытом и открытом состояниях ключа.
|
|
На входной характеристике отметим три характерные точки:
 – граница
между режимом отсечки и активным
режимом;
– граница
между режимом отсечки и активным
режимом; – Середина
области активного режима;
– Середина
области активного режима; – граница
между активным режимом и режимом
насыщения.
– граница
между активным режимом и режимом
насыщения.
Для кремниевых p—n переходов при комнатной температуре значения характерных точек следующие:

Перечисленные выше цифры хорошо отражают работу ИС с p-n переходами на основе кремния.
Для переходов металл-полупроводник (например, переходы диодов Шоттки):

Режим отсечки.
В закрытом состоянии оба перехода транзистора смещены в обратном направлении. Для этого на вход транзистора необходимо подать близкое к нулю или небольшое отрицательное напряжение.
Для надежности запирания величина отрицательного напряжения выбирается из условия:

где  – запирающее напряжение с генератора,
– запирающее напряжение с генератора,  – тепловой коллекторный ток. Его величина
очень мала, особенно у кремниевых
транзисторов (единицы наноампер). Поэтому
в закрытом состоянии напряжение на
коллекторе практически равно напряжению
источника питания
– тепловой коллекторный ток. Его величина
очень мала, особенно у кремниевых
транзисторов (единицы наноампер). Поэтому
в закрытом состоянии напряжение на
коллекторе практически равно напряжению
источника питания  .
.
При
повышении напряжения на базе транзистора
он начинает отпираться и, начиная с
напряжения  начинается резкое нарастание тока базы.
начинается резкое нарастание тока базы.
С ростом тока базы увеличивается ток коллектора и уменьшается напряжение на коллекторе и транзистор буде находиться в активном режиме. В этом режиме между током базы и коллектора буде выполняться известное соотношение:

Наконец,
при некотором управляющем токе  (напряжение
(напряжение  )
рабочая точка А на выходных характеристиках
переместится в такое положение, при
котором ток в цепи коллектора практически
перестанет зависеть от тока базы, а оба
перехода окажутся смещенными в прямом
направлении, что является условием для
создания режима насыщения.
)
рабочая точка А на выходных характеристиках
переместится в такое положение, при
котором ток в цепи коллектора практически
перестанет зависеть от тока базы, а оба
перехода окажутся смещенными в прямом
направлении, что является условием для
создания режима насыщения.
Режим насыщения.
В этом режиме не все носители заряда, инжектированные эмиттером, попадают в цепь коллектора. Часть из них компенсируется неосновными носителями, идущими из коллектора в базу, что приводит к прекращению роста тока коллектора при дальнейшем росте тока базы.
В режиме насыщения ток базы будет определяться соотношением:

Ток коллектора принимает при этом максимально возможное значение:

На границе насыщения ток коллектора и ток базы связаны соотношением:

Следует
отметить, что при превышении тока базы
значения  приводит к накоплению заряда неосновных
носителей в базе, что отражается
динамических свойствах транзистора.
приводит к накоплению заряда неосновных
носителей в базе, что отражается
динамических свойствах транзистора.
Малая
величина напряжения на коллекторном
переходе транзистора в режиме насыщения
обуславливает сравнительно малые потери
в нем даже при больших коллекторных
токах. Поэтому важно обеспечивать режим
насыщения в самых неблагоприятных
условиях работы ключа (изменение
температуры, разброс параметров элементов
и пр.). С этой целью ток базы выбирают с
некоторым запасом, чтобы гарантированно
обеспечить этот режим. Количественно
это определяется коэффициентом, который
называется степень насыщения и показывает
во сколько раз ток базы больше тока  :
:

Используя уравнения статических характеристик из модели Эбберса –Молла найдем величину напряжения насыщения. Выразим напряжения на открытых p—n переходах используя уравнения (1):

Тогда напряжение между эмиттером и коллектором будет равно:

Отношение
обратных токов выразим как отношение
коэффициентов  :
:

Используя эту пропорцию и уравнения (2) перепишем формулу для напряжения насыщения:

Введем ещё один параметр, характеризующий степень насыщения:

Опустим несложные математические преобразования и запишем окончательное выражение для напряжения насыщения:
 (3)
(3)
Для инверсного включения транзистора напряжение насыщение можно найти аналогично, заменяя нормальные параметры инверсными:

Тогда

Напряжение насыщения между коллектором и эмиттером называют четвертой характерной точкой.
Температурная зависимость напряжения насыщения.
Перепишем выражение (3), выделив из теплового потенциала температуру:

Обозначим
символом  часть формулы, которая не зависит от
температуры:
часть формулы, которая не зависит от
температуры:

Тогда выражение (3) представим в виде температурной зависимости:

Очевидно,
что  является
производной
является
производной  по
температуре:
по
температуре:

Поэтому можно записать:

где  –
фиксированная температура в градусах
Кельвина,
–
фиксированная температура в градусах
Кельвина,  – изменение температуры, а
– изменение температуры, а  ничто иное как напряжение насыщения
при заданной температуре, например
25ºС. Таким образом:
ничто иное как напряжение насыщения
при заданной температуре, например
25ºС. Таким образом:

Температурная зависимость трех характерных точек.
Температурный сдвиг характерных точек является вполне предсказуемым и позволяет проводить расчеты статических режимов при различных температурах.
Рассмотрим прямую ветвь ВАХ p-n перехода (ен важно, где он используется, в транзистор-ли в диоде).
Из уравнения Шокли выразим напряжение на переходе:
 (4)
(4)
Обратный
ток  зависит от температуры и ширины
запрещенной зоны кремния, которая равна
зависит от температуры и ширины
запрещенной зоны кремния, которая равна  .
Функционально эту зависимость можно
представить следующим образом:
.
Функционально эту зависимость можно
представить следующим образом:
 (5)
(5)
Здесь  –
фиксированная температура в градусах
Кельвина;
–
фиксированная температура в градусах
Кельвина;
 и
и  – значения теплового потенциала при
соответствующих температурах
– значения теплового потенциала при
соответствующих температурах  и
и  ;
;
 – значение
обратного тока при температуре
– значение
обратного тока при температуре  .
.
Обозначим
показатель экспоненты через  и выразим значения тепловых потенциалов:
и выразим значения тепловых потенциалов:
 (6)
(6)
Подставив
в формулу (4) значение  из (5) и использовав (6) получим:
из (5) и использовав (6) получим:

Сократив сомножители и преобразовав первое выражение получим:

Подставим
значение ширины запрещенной зоны кремния
1.11В и значение  получим окончательно:
получим окончательно:

Введем определение температурного коэффициента напряжения:

Подставляя в эту формулу значения характерных точек можно получить зависимости их значений от температуры.
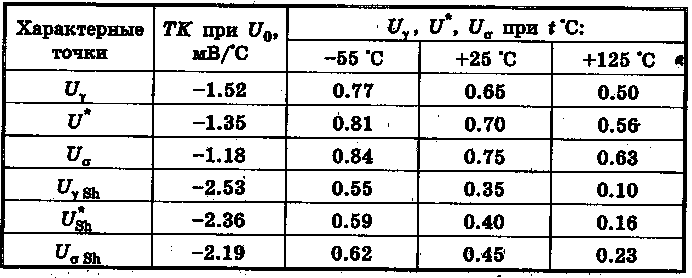
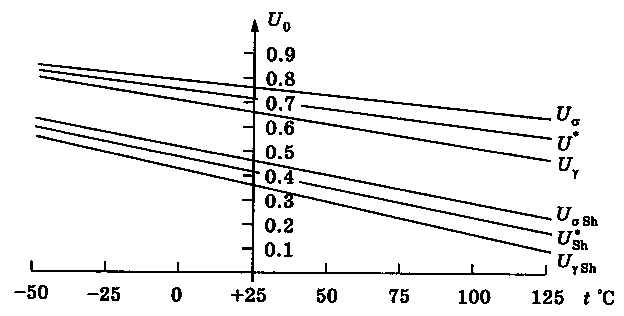
10




 ,
,


 .
. ,
, ,
,
 .
.
 .
. .
. .
. имеем
имеем .
.
 .
. и
и .
. .
. .
.
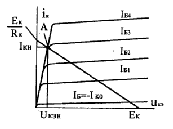
 – граница
между режимом отсечки и активным
режимом;
– граница
между режимом отсечки и активным
режимом; – Середина
области активного режима;
– Середина
области активного режима; – граница
между активным режимом и режимом
насыщения.
– граница
между активным режимом и режимом
насыщения.