Корпусирование интегральных схем (ИС), технология корпусирования микросхем
Сборка и герметизация интегральных схем, процессоров и полупроводниковых приборов включает в себя три основных этапа.Присоединение кристалла к основанию корпуса. Основными требованиями к этой операции относятся надежность и механическая прочность соединения, в отдельных случаях – быстрое рассеивание тепла (передача его к подложке). Присоединение осуществляется приклеиванием или пайкой.
Материалы для приклеивания. При корпусировании кристаллов используются диэлектрические и электропроводящие клеи. Для улучшения теплопроводящих свойств в состав первых добавляют керамические или стеклянные порошки, во вторые – мелкодисперсное серебро.
Материалы для пайки. Припаивание кристаллов/микросхем осуществляется проводящими припоями:
- стеклянными. Они состоят из окислов металлов, устойчивы к коррозии, имеют хорошее сцепление практически со всеми материалами;
- металлическими.
 Такая пайка осуществляется с помощью паяльной пасты или навесок/прокладок припоя (преформ). Последние помещают между кристаллом и подложкой.
Такая пайка осуществляется с помощью паяльной пасты или навесок/прокладок припоя (преформ). Последние помещают между кристаллом и подложкой.
Проволочный монтаж. Присоединение осуществляется с помощью металлических лент или проволоки из меди, алюминия или золота. Для этого используется ультразвуковая, термокомпрессионная или электроконтактная сварка.
Беспроволочный монтаж. Его проводят по технологии flip-chip («перевернутый кристалл»). Контакты, имеющие вид шариков/балок, формируются при металлизации поверхности методами:
- электролитического/вакуумного напыления;
- заполнением готовыми микросферами;
- трафаретной печати.
Защита от внешнего воздействия. Окружающая среда оказывает значительное влияние на качество поверхности кристалла и, как результат, на стабильность его рабочих характеристик. Поэтому правильная защита от неблагоприятного внешнего воздействия является важным этапом корпусирования. Она осуществляется на завершающем этапе сборки и может проводиться в одном из двух вариантов (в зависимости от технологии производства).
Поэтому правильная защита от неблагоприятного внешнего воздействия является важным этапом корпусирования. Она осуществляется на завершающем этапе сборки и может проводиться в одном из двух вариантов (в зависимости от технологии производства).
Корпусная герметизация. Ее проводят присоединением крышки корпуса к его основанию. Для этого используются пайка, сварка или приклеивание, обеспечивающие вакуум-плотную герметизацию. Технология присоединения, тип клея и припоя (стеклянный либо металлический) выбираются под конкретные задачи производства.
Бескорпусная герметизация. Для нее используются полимеры (пластмассы) либо компаунды. После отвердевания (полимеризации) они могут быть мягкими или твердыми, в соответствии с поставленными задачами. В современном производстве используется две технологии бескорпусной герметизации:
- glob-top («капля»). Компаунд наносится на верхнюю часть микросборки так, чтобы сформировался купол, покрывающий как сам кристалл, так и его выводы.
 Для этого используется герметизирующий состав средней вязкости;
Для этого используется герметизирующий состав средней вязкости; - dam-and-fill («дамба и наполнение»). Такая технология применяется для бескорпусной герметизации микросхем и кристаллов с большим количеством выводов. Сначала по периметру возводится «дамба» из компаунда с высокой вязкостью. Затем она заполняется низковязким материалом.
Корпусирование ИС | это… Что такое Корпусирование ИС?
Ранняя советская микросхема К1ЖГ453Корпусирование интегральных схем — завершающая стадия микроэлектронного производства, в процессе которой полупроводниковый кристалл устанавливается в корпус. Обычно состоит из этапов прикрепления кристалла на основание или носитель кристалла, электрического соединения контактных площадок кристалла с выводами корпуса и герметизации корпуса. После корпусирования следует окончательное тестирование микросхем.
После корпусирования следует окончательное тестирование микросхем.
Дополнительные сведения: Сборка (микроэлектроника)
Содержание
|
Типоразмеры корпусов
Основная статья: Типы корпусов микросхем
Операции
Проволочный монтаж- Установка кристалла на носитель (en:Die attaching) или непосредственно на плату (Chip-On-Board)
- Электрическое соединение выводов кристалла и корпуса (англ.
- при помощи проволочных перемычек (Wire bonding)
- термоультразвуковая сварка (Thermosonic Bonding)
- монтаж методом перевернутого чипа (en:Flip chip)
- (Quilt packaging)
- (Tab bonding)
- (en:Wafer bonding)
- (Film attaching)
- (Spacer attaching)
- Герметизация корпуса
- Сваркой
- Пайкой мягкими или твердыми припоями
- Клеем, пластмассой, смолой, стеклом.

- Плавлением кромок соединяемых деталей
- Инкапсулирование ИС
- Нанесение покрытий — пленок, лака, металлов
- (en:Baking)
- Плакирование (Plating)
- резка и формовка (Trim&Form)
- маркировка (Lasermarking)
- конечная паковка (packaging)
После завершения этапа корпусирования, следует этап тестирования полупроводникового прибора («корпусированных чипов»).
Рынок
В 2010 году количество микросхем, прошедших корпусирование, составило около 200 млрд.[1] Крупнейшие компании, работающие в области сборки и корпусирования интегральных схем на 2011 год:[1]Amkor Technology, Anst China, ASE Group (Advanced Semiconductor Engineering Inc., Тайвань), Azimuth Industrial, Carsem, China Wafer Level CSP, ChipMOS, CORWIL Technology, EEMS (EEMS Suzhou,EEMS Test Singapore Pte.), FlipChip International (en:Delco Electronics,Kulicke & Soffa Industries), Hana Microelectronics, Hana Micron, i2a Technologies, IDS Electronics (Intan Utilities Berhad), Infiniti Solutions, Jiangsu Changjiang Electronics Technology, Lingsen Precision Industries, Millennium Microtech (en:Alphatec), Naito Densei Kogyo (Япония), Nantong Fujitsu Microelectronics (Япония), NxGen Electronics (en:NexGen), Orient Semiconductor Electronics (OSE), Powertech Technology (PTI), Shinko Electric Industries (Fujitsu), en:Signetics, Siliconware Precision Industries, SPEL (SPIC Electronics), en:STATS ChipPAC Ltd, Tianshui Huatian Technology, Unisem Group, en:UTAC Group, Vigilant Technology (Ladkrabang Industrial Estate, Таиланд), XinTec (en:Zhongli, Taiwan).
Примечания
- ↑ 1 2 The worldwide IC packaging market. 2011 edition — New Venture Research Corp.
Литература
- Бер А. Ю., Минскер Ф. Е. Сборка полупроводниковых приборов и интегральных микросхем: Учебник для сред. ПТУ. — 3-е изд., переаб. и доп. — М.: Высшая школа, 1986. — 279 с.
- Жан М. Рабаи, Ананта Чандракасан, Боривож Николич.
- Charles A. Harper. Electronic packaging and interconnection handbook — McGraw-Hill Professional, 2005—1000 pages
- Панфилов. Оборудование производства интегральных микросхем и промышленные роботы. 1988
См. также
- Технологический процесс в электронной промышленности
Картофельные чипсы Упаковка от Sonoco
Картофельные банки Упаковка от Sonoco
Любимая закуска малазийцев, изысканная упаковка картофельных чипсов разработана с максимальной заботой Sonoco о качестве и неизменном вкусе. По сути, жестяная композитная упаковка предназначена для простоты использования, портативности и удобства потребителей.
По сути, жестяная композитная упаковка предназначена для простоты использования, портативности и удобства потребителей.
Примечательно, что существует жесткая упаковка, пластиковая упаковка для картофельных чипсов и другая упаковка, которая дает потребителям разное впечатление от продукта. Теперь давайте посмотрим на разницу между упаковкой из композитной банки и пластиковой упаковкой для картофельных чипсов.
Композитная упаковка для банок
КОМПОЗИТНАЯ УПАКОВКА ДЛЯ БАНОК SUB
Композитные банки, также известные как контейнеры из жесткой бумаги или картона, помогают предотвратить раздавливание деликатных пищевых продуктов, таких как чипсы. Эта упаковка также помогает сохранить качество вашей любимой закуски. В первую очередь, свежесть продуктов может дольше сохраняться благодаря закрывающимся крышкам.
Кроме того, композитная банка состоит из нескольких слоев для повышения защиты. Эта многослойная упаковка лучше всего подходит для хранения деликатных продуктов.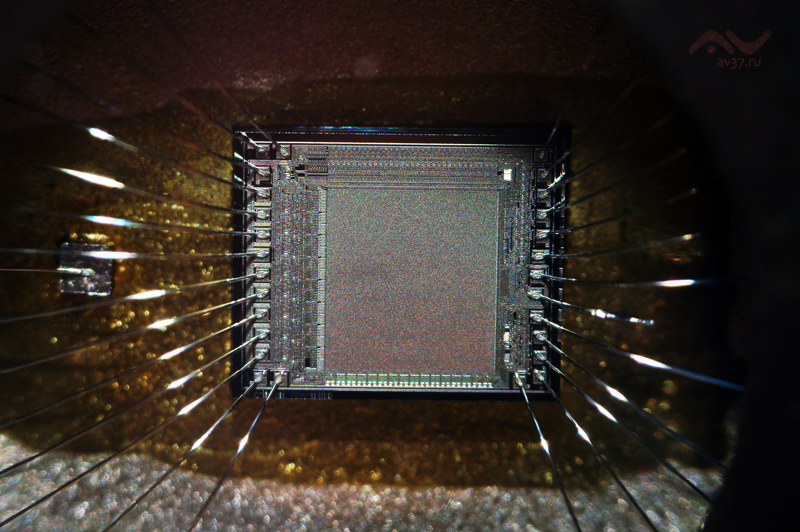 Первый слой композитной упаковки — это слой корпуса банки. Он сделан из переработанной бумаги. Далее идут различные внутренние конструкции вкладышей для барьерной защиты.
Первый слой композитной упаковки — это слой корпуса банки. Он сделан из переработанной бумаги. Далее идут различные внутренние конструкции вкладышей для барьерной защиты.
Упаковка из композитных банок для картофельных чипсов также имеет сверху легко отделяемую мембрану для герметизации продуктов. Этот дополнительный слой гарантирует потребителям свежие чипсы, которые они смогут съесть. Этот тип упаковки предназначен для удобства путешествий и организации.
Пластиковая упаковка для чипсов
Другим видом упаковки для картофельных чипсов является пластиковая упаковка. Типичный пакет для картофельных чипсов состоит из нескольких слоев полимерных материалов. Материалы представляют собой биаксиально ориентированный полипропилен (BOPP) внутри, полиэтилен низкой плотности (LDPE) и BOPP в середине и внешний слой Surlyn®, термопластичной смолы. Каждый слой выполняет определенную функцию для хранения картофельных чипсов.
Однако недостатком пластиковой упаковки является то, что ее трудно повторно запечатать после вскрытия, а также с ней нелегко путешествовать и организовывать.
Почему упаковка имеет значение
Хорошая упаковка помогает бренду выделиться среди остальных. Отличие от других привлекает внимание к вашему продукту и повышает лояльность к бренду. Независимо от вашего продукта, ваша упаковка может быть использована для дифференциации вашего бизнеса. Кроме того, исследования показывают, что люди склонны выбирать определенные бренды из-за изысканной и качественной упаковки.
Чтобы привлечь внимание потребителей, брендам нужны универсальные упаковочные материалы. Им также потребуются технологии для повышения качества перекусов за счет привлекательного дизайна и высокофункциональной упаковки, которые обеспечат потребителям удобство.
Компания Sonoco специализируется на контейнерах из жесткого картона. У нас есть подтвержденный опыт работы на рынках снеков, чипсов, орехов и порошковых смесей. Наши контейнеры сохранят ваш продукт свежим и защищенным, а также привлекут внимание потребителей на переполненных полках магазинов.
Свяжитесь с нами, предоставив свои данные, чтобы наша команда экспертов проконсультировала вас по вашим потребностям или услугам. Воспользуйтесь возможностью персонализировать свою упаковку, добавив больше возможностей, чтобы удовлетворить своих клиентов и выделить свой бренд.
Что это такое и зачем вам это нужно для ваших электронных устройств?
Когда вы видите слово; Упаковка IC, что первое приходит на ум?
Конечно, защита. Или, может быть, безопасность. Какое бы слово вы ни выбрали, оно приемлемо. И это потому, что упаковка ИС позволяет полупроводникам служить дольше.
Если вы инженер, вы должны знать о них. И было бы полезно, если бы вы использовали их, чтобы ваш полупроводник работал много лет без возникновения неисправностей.
Ничего страшного, если вы не знаете об упаковке микросхем. Мы будем подробно говорить об этом позже в этом посте.
Но как это работает?
Упаковка ИС делает каждую микросхему на печатной плате защищенной от возможных воздействий и элементов.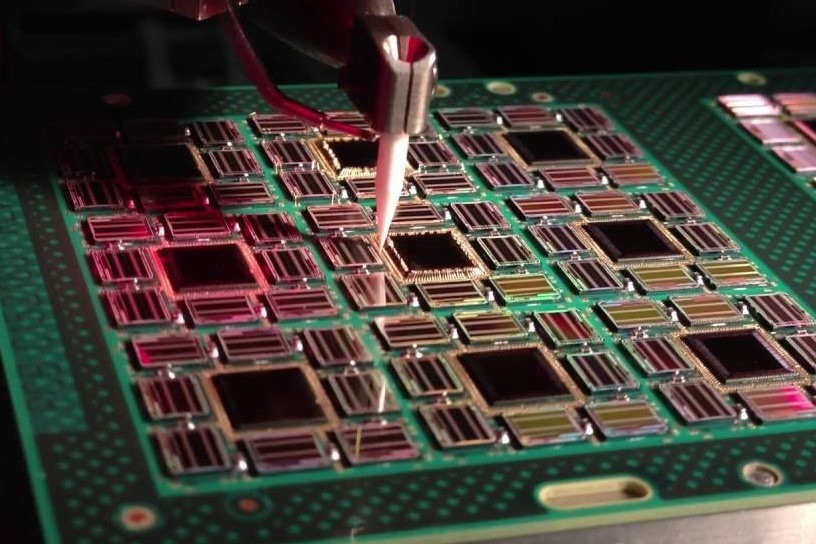
Итак, вы готовы к более глубоким знаниям об упаковке микросхем? Тогда давайте перейдем к статье.
1. Что такое упаковка IC?
Мы дадим определение корпусу ИС, также известному как корпус интегральной схемы, простыми словами.
Таким образом, это относится к любому компоненту, имеющему полупроводниковое устройство. И упаковка представляет собой оболочку, которая окружает схемное устройство. Кроме того, его основная цель состоит в том, чтобы предотвратить устройство от:
- Физических повреждений
- Коррозия
Но это еще не все.
Он также служит платформой, которая позволяет установленным на нем электрическим контактам подключаться к печатной плате.
Когда дело доходит до упаковки ИС, можно рассмотреть различные варианты. И это из-за различных доступных схем. Кроме того, к этим схемам предъявляются другие требования из-за их внешней оболочки.
На каком этапе необходима упаковка ИС?
Как правило, упаковка ИС является последней стадией производства полупроводниковых устройств. Следовательно, на этом этапе полупроводниковый компонент защищается в корпусе. И этот корпус делает одну вещь. Он защищает микросхему от возможного повреждения внешних элементов. Кроме того, он также защищает его от коррозии.
Следовательно, на этом этапе полупроводниковый компонент защищается в корпусе. И этот корпус делает одну вещь. Он защищает микросхему от возможного повреждения внешних элементов. Кроме того, он также защищает его от коррозии.
Итак, вот в чем дело.
Пакет корпуса представляет собой кожух. Он отвечает за защиту блока устройства. И это также помогает продвигать жизненно важные компоненты. Одним из таких являются электрические контакты. Эти компоненты помогают передавать сигналы на печатную плату электронного устройства.
История упаковки с интегральной схемой
С 1970-х годов технология упаковки с интегральной схемой неуклонно растет. Первоначально они начинались как пакет с шариковой решеткой (BGA). И большинство производителей электроники также использовали его.
Но позже, в начале 21-го века, более новые варианты обогнали пакеты с массивом штыревой сетки.
Новые разновидности назвали:
- Пластиковая четырехъядерная плоская упаковка
- Тонкая маленькая контурная упаковка
Со временем несколько производителей, таких как Intel, создали массивы наземных сетей.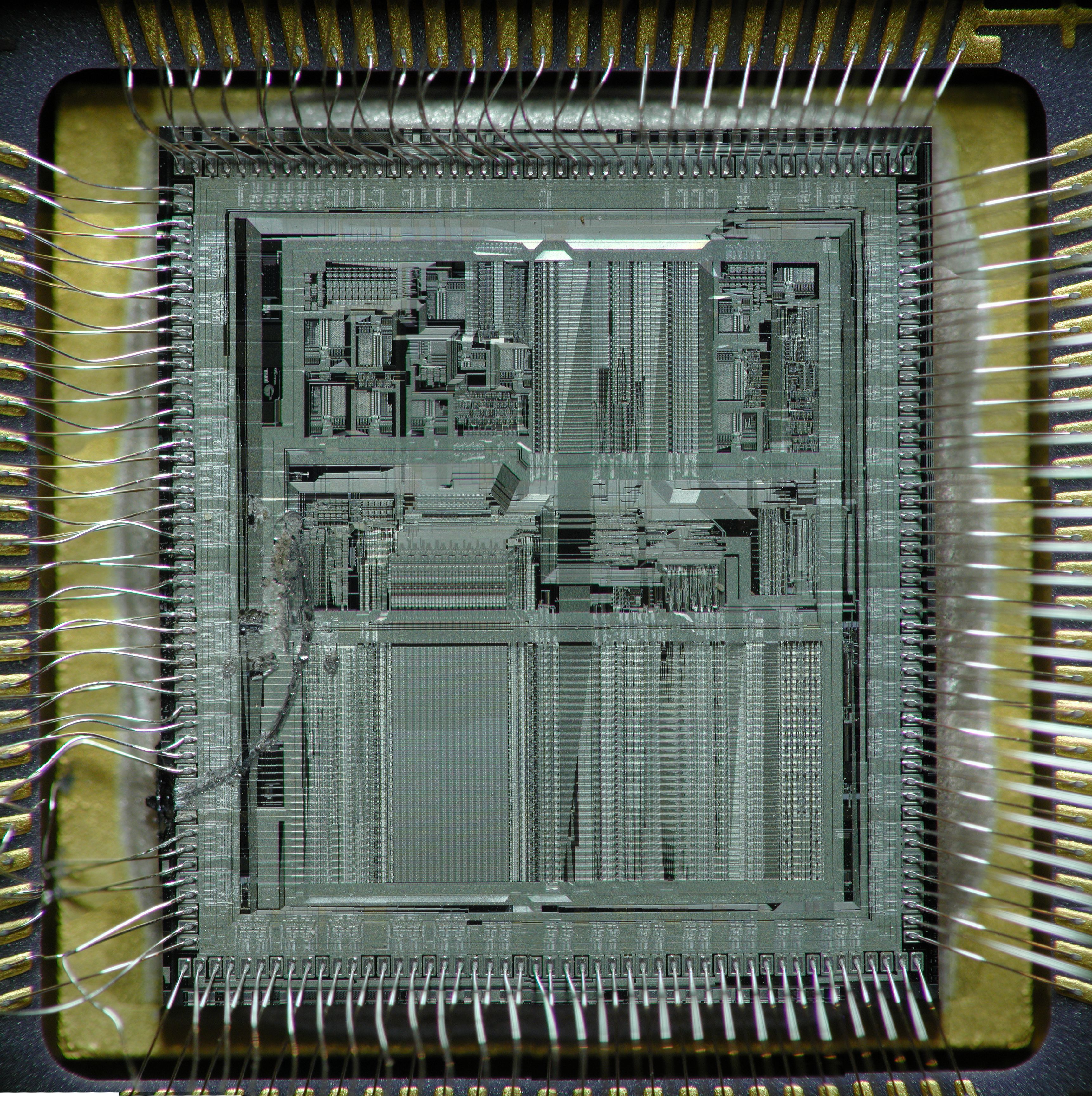
Тем временем массивы шаровых решеток с перевернутыми кристаллами (FCBGA) превзошли BGA. И это из-за того, что в FCBGA содержится больше контактов, чем в других конструкциях упаковки.
Кроме того, FCBGA имеет входные и выходные сигналы выше всего кристалла, в отличие от краев.
2. Различные типы упаковки ИС
Существует около десяти различных типов упаковки ИС. Но в этой статье мы перечислим четыре.
2.1 Комплекты для монтажа в сквозное отверстие
Эта упаковка ИС представляет собой монтажную конструкцию, используемую для электронных компонентов. И они включают использование свинца (Pb) на деталях, которые вставляются в просверленные отверстия печатной платы.
Они также приклеиваются к колодкам с обратной стороны. И это происходит с помощью механизированных установочных машин. Или с помощью ручной сборки, которая представляет собой ручную установку.
Упаковка для сквозного монтажа идеально подходит для деталей, которые не подходят для поверхностного монтажа.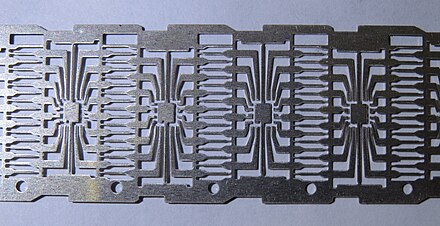 Примером этого являются силовые полупроводники с теплоотводом и большие трансформаторы.
Примером этого являются силовые полупроводники с теплоотводом и большие трансформаторы.
2.2 Упаковка для поверхностного монтажа
Упаковка ИС для поверхностного монтажа относится к методу, при котором электрические компоненты монтируются непосредственно на внешней стороне печатной платы.
Любое электрическое устройство, в котором используется этот метод упаковки ИС, является устройством для поверхностного монтажа (SMD).
Кроме того, появление технологии упаковки для поверхностного монтажа поглотило упаковку для монтажа в сквозное отверстие.
Почему так?
Это произошло потому, что SMT поддерживала автоматизированное производство. И это позволяет улучшить качество и снизить затраты.
Но это еще не все.
Упаковка для поверхностного монтажа имеет платформу, которая позволяет устанавливать большее количество компонентов в определенной области.
Кроме того, по сравнению с креплениями для сквозных отверстий размер SMT меньше.
- Плоские контакты
- Поводок различных видов или короткие булавки
- Заделки на внешней стороне компонента
- Матрица шариков припоя
2.3 Упаковки в масштабе чипа
Другое название корпусов в масштабе чипа — упаковка размером с чип. Он получил это название, потому что это один из немногих пакетов, которые имеют размер чипа.
Но это еще не все.
Для того чтобы корпус микросхемы был квалифицирован как масштабируемый, он должен соответствовать следующим критериям:
- Быть однокристальным
- Имеют корпус для непосредственного монтажа на поверхность
- Иметь площадь, которая менее чем в 1,2 раза превышает размер игральной кости
В 1993 г. генерал Мураками из Hitachi Cable и Джуничи Касаи из Fujitsu предложили описанную выше концепцию. Тем не менее, Mitsubishi Electric создала первую демо-концепцию.
Но это еще не все.
Технология масштабирования чипов требует следующего:
Во-первых, промежуточный элемент, в котором формируются шарики или подушечки, должен удерживать матрицу. И эта упаковка аналогична технологии упаковки массива шариковых решеток флип-чипа.
Во-вторых, контактные площадки могут быть напечатаны или выгравированы непосредственно на кремниевой пластине. В результате получается упаковка размером почти с кремниевый кристалл. Прекрасным примером такой упаковки является упаковка чипсов на уровне воды (WL-CSP) или упаковка на уровне воды (WLP).
В 1990-х годах началось производство WL-CSP. Но многие компании начали его серийное производство в начале 2000-х годов. Advanced Semiconductor Engineering — отличный пример компании, производившей WL-CSP серийно.
2.4 Массив шариковых решеток
Массив решетчатых шариков — это тип упаковки, используемый для стационарного монтажа микропроцессоров.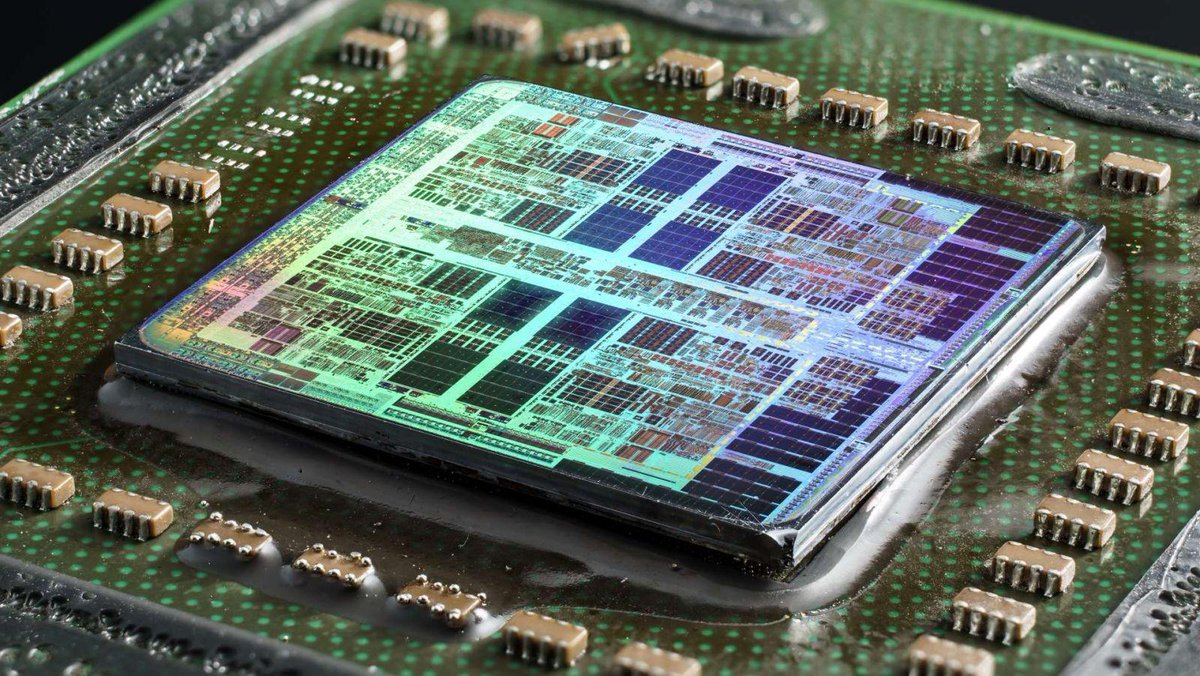
Но это еще не все.
В этом корпусе также больше соединительных контактов, чем в плоском или двухрядном корпусе.
Следовательно, лучшая часть этого пакета:
Вы можете использовать всю нижнюю поверхность, а не только периметр. А следы, примыкающие к упаковке, ведут к шарикам или проводам.
Есть еще.
Эти шарики или провода соединяют матрицу с более короткими упаковками, которые расположены только по периметру. В конце концов, пакет обеспечивает более высокую скорость и лучшую производительность.
Кроме того, вам, как инженеру, необходим точный контроль для пайки устройств BGA. И это из-за его очень тонкой системы. Таким образом, большинство компаний придерживаются автоматизированных процессов, чтобы избежать ошибок.
3. Какие материалы требуются для корпусов ИС и способ сборки
Требуемые материалы, используемые для изготовления различных корпусов ИС, очень важны.
Почему?
Это потому, что основу упаковки составляют три фактора. И это:
И это:
- Химические свойства
- Физические свойства
- Электрические свойства
Но это еще не все.
Производительность упаковки также является ограничивающим фактором.
Итак, давайте рассмотрим три основных материала упаковки.
3.1 Для материалов выводной рамки
Материалы выводной рамки являются преобладающими материалами корпусов ИС. Следовательно, инженеры используют их в основном для скрепления проволокой отделки и соединенных проволокой штампов. И прекрасный пример — золото или серебро.
Эти отделочные покрытия наносятся на внутреннюю контактную площадку методом точечного покрытия. Сделав это, вы сэкономите массу средств. И это потому, что благородные металлы не легко соединяются с инкапсулянтами.
3.2 Для керамических корпусов
Инконель или сплав 42 обычно выбирают для керамических корпусов. Почему? Это потому, что существует связь между сплавами и КТР.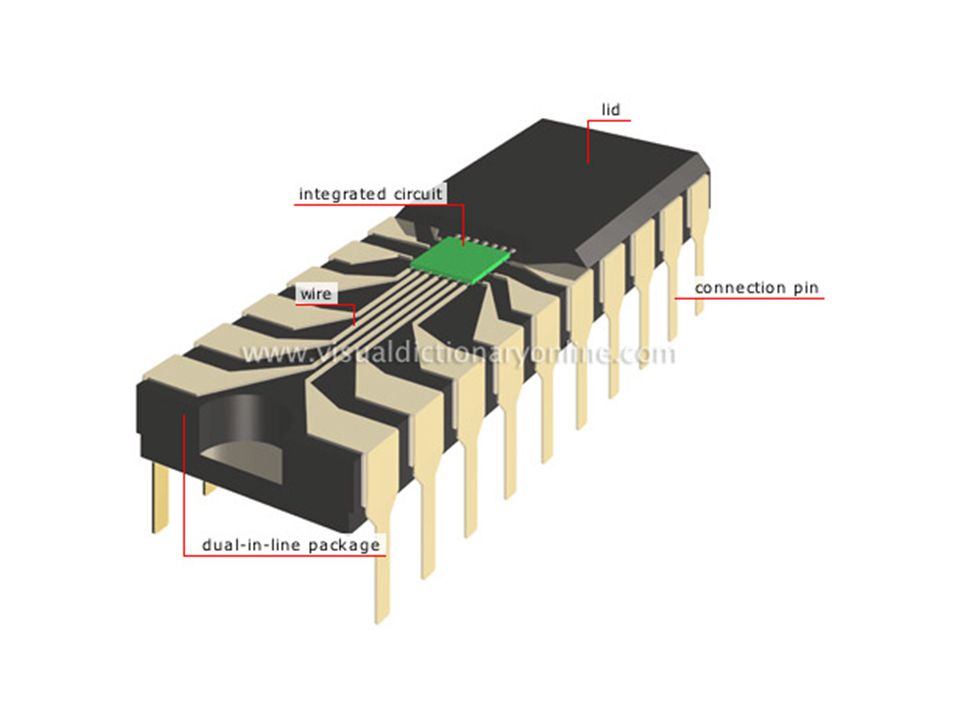 Точное совпадение является важной характеристикой из-за хрупкости керамики.
Точное совпадение является важной характеристикой из-за хрупкости керамики.
Но низкий КТР может иметь вредные последствия. И еще хуже, если вы устанавливаете окончательную сборку устройств поверхностного монтажа. Тем не менее, размер CTE играет значительную роль. И мы можем связать все с несоответствием наиболее распространенных подложек печатных плат.
Мы также должны отметить, что металлы с более низким КТР имеют отличную репутацию и хорошо подходят для изготовления свинцовых рамок. И они отлично подходят для пластиковых DIP-типа и керамических корпусов.
Однако медные материалы выводной рамки обычно являются идеальным выбором для пластиковых корпусов для поверхностного монтажа. И это потому, что они обладают способностью и соответствием требованиям для обеспечения безопасности паяных соединений.
Но это еще не все.
Медь также имеет более высокую проводимость, что является большим плюсом.
3.3 Ламинированные материалы
Для упаковки ИС вы можете заменить выводные рамки на ламинированные материалы. И они пригодятся, когда у вас много операций ввода-вывода. Или, возможно, вы ищете высокопроизводительные уровни.
И они пригодятся, когда у вас много операций ввода-вывода. Или, возможно, вы ищете высокопроизводительные уровни.
Но вот что вам следует знать.
С конца 1970-х годов существуют ламинаты. А затем они использовали их для систем «чип-на-плате». Следовательно, если вы внимательно посмотрите на чип на плате, вы заметите кое-что. Он поставляется со всеми необходимыми элементами, требуемыми в упаковке.
Плюс у него упаковка находится на прежнем месте.
Кроме того, упаковка из ламината является экономичным вариантом. Это даже более доступно, чем тонкие и толстые керамические подложки. Таким образом, большинство инженеров широко используют его из-за его экономической ценности.
Кроме того, инженеры предпочитают более новые органические ламинаты с более высокими температурами. И не только потому, что это выгодно. Но у них более предпочтительные электрические атрибуты. Отличным примером является более низкая диэлектрическая проницаемость.
4.
 Материалы для крепления штампа
Материалы для крепления штампа
Материалы для крепления штампа отлично подходят для приклеивания штампа к подложке. Сначала этот процесс может показаться простым, но к нему предъявляются различные требования. И это зависит от приложения.
Однако в большинстве случаев крепление матрицы идеально подходит для сборки проволокой лицевой стороной вверх. Значит, он теплопроводный. Но в некоторых случаях он электропроводен.
Кроме того, в процессе прикрепления штампа не должно быть вакуума в прикрепленном материале. Таким образом, вы сможете избежать горячих точек на кристалле. И по мере того, как повышается мощность материала для крепления кристалла, его ценность возрастает.
5. Герметики
Герметик больше похож на заключительную часть корпуса ИС. Следовательно, он выполняет основную функцию защиты. А герметики защищают тонкие соединительные провода и микросхемы от окружающей среды и физических повреждений.
Поэтому наносить его нужно аккуратно и осторожно.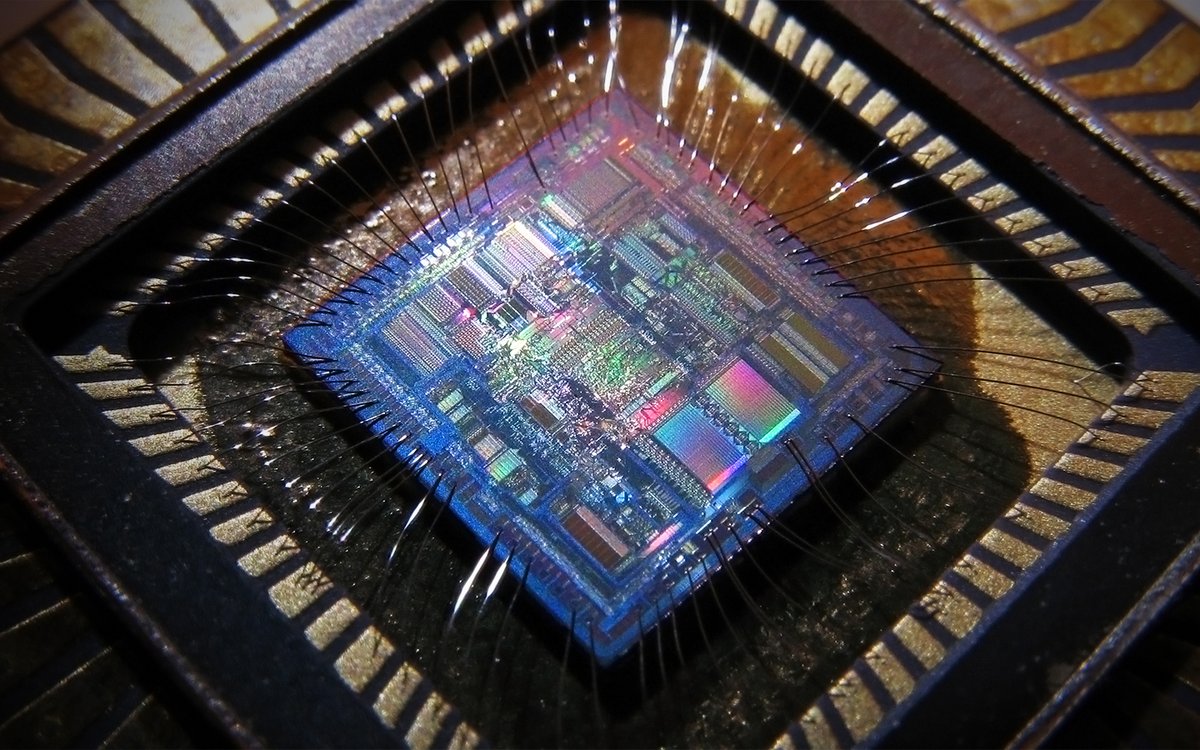 Таким образом, вы предотвратите проскальзывание проводов, что может привести к замыканию проводов друг на друга.
Таким образом, вы предотвратите проскальзывание проводов, что может привести к замыканию проводов друг на друга.
Но это еще не все.
Когда дело доходит до упаковки ИС, есть три основных типа полезных герметизирующих материалов:
5.1 Эпоксидная смола и эпоксидные смеси
Эпоксидная смола и эпоксидная смесь весьма популярны среди производителей. В конце концов, органические смолы наиболее распространены в строительных конструкциях. Кроме того, это выгодное сочетание тепловых характеристик и свойств по низкой цене.
5.2 Силиконовые материалы
Силиконовые материалы являются вторыми по популярности герметиками. И они пригодятся для микросхем. Без сомнения, режимы обработки и отверждения силиконовых материалов аналогичны органическим смолам.
Но этот материал не является органической смолой.
Существует два основных типа силиконовых смол:
- Вулканизуемый при комнатной температуре (RTV)
- На основе растворителя
Вы также можете добиться отверждения (превращения силикона в твердое вещество) с помощью различных механизмов.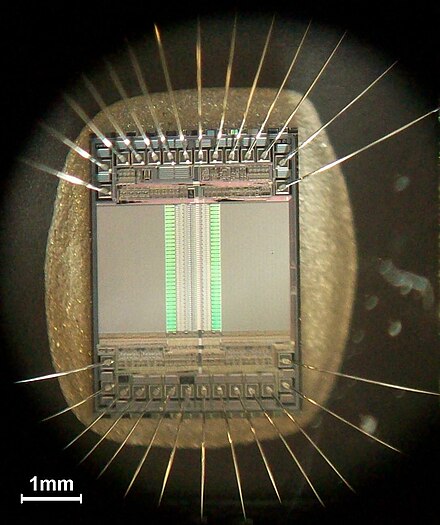 И это зависит от типа силиконового материала, который вы выберете.
И это зависит от типа силиконового материала, который вы выберете.
Что касается вулканизируемого при комнатной температуре, вы можете отверждать его одним из следующих способов:
- Добавление катализатора
- Воздействие влаги (комнатная влажность)
С другой стороны, наиболее распространенным способом отверждения смол на основе растворителей является термическое воздействие. Но закрепить смолы на основе растворителя можно только после испарения растворителя.
Силиконовые смолы являются популярным выбором для CSP, стремящихся соответствовать требованиям. И это потому, что эти смолы гибки в диапазоне температур (от -650 до 1500°C).
5.3 Полиимид
Этот герметик не так популярен, как предыдущие в этом списке. Кроме того, его редко можно найти в клеевых составах для приклеивания к штампу. Но это довольно распространено, когда речь идет о гибких печатных платах. И это прекрасный выбор благодаря таким полезным свойствам, как:
- Исключительная устойчивость к химическим веществам
- Впечатляющие электрические свойства
- Экстремальная прочность
- Отличная прочность на растяжение
- Стабильность в широком диапазоне температур
- Отличная термостойкость
- Широкий диапазон рабочих температур от -2000 до 3000C
6.
 Соединение проводов
Соединение проводов
Соединение проводов — это процесс, полезный для изготовления полупроводниковых устройств. Это также включает в себя создание взаимосвязей между ИС или другим полупроводниковым устройством и его корпусом.
Соединение проводов также пригодится, если вы планируете соединить микросхему с другой электроникой. Или если вы хотите создать соединение между двумя платами. Метод является наиболее экономичным. И вы можете использовать его на частотах выше 100 Гц.
Соединительные провода изготовлены из следующих материалов:
- Серебро
- Алюминий
- Золото
- Медь
Золотые провода довольно часто используются для соединения проводов. Но если у вас богатая азотом среда сборки, хорошим вариантом будет медная проволока.
Если вам нужна экономичная альтернатива, вы можете заклинить соединение алюминиевой проволокой.
Соединения с проволочным соединением бывают трех форматов:
- Ультразвуковое клиновое соединение при комнатной температуре
- Термокомпрессионное склеивание
- Термозвуковое склеивание шариков
Ультразвуковое соединение включает в себя соединение штампа и подложки. Кроме того, он начинается с использования отверстия на поверхности сборки компонентов для подачи проволоки.
Кроме того, он начинается с использования отверстия на поверхности сборки компонентов для подачи проволоки.
Если вы хотите подключить кремниевые ИС к компьютерам, идеально использовать термозвуковое соединение. И процедура помогает собрать компоненты процессоров. Следовательно, он объединяет схемы ноутбуков и ПК.
Термокомпрессионное соединение предполагает соединение двух металлов с помощью сочетания тепла и силы. Этот процесс помогает защитить корпуса устройств и электрические конструкции от поверхностного монтажа.
7. Склеивание пластин
Склеивание пластин осуществляется на уровне пластин. И пригодится для изготовления:
- Оптоэлектроника
- Микроэлектромеханические системы (МЭМС)
- Микроэлектроника
- Наноэлектромеханические системы (НЭМС)
Эта технология упаковки обеспечивает механически стабильную и герметичную герметизацию. Плюс диапазон его диаметров составляет 12 дюймов для производства устройств микроэлектроники. Напротив, МЭМС/НЭМС имеют диапазон диаметров от 4 до 8 дюймов.
Напротив, МЭМС/НЭМС имеют диапазон диаметров от 4 до 8 дюймов.
Склеивание пластин помогает защитить чувствительные внутренние структуры NEMS и MEMS от воздействия окружающей среды. Примеры воздействия на окружающую среду:
- Окисляющие вещества
- Температура
- Влага
- Высокое давление
Итак, упаковка должна соответствовать следующим требованиям:
- Тепловыделение
- Оптимальное обслуживание энергетических и информационных потоков
- Включение элементов по разным технологиям
- Защита от воздействия окружающей среды
- Совместимость с окружающей периферией
8. Дизайн упаковки с интегральной схемой
Разработка упаковки с интегральной схемой следующего поколения — лучший способ добиться следующего:
- Функциональная плотность
- Гетерогенная интеграция
- Силиконовый скейлинг
Кроме того, во многих случаях он идеально подходит для уменьшения общего размера упаковки.
Следовательно, однородная и разнородная упаковка ИС открывают путь к следующему:
- Ускорение выхода на рынок
- Устойчивость к выходу кремния
- Расширенная функциональность устройства
Сегодня появились различные технологические платформы ИС, которые отвечают следующим требованиям:
- Высокая производительность
- Оптимизация питания
- Экономическая эффективность
И они удовлетворяют потребности различных отраслей, таких как:
- Искусственный интеллект (ИИ)
- Высокопроизводительные вычисления (HPC)
- Аэрокосмическая отрасль
- Медицинский
- Интернет вещей
- Мобильные вычисления
- Автомобилестроение
- 5G
- Виртуальная реальность (VR)
- Дополненная реальность (AR)
Но мы должны отметить одну вещь о новых технологиях упаковки ИС.
Они создают уникальные узкие места для устаревших методологий упаковки и инструментов проектирования.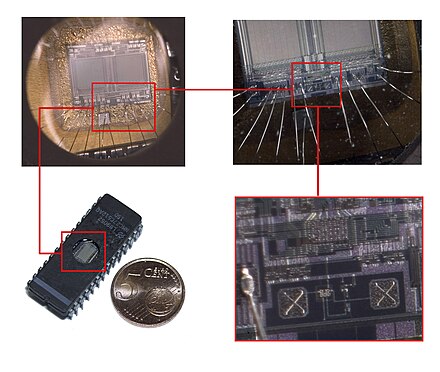
Итак, если ваша группа разработчиков должна использовать эти новые пакеты ИС, они должны сделать одну вещь.
Они должны работать над оптимизацией и проверкой всей своей инженерной системы. Это означает, что вы не можете останавливаться на отдельных элементах — вы должны запустить все.
Кроме того, вы должны знать следующий факт:
Мелкоразмерная печатная плата из ламината или наплавленной печатной платы очень похожа на традиционную конструкцию подложки для упаковки ИС. А традиционные производители печатных плат могут проектировать и изготавливать старые корпуса ИС с помощью модифицированных инструментов для печатных плат.
Но это совсем другая игра с современными продвинутыми пакетами, доступными сегодня. Они используют новейшие методы производства, процессы и материалы. Кроме того, они очень похожи на процессы литья кремния.
Они также требуют свежего и новаторского подхода к проектированию и проверке на каждом уровне.
Проблема с одним корпусом ИС, которую должен избегать каждый инженер
При работе с новейшими технологиями корпусирования ИС инженеры должны избегать следующего:
Точное скопление субстратов, так как оно может быть пассивным и активным одновременно.


 Такая пайка осуществляется с помощью паяльной пасты или навесок/прокладок припоя (преформ). Последние помещают между кристаллом и подложкой.
Такая пайка осуществляется с помощью паяльной пасты или навесок/прокладок припоя (преформ). Последние помещают между кристаллом и подложкой.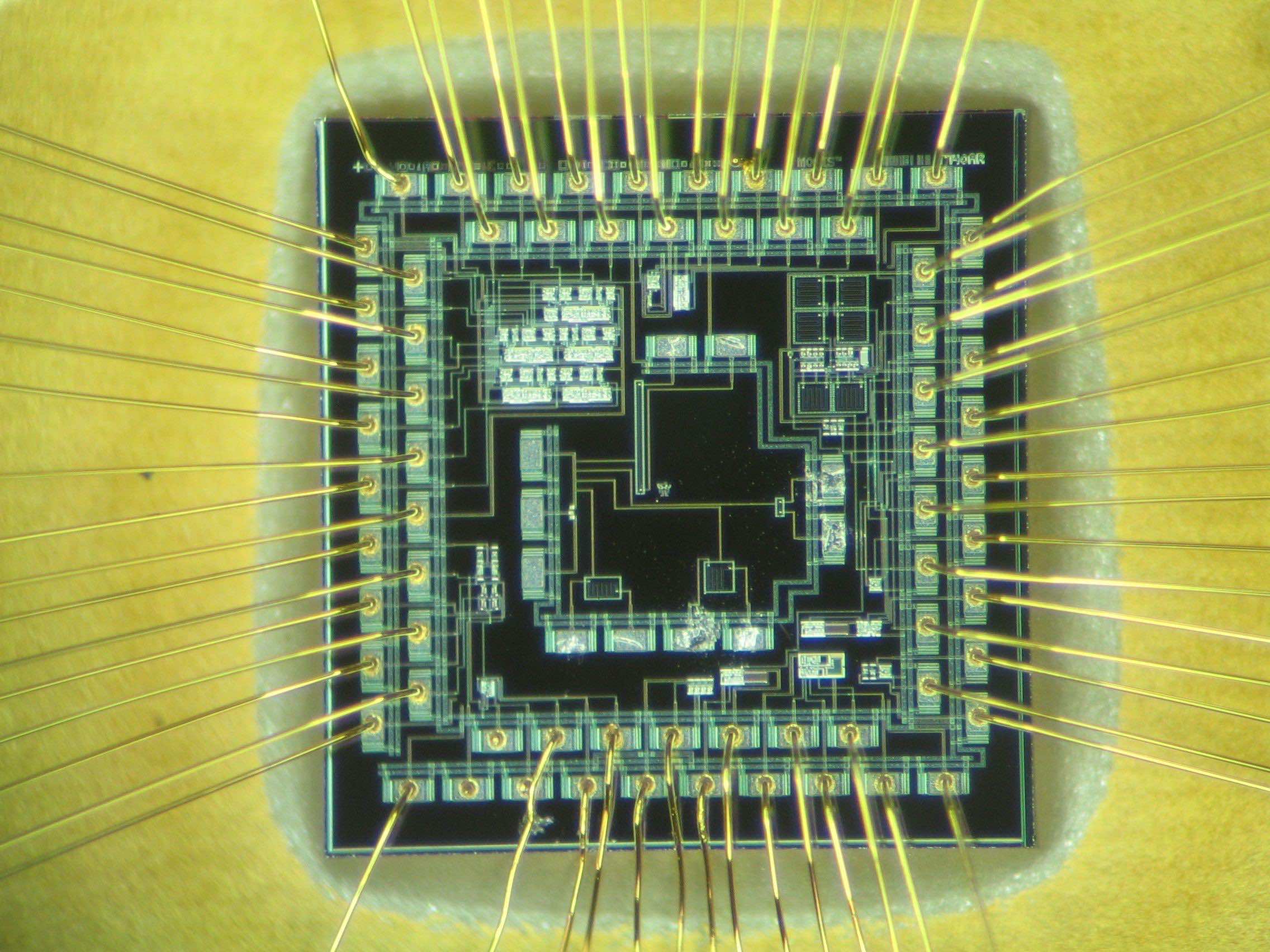 Для этого используется герметизирующий состав средней вязкости;
Для этого используется герметизирующий состав средней вязкости;