ПОЛУПРОВОДНИКИ • Большая российская энциклопедия
ПОЛУПРОВОДНИКИ́, вещества, характеризующиеся электрич. проводимостью $σ$, промежуточной между проводимостью хороших проводников, напр. металлов ($σ≈10^4-10^6$ Ом–1·см–1), и хороших диэлектриков ($σ≈10^{–12}-10^{–10}$ Ом–1·см–1) (проводимость указана при комнатной темп-ре). Характерной особенностью П. является сильная зависимость их проводимости от темп-ры, причём в достаточно широком интервале температур проводимость П., в отличие от металлов, экспоненциально увеличивается с ростом темп-ры $T$: $$σ=σ_0\exp(–ℰ_a/kT).\tag{*}$$ Здесь $k$ – постоянная Больцмана, $ℰ_a$ – энергия активации электронов в П., которая может меняться от нескольких мэВ до нескольких эВ, $σ_0$ – коэф. пропорциональности, который также зависит от темп-ры, но эта зависимость более слабая, чем экспоненциальная. С повышением темп-ры тепловое движение разрывает часть химич. связей в атомах П. и электроны, число которых пропорционально $\exp(–ℰ_a/kT)$, становятся свободными и участвуют в электрич. проводимости. Энергия, необходимая для того, чтобы разорвать химич. связь и сделать валентный электрон свободным, называется энергией активации.
П. и диэлектрики относят к одному классу материалов; различие между ними является скорее количественным, чем качественным. Проводимость диэлектриков также имеет активационный характер, однако $ℰ_a$ для них составляет 10 эВ и более, поэтому собств. проводимость диэлектриков могла бы стать существенной только при очень высоких темп-рах, при которых уже наступают структурные изменения вещества. В связи с этим термин «П.» часто понимают в узком смысле как совокупность веществ, полупроводниковые свойства которых ярко выражены при комнатной темп-ре (300 К).
Химич. связи могут быть разорваны не только тепловым движением, но и разл. внешними воздействиями: электромагнитным излучением, потоком быстрых частиц, деформацией, сильным электрич. и магнитным полями и др. Поэтому для П. характерна высокая чувствительность проводимости к внешним воздействиям, а также к концентрации структурных дефектов и примесей.
Классификация полупроводников
По агрегатному состоянию П. делятся на твёрдые и жидкие (см. Жидкие полупроводники), по внутр. структуре – на кристаллич. и аморфные (см. Аморфные и стеклообразные полупроводники), по химич. составу – на неорганические и органические. Наиболее широко изучены и используются в полупроводниковой электронике кристаллич. неорганич. П. К ним относятся:
– элементарные П. – элементы IV группы короткой формы периодич. системы химич. элементов – углерод С (графит, алмаз, графен, нанотрубки), германий Ge и кремний Si (базовый элемент большинства интегральных схем в микроэлектронике), элементы VI группы – селен Se и теллур Te, а также их соединения, напр. карбид кремния SiC, образующий слоистые структуры, и непрерывный ряд твёрдых растворов SixGe1–x;
– соединения AIIBVI, где А=Zn, Cd, Hg; B=S, Se, Te, напр. ZnTe, ZnSe, ZnO, ZnS, CdTe, CdS, HgTe и др.;
– соединения элементов I и V групп с элементами VI группы, напр. PbS, PbSe, PbTe, Bi2Se3, Bi2Te3,Cu2O и др.;
– тройные и четверные твёрдые растворы на основе соединений A III B V и A II B VI , напр. GaxAl1–xAs, GaxAl1–xN, CdxHg1–xTe, Cdx
Примеры аморфных и стеклообразных П.: аморфный гидрированный кремний a-Si:H, аморфные Ge, Se, Te, многокомпонентные стеклообразные сплавы халькогенидов на основе S, Se, Te.
К органическим П. относятся: ряд органич. красителей, ароматич. соединения (нафталин, антрацен и др.), полимеры с сопряжёнными связями, некоторые природные пигменты. Органич. П. существуют в виде монокристаллов, поликристаллич. или аморфных порошков и плёнок. Достоинство органич. П. – относит. дешевизна их произ-ва и механич. гибкость. Они применяются как светочувствит. материалы для фотоэлементов и ПЗС-матриц; на их основе созданы светоизлучающие диоды, в т. ч. для гибких экранов и мониторов.
Большинство изученных П. находятся в кристаллич. состоянии. Свойства таких П. в значит. мере определяются их химич. составом и симметрией кристаллич. решётки. Атомы кремния, обладая четырьмя валентными электронами, образуют кубич. кристаллич. решётку типа алмаза с ковалентной связью атомов (кристаллографич. класс $m\bar 3m$, или $O_h$). Такую же кристаллич. решётку имеют германий и серое олово. В GaAs каждый атом образует 4 валентные связи с ближайшими соседями, в результате чего получается кристаллич. решётка, подобная решётке алмаза, в которой ближайшими соседями катиона Ga являются анионы As и наоборот. За счёт частичного перераспределения электронов атомы Ga и As оказываются разноимённо заряженными и связи между атомами становятся частично ионными. Кристаллич. решётка GaAs не обладает центром инверсии, поэтому в таких П. возникают эффекты, отсутствующие в центросимметричных полупроводниковых структурах, напр. пьезоэлектричество (см. Пьезоэлектрики), генерация 2-й оптич. гармоники, фотогальванические эффекты. Структурой, подобной арсениду галлия, обладают InAs, InP, ZnTe, ZnSe и др.
Чистые и структурно совершенные П. получают в результате кристаллизации из расплава или раствора. Для создания тонких полупроводниковых плёнок применяют метод эпитаксии из жидкой или газовой фазы.
Электроны и дырки в полупроводниках
В твёрдом теле волновые функции валентных электронов соседних атомов перекрываются, их валентные электроны обобществляются и возникает устойчивая химич. (ковалентная) связь. На каждую связь между атомами приходится по два электрона, и распределение электронной плотности в пространстве оказывается жёстко фиксированным. Проводимость П. появляется, если разорвать связи между некоторыми атомами, напр., тепловым или оптич. воздействием, передав небольшой части валентных электронов дополнит. энергию и переведя их на вакантные (пустые) электронные орбитали, расположенные выше по энергии. Такие электроны могут свободно передвигаться по кристаллу, переходя с одного атома на другой, и переносить отрицат. электрич. заряд. Разорванная связь с недостатком электрона (дырка) также может перемещаться по кристаллу за счёт перехода на неё электрона из соседней связи. Поскольку разорванная связь означает наличие локального положительного электрич. заряда, дырки переносят положительный заряд. Дырки, как и электроны, могут перемещаться на значит. расстояния в периодич. потенциале кристалла без рассеяния.
В идеальных кристаллах, не содержащих дефектов и примесей, электроны и дырки всегда появляются па́рами в силу сохранения электрич. заряда, однако подвижности электронов и дырок, как правило, различны. В легированных П. концентрации свободных электронов и дырок могут различаться на неск. порядков, так что электропроводность осуществляется практически полностью носителями заряда одного типа.

Чередование разрешённых и запрещённых энергетических зон в кристаллических полупроводниках. Заполнение разрешённых зон: (а) при абсолютном нуле температуры; (б) при отличной от нуля температуре. Чёрны…
Последовательное и строгое описание состояний носителей заряда и их движения в кристаллах можно сделать в рамках зонной теории. Осн. состояние кристалла при темп-ре 0 К формируется за счёт последовательного заполнения электронами наинизших энергетич. состояний. Согласно принципу Паули, в каждом состоянии с определённым значением спина может находиться только один электрон. В зависимости от кристаллич. структуры и от числа электронов в каждом из атомов, составляющих кристалл, возможны два случая: 1) электроны полностью заполняют неск. нижних разрешённых зон, а все верхние зоны остаются пустыми; 2) одна из разрешённых зон заполнена частично. В первом случае распределение электронной плотности в кристалле фиксировано, электроны не могут участвовать в проводимости и кристалл является П. или диэлектриком. Во втором случае часть электронов в пределах частично заполненной зоны может свободно перемещаться по кристаллу3 и кристалл является металлом. В П. и диэлектриках верхняя полностью заполненная разрешённая зона энергий называется валентной зоной, нижняя пустая зона – зоной проводимости. Энергетич. интервал между дном (минимумом энергии) зоны проводимости и потолком (максимумом энергии) валентной зоны называется шириной запрещённой зоны $ℰ_g$. Различие между П. и диэлектриками чисто количественное: условно считают, что вещества с $ℰ_g<2$ эВ являются П., а с $ℰ_g>2$ эВ – диэлектриками. При отличной от нуля темп-ре тепловое движение перераспределяет электроны по энергии: часть электронов «забрасывается» из валентной зоны в зону проводимости. При этом появляются свободные носители заряда – электроны в зоне проводимости и дырки в валентной зоне (рис.). Количество свободных электронов и дырок экспоненциально зависит от темп-ры, поэтому температурная зависимость проводимости П. определяется формулой ( * ).
В широком классе П. ширина энергетич. зон значительно превышает тепловую энергию при комнатной темп-ре (0,025 эВ), поэтому носители заряда заполняют состояния только вблизи экстремумов разрешённых зон, т. е. вблизи дна зоны проводимости и потолка валентной зоны. Зависимость энергии от квазиимпульса вблизи экстремума часто оказывается квадратичной, и можно ввести представление об эффективной массе носителей заряда, которая зависит от номера разрешённой зоны и направления квазиимпульса. В некоторых П. одному значению энергии отвечает неск. экстремумов в первой зоне Бриллюэна и носители заряда распределены по эквивалентным «долинам» (окрестностям экстремумов). Такие П. называют многодолинными.
Примеси и дефекты в полупроводниках
Электрич. проводимость П. может быть обусловлена как электронами собственных атомов данного вещества (собственная проводимость), так и электронами и дырками примесных атомов (примесная проводимость). Процесс внедрения примесей в П. для получения необходимых физич. свойств называется легированием полупроводников. Поскольку энергия связи носителей заряда в примесных атомах составляет от нескольких мэВ до нескольких десятков мэВ, именно примесная проводимость объясняет экспоненциальный рост концентрации свободных носителей заряда в большинстве П. в интервале температур вблизи комнатной.
Примеси в П. обычно вводят в процессе роста структуры, они могут быть донорами или акцепторами, т. е. поставщиками электронов или дырок. Если, напр., в германий Ge или кремний Si (элементы IV группы) ввести примесные атомы элементов V группы (As, P), то 4 внешних электрона этих атомов образуют устойчивую связь с четырьмя соседними атомами решётки, а пятый электрон окажется несвязанным и будет удерживаться около примесного атома только за счёт кулоновского взаимодействия, ослабленного диэлектрич. поляризацией среды. Такой примесный атом является донором и легко ионизуется при комнатной темп-ре. Акцептор возникает, напр., при введении в Ge или Si элементов III группы (Ga, Al). В этом случае для образования всех четырёх связей с ближайшими атомами требуется дополнит. электрон, который берётся из внутр. оболочек атомов, так что примесный атом оказывается заряжен отрицательно. Электронейтральность восстанавливается за счёт того, что внутр. незаполненная орбиталь распределяется вблизи соседних атомов решётки, расположенных от примесного на расстояниях, превосходящих межатомное расстояние. Наличие доноров или акцепторов приводит соответственно к проводимости n- или р-типа.
П., в которых могут одновременно существовать акцепторные и донорные примеси, называются компенсированными. Компенсация примесей приводит к тому, что часть электронов от доноров переходит к акцепторам, и в результате возникает значит. концентрация ионов, которые эффективно влияют на проводимость полупроводников.
Амплитуда волновой функции электронов или дырок, локализованных на примесных атомах, составляет 1–10 нм. Это означает, что при концентрации примесных атомов ок. 1018 см–3 волновые функции электронов и дырок соседних атомов начинают перекрываться, носители заряда могут переходить от иона к иону и П. становится вырожденным (см. Вырожденные полупроводники). Такие П. называются сильнолегироваными. Из-за сильного экранирования кулоновского притяжения носители заряда в них оказываются свободными даже при таких низких темп-рах, при которых была невозможна термич. активация электрона или дырки из изолированного атома.
В отсутствие внешнего электрич. поля или освещения концентрация свободных носителей заряда называется равновесной и определяется шириной запрещённой зоны П., эффективными массами носителей заряда, концентрацией примесей и энергией связи примесных носителей заряда.
Наряду с примесями, источниками носителей заряда могут быть и разл. дефекты структуры, напр. вакансии (отсутствие одного из атомов решётки), межузельные атомы, а также недостаток или избыток атомов одного из компонентов в полупроводниковых соединениях (отклонения от стехиометрич. состава).
Электрические свойства полупроводников
Во внешнем электрич. поле на носители заряда в твёрдом теле действует сила, которая изменяет их скорость и приводит к направленному движению. Под действием силы носители заряда должны ускоряться, однако в кристаллах вследствие взаимодействия электронов с дефектами, колебаниями решётки и т. д. возникает сила трения, которая уравновешивает силу, действующую со стороны поля. В результате носители заряда движутся с постоянной средней (дрейфовой) скоростью $v_{др}$, зависящей от напряжённости $E$ электрич. поля. Можно ввести понятие подвижности носителей заряда $μ=v_{др}/E$. Действие силы трения означает, что в электрич. поле носитель заряда испытывает свободное ускорение только в промежутке времени $Δt$ между двумя актами рассеяния, так что $v_{др}=eEτ/m$ ($m$ – эффективная масса носителя, $e$ – его заряд, $τ$ – время релаксации, за которое свободный носитель заряда в отсутствие поля теряет свой направленный квазиимпульс). Обычно $τ$ не зависит от величины внешнего поля и определяется тепловым хаотич. движением носителей заряда в твёрдом теле, так что скорость теплового движения на неск. порядков превосходит $v_{др}$. Так, напр., для типичных П. при $T=300$ К в весьма сильном электрич. поле ($E$=3·104 В/м) скорость $v_{др}$ составляет 10–100 м/с, а величина ср. тепловой скорости – 105–106 м/с.
Величины $τ$ и $μ$ зависят от типа проводимости, химич. состава П., темп-ры, концентрации дефектов и примесей. При темп-рах ниже темп-ры кипения жидкого азота (77 К) подвижность $μ$ возрастает с ростом темп-ры, а при темп-рах выше 77 К – уменьшается, проходя через максимум вблизи 100 К. Такая зависимость $μ(T)$ объясняется наличием двух осн. причин рассеяния носителей заряда – на заряженных примесях и фононах. При низких темп-рах, когда примесные атомы ионизованы, рассеяние на них превосходит рассеяние на фононах, поскольку равновесных фононов мало. С увеличением темп-ры ср. энергия носителей возрастает, эффективность рассеяния уменьшается, время между столкновениями и подвижность возрастают. При темп-рах ок. 100 К резко возрастает концентрация равновесных фононов и взаимодействие с ними ограничивает подвижность, вследствие этого с увеличением темп-ры подвижность уменьшается. При $T$=300 К характерные значения $τ$ для П. лежат в интервале 10–13–10–12 с, а $μ$ – в интервале 102–10–2 м/с. При меньших значениях подвижности длина свободного пробега (произведение ср. скорости теплового движения на время $τ$) становится меньше расстояния между атомами и говорить о свободном движении носителей заряда нельзя. Возникает прыжковая проводимость, которая обусловлена перескоками носителей заряда в пространстве от одного иона к другому (реализуется в органических полупроводниках).
Направленному движению носителей заряда во внешнем электрич. поле препятствует их тепловое хаотич. движение. Если в результате приложения электрич. поля носители собираются у границы образца и их концентрация зависит от координат, то хаотич. движение приводит к выравниванию концентрации и носители переходят из области пространства с большей концентрацией в область, где их концентрация меньше. Такой процесс называется диффузией носителей заряда и определяется коэф. диффузии $D$. В условиях равновесия полный поток носителей заряда отсутствует, так что диффузионный поток полностью компенсирует поток частиц во внешнем поле. Это означает, что коэф. диффузии связан с подвижностью. Для невырожденных носителей $D=kTμ/e$ (соотношение Эйнштейна). Для типичных П. при комнатной темп-ре величина $D$ составляет 10–3–10–2 м2/с. Для неравновесных носителей заряда, напр. в случае инжекции в электронно-дырочном переходе (см. p–n-Переход), вводится понятие диффузионной длины $L_D$, которая определяет уменьшение числа носителей в процессе диффузии за счёт их рекомбинации: $L_D=\sqrt{D\tau_0}$, где $τ_0$ – время жизни неосновных носителей.
Наложение внешнего магнитного поля изменяет условия протекания электрич. тока в П. и приводит к гальваномагнитным явлениям, которые наиболее сильно проявляются в магнитных полупроводниках и полумагнитных полупроводниках. В П. для исследований и практич. применений наиболее часто магнитное поле прикладывают перпендикулярно электрич. полю, в этом случае имеют место Холла эффект и Шубникова – де Хааза эффект, классич. магнитосопротивление, слабая локализация носителей заряда, а в двумерных структурах – квантовый эффект Холла и дробный квантовый эффект Холла. В магнитном поле на заряженные частицы действует сила Лоренца, они начинают вращаться в плоскости, перпендикулярной направлению магнитного поля, с циклотронной частотой $ω_с$ и сохраняют свою скорость вдоль магнитного поля. В зависимости от величины произведения $ω_сτ$ различают классические слабые ($ω_сτ≪1$), классические ($ω_сτ>1$) и квантующие ($ωсτ≫1$ и $\hbar ω_с≫kT$) магнитные поля, где $\hbar$ – постоянная Планка.
В магнитных полях, когда $ω_сτ∼1$, движение носителей заряда можно описывать классич. уравнениями Ньютона, в этом случае имеет место эффект Холла, состоящий в возникновении дополнит. электрич. поля, перпендикулярного внешним электрич. и магнитному полям. Это дополнит. поле компенсирует поток частиц, вызванный совместным действием приложенных электрич. и магнитного полей, и зависит от величины магнитного поля и концентрации свободных носителей заряда, а его направление определяется знаком заряда, поэтому эффект Холла используется для определения знака и концентрации носителей заряда.
В более сильных полях, когда $ω_сτ≫1$, но характерная энергия носителей заряда значительно превосходит $\hbar ω_с$, необходимо учитывать квантование носителей заряда во внешнем магнитном поле, в результате плотность состояний как функция обратного поля приобретает вид острых, периодически расположенных пиков. При увеличении магнитного поля эти пики начинают пересекать уровень химич. потенциала электронного газа, в результате в квантующем магнитном поле сопротивление осциллирует.
В двумерных полупроводниковых структурах при $ω_сτ≫1$ и $\hbar ω_с≫kT$ возникает квантовый эффект Холла, состоящий в появлении ступенек на зависимости поперечного сопротивления от магнитного поля. Высота ступенек с большой точностью равняется кванту удельного сопротивления $h/e^2$. Значение продольного сопротивления обращается в нуль в магнитных полях, отвечающих ступенькам на зависимости поперечного сопротивления от магнитного поля и пикам между ступеньками. Такое поведение объясняется особенностями движения носителей заряда в сильном магнитном поле в условиях действия случайных электрич. и деформационных полей, имеющих разл. пространственный масштаб. При ещё большем магнитном поле имеет место дробный квантовый эффект Холла, проявляющийся в дополнит. расщеплении ступенек. Однако квантовый характер носителей заряда может проявляться и в слабых магнитных полях. Оказалось, что при низких темп-рах в П. и металлах наблюдается небольшое (ок. 1–5% от общего) изменение проводимости, пропорциональное квадрату магнитного поля. Этот эффект объясняется явлением слабой локализации, состоящим в увеличении сопротивления проводящих материалов за счёт усиления рассеяния назад при диффузионном движении частиц.
Оптические свойства полупроводников
Зонная структура кристаллов проявляется в свойствах пропускания, отражения и поглощения полупроводниками электромагнитного излучения. Наиболее очевидно существование запрещённой зоны следует из того, что излучение с энергией кванта, меньшей ширины запрещённой зоны $ℰ_g$ чистого П., не поглощается. Поглощение начинается только тогда, когда энергия кванта превысит $ℰ_g$. Для П. типа GaAs при низких темп-рах длина волны, на которой интенсивность падающего излучения уменьшается в $e$ раз, приблизительно равна 0,1 мкм. При таком поглощении кванта света в П. возникают электрон и дырка и имеет место закон сохранения квазиимпульса. Обычно импульс света значительно меньше квазиимпульсов носителей заряда, и при оптич. переходе электрона из валентной зоны в зону проводимости квазиимпульс не изменяется, так что в момент рождения электрон и дырка имеют противоположные квазиимпульсы. Такие переходы называются прямыми; они происходят в т. н. прямозонных П. (GaAs, InSb, Te, SiC), в которых потолок валентной зоны и дно зоны проводимости расположены в одной точке зоны Бриллюэна.
Электронные переходы со значит. изменением квазиимпульса происходят в т. н. непрямозонных П. (Ge, Si, AlAs, GaP), у которых вершина валентной зоны и дно зоны проводимости разнесены в пространстве квазиимпульсов на величину порядка $π/d$, где $d$ – межатомное расстояние в кристаллич. решётке. В этом случае для выполнения закона сохранения квазиимпульса необходимо участие третьей частицы, в качестве которой может выступать либо примесный атом, либо фонон. Типичная длина поглощения для непрямых переходов составляет 1–10 мкм.
В спектре поглощения П. присутствуют широкие энергетич. полосы, что указывает на то, что электроны в валентных зонах связаны слабо и легко поляризуются под действием электрич. поля. Это означает, что П. характеризуются относительно большой диэлектрич. проницаемостью $ε$, напр. в Ge $ε=16$, в GaAs $ε=11$, в PbTe $ε=30$. Благодаря большим значениям $ε$ кулоновское взаимодействие электронов и дырок друг с другом или с заряженными примесями сильно подавлено, если они находятся друг от друга на расстоянии, превышающем размеры элементарной ячейки. Это и позволяет во многих случаях рассматривать движение каждого носителя заряда независимо от других. Если бы кулоновское взаимодействие не ослаблялось, то примесные ионы могли бы связывать носители заряда в устойчивые, локализованные в пространстве образования с энергией ок. 10 эВ. В этом случае при темп-рах ок. 300 К тепловое движение практически не могло бы разорвать эти связи, создать свободные носители заряда и привести к заметной электропроводности. Такое связывание имеет место в П. и диэлектриках, но из-за ослабления кулоновского взаимодействия и относительно малых эффективных масс электронов и дырок (ок. 0,1–0,5 от массы свободного электрона) энергия связи таких образований (экситонов) составляет 1–50 мэВ, что много меньше энергии ионизации атомов. Экситоны легко ионизуются при темп-рах выше темп-ры жидкого азота и, т. о., не препятствуют образованию свободных носителей. Тем не менее при низких темп-рах образование экситонов приводит к поглощению в чистых П. электромагнитного излучения с энергией кванта, меньшей $ℰ_g$ на величину энергии связи экситона.
Прозрачность П. в узкой области частот вблизи края собств. поглощения изменяется под действием внешних (электрич., магнитного и др.) полей. Электрич. поле, ускоряя электрон, может в процессе оптич. перехода передать ему небольшую дополнит. энергию, в результате чего прямые оптич. переходы из валентной зоны в зону проводимости происходят под действием квантов света с энергией, меньшей $ℰ_g$ (Келдыша – Франца эффект).
В однородном магнитном поле закон сохранения квазиимпульса приводит к сохранению кругового движения электронов и дырок после поглощения излучения. В результате зависимость коэф. поглощения от частоты падающего излучения принимает вид узких пиков. Кроме собств. поглощения (за счёт прямых или непрямых переходов), в П. имеет место поглощение света свободными носителями, связанное с их переходами в пределах одной разрешённой зоны. Их вклад в общее поглощение мал, поскольку число свободных носителей заряда в П. малó по сравнению с полным числом валентных электронов, и для их реализации требуется участие третьей частицы – примеси или фонона. Кроме того, в нелегированных П. со значит. долей ионной связи наблюдается поглощение далёкого ИК-излучения за счёт возбуждения колебаний решётки – фононов.
Спектр фотолюминесценции П. сосредоточен в узкой области вблизи ширины запрещённой зоны. Вклад в фотолюминесценцию П. могут вносить разл. механизмы излучательной рекомбинации: зона – зона, зона – примесь, донор – акцептор, с участием фонона, излучение свободных, связанных или локализованных экситонов, экситон-поляритонная, биэкситонная рекомбинации. В нелегированных структурах с квантовыми ямами низкотемпературная фотолюминесценция обусловлена излучательной рекомбинацией экситонов, локализованных на шероховатостях поверхности и флуктуациях состава.
Оптич. свойства твёрдых растворов П. можно менять в широких пределах, подбирая химич. состав раствора, что обусловливает их широкое применение в приборах оптоэлектроники, в первую очередь в качестве рабочих материалов лазеров, свето- и фотодиодов, солнечных элементов, детекторов излучения.
Полупроводниковые гетеро- и наноструктуры
Совр. физика П. – это, прежде всего, физика полупроводниковых гетероструктур и наноструктур. В последних возникает ряд новых физич. явлений, которые невозможны в объёмных П., напр. квантовые целочисленный и дробный эффекты Холла. В наноструктурах движение свободных носителей заряда ограничено в одном или нескольких направлениях, что приводит к размерным эффектам, кардинально изменяющим энергетич. спектры носителей заряда, а также фононов и др. квазичастиц. Важную роль в наноструктурах играют гетерограницы, поскольку в системах малого размера отношение площади поверхности к внутр. объёму структуры является большим. Наиболее совершенные полупроводниковые наноструктуры получают методами молекулярно-пучковой эпитаксии и газофазной эпитаксии из металлоорганич. соединений.
В нач. 21 в. сложилась устойчивая терминология низкоразмерной физики П. Систематика начинается с одиночного гетероперехода между двумя композиционными материалами – полупроводниками A и B. Один или оба материала могут быть твёрдыми растворами (примеры гетеропар A/B: GaAs/Al1–xGaxAs, ZnSe/BeTe). По определению, в гетеропереходах первого типа запрещённая зона $ℰ_g$ одного из композиц. материалов лежит внутри запрещённой зоны др. материала. В этом случае потенциальные ямы для электронов или дырок расположены в одном и том же слое. В гетеропереходах второго типа дно зоны проводимости ниже в одном, а потолок валентной зоны выше в другом П. Для указанных гетеропар запрещённые зоны перекрываются. Имеются также гетеропереходы второго типа (напр., InAs/GaSb), у которых запрещённые зоны не перекрываются и дно зоны проводимости одного П. лежит ниже потолка валентной зоны другого П. К третьему типу относят гетеропереходы, в которых один из слоёв является бесщелевым П., напр. в паре HgTe/CdTe. Двойной гетеропереход B/A/B первого типа представляет собой структуру с одиночной квантовой ямой, если $ℰ^A_g<ℰ^B_g$, или структуру с одиночным барьером, если $ℰ^A_g>ℰ^B_g$.
К полупроводниковым наноструктурам относят квантовые ямы, квантовые проволоки, квантовые точки. В квантовой яме движение свободного носителя заряда (электрона или дырки) ограничено в одном из направлений. В результате возникает пространственное квантование и энергетич. спектр по одному из квантовых чисел из непрерывного становится дискретным – каждая трёхмерная энергетич. электронная зона превращается в серию двумерных подзон размерного квантования. Естеств. развитием однобарьерной структуры являются двух- и мультибарьерные структуры, на основе которых создаются резонансно-барьерные приборы. От одиночной квантовой ямы переходят к структуре с двумя или тремя квантовыми ямами и структурам с целым набором изолированных квантовых ям. По мере того как барьеры становятся тоньше, туннелирование носителей заряда из одной ямы в другую становится заметнее, и электронные состояния в подзонах размерного квантования изолированных ям трансформируются в трёхмерные минизонные состояния. В результате периодич. структура изолированных квантовых ям, или толстобарьерная сверхрешётка, превращается в тонкобарьерную сверхрешётку, или просто сверхрешётку. Полупроводниковая сверхрешётка используется для создания квантовых каскадных лазеров, излучение которых возникает при переходе электронов между слоями структуры.
Кроме структур с квантовыми ямами, существуют и др. двумерные системы, напр. графен и структура металл – диэлектрик – полупроводник (МДП-структура), которая используется в микроэлектронике в виде полевого МДП-транзистора.
В одномерных системах – квантовых проволоках – движение носителей заряда свободно только в одном направлении (напр., в углеродной нанотрубке, получаемой свёртыванием графеновой полоски и закреплением её противоположных сторон). Др. пример такой структуры – квантовая яма, выращенная на сколе, содержащем перпендикулярную ему квантовую яму. Квантовая механика допускает формирование одномерных электронных состояний на стыке двух таких ям.
В квантовых точках движение носителей заряда ограничено во всех трёх направлениях, напр. в нанокристаллах CdSe, выращенных в стеклянной матрице, и в эпитаксиальных квантовых точках GaAs/InAs, выращенных по механизму Странски – Крастанова.
Широкое применение получили полупроводниковые лазеры на квантовых ямах и массивах квантовых точек. В структуре с двойным ограничением стимулированное излучение выходит из торца, перпендикулярно направлению роста. Квантовый микрорезонатор, т. е. квантовые ямы или квантовые точки, выращенные в активной области оптич. микрорезонатора, используется для создания вертикально излучающих лазеров.
Возможность в широких пределах управлять физич. свойствами П. приводит к их многочисленным и разнообразным применениям (см. Полупроводниковые материалы).
Полупроводники — это… Что такое Полупроводники?
Полупроводники — вещества, которые по своей удельной проводимости занимают промежуточное место между проводниками и диэлектриками и отличаются от проводников сильной зависимостью удельной проводимости от концентрации примесей, температуры и различных видов излучения. Полупроводниками являются вещества, ширина запрещённой зоны которых составляет порядка нескольких эВ (электрон-вольта), то есть соизмерима с kT. Например, алмаз можно отнести к широкозонным полупроводникам, а InAs — к узкозонным.
В зависимости от того, отдаёт ли атом примеси электрон или захватывает его, примесные атомы называют донорными или акцепторными. Характер примеси может меняться в зависимости от того, какой атом кристаллической решётки она замещает, в какую кристаллографическую плоскость встраивается.
Проводимость полупроводников сильно зависит от температуры. Вблизи абсолютного нуля температуры полупроводники имеют свойства изоляторов.
Типы полупроводников в периодической системе элементов
В нижеследующей таблице представлена информация о большом количестве полупроводниковых соединений. Их делят на несколько типов: одноэлементные полупроводники IV группы периодической системы элементов, сложные: двухэлементные AIIIBV и AIIBVI из третьей и пятой группы и из второй и шестой группы элементов соответственно. Все типы полупроводников обладают интересной зависимостью ширины запрещённой зоны от периода, а именно — с увеличением периода ширина запрещённой зоны уменьшается.
Физические свойства и применения
Прежде всего, следует сказать, что физические свойства полупроводников наиболее изучены по сравнению с металлами и диэлектриками. В немалой степени этому способствует огромное количество эффектов, которые не могут быть наблюдаемы ни в тех ни в других веществах, прежде всего связанные с устройством зонной структуры полупроводников, и наличием достаточно узкой запрещённой зоны. Конечно же, основным стимулом для изучения полупроводников является производство полупроводниковых приборов и интегральных микросхем — это в первую очередь относится к кремнию, но затрагивает и другие соединения (Ge, GaAs, InP, InSb).
Кремний — непрямозонный полупроводник, оптические свойства которого широко используются для создания фотодиодов и солнечных батарей, однако его очень трудно заставить работать в качестве источника света, и здесь вне конкуренции прямозонные полупроводники — соединения типа AIIIBV, среди которых можно выделить GaAs, GaN, которые используются для создания светодиодов и полупроводниковых лазеров.
Собственный полупроводник при температуре абсолютного ноля не имеет свободных носителей в зоне проводимости в отличие от проводников и ведёт себя как диэлектрик. При легировании ситуация может поменяться (cм. вырожденные полупроводники).
В связи с тем, что технологи могут получать очень чистые вещества встаёт вопрос о новом эталоне для числа Авогадро.
Легирование
Объёмные свойства полупроводника могут сильно зависеть от наличия дефектов в кристаллической структуре. И поэтому стремятся выращивать очень чистые вещества, в основном для электронной промышленности. Легирующие примеси вводят для управления величиной и типом проводимости полупроводника. Например, широко распространённый кремний можно легировать элементом V подгруппы периодической системы элементов — фосфором, который является донором, и создать n-Si. Для получения кремния с дырочным типом проводимости (p-Si) используют бор (акцептор). Также создают компенсированные полупроводники с тем чтобы зафиксирован уровень Ферми в середине запрещённой зоны.
Методы получения
Свойства полупроводников зависят от способа получения, так как различные примеси в процессе роста могут изменить их. Наиболее дешёвый способ промышленного получения монокристаллического технологического кремния — метод Чохральского. Для очистки технологического кремния используют также метод зонной плавки.
Для получения монокристаллов полупроводников используют различные методы физического и химического осаждения. Наиболее прецизионный и дорогой инструмент в руках технологов для роста монокристаллических плёнок — установки молекулярно-лучевой эпитаксии, позволяющей выращивать кристалл с точностью до монослоя.
Оптика полупроводников
Поглощение света полупроводниками обусловлено переходами между энергетическими состояниями зонной структуры. Учитывая принцип запрета Паули, электроны могут переходить только из заполненного энергетического уровня на незаполненный. В собственном полупроводнике все состояния валентной зоны заполнены, а все состояния зоны проводимости незаполненные, поэтому переходы возможны лишь из валентной зоны в зону проводимости. Для осуществления такого перехода электрон должен получить от света энергию, превышающую ширину запрещённой зоны. Фотоны с меньшей энергией не вызывают переходов между электронными состояниями полупроводника, поэтому такие полупроводники прозрачны в области частот  , где Eg — ширина запрещённой зоны,
, где Eg — ширина запрещённой зоны,  — постоянная Планка. Эта частота определяет фундаментальный край поглощения для полупроводника. Для полупроводников, которые зачастую применяются в электронике (кремний, германий, арсенид галлия) она лежит в инфракрасной области спектра.
— постоянная Планка. Эта частота определяет фундаментальный край поглощения для полупроводника. Для полупроводников, которые зачастую применяются в электронике (кремний, германий, арсенид галлия) она лежит в инфракрасной области спектра.
Дополнительные ограничения на поглощение света полупроводников накладывают правила отбора, в частности закон сохранения импульса. Закон сохранения импульса требует, чтобы квазиимпульс конечного состояния отличался от квазиимпульса начального состояния на величину импульса поглощённого фотона. Волновое число фотона 2π / λ, где λ — длина волны, очень мало по сравнению с волновым вектором обратной решётки полупроводника, или, что то же самое, длина волны фотона в видимой области намного больше характерного межатомного расстояния в полупроводнике, что приводит к требованию того, чтобы квазиимпульс конечного состояния при электронном переходе практически равнялся квазиимпульсу начального состояния. При частотах, близких к фундаментальному краю поглощения, это возможно только для прямозонных полупроводников. Оптические переходы в полупроводниках, при которых импульс электрона почти не меняется называются прямыми или вертикальными. Импульс конечного состояния может значительно отличаться от импульса начального состояния, если в процессе поглощения фотона участвует ещё одна, третья частица, например, фонон. Такие переходы тоже возможны, хотя и менее вероятны. Они называются непрямыми переходами.
Таким образом, прямозонные полупроводники, такие как арсенид галлия, начинают сильно поглощать свет, когда энергия кванта превышает ширину запрещённой зоны. Такие полупроводники очень удобны для использования в оптоэлектронике.
Непрямозонные полупроводники, например, кремний, поглощают в области частот света с энергией кванта чуть больше ширины запрещённой зоны значительно слабее, только благодаря непрямым переходам, интенсивность которых зависит от присутствия фононов, и следовательно, от температуры. Граничная частота прямых переходов кремния больше 3 эВ, то есть лежит в ультрафиолетовой области спектра.
При переходе электрона из валентной зоны в зону проводимости в полупроводнике возникают свободные носители заряда, а следовательно фотопроводимость.
При частотах ниже края фундаментального поглощения также возможно поглощение света, которое связано с возбуждением экситонов, электронными переходами между уровнями примесей и разрешенными зонами, а также с поглощением света на колебаниях решетки и свободных носителях. Экситонные зоны расположены в полупроводнике несколько ниже дна зоны проводимости благодаря энергии связи экситона. Экситонные спектры поглощения имеют водородоподобную структуру энергетических уровней. Аналогичным образом примеси, акцепторы или доноры, создают акцепторные или донорные уровни, лежащие в запрещённой зоне. Они значительно модифицируют спектр поглощения легированного полупроводника. Если при непрямозонном переходе одновременно с квантом света поглощается фонон, то энергия поглощенного светового кванта может быть меньше на величину энергии фонона, что приводит к поглощению на частотах несколько ниже по энергии от фундаментального края поглощения.
Полупроводники
- кремний, Si
- германий, Ge
- серое олово, α-Sn
- карбид кремния, SiC
- нитрид бора, BN
- нитрид алюминия, AlN
- фосфид алюминия, AlP
- арсенид алюминия, AlAs
- нитрид галлия, GaN
- фосфид галлия, GaP
- арсенид галлия, GaAs
- антимонид галлия, GaSb
- фосфид индия, InP
- арсенид индия, InAs
- антимонид индия, InSb
- селенид цинка, ZnSe
- селенид кадмия, CdSe
- теллурид кадмия, CdTe
- теллурид цинка, ZnTe
- теллурид ртути, HgTe
- оксид цинка, ZnO
- диоксид титана, TiO2
- сульфид цинка, ZnS
- сульфид свинца, PbS
- теллурид свинца, PbTe
- теллурид олова, SnTe
- теллурид висмута, Bi2Te3
- органические полупроводники
См. также
Ссылки
Wikimedia Foundation. 2010.
Аморфный полупроводник — Википедия
Аморфный полупроводник — вещество в аморфном состоянии, которое имеет ряд свойств, характерных для кристаллических полупроводников. К таким свойствам, в частности, относятся сильная температурная зависимость электрической проводимости, существование порога оптического поглощения[1][2][3]. Важность этих материалов обусловлена уникальными свойствами, которые открывают широкие возможности для их практического использования. Наиболее изученными аморфными полупроводниками являются аморфные германий и кремний, сплавы халькогенидов с различными металлами (например, As-S-Se, As-Ge-Se-Тe), стекловидные селен и теллур.
Электронная структура[править | править код]
 Схематическое изображение структуры кристаллического, аморфного и аморфного гидрогенизированного кремния.
Схематическое изображение структуры кристаллического, аморфного и аморфного гидрогенизированного кремния.Свойства аморфных полупроводников как неупорядоченных систем, для которых отсутствует дальний порядок, не могут быть объяснены на основе классической зонной теории для кристаллов. Атомы в аморфном полупроводнике вместо упорядоченного расположения образуют непрерывную случайную сеть. Благодаря своей структуре некоторые атомы имеют оборванные связи, которые, фактически, являются дефектами в непрерывной случайной сети и могут привести к аномальной электропроводности материала. Однако из-за наличия ближнего порядка в аморфных полупроводниках некоторые особенности энергетического спектра электронов и электронных свойств подобны свойствам кристаллических полупроводников. Хотя энергетический спектр аморфных полупроводников и подобный энергетического спектра кристаллических, он не тождественен ему.
Для обоих типов полупроводников характерно наличие валентной, запрещенной и зоны проводимости. Близки и формы распределения плотности состояний в валентной зоне и зоне проводимости. В то же время структура состояний в запрещённой зоне в некристаллических полупроводниках отличается от кристаллических. Вместо четко очерченной запрещенной зоны, которая наблюдается в кристаллических полупроводников, запрещённая зона аморфных полупроводников содержит обусловленные структурным разупорядочением локализованные состояния, которые формируют хвосты плотности состояний выше валентной зоны и ниже зоны проводимости. Эти хвосты локализованных состояний распространяются в запрещённую зону на несколько десятых эВ. Те состояния, которые находятся ближе к середине запрещённой зоны, более локализованы («мелкие» локализованные состояния), находящиеся ближе к краям зон — протяжённые. Такой аналог запрещённой зоны полупроводников, в аморфных полупроводниках сплошь заполнен локализованными уровнями, называется щелью подвижности или запрещённой зоной по подвижности, а границы щели подвижности, которые разделяют локализованные и делокализованных состояний, называются порогами подвижности.
«Мелкие» локализованные состояния в хвостах зон, находящихся в тепловом обмене с делокализованных состояниями выше порога подвижности, представляют собой уровни «прилипания». Многократный захват резко снижает дрейфовую подвижность носителей тока. Взаимодействие свободных электронов в разрешённых зонах с «мелкими» локализованными состояниями в хвостах зон обуславливает переход к дрейфовому характеру переноса. Если система локализованных состояний характеризуется высокой плотностью, то дрейф заменяется дисперсионным транспортом [4] .
Проводимость[править | править код]
Для аморфных полупроводников выделяют три механизма электропроводности, которые преобладают в различных температурных диапазонах [2] :
- проводимость, обусловленная носителями в делокализованных состоянии, температурная зависимость которой описывается выражением:
- σ=σ1e−ΔE/kT{\displaystyle \sigma =\sigma _{1}e^{-\Delta E/kT}}.
Этот тип проводимости, аналогичный собственной проводимости кристаллических полупроводников, преобладает при высоких температурах;
- проводимость, обусловленная носителями, возбужденными в локализованные состояния в «хвостах» зон .
- проводимость, обусловленная носителями, которые совершают прыжки между локализованными состояниями вблизи уровня Ферми, то есть прыжковая проводимость, которая описывается формулой Мотта для трёхмерногослучая:
- σ=σ3e−(T0/T)1/4{\displaystyle \sigma =\sigma _{3}e^{-(T_{0}/T)^{1/4}}}.
Прыжковая проводимость преобладает при низких температурах. В халькогенидных стеклообразных проводниках эффективное взаимодействие между локализованными электронами может носить характер притяжения; это приводит к их спариванию, и прыжковая проводимость, как правило, не наблюдается.
В отличие от кристаллических, большинство аморфных полупроводников практически нечувствительны к добавлению примесей. Объяснение может заключаться в том, что в аморфных веществах может осуществляться такая перестройка связей, где все валентные электроны примесного атома будут участвовать в связях. Так, например, в кристаллическом кремнии атом фосфора образует четыре ковалентных связи. Предполагается, что в аморфном кремнии атом фосфора окружен пятью атомами кремния. Если это так, то примесные уровни образовываться не будут.
Следует отметить, что дрейфовая подвижность носителей тока в аморфных полупроводниках значительно ниже подвижности в кристаллах. Большинство аморфных полупроводников характеризуются заметной фотопроводимостью .
Эффект переключения[править | править код]
Для многих халькогенидных стекловидных полупроводников в системах металл — полупроводниковая пленка наблюдается быстрый (~ 10−10с) обратный эффект переключения с высокоомного в низкоомное состояние, при котором проводимость возрастает на несколько порядков под действием сильного электрического поля[5]. В частности, существует переключение с «памятью», когда низкоомное состояние сохраняется и после снятия электрического поля (эффект Овчинского). Эта «память» стирается сильным и коротким импульсом тока. Единственная теория, которая объясняла бы это явление, по состоянию на 2019 год не создана, разработан только ряд моделей и гипотез, хотя соответствующие аморфные полупроводники уже используются для создания элементов памяти.
Природа эффекта переключения может быть как электронная за счёт инжекции носителей тока из металлического контакта в полупроводник, так и тепловая вследствие эффекта шнурования тока. Инжекции носителей можно достичь, приложив высокое напряжение между металлических контактов на поверхности аморфного полупроводника. Если напряжение уменьшить, то электроны «упадут» из проводящих состояний в ловушки вблизи верхнего края щели подвижности, откуда затем могут быть легко возбуждены в зону проводимости. Эта неравновесная ситуация может привести к такому заселению энергетических состояний вблизи верхнего края щели подвижности, как будто уровень Ферми поднялся в эту область. В результате проводимость полупроводника возрастёт. По тепловой природы эффекта переключения в проводнике возникает горячая «нить», в результате увеличения температуры в которой проводимость вещества в ней также растёт. Увеличение температуры является следствием выделения тепла Джоуля — Ленца при прохождении электрического тока через полупроводник.
Оптические свойства[править | править код]
Оптические свойства аморфных полупроводников обусловлены их электронный структурой. Исследование оптических свойств даёт обширную информацию о зонной структуре[6]. Сравнение оптических свойств некристаллических полупроводников с кристаллическими указывает на сходство этих свойств, но не тождественность. В спектрах поглощения аморфных полупроводников, как и кристаллических, имеется полоса собственного поглощения, положение края которой определяет ширину оптической запрещенной зоны. Коэффициент оптического поглощения аморфных полупроводников α(ω){\displaystyle \alpha (\omega )} заметно падает до некоторой пороговой частоты ω0{\displaystyle \omega _{0}}. Поэтому в зависимости от способа получения аморфного полупроводника наблюдается два типа поведения:
- коэффициент оптического поглощения резко обрывается по пороговой частоте, практически падая до нуля, образуя резкий край зоны (край поглощения)
- коэффициент оптического поглощения только уменьшается, оставаясь конечным в области частот, ниже пороговой, образуя «хвост» в спектре поглощения.
Наличие края поглощения можно объяснить тем, что, несмотря на большую концентрацию локализованных состояний в запрещённой зоне подвижности, оптически возбуждены переходы между локализованными состояниями маловероятны из-за большого расстояния.
Частотная зависимость коэффициента поглощения в области оптического «хвоста» хорошо описывается правилом Урбаха [7] :
- α(ω)∼exp{−h(ω−ω0)/2πE}{\displaystyle \alpha (\omega )\sim \exp\{-h(\omega -\omega _{0})/2\pi \mathrm {E} \}},
где E{\displaystyle \mathrm {E} }- некоторая характерная энергия. В области частот, превышающих пороговую, частотная зависимость коэффициента поглощения достаточно хорошо описывается формулой
- α(ω)∼(ω−ω0)2/ω{\displaystyle \alpha (\omega )\thicksim (\omega -\omega _{0})^{2}/\omega }.
Если сравнивать спектры поглощения аморфного полупроводника и того же полупроводника в кристаллическом состоянии, то кроме сдвига края поглощения в длинноволновую область наблюдается уширение спектрального максимума, который сдвигается в область коротких волн. Пики в спектрах α(ω){\displaystyle \alpha (\omega )}, отвечающие особым точкам Вант — Хоффа в кристаллических полупроводниках, в аморфных обычно «размываются», иногда вообще исчезая.
Экситонные линии в спектрах оптического поглощения аморфных полупроводников, как правило, не наблюдаются[7].
Многие аморфные полупроводники характеризуются выраженной фотопроводностью, однако, в отличие от кристаллических полупроводников, концентрация фотовозбуждённых неравновесных носителей тока в них может на порядок превышать концентрацию равновесных при одной и той же температуре. Зависимость фотопроводимости σϕ{\displaystyle \sigma _{\phi }} от интенсивности света I{\displaystyle I} в большинстве аморфных полупроводников может быть описана зависимостью σϕ∼In,{\displaystyle \sigma _{\phi }\sim I^{n},} где 0,5≤n≤1.{\displaystyle 0{,}5\leq n\leq 1.}
Технологии получения аморфных полупроводников проще и продуктивнее технологии получения кристаллических, что существенно удешевляет соответствующие материалы и продукты на их основе. Аморфные кремний и германий получают путем их испарения и конденсации в глубоком вакууме или катодной распылением в аргоновой плазме.
Практическое применение аморфных полупроводников определяется особенностями их структуры, свойств, химической стойкостью и механической прочностью, а также технологичностью их обработки и возможностью получения материалов с заданными свойствами. Преимущества неупорядоченных полупроводников, которые определяют их практическое применение, по сравнению с кристаллическими заключаются в следующем[8]:
- практическое отсутствие ограничений по площади;
- низкая (по сравнению с монокристаллами) стоимость производства, слабая связь «размеры-стоимость»;
- возможность изготовления электронных матриц на некристаллических подложках;
- соотношение некоторых электрофизических характеристик, которые недоступны в кристаллах;
- наличие уникальных эффектов, которые отсутствуют в кристаллах и позволяют разработку приборов на новых принципах.
Аморфные полупроводники используются для создания фотоэлектрических преобразователей, тонкоплёночных транзисторов, элементов памяти, жидкористалических дисплеев. Некоторые устройства регистрации оптических изображений удалось создать только благодаря использованию аморфных полупроводников. К таким устройствам относятся, например, телевизионные трубки типа «видикон», современные фотокопировальные приборы и регистрирующие среды типа «халькогенидных стекловидный полупроводник — термопластик».
В 1956 году Н. А. Горюнова и Б. Т. Коломиец обнаружили, что некоторые стекловидные халькогениды имеют полупроводниковые свойства. Выявление этого факта, а также следующие фундаментальные работы А. Ф. Иоффе, А. Р. Регеля, А. И. Губанова, Н. Мотта и Э. Дэвиса стали толчком к большому числу теоретических и экспериментальных исследований аморфных полупроводников.
В 1960 году Иоффе и Регель высказали предположение, что электрические свойства аморфных полупроводников определяются не дальним, а ближним порядком. На основе этой идеи была развита теория неупорядоченных материалов, которая позволила объяснить многие свойства некристаллических веществ. В 1961—1962 годах А. Д. Пирсоном, Б. Т. Коломийцем, С. Г. Овшинским независимо друг от друга был обнаружен эффект переключения. В патентной литературе эффект переключения, на который Овшинским в 1963 году был получен патент США, называется эффектом Овшинского. Он впервые указал на возможность использования эффекта переключения для создания элементов памяти. Значительный прогресс в теоретических и экспериментальных исследованиях, а также перспективы практического использования аморфных полупроводников способствовали значительному повышению интереса к ним со стороны научного сообщества.
Наибольших успехов здесь удалось достичь в начале 70-х годов, когда были разработаны промышленные технологии получения аморфных полупроводниковых галогенидов, из которых были изготовлены кинескопы, флуоресцентные ламп тлеющего разряда, оптические приборы памяти, поляризационные переключатели, процессоры для фотолитографии и тому подобное.
В 1972 году было проведено первое заседание японского постоянного семинара по физике и использование аморфных полупроводников под руководством керамического общества Японии[9]. С 1974 по 1982 год семинары по физике и использование аморфных полупроводников проводились практически ежегодно. Открытие в 1976 году возможности легирования аморфного кремния (a-Si), полученного в тлеющем разряде, положило начало использованию его фотопроводящих свойств, связанных с сильным оптическим поглощением в видимой части спектра. В 1979 году был создан первый тонкоплёночный транзистор на основе a-Si.
- Аморфные полупроводники и приборы на их основе / под ред. Горелика С. С.. — М.: Металлургия, 1986. — 366 с. (рус.)
- Чабан И. А. Эффект переключения в халькогенидных стеклах // Физика твердого тела. — 2007. — Т. 49. — С. 405—410. (рус.)
- Мотт Н., Дэвис Э. Электронные процессы в некристаллических веществах. — 2-е изд., перераб. и доп. — : Мир, 1982. — 386 с. (рус.)
- Забродский А. Г.,Немов С. А.,Равич Ю. И. Электронные свойства неупорядоченных систем.. — С.-Петербург: «Наука», 2000. — 70 с. — ISBN 5-02-024927-0. (рус.)
- Меден А. Физика и примененение аморфных полупроводников: пер. с англ. / А. Меден, М. Шо. — М.: Мир, 1991. — 670 с. — ISBN 5-03-001895-6. (рус.)
- Названов В. Ф. Физика неупорядоченных полупроводников: Учеб. пособие для студ. физ. и мех.- мат. фак.. — Саратов: Изд-во «Саратов», 2004. — 56 с. — ISBN 5-292-03340-5. (рус.)
- Попов А. И. Аморфные полупроводники в микро- и наноелектронике // Приложение к журналу «Вестник РГРТУ». — 2009. — № 4. — ISSN 1995-4565. (рус.)
- Дойніков Л. І. Аморфні напівпровідники: від ідеї до виробництва / Л. І. Дойніков, В.Т. Маслюк.. — Київ: Т-во «Знання», УРСР, 1984. — 47 с.
- Хамакава Й. Аморфные полупроводники и приборы на их основе. Под редакцией докт.техн.наук С.С. Горелика.. — М.: Металлургия, 1986. — 376 с. (рус.)
- Васін А. В. Структурно-морфологічні, електронні та оптичні властивості аморфних нанокомпозитних матералів на основі сполук SiOС: дис. на здобуття наук. ступеня д-ра фіз.-мат. наук: 01.04.17. — К.: Інститут фізики напівпровідників ім. В. Є. Лашкарьова НАН України, 2016. — 328 с.
полупроводники — это… Что такое полупроводники?
ПОЛУПРОВОДНИКИ́ -о́в; мн. (ед. полупроводни́к, -а́; м.). Физ. Вещества, которые по электропроводности занимают промежуточное место между проводниками и изоляторами. Свойства полупроводников. Производство полупроводников. // Электрические приборы и устройства, изготовленные из таких веществ. Радиоприёмник на полупроводниках.
◁ Полупроводнико́вый, -ая, -ое. П-ое вещество. П-ое производство. П-ая электроника. П-ые свойства веществ. П-ые материалы. П-ые приборы, установки.
ПОЛУПРОВОДНИКИ́, вещества, электропроводность которых при комнатной температуре имеет промежуточное значение между электропроводностью металлов (106 — 104 Ом-1 см-1) и диэлектриков (10-8 — 10-12 Ом-1 см-1), обусловлена переносом электронов и возрастает при повышении температуры. Наиболее существенная особенность полупроводников — способность изменять свои свойства в чрезвычайно широких пределах под влиянием различных воздействий (температуры, освещения, электрического и магнитного поля, внешнего гидростатического давления). В результате таких воздействий характеристики полупроводника могут сильно изменяться, (например, электропроводность может меняться в 106-107 раз). Именно эта способность изменять свойства под влиянием внешних воздействий и обусловила широкое применение полупроводников. На основе различных полупроводниковых материалов (см. ПОЛУПРОВОДНИКОВЫЕ МАТЕРИАЛЫ) разработано и создано огромное количество разнообразных полупроводниковых приборов (см. ПОЛУПРОВОДНИКОВЫЕ ПРИБОРЫ).Физические свойства полупроводников получили свое объяснение на основе зонной теории (см. ЗОННАЯ ТЕОРИЯ), которая позволяет сформулировать критерий, разделяющий твердые вещества на два класса — металлы и полупроводники (диэлектрики). В металлах валентная зона (см. ВАЛЕНТНАЯ ЗОНА) заполнена полностью или перекрывается с зоной проводимости (см. ПРОВОДИМОСТИ ЗОНА). В полупроводниках и диэлектриках зона проводимости отделена от валентной зоны запрещенной зоной (см. ЗАПРЕЩЕННАЯ ЗОНА), и не содержит носителей. Деление неметаллических веществ на полупроводники и изоляторы (диэлектрики) является чисто условным. Ранее к изоляторам относили вещества с величиной запрещенной зоны Eg >2—3 эВ. Однако многие из таких кристаллов являются типичными полупроводниками.
Проводимость в полупроводниках
Электрический ток в полупроводниках связан с дрейфом носителей заряда (см. дрейф заряженных частиц (см. ДРЕЙФ ЗАРЯЖЕННЫХ ЧАСТИЦ)). В полупроводниках появление носителей заряда определяется рядом факторов, важнейшими из которых являются химическая чистота материала и температура. В зависимости от чистоты полупроводники подразделяют на собственные и примесные.
В собственном полупроводнике можно пренебречь влиянием примесей при данной температуре. Так как в полупроводниках запрещенная зона не очень широкая, в собственном полупроводнике при температуре абсолютного нуля валентная зона полностью заполнена электронами, а зона проводимости абсолютно свободна: он не обладает электропроводностью и ведет себя подобно идеальному диэлектрику. При температурах, отличных от абсолютного нуля, имеется конечная вероятность того, что некоторые из электронов за счет тепловых флуктуаций (неравномерного распределения тепловой энергии между частицами) преодолеют потенциальный барьер и окажутся в зоне проводимости. Вероятность перехода электрона из валентной зоны в зону проводимости зависит от температуры и ширины запрещенной зоны( Eg), ПОЛУПРОВОДНИКИ-Eg/kT.
В собственном полупроводнике каждый переход электрона в зону проводимости сопровождается образованием дырки (см. ДЫРКА) в валентной зоне. Благодаря дыркам электроны валентной зоны также принимают участие в процессе электропроводности за счет эстафетных переходов под действием электрического поля на более высокие освободившиеся энергетические уровни. Совокупное поведение электронов валентной зоны можно представить как движение дырок, обладающих положительным зарядом и некоторой эффективной массой (см. ЭФФЕКТИВНАЯ МАССА). Чем выше температура и меньше ширина запрещенной зоны, тем выше скорость тепловой генерации носителей заряда (электронов и дырок). Одновременно с генерацией в полупроводнике непрерывно идет и обратный процесс, процесс рекомбинации (см. РЕКОМБИНАЦИЯ в физике) носителей заряда, т.е. возвращение электронов в валентную зону с исчезновением пары носителей заряда. В результате протекания двух конкурирующих процессов в полупроводнике при любой температуре устанавливается некоторая равновесная концентрация электронов no и дырок po, которые равны друг другу в собственном полупроводнике (равновесная концентрация электронов ni = равновесной концентрации дырок pi) . (Индекс i происходит от англ. intrinsic — собственный).
В собственных полупроводниках наблюдается электронно-дырочный механизм проводимости.
Электрофизические свойства примесного полупроводника определяются в первую очередь типом и концентрацией примеси, которая создает дополнительные уровни в запрещенной зоне полупроводника. При малой концентрации примесей расстояние между примесными атомами велико, их электронные оболочки не взаимодействуют друг с другом. Поэтому примесные энергетические уровни являются дискретными, т. е. не расщепляются в зону, как это имеет место для уровней основных атомов кристаллической решетки. Роль дискретных уровней могут играть и всевозможные дефекты структуры, в первую очередь, вакансии и междоузельные атомы. Примеси могут либо поставлять электроны в зону проводимости полупроводника, либо принимать их с уровней его валентной зоны. Примеси, являющиеся источником электронов, называются донорами (см. ДОНОР (в физике)), а энергетические уровни этих примесей — донорными уровнями. Основными носителями тока в таких полупроводниках являются электроны, возникает электронная проводимость (проводимость n -типа). Примеси, захватывающие электроны из валентной зоны полупроводника, называются акцепторами (см. АКЦЕПТОР), а энергетические уровни этих примесей — акцепторными уровнями. Основные носители заряда в таких полупроводниках — дырки. В них наблюдается дырочная проводимость (проводимость p -типа).
В полупроводниках всегда присутствуют оба типа носителей заряда. Основными называют носители заряда, концентрация которых в данном полупроводнике больше, неосновными — носители заряда, концентрация которых меньше. В полупроводнике n — типа основные носители заряда — электроны, неосновные — дырки, в полупроводнике p-типа дырки — основные, а электроны — неосновные.
Если в полупроводнике n — типа увеличить концентрацию доноров, то возрастет число электронов, переходящих в единицу времени с примесных уровней в зону проводимости. Соответственно возрастет скорость рекомбинации носителей заряда и уменьшится равновесная концентрация дырок. При помощи соотношения:
no.po = n2i
называемого соотношением действующих масс для носителей заряда всегда можно, найти концентрацию неосновных носителей заряда, если известна концентрация основных. Характерная особенность полупроводников — рост электропроводности с увеличением температуры — обусловлена ростом концентрации носителей при увеличении температуры.
Механизмы рассеяния и подвижность носителей заряда в полупроводниках
Под действием внешнего электрического поля носители заряда приобретают некоторую скорость направленного движения (скорость дрейфа) и создают электрический ток. Подвижность носителей заряда (см. ПОДВИЖНОСТЬ НОСИТЕЛЕЙ ЗАРЯДА), равная средней скорости носителей заряда в полупроводнике в электрическом поле с напряженностью 1В/см, зависит от длины их свободного пробега, а, следовательно, определяется процессами рассеяния (см. РАССЕЯНИЕ МИКРОЧАСТИЦ) движущихся в полупроводнике электронов.
Процесс рассеяния представляет собой искривление траектории движения носителя заряда под влиянием сил, действующих на электрон или дырку со стороны рассеивающего центра. Если таким центром является положительный ион, то рассеивающей силой будет кулоновский потенциал, если рассеивающим центром является нейтральный атом примеси, рассеиваемый электрон, сталкиваясь с ним, выбивает электрон, принадлежащий атому, рассеиваемый электрон остается в атоме, а выбитый, получив энергию, движется по измененной траектории. Так как электроны неразличимы, акт обмена электронами рассматривается как акт изменения траектории электрона, т. е. рассеяние. Характерной особенностью рассеяния на нейтральных атомах является независимость времени релаксации от энергии рассеиваемых носителей заряда и температуры. Процесс рассеяния электронов на тепловых колебаниях решетки рассматривается как столкновение с фононом (см. ФОНОН). Поскольку число фононов определяется температурой, то и рассеяние носителей заряда зависит от температуры. Рассеивающими центрами при движении электрона являются также структурные дефекты (см. ДЕФЕКТЫ) кристаллической решетки — дислокации (см. ДИСЛОКАЦИИ), вакансии, имеет место также электрон-электронное рассеяние.
В реальных полупроводниках действуют одновременно несколько механизмов рассеяния, причем вклад каждого из них может сильно меняться с изменением температуры и концентрации примеси.
Механизмы рекомбинации в полупроводниках
Закон действующих масс для носителей заряда применим только к равновесным процессам. Генерация носителей заряда в полупроводниках может осуществляться не только за счет теплового воздействия но и при облучении светом, при воздействии электрического поля, при инжекции (см. ИНЖЕКЦИЯ НОСИТЕЛЕЙ ЗАРЯДА) через контакт и т. д. В результате таких воздействий в полупроводнике появляются дополнительные, неравновесные носители заряда. Их концентрация является избыточной по отношению к равновесной и после прекращения нетеплового возбуждения полупроводник возвращается в равновесное состояние, при этом избыточная концентрация носителей заряда за счет процесса рекомбинации спадает до нуля. Принцип действия почти всех электронных приборов основан на явлении инжекции неравновесных носителей при воздействии на кристалл внешних сил (световое, электромагнитное излучение радиочастотного диапазона, облучение ядерными частицами и т. д.). Поэтому скорость рекомбинации определяет быстродействие прибора. Чем больше скорость рекомбинации, тем на более высоких частотах будет работать прибор.
Скорость рекомбинации характеризуется временем жизни носителей заряда — характеристическим временем, по истечении которого избыточная концентрация носителей заряда при линейной рекомбинации уменьшается в е раз. Т. е. характеризует среднее время существования избыточной концентрации и зависит от вида и механизма рекомбинации, состава полупроводника, температуры.
Существует два вида рекомбинации: зона — зона, при котором избыточные электроны из зоны проводимости непосредственно переходят в валентную зону, и рекомбинация через глубокие уровни в запрещенной зоне полупроводника.
При рекомбинации происходит отдача энергии, полученной при генерации. Механизмы рекомбинации классифицируют по способу отдачи энергии, выделяющейся при акте захвата носителей при рекомбинации.
Наиболее вероятные механизмы рекомбинации в полупроводниках:
— излучательная рекомбинация, при которой энергия выделяется в виде кванта электромагнитного излучения;
— фононная рекомбинация, связанная с непосредственной передачей выделяющейся энергии колебаниям атомной решетки:
— ударная рекомбинация (эффект Оже (см. ИОНИЗАЦИЯ)), когда энергия сначала передается ближайшему свободному электрону (или дырке), который затем отдает свою избыточную энергию либо колебаниям атомов решетки, либо другим носителям.
Все три механизма могут осуществляться как при рекомбинации зона-зона, так и при рекомбинации через локальные центры.
Оптические явления в полупроводниках
При воздействии на полупроводник светом могут быть реализованы следующие типы взаимодействия квантов света с носителями заряда: собственное поглощение, экситонное поглощение, поглощение на свободных носителях, примесное поглощение.
В случае собственного поглощения происходит взаимодействие фотонов с электронами в валентной зоне, т. е. с собственными электронами атомов, составляющих кристаллическую решетку, Фотоны определенной энергии способны отдать свою энергию этим электронам, оторвать их от атомов и перевести электроны на более высокие энергетические уровни. В этом случае фотоны поглощаются в кристалле. При собственном поглощении переходы могут быть прямые, когда волновой вектор электрона остается неизменным, и электрон и оставляемая им дырка имеют одинаковые квазиимпульсы. Возможны также непрямые переходы с участием фононов, которым передается избыточный импульс. По краю собственного поглощения можно определить ширину запрещенной зоны полупроводника.
В некоторых полупроводниках наблюдается экситонное поглощение. При поглощении фотонов образуются экситоны (см. ЭКСИТОН), которые могут блуждать по кристаллу. При столкновении с примесными центрами экситон может либо распасться и образовать электрон и дырку, либо рекомбинировать и перевести атом в невозбужденное состояние. В первом случае экситону необходима тепловая энергия, во втором — либо происходит излучение кванта энергии, либо энергия экситона переходит решетке полупроводника в виде теплоты.
Поглощение на свободных носителях имеет место, когда фотоны реагируют со свободными носителями заряда в разрешенных зонах. При этом энергия фотонов расходуется на перевод носителей заряда на более высокие уровни. Под действием электрического поля световой волны носители заряда совершают колебательные движения синхронно с полем и при столкновении с узлами решетки отдают накопленную энергию.
В случае примесного поглощения света фотоны взаимодействуют с примесными атомами, ионизируя или возбуждая их. Взаимодействие фотонов с примесными атомами носит резонансный характер.
В полупроводниковых кристаллах также имеет место поглощение света кристаллической решеткой. Оно проявляется в далекой ИК-области спектра и накладывается на другие виды поглощения.
В случае примесного и собственного оптического поглощения происходит генерация неравновесных носителей заряда, которая сопровождается изменением электрических свойств полупроводника при освещении — наблюдается эффект фотопроводимости (см. ФОТОПРОВОДИМОСТЬ), используемый для создания широкого класса приборов. К неравновесным оптическим явлениям, характерным для полупроводниковых кристаллов и нашедших широкое применение в полупроводниковом приборостроении относится люминесценция (см. ЛЮМИНЕСЦЕНЦИЯ).
Сильно легированные полупроводники
При больших концентрациях примесей или дефектов проявляется их взаимодействие, ведущее к качественным изменениям свойств полупроводников. Это можно наблюдать в сильно легированных полупроводниках, когда что среднее расстояние между атомами примеси становится меньше (или порядка) среднего расстояния а, на котором находится от примеси захваченный ею электрон или дырка. В таких условиях носитель вообще не может локализоваться на каком-либо центре, т. к. он все время находится на сравнимом расстоянии сразу от нескольких одинаковых примесей. Более того, воздействие примесей на движение электронов вообще мало, т. к. большое число носителей со знаком заряда, противоположным заряду примесных ионов, экранируют (т. е. существенно ослабляют) электрическое поле этих ионов. В результате все носители, вводимые с этими примесями, оказываются свободными даже при самых низких температурах.
Полупроводники в сильном электрическом поле
Сильное электрическое поле влияет на подвижность и концентрацию носителей заряда. Существуют несколько механизмов увеличения концентрации носителей в сильном электрическом поле. Основными механизмами являются три: термоэлектрическая (термополевая) ионизация (эффект Френкеля), электростатическая ионизация (туннельный эффект (см. ТУННЕЛЬНЫЙ ЭФФЕКТ)) и ударная ионизация (см. УДАРНАЯ ИОНИЗАЦИЯ).
Механизм термополевой ионизации реализуется при низких температурах, когда концентрация электронов в зоне проводимости определяется вероятностью их освобождения с донорных уровней. На электрон, находящийся на донорном уровне, в электрическом поле помимо силы кулоновского притяжения к иону-донору действует сила F=-qE, способная помочь электрону оторваться от донора и стать свободным. Т. е. повышается вероятность перехода электронов с донорных уровней в зону проводимости, что и означает увеличение концентрации носителей и возрастание электропроводности.
При более высоких температурах, когда донорная примесь ионизирована полностью, главную роль в увеличении концентрации носителей играют явления, связанные с ударной и электростатической (туннельной) ионизацией решетки кристалла в полях большой напряженности.
Полупроводник — это… Что такое Полупроводник?
Полупроводник (Semiconductor) — это
Полупроводники долгое время не привлекали особого внимания ученых и инженеров. Одним из первых начал систематические исследования физических свойств полупроводников выдающийся советский физик Абрам Федорович Иоффе. Он выяснил что полупроводники — особый класс кристаллов со многими замечательными свойствами:
1. С повышением температуры удельное сопротивление полупроводников уменьшается, в отличие от металлов, у которых удельное сопротивление с повышением температуры увеличивается.
2. Свойство односторонней проводимости контакта двух полупроводников. Именно это свойство используется при создании разнообразных полупроводниковых приборов: диодов, транзисторов, тиристоров и др.
3. Контакты различных полупроводников в определенных условиях при освещении или нагревании являются источниками фото — э. д. с. или, соответственно, термо — э. д. с.
Строение полупроводников и принцип их действия.
Как было уже сказано, полупроводники представляют собой особый класс кристаллов. Валентные электроны образуют правильные ковалентные связи. Такой идеальный полупроводник совершенно не проводит электрического тока (при отсутствии освещения и радиационного облучения).
Так же как и в непроводниках электроны в полупроводниках связаны с атомами, однако данная связь очень непрочная. При повышении температуры ( T>0 K), освещении или облучении электронные связи могут разрываться, что приведет к отрыву электрона от атома. Такой электрон является носителем тока. Чем выше температура полупроводника, тем выше концентрация электронов проводимости, следовательно, тем меньше удельное сопротивление. Таким образом, уменьшение сопротивления полупроводников при нагревании обусловлено увеличением концентрации носителей тока в нем.

В отличии от проводников носителями тока в полупроводниковых веществах могут быть не только электроны, но и «дырки». При потере электрона одним из атомов полупроводника на его орбите остается пустое место-«дырка» при воздействии электрическим поле на кристалл «дырка » как положительный заряд перемещается в сторону вектора E, что фактически происходит благодаря разрыву одних связей и восстановление других. «Дырку» условно можно считать частицей, несущей положительный заряд.
Механизм проведения электрического тока полупроводниками
Электропроводность полупроводников: — обеспечивается свободными электронами и дарками; — остается постоянной в пределах области температур, специфической для каждого вида полупроводников, и увеличивается с повышением температуры; — зависит от примесей; — увеличивается под действием света и с возрастанием напряженности электрического поля.
В зависимости от того, отдаёт ли атом примеси электрон или захватывает его, примесные атомы называют донорными или акцепторными. Характер примеси может меняться в зависимости от того, какой атом кристаллической решётки она замещает, в какую кристаллографическую плоскость встраивается.
Проводимость полупроводников сильно зависит от температуры. Вблизи абсолютного нуля температуры полупроводники имеют свойства изоляторов.
Полупроводники характеризуются как свойствами проводников, так и диэлектриков. Так как, образуя кристаллы, атомы полупроводников устанавливают ковалентные связи (то есть, один электрон в кристалле кремния, как и алмаза, связан двумя атомами), электронам необходим уровень внутренней энергии для высвобождения из атома (1, 76*10-19Дж против 11, 2*10-19Дж, чем и характеризуется отличие между полупроводниками и диэлектриками). Эта энергия появляется в них при повышении температуры (например, при комнатной температуре уровень энергии теплового движения атомов равняется 0, 4*10-19Дж), и отдельные атомы получают энергию для отрыва электрона от атома. В процессе повышения температуры количество свободных электронов возрастает — удельное сопротивление падает. Условно принято считать полупроводниками элементы с энергией связи электронов меньшей чем 1, 5 — 2 эВ.
Во время разрыва связи между электроном и ядром появляется свободное место в электронной оболочке атома. Это обуславливает переход электрона с другого атома на атом со свободным местом. На атом, откуда перешел электрон, входит другой электрон из другого атома и т. д. Это обуславливается ковалентными связями атомов. Таким образом, происходит перемещение позитивно заряженного атома без перемещения самого атома. Этот процесс назвали «дыркой».
Виды полупроводников
По характеру проводимости
— Собственная проводимость
Полупроводники, в которых свободные электроны и «дырки» появляются в процессе ионизации атомов, из которых построен весь кристалл, называют полупроводниками с собственной проводимостью. В полупроводниках с собственной проводимостью концентрация свободных электронов равняется концентрации «дырок».
— Примесная проводимость
Для создания полупроводниковых механизмов используют кристаллы с примесной проводимостью. Такие кристаллы изготовляются с помощью внесения смесей с атомами трехвалентного или пятивалентного химического элемента.
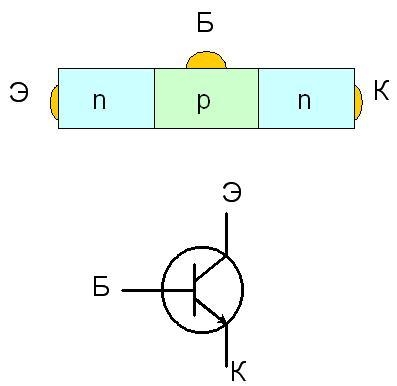
По виду проводимости
— Электронные полупроводники (n-типа)
Этот вид полупроводников имеет примесную природу. В четырехвалентный полупроводник (например, кремний) добавляют примесь пятивалентного полупроводника (например, мышьяка). В процессе взаимодействия каждый атом примеси вступает в ковалентную связь с атомами кремния. Однако для пятого электрона атома мышьяка нет места в насыщенных валентных связях, и он переходит на дальнюю электронную оболочку. Там для отрыва электрона от атома нужно меньшее количество энергии. Электрон отрывается и превращается в свободный. В данном случае перенос заряда осуществляется электроном, а не дыркой, то есть данный вид полупроводников проводит электрический ток подобно металлам. Примеси, которые добавляют в полупроводники, вследствие чего они превращаются в полупроводники n-типа, называются донорными.
— «Дырочные полупроводники (р-типа)»
Этот вид полупроводников, кроме примесной основы, характеризуется дырочной природой проводимости. В четырехвалентный полупроводник (например, в кремний) добавляют небольшое количество атомов трехвалентного элемента (например, Индия). Каждый атом примеси устанавливает ковалентную связь с тремя соседними атомами кремния. Для установки связи с четвертым атомом кремния у атома Индия нет валентного электрона, поэтому он захватывает валентный электрон из ковалентной связи между соседними атомами кремния и становится отрицательно заряженным ионом, вследствие чего образуется дырка. Примеси, которые добавляют в полупроводники, вследствие чего они превращаются в полупроводники p-типа, называются акцепторными.
Использование полупроводников в электродинамике
Полупроводниковый диод
Полупроводниковый диод состоит из двух типов полупроводников — дырчатого и электронного. В процессе контакта между этими областями из области с полупроводником n-типа в область с полупроводником p-типа проходят электроны, которые затем рекомбинируют с дырками. Вследствие этого возникает электрическое поле между двумя областями, что устанавливает предел деления полупроводников — так называемый p-n переход. В результате в области с полупроводником p-типа возникает некомпенсированный заряд из отрицательных ионов, а в области с полупроводником n-типа возникает некомпенсированный заряд из положительных ионов. Разница между потенциалами достигает 0,3-0,6 В. В процессе подачи напряжения плюсом на p-полупроводник и минусом на n-полупроводник внешнее электрическое поле будет направлено против внутреннего электрического поля p-n перехода и при достаточном напряжении электроны преодолеют p-n переход, и в цепи диода появится электрический ток (прямая проводимость). При подаче напряжения минусом на область с полупроводником p-типа и плюсом на область с полупроводником n-типа между двумя областями возникает область, которая не имеет свободных носителей электрического тока (обратная проводимость). Обратный ток полупроводникового диода не равен нулю, так как в обоих областях всегда есть неосновные носители заряда. Для этих носителей p-n переход будет открыт. Таким образом, p-n переход проявляет свойства односторонней проводимости, что обуславливается подачей напряжения с различной полярностью. Это свойство используют для выпрямления переменного тока.

Транзистор
Транзистор — полупроводниковое устройство, которое состоит из двух областей с полупроводниками p- или n-типа, между которыми находится область с полупроводником n- или p-типа. Таким образом, в транзисторе есть две области p-n перехода. Область кристалла между двумя переходами называют базой, а внешние области называют эмиттером и коллектором.
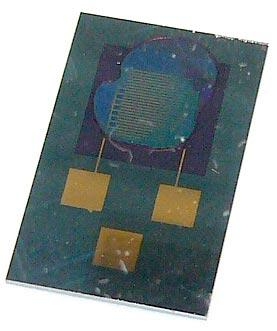
Самой употребляемой схемой включения транзистора является схема включения с общим эмиттером, при которой через базу и эмиттер ток распространяется на коллектор. Биполярный транзистор используют для усиления электрического тока.
Типы полупроводников в периодической системе элементов
В нижеследующей таблице представлена информация о большом количестве полупроводниковых соединений. Их делят на несколько типов: одноэлементные полупроводники IV группы периодической системы элементов, сложные: двухэлементные AIIIBV и AIIBVI из третьей и пятой группы и из второй и шестой группы элементов соответственно. Все типы полупроводников обладают интересной зависимостью ширины запрещённой зоны от периода, а именно — с увеличением периода ширина запрещённой зоны уменьшается.
Физические свойства и применения
Прежде всего, следует сказать, что физические свойства полупроводников наиболее изучены по сравнению с металлами и диэлектриками. В немалой степени этому способствует огромное количество эффектов, которые не могут быть наблюдаемы ни в тех ни в других веществах, прежде всего связанные с устройством зонной структуры полупроводников, и наличием достаточно узкой запрещённой зоны. Конечно же, основным стимулом для изучения полупроводников является производство полупроводниковых приборов и интегральных микросхем — это в первую очередь относится к кремнию, но затрагивает и другие соединения (Ge, GaAs, InP, InSb).
Кремний — непрямозонный полупроводник, оптические свойства которого широко используются для создания фотодиодов и солнечных батарей, однако его очень трудно заставить работать в качестве источника света, и здесь вне конкуренции прямозонные полупроводники — соединения типа AIIIBV, среди которых можно выделить GaAs, GaN, которые используются для создания светодиодов и полупроводниковых лазеров.
Собственный полупроводник при температуре абсолютного ноля не имеет свободных носителей в зоне проводимости в отличие от проводников и ведёт себя как диэлектрик. При легировании ситуация может поменяться (см. вырожденные полупроводники).
В связи с тем, что технологи могут получать очень чистые вещества встаёт вопрос о новом эталоне для числа Авогадро.
Наиболее важные для техники полупроводниковые приборы — диоды, транзисторы, тиристоры основаны на использовании замечательных материалов с электронной или дырочной проводимостью.
Широкое применение полупроводников началось сравнительно недавно, а сейчас они получили очень широкое применение. Они преобразуют свтовую и тепловую энергию в электрическую и, наоборот, с помощью электроэнергии создают тепло и холод. Полупроводниковые приборы можно встретить в обычном радиоприемнике и в квантовом генераторе — лазере, в крошечной атомной батарее и в микропроцессорах.
Инженеры не могут обходиться без полупровдниковых выпрямителей,
переключателей и усилителей. Замена ламповой аппаратуры полупроводниковой позволила в десятки раз уменьшить габариты и массу электронных устройств, снизить потребляемую ими мощность и резко увеличить надежность.
Легирование
Объёмные свойства полупроводника могут сильно зависеть от наличия дефектов в кристаллической структуре. И поэтому стремятся выращивать очень чистые вещества, в основном для электронной промышленности. Легирующие примеси вводят для управления величиной и типом проводимости полупроводника. Например, широко распространённый кремний можно легировать элементом V подгруппы периодической системы элементов — фосфором, который является донором, и создать n-Si. Для получения кремния с дырочным типом проводимости (p-Si) используют бор (акцептор). Также создают компенсированные полупроводники с тем чтобы зафиксирован уровень Ферми в середине запрещённой зоны.
Методы получения
Свойства полупроводников зависят от способа получения, так как различные примеси в процессе роста могут изменить их. Наиболее дешёвый способ промышленного получения монокристаллического технологического кремния — метод Чохральского. Для очистки технологического кремния используют также метод зонной плавки.
Для получения монокристаллов полупроводников используют различные методы физического и химического осаждения. Наиболее прецизионный и дорогой инструмент в руках технологов для роста монокристаллических плёнок — установки молекулярно-лучевой эпитаксии, позволяющей выращивать кристалл с точностью до монослоя.
Оптика полупроводников
Поглощение света полупроводниками обусловлено переходами между энергетическими состояниями зонной структуры. Учитывая принцип запрета Паули, электроны могут переходить только из заполненного энергетического уровня на незаполненный. В собственном полупроводнике все состояния валентной зоны заполнены, а все состояния зоны проводимости незаполненные, поэтому переходы возможны лишь из валентной зоны в зону проводимости. Для осуществления такого перехода электрон должен получить от света энергию, превышающую ширину запрещённой зоны. Фотоны с меньшей энергией не вызывают переходов между электронными состояниями полупроводника, поэтому такие полупроводники прозрачны в области частот , где Eg — ширина запрещённой зоны, — постоянная Планка. Эта частота определяет фундаментальный край поглощения для полупроводника. Для полупроводников, которые зачастую применяются в электронике (кремний, германий, арсенид галлия) она лежит в инфракрасной области спектра.
Дополнительные ограничения на поглощение света полупроводников накладывают правила отбора, в частности закон сохранения импульса. Закон сохранения импульса требует, чтобы квазиимпульс конечного состояния отличался от квазиимпульса начального состояния на величину импульса поглощённого фотона. Волновое число фотона 2π / λ, где λ — длина волны, очень мало по сравнению с волновым вектором обратной решётки полупроводника, или, что то же самое, длина волны фотона в видимой области намного больше характерного межатомного расстояния в полупроводнике, что приводит к требованию того, чтобы квазиимпульс конечного состояния при электронном переходе практически равнялся квазиимпульсу начального состояния. При частотах, близких к фундаментальному краю поглощения, это возможно только для прямозонных полупроводников. Оптические переходы в полупроводниках, при которых импульс электрона почти не меняется называются прямыми или вертикальными. Импульс конечного состояния может значительно отличаться от импульса начального состояния, если в процессе поглощения фотона участвует ещё одна, третья частица, например, фонон. Такие переходы тоже возможны, хотя и менее вероятны. Они называются непрямыми переходами.
Таким образом, прямозонные полупроводники, такие как арсенид галлия, начинают сильно поглощать свет, когда энергия кванта превышает ширину запрещённой зоны. Такие полупроводники очень удобны для использования в оптоэлектронике.
Непрямозонные полупроводники, например, кремний, поглощают в области частот света с энергией кванта чуть больше ширины запрещённой зоны значительно слабее, только благодаря непрямым переходам, интенсивность которых зависит от присутствия фононов, и следовательно, от температуры. Граничная частота прямых переходов кремния больше 3 эВ, то есть лежит в ультрафиолетовой области спектра.
При переходе электрона из валентной зоны в зону проводимости в полупроводнике возникают свободные носители заряда, а следовательно фотопроводимость.
При частотах ниже края фундаментального поглощения также возможно поглощение света, которое связано с возбуждением экситонов, электронными переходами между уровнями примесей и разрешенными зонами, а также с поглощением света на колебаниях решетки и свободных носителях. Экситонные зоны расположены в полупроводнике несколько ниже дна зоны проводимости благодаря энергии связи экситона. Экситонные спектры поглощения имеют водородоподобную структуру энергетических уровней. Аналогичным образом примеси, акцепторы или доноры, создают акцепторные или донорные уровни, лежащие в запрещённой зоне. Они значительно модифицируют спектр поглощения легированного полупроводника. Если при непрямозонном переходе одновременно с квантом света поглощается фонон, то энергия поглощенного светового кванта может быть меньше на величину энергии фонона, что приводит к поглощению на частотах несколько ниже по энергии от фундаментального края поглощения.
Список полупроводников
Группа IV
собственные полупроводники
Углерод, C
Кремний, Si
Кремний, Ge
Cерое олово, α-Sn
составной полупроводник
Карбид кремния, SiC
Кремний-германий, SiGe
Группа III-V
2-х компонентные полупроводники
Антимонид алюминия, AlSb
Арсенид алюминия, AlAs
Нитрид алюминия, AlN
Фосфид алюминия, AlP
Нитрид бора, BN
Фосфид бора, BP
Арсенид бора, BAs
Антимонид галлия, GaSb
Арсенид галлия, GaAs
Нитрид галлия, GaN
Фосфид галлия, Gap
Антимонид Индия, InSb
Арсенид Индия, InAs
Нитрид Индия, InN
фосфид Индия, InP
3-х компонентные полупроводники
AlxGa1-xAs
InGaAs, InxGa1-xAs
InGaP
AlInAs
AlInSb
GaAsN
GaAsP
AlGaN
AlGaP
InGaN
InAsSb
InGaSb
4-х компонентные полупроводники
AlGaInP, InAlGaP, InGaAlP, AlInGaP
AlGaAsP
InGaAsP
AlInAsP
AlGaAsN
InGaAsN
InAlAsN
GaAsSbN
5-ти компонентные полупроводники
GaInNAsSb
GaInAsSbP
Группа II-VI
2-х компонентные полупроводники
Селенид кадмия, CdSe
Сульфид кадмия, CdS
Теллурид кадмия, CdTe
Оксид цинка, ZnO
Селенид цинка, ZnSe
Сульфид цинка, ZnS
Теллурид цинка, ZnTe
3-х компонентные полупроводники
CdZnTe, CZT
HgCdTe
HgZnTe
HgZnSe
Группа I-VII
2-х компонентные полупроводники
Хлорид купрума, CuCl
Группа IV-VI
2-х компонентные полупроводники
Селенид свинца, PbSe
Сульфид свинца, PbS
Теллурид свинца, PbTe
Сульфид олова, SnS
Теллурид олова, SnTe
3-х компонентные полупроводники
PbSnTe
Tl2SnTe5
Tl2GeTe5
Группа V-VI
2-х компонентные полупроводники
Теллурид висмута, Bi2Te3
Группа II-V
2-х компонентные полупроводники
Фосфид кадмия, Cd3P2
Арсенид кадмия, Cd3As2
Антимонид кадмия, Cd3Sb2
Фосфид цинка, Zn3P2
Арсенид цинка, Zn3As2
Антимонид цинка, Zn3Sb2
Другие
CInGaSe
Силицид платины, PtSi
Иодид висмута(III), BiI3
Иодид ртути(II), HgI2
Бромид таллия(I), TlBr
Иодид меди(II), PbI2
Дисульфид молибдена, MoS2
Селенид галлия, GaSe
Сульфид олова(II), SnS
Сульфид висмута, Bi2S3
Разные оксиды
Диоксид титана, TiO2
Оксид меди(I), Cu2O
Оксид меди(II), CuO
Диоксид урана, UO2
Триоксид урана, UO3
Органические полупроводники
Тетрацен
Пентацен
Акридон
Перинон
Флавантрон
Индантрон
Индол
Alq3
Магнитные полупроводники
Ферромагнетики
Оксид европия, EuO
Сульфид европия, EuS
CdCr2Se4
GaMnAs
Pb1-xSnxTe легированный Mn2+
GaAs легированный Mn2+
ZnO легированный Co2+
Антиферромагнетики
Теллурид европия, EuTe
Селенид европия, EuSe
Оксид никеля, NiO
Технологии обработки полупроводников
Наряду с сотрудничеством отдела исследования и развития организации Atotech с институтом CNSE (США) по разработке новых технологий (разработок) медных покрытий для внутренней проводки микросхем, внедряется передовой метод, основанный на электролитическом и химическом осаждении металла для различных применений в горизонтальной вейферной сборке.
Передовая технология сборки
Финишная обработка контактных площадок
Нанесение покрытия через трафарет
3D сборка
Передовая технология сборки Atotech подкрепляется международной компанией и структурой логистики фирмы с огромным ноу-хау в области электронной индустрии в целом с нашими филиалами в более 30 странах. Мы можем предложить полупроводниковой отрасли наши технологии химической обработки, опыт электролитического производства, а также глобально действующую структуру поддержки. Метод передовой сборки основан на металлизации межслойных переходов, произведенной химическим или электролитическим путем для различных применений в горизонтальной вейферной сборке.
Требования миниатюризации в межслойных технологиях и, соответственно, более высокий ввод/вывод, а также возросшие электрические нагрузки на тракт сигнала требуют инновативные процессы сборки вейферов. Включение электроосажденной купрума в процесс сборки полупроводниковых вейферов, как, например, перераспределяющего слоя (RDL) или медного контактного столбика, имеет следующие преимущества:
Применение малого шага,
Эффективная передача сигнала
Тепловая стабильность
Более того, для экономически эффективного производства полупроводниковых устройств химический процесс обеспечивает меньшее осаждение металла. Уникальная технология Atotech по химической универсальной финишной обработке контактных площадок может применяться в двух главных областях использования, в качестве диффузионного барьера для соединения шин на алюминиевых и медных контактных площадках и как паяемое финишное покрытие для перевернутого кристалла. Основные преимущества:
Исключительная антикоррозийная устойчивость осажденного металла
Высокая надежность паяных соединений
Улучшенная надежность соединения шин для высокотемпературных применений
Источники
ru.wikipedia.org ВикипедиЯ – свободная энциклопедия
glossary.ru Голоссарий. РУ
atotech.com АвтоТех
radiopartal.tut.su Радиопортал
Энциклопедия инвестора. 2013.
Оптические явления в полупроводниках
При любой температуре более абсолютного нуля в полупроводнике происходят процессы генерации и рекомбинации носителей и в результате устанавливается равновесные концентрации электронов и дырок n 0 = p0 . Помимо тепловой генерации возможны и другие механизмы появления носителей зарядов: при облучении светом, при воздействии сильного электрического поля, механических нагрузок и др. Действие таких внешних факторов приводит к появлению дополнительных, неравновесных носителей заряда, концентрация которых является избыточной по отношению к равновесной: Δ n = n – n 0 ; Δp = p – р 0 , n и p – полные (неравновесные) концентрации электронов и дырок, возникающие под действием температуры и других факторов. При генерации носителей электроны переходят на более высокий энергетический уровень, поэтому этот процесс происходит с потреблением энергии, соответственно, процесс рекомбинации происходит с выделением энергии так как носители переходят с более высокого на более низкий энергетический уровень. Что касается оптических явлений в полупроводниках, то последнее обстоятельство приводит к тому, что полупроводники могут поглощать и выделять световую энергию в зависимости от преобладания одного над другим процессов генерации и рекомбинации. Рассмотрим эти процессы.
Поглощение света.Свет, проникая в полупроводник, вступает в обменное (энергетическое) взаимодействие с кристаллической решёткой. Пусть Р0 мощность падающего на кристалл светового потока. Световой поток, проходя через кристалл, ослабляется вследствие процесса поглощения.Выделим в кристалле тонкий слой dx на расстоянии х от поверхности, на которую падает
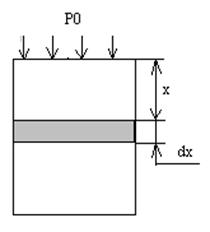 Рисунок 3.8. Поглощение света полупроводниками.
Рисунок 3.8. Поглощение света полупроводниками.
| световой поток (рис. 3.8). В этом слое поглощается часть энергии падающего светового потока dP = — α W dx.. Здесь α – коэффициент поглощения, численно равный относительному изменению мощности светового потока на единицу пути пройденного им в кристалле (размерность м – 1 , см – 1 ). Поглощение излучения в полупроводниках связано с изменением состояния электронов, а также с |
изменением колебательной энергии атомов решётки. В связи с этим различают несколько механизмов поглощения света полупроводниками. На рис. 3.9 приведены зонные диаграммы, иллюстрирующие различные типы процессов поглощения света.
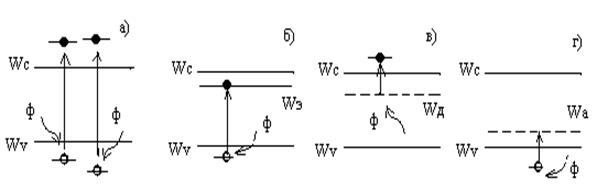
Рисунок 3.9. Различные механизмы поглощения света полупроводниками: — а) собственное поглощение; — б) экситонное поглощение; — в), — г) примесное поглощение.
Собственное поглощение обусловлено переходами электронов из валентной зоны в зону проводимости, т.е. энергия света расходуется на возбуждение валентных электронов в зону проводимости. По закону сохранения энергии энергия фотона ( ф ) hυ должна быть в этом случае не меньше ширины запрещённой зоны ΔW = Wc – Wv, т.е. hυ ≥ ΔW (Wc – дно зоны проводимости; Wv – потолок валентной зоны; hυ – энергия фотона). Отсюда максимальная длинаволны (красная граница) собственного поглощения:
 . ( 3.9 ).
. ( 3.9 ).
Переходы из валентной зоны в зону проводимости могут быть прямыми и непрямыми. Рассмотренные переходы являются прямыми, они осуществляются под действием энергии фотона на электрон, имеющий такой же квазиимпульс (волновой вектор), что и оставляемая им дырка. Если валентная зона и зона проводимости имеют сложную структуру, то могут возникнуть непрямые переходы под совместным действием фотона и «порции» тепловой энергии (фонона). Поскольку для осуществления непрямого перехода необходимо взаимодействие не двух, а трёх частиц (электрона, фотона и фонона), то вероятность их меньше вероятности прямых переходов. Соответственно меньше и показатель поглощения.
Экситонное поглощение. В некоторых полупроводниках возможно образование экситона – системы из взаимосвязанных собственными электростатическими полями электрона и дырки. Экситон электрически нейтрален, может хаотически блуждать по кристаллу и при столкновении с примесными центрами может либо образовать два заряда ( электрон и дырку), либо рекомбинировать и привести атом в нейтральное состояние. Первое требует сообщение экситону тепловой энергии, необходимой для перевода электрона с экситонного уровня в зону проводимости; второе сопровождается либо излучением кванта энергии, либо чаще всего отдачей энергии экситона решётке полупроводника в виде теплоты. Энергетические уровни электрона, возбуждённого под действием фотона hυ и находящегося в составе экситона, располагаются в запрещённой зоне немного ниже дна зоны проводимости ( см. рис. 3.9 – б), где Wэ – экситонные уровни ). Поэтому энергия образования экситона несколько меньше ширины запрещённой зоны, поскольку последняя представляет собой энергетический минимум, необходимый для образования пары свободных ( и разделённых ) носителей. Это же обстоятельство приводит к тому, что экситонное поглощение сдвинуто в низкочастотную часть спектра по сравнению с собственным поглощением.
Примесное поглощение происходит при ионизации примесных атомов кристаллической решётки. При этом энергия поглощаемых фотонов света расходуется либо на перебрасывание электронов с донорных уровней в зону проводимости ( рис. 3. 9 – в), либо из валентной зоны на акцепторные уровни (рис. 3 9 – г). Так как энергия ионизации примесей значительно меньше ширины запрещённой зоны, то примесное поглощение смещено от края собственного поглощения в далёкую инфракрасную область и может наблюдаться при низких температурах ( ниже температуры истощения примеси), когда большинство атомов примеси не ионизованы.
Как следует из рассмотрения механизмов собственного, экситонного и примесного вида поглощения, длина волны поглощаемого света определяется шириной энергетического промежутка, преодолеваемого электроном при воздействии фотона. В связи с этим в выражении (3.9) вместо ширины запрещённой зоны следует использовать энергию ΔWэ = Wэ – Wv при экситоном поглощении; ΔWд = Wс – Wд при поглощении электронами донорных уровней; ΔWа = Wа — Wv при возбуждении акцепторных атомов.
При всех видах поглощения свет в полупроводнике возникают дополнительные ( нескомпенсированные ) носители заряда и это приводит к изменению проводимости полупроводника. Изменение элетрической проводимости ( удельного сопротивления ) под действием электромагнитного излучения называют фотопроводимостью ( фоторезистивным эффектом). Фотопроводимость Δγ равна разности проводимостей полупроводника на свету и в темноте:  , где Δn и Δр – концентрации неравновесных носителей заряда, возникающих вследствие оптической генерации. Основные свойства полупроводниковой фотопроводимости:
, где Δn и Δр – концентрации неравновесных носителей заряда, возникающих вследствие оптической генерации. Основные свойства полупроводниковой фотопроводимости:
– фотопроводимость носит временный характер – после облучения она более или менее быстро возвращается к темновой;
– при воздействии импульса света фотопроводимость возрастает до установившегося значения по экспоненциальному закону;
– при слабых световых потоках зависимость фотопроводимости от интенсивности света носит линейный характер;
– спектральная зависимость фотопроводимости соответствует спектрам оптического поглощения полупроводника.
Излучение света полупроводниками сопровождается выделением электромагнитной энергии излучения в оптическом диапазоне, что может происходить в процессе рекомбинации неравновесных носителей. Поскольку при рекомбинации возможно выделение и тепловой энергии, то при создании светоизлучающих приборов необходимо создать условия, обеспечивающие именно излучательную рекомбинацию. Различают несколько механизмов рекомбинации, принцип действия которых поясняет рис. 3.10.
Межзонная. или прямая рекомбинация происходит при переходе свободного электрона из зоны проводимости на один из свободных уровней валентной зоны, что соответствует исчезновению пары носителей заряда – свободного электрона и дырки (рис. 3.10 – а). При этом излучается фотон света. Однако прямая рекомбинация маловероятна, потому что для её осуществления необхо –
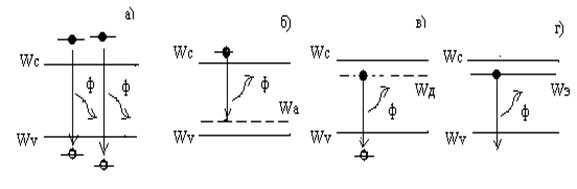
Рисунок 3. 10. Зонные диаграммы полупроводника при излучении света: а) – прямая рекомбинация; б), в) – примесные рекомбинации; г) – аннигиляция экситона.
димо совпадение в пространстве положения дырки и электрона с одинаковыми и противоположно направленными импульсами. Это приводит к тому, что, например, в германии на 10 тысяч рекомбинаций лишь одна происходит в результате непосредственного исчезновения пары электрон – дырка.
Аналогичные процессы происходят и при исчезновении экситона (рис. 3. 10 – г ), однако, это чаще всего сопровождается излучением фонона, который затрачивается на нагрев кристаллической решётки.
Излучение света может происходить и при рекомбинационных процессах на примесных уровнях ( примесная рекомбинация ): при переходе электрона из зоны проводимости на акцепторный уровень (рис. 3.10 – б) или с донорного уровня в зону проводимости (рис. 3.10 – в). Строго говоря рис. 3.10 поясняет лишь часть процесса рекомбинационного излучения с использованием примесных уровней. Примесные уровни являются частным случаем так назы –
ваемых рекомбинационных ловушек Рекомбинационными ловушками называются примеси и дефекты ( примесные атомы или ионы, различные включения, незаполненные узлы в решётке и др.), создающие свои уровни в запрещённой
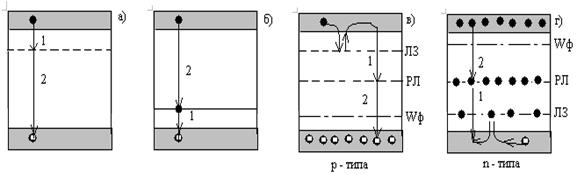
Рисунок 3.11. Механизм рекомбинации с участием ловушек: а), б) – донорный и акцепторный уровни в качестве ловушек; схемы расположения ловушек захвата ЛЗ и рекомбинационных ловушек РЛ для р – полупроводника ( — а) и n – полупроводника ( — б ).
зоне полупроводника. Рекомбинация с помощью ловушек происходит в два этапа – 1 — захват электрона из зоны проводимости на свободный уровень ловушки (рис. 3.11 – а) и второй этап – 2 – переход электрона на свободный уровень в валентной зоне. На уровне ловушки электрон будет находиться до тех пор, пока к нему не подойдёт дырка, т.е. этапы 1 и 2 могут отделять различные промежутки времени. Если в исходном состоянии уровень ловушки занят электроном ( рис.3.11 – б), то на первом этапе произойдёт захват дырки из валентной зоны ( т.е. электрон перейдёт на свободное состояние в валентной зоне), а на втором ловушка примет электрон из зоны проводимости. В результате последовательных переходов 1 и 2 произойдёт исчезновение пары носителей заряда и в случае а) и в случае б). Такой двухступенчатый процесс более вероятен, чем непосредственная рекомбинация с участием примесных уровней ( рис. 3.10 – а ) и – б )), потому что он не требует одновременного присутствия в одной точке пространства электрона и дырки.
Кроме рекомбинационных ловушек в запрещённой зоне полупроводника могут существовать уровни, которые захватывают носители только одного знака – так называемые ловушки захвата. Носитель заряда, находящийся на таком уровне, через некоторое время освобождается и снова может принимать участие в процессе электропроводности. Характерной особенностью ловушек захвата является их взаимодействие только с одной зоной – проводимости или валентной. Неравновесные носители заряда, переходя на мелкие уровни ловушек захвата на некоторое время выбывают из процесса рекомбинации. Поэтому наличие ловушек захвата уменьшает скорость рекомбинации, так как уменьшается количество переходов носителей заряда на уровни рекомбинационных ловушек.
В процессе рекомбинации освобождается энергия, которая либо излучается в виде фотона ( излучательная рекомбинация ), либо передаётся кристаллической решётке в виде фонона ( безызлучательная рекомбинация — фононная). Для построения светоизлучающих полупроводниковых приборов используют и межзонную рекомбинацию ( полупроводники с узкой запрещённой зоной), и рекомбинацию через примесные уровни (широкозонные полупроводники), причём достижение высокого совершенства структуры кристалла, снижение остаточных примесей позволяет достичь высоких значений части излучательных рекомбинаций – более 80 % от общего числа рекомбинаций.
Во всех случаях излучательной рекомбинации длина волны излучаемого света определяется, как и при поглощении света, шириной энергетического промежутка между начальным и конечным уровнями, занимаемых носителями ( см. выражение 3.9).
Дата добавления: 2016-11-26; просмотров: 3634;
Похожие статьи:
Полупроводники — Википедия. Что такое Полупроводники
Монокристаллический кремний — полупроводниковый материал, наиболее широко используемый в промышленности сегодня.Полупроводники́ — материалы, по удельной проводимости занимающие промежуточное место между проводниками и диэлектриками, и отличающиеся от проводников сильной зависимостью удельной проводимости от концентрации примесей, температуры и воздействия различных видов излучения. Основным свойством полупроводников является увеличение электрической проводимости с ростом температуры[1].
Полупроводниками являются кристаллические вещества, ширина запрещённой зоны которых составляет порядка электрон-вольта (эВ). Например, алмаз можно отнести к широкозонным полупроводникам (около 7 эВ), а арсенид индия — к узкозонным (0,35 эВ). К числу полупроводников относятся многие химические элементы (германий, кремний, селен, теллур, мышьяк и другие), огромное количество сплавов и химических соединений (арсенид галлия и др.).
Атом другого химического элемента в чистой кристаллической решётке (например, атом фосфора, бора и т. д. в кристалле кремния) называется примесью. В зависимости от того, отдаёт ли примесной атом электрон в кристалл (в вышеприведённом примере – фосфор) или захватывает его (бор), примесные атомы называют донорными или акцепторными. Характер примеси может меняться в зависимости от того, какой атом кристаллической решётки она замещает, в какую кристаллографическую плоскость встраивается.
Проводимость полупроводников сильно зависит от температуры. Вблизи температуры абсолютного нуля полупроводники имеют свойства диэлектриков.
Механизм электрической проводимости
Полупроводники характеризуются как свойствами проводников, так и диэлектриков. В полупроводниковых кристаллах атомы устанавливают ковалентные связи (то есть, один электрон в кристалле кремния, связан двумя атомами), электронам необходим уровень внутренней энергии для высвобождения из атома (1,76·10−19 Дж против 11,2·10−19 Дж, чем и характеризуется отличие между полупроводниками и диэлектриками). Эта энергия появляется в них при повышении температуры (например, при комнатной температуре уровень энергии теплового движения атомов равняется 0,04·10−19 Дж), и отдельные электроны получают энергию для отрыва от ядра. С ростом температуры число свободных электронов и дырок увеличивается, поэтому в полупроводнике, не содержащем примесей, удельное электрическое сопротивление уменьшается. Условно принято считать полупроводниками элементы с энергией связи электронов меньшей чем 1,5—2 эВ. Электронно-дырочный механизм проводимости проявляется у собственных (то есть без примесей) полупроводников. Он называется собственной электрической проводимостью полупроводников.
Дырка
Во время разрыва связи между электроном и ядром появляется свободное место в электронной оболочке атома. Это обуславливает переход электрона с другого атома на атом со свободным местом. На атом, откуда перешёл электрон, входит другой электрон из другого атома и т. д. Этот процесс обуславливается ковалентными связями атомов. Таким образом, происходит перемещение положительного заряда без перемещения самого атома. Этот условный положительный заряд называют дыркой.
Обычно подвижность дырок в полупроводнике ниже подвижности электронов.
Энергетические зоны
Между зоной проводимости Еп и валентной зоной Ев расположена зона запрещённых значений энергии электронов Ез. Разность Еп−Ев равна ширине запрещенной зоны Ез. С ростом ширины Ез число электронно-дырочных пар и проводимость собственного полупроводника уменьшается, а удельное сопротивление возрастает.
Подвижность
 Подвижность электронов (верхняя кривая) и дырок (нижняя кривая) в кремнии в зависимости от концентрации атомов легирующих примесей
Подвижность электронов (верхняя кривая) и дырок (нижняя кривая) в кремнии в зависимости от концентрации атомов легирующих примесейПодвижностью μ{\displaystyle \mu } называют коэффициент пропорциональности между дрейфовой скоростью v→{\displaystyle {\vec {v}}} носителей тока и величиной приложенного электрического поля E→{\displaystyle {\vec {E}}}:
- v→=μE→.{\displaystyle {\vec {v}}=\mu {\vec {E}}.}
При этом, вообще говоря, подвижность является тензором:
- vα=μαβEβ.{\displaystyle \ v_{\alpha }=\mu _{\alpha \beta }E_{\beta }.}
Подвижность электронов и дырок зависит от их концентрации в полупроводнике (см. рисунок). При большой концентрации носителей заряда вероятность столкновения между ними вырастает, что приводит к уменьшению подвижности и проводимости.
Размерность подвижности — м²/(В·с) в СИ или см/(В·с)в системе СГС.
Собственная плотность
При термодинамическом равновесии, концентрация электронов полупроводника связана с температурой следующим соотношением:
- n¯=2h4(2πmkT)3/2e−EC−EFkT{\displaystyle {\bar {n}}={\frac {2}{h^{3}}}(2\pi mkT)^{3/2}e^{-{\frac {E_{C}-E_{F}}{kT}}}}
где:
- h{\displaystyle h} — Постоянная Планка;
- m{\displaystyle m} — масса электрона;
- T{\displaystyle T} — абсолютная температура;
- EC{\displaystyle E_{C}} — уровень зоны проводимости;
- EF{\displaystyle E_{F}} — уровень Ферми.
Также, концентрация дырок полупроводника связана с температурой следующим соотношением:
- p¯=2h4(2πmkT)3/2e−EF−EVkT{\displaystyle {\bar {p}}={\frac {2}{h^{3}}}(2\pi mkT)^{3/2}e^{-{\frac {E_{F}-E_{V}}{kT}}}}
где:
- h{\displaystyle h} — Постоянная Планка.
- m{\displaystyle m} — эффективная масса дырки;
- T{\displaystyle T} — абсолютная температура;
- EF{\displaystyle E_{F}} — уровень Ферми;
- EV{\displaystyle E_{V}} — уровень валентной зоны.
Собственная концентрация ni{\displaystyle n_{i}} связана с n¯{\displaystyle {\bar {n}}} и p¯{\displaystyle {\bar {p}}} следующим соотношением:
- n¯p¯=ni2{\displaystyle {\bar {n}}{\bar {p}}=n_{i}^{2}}
Виды полупроводников
По характеру проводимости
Собственная проводимость
Полупроводники, в которых свободные электроны и «дырки» появляются в процессе ионизации атомов, из которых построен весь кристалл, называют полупроводниками с собственной проводимостью. В полупроводниках с собственной проводимостью концентрация свободных электронов равняется концентрации «дырок».
Проводимость связана с подвижностью частиц следующим соотношением:
- σ=1ρ=q(Nnμn+Npμp){\displaystyle \sigma ={\frac {1}{\rho }}=q(N_{\rm {n}}\mu _{\rm {n}}+N_{\rm {p}}\mu _{\rm {p}})}
где ρ{\displaystyle \rho } — удельное сопротивление, μn{\displaystyle \mu _{\rm {n}}} — подвижность электронов, μp{\displaystyle \mu _{\rm {p}}} — подвижность дырок, Nn,p{\displaystyle N_{n,p}} — их концентрация, q — элементарный электрический заряд (1,602·10−19 Кл).
Для собственного полупроводника концентрации носителей совпадают и формула принимает вид:
- σ=1ρ=qN(μn+μp){\displaystyle \sigma ={\frac {1}{\rho }}=qN(\mu _{\rm {n}}+\mu _{\rm {p}})}
Примесная проводимость
Для создания полупроводниковых приборов часто используют кристаллы с примесной проводимостью. Такие кристаллы изготавливаются с помощью внесения примесей с атомами трехвалентного или пятивалентного химического элемента.
По виду проводимости
Электронные полупроводники (n-типа)
Термин «n-тип» происходит от слова «negative», обозначающего отрицательный заряд основных носителей. Этот вид полупроводников имеет примесную природу. В четырёхвалентный полупроводник (например, кремний) добавляют примесь пятивалентного полупроводника (например, мышьяка). В процессе взаимодействия каждый атом примеси вступает в ковалентную связь с атомами кремния. Однако для пятого электрона атома мышьяка нет места в насыщенных валентных связях, и он переходит на дальнюю электронную оболочку. Там для отрыва электрона от атома нужно меньшее количество энергии. Электрон отрывается и превращается в свободный. В данном случае перенос заряда осуществляется электроном, а не дыркой, то есть данный вид полупроводников проводит электрический ток подобно металлам. Примеси, которые добавляют в полупроводники, вследствие чего они превращаются в полупроводники n-типа, называются донорными.
Проводимость N-полупроводников приблизительно равна:
- σ≈qNnμn{\displaystyle \sigma \approx qN_{\rm {n}}\mu _{\rm {n}}}
Дырочные полупроводники (р-типа)
Термин «p-тип» происходит от слова «positive», обозначающего положительный заряд основных носителей. Этот вид полупроводников, кроме примесной основы, характеризуется дырочной природой проводимости. В четырёхвалентный полупроводник (например, в кремний) добавляют небольшое количество атомов трехвалентного элемента (например, индия). Каждый атом примеси устанавливает ковалентную связь с тремя соседними атомами кремния. Для установки связи с четвёртым атомом кремния у атома индия нет валентного электрона, поэтому он захватывает валентный электрон из ковалентной связи между соседними атомами кремния и становится отрицательно заряженным ионом, вследствие чего образуется дырка. Примеси, которые добавляют в этом случае, называются акцепторными.
Проводимость p-полупроводников приблизительно равна:
- σ≈qNpμp{\displaystyle \sigma \approx qN_{\rm {p}}\mu _{\rm {p}}}
Использование в радиотехнике
Полупроводниковый диод
 Схема полупроводникового кремниевого диода. Ниже приведено его символическое изображение на электрических принципиальных схемах.
Схема полупроводникового кремниевого диода. Ниже приведено его символическое изображение на электрических принципиальных схемах.Полупроводниковый диод состоит из двух типов полупроводников — дырочного и электронного. В процессе контакта между этими областями из области с полупроводником n-типа в область с полупроводником p-типа проходят электроны, которые затем рекомбинируют с дырками. Вследствие этого возникает электрическое поле между двумя областями, что устанавливает предел деления полупроводников — так называемый p-n переход. В результате в области с полупроводником p-типа возникает некомпенсированный заряд из отрицательных ионов, а в области с полупроводником n-типа возникает некомпенсированный заряд из положительных ионов. Разница между потенциалами достигает 0,3-0,6 В.
Связь между разницей потенциалов и концентрацией примесей выражается следующей формулой:
- φ=VTln(NnNpni2){\displaystyle \varphi =V_{\rm {T}}\ln \left({\frac {N_{\rm {n}}N_{\rm {p}}}{n_{\rm {i}}^{2}}}\right)}
где VT{\displaystyle V_{\rm {T}}} — термодинамическое напряжение, Nn{\displaystyle N_{\rm {n}}} — концентрация электронов, Np{\displaystyle N_{\rm {p}}} — концентрация дырок, ni{\displaystyle n_{\rm {i}}} — собственная концентрация[2].
В процессе подачи напряжения плюсом на p-полупроводник и минусом на n-полупроводник внешнее электрическое поле будет направлено против внутреннего электрического поля p-n перехода и при достаточном напряжении электроны преодолеют p-n переход, и в цепи диода появится электрический ток (прямая проводимость, диод пропускает максимальный электрический ток).При подаче напряжения минусом на область с полупроводником p-типа и плюсом на область с полупроводником n-типа между двумя областями возникает область, которая не имеет свободных носителей электрического тока (обратная проводимость, диод сопротивляется пропусканию электрического тока). Обратный ток полупроводникового диода близок к нулю, но не равен нулю, так как в обоих областях всегда есть неосновные носители заряда. Для этих носителей p-n переход будет открыт.
Таким образом, p-n переход проявляет свойства односторонней проводимости, что обуславливается подачей напряжения с различной полярностью. Это свойство используют для выпрямления переменного тока.
Транзистор
Структура биполярного n-p-n транзистора.Транзистор — полупроводниковое устройство, которое состоит из двух областей с полупроводниками p- или n-типа, между которыми находится область с полупроводником n- или p-типа. Таким образом, в транзисторе есть две области p-n перехода.
Типы полупроводников в периодической системе элементов
В нижеследующей таблице представлена информация о большом количестве полупроводниковых элементов и их соединений, разделённых на несколько типов:
- одноэлементные полупроводники IV группы периодической системы элементов,
- сложные: двухэлементные AIIIBV и AIIBVI из третьей и пятой группы и из второй и шестой группы элементов соответственно.
Все типы полупроводников обладают интересной зависимостью ширины запрещённой зоны от периода, а именно — с увеличением периода ширина запрещённой зоны уменьшается.
| Группа | IIB | IIIA | IVA | VA | VIA |
| Период | |||||
| 2 | 5 B | 6 C | 7 N | ||
| 3 | 13 Al | 14 Si | 15 P | 16 S | |
| 4 | 30 Zn | 31 Ga | 32 Ge | 33 As | 34 Se |
| 5 | 48 Cd | 49 In | 50 Sn | 51 Sb | 52 Te |
| 6 | 80 Hg |
Физические свойства и применение
Прежде всего, следует сказать, что физические свойства полупроводников наиболее изучены по сравнению с металлами и диэлектриками. В немалой степени этому способствует огромное количество эффектов, которые не могут быть наблюдаемы ни в тех, ни в других веществах, прежде всего связанные с устройством зонной структуры полупроводников, и наличием достаточно узкой запрещённой зоны. Конечно же, основным стимулом для изучения полупроводников является производство полупроводниковых приборов и интегральных микросхем — это в первую очередь относится к кремнию, но затрагивает и другие соединения (Ge, GaAs, InP, InSb).
Кремний — непрямозонный полупроводник, оптические свойства которого широко используются для создания фотодиодов и солнечных батарей, однако его очень трудно заставить работать в качестве источника света, и здесь вне конкуренции прямозонные полупроводники — соединения типа AIIIBV, среди которых можно выделить GaAs, GaN, которые используются для создания светодиодов и полупроводниковых лазеров.
Собственный полупроводник при температуре абсолютного нуля не имеет свободных носителей в зоне проводимости в отличие от проводников и ведёт себя как диэлектрик. При легировании ситуация может поменяться (см. вырожденные полупроводники).
В связи с тем, что технологи могут получать очень чистые вещества, встаёт вопрос о новом эталоне для числа Авогадро.
Легирование
Объёмные свойства полупроводника могут сильно зависеть от наличия дефектов в кристаллической структуре. И поэтому стремятся выращивать очень чистые вещества, в основном для электронной промышленности. Легирующие примеси вводят для управления величиной и типом проводимости полупроводника. Например, широко распространённый кремний можно легировать элементом V подгруппы периодической системы элементов — фосфором, который является донором, и создать n-Si. Для получения кремния с дырочным типом проводимости (p-Si) используют бор (акцептор). Также создают компенсированные полупроводники с тем чтобы зафиксировать уровень Ферми в середине запрещённой зоны.
Методы получения
Свойства полупроводников зависят от способа получения, так как различные примеси в процессе роста могут изменить их. Наиболее дешёвый способ промышленного получения монокристаллического технологического кремния — метод Чохральского. Для очистки технологического кремния используют также метод зонной плавки.
Для получения монокристаллов полупроводников используют различные методы физического и химического осаждения. Наиболее прецизионный и дорогой инструмент в руках технологов для роста монокристаллических плёнок — установки молекулярно-лучевой эпитаксии, позволяющей выращивать кристалл с точностью до монослоя.
Оптика полупроводников
Поглощение света полупроводниками обусловлено переходами между энергетическими состояниями зонной структуры. Учитывая принцип запрета Паули, электроны могут переходить только из заполненного энергетического уровня на незаполненный. В собственном полупроводнике все состояния валентной зоны заполнены, а все состояния зоны проводимости незаполненные, поэтому переходы возможны лишь из валентной зоны в зону проводимости. Для осуществления такого перехода электрон должен получить от света энергию, превышающую ширину запрещённой зоны. Фотоны с меньшей энергией не вызывают переходов между электронными состояниями полупроводника, поэтому такие полупроводники прозрачны в области частот ω<Eg/ℏ{\displaystyle \omega <E_{g}/\hbar } , где Eg{\displaystyle E_{g}} — ширина запрещённой зоны, ℏ{\displaystyle \hbar } — постоянная Планка. Эта частота определяет фундаментальный край поглощения для полупроводника. Для полупроводников, которые зачастую применяются в электронике (кремний, германий, арсенид галлия) она лежит в инфракрасной области спектра.
Дополнительные ограничения на поглощение света полупроводников накладывают правила отбора, в частности закон сохранения импульса. Закон сохранения импульса требует, чтобы квазиимпульс конечного состояния отличался от квазиимпульса начального состояния на величину импульса поглощённого фотона. Волновое число фотона 2π/λ{\displaystyle 2\pi /\lambda }, где λ{\displaystyle \lambda } — длина волны, очень мало по сравнению с волновым вектором обратной решётки полупроводника, или, что то же самое, длина волны фотона в видимой области намного больше характерного межатомного расстояния в полупроводнике, что приводит к требованию того, чтобы квазиимпульс конечного состояния при электронном переходе практически равнялся квазиимпульсу начального состояния. При частотах, близких к фундаментальному краю поглощения, это возможно только для прямозонных полупроводников. Оптические переходы в полупроводниках, при которых импульс электрона почти не меняется называются прямыми или вертикальными. Импульс конечного состояния может значительно отличаться от импульса начального состояния, если в процессе поглощения фотона участвует ещё одна, третья частица, например, фонон. Такие переходы тоже возможны, хотя и менее вероятны. Они называются непрямыми переходами.
Таким образом, прямозонные полупроводники, такие как арсенид галлия, начинают сильно поглощать свет, когда энергия кванта превышает ширину запрещённой зоны. Такие полупроводники очень удобны для использования в оптоэлектронике.
Непрямозонные полупроводники, например, кремний, поглощают в области частот света с энергией кванта чуть больше ширины запрещённой зоны значительно слабее, только благодаря непрямым переходам, интенсивность которых зависит от присутствия фононов, и следовательно, от температуры. Граничная частота прямых переходов кремния больше 3 эВ, то есть лежит в ультрафиолетовой области спектра.
При переходе электрона из валентной зоны в зону проводимости в полупроводнике возникают свободные носители заряда, а следовательно фотопроводимость.
При частотах ниже края фундаментального поглощения также возможно поглощение света, которое связано с возбуждением экситонов, электронными переходами между уровнями примесей и разрешенными зонами, а также с поглощением света на колебаниях решётки и свободных носителях. Экситонные зоны расположены в полупроводнике несколько ниже дна зоны проводимости благодаря энергии связи экситона. Экситонные спектры поглощения имеют водородоподобную структуру энергетических уровней. Аналогичным образом примеси, акцепторы или доноры, создают акцепторные или донорные уровни, лежащие в запрещённой зоне. Они значительно модифицируют спектр поглощения легированного полупроводника. Если при непрямозонном переходе одновременно с квантом света поглощается фонон, то энергия поглощенного светового кванта может быть меньше на величину энергии фонона, что приводит к поглощению на частотах несколько ниже по энергии от фундаментального края поглощения.
Список полупроводников
Полупроводниковые соединения делят на несколько типов:
- простые полупроводниковые материалы — собственно химические элементы: бор B, углерод C, германий Ge, кремний Si, селен Se, сера S, сурьма Sb, теллур Te и йод I. Самостоятельное применение широко нашли германий, кремний и селен. Остальные чаще всего применяются в качестве легирующих добавок или в качестве компонентов сложных полупроводниковых материалов;
- в группу сложных полупроводниковых материалов входят химические соединения из двух, трёх и более химических элементов. Полупроводниковые материалы из двух элементов называют бинарными, и так же, как это принято в химии, имеют наименование того компонента, металлические свойства которого выражены слабее. Так, бинарные соединения, содержащие мышьяк, называют арсенидами, серу — сульфидами, теллур — теллуридами, углерод — карбидами. Сложные полупроводниковые материалы объединяют по номеру группы Периодической системы элементов Д. И. Менделеева, к которой принадлежат компоненты соединения, и обозначают буквами латинского алфавита (A — первый элемент, B — второй и т. д.). Например, бинарное соединение фосфид индия InP имеет обозначение AIIIBV
Широкое применение получили следующие соединения:
- AIIIBV
- InSb, InAs, InP, GaSb, GaP, AlSb, GaN, InN
- AIIBV
- AIIBVI
- ZnS, ZnSe, ZnTe, CdS, CdTe, HgSe, HgTe, HgS
- AIVBVI
- PbS, PbSe, PbTe, SnTe, SnS, SnSe, GeS, GeSe
а также некоторые окислы свинца, олова, германия, кремния а также феррит, аморфные стёкла и многие другие соединения (AIBIIIC2VI, AIBVC2VI, AIIBIVC2V, AIIB2IIC4VI, AIIBIVC3VI).
На основе большинства из приведённых бинарных соединений возможно получение их твёрдых растворов: (CdTe)x(HgTe)1-x, (HgTe)x(HgSe)1-x, (PbTe)x(SnTe)1-x, (PbSe)x(SnSe)1-x и других.
Соединения AIIIBV, в основном, применяются для изделий электронной техники, работающих на сверхвысоких частотах
Соединения AIIBV используют в качестве люминофоров видимой области, светодиодов, датчиков Холла, модуляторов.
Соединения AIIIBV, AIIBVI и AIVBVI применяют при изготовлении источников и приёмников света, индикаторов и модуляторов излучений.
Окисные полупроводниковые соединения применяют для изготовления фотоэлементов, выпрямителей и сердечников высокочастотных индуктивностей.
| Параметры | AlSb | GaSb | InSb | AlAs | GaAs | InAs |
|---|---|---|---|---|---|---|
| Температура плавления, К | 1333 | 998 | 798 | 1873 | 1553 | 1218 |
| Постоянная решётки, Å | 6,14 | 6,09 | 6,47 | 5,66 | 5,69 | 6,06 |
| Ширина запрещённой зоны ΔE, эВ | 0,52 | 0,7 | 0,18 | 2,2 | 1,32 | 0,35 |
| Диэлектрическая проницаемость ε | 8,4 | 14,0 | 15,9 | — | — | — |
| Подвижность, см²/(В·с): | ||||||
| электронов | 50 | 5000 | 60 000 | — | 4000 | 34000[3] |
| дырок | 150 | 1000 | 4000 | — | 400 | 460[3] |
| Показатель преломления света, n | 3,0 | 3,7 | 4,1 | — | 3,2 | 3,2 |
| Линейный коэффициент теплового расширения, K-1 | — | 6,9·10-6 | 5,5·10-6 | 5,7·10-6 | 5,3·10-6 | — |
Группа IV
- собственные полупроводники
- составной полупроводник
Группа III-V
- 2-компонентные полупроводники
- 3-компонентные полупроводники
- 4-компонентные полупроводники
- 5-компонентные полупроводники
Группа II-VI
- 2-компонентные полупроводники
- 3-компонентные полупроводники
Группа I-VII
- 2-компонентные полупроводники
Группа IV-VI
- 2-компонентные полупроводники
- 3-компонентные полупроводники
Группа V-VI
- 2-компонентные полупроводники
Группа II—V
- 2-компонентные полупроводники
Другие
- Разные оксиды
Органические полупроводники
Магнитные полупроводники
См. также
Примечания
- ↑ Н. С. Зефиров (гл. ред.). Химическая энциклопедия. — Москва: Большая Российская Энциклопедия, 1995. — Т. 4. — С. 55. — 639 с. — 20 000 экз. — ISBN 5-85270-092-4.
- ↑ Физические величины: справочник/ А. П. Бабичев Н. А. Бабушкина, А. М. Бартковский и др. под ред. И. С. Григорьева, Е. З. Мейлихова. — М.; Энергоатомиздат, 1991. — 1232 с — ISBN 5-283-04013-5
- ↑ 1 2 Индия арсенид // Химическая энциклопедия
Литература
- Тауц Я. Фото- и термоэлектрические явления в полупроводниках. М.: Издательство иностранной литературы, 1962, 256 с.
- Тауц Я. Оптические свойства полупроводников. М.: Мир, 1967, 74 с.
- Киреев П. С. Физика полупроводников. — М., Высшая школа, 1975. — Тираж 30000 экз. — 584 с.

