Фоторезисты. Позитивные и негативные фоторезисты
Электротехника \ Микроэлектронные устройства
Страницы работы
2 страницы (Word-файл)
Посмотреть все страницы
Скачать файл
Содержание работы
Фоторезисты
В качестве светочувствительных материалов в полупроводниковой промышленности применяют различные составы на основе органических веществ. Основное свойство такого состава — существенное изменение физикохимических свойств под действием облучения актиничным светом — объясняется фотохимическими реакциями между компонентами состава, в результате которых происходит в одних случаях сшивание молекул вещества в полимерные структуры, в других — разрушение межмолекулярных связей. В результате растворимость пленки такого вещества в проявителях специального состава изменяется таким образом, что в облученных местах пленка переходит для одних веществ из нерастворимого состояния в растворимое (
 В пленке позитивного
фоторезиста после проявления на облученных участках получаются окошки, для негативного фоторезиста картина будет обратной (негативной) — облученным участкам будет
соответствовать нерастворенная
пленка.
В пленке позитивного
фоторезиста после проявления на облученных участках получаются окошки, для негативного фоторезиста картина будет обратной (негативной) — облученным участкам будет
соответствовать нерастворенная
пленка.Позитивные фоторезисты чаще всего синтезируются на основе нафтохинондиазидов. Принцип действия этих фоторезистов заключается в замене (деструкции) диазогруппы на другие функциональные группы под действием света, в результате чего пленка фоторезиста приобретает растворимость в щелочных проявителях.
В негативных фоторезистах

Поливинилциннаматы чувствительны к ультрафиолетовой обмети спектра с длиной волны от 330 нм и меньше, но с помощью специальных сенсибиллизаторов граница чувствительности может быть существенно смещена в длинноволновую область спектра до 450 нм. Позитивные фоторезисты имеют длинноволновую границу ;сточувствительности в районе 460-480 нм,что снимает ряд требований к прозрачным материалам при конструировании аппаратуры для экспонирования. В частности, для экспонирования позитивного фоторезиста можно использовать обычную оптику, а не кварцевую. Это обстоятельство делает позитивный фоторезист более удобным для проекционной печати.
Основные требования, предъявляемые к фоторезистам, вытекают из технологических особенностей их применения.
Светочувствительные
материалы должны образовывать однородные
растворы заданной степени вязкости, с тем чтобы обеспечить равномерное нанесение сплошной тонкой (0,3 – 0,6 мкм)пленки, высыхающей достаточно
быстро. Фоторезистивные составы не должны иметь механических нерастворенных включений (пыли) с размерами частиц
более чем 0,1 — 0,2 мкм, в противном случае эти частицы образуют
проколы в обработанной пленке фоторезиста.
Пленки фоторезистов должны иметь достаточно высокую адгезионную способность к подложкам и стойкость к травителям разного состава, сохраняя при травлении хорошую адгезию и обеспечивая травление рельефа на необходимую глубину, определяемую технологическим процессом изготовления основного изделия. Фоторезисты должны обеспечивать достаточно высокую разрешающую способность, а также воспроизводимую гравировку рельефа с минимальными поперечными размерами. Кроме того, к составам фоторезистов предъявляются требования стабильности их свойств во времени и от партии к партии.
В отечественной и зарубежной промышленности создано большое количество фоточувствительных материалов, отвечающих указанным выше требованиям. Основные фоторезисты, нашедшие наиболее широкое применение в промышленности, приведены и табл. 6.3.
Разрешающая способность приведенных фоторезистов
зависит от толщины пленки и при ее снижении до 0,2-0,3 мкм может достигать 1200-2000 лин/мм, что позволяет
фотогравировать структуры самых различных конфигураций с размерами
элементов структур до 1 мкм, и менее.
Изображения, полученные на фоторезистовых пленках, имеют более четкие границы, чем могут обеспечить фотоэмульсии высокой разрешающей способности. Это явление обусловлено тем, что по своей природе фоторезисты имеют молекулярную, а не зернистую структуру, характерную для всех фотоэмульсий на основе галоидных соединений серебра.
Однако следует помнить, что разрешающая способность фоторезиста определяется на проявленном рельефе, а разрешающая способность процесса фотолитографии в целом определяется после травления пленки на подложке. На разрешающую способность процесса в значительной степени оказывают влияние как условия экспонирования (время, освещенность), так и качество обработки пластин после экспонирования (время проявления, кислотостойкость ФР, время травления).
Под кислотостойкостью ФР понимается стойкость
фоторезиста к воздействию агрессивных сред
при выполнении операций травления, т. е. при получении рельефа на
подложке. Для этой цели в фотолитографии на полупроводниковой пластине
используются кислоты: азотная, плавиковая и др.
Недостаточная кислотостойкость фоторезиста проявляется в следующем: фоторезист подтравливается на краях рельефа (что изменяет геометрические размеры рисунка), а также отслаивается от подложки при травлении или разрушается полностью (что является совершенно недопустимым).
Похожие материалы
Информация о работе
Скачать файл
Выбери свой ВУЗ
- АлтГТУ 419
- АлтГУ 113
- АмПГУ 296
- АГТУ 267
- БИТТУ 794
- БГТУ «Военмех» 1191
- БГМУ 172
- БГТУ 603
- БГУ 155
- БГУИР 391
- БелГУТ 4908
- БГЭУ 963
- БНТУ 1070
- БТЭУ ПК 689
- БрГУ 179
- ВНТУ 120
- ВлГУ 645
- ВМедА 611
- ВолгГТУ 235
- ВНУ им.
 Даля 166
Даля 166 - ВЗФЭИ 245
- ВятГСХА 101
- ВятГГУ 139
- ВятГУ 559
- ГГДСК 171
- ГомГМК 501
- ГГМУ 1966
- ГГУ им. Скорины 1590
- ГМА им. Макарова 299
- ДГПУ 159
- ДальГАУ 279
- ДВГГУ 134
- ДВГМУ 408
- ДВГТУ 936
- ДВГУПС 305
- ДВФУ 949
- ДонГТУ 498
- ДИТМ МНТУ 109
- ИвГМА 488
- ИГХТУ 131
- ИжГТУ 145
- КемГУ 508
- КГМТУ 270
- КировАТ 147
- КГКСЭП 407
- КГТА им.
 Дегтярева 174
Дегтярева 174 - КнАГТУ 2910
- КрасГАУ 345
- КрасГМУ 629
- КГПУ им. Астафьева 133
- КГТУ (СФУ) 567
- КПК №2 177
- КубГТУ 138
- КубГУ 109
- КузГПА 182
- КузГТУ 789
- МГТУ им. Носова 369
- МГЭУ им. Сахарова 232
- МГЭК 249
- МГПУ 165
- МАИ 144
- МАДИ 151
- МГИУ 1179
- МГОУ 121
- МГСУ 331
- МГУ 273
- МГУКИ 101
- МГУПИ 225
- МГУПС (МИИТ) 637
- МГУТУ 122
- МТУСИ 179
- ХАИ 656
- ТПУ 455
- НИУ МЭИ 640
- НМСУ «Горный» 1701
- ХПИ 1534
- НТУУ «КПИ» 213
- НУК им.
 Макарова 543
Макарова 543 - НВ 1001
- НГАВТ 362
- НГАУ 411
- НГАСУ 817
- НГМУ 665
- НГПУ 214
- НГТУ 4610
- НГУ 1993
- НГУЭУ 499
- НИИ 201
- ОмГТУ 302
- ОмГУПС 230
- СПбПК №4 115
- ПГУПС 2489
- ПГПУ им. Короленко 296
- ПНТУ им. Кондратюка 120
- РАНХиГС 190
- РОАТ МИИТ 608
- РТА 245
- РГГМУ 117
- РГПУ им.
 Герцена 123
Герцена 123 - РГППУ 142
- РГСУ 162
- «МАТИ» — РГТУ 121
- РГУНиГ 260
- РЭУ им. Плеханова 123
- РГАТУ им. Соловьёва 219
- РязГМУ 125
- РГРТУ 666
- СамГТУ 131
- СПбГАСУ 315
- ИНЖЭКОН 328
- СПбГИПСР 136
- СПбГЛТУ им. Кирова 227
- СПбГМТУ 143
- СПбГПМУ 146
- СПбГПУ 1599
- СПбГТИ (ТУ) 293
- СПбГТУРП 236
- СПбГУ 578
- ГУАП 524
- СПбГУНиПТ 291
- СПбГУПТД 438
- СПбГУСЭ 226
- СПбГУТ 194
- СПГУТД 151
- СПбГУЭФ 145
- СПбГЭТУ «ЛЭТИ» 379
- ПИМаш 247
- НИУ ИТМО 531
- СГТУ им.
 Гагарина 114
Гагарина 114 - СахГУ 278
- СЗТУ 484
- СибАГС 249
- СибГАУ 462
- СибГИУ 1654
- СибГТУ 946
- СГУПС 1473
- СибГУТИ 2083
- СибУПК 377
- СФУ 2424
- СНАУ 567
- СумГУ 768
- ТРТУ 149
- ТОГУ 551
- ТГЭУ 325
- ТГУ (Томск) 276
- ТГПУ 181
- ТулГУ 553
- УкрГАЖТ 234
- УлГТУ 536
- УИПКПРО 123
- УрГПУ 195
- УГТУ-УПИ 758
- УГНТУ 570
- УГТУ 134
- ХГАЭП 138
- ХГАФК 110
- ХНАГХ 407
- ХНУВД 512
- ХНУ им.
 Каразина 305
Каразина 305 - ХНУРЭ 325
- ХНЭУ 495
- ЦПУ 157
- ЧитГУ 220
- ЮУрГУ 309
Фильтрация фоторезиста при промышленном производстве микроэлектроники
Задачей фотолитографии является создание защитной маски, заданной конфигурации на подложке полупроводника. Это комплексный процесс, включающий выбор и очистку светочувствительного материала, подготовку подложек с дальнейшим формированием на них защитных пленок и дальнейшие технологические операции (экспонирование, термообработка, травление, проявление).
Светочувствительный материал, наносимый на подложку, называется фоторезистом. Фоторезисты – это полимерные системы, обладающие комплексными свойствами: способностью изменять свои свойства под воздействием света (светочувствительность) и способностью сопротивляться воздействию температуры и агрессивных кислотных и щелочных сред (резистивность).
В зависимости от реакции фоторезиста на воздействие света они делятся на позитивные и негативные. Негативные образуют на поверхности пластины нерастворимые участки, которые являются негативным отображением оригинала и остаются на поверхности пластины после проявления. Позитивные, напротив, создают растворимые участки и являются копией рисунка оригинала.
Среди негативных наиболее распространены соединения на основе сшитых полимеров на основе диазидов с фенол- и крезолформальдегидными смолами или циклоолефиновыми каучуками. Реакция полимеризации инициируется воздействием света, в результате происходит превращение диазида в нитрен с выделением азота с последующим присоединением нитрена к смоле или каучуку путем образования диазиридиновых мостиков. Механизм реакции может быть представлен уравнением:
Также применяются фоторезисты на основе сенсобилизированного поливинилового спирта [-CH2CH- (OH)-]n или состав на основе его сложного эфира с коричной кислотой – поливинилциннамата.
Для негативных фоторезистов применяются органические растворители, например, ксилол, толуол (их смеси), хлорбензол, циклогексанон (их смеси).
Типичными позитивными фоторезистами выступают системамы в которых в качестве светочувствительного компонента выступает сульфо-эфир о-нафтохинондиазида, содержание которого находится в пределах 5-40 %масс., а в качестве пленкообразующего агента выступают новолачные смолы. Также новолачные смолы значительно улучшают адгезию и химическую стойкость.
При воздействии света сложный эфир превращается в производное индекарбоновой кислоты. При воздействии водного раствора калийной щелочи при проявлении оно удаляется с поверхности вместе с новолачной смолой.
Очевидно, что качество фоторезиста напрямую влияет на процесс фотолитографии. Поэтому перед нанесением необходима фильтрация непосредственно перед точкой ввода в процесс – Point-of-Use. Среди возможных нежелательных включений в фоторезистах можно выделить следующие:
- Твердые механические частицы.
 Оседая между компонентами микросхемы, частица размером 0,2-0,3 мкм может приводить короткому замыканию и, как следствие, браку всего изделия. Также такие частицы препятствуют формированию равномерного слоя, причем этот дефект накапливается с каждым последующем слоем и может стать критическим.
Оседая между компонентами микросхемы, частица размером 0,2-0,3 мкм может приводить короткому замыканию и, как следствие, браку всего изделия. Также такие частицы препятствуют формированию равномерного слоя, причем этот дефект накапливается с каждым последующем слоем и может стать критическим. - Мягкие частицы (гели). Присутствие частиц данного типа в фоторезисте обусловлено особенностями процесса производства и хранения. В отличие от твердых частиц они способны к деформации при определенном давлении.
- Растворенные металлы. Остаточные концентрации железа, натрия, кальция в концентрациях более 20 мкг/л могут приводить к нарушениям проводящих свойств, что сказывается на качестве изделия в целом.
- Микропузырьки воздуха и газов. Для современных техпроцессов требуется применения фильтрующих элементов с тонким рейтингом фильтрации. В процессах могут применяться покрытия, содержащие ПАВ. Фоторезисты содержат достаточно большие количества растворенного воздуха.
 Эти факторы являются причиной возникновения микропузырьков, которые не только оказывают влияние на правильность нанесения и создания защитных масок, но и напрямую будут влиять на процесс фильтрации.
Эти факторы являются причиной возникновения микропузырьков, которые не только оказывают влияние на правильность нанесения и создания защитных масок, но и напрямую будут влиять на процесс фильтрации.
Исходя из понимания состава фоторезистов, возможных нежелательных включений и их особенностей, можно сформулировать требования к фильтрующим элементам:
- Должны обладать химической совместимостью с фоторезистом и должны быть чистыми. Учитывая крайне малый размер частиц, приводящий к негативным последствиям необходимо, чтобы фильтрующие элементы не привносили никаких дополнительных загрязнений в фильтрат. Как правило, фоторезист подается небольшими количествами и насосы, используемые для его подачи, не рассчитаны на длительные циклы отмывки элементов
- Должны обеспечивать минимальное дифференциальное давление при фильтрации. Данное требование вытекает сразу из двух возможных видов загрязнений фоторезиста: гелей и микропузырьков.
 Гели могут деформироваться под воздействием давления. Чем выше дифференциальное давление на элементе, тем большее давление на входе требуется для поддержания постоянного потока. В итоге при росте перепада давления входное давление может достичь значения, достаточного для деформации частицы и проникновения ее в фильтрат. Повышенное дифференциальное давление является одной из причин появления микропузырьков. Попадая в пору гидрофобного фильтрующего элемента, они приводят к недостаточной смачиваемости, в результате чего пора блокируется. По мере увеличения количества заблокированных пор растет перепад давления (происходит усиление эффекта) и снижается пропускная способность элемента.
Гели могут деформироваться под воздействием давления. Чем выше дифференциальное давление на элементе, тем большее давление на входе требуется для поддержания постоянного потока. В итоге при росте перепада давления входное давление может достичь значения, достаточного для деформации частицы и проникновения ее в фильтрат. Повышенное дифференциальное давление является одной из причин появления микропузырьков. Попадая в пору гидрофобного фильтрующего элемента, они приводят к недостаточной смачиваемости, в результате чего пора блокируется. По мере увеличения количества заблокированных пор растет перепад давления (происходит усиление эффекта) и снижается пропускная способность элемента. - Фильтрующий материал должен обладать хорошей смачиваемостью. Хорошая смачиваемость материала с одной стороны значительно снижает время подготовки элемента к фильтрации за счет быстрого удаления воздуха из пор, а с другой – предотвращает образование пузырьков и блокирование пор в процессе фильтрации.
 Величина критического поверхностного натяжения смачивания определяет необходимость предварительного смачивания материала и продолжительность подготовки к фильтроциклу.
Величина критического поверхностного натяжения смачивания определяет необходимость предварительного смачивания материала и продолжительность подготовки к фильтроциклу.
Для фильтрации фоторезиста мы рекомендуем картридж Amazon Supapore 16TTG, мембрана которого выполнена из гидрофобного ПТФЭ, а оснастка из PFA. Рекомендуемая рабочая температура – до 170 °С. Доступные рейтинги фильтрации от 0,05 до 10,0 мкм.
Также отличным выбором станет элемент Amazon Supapore Halar, с фильтрующим материалом ECTFE Halar и оснасткой из нейлона или полипропилена.
Фильтрующие элементы Amazon 16MPG – конструкция, полностью изготовленная из полипропилена. Абсолютная мембрана из полипропилена с рейтингом 0,1 или 0,2 мкм обладает широкой химической совместимостью, превосходной смачиваемостью и низким дифференциальным давлением.
Все, что вы должны знать о фотолитографии в нанотехнологиях
Фотолитография — один из самых популярных методов создания наноразмерных компонентов схемы. Нисефор Ньепс, французский ученый, разработал первый фоторезист в 1820 году. Этот компонент имеет основополагающее значение для фотолитографии в нанотехнологии. Фоторезисты — это вещества, вступающие в химическую реакцию под воздействием света. Сегодняшняя фотолитография очень похожа на оригинальный процесс Ньепса. Фотолитография в нанотехнологиях — это шестиэтапный процесс.
Нисефор Ньепс, французский ученый, разработал первый фоторезист в 1820 году. Этот компонент имеет основополагающее значение для фотолитографии в нанотехнологии. Фоторезисты — это вещества, вступающие в химическую реакцию под воздействием света. Сегодняшняя фотолитография очень похожа на оригинальный процесс Ньепса. Фотолитография в нанотехнологиях — это шестиэтапный процесс.
- Подготовка вафель
- нанесение фоторезиста
- Запекание перед экспозицией
- Воздействие
- Запекание после экспонирования
- Разработка
Пластина представляет собой тонкий кусок полупроводникового материала, такого как кристаллический кремний, образующий основу для фотолитографии. Прежде чем пластина будет готова к использованию, она должна пройти несколько этапов подготовки и очистки от органических загрязнений.
В чем разница между фотолитографическим позитивным негативным резистом? Фоторезист является важным материалом для поставщиков полупроводников. Однако два типа этого светочувствительного материала, отрицательный и положительный, по-разному реагируют на УФ-излучение. Поэтому крайне важно полностью понимать различия между фотолитографическим позитивным негативным резистом и резистом , чтобы обеспечить высочайшее качество результатов в бизнесе по производству полупроводников.
Однако два типа этого светочувствительного материала, отрицательный и положительный, по-разному реагируют на УФ-излучение. Поэтому крайне важно полностью понимать различия между фотолитографическим позитивным негативным резистом и резистом , чтобы обеспечить высочайшее качество результатов в бизнесе по производству полупроводников.
Позитивные фоторезисты
Позитивные фоторезисты стратегически нацелены на зону поставщика полупроводников для удаления УФ-излучения. Химическая структура фоторезиста изменяется под воздействием УФ-излучения. Он становится более растворимым в проявителях фоторезиста.
Растворитель для проявителя фоторезиста используется для смывания экспонированных участков, оставляя нижележащий материал. Проявитель фоторезиста не растворяет области, которые не подвергались воздействию УФ-излучения. Вы получаете идентичную копию шаблона при работе с позитивными фоторезистами в производстве полупроводников. Эта маска помещается на пластину.
Эта маска помещается на пластину.
Негативные фоторезисты
Воздействие УФ-излучения может вызвать полимеризацию негативных резистов. Это противоположность позитивным фоторезистам. Негативные фоторезисты менее растворимы и труднее растворяются. Таким образом, обработанный УФ-излучением негативный резист остается на поверхности, а раствор для проявления фоторезиста удаляет неэкспонированные области. Это создает маску с рисунком, обратным оригиналу, нанесенному на пластину.
Хотя сегодня в производстве полупроводников все еще можно использовать как позитивные, так и негативные фоторезисты, многие поставщики полупроводников предпочитают позитивные фоторезисты из-за их более высокого разрешения. Поскольку растворитель, используемый для проявления фоторезиста, не проникает в области, не подверженные воздействию УФ-излучения, позитивные фоторезисты могут сохранять свой рисунок и размер. Негативные резисты могут вызывать искажения рисунка, проникая как в области, подвергшиеся воздействию УФ-излучения, так и в области, не подвергавшиеся воздействию.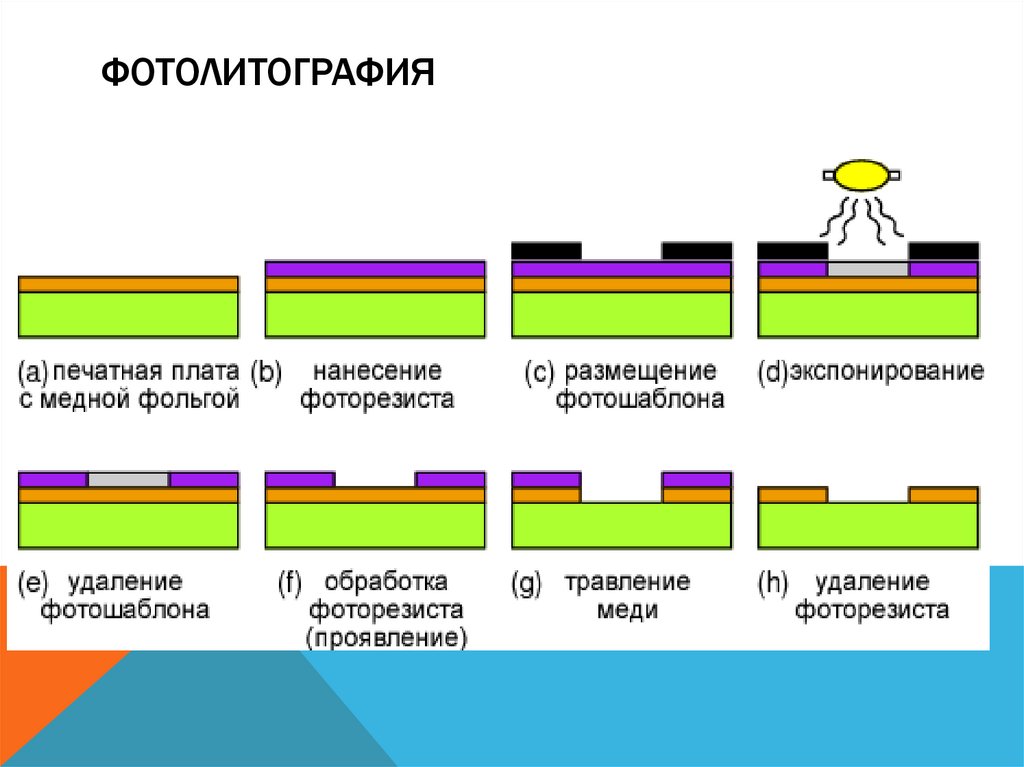
Хотя позитивные фоторезисты имеют преимущество, они не являются единственным вариантом. Негативные резисты могут быть отличным выбором для полупроводниковых источников питания с низкими требованиями к разрешению. Негативные резисты работают быстрее, чем позитивные фоторезисты, имеют более широкий диапазон процессов, более низкие эксплуатационные расходы и более высокую скорость фотопечати. Кроме того, негативные фоторезисты имеют более высокую адгезию к определенным материалам подложки. В результате как негативные, так и позитивные фоторезисты необходимы в производстве полупроводников и позволяют производить различные высококачественные продукты.
Олеофобные фоторезисты и пример корпуса
02/
Пример применения технологии олеофобного фоторезиста при производстве OLED-дисплеев В этом разделе объясняется, почему технология олеофобного фоторезиста стала необходимой при производстве OLED-дисплеев, проблемы, которые были решены, требуемые спецификации и т. д.
д.
OLED-дисплей используется в качестве примера технологии олеофобного фоторезиста. Объясняется, почему эта технология стала необходимой при производстве OLED-дисплеев, решаемые проблемы, требуемые характеристики и т. д. Пожалуйста, изучите возможности олеофобного фоторезиста на примере этого случая.
Почему олеофобность стала необходимой при производстве OLED-панелей
Почему олеофобность стала необходимой при производствепанели OLED-дисплея
Традиционными методами производства панелей OLED-дисплеев являются метод осаждения из паровой фазы белого цвета + цветной фильтр и метод осаждения из паровой фазы RGB. Эти производственные процессы требуют больших вакуумных устройств и тонких масок. Однако использование этих методов для больших дисплеев сопряжено с чрезвычайными техническими трудностями, а также с увеличением производственных затрат из-за низкой эффективности производства, увеличением стоимости материалов из-за низкого коэффициента использования материалов и воздействия на окружающую среду.
Между тем, метод печати RGB, который был предметом исследований и разработок, сокращает процессы больших вакуумных устройств и не требует тонкой маски. Это позволило наладить массовое производство мониторов среднего размера, повысить эффективность производства и снизить производственные затраты. JOLED Inc. запустила линию массового производства с использованием метода RGB-печати для производства 32-дюймового дисплея (OLEDIO™) в 2021 году.
JOLED Inc.:
https://www.j-oled.com/eng/technology/
JOLED Inc.:
https://www.j-oled.com/eng/press/20210329/
Олеофобная технология имеет важное значение в методе печати RGB.
Отдельное применение чернил RGB на струйном OLED-дисплее с использованием олеофобной технологии
Отдельное приложение для чернил RGBна струйном OLED-дисплее
решено по олеофобной технологии
В методе печати RGB, который является эффективным способом производства OLED-дисплеев, люминесцентные материалы наносятся на пиксели RGB внутри панели OLED-дисплея с помощью струйной печати.
OLED использует органические соединения (чернила) в качестве люминесцентных материалов. Также имеются пиксели RGB шириной от 10 до 30 мкм и толщиной пленки от 1 до 2 мкм, выровненные внутри панели, как показано на рис. 3.
Для предотвращения смешения цветов между соседними пикселями, когда чернила наносятся на пиксели в качестве люминесцентного материала. , стена (банка), разделяющая пиксели, должна быть олеофобной. В процессе фотолитографии гидрофобный и олеофобный слой формируются только в верхней части стенки (банки), разделяющей RGB-пиксели (см. рис. 4), для предотвращения смешения цветов.
Рис. 3: RGB-пиксели на подложке OLED-дисплея
Рис. 4: Поперечное сечение RGB-пикселей на подложке OLED-дисплея
Олеофобный фоторезист, поддерживающий метод RGB-печати для изготовления панелей OLED-дисплеев
Олеофобный фоторезист, поддерживающийметод печати RGB
для производства OLED-панелей
Для олеофобного фоторезиста, используемого в методе RGB-печати, гидрофобный и олеофобный слой должны формироваться только на верхней части стенки (банки), разделяющей RGB-пиксели в процессе фотолитографии.
Подложка с гидрофобным и олеофобным слоем, сформированным после процесса фотолитографии, направляется в процесс нанесения люминесцентного материала (чернил) внутрь пикселей методом струйной печати. В этом процессе можно контролировать чернила, поскольку люминесцентный материал (чернила) скользит вниз и оседает внутри пикселя благодаря олеофобным характеристикам, даже когда чернила капают на гидрофобный и олеофобный слой в верхней части блока (см. 5).
Рис. 5: Поперечное сечение пикселей RGB на подложке OLED-дисплея и функция гидрофобного и олеофобного слоев в олеофобном фоторезисте
Свойство переноса фтора на поверхность, которое требуется в олеофобном фоторезисте для струйных дисплеев OLED
Поверхностная переносимость фтора,что требуется в олеофобном фоторезисте
для струйных OLED-панелей
Соединение фтора используется в олеофобных фоторезистах для струйных OLED-дисплеев. Это связано с тем, что фтор обладает свойствами гидрофобности и олеофобности, а также переносом поверхности на границу раздела с воздухом.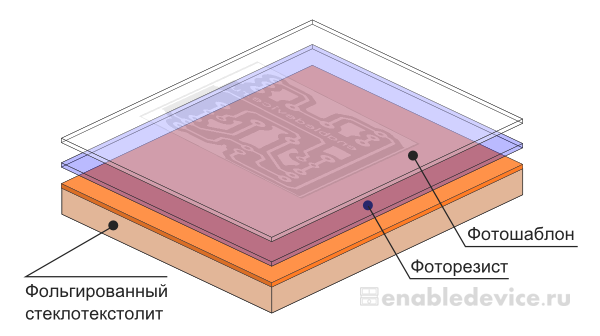 В частности, свойство поверхностного переноса важно для формирования гидрофобного и олеофобного слоев только в верхней части стенки (банки), разделяющей RGB-пиксели.
В частности, свойство поверхностного переноса важно для формирования гидрофобного и олеофобного слоев только в верхней части стенки (банки), разделяющей RGB-пиксели.
Фтор переносится на поверхность благодаря малой силе Ван-дер-Ваальса (межмолекулярной силе) и малой внутренней энергии. В то время как в растворителе олеофобного фоторезиста смешиваются несколько соединений, включая фтористый компонент, фтористый компонент отделяется от других компонентов из-за разницы в силе Ван-дер-Ваальса при удалении растворителя в процессе фотолитографии. Поскольку воздух обладает небольшой силой Ван-дер-Ваальса, аналогичной фторсодержащей составляющей, фторсодержащая составляющая, обладающая относительно небольшой внутренней энергией по сравнению с другими соединениями, имеет тенденцию двигаться к поверхности раздела с воздухом, чтобы стабилизировать пленку покрытия (см. 6).
Данная характеристика позволяет избирательно переносить фторсодержащую составляющую на поверхность, формируя таким образом олеофобный фоторезист с гидрофобным и олеофобным слоем только в верхней части банки.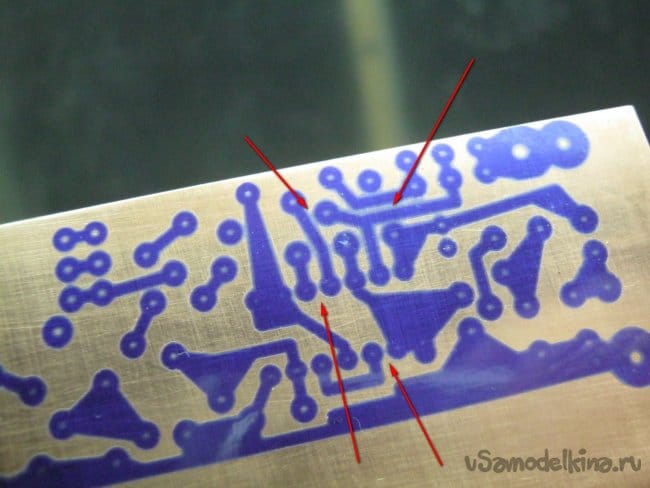


 Даля 166
Даля 166 Дегтярева 174
Дегтярева 174 Макарова 543
Макарова 543 Герцена 123
Герцена 123 Гагарина 114
Гагарина 114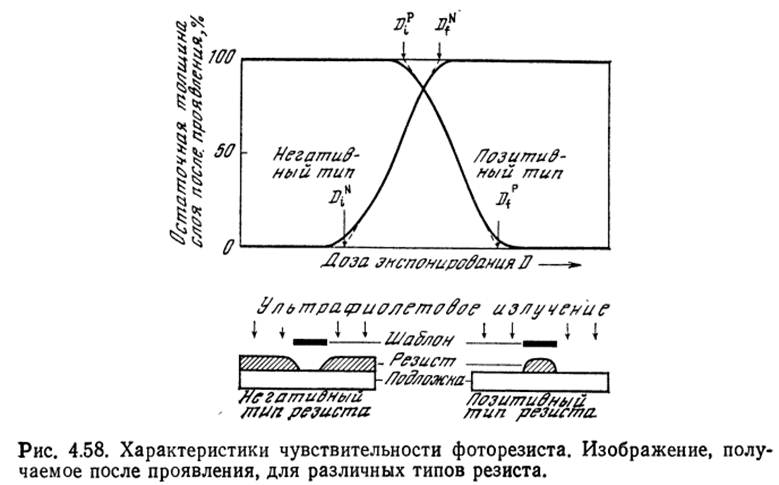 Каразина 305
Каразина 305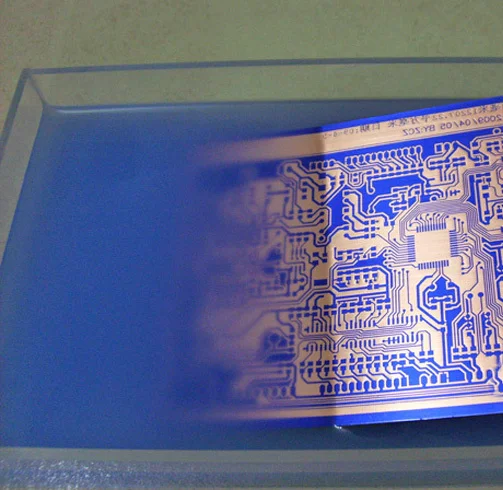 Оседая между компонентами микросхемы, частица размером 0,2-0,3 мкм может приводить короткому замыканию и, как следствие, браку всего изделия. Также такие частицы препятствуют формированию равномерного слоя, причем этот дефект накапливается с каждым последующем слоем и может стать критическим.
Оседая между компонентами микросхемы, частица размером 0,2-0,3 мкм может приводить короткому замыканию и, как следствие, браку всего изделия. Также такие частицы препятствуют формированию равномерного слоя, причем этот дефект накапливается с каждым последующем слоем и может стать критическим.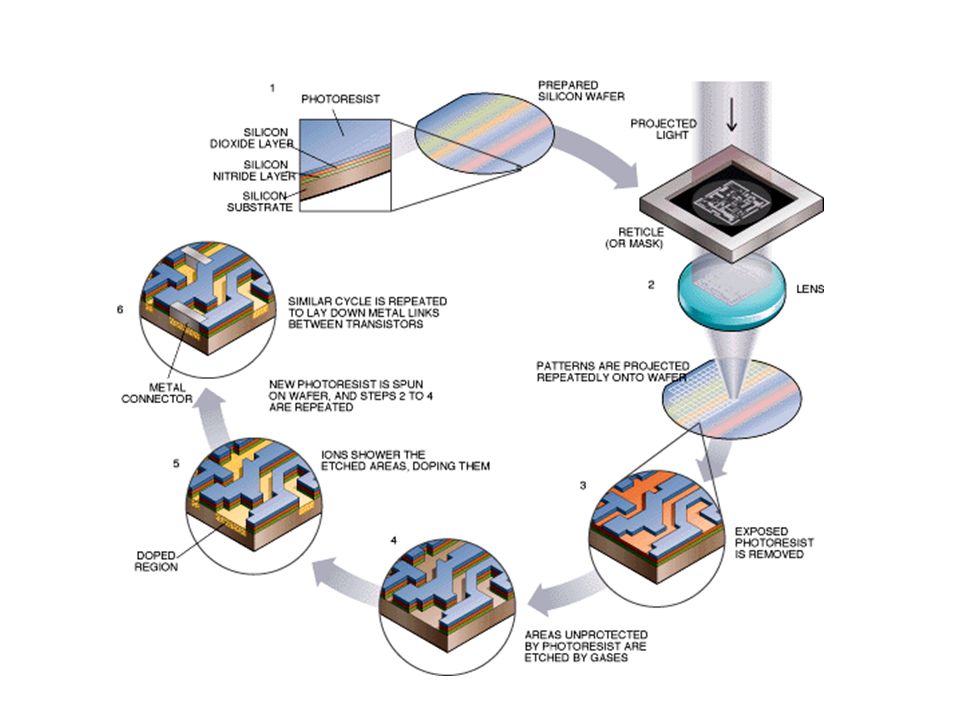 Эти факторы являются причиной возникновения микропузырьков, которые не только оказывают влияние на правильность нанесения и создания защитных масок, но и напрямую будут влиять на процесс фильтрации.
Эти факторы являются причиной возникновения микропузырьков, которые не только оказывают влияние на правильность нанесения и создания защитных масок, но и напрямую будут влиять на процесс фильтрации. Гели могут деформироваться под воздействием давления. Чем выше дифференциальное давление на элементе, тем большее давление на входе требуется для поддержания постоянного потока. В итоге при росте перепада давления входное давление может достичь значения, достаточного для деформации частицы и проникновения ее в фильтрат. Повышенное дифференциальное давление является одной из причин появления микропузырьков. Попадая в пору гидрофобного фильтрующего элемента, они приводят к недостаточной смачиваемости, в результате чего пора блокируется. По мере увеличения количества заблокированных пор растет перепад давления (происходит усиление эффекта) и снижается пропускная способность элемента.
Гели могут деформироваться под воздействием давления. Чем выше дифференциальное давление на элементе, тем большее давление на входе требуется для поддержания постоянного потока. В итоге при росте перепада давления входное давление может достичь значения, достаточного для деформации частицы и проникновения ее в фильтрат. Повышенное дифференциальное давление является одной из причин появления микропузырьков. Попадая в пору гидрофобного фильтрующего элемента, они приводят к недостаточной смачиваемости, в результате чего пора блокируется. По мере увеличения количества заблокированных пор растет перепад давления (происходит усиление эффекта) и снижается пропускная способность элемента. Величина критического поверхностного натяжения смачивания определяет необходимость предварительного смачивания материала и продолжительность подготовки к фильтроциклу.
Величина критического поверхностного натяжения смачивания определяет необходимость предварительного смачивания материала и продолжительность подготовки к фильтроциклу.