Под термином фоторезист понимается светочувствительная полимерная пленка, которая под воздействием света меняет свои физико-химические свойства и обладает устойчивостью к химическому или механическому воздействию. Развитие современной электроники, средств связи, спутников, телевидения, компьютеров невозможно
представить без применения фоторезистов.
Фоторезист — один из ключевых материалов
микро- и радиоэлектроники. Необходимо различать позитивные и негативные фоторезисты. Позитивный фоторезист точно передает рисунок с оригинал — макета на подложку. Негативный фоторезист передает рисунок в обращенном виде. Необходимо также различать жидкие и сухие пленочные фоторезисты. Жидкий фоторезист — это раствор полимера и светочувствительного соединения в органическом растворителе. Сухой пленочный фоторезист — это «сэндвич» из трех слоев полимеров, в середине которого находится светочувствительный слой. Для получения пленки из жидкого фоторезиста необходимо его либо налить на поверхность и затем подложку привести во вращение (центрифуга), либо распылить из аэрозольной упаковки. Сухой пленочный фоторезист прикатывают к поверхности ламинатором. Основное различие этих двух типов фоторезистов заключается в максимально достижимом разрешении элементов изображения. Стандартное разрешение сухих пленочных фоторезистов — это 125-250 мкм.
Поэтому основное их применение — изготовление печатных плат, в особенности многослойных
печатных плат. Современные жидкие фоторезисты обеспечивают разрешение 0,35 — 0,5 микрон (процессоры Pentium III и IV). Микроэлектроника не может развиваться без совершенствования физико-химических параметров фоторезистов. Это залог успеха на рынке микроэлектроники. По этой причине о разработке фоторезиста с разрешением 0,18 микрон сообщили одновременно несколько западных фирм. Хотя и известен физический механизм работы этого фоторезиста, но состав его держится в строгом секрете. Помимо электроники жидкие фоторезисты широко используются:
Подробно органические светочувствительные среды
для голографии описаны на сайте: http://bsfp.media-security.ru/school7/24.htm.
Основным преимуществом фоторезистов в отличие от других сред для голографии,
содержащих желатину (фотографические пластины, хромированная желатина), является
их безусадочность, что чрезвычайно важно при голографической записи. Главный
недостаток фоторезистов связан с их светочувствительностью только в
ультрафиолетовой области При изготовлении голографическими способами
мастер — диска, штамп — матрицы, дифракционных решеток ранее, как правило,
использовался импортный
фоторезист типа AZ-1350. В настоящее время применяют фоторезисты фирмы Shipey S1813 или S1818.
Однако новые отечественные фоторезисты с локальной разнотолщинностью пленки менее 10 нм и
фильтрацией на уровне 0,2 мкм вполне заменяют фоторезист AZ-1350, S1813 или S1818. Жидкие фоторезисты незаменимы в производстве печатных плат с высокой степенью монтажа (разрешение элементов до 10 микрон), а также при изготовлении односторонних печатных плат. В последнем случае применение жидких фоторезистов удешевляет процесс, что существенно для радиолюбительской практики. В настоящее время любители могут изготовлять печатные платы с помощью фоторезиста в аэрозольной упаковке , с помощью заготовок печатных плат с заранее нанесенным слоем фоторезиста или пигментной бумаги. В последнем случае весь процесс изготовления печатных плат можно перенести практически в домашние условия. И, наконец, совокупность стадий применения фоторезистов называется фотолитографией. Ссылки по теме:
|
||
Что такое фоторезист
На примере фоторезистов фирмы Elga Europa рассматривается применение сухих пленочных фоторезистов при изготовлении печатных плат по различным технологическим режимам. Версия в PDF Kb. Для изготовления печатных плат фирма Elga Europa рекомендует следующие основные типы фоторезистов:. Ограничение по показателю разрешения зависит в основном от оборудования, используемого при работе с фоторезистом.
Версия в PDF Kb. Для изготовления печатных плат фирма Elga Europa рекомендует следующие основные типы фоторезистов:. Ограничение по показателю разрешения зависит в основном от оборудования, используемого при работе с фоторезистом.
Поиск данных по Вашему запросу:
Схемы, справочники, даташиты:
Прайс-листы, цены:
Обсуждения, статьи, мануалы:
Дождитесь окончания поиска во всех базах.
По завершению появится ссылка для доступа к найденным материалам.
Содержание:
- Фоторезист пленочный 300×1000мм
- фоторезист
- Изготовление платы по фоторезистивной технологии
- Выбор фоторезиста для различных технологий производства печатных плат
- Путь от схемы до устройства.
Часть 5: фоторезист - Фоторезист
- Пленочный фоторезист. Изготовление печатных плат в домашних условиях.
- Справочник химика 21
- Позитивный фоторезист ФП-2550
- Нанесение пленочного фоторезиста на печатную плату
ПОСМОТРИТЕ ВИДЕО ПО ТЕМЕ: Изготовление печатных плат своими руками 3 — фоторезист
Фоторезист пленочный 300×1000мм
На примере фоторезистов фирмы Elga Europa рассматривается применение сухих пленочных фоторезистов при изготовлении печатных плат по различным технологическим режимам. Версия в PDF Kb. Для изготовления печатных плат фирма Elga Europa рекомендует следующие основные типы фоторезистов:. Ограничение по показателю разрешения зависит в основном от оборудования, используемого при работе с фоторезистом.
Для изготовления печатных плат фирма Elga Europa рекомендует следующие основные типы фоторезистов:. Ограничение по показателю разрешения зависит в основном от оборудования, используемого при работе с фоторезистом.
Сами фоторезисты различаются по устойчивости к щелочному раствору, пластичности, методам удаления. Чувствителен к влажности и температурным условиям хранения. Возможны проблемы, связанные с растеканием фоторезиста по краям рулона и утончением на краях отверстий печатной платы. Обладает хорошей адгезией к основанию печатной платы. Время удаления составляет с, размер частиц удаляемого фоторезиста меньше среднего. Этот фоторезист тверже, чем Alpha , конформность хорошая, но хуже чем у Alpha Рекомендуется для металлизации меди, тентинга с кислотным травлением или очень мягкого щелочного травления.
Обладает очень хорошей адгезией, хорошо удаляется за более короткое время, чем Alpha Фоторезист широкого применения, рекомендуется для всех процессов, кроме нанесения золота толщиной больше 0,2 мкм.
Рекомендуется для всех видов применения кроме нанесения слоя золота большой толщины и особенно для различных вариантов прямой металлизации палладий, углерод, полимер и т. Все остальные свойства такие же, как у фоторезиста Alpha S, но у AM лучше адгезия, меньше размер частиц и лучше устойчивость к золотому покрытию. Фоторезист широкого применения с хорошей устойчивостью к химикатам; идеален для долгого травления травление Превосходная устойчивость к осаждению золота, даже при большой толщине.
Используется для металлизации, тентинга и изготовления внутренних слоев. Удаляется фоторезист медленно, размер удаляемых частиц от среднего до большого, по этой причине предпочтительнее использовать растворы для удаления от компании Elga Europe.
Удаляется фоторезист медленно, размер удаляемых частиц от среднего до большого, по этой причине предпочтительнее использовать растворы для удаления от компании Elga Europe.
Хранение в некондиционируе-мых помещениях влажность и температура не контролируются. Чтобы избежать проблем с растеканием фоторезиста по краям рулона и утончением по краям отверстия печатной платы, рекомендуется использовать более твердые фоторезисты. Однако в этом случае могут возникнуть проблемы при ламинировании и тентинге.
Фоторезист, распадающийся при раздубливании на мелкие частицы, можно использовать на любом оборудовании снятия фоторезиста и при любых условиях. Применение фоторезистов Alpha , AM и AR S может приводить к проблемам с системой фильтрации циклонного типа из-за очень большого размера удаляемых частиц. Дополнительных требований к установкам экспонирования нет, так как все материалы являются высокочувствительными и могут быть использованы с лампами мощностью 3 кВт.
Все фоторезисты обладают высоким разрешением, очень высокое разрешение 20 мкм требует применения особых фоторезистов, таких как FP Толщина всех фоторезистов 30, 40 и 50 мкм, по особому требованию производятся фоторезисты толщиной 20 и 75 мкм.
Рассмотрим основные операции при работе с сухими пленочными фоторезистами. Подготовка поверхности перед нанесением сухого пленочного фоторезиста призвана обеспечить оптимальную адгезию фоторезиста к поверхности заготовки. Адгезия к меди зависит от двух факторов: микрорельефа поверхности меди на заготовке и химических реакций на поверхности. Шероховатая поверхность обеспечивает требуемую площадь контакта для лучшего механического сцепления сухого пленочного фоторезиста.
В то же время, избыточная адгезия отрицательно влияет на дальнейшую обработку фоторезиста. Состав фоторезиста разрабатывается таким образом, чтобы он надлежащим образом соединялся с подготовленной медной поверхностью, которая по отношению к нему является гидрофильной, гидратированной и полярной.
Удаление защитной пленки или антиоксидантов, которые применяются для предотвращения окисления медной фольги, и удаление отпечатков пальцев, жиров, масел и т. Создание шероховатой поверхности при помощи механических средств или микротравления.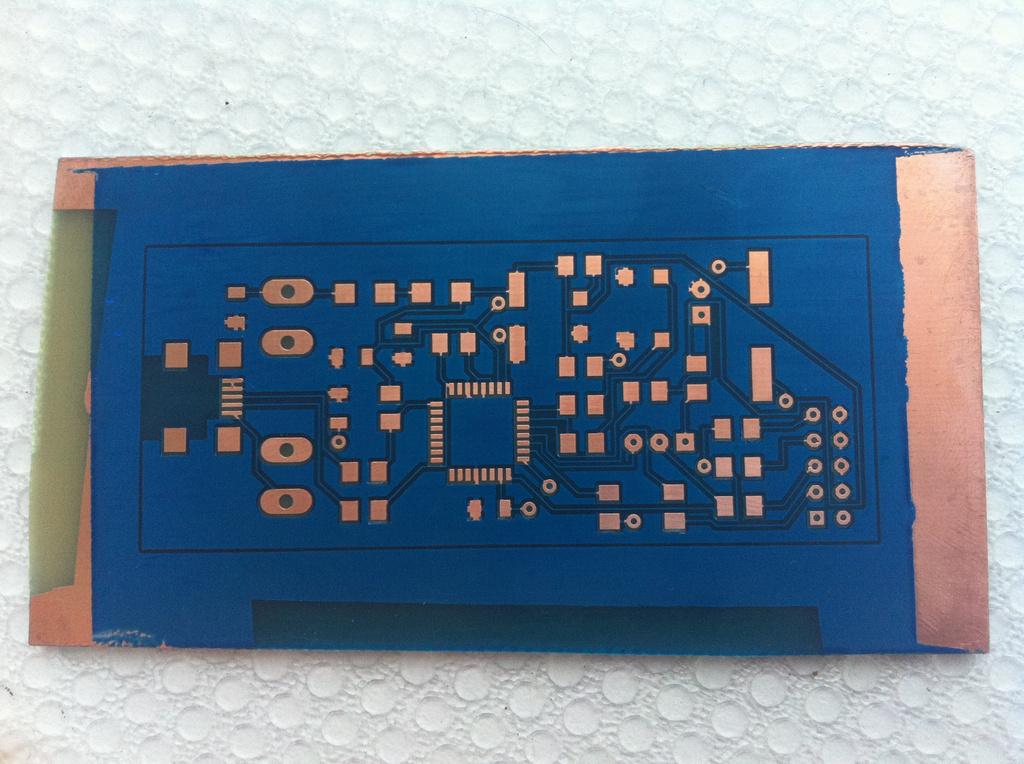
При подготовке поверхности медной фольги применяются химическая очистка, включая микротравление, и различные виды механической очистки пемзовая щеточная, гидроабразив, абразивные валки. Кислотная химическая очистка с микротравлением позволяет получить подходящую поверхность без риска деформации, которая возможна при механической подготовке на тонком ламинате. Для микротравления используется раствор персульфата или моноперсульфата натрия.
При этом с поверхности должно быть стравлено порядка 1,0 мкм меди. Следующим шагом является травление серной кислотой или промывка водой под высоким давлением и просушка. Подготовленная поверхность сохраняет свойства около 4 ч. Следует заметить, что повторное окисление происходит быстрее при химической подготовке поверхности и медленнее при механической подготовке.
Фоторезист наносится на металлизированную поверхность заготовки. Так как гальваническая медь очень чиста, она не требует дополнительной химической очистки перед нанесением фоторезиста.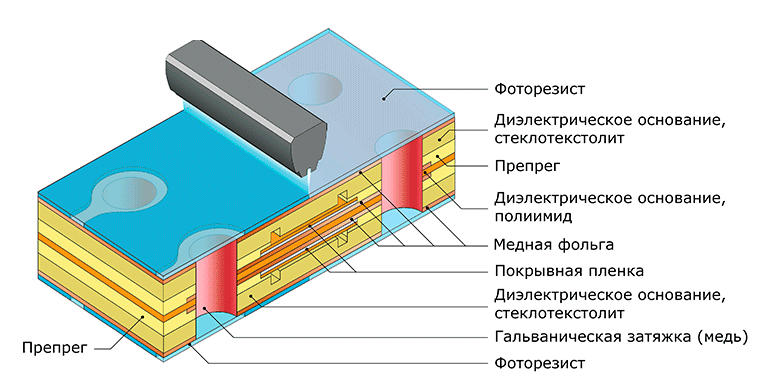 Если оборудование для металлизации заготовок не обеспечивает требуемой чистоты, требуется очистка раствором кислоты для удаления оксидов. Металлизированная медная поверхность должна быть равномерной по структуре. При наличии де-ндритов меди необходима дополнительная механическая очистка.
Если оборудование для металлизации заготовок не обеспечивает требуемой чистоты, требуется очистка раствором кислоты для удаления оксидов. Металлизированная медная поверхность должна быть равномерной по структуре. При наличии де-ндритов меди необходима дополнительная механическая очистка.
После осаждения химической меди с последующей затяжкой поверхность можно подготовить механическим или химическим способом. Максимальное время межоперационного хранения до нанесения фоторезиста — 4 ч.
В противном случае необходимо провести повторную подготовку поверхности. В случае прямой металлизации фоторезист наносят прямо на металлизированную поверхность, как только заготовка выйдет с линии. По этой причине на многих предприятиях ламинатор размещают в непосредственной близости от линии прямой металлизации. Чтобы улучшить адгезию фоторезиста металлизированные поверхности иногда зачищают механически. Необходимость этого определяется конкретным процессом и типом фоторезиста.
Обратите внимание, что после некоторых процессов прямой металлизации не рекомендуется зачищать или химически обрабатывать поверхности заготовок, чтобы не нарушить целостность металлизации в отверстиях. В некоторых случаях микротравление также может быть частью процесса прямой металлизации для удаления частиц катализатора углерода, графита или сульфида палладия с поверхности.
В некоторых случаях микротравление также может быть частью процесса прямой металлизации для удаления частиц катализатора углерода, графита или сульфида палладия с поверхности.
В этом случае медная. Фоторезист Огс1у1 может применяться со всеми современными ламинаторами. Технологическая операция нанесения фоторезиста требует очень высокой чистоты.
Заготовки, валик для нанесения фоторезиста и окружающая среда должны быть свободны от грязи и частиц пыли, которые могут приводить к проколам. Валики для ламинирования надо периодически проверять и очищать изопропило-вым спиртом, чтобы избежать повторяющихся дефектов при нанесении фоторезиста на поверхность заготовки печатной платы см.
Дефекты ламинирования: а дефект, вызванный выпуклостью на валике; б дефект, вызванный впадиной на валике. Внешний вид дефекта, вызванного впадиной царапиной на валике, отличается от дефекта, вызванного выпуклостью. Дефект от выпуклости проявляется в виде слабых пятен, некоторые могут иметь светлые ореолы вокруг.
Дефекты, вызванные впадиной, проявляются в виде однородных светлых участков, а форма дефекта похожа на форму впадины. Для обеспечения высокого процента выхода годных плат тип фоторезиста должен соответствовать степени волнистости поверхности материала, вызванной переплетением нитей стеклоткани в диэлектрике так называемый феномен доминирования стеклоткани.
Это очень важно при изготовлении рисунка с высоким разрешением. Верхний температурный предел определяется тенденцией фоторезиста к сморщиванию. Повышение температуры валика, подогрева и увеличивающееся давление должны быть тщательно выверены, чтобы не произошло повреждения покрытия из-за того, что фоторезист будет затягиваться в сквозные отверстия.
Условия нанесения фоторезиста всегда должны соответствовать его пластичности. Контроль температуры фоторезиста на заготовке на выходе из ламинатора используется для проверки правильности нанесения фоторезиста. Температура платы на выходе зависит от толщины платы, конструкции ламинатора, наличия предварительного нагрева платы, температуры валиков для нанесения фоторезиста, скорости его нанесения. Рекомендуется использовать контроль температуры как инструмент контроля качества, но не в качестве технических требований.
Рекомендуется использовать контроль температуры как инструмент контроля качества, но не в качестве технических требований.
Замер температуры заготовки на выходе осуществляется термополосками. Время выдержки. Фоторезист Огс1у1 можно экспонировать сразу же после нанесения, что не ухудшит его разрешения. Но так как заготовки и фотошаблоны меняют размеры с изменением температуры, перед экспонированием заготовки следует охладить до комнатной температуры.
При конвейерной организации производства необходимо использовать накопитель, располагаемый между ламинатором и установкой экспонирования, чтобы заготовки охладились до комнатной температуры. Максимальное время выдержки определяется эмпирически, так как оно зависит от температуры и влажности помещения, где хранятся заламинированные заготовки, а также от типа химического состава фоторезиста.
После операций металлизации отверстий следует проверить, что сквозные отверстия хорошо высушены перед ламинированием. Если в отверстиях находится вода, фоторезист может затечь в них, вызвав тем самым пустоты по краю, которые будут увеличиваться со временем. Чувствительность фоторезиста ОМу1 в ультрафиолетовой области максимальна на длине волны Вообще, фоторезист чувствителен в области Чтобы обеспечить оптимальное разрешение и хорошее качество канала фоторезиста, необходимо иметь:.
Чувствительность фоторезиста ОМу1 в ультрафиолетовой области максимальна на длине волны Вообще, фоторезист чувствителен в области Чтобы обеспечить оптимальное разрешение и хорошее качество канала фоторезиста, необходимо иметь:.
Определение оптимального времени экспонирования следует производить с помощью ступенчатого клина Што-уффера. Существует линейная зависимость между проявлением ступеней клина Штоуффера и экспонированием см. Тип фоторезиста и особенности процесса экспонирования влияют на выбор оптимальной энергии экспонирования.
Для фоторезиста Огс1у1 она может варьироваться в пределах 8. Далее приводятся некоторые основные показатели, обеспечивающие оптимальный выбор и влияющие на процесс экспонирования фоторезиста. Проявление можно выполнить сразу же после экспонирования, в противном случае допускается хранение заготовок в темном месте в течение нескольких дней.
Фоторезист, обладающий более высоким разрешением, характеризуется меньшим увеличением ширины проводника при воздействии на него избыточной энергии экспонирования. Процессы нанесения фоторезиста и экспонирования являются наиболее чувствительными к загрязнению. Посторонние частицы между фоторезистом и медью при нанесении фоторезиста понижают адгезию и препятствуют экспонированию фоторезиста.
Процессы нанесения фоторезиста и экспонирования являются наиболее чувствительными к загрязнению. Посторонние частицы между фоторезистом и медью при нанесении фоторезиста понижают адгезию и препятствуют экспонированию фоторезиста.
Обе эти проблемы могут вызвать разрывы при травлении и короткие замыкания при металлизации. Частицы размером 15 мкм и более могут вызвать дефекты, так как они слишком велики, оседают на поверхности и поэтому не удаляются при помощи системы циркуляции воздуха в чистых комнатах.
фоторезист
Портал QRZ. RU существует только за счет рекламы, поэтому мы были бы Вам благодарны если Вы внесете сайт в список исключений. Мы стараемся размещать только релевантную рекламу, которая будет интересна не только рекламодателям, но и нашим читателям. Отключив Adblock, вы поможете не только нам, но и себе.
В чем суть субтрактивной технологии изготовления печатных плат? 3. Что такое фоторезист? 4. Какие типы трафаретов используют в произоводстве.
Изготовление платы по фоторезистивной технологии
Что такое фоторезист? Фоторезист это пленка, покрытая светочувствительным слоем, который при воздействии ультрафиолетового излучения полимеризуется. Полимерный слой стоек к агрессивными средам, таким как хлорное железо, кислоты, всевозможные травильные составы. Благодаря чему, с помощью фоторезиста изготавливают высокоточные печатные платы. В этой статье я хотел поделиться своим опытом нанесения пленочного фоторезиста Ordyl Alpha на печатную плату. В интернете есть множество описаний как это сделать. Сколько я не пытался приклеить фоторезист к плате, без пузырьков не получалось. В результате после проявки фоторезиста получались рваные дорожки, одним словом брак и приходилось все переделывать. Итак, берем текстолит нужного размера.
Полимерный слой стоек к агрессивными средам, таким как хлорное железо, кислоты, всевозможные травильные составы. Благодаря чему, с помощью фоторезиста изготавливают высокоточные печатные платы. В этой статье я хотел поделиться своим опытом нанесения пленочного фоторезиста Ordyl Alpha на печатную плату. В интернете есть множество описаний как это сделать. Сколько я не пытался приклеить фоторезист к плате, без пузырьков не получалось. В результате после проявки фоторезиста получались рваные дорожки, одним словом брак и приходилось все переделывать. Итак, берем текстолит нужного размера.
Выбор фоторезиста для различных технологий производства печатных плат
Изображение, расширенное в пленках фоторезиста в зависимости от толщины. Изображение, расширенное в пленках фоторезиста в зависимости от толщины обусловленное передержкой. Изображение, расширенное в пленках фоторезиста в зависимости от толщины обусловленное расходимостью пучка света. Изображение, расширенное в пленках фоторезиста в зависимости от толщины обусловленное явлением дифракции.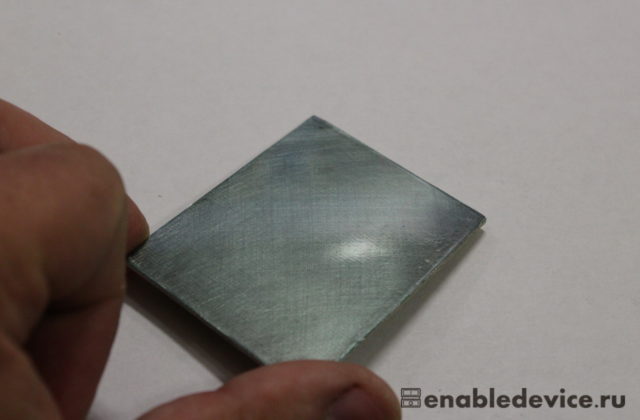
В зависимости от характера изменения структуры и свойств в результате облучения, фоторезисты делят на негативные и позитивные. Если в результате облучения пленка полимеризуется и теряет растворимость, то обработка растворителем проявление ведет к удалению только необлученных участков, и на подложке возникает негативное изображение маски.
Путь от схемы до устройства. Часть 5: фоторезист
Войдите , пожалуйста. Хабр Geektimes Тостер Мой круг Фрилансим. Войти Регистрация. Меня зовут Сергей. Сегодня хочу показать один из способов формирования слоя Сразу скажу, что способ не очень новый, но реализации я не видел. Так же, хочу задать несколько вопросов по нанесению фоторезиста, травлению.
Фоторезист
Новокузнецк, Кемеровская обл. Логин: Пароль Забыли? Фоторезист Positiv и печатные платы. Дневник Гунтиса Кольча Секреты самодельщика. Как и многие другие, я свои первые печатние платы рисовал со спичкой и нитролаком. Дорожки получились не очень красивыми, но это не мешало устроиствам исправно работать.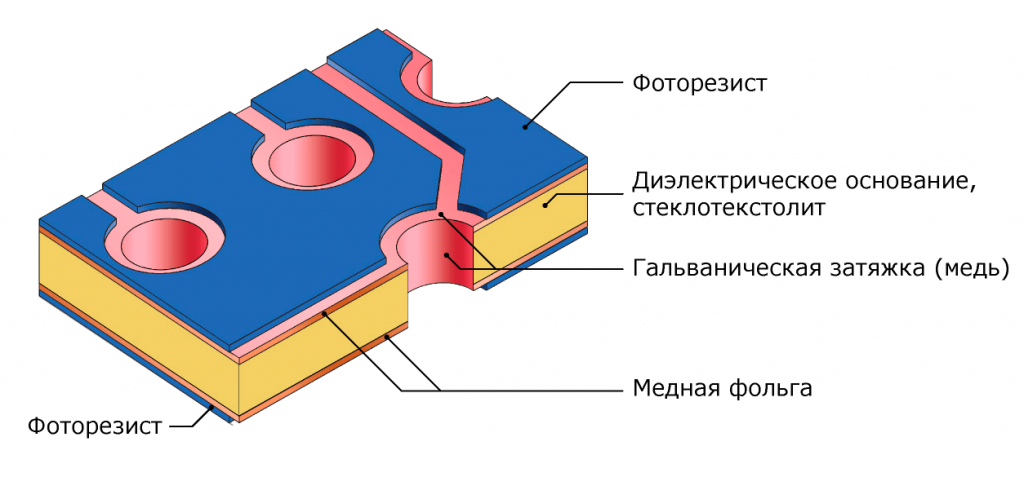 Рисовал и маркером.
Рисовал и маркером.
Сегодня мы будем говорить о такой технологии, как изготовление печатных плат в домашних условиях с использованием пленочного фоторезиста.
Пленочный фоторезист. Изготовление печатных плат в домашних условиях.
Под термином фоторезист понимается светочувствительная полимерная пленка, которая под воздействием света меняет свои физико-химические свойства и обладает устойчивостью к химическому или механическому воздействию. Развитие современной электроники, средств связи, спутников, телевидения, компьютеров невозможно представить без применения фоторезистов. Фоторезист — один из ключевых материалов микро- и радиоэлектроники. Необходимо различать позитивные и негативные фоторезисты.
Справочник химика 21
ВИДЕО ПО ТЕМЕ: Печатная плата с помощью пленочного фоторезиста. Фоторезист просрочен на 1,5 года.
Напомню, что ранее в этом блоге рассказывалось об изготовлении печатных плат при помощи ЛУТ. Это хороший метод, но со своими ограничениями. Например, если немного передержать утюг, тонер потечет и близко расположенные дорожки склеятся. То есть, если вы решили использовать SMD-чипы, метод становится практически непригодным. Кто-то успешно решает эту проблему, покупая в дополнение к и без того не дешевому и занимающему место лазерному принтеру еще и ламинатор.
Это хороший метод, но со своими ограничениями. Например, если немного передержать утюг, тонер потечет и близко расположенные дорожки склеятся. То есть, если вы решили использовать SMD-чипы, метод становится практически непригодным. Кто-то успешно решает эту проблему, покупая в дополнение к и без того не дешевому и занимающему место лазерному принтеру еще и ламинатор.
By Данила Бодров , March 24, in Мастерская радиолюбителя. Я много слышал про фоторезист, но не понимаю- зачем он нужен и что это такое!
Позитивный фоторезист ФП-2550
Я ничего не имею против ЛУТ, но она меня более не устраивает по качеству и повторяемости результата. Для сравнения на фото ниже приведен результат, полученный при применении ЛУТ слева и с помощью плёночного фоторезиста справа. Толщина дорожек 0,5 мм. При применении ЛУТ край дорожки получается рваным, а на поверхности могут быть раковины. Это обусловлено пористой структурой тонера, вследствие чего травящий раствор все же проникает к закрытым тонером зонам.
Нанесение пленочного фоторезиста на печатную плату
Фоторезист от фото и англ. Наносится на обрабатываемый материал в процессе фотолитографии или фотогравировки с целью получить соответствующее фотошаблону расположение окон для доступа травящих или иных веществ к поверхности обрабатываемого материала. В позитивных фоторезистах, проэкспонированные области становятся растворимыми и после проявления разрушаются. Такие фоторезисты, как правило, позволяют получать более высокие разрешения нежели негативные [1] [2] [3] , но стоят дороже [4].
ХиМиК.ru — ФОТОРЕЗИСТЫ — Химическая энциклопедия
А Б В Г Д Е Ж З И К Л М Н О П Р С Т У Ф Х Ц Ч Ш Щ Э Ю Я
ФОТОРЕЗИСТЫ, светочувствит.
материалы, применяемые в фотолитографии для формирования рельефного покрытия
заданной конфигурации и защиты нижележащей пов-сти от воздействия травителей.
Фоторезисты обычно представляют
собой композиции из светочувствит. орг. в-в, пленкообразователей (феноло-формальдегидные
и др. смолы), орг. р-рителей и спец. добавок. Характеризуют фоторезисты светочувствительностью,
контрастностью, разрешающей способностью и теплостойкостью (см. Репрография,
Фотографические материалы). Область спектральной чувствительности фоторезистов определяется
наличием в светочувствит. орг. в-вах хромофорных групп способных к фотохим.
превращениям, и областью
пропускания пленкообразователя.
По спектральной чувствительности
различают фоторезисты для видимой области спектра, ближнего (
320-450 нм) и дальнего (180-320
нм) УФ излучения, по характеру взаимод. с излучением делят на позитивные и негативные.
Фоторезисты могут быть жидкими, сухими и пленочными. Жидкие фоторезисты содержат 60-90% по массе
орг. р-рителя, пленочные — менее 20%, сухие обычно состоят только из светочувствит. в-ва. Жидкие фоторезисты наносят на подложку (см. Планарная технология)центрифугированием,
напылением или накаткой валиком, сухие -напылением и возгонкой, пленочные —
накаткой. Последние имеют вид пленки, защищенной с двух сторон тонким слоем
светопроницаемого полимера, напр. полиэтилена. В зависимости от метода нанесения
формируют слои толщиной 0,1-10 нм; наиб. тонкие слои (0,3-3,0 мкм) формируют
из жидких фоторезистов методом центрифугирования или из сухих фоторезистов методом возгонки.
в-ва. Жидкие фоторезисты наносят на подложку (см. Планарная технология)центрифугированием,
напылением или накаткой валиком, сухие -напылением и возгонкой, пленочные —
накаткой. Последние имеют вид пленки, защищенной с двух сторон тонким слоем
светопроницаемого полимера, напр. полиэтилена. В зависимости от метода нанесения
формируют слои толщиной 0,1-10 нм; наиб. тонкие слои (0,3-3,0 мкм) формируют
из жидких фоторезистов методом центрифугирования или из сухих фоторезистов методом возгонки.
При экспонировании в слое
фоторезиста образуется скрытое изображение. При этом светочувствит. компонент претерпевает
ряд фотохим. превращений, напр. подвергается фотополимеризации или структурированию
либо разлагается с выделением газообразных продуктов; в зависимости от этого
светочувствит. в-во закрепляется (сшивается) на экспониров. участках и не удаляется
при дальнейшем проявлении (визуализации) под действием орг. или водно-щелочных
р-рителей или плазмы (негативные фоторезисты) либо переходит в растворимое состояние
и легко удаляется с экспониров. участков при проявлении (позитивные фоторезисты).
или водно-щелочных
р-рителей или плазмы (негативные фоторезисты) либо переходит в растворимое состояние
и легко удаляется с экспониров. участков при проявлении (позитивные фоторезисты).
Из позитивных фоторезистов наиб.
распространены композиции, содержащие в качестве светочувствит. компонента сульфо-эфиры
о-нафгохинондиазида (5-40% по массе), а в качестве пленкообразователя
— новолачные смолы (до 50%). При экспонировании сульфоэфир переходит в сульфопроизводное
инденкарбоновой к-ты (ф-ла I) и при проявлении под действием водно-щелочного
р-рителя удаляется с экспониров. участков пов-сти вместе со смолой:
Среди негативных фоторезистов
наиб. распространены композиции на основе циклоолефиновых каучуков с диазидами
в качестве сшивающих агентов, а также сенсибилизированные поливиниловый спирт,
поливинилциннамат и др. Схема превращения негативного фоторезиста на основе каучука и
диазида представлена р-цией:
Сшитый полимер закрепляется
на подложке, а рельефное изображение (маска) образуется в результате вымывания
фоторезиста с неэкспониров. участков.
участков.
Для дальнего УФ излучения
применяют позитивные фоторезисты на основе сенсибилизиров. полиметакрилатов и арилсульфоэфи-ров
с фенольными смолами, а также негативные фоторезисты на основе композиций галогенированных
полистиролов и диазидов с феноло-формальдегидными и др. смолами. Перспективны
фоторезисты, работающие на принципе хим. усиления скрытого изображения; такие фоторезисты в качестве
светочувствит. компонента содержат ониевые соли (напр., Ph3S+X—
и Ph2I+X—, где X = AsF6, SbF6,
PF6, CF3SO3), катализирующие темновые р-ции
др. компонентов фоторезистов (напр., эфиров нафтолов, резольных смол).
Позитивные фоторезисты чувствительны
к экспозиции 10-250 мДж/см2, имеют разрешающую способность 0,1-2,0
мкм, контрастность 1,5-5, теплостойкость 120-140 0C; негативные фоторезисты,
как правило, более чувствительны, но имеют худшую разрешающую способность.
Для получения защитных
покрытий заданной конфигурации помимо фоторезистов используют материалы, чувствительные
к воздействию пучка электронов с энергией 5-50 кэВ (электронорезисты), рентгеновского
излучения с0,2-0,5
нм (рентгенорезисты) или ионов легких элементов (напр., H+, Не+,
O+, Ar+) с энергией более 50 кэВ (ионорезисты). В качестве
наиб. Вaжныx позитивных электроно-, рентгено- и ионорезистов применяют
композиции на основе производных полиметакрилатов (напр., галоген-, циано- и
амидозамещенных), поли-алкиленкетонов и полиолефинсульфонов, в качестве негативных
— гомо- и сополимеры производных метакрилата, бутадиена, изопрена, стирола,
кремнийорг. соед. и др.
Лит.: Валиев К.А.,
Раков А.А., Физические основы субмикронной литографии в микроэлектронике, M.,
1984; Светочувствительные полимерные материалы, под ред. А.В. Ельцова, Л., 1985. Г.К. Селиванов.
Г.К. Селиванов.
А Б В Г Д Е Ж З И К Л М Н О П Р С Т У Ф Х Ц Ч Ш Щ Э Ю Я
Фоторезисты для плазмохимического травления
В современном производстве изделий микроэлектроники активно используются процессы плазмохимического травления (ПХТ). Многие наши клиенты при освоении производства новых изделий сталкиваются с проблемой выбора фоторезистов для данной задачи, потому что в процессе травления фоторезист подвергается существенному воздействию плазмы. Универсальные фоторезисты, широко используемые в микроэлектронике на протяжении последних десятилетий, не всегда могут обеспечить приемлемое качество процесса для новых задач.
Особенно ощутимо влияние плазмы, когда необходимо провести травление на большую глубину. Такая задача стоит, прежде всего, перед изготовителями МЭМС, устройств микрофлюидики, интерпойзеров для 2,5D-интеграции, а также перед производителями микросхем со сквозными электрическими выводами через подложку — как кремниевых, так и арсенид галлиевых.
При разработке технологических операций для глубокого ПХТ вышеперечисленных изделий необходимо особенно тщательно подойти к вопросу выбора маски. Часто невозможно или нетехнологично использовать неорганическую маску (англ.: hard mask), и в этом случае возникает вопрос: каким образом подобрать соответствующую резистивную маску (англ.: soft mask). Этот выбор зависит от топологии, глубины травления, условий технологического процесса, особенностей оборудования и свойств самого материала.
Воздействия плазмы на подложку
Во время травления фоторезист (ФР) подвергается воздействию ряда факторов, основные из которых приведены ниже и проиллюстрированы на рис 1:
- химические реакции;
- физическое распыление;
- УФ-излучение;
- температура.
Все эти факторы действуют одновременно. Чтобы понять, какие воздействия они осуществляют и как их минимизировать, рассмотрим каждый фактор отдельно.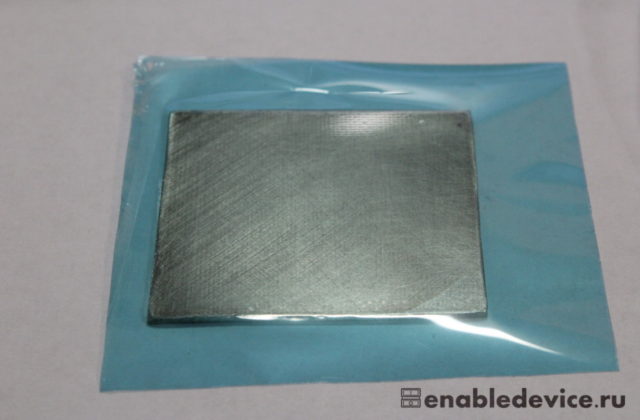
Химические реакции и физическое распыление
Фоторезист состоит из органических соединений, подверженных химическим реакциям с газами, в плазме которых происходит ПХТ. Кроме того, происходит физическое распыление фоторезиста высокоэнергетичными ионами и атомами плазмы1. Именно эти два фактора влияют на скорость травления.
Скорость травления в каждом процессе зависит от его параметров. Поэтому часто невозможно сравнивать результаты, полученные у разных исследователей при определении скорости травления тех или иных фоторезистов. Можно лишь с высокой степенью достоверности утверждать, что при прочих равных условиях скорости травления всех без исключения фоторезистов сравнимы для плазмы какого-то одного конкретного газа. В разное время предпринимались попытки увеличить устойчивость резистивной плёнки к плазме. Эмпирически было установлено, что скорость травления зависит от удельной массы атомов углерода в материале2.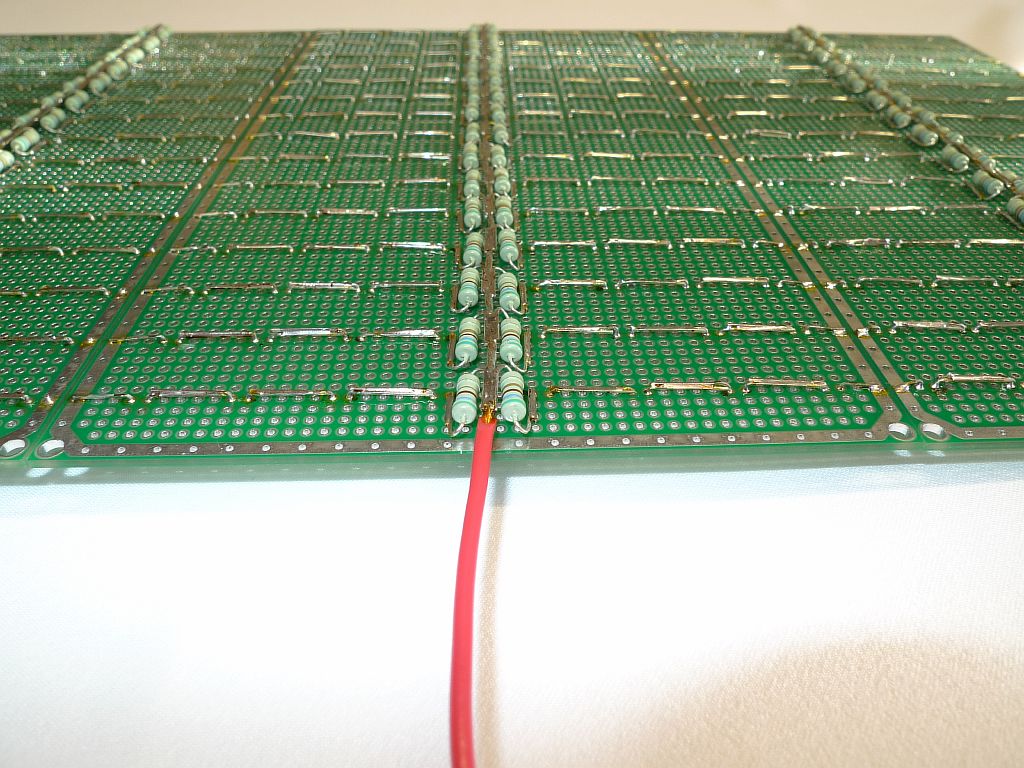 Чем больше углерода в составе полимера, тем ниже скорость его травления. Количество углерода слабо меняется при внесении каких-либо добавок к новолачной, акриловой или феноловой смолам, на основе которых производятся фоторезисты, поэтому для обычных фоторезистов не следует ожидать очень существенного различия в скорости травления при прочих разных условиях. Существенно увеличивает селективность добавление фуллеренов в состав фоторезиста, но такие материалы в настоящий момент всё ещё являются экзотическими и недоступны для регулярных поставок.
Чем больше углерода в составе полимера, тем ниже скорость его травления. Количество углерода слабо меняется при внесении каких-либо добавок к новолачной, акриловой или феноловой смолам, на основе которых производятся фоторезисты, поэтому для обычных фоторезистов не следует ожидать очень существенного различия в скорости травления при прочих разных условиях. Существенно увеличивает селективность добавление фуллеренов в состав фоторезиста, но такие материалы в настоящий момент всё ещё являются экзотическими и недоступны для регулярных поставок.
В качестве примера в Таблице 1 приведены скорости травления во фтор- и кислородсодержащих плазмах для позитивного фоторезиста Microposit S1822 и ряда других материалов, применяемых в микроэлектронике. Microposit S1822 является классическим позитивным фоторезистом, он изготовлен на основе нафтохинондиазида (НХД) и новолачных смол, прочие позитивные фоторезисты с той же химией в основе будут демонстрировать подобное поведение при травлении. Из таблицы видно, что скорость травления ФР значительно ниже скорости травления Si, значительно выше скорости травления Al и SiO2, а также сравнима со скоростью травления Si3N4. Это означает, что фоторезист наряду с SiO2 или Al может быть успешно применён в качестве маски для травления кремния.
Из таблицы видно, что скорость травления ФР значительно ниже скорости травления Si, значительно выше скорости травления Al и SiO2, а также сравнима со скоростью травления Si3N4. Это означает, что фоторезист наряду с SiO2 или Al может быть успешно применён в качестве маски для травления кремния.
Таблица 1 Сравнительные скорости травления (нм/мин) для фоторезиста Microposit S1822 и других распространённых технологических слоёв4
|
Скорость травления, нм/мин |
|||||
|
Процесс |
S1813 |
SiO2 |
Si3N4 |
Al |
Si |
|
Глубокое травление кремния ВЧ (высокая частота) |
30 |
1500 |
|||
|
Глубокое травление кремния НЧ (низкая частота) |
35 |
2400 |
|||
|
SF6, 100 Вт, 13,56 МГц, 20 мТорр |
120 |
||||
|
SF6+O2, 100 Вт, 13,56 МГц, 20 мТорр |
180 |
30 |
150 |
<2,8 |
1500 |
|
CF4, 100 Вт, 13,56 МГц, 60 мТорр |
42 |
34 |
|||
|
CF4+O2, 100 Вт, 13,56 МГц, 60 мТорр |
130 |
21 |
120 |
0,87 |
95 |
|
O2, 400 Вт, 30 кГц, 300 мТорр |
300 |
||||
В Таблице 2 приведены скорости травления для фоторезистов компании Allresist, которые указаны в описаниях на их продукты. Таблица показывает, что скорости травления всех резистов, как позитивных, так и негативных, примерно одинаковы в плазме O2, CF4 и их смеси. Скорость травления фоторезистов в плазмах хлор- и бромсодержащих газов приблизительно сравнима с таковой для фторсодержащих газов3.
Таблица показывает, что скорости травления всех резистов, как позитивных, так и негативных, примерно одинаковы в плазме O2, CF4 и их смеси. Скорость травления фоторезистов в плазмах хлор- и бромсодержащих газов приблизительно сравнима с таковой для фторсодержащих газов3.
Таблица 2 Сравнительные скорости травления фоторезистов компании Allresist. Параметры процесса: индуктивно связанная плазма 13,56 МГц, смещение 240-250 В, давление 5 Па5
|
Серия фоторезистов |
O2 |
CF4 |
80 CF4+ 16 O2 |
Комментарий |
|
AR-P 1200 |
169 |
38 |
90 |
Универсальный позитивный резист для нанесения спреем |
|
AR-P 3100 |
165 |
38 |
89 |
Позитивный резист для производства фотошаблонов |
|
AR-P 3200 |
170 |
39 |
90 |
Универсальный позитивный резист с большой толщиной плёнки |
|
AR-P 3500 |
165 |
37 |
88 |
Универсальный позитивный резист |
|
AR-P 5300 |
161 |
39 |
90 |
Позитивный резист для взрывной фотолитографии |
|
AR-P 5910 |
161 |
38 |
89 |
Позитивный резист для жидкостного травления с HF |
|
AR-N 1200 |
173 |
33 |
93 |
Универсальный негативный резист для нанесения спреем |
|
AR-N 4200 |
170 |
39 |
91 |
Универсальный негативный резист с высоким разрешением |
|
AR-N 4300 |
173 |
33 |
93 |
Универсальный негативный резист |
|
AR-N 4240 |
170 |
39 |
91 |
Универсальный негативный резист |
|
AR-N 4400 |
122 |
31 |
81 |
Толстоплёночный негативный резист, аналог SU-8 |
Таким образом, на данный момент не существует коммерчески доступного фоторезиста, который не травился бы в плазме. Поэтому при разработке технологических процессов нужно обязательно учитывать уменьшение толщины плёнки фоторезиста во время процесса.
Поэтому при разработке технологических процессов нужно обязательно учитывать уменьшение толщины плёнки фоторезиста во время процесса.
Ультрафиолет
Ультрафиолетовое излучение возникает в процессе перехода электронов в атомах и ионах плазмы между энергетическими уровнями. В плазме разных газов интенсивность и спектр УФ-излучения будут различны. Интенсивность также зависит от таких параметров, как давление внутри камеры установки и мощность электромагнитного излучения, возбуждающего плазму. В спектре УФ-излучения могут быть пики, соответствующие длинам волн, на которых происходят фотохимические реакции в резисте, а также пики в области глубокого ультрафиолета (<250 нм).
При воздействии излучения определённых длин волн фоторезист будет подвергаться неконтролируемому экспонированию. В фоторезистах на основе НХД при фотохимичсеких реакциях происходит выделение молекулярного азота. При высокой интенсивности такого излучения и при большой толщине плёнки ФР (>3 мкм) выделение азота может быть настолько интенсивным, что будут образовываться пузыри.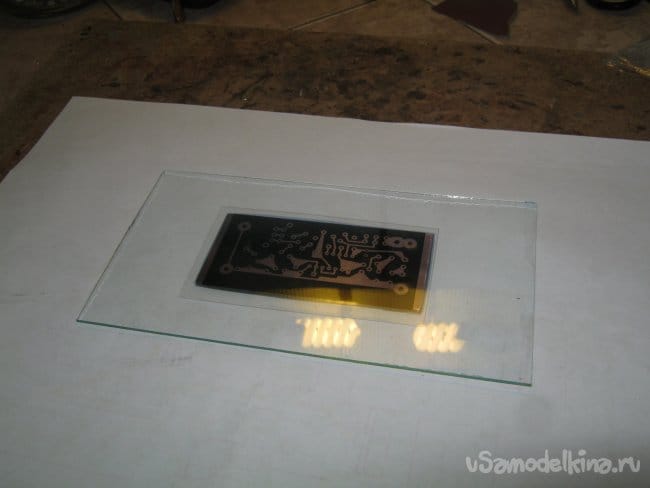 Характерный пример вызываемого этим явлением дефекта приведён на рис 2. Пластины с таким дефектом являются непригодными для дальнейшего использования ввиду невозможности точного повторного совмещения при литографии и повреждения поверхности на тех участках, где пузыри вскрылись.
Характерный пример вызываемого этим явлением дефекта приведён на рис 2. Пластины с таким дефектом являются непригодными для дальнейшего использования ввиду невозможности точного повторного совмещения при литографии и повреждения поверхности на тех участках, где пузыри вскрылись.
При воздействии коротковолнового УФ-излучения также происходит сшивка органических молекул внутри ФР. Это явление может усложнить процесс снятия ФР в жидкостных процессах.
С генерацией азота под воздействием УФ можно бороться различными способами, о которых будет сказано ниже. Но сшивку под действием ультрафиолета предотвратить нельзя, это фундаментальное свойство всех доступных к настоящему времени фоторезистов.
Температура
Температурное воздействие возникает вследствие нагрева от высокоэнергетических ионов и атомов плазмы. Температура фоторезиста в процессе травления может достигать 120-150 °C, что выше характерной температуры оплавления большинства коммерчески доступных фоторезистов (100-110 °C). С одной стороны, нагрев ведет к оплавлению маски (рис 3), что приводит к изменению размеров. С другой стороны, температура является дополнительным фактором, способствующим задубливанию ФР при травлении (сшивке), что усложнит его снятие в смеси органических растворителей.
С одной стороны, нагрев ведет к оплавлению маски (рис 3), что приводит к изменению размеров. С другой стороны, температура является дополнительным фактором, способствующим задубливанию ФР при травлении (сшивке), что усложнит его снятие в смеси органических растворителей.
Абсолютно все фоторезисты оплавляются при увеличении температуры. Ниже будут рассмотрены способы уменьшения влияния этого эффекта. Сшивка при повышенной температуре также неизбежна со всеми вытекающими проблемами при снятии фоторезиста в жидкостных процессах.
Выбор фоторезиста для плазмохимического травления
Все приведённые факторы оказывают влияние на маску из любого фоторезиста в процессе травления. Их влияние тем сильнее, чем длительней процесс ПХТ. Если глубина травления невелика, т.е. сравнима или меньше, чем толщина фоторезистивной маски, то время процесса в большинстве случаев будет небольшим, т.е. воздействие плазмы на ФР будет минимальным. В таких случаях для процесса подойдут практически любые коммерчески доступные фоторезисты на основе нафтохинондиазида. Для этих процессов стоит выбирать особый тип резиста только в том случае, если требуется высокая стабильность маски при нагреве (отсутствие оплавления). Такая необходимость возникает, если отвод тепла от подложки в реакторе ПХТ недостаточен.
Для этих процессов стоит выбирать особый тип резиста только в том случае, если требуется высокая стабильность маски при нагреве (отсутствие оплавления). Такая необходимость возникает, если отвод тепла от подложки в реакторе ПХТ недостаточен.
Выбор резиста сложнее, когда необходимо обеспечить травление на глубину, намного превосходящую толщину фоторезистивной маски. Учитывая ранее упомянутый тезис о том, что химическая устойчивость всех распространённых фоторезистов примерно одинакова, только выбор достаточно толстой маски способен обеспечить травление на значительную глубину. Например, маска толщиной 10 мкм обеспечивает травление кремния в Bosh-процессе на глубину до 150 мкм (рис 4). Выбирая толстые фоторезисты, необходимо знать особенности работы с ними, а также методы минимизации негативных воздействий плазмы на резисты с такой толщиной плёнки.
Для борьбы с выделением азота в толстых плёнках фоторезистов на основе НХД перед обработкой пластин в установке ПХТ можно проводить засветку фоторезиста без маски на установке контактной литографии, чтобы уменьшить концентрацию выделяющего азот фоточувствительного соединения. Можно и вовсе отказаться от использования резистов на основе НХД. Альтернативой им являются новые химически усиленные позитивные резисты. Примеры таких материалов — AZ 12xT (толщина плёнки 3-22 мкм) и AZ 40xT (толщина плёнки 18-65 мкм) либо фотополимерные негативные резисты семейства AZ nXT. У химически усиленных резистов для i-линии механизм распада фотоингибитора травления отличен от такового в случае НХД и не связан с выделением азота. Принцип действия негативных фотополимерных резистов также не связан с выделением никаких побочных газообразных продуктов, в этих материалах под действием ультрафиолета происходит сшивка молекул, образуется нерастворимый в проявителе полимер.
Можно и вовсе отказаться от использования резистов на основе НХД. Альтернативой им являются новые химически усиленные позитивные резисты. Примеры таких материалов — AZ 12xT (толщина плёнки 3-22 мкм) и AZ 40xT (толщина плёнки 18-65 мкм) либо фотополимерные негативные резисты семейства AZ nXT. У химически усиленных резистов для i-линии механизм распада фотоингибитора травления отличен от такового в случае НХД и не связан с выделением азота. Принцип действия негативных фотополимерных резистов также не связан с выделением никаких побочных газообразных продуктов, в этих материалах под действием ультрафиолета происходит сшивка молекул, образуется нерастворимый в проявителе полимер.
Если требуется обеспечить вертикальный профиль и минимальное изменение латеральных размеров при травлении, необходимо выбирать резист с максимальной устойчивостью к оплавлению. На рис 5 показаны примеры профиля термостабильных фоторезистов при оплавлении. По сравнению с обычным фоторезистом без специальных добавок для улучшения термостабильности (рис 3) оплавление происходит при более высоких температурах.
Увеличению устойчивости профиля ФР также способствует стабилизация в глубоком ультрафиолете (ГУФ). Пример поведения ФР после ГУФ-стабилизации приведён на рис 6. При облучении жёстким ультрафиолетом (длины волн <250 нм) происходит дополнительная сшивка полимеров поверхностного слоя, который препятствует сильной деформации плёнки при повышенной температуре. Такой слой делает сложным или невозможным снятие резиста в обычных растворителях (ацетон, NMP). Это, а также дополнительная сшивка полимеров фоторезиста из-за воздействия паразитного УФ и температуры, заставляют искать альтернативы стандартным снимателям. Один из вариантов — снятие в плазме кислорода с дополнительной отмывкой после процесса. Также существуют сниматели на основе более эффективных растворителей, например TechiStrip P1316.
Термическое воздействие при плазмохимическом травлении может вызвать такой нежелательный эффект как вскипание остаточного растворителя. В этом случае нужно увеличить время сушки фоторезиста для гарантированного удаления растворителя, но температура такой сушки не должна превышать температуру оплавления фоторезиста. Удлинённая сушка после проявления также способствует снижению риска интенсивного выделения остатков растворителя и воды.
Удлинённая сушка после проявления также способствует снижению риска интенсивного выделения остатков растворителя и воды.
Термические воздействия при глубоком травлении часто учтены производителями оборудования для этого процесса. Столик, на который помещается пластина внутри реактора, часто делают массивным, чтобы обеспечить возможности для отвода большого количества тепла. Существуют решения, при которых столик дополнительно охлаждается жидкостью или газом, либо сама подложка охлаждается потоком инертного газа с обратной стороны.
Таким образом, для глубокого плазмохимического травления необходимо выбирать резист, обладающий следующими свойствами:
- большая толщина плёнки;
- малое выделение газов при экспонировании или отсутствие такого явления;
- высокая температурная стойкость.
Заключение
В тех случаях, когда плазмохимическое травление по неорганической маске становится невозможным или нетехнологичным, единственным вариантом проведения этого процесса является использование фоторезистивной маски.
Фоторезист в процессе плазмохимического травления подвергается довольно агрессивным физико-химическим воздействиям. Поэтому нужно выбирать резист, который способен образовывать толстую плёнку при нанесении (желательно за один цикл), который (в идеале) не выделяет никаких газов при воздействии УФ-излучения плазмы и который сохраняет свой профиль при росте температуры максимально долго. При разработке технологического маршрута нужно также учитывать, что в ряде случаев могут возникнуть сложности с его снятием в жидкостных процессах, что потребует добавления новых реагентов в дополнение к стандартно используемой химии. При выборе оборудования для глубокого плазмохимического травления желательно выбирать модели, обеспечивающие максимальные возможности по снижению термического воздействия плазмы на ФР.
ООО «Остек-Интегра» сотрудничает с производителями фоторезистов для самых передовых технологических процессов. При необходимости специалисты компании могут оказать технологическую поддержку при выборе наилучшего фоторезиста для глубокого плазмохимического травления, помочь с применением нового материала, привлекая его производителей.
1 Handbook of Semiconductor Manufacturing Technology
2 M. Goosey, Plastics for electronics
3 K. Booker et al., Deep, vertical etching for GaAs using inductively coupled plasma/reactive ion etching, Journal of Vacuum Science & Technology B 38, 012206 (2020)
4 WILLIAMS et al., ETCH RATES FOR MICROMACHINING PROCESSING—PART II, JOURNAL OF MICROELECTROMECHANICAL SYSTEMS, VOL. 12, NO. 6, 2003
5 https://www.allresist.com/product-overview/products-photoresists/
6 N.W. Bartlett, R.J. Wood, Comparative analysis of fabrication methods for achieving rounded microchannels in PDMS, Journal of Micromechanics and Microengineering, 26 (2016) 115013 (10pp)
Автоматическая система фотолитографии — SUSS ACS300 Gen2
SUSS ACS300 Gen2 — установка нанесения и проявления фоторезиста от пилотных экземпляров до крупносерийного производства. Мощное решение для обработки пластин диаметром 300 мм.
Мощное решение для обработки пластин диаметром 300 мм.
Содержание:
Обработка толстопленочного фоторезиста
LITHOPACK300
Система предлагает превосходные характеристики в нанесении фоторезиста, спекании и проявлении пластин при работе с тонко- и толстопленочным фоторезистом или фоточувствительными полимерами, например полиимидом или циклотеном Cyclotene™ (BCB).
Благодаря лучшей среди моделей данного класса способности нанесения резиста, равномерности проявления и исключительным характеристикам по удалению резиста с края пластины установка ACS300 Gen2 является эффективным и экономичным решением для рынка интегральных микросхем.
Системы серии ACS300 от компании SUSS MicroTec установлены на многих производствах научно-исследовательских институтах по всему миру. ACS300 Gen2 представляет собой гибкую модульную систему с модернизируемыми на месте модулями, которая позволяет планировать рабочий процесс от стадии разработки и пилотного запуска до крупносерийного производства. Ее можно объединить с установкой совмещения SUSS MA300 Gen2 1X Full Field Proximity Mask Aligner, чтобы создать интегрированный кластер LithoPack300.
Ее можно объединить с установкой совмещения SUSS MA300 Gen2 1X Full Field Proximity Mask Aligner, чтобы создать интегрированный кластер LithoPack300.
ACS300 Gen2 является гибким, экономичным и эффективным решением в области нанесения резиста от компании SUSS MicroTec, которое отвечает различным производственным потребностям и может быть дополнено устройствами различных поколений.
Особая система для рынка интегральных микросхем
Установка ACS300 Gen2 предназначена для использования в области интегральных микросхем и служит для формирования столбиковых выводов из припоя, из золота, а также для перераспределения слоев (RDL) с передней стороны, которое используется при формировании корпусов, сравнимых с размерами кристалла, или для перераспределения слоев задней стороны для 3D-интеграции. Технология GYRSET позволяет получить толщину нанесения в диапазоне от менее 1 мкм до более 100 мкм:
Результаты покрытия ACS300 Gen2:
|
|
|
|
|
AZ1505 позитивный фоторезист Тестовый диам: 290 мм |
JSR WPR Фоточувствительный диэлектрик Тестовый диам.: 296 мм |
AZ10XT Позитивный фоторезист Тестовый диам.: 288 мм |
|
|
|
|
|
HD-4000
Полиимид Тестовый диам.: 284 ммСреднее: 17.1 мкм Стд. откл.: 0.31 % Выс/низ. колебания: 0.78 % |
TOK Pmer P/CA1000PM позитивный фоторезист, химически усиленный Тестовый диам. |
AZ40XT позитивный фоторезист Тестовый диам.: 290 мм |
|
|
|
|
JSR THB 151-N
негативный фоторезист Тестовый диам.: 295 mmСреднее: 72.0 µm Стд. откл.: 1.31 % Выс/низ. колебания: 3.95 % |
JSR THB 151-N негативный фоторезист, двойное покрытие Тестовый диам.: 294 мм |
Эксперт в области обработки толстопленочного фоторезиста
Сложности обработки фоторезиста в области формирования столбиковых выводов на полупроводниковой пластине, упаковки на уровне пластины и 3D-интеграции требуют тщательного подбора модулей нанесения, задубливания и проявления для достижения оптимальных результатов обработки. Система ACS300 Gen2 предназначена для создания слоя фоторезиста различной толщины в диапазоне от менее одного до более ста микрон. Для работы с толстопленочным фоторезистом требуется конфигурация модуля нанесения, которая позволит справиться с высокой вязкостью материала и получить исключительно однородные пленки.
Система ACS300 Gen2 предназначена для создания слоя фоторезиста различной толщины в диапазоне от менее одного до более ста микрон. Для работы с толстопленочным фоторезистом требуется конфигурация модуля нанесения, которая позволит справиться с высокой вязкостью материала и получить исключительно однородные пленки.
Нанесение толстопленочного фоторезиста.
Установка ACS300 Gen2 является экспертом в обработке ультра-толстопленочного фоторезиста, которая зачастую включает в себя центрифугирование материала со скоростью ниже оптимального динамического диапазона. ACS300 Gen2 обеспечивает контроль загрязнения и предлагает опции автоматизированной очистки, что особенно важно при обработке материала с высокой вязкостью. Сочетание точности удаления наплава фоторезиста с края материала и оптимизированная конструкция держателя/чаши гарантирует лучшие результаты среди моделей данного класса.
Задубливание толстопленочного фоторезиста
Для обеспечения превосходных характеристик задубливания ультра-толстопленочных фоторезистов ACS300 Gen2 предлагает полностью программируемые циклы задубливание с зазором, что позволяет оптимизировать соотношение времени и температуры задубливания. Симметричная конфигурация вытяжки и продувки гарантируют равномерное удаление растворителя по всей площади пластины в процессе задубливания. При использовании таких циклов равномерно распределенное содержание растворителя в слое фоторезиста готовит подложку к последующему экспонированию и проявлению.
Симметричная конфигурация вытяжки и продувки гарантируют равномерное удаление растворителя по всей площади пластины в процессе задубливания. При использовании таких циклов равномерно распределенное содержание растворителя в слое фоторезиста готовит подложку к последующему экспонированию и проявлению.
Проявление толстопленочного фоторезиста
SUSS MicroTec использует в своих системах элементы, которые позволяют добиться исключительно равномерного проявления фоторезиста с минимальным расходом материалов за малое время. Химические вещества проявителя нагреваются управляемым способом и наносятся на пластину с помощью распыляющих сопел различной конфигурации. Рисунок распыления управляется поворотами руки, которые настраиваются пользователем. Для оптимизации воздействия проявляющих материалов и нанесения покрытия на пластину используется настраиваемый в рецепте зазор распыляющих рук. При проявлении тонкопленочных фоторезистов и других полимеров система ACS300 Gen2 демонстрируется исключительную равномерность распределения и стабильность благодаря контролю расхода материала, скорости вращения и температуры в точке использования.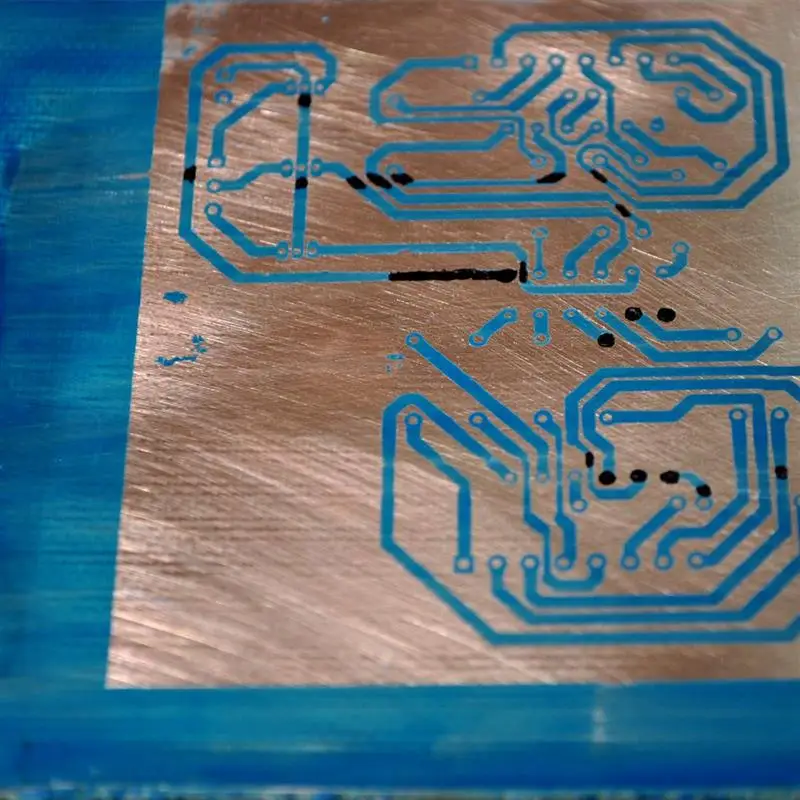
| Формирование столбиковых выводов из припоя | Формирование столбиковых выводов из золота | Распределение слоев | Формирование медных столбиковых выводов |
|---|---|---|---|
|
Нанесение и проявление фоторезиста |
Нанесение и проявление |
Трассировка слоев |
Формирование |
|
Сухое проявление пленки |
диэлектрики |
||
|
Полиимид для репассивации |
Литография для 3D-интеграции |
Технология GYRSET
Процесс нанесения фоторезиста с закрытой крышкой по технологии GYRSET® позволяет создать уникальную не содержащую завихрений среду, насыщенную растворителем, над подложкой в процессе нанесения резиста, что значительно уменьшает воздействие температуры и влажности окружающей среды на результаты обработки.
Технология использует преимущества двух физических эффектов:
Во-первых, поток воздуха над пластиной не образует завихрений, поскольку среда в закрытом пространстве вращается с той же скоростью, что и подложка. Фоторезисты, предназначенные для работы с пластинами диаметром 200 мм, не всегда подходят для пластин 300 мм, поскольку необходимые скорости вращения выше допустимого предела для приграничного потока воздуха. В результате, при центрифугировании с превышением критического предела скорости по краям пластины образуются полосы и неоднородности. При работе с подложками не круглой формы, например квадратными, такое происходит даже на более низких скоростях. Технология GYRSET® позволяет исключить такие завихрения практически полностью.
Во-вторых, насыщенная растворителем среда поддерживает материал на уровне близком к исходной вязкости более продолжительное время. Таким образом, фоторезист также может разравниваться дольше, чем при стандартном нанесении покрытия с открытой чашей. Это позволяет значительно расширить окно процесса. Соответствующий резист можно использовать даже для более тонких слоев, чем изначально предполагалось. Это позволяет уменьшить работу по согласованию резиста и количество типов резистов, находящихся на хранении.
Это позволяет значительно расширить окно процесса. Соответствующий резист можно использовать даже для более тонких слоев, чем изначально предполагалось. Это позволяет уменьшить работу по согласованию резиста и количество типов резистов, находящихся на хранении.
Центрифуга
Технология GYRSET® позволяет наносить однородные покрытия на пластины диаметром 200/300 мм, а также квадратные подложки с минимальным расходом фоторезиста. Возможно использование процессов как с открытой, так и с закрытой крышкой.
Модули нанесения фоторезиста имеют три независимых линии распыления с опционным контролем температуры на каждую руку. Настройки использования растворителя позволяют добиться точности при удалении наплывов резиста на краях пластины и промывке задней стороны. Опция автоматической очистки дает возможность промыть каждое сопло отдельно. Автоматическая очистка камеры обеспечивает простоту обслуживания и увеличивает время непрерывной эксплуатации.
Этажерочный модуль с нагревательной плитой
Этажерочный модуль ACS300 Gen2 HCV можно дополнительно оборудовать 7 кассетами с нагревательными или охлаждающими плитами или вакуумным праймером ГМДС, который занимает в модуле две ячейки. Один этажерочный модуль можно установить непосредственно в ACS300 Gen2, и еще два в дополнительное расширение рамы.
Кассеты оснащены моторизованными подъемными штифтами с настраиваемой высотой подъема и неподвижными ограничителями минимального зазора, что гарантирует оптимальные результаты задубливания. Испарения растворителя выводятся с помощью вытяжки и продувки азотом.
Модуль проявления
Для проявления экспонированных пленок доступен целый ряд опций. Стандартными конфигурациями являются бинарный спрей, веерный спрей и распыление наливом. Возможна настройка движений рук и их высоты для достижения лучшей геометрии распыления.
Для оптимального контроля однородности в каждом рецепте возможна настройка образцов движений рук. Контроль температуры в точке использования гарантирует равномерное воздействие в процессах, чувствительных к температуре.
Контроль температуры в точке использования гарантирует равномерное воздействие в процессах, чувствительных к температуре.
Модуль ввода/вывода (i/o)
Система ACS300 Gen2 предлагает два варианта загрузки/выгрузки. К раме машины можно напрямую подсоединить до двух модулей с загрузочными портами. При использовании отдельного монитора EFEM система ACS300 Gen2 может быть дополнительно оборудована 4 модулями с загрузочными портами, которые имеют встроенную функцию картирования пластины и могут использоваться со стандартными устройствами FOUP или FOSB. Схема «полного моста» обеспечивается с помощью кассетных переходников, что позволяет использовать пластины диаметром 200 мм. Система ACS300 Gen2 предлагает возможность одновременной обработки пластин диаметром 200 и 300 мм без механической замены.
Интеграция технологической схемы
В каждой раме один центральный шестикоординатный робот обслуживает до 4 модулей нанесения. Для расширенных конфигураций возможно дальнейшее увеличение количества роботов. Шестикоординатный робот сочетает максимальную скорость и точность с большим диапазоном действия.
Для расширенных конфигураций возможно дальнейшее увеличение количества роботов. Шестикоординатный робот сочетает максимальную скорость и точность с большим диапазоном действия.
Робот имеет максимальную номинальную нагрузку более 3 кг, что позволяет ему перемещать подложки с большим весом, например сложенные пластины или кассетные решения из стекла, кремния или керамики. Бесконтактное центрирование пластины осуществляется с помощью оптической системой предварительного совмещения, которая использует видеосистему установки для определения положения пластины. Отклонения в совмещении исправляются роботом.
Шкаф с материалами
Шкаф с материалами оснащен отдельными ящиками для обеспечения легкого доступа к резисту и химическим веществам. Танки можно заполнять из центрального трубопровода. Автоматическая смена танка и бутыли обеспечивает непрерывную эксплуатацию. Доступен широкий ряд настроек подачи материалов.
В зависимости от конфигурации системы в специальные отделения системы можно напрямую установить большее количество танков и бутылей с фоторезистом.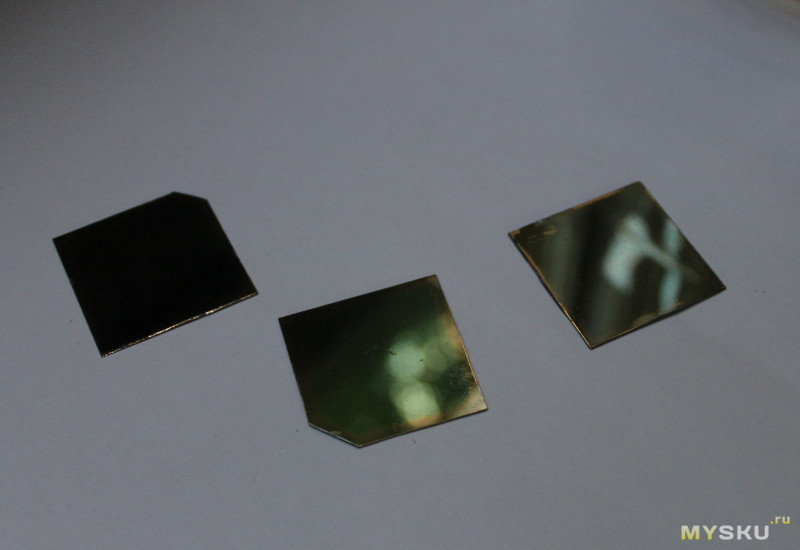 Это гарантирует максимально короткие линии распыления, что особенно важно при работе с вязкими материалами.
Это гарантирует максимально короткие линии распыления, что особенно важно при работе с вязкими материалами.
Технология системы управления
Проверенное в производственных условиях ПО системы ACS300 Gen2 предлагает самую современную технологию из существующих на рынке в данный момент. Установка работает на базе операционной системы Windows 7 в сочетании с ПО мультимодульного контроллера (ММК).
Интерфейс пользователя графически отображает текущий статус всей установки. Для удобства обслуживания каждый модуль имеет отдельный доступ. Управление интуитивное и простое в освоении. Расположение и статус каждой пластины в установке отображается в режиме реального времени. Компоненты контроллера и ПО имеют стандартный дизайн для удобства эксплуатации.
Рецепты процесса и последовательности действий создаются в несколько нажатий. Функция каскадного запуска последовательностей обеспечивает непрерывный поток подложек даже при смене последовательности. Оператор может управлять различными процессами и размерами подложек одновременно. Он может, например, запустить одну кассету пластин в режиме нанесения резиста, а другую – в режиме проявления. Редактирование последовательности и моделирование процесса в режиме онлайн и офлайн возможны даже во время работы.
Оператор может управлять различными процессами и размерами подложек одновременно. Он может, например, запустить одну кассету пластин в режиме нанесения резиста, а другую – в режиме проявления. Редактирование последовательности и моделирование процесса в режиме онлайн и офлайн возможны даже во время работы.
Подробные протоколы и состояния E10 упрощают отслеживание пластин и устройств. Кроме того, доступен главный интерфейс, совместимый со стандартами SECS-II/GEM (SEMI E4/ E5/E30/E37) и 300 мм (SEMI E40/E87/E90/E94 и E116).
LITHOPACK300 — интегрированное решение для нанесения, задубливания, экспонирования и проявления
SUSS LithoPack300 – специальная система для обработки пластин диаметром 200 и 300 мм с помощью модулей нанесения, задубливания, экспонирования и проявления.
Она позволяет производить быструю смену между пластинами 200 и 300 мм и является решением в области литографии для производителей оптоэлектронных ИС и микроэлектронных производств.
Новые поколения системы ACS300 для нанесения/проявления резиста, а также установки совмещения МA300 компании SUSS MicroTec являются беспрецедентными решениями в области литографии.
Модуль mA300 Gen2
Система экспонирования MA300 Gen2 представляет собой установку совмещения с зазором всей поверхности пластины диаметром 300 мм, которая позволяет провести экспонирование за один шаг, что обеспечивает формирование структуры без снижения производительности. Это чрезвычайно важное преимущество установки совмещения перед технологией пошагового экспонирования, особенно если требуется последующая металлизация столбиковых выводов методом электроосаждения.
Установка SUSS MA300 включает в себя специальный набор инструментов совмещения для создания интегральных межсоединений для этажерочной архитектуры чипов или 3D-интеграции.
ACS300 Gen2 представляет собой модульную кластерную систему, которая составляется из рамочных компонентов и технологических модулей в идеальном соответствии вашим требованиям. Расширяемая архитектура системы с технологическими модулями с возможностью модернизации на месте обеспечивает полную гибкость, начиная со стадии разработки и до крупносерийного производства.
Расширяемая архитектура системы с технологическими модулями с возможностью модернизации на месте обеспечивает полную гибкость, начиная со стадии разработки и до крупносерийного производства.
Процессы и использование фотолитографии и нанолитографи Конструирование…
Сразу хочу сказать, что здесь никакой воды про фотолитография, и только нужная информация. Для того чтобы лучше понимать что такое фотолитография, нанолитография , настоятельно рекомендую прочитать все из категории Конструирование и проектирование электронной аппаратуры.
фотолитография — метод получения определенного рисунка на поверхности материала, широко используемый в микроэлектронике и полиграфии. Один из основных и самых дорогостоящих приемовпланарной технологии, используемой в производстве полупроводниковых приборов.
Суть процесса фотолитографии сводится к тому, что на обрабатываемую поверхность наноситсяфоторезист, который экспонируется светом через фотошаблон с заданным рисунком. Далее проэкспонированные участки фоторезиста удаляются в проявителе. Получившийся на фоторезисте рисунок используется для таких технологических этапов планарной технологии, как травление,электроосаждение, вакуумное напыление, пескоструйная обработка и другие. После проведения одного из этих процессов, остатки фоторезиста удаляются снимателем.
Далее проэкспонированные участки фоторезиста удаляются в проявителе. Получившийся на фоторезисте рисунок используется для таких технологических этапов планарной технологии, как травление,электроосаждение, вакуумное напыление, пескоструйная обработка и другие. После проведения одного из этих процессов, остатки фоторезиста удаляются снимателем.
Принципиальное отличие фотолитографии от других видов литографии заключается в том, что экспонирование производится видимым или ультрафиолетовым излучением, тогда как в других видах литографии для этого используется рентгеновское излучение, поток электронов, поток ионов, жесткий ультрафиолет, и другое.
•Таким образом,
нанолитография в современном понимании — это технология переноса рисунка с шаблона на конкретную поверхность (полимерную пластину, полупроводниковую подложку и т.д.) с помощью светового излучения (фотолитография), рентгеновского излучения (рентгенолитография), потока электронов/ионов (электронно-лучевая/ионно-лучевая), а также непосредственно методами сканирующей зондовой микроскопии (с помощью СТМ или АСМ).
•В последнее десятилетие термин “нанолитография” используется в более широком значении как метод формирования на поверхности подложки не только электронных схем, но и наноструктур (или рисунков с нанометровым разрешением) путем переноса их изображения с помощью маски или штампа, или же непосредственным воздействием на поверхность образца (литография с помощью СТМ или АСМ).
В соответствии с последним определением, нанолитография — это создание «правильных» групп атомов и молекул на подложке из обычного вещества.
Нанолитографией в широком смысле слова называют создание любых структур, имеющих размеры порядка нескольких нанометров.
Это шаг к разработке и конструированию первых деталей наномашин, в том числе ассемблера (нанороботов).
Нанолитография (в микроэлектронике)
— способ массового изготовления интегральных микросхем с использованием в литографическом оборудовании источника излучения с длиной волны менее 13,5 нм и проекционной оптической системы на основе отражающих многослойных зеркал.
Технология нанолитографии в микроэлектронике чаще всего включает в себя следующие этапы:
- — нанесение фоточувствительной полимерной пленки (фоторезиста) на кремневую пластину;
- — сушку и последующее облучение (экспонирование) пленочного покрытия пластины с определенным рисунком через соответствующую маску;
- — проявление (травление) экспонированного покрытия в специальном растворе;
- — формирование на подло жке физической структуры элементов электронной схемы.
Нанолитография требует осуществление процесса с бóльшим разрешением.
Количественно разрешение по закону Рэлея определяется соотношением
Δ = kλ / A
где k ≈ 0,6; λ – длина волны используемого излучения;
А – апертура оптики.
Из этого соотношения следует, что улучшать разрешение можно путем уменьшения λ и увеличения А.
Возможности увеличения А ограничены техническими особенностями оптических систем, пригодных для литографии. Реально удается достигать А ≈ 0,8.
Реально удается достигать А ≈ 0,8.
Таким образом, остается один путь – применение источников излучения с меньшей величиной длины волны λ.
В оптическом диапазоне и ултрафиолетовом диапазоне (436 –126 нм ) этого добиться невозможно.
Из приведенных соображений и вытекает, что нанолитография с размером элементов изображения R< 100 нм требует перехода к более жесткому излучению.
Процесс фотолитографии
Очистка и подготовка поверхности
При наличии на пластине загрязнений, пластина может быть отмыта в ходе двухступенчатого процесса: очистка ацетоном, для устранения органических загрязнений и последующее полоскание в изопропаноле для удаления оставшегося ацетона. В случае значительных загрязнений поверхности, ее можно обработать раствором h3SO4и h3O2 с последующим применением процесса RCA очистки. Для очистки поверхности от осажденных из воздуха молекул воды, поверхность нагревают до температуры около 120оС в течении нескольких минут.
Различные поверхности имеют различную адгезию, что необходимо учитывать в процессе нанесения фоторезиста. Например, такие металлы, как алюминий, хром ититан имеют превосходную адгезию, в то время как благородные металлы, такие как золото или платина имеют очень плохую адгезию. В случае плохой адгезии, перед нанесением фоторезиста, сначала наносят подслой (адгезив) усиливающий адгезию, например гексаметилдисилазан (ГМДС). Кроме этого, иногда предварительно, а иногда и поверх фоторезиста, наносят антиотражающие покрытия.
Нанесение фоторезиста
Установки центрифугирования для нанесения фоторезиста
Фоторезист
Наиболее широко распространенный метод нанесения фоторезистов на поверхность — это центрифугирование. Этот метод позволяет создавать однородную пленку фоторезиста и контролировать ее толщину скоростью вращения пластины (порядка нескольких тысяч оборотов в минуту). Как правило используется при работе с большими круглыми пластинами.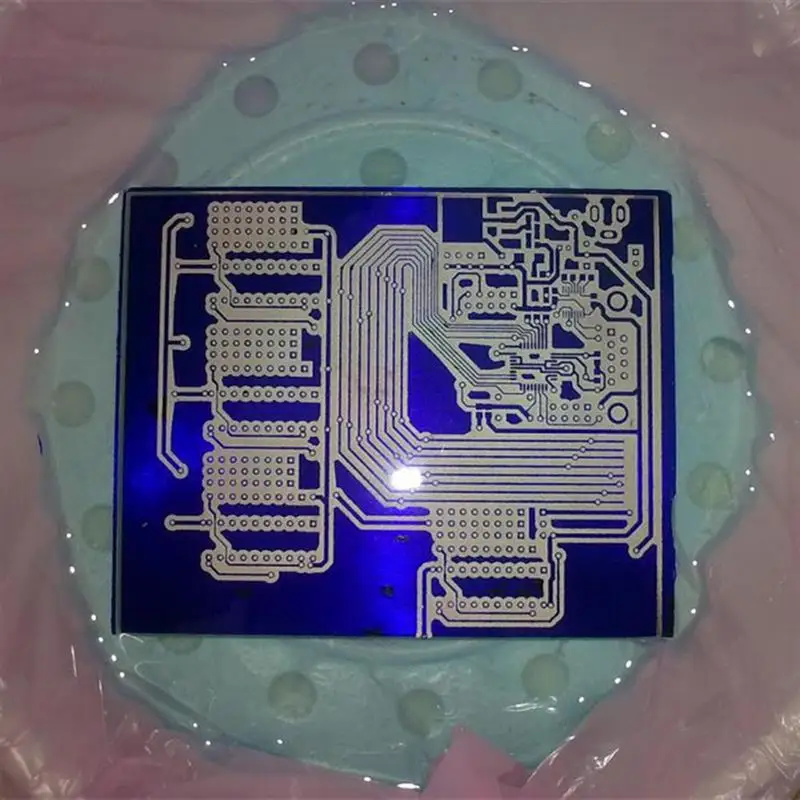
При использовании не подходящих для центрифугирование поверхностей, например для покрытия небольших поверхностей, используется нанесение окунанием в фоторезист. Недостатками этого метода являются большой расход фоторезиста и неоднородность получаемых пленок.
При необходимости нанести резист на сложные поверхности используется аэрозольное распыление, однако толщина пленки при таком методе нанесения также не является однородной.
•Фоторезистора — специальный материал, который изменяет свои физико-химические свойства при облучении светом.
•Фоторезист имеет светочувствительный состав, обычно органический
•Если после экспонирования становятся растворимыми засвеченные области фоторезиста, то процесс фотолитографии называется негативным. Иначе — позитивным.
•Спектр используемого света
–Ультрафиолет ~ 350, 400, 435 нм (линии ртутной лампы)
•DNQ-novolac, позитивный
–Дальний ультрафиолет ~ 157, 193, 248 нм(эксимерные газовые лазеры)
•Полигидроксистирен
•Рентгенорезисты и электронорезисты
–ПММА (PMMA) – полиметилметактрилат – оргстекло, позитивный
Эксимерными называют газовые лазеры, работающие на электронных переходах молекул, кратковременно существующих в условиях электрического разряда.
Многостадийная очистка подложки
- Удаление органических соединений
- Удаление металлов
- Удаление остатков от растворителей – деионизованная вода
- Сушка пластины – нельзя допускать высыхания воды на пластине самой по себе (очистка паром, горячая вода, сушка с обдувом)
- Нанесение праймера для улучшения адгезии
Резист обычно наносится с помощью центрифугирования
- Скорость вращения от 1000 до 10000 об/мин
- Скорость вращения, время, количество резиста определяются для каждого типа резиста, требуемой толщины, типа подложки и т.п.
Сушка резиста — обычно не более 100 градусов
Фотошаблон•Фотошаблон — пластина, прозрачная для используемого в данном процессе электромагнитного излучения, с рисунком, выполненным непрозрачным для используемого излучения красителем.
•Фотошаблон — плоскопараллельная кварцевая пластина
с нанесенным тонким слоем хрома – рисунок
–При массовом производстве получают несколько наборов шаблонов – рабочий и мастер-шаблон
•Главная проблема — прецизионное совмещение шаблона и подложки
– необходимо попасть в нужное место
Предварительное задубливаниеПосле нанесения резиста необходимо провести его предварительную сушку (задубливание) . Об этом говорит сайт https://intellect.icu . Для этого образец выдерживается несколько минут в печи, при температуре 100—120оС. Этот этап необходим для испарения растворителя содержащегося в фоторезисте, что способствует улучшению адгезии, исключению прилипания кфотошаблону, возможности нанесения второго слоя фоторезиста и имеет положительное влияние в некоторых других аспектах.
Об этом говорит сайт https://intellect.icu . Для этого образец выдерживается несколько минут в печи, при температуре 100—120оС. Этот этап необходим для испарения растворителя содержащегося в фоторезисте, что способствует улучшению адгезии, исключению прилипания кфотошаблону, возможности нанесения второго слоя фоторезиста и имеет положительное влияние в некоторых других аспектах.
Экспонирование
Длины волн экспонирования в литографии
Схемы 4х различных видов экспонирования.
Показаны
a) контактный метод экспонирования,
b)экспонирование с микрозазором и
c) d)проекционные методы экспонирования
Процесс экспонирования заключается засветке фоторезиста через фотошаблон, содержащий желаемый рисунок, светом видимого или ультрафиолетового диапазона, что и отличает процесс фотолитографии от других видов литографии. К примеру, в случае рентгеновской, ионно-лучевой иэлектронной литографии, для экспонирования, используются рентгеновкие лучи, ионы и электронысоответственно.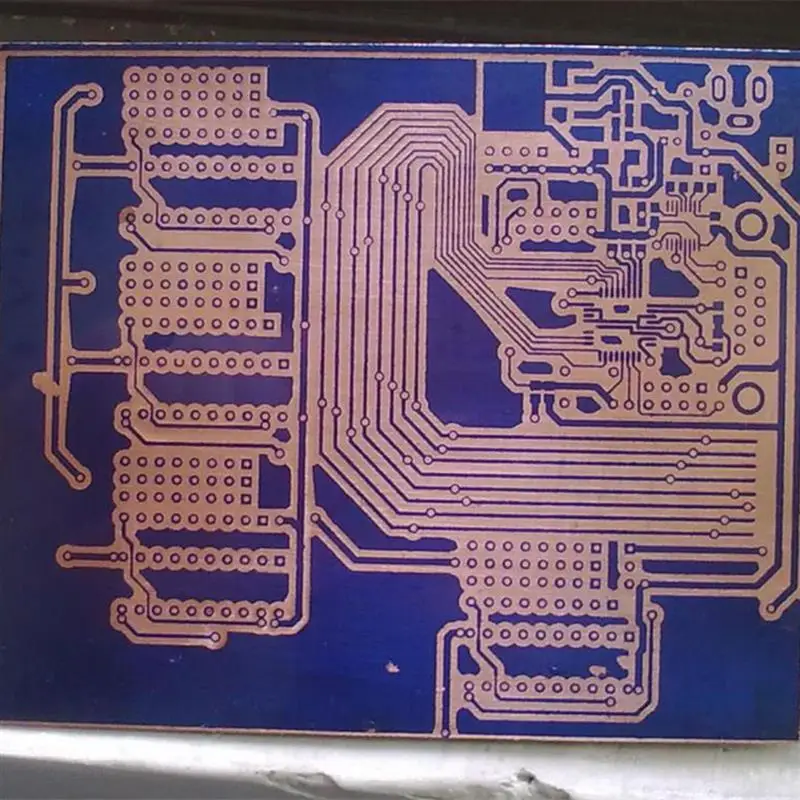
Наиболее стандартными длинами волны экспонирования в фотолитографии являются i-линия (365нм), h-линия (405нм) и g-линия (436нм). Как бы то ни было, большинство фоторезистов могут быть проэкспонированы и широким спектром в ультрафиолетовом диапазоне (интегральное экспонирование), для чего обычно применяется ртутная лампа. В случае фотолитографии в глубоком (жестком) ультрафиолете используются длины волн около 13,5нм и специальные фоторезисты. Среди источников излучения, использующихся в фотолитографии наиболее распространены:
- Ртутная лампа (около 400 нм)
- Эксимерный лазер KrF (248 нм)
- Эксимерный лазер ArF (193 нм)
- Эксимерный лазер F2 (157 нм; только экспериментальные установки)
Экспонирование может проводиться как с использованием фотошаблона, так и без него (безмасочная литография). В последнем случае рисунок на фоторезисте формируется непосредственно перемещающимся лазерным или электронным лучом или их группой, сфокусированным на поверхности фоторезиста.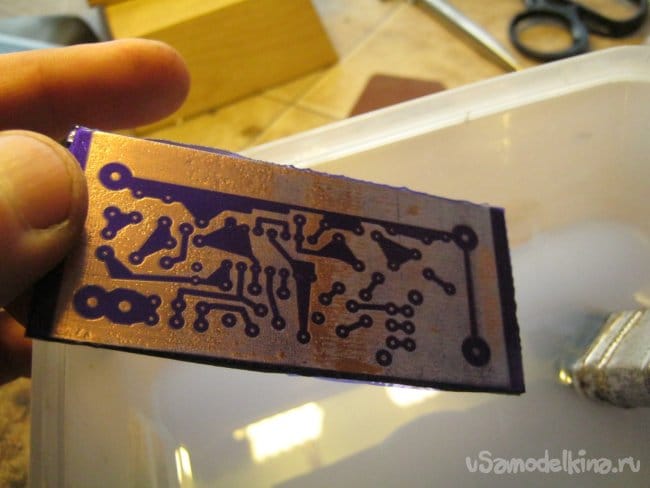 В случае же применения фотошаблонов чаще используются проекционные методы экспонирования, когда рисунок с фотошаблона переносится на фоторезист с использованием системы оптических линз. В некоторых вариантах литографии, маска может находиться в контакте с фоторезистом, или в непосредственной близости, при наличии микрозазора.
В случае же применения фотошаблонов чаще используются проекционные методы экспонирования, когда рисунок с фотошаблона переносится на фоторезист с использованием системы оптических линз. В некоторых вариантах литографии, маска может находиться в контакте с фоторезистом, или в непосредственной близости, при наличии микрозазора.
Существуют технологии, позволяющие уменьшить искажения и изготовить микросхемы с меньшими проектными нормами:
- Optical proximity correction (Коррекция эффекта оптической близости)
- Off-axis illumination (Применение вне-осевого освещения)
- Фазосдвигающие маски (PCM)
- Иммерсионная литография
- Двойное формирование рисунка
- Двойное формирование рисунка со спейсерами (spacer double patterning)
При производстве полупроводниковых приборов, для экспонирования больших по площади пластин (150, 200, 300 мм в диаметре) используют такие аппараты, какстепперы и сканеры, в которых небольшой фотошаблон экспонируется на пластину многократно с помощью перемещения экспонируемой поверхности.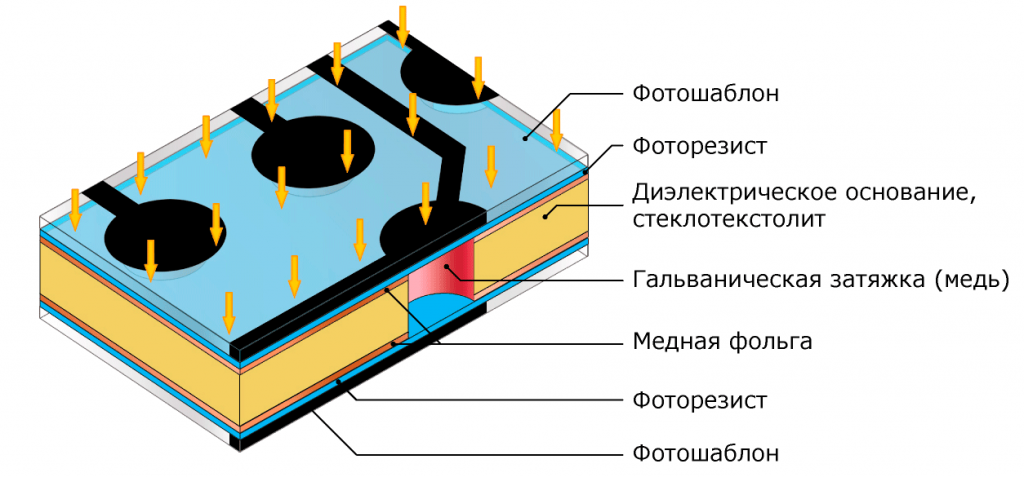
Основными параметрами экспонирования являются длина волны, время экспонирования и мощность источника излучения. Как правило каждый фоторезист имеет определенное значение дозы (мДж/см2), необходимой для его экспонирования, поэтому важно правильно подобрать параметры экспонирования. При недостаточной дозе могут возникнуть проблемы с проявлением фоторезиста, а чрезмерное экспонирование может вызвать повреждения пленки фоторезиста. От мощностных параметров зависит производительность фотолитографических установок, измеряемая в пластинах в час (wph).
Дополнительно стоит отметить такой метод фотолитографии, как «выжигание», при котором необходимые окна в полимерном слое выжигаются под воздействием на них мощного светового потока, испаряющего нанесенную на материал пленку или прожигающего сам материал насквозь. Этот способ применяется для изготовления малотиражных офсетных форм и в некоторых системах ризографии.
Вторичное задубливание
Вторичное задубливание производится непосредственно после экспонирования и не является обязательным шагом. Этот этап требуется лишь в случаях применения химически усиленных фоторезистов, применения обращаемого фоторезиста, потребности в релаксации толстых пленок фоторезиста и в некоторых других ситуациях.
Этот этап требуется лишь в случаях применения химически усиленных фоторезистов, применения обращаемого фоторезиста, потребности в релаксации толстых пленок фоторезиста и в некоторых других ситуациях.
Проявление
В процессе проявления, части фоторезиста удаляются специальной жидкостью — проявителем (например гидроксид тетраметиламмония), формируя окна в пленке фоторезиста. В случае использования позитивного фоторезиста, удаляется проэкспонированная область, а в случае негативного, не проэкспонированная.
Определенные фоторезисты проявляются определенным проявителем и не проявляются другими. Как правило, проявитель разбавляется водой (1:2, 1:4), при этом степень разбавления контролирует скорость проявления, которая так же зависит от полученной фоторезистом дозы при экспонировании.
Финальное задубливание
Окончательное задубливание фоторезиста также является не обязательным шагом, хотя нередко помогает улучшить его свойства. В частности, сушка при 130—140оС повышает химическую и температурную устойчивость проявленного фоторезиста для таких последующих этапов, как электроосаждение, сухое и жидкостное травление.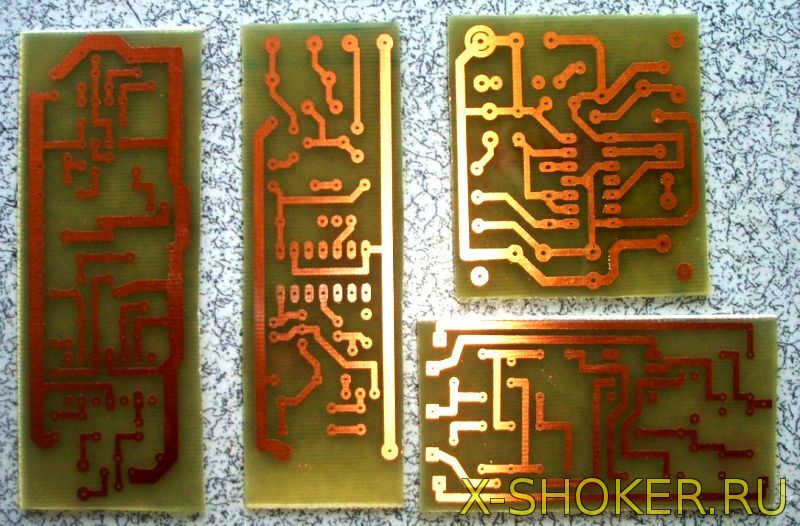
Обработка поверхности
Как правило, фотолитография тесно связана с технологическим этапом, для которого собственно и требуется получаемый из фоторезиста рисунок. Наиболее распространенным процессом на этом этапе является травление, хотя нередко применяются и такие процессы как электроосаждение и напыление при проведении обратной фотолитографии.
Травление
Травления является наиболее часто используемым в совокупности с фотолитографией процессом, при производстве печатных плат и полупроводниковых приборов длямикроэлектроники. Существуют два основных вида травления: жидкостное (жидкое) и плазменное (сухое). В зависимости от задач, применяют тот или иной тип травления. В целом, жидкостное травление применяют, в основном, при изготовлении печатных плат, а также для вытравливания жертвенного слоя при изготовленииМЭМС, и других применений, где требуется изотропное травление (то есть травление во всех направлениях). Плазменное, и в особенности глубокое плазменное травление, применяют когда необходимо протравить структуру относительно глубоко, сохраняя при этом, как можно более вертикальный угол наклона стенок, то есть протравить анизотропно, только в вертикальном направлении. Результат травления тесно связан с параметрами фоторезиста, что во многом, и определяет его выбор.
Результат травления тесно связан с параметрами фоторезиста, что во многом, и определяет его выбор.
Электроосаждение
В процессе электроосаждения, окна в фоторезисте используются для осаждения в них материала из электролита.
Напыление. Обратная литография
В случаях, когда требуется получить рисунок из материала плохо подвергающегося травлению, используют процесс обратной (взрывной) литографии. В процессе обратной литографии, на нанесенный и проявленный фоторезист напыляется тонкий слой материала (обычно металла) из которого требуется сформировать рисунок. На следующем этапе, производится снятие фоторезиста, так что напыленный материал остается только в окнах, незащищенных фоторезистом, а пленка попавшая на фоторезист уносится вместе с ним, то есть осуществляется так называемый «взрыв». Для обратной литографии, как правило, используются специальные LOR (lift-of-resist) фоторезисты. Существуют многочисленные модификации этого метода, например, когда используются два или даже три слоя фоторезистов с разной скоростью проявления. В целом, для аккуратного снятия фоторезиста, требуется чтобы пленка фоторезиста была в два и более раз толще, чем пленка напыленного материала, а также, чтобы стенки фоторезиста имели отрицательный наклон, что исключит возможность их покрытия напыляемым материалом.
В целом, для аккуратного снятия фоторезиста, требуется чтобы пленка фоторезиста была в два и более раз толще, чем пленка напыленного материала, а также, чтобы стенки фоторезиста имели отрицательный наклон, что исключит возможность их покрытия напыляемым материалом.
Снятие фоторезиста
Финальным этапом процесса фотолитографии является снятие фоторезиста. Для удаления фоторезиста с обработанной поверхности используют специальную жидкость — сниматель (например диметилсульфоксид). Как правило, определенные сниматели подходят только к определенным группам фоторезистов. В процессах обратной фотолитографии, вместе с фоторезистом удаляется и покрывающая его пленка материала. Если на предыдущих этапах применялись усилители адгезии или антиортажающие покрытия, они, как правило, также удаляются снимателем.
Сравнение различных методов литографииДругие виды литографии
Как видно из табл. 1, в которой сравниваются различные методы литографии, рентгеновская литография позволяет получать размеры элементов около 0,1 мкм
Рентгенолитография представляет собой метод контактной печати, аналогичный методу фотолитографической контактной печати с зазором и использующий актиничное излучение мягких рентгеновских лучей с λ = 0,2÷1,5 нм, что способствует устранению дифракционных ограничений, характерных для фотолитографии [55]. Ей присущи такие неоспоримые преимущества, как высокая разрешающая способность (примерно 500 нм), нечувствительность к пыли и загрязнениям, отсутствие проблем, связанных с рассеянием, возможность применения как позитивных, так и негативных рентгенорезистов, возможность экспонирования всей пластины в отсутствие вакуума, простота и низкая стоимость [56]. Разрешающая способность реально ограничена величиной поглощения рентгеновского излучения металлическим рисунком шаблона. Шаблоны, применяемые в процессе рентгенолитографии, изготавливаются с помощью электронолитографии из пленок золота на кремниевой подложке толщиной 2–5 мкм. Кремний может быть заменен майларом, который обладает меньшим коэффициентом поглощения, что позволяет увеличить толщину подложки [56]. Рисунок шаблона выполняется на пленке золота, обладающего большим коэффициентом поглощения рентгеновских лучей. Дальнейшее повышение разрешающей способности обеспечивают электронно-лучевые методы (табл. 5.7.25).
Ей присущи такие неоспоримые преимущества, как высокая разрешающая способность (примерно 500 нм), нечувствительность к пыли и загрязнениям, отсутствие проблем, связанных с рассеянием, возможность применения как позитивных, так и негативных рентгенорезистов, возможность экспонирования всей пластины в отсутствие вакуума, простота и низкая стоимость [56]. Разрешающая способность реально ограничена величиной поглощения рентгеновского излучения металлическим рисунком шаблона. Шаблоны, применяемые в процессе рентгенолитографии, изготавливаются с помощью электронолитографии из пленок золота на кремниевой подложке толщиной 2–5 мкм. Кремний может быть заменен майларом, который обладает меньшим коэффициентом поглощения, что позволяет увеличить толщину подложки [56]. Рисунок шаблона выполняется на пленке золота, обладающего большим коэффициентом поглощения рентгеновских лучей. Дальнейшее повышение разрешающей способности обеспечивают электронно-лучевые методы (табл. 5.7.25).
Вышеуказанные методы литографии для получения требуемой конфигурации элементов с высоким разрешением, как и метод оптической литографии, требуют специальной разработки новых резистов, технологического оборудования, технологических процессов и условий их проведения, а также отдельного и детального описания этих методов литографии (достоинств, недостатков, возможностей и технологических режимов и т.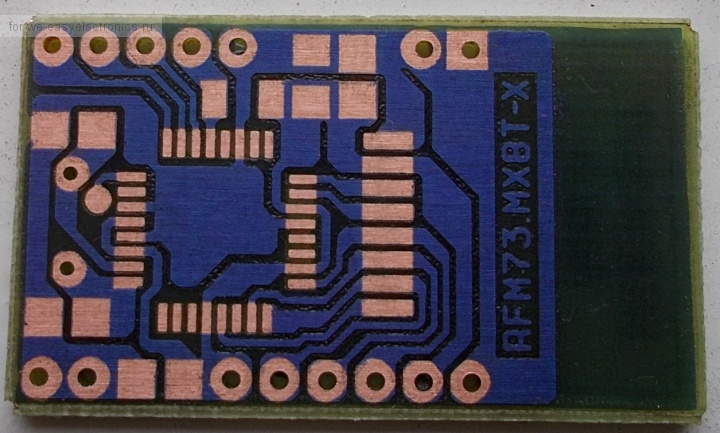 д.).
д.).
К основным достоинствам фотолитографии относятся:
- повышение разрешающей способности, проявляющееся в разработке методов проекционной фотолитографии и, особенно, в переходе от оптической фотолитографии к рентгеновской и электронно-лучевой литографии;
- улучшение реального качества процесса, в первую очередь снижение плотности локальных дефектов за счет повышения производственной гигиены, автоматизации процесса, сокращения числа операций (например, создание рисунка без шаблона, т. е. непосредственно на рабочей пластине).
Таблица 1
Сравнение различных методов литографии
| Характеристика процесса | Оптическая литография | Рентгеновская литография | Электронно-лучевая литография | ||
| контактная | проекционная | сканирующая | полная проекция | ||
|
Длина волны излучения, нм |
300 | 300 | 0,4–1,4 | 0,01 | 0,01 |
|
Практическое разрешение, мкм |
0,6–1,0 | 0,4–1,0 | 0,7 | 0,1–0,15 | 1,0–2,0 |
|
Шаблон |
Стекляный с хромовым покрытием |
Стекляный |
Кремниевый с золотым покрытием |
Не нужен |
Сложный фотокатод |
|
Время экспонирования (стандартная пластина) |
Секунды | Десятки секунд |
От нескольких секунд до нескольких минут |
От нескольких минут до нескольких часов (сложные рисунки) |
Десятки секунд |
|
Совмещение |
Визуальное, фотоэлектрическое |
С помощью датчика рентгеновского излучения |
С помощью специального датчика электрического сигнала |
||
|
Достоинства |
Простота, высокая производительность |
Отсутствие износа шаблонов, более чистые условия, отсутствие дифракции в зазоре между шаблоном и резистом |
Отсутствие контакта при обеспечении высокой разрешающей способности, высокая производительность, относительная простота (пластина не в вакууме) |
Отсутствие шаблона, высокая разрешающая способность |
Высокие производительность и разрешающая способность |
|
Недостатки |
Износ шаблонов и повреждение слоя при контакте, дифракция в зазоре между шаблоном и резистом |
Сложная оптика, мощные УФ осветители, трудности фокусировки высокоразрешающих объективов |
Трудности фокусировки рентгеновских лучей, необходимость вакуумной системы для источника |
Сложное Лабораторное оборудование, помещение пластины в вакуум, трудности совмещения, низкая производительность |
Сложное Лабораторное оборудование, помещение пластины в вакуум, трудности совмещения, сложности изготовления шаблонов-фотокатодов |
Альтернативные способы фотолитографии:
•«Взрывной». (обратная фотолитография) При его использовании слой материала наносится на слой предварительно облученного и протравленного фоторезиста, после чего остатки фоторезиста удаляются, унося с собой области материала, под которыми он располагался. Используется для изготовления рисунков из материалов, не имеющих травителя, либо если травитель является слишком агрессивным.
(обратная фотолитография) При его использовании слой материала наносится на слой предварительно облученного и протравленного фоторезиста, после чего остатки фоторезиста удаляются, унося с собой области материала, под которыми он располагался. Используется для изготовления рисунков из материалов, не имеющих травителя, либо если травитель является слишком агрессивным.
•«Выжигание». Необходимые окна в полимерном слое разрушаются воздействием на них мощного светового потока, испаряющего нанесенную на материал пленку или прожигающего сам материал насквозь. Применяется для изготовления малотиражных офсетных форм и в некоторых системах ризографии.
Другие способы нанолитографии —
существуют и другие методы в порядке развития микро- и нанолитографии(уменьшения размров получаемых элементов)
См. также
- электронная литография ,
- рентгенолитография , рентгеновская литография ,
- атомная нанолитография , наноимпринт ,
- euv-литография , нанолитография ,
- Фотолитография
- EUV литография
- Рентгеновская литография ( рентгенолитография )
- Электронная литография
- Ионно-лучевая литография
- Лазерно-интерференционная литография
- Сканирующая зондовая литография (с помощью СТМ и АСМ)
- Dip-pen и Nano-pen литография
- Наноимпринт и нанопечатная литография
- Оптическая нанолитография
- Литография наносферами
- Атомная нанолитография
- Литографически индуцированная самосборка
- технология изготовления интегральных микросхем , технология изготовления печатных плат ,
Статью про фотолитография я написал специально для тебя. Если ты хотел бы внести свой вклад в развии теории и практики,
ты можешь написать коммент или статью отправив на мою почту в разделе контакты.
Этим ты поможешь другим читателям, ведь ты хочешь это сделать? Надеюсь, что теперь ты понял что такое фотолитография, нанолитография
и для чего все это нужно, а если не понял, или есть замечания,
то нестесняся пиши или спрашивай в комментариях, с удовольствием отвечу. Для того чтобы глубже понять настоятельно рекомендую изучить всю информацию из категории
Конструирование и проектирование электронной аппаратуры
Если ты хотел бы внести свой вклад в развии теории и практики,
ты можешь написать коммент или статью отправив на мою почту в разделе контакты.
Этим ты поможешь другим читателям, ведь ты хочешь это сделать? Надеюсь, что теперь ты понял что такое фотолитография, нанолитография
и для чего все это нужно, а если не понял, или есть замечания,
то нестесняся пиши или спрашивай в комментариях, с удовольствием отвечу. Для того чтобы глубже понять настоятельно рекомендую изучить всю информацию из категории
Конструирование и проектирование электронной аппаратуры
Фоторезист — Полупроводниковая техника
Фоторезист — Полупроводниковая техникаФоторезист — Полупроводниковая техникаЦентр знаний
Светочувствительный материал, используемый для формирования рисунка на подложке.
Фоторезист представляет собой светочувствительный полимер. При воздействии ультрафиолетового света превращается в растворимый материал.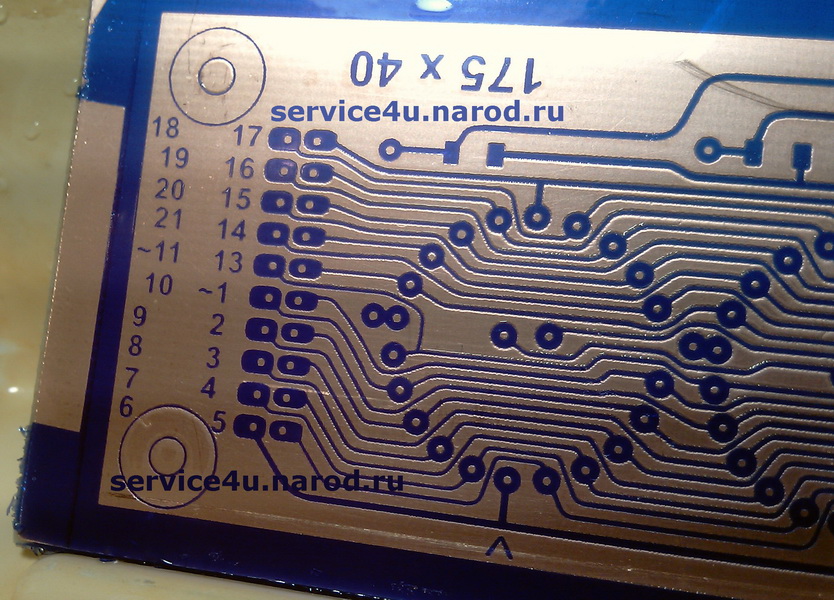 Затем эти открытые участки можно растворить с помощью растворителя, оставив после себя рисунок.
Затем эти открытые участки можно растворить с помощью растворителя, оставив после себя рисунок.
Хотя в полупроводниковой литографии это делалось в течение многих лет, проблема заключается в том, что световой пучок ArF с длиной волны 193 нм слишком толстый для создания конструкций с толщиной менее 22 нм с использованием одного прохода лазера. Однако экстремальное ультрафиолетовое излучение неоднократно задерживалось, потому что источник энергии недостаточен для того, чтобы сделать его экономически выгодным. Пока продолжается работа над источником питания, исследователи также пытаются сделать фоторезист более чувствительным, решая проблему с двух сторон, а не только с одной.
Большинство резистов, используемых сегодня, представляют собой химически амплифицированные резисты. В них падающий свет не вызывает растворения полимера основной цепи напрямую. Скорее, свет поглощается генераторами фотокислоты (ПАГ), которые высвобождают несколько молекул фотокислоты на фотон. Фотокислота вступает в реакцию с защитными группами на основной цепи полимера, «снимая защиту» с нее и заставляя ее растворяться в проявителе. С резистами EUV падающий свет может также возбуждать фотоэлектроны, которые, в свою очередь, могут запускать реакцию образования фотокислоты.
С резистами EUV падающий свет может также возбуждать фотоэлектроны, которые, в свою очередь, могут запускать реакцию образования фотокислоты.
Таким образом, в самом сердце химии химически усиленных резистов мы находим компромисс между разрешением и чувствительностью. Чтобы максимизировать разрешение, разработчики резистов хотели бы, чтобы молекулы основной цепи были небольшими, а реакция снятия фотокислотной защиты происходила близко к местоположению ПАГ. Как расстояние диффузии фотокислоты, так и количество резиста, снятого с защиты каждой молекулой фотокислоты, должны быть небольшими.
С другой стороны, чтобы максимизировать чувствительность, разработчики ищут практически противоположные характеристики. Поперечное сечение захвата фотонов должно быть большим, чтобы использовать как можно больше фотонов. Каждый фотон должен генерировать множество молекул фотокислоты, которые должны быстро диффундировать в слой резиста, чтобы снять защиту с максимально возможного количества полимерных цепей. К сожалению, большое расстояние распространения, которое предполагает это поведение, способствует размытию, неопределенности размеров экспонируемого элемента.
К сожалению, большое расстояние распространения, которое предполагает это поведение, способствует размытию, неопределенности размеров экспонируемого элемента.
Несколько микросхем, расположенных в плоской или сложенной конфигурации, с промежуточным устройством для связи.
2.5D и 3D формы интеграции
Архитектура памяти, в которой ячейки памяти спроектированы вертикально вместо использования традиционного плавающего затвора.
Беспроводная технология следующего поколения с более высокой скоростью передачи данных, малой задержкой и поддержкой большего количества устройств.
Начнем со схем и закончим ESL
Важные события в истории логического моделирования
Раннее развитие, связанное с логическим синтезом
Общеупотребительные и не очень часто используемые аббревиатуры.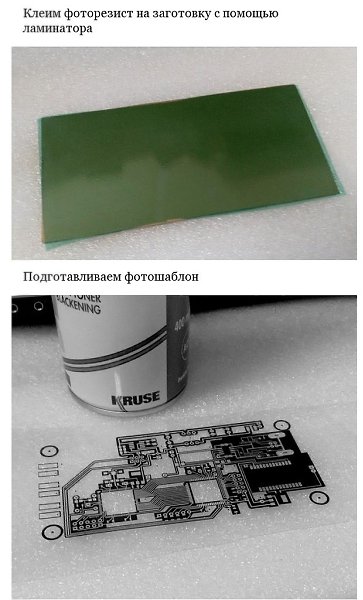
Датчики и обработка, чтобы сделать вождение более безопасным.
В более новых узлах для заполнения требуется больше интеллекта, поскольку это может повлиять на синхронизацию, целостность сигнала и потребовать заполнения для всех слоев.
Набор подходов к объединению микросхем в пакеты, что приводит к снижению энергопотребления и стоимости.
Подход к разработке программного обеспечения, ориентированный на непрерывную поставку и гибкость к изменяющимся требованиям
Как Agile применяется при разработке аппаратных систем
Способ улучшения изоляции между различными компонентами полупроводника путем создания пустого пространства.
Коллекция интеллектуальных электронных сред.
Полупроводники, измеряющие реальные условия
Аналоговые интегральные схемы — это интегральные схемы, которые представляют непрерывные сигналы в электрической форме.
Проектирование и проверка аналоговых компонентов.
Программный инструмент, используемый в программировании программного обеспечения, который абстрагирует все этапы программирования в пользовательский интерфейс для разработчика.
Заказная, специально разработанная интегральная схема, созданная для конкретной задачи или продукта.
ИС, созданная и оптимизированная для рынка и проданная нескольким компаниям.
Использование машин для принятия решений на основе накопленных знаний и сенсорной информации.
Код, который ищет нарушения собственности
Метод измерения поверхностных структур вплоть до ангстремного уровня.
Метод нанесения материалов и пленок в точно заданных местах на поверхность.
ALE — это технология травления нового поколения для селективного и точного удаления целевых материалов в атомарном масштабе.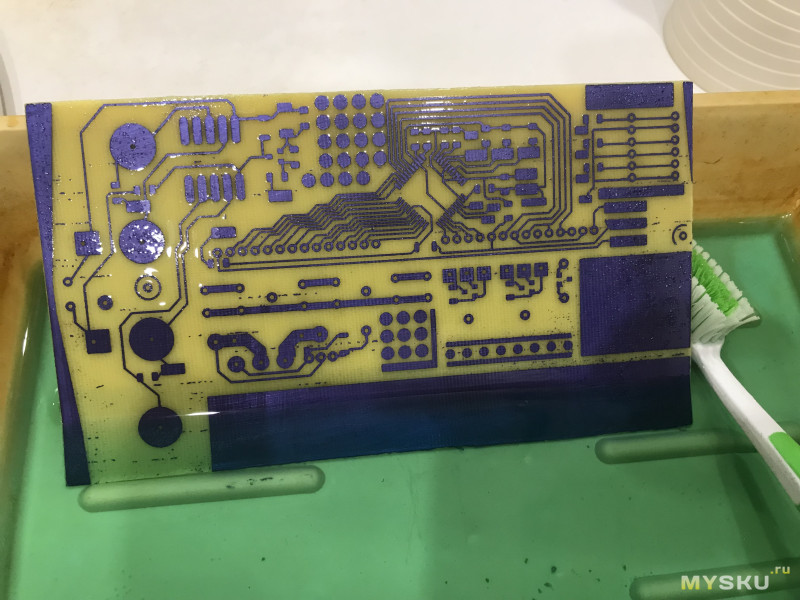
Создание тестов, которые можно использовать для функциональной или производственной проверки
Вопросы, связанные с развитием автомобильной электроники.
Чувствительная ко времени сеть переводит автомобильный Ethernet в режим реального времени.
Шум в переходах с обратным смещением
Методология проверки, созданная Mentor
Производственные процессы ИС, в которых изготавливаются межсоединения.
Устройства, которые химически накапливают энергию.
Преобразование дизайна, описанного на высоком уровне абстракции, в RTL
Безопасность на основе сканирования отпечатков пальцев, ладоней, лиц, глаз, ДНК или движения.
Сила, обратная электромиграции.
Также известный как Bluetooth 4. 0, расширение беспроводного протокола ближнего действия для приложений с низким энергопотреблением.
0, расширение беспроводного протокола ближнего действия для приложений с низким энергопотреблением.
Модель транзистора
Встроенная логика для тестирования конструкции.
Модель интерфейса между тестовым стендом и тестируемым устройством
C, C++ иногда используются при разработке интегральных схем, потому что они предлагают более высокую абстракцию.
Стандарт межсоединений, обеспечивающий согласованность кэш-памяти для ускорителей и периферийных устройств расширения памяти, подключаемых к процессорам.
Автомобильный автобус разработки Bosch
CD-SEM, или сканирующий электронный микроскоп критических размеров, представляет собой инструмент для измерения размеров элементов на фотошаблоне.
Обеспечение предсказуемости интерфейсов CDC
Модель сбоя для сбоев внутри ячеек
Методология тестирования Cell-aware для устранения механизмов дефектов, специфичных для FinFET.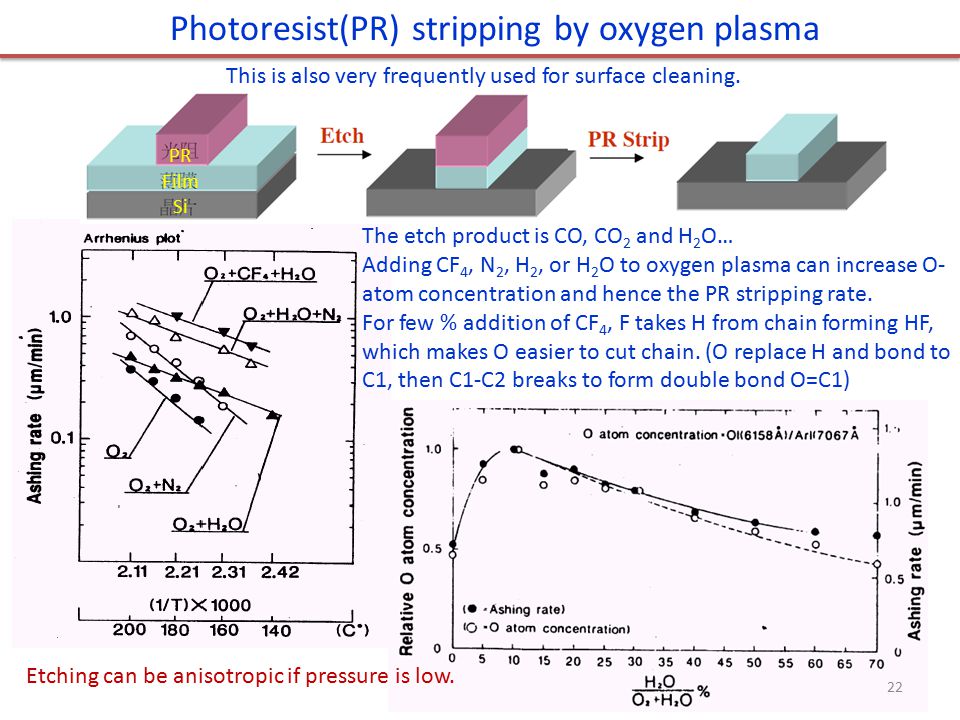
ЦП — это специализированная интегральная схема или IP-ядро, которое обрабатывает логические и математические операции.
Лаборатория, которая сотрудничает с научно-исследовательскими организациями и заводами, участвующими в ранней аналитической работе для устройств, корпусов и материалов следующего поколения.
Компонент Testbench, который проверяет результаты
Процесс, используемый для проявления тонких пленок и полимерных покрытий.
Дизайн – это процесс создания реализации из концептуальной формы
Проектирование, проверка, внедрение и испытание электронных систем в интегральных схемах.
Обмен информацией о тепловых расчетах для 3D ИС
Асинхронная связь через границы
Динамическое снижение мощности за счет стробирования часов
Конструкция тактовых деревьев для снижения мощности
Облако — это набор серверов, на которых запущено интернет-программное обеспечение, которое вы можете использовать на своем устройстве или компьютере.
Технология изготовления
Кобальт является ферромагнитным металлическим ключом к литий-ионным батареям.
Метрики, относящиеся к коду, выполненному при функциональной проверке
Убедитесь, что функциональность между регистрами остается неизменной после преобразования
Связь на чипе, между чипами и между устройствами, которая отправляет биты данных и управляет этими данными.
Более быстрая форма для логического моделирования
Комплементарный FET, новый тип вертикального транзистора.
Соединение между процессором и ускорителями.
Структура, которая соединяет транзистор с первым слоем медных межсоединений.
Технология компьютерного зрения, основанная на машинном обучении.
Показатели завершения функциональной проверки
Помехи между сигналами
Криптопроцессоры — это специализированные процессоры, которые выполняют криптографические алгоритмы на оборудовании.
Компании, предоставляющие ИС или услуги ИС
Метод экономии энергии в микросхемах путем отключения сегментов микросхемы, когда они не используются.
Аналитика данных использует AI и ML для поиска закономерностей в данных для улучшения процессов в EDA и производстве полуфабрикатов.
Как сортируются и тестируются полупроводники до и после внедрения чипа в систему.
Центр обработки данных — это физическое здание или помещение, в котором размещается несколько серверов с центральными процессорами для удаленного хранения и обработки данных.
Обработка данных — это когда к необработанным данным применяются операнды через компьютер или сервер для преобразования данных в другую пригодную для использования форму. Эта категория определений включает в себя то, как и где обрабатываются данные.
Эта категория определений включает в себя то, как и где обрабатываются данные.
Стандарт, который возникает благодаря широкому признанию или внедрению.
Удаление ошибок из дизайна
Глубокое обучение — это подмножество искусственного интеллекта, в котором представление данных основано на нескольких слоях матрицы.
Наблюдение, что по мере уменьшения возможностей уменьшается и энергопотребление.
Действия, предпринятые на этапе физического проектирования ИС для обеспечения точного изготовления конструкции.
Методы, которые уменьшают сложность и стоимость, связанные с тестированием интегральной схемы.
Охрана орнамента изделия
Процесс физического проектирования для определения соответствия чипа правилам, установленным производителем полупроводников
Поиск правил проектирования с использованием методов сопоставления с образцом.
Источники шума в устройствах
Вставка тестовой логики для синхронизации часов
Широкозонный синтетический материал.
Классификация цифровых IP
Разрешено сохранение изображения в цифровом виде
Процессор цифровых сигналов — это процессор, оптимизированный для обработки сигналов.
Цифровое представление продукта или системы.
Дополнительная технология литографии.
Анализ ДНК основан на уникальном секвенировании ДНК.
Использование дезоксирибонуклеиновой кислоты для защиты чипов от хакеров.
Техника формирования рисунка с использованием нескольких проходов лазера.
Цветные и бесцветные потоки для двойного нанесения рисунка
Однотранзисторная память, требующая обновления
Динамическая регулировка напряжения и частоты для снижения мощности
Язык проверки оборудования
Более медленный метод поиска мелких дефектов.
Литография с использованием однолучевого электронно-лучевого инструмента
Разница между предполагаемыми и напечатанными характеристиками макета ИС.
Электромиграция (ЭМ) из-за плотности мощности
Electronic Design Automation (EDA) — это отрасль, которая коммерциализирует инструменты, методологии и процессы, связанные с изготовлением электронных систем.
Уровни абстракции выше, чем RTL, используемые для проектирования и проверки
Перенос электростатического заряда.
eFPGA — это IP-ядро, интегрированное в ASIC или SoC, которое обеспечивает гибкость программируемой логики без затрат на FPGA.
Аппаратные средства специального назначения, используемые для логической проверки
Получение энергии из окружающей среды
Шум окружающей среды
Способ выращивания или осаждения монокристаллических пленок на подложку.
Программируемая память только для чтения с возможностью массового стирания.
Методология повторного использования на основе электронного языка
Методы обнаружения и исправления ошибок.
Ethernet — это надежный открытый стандарт для подключения устройств по проводам.
Литография EUV — это технология мягкого рентгеновского излучения.
Выяснение того, что пошло не так в разработке и производстве полупроводников.
Способ включения большего количества функций, которые обычно находятся на печатной плате внутри корпуса.
Оценка конструкции на наличие производственного брака
Форма малых сот с наименьшей мощностью, используемая для домашних сетей Wi-Fi.
Сегнетоэлектрический полевой транзистор — это новый тип памяти.
Перепрограммируемое логическое устройство
Использование металлического наполнителя для улучшения плоскостности и управления электрохимическим осаждением (ЭХД), травлением, литографией, эффектами напряжения и быстрым термическим отжигом.
Трехмерный транзистор.
энергонезависимая стираемая память
Интегральные схемы на гибкой подложке
Автомобильный протокол связи
Шум, связанный с колебаниями сопротивления
Тип межсоединения с использованием шариков припоя или микровыступов.
Транзисторный тип со встроенными nFET и pFET.
Формальная проверка включает в себя математическое доказательство того, что дизайн соответствует свойству
FD-SOI представляет собой полупроводниковый материал подложки с меньшей утечкой тока по сравнению с объемной КМОП.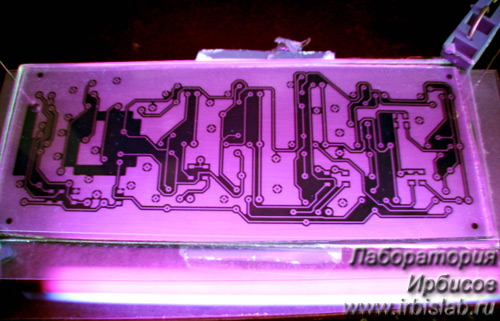
Метрика покрытия, используемая для индикации прогресса в проверке функциональности
Функциональный дизайн и проверка в настоящее время связаны со всеми функциями проектирования и проверки, выполняемыми до синтеза RTL.
Функциональная проверка используется для определения того, соответствует ли проект или его часть спецификации.
Статистический метод определения готовности испытательной системы к производству путем измерения отклонений во время испытаний на повторяемость и воспроизводимость.
GaN представляет собой материал III-V с широкой запрещенной зоной.
Возможная замена конструкции транзистора для finFET.
Методы снижения мощности, доступные на уровне ворот.
шум, связанный с генерацией-рекомбинацией
Структура нейронной сети, которая может генерировать новые данные.
Германия известна своей автомобильной промышленностью и промышленным оборудованием.
Двумерная форма углерода в гексагональной решетке.
Электронная схема, предназначенная для обработки графики и видео.
Добавление дополнительных схем или программного обеспечения в конструкцию, чтобы гарантировать, что если одна часть не работает, вся система не выйдет из строя.
Полностью разработанный аппаратный блок IP
Использование специального оборудования для ускорения проверки
Историческое решение, в котором в процессе моделирования использовались настоящие чипы
Оптимизация дизайна за счет использования единого языка для описания аппаратного и программного обеспечения.
Энергия создает тепло, а тепло влияет на мощность
Плотная многоуровневая версия памяти с высокоскоростными интерфейсами, которую можно использовать в расширенной упаковке.
Технология синтеза, которая преобразует описание поведения без учета времени в RTL
Определяет набор функций и возможностей для аппаратного обеспечения HSA
HSAIL Virtual ISA и модель программирования, средство записи компилятора и формат объекта (BRIG)
Возможности среды выполнения для архитектуры HSA
Сочетает использование общедоступной облачной службы с частным облаком, таким как внутренние корпоративные серверы или центры обработки данных компании.
Центр обработки данных, принадлежащий компании, которая предлагает облачные услуги через этот центр обработки данных.
Какие существуют типы интегральных схем?
Язык описания оборудования
Аналоговые расширения для VHDL
Коллекция пакетов VHDL 1076.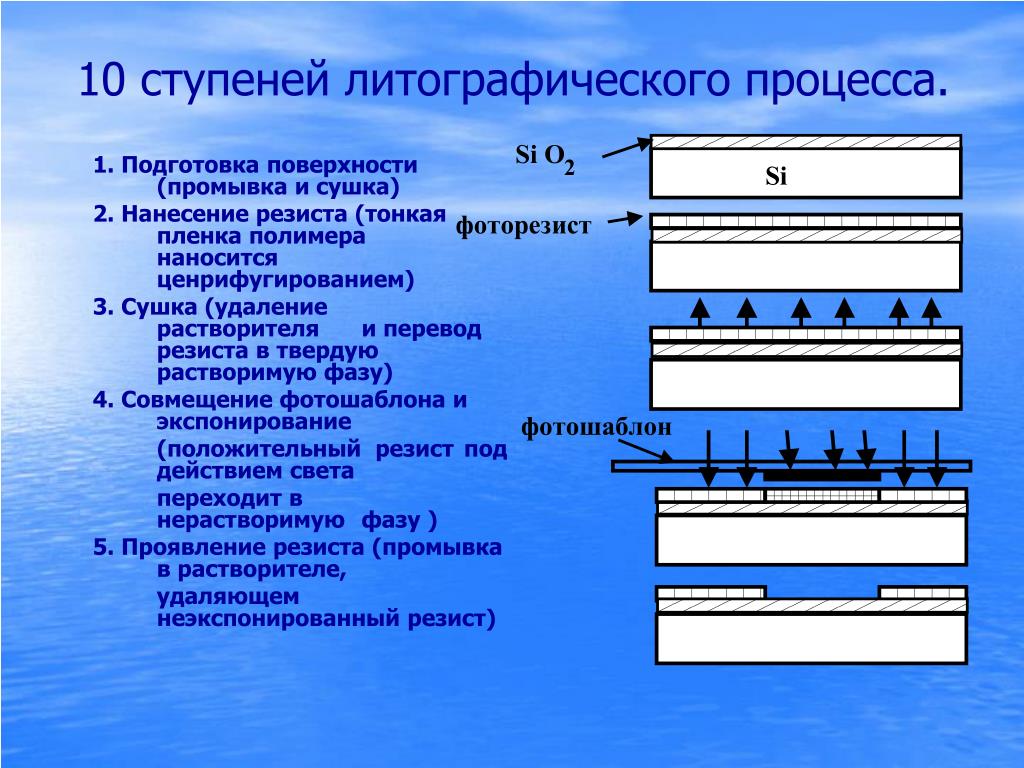 1
1
Моделирование макроячеек в VHDL
Тест сканирования границ
Утвержденная IEEE версия Verilog
Стандарт Verilog для синтеза уровня передачи регистров
Расширение до 1149.1 для программирования сложных устройств
Функциональный язык проверки
СистемаC
Стандарт интеграции IP в System-on-Chip
Стандарт IEEE для доступа и управления приборами, встроенными в полупроводниковые устройства
Версия SystemVerilog
, ратифицированная IEEE Универсальная методология проверки
Стандарт IEEE для проектирования и проверки маломощных интегральных схем, также известный под названием Unified Power Format (UPF) Accellera
. Стандарт архитектуры тестового доступа для трехмерных многослойных интегральных схем
Стандарт архитектуры тестового доступа для трехмерных многослойных интегральных схем
Язык проверки на основе формальной спецификации поведения
IEEE 802.1 — это стандарт и рабочая группа для протоколов локальных сетей более высокого уровня.
Рабочая группа IEEE 802.11 управляет стандартами для беспроводных локальных сетей (LAN).
IEEE 802.15 — это рабочая группа по беспроводным специализированным сетям (WSN), которые используются в IoT, носимых устройствах и автономных транспортных средствах.
«RR-TAG» — это техническая консультативная группа, поддерживающая группы стандартов IEEE, работающие над стандартами 802.11, 802.12, 802.16, 802.20, 802.21 и 802.22.
Стандарты сосуществования беспроводных стандартов нелицензионных устройств.
Обеспечивает широкополосный беспроводной доступ с использованием технологии когнитивного радио и совместного использования спектра в пустых пространствах.
Рабочая группа IEEE 802.3-Ethernet управляет стандартами IEEE 802.3-Ethernet.
Стандарт унифицированной аппаратной абстракции и уровень для электронных систем пропорционального энергопотребления
Стандарт моделирования мощности для обеспечения анализа системного уровня
Особые требования и особое внимание к Интернету вещей в промышленных условияхg
Стоимость вафли в узлах
Методы оптимизации энергопотребления для физической реализации
Выполнение функций непосредственно в ткани памяти.
Тепловой шум в канале
Набор основных операций, которые должен поддерживать компьютер.
БТИЗ представляют собой комбинацию МОП-транзисторов и биполярных транзисторов.
Интеграция нескольких устройств в один полупроводниковый элемент
Полупроводниковая компания, которая разрабатывает, производит и продает интегральные схемы (ИС).
Модуль проектирования или проверки, предварительно упакованный и доступный для лицензирования.
Сети, которые могут анализировать условия работы и реконфигурироваться в режиме реального времени.
Метод подтверждения действительности одного или нескольких пунктов формулы изобретения
Шины, NoC и другие формы соединения между различными элементами интегральной схемы.
Интернет вещей, также известный как Интернет всего или IoE, представляет собой глобальное приложение, в котором устройства могут подключаться к множеству других устройств, каждое из которых либо предоставляет данные с датчиков, либо содержит приводы, которые могут управлять некоторой функцией. Данные можно консолидировать и массово обрабатывать в облаке.
Быстрые и маломощные межкристальные каналы для электрических сигналов 2,5D.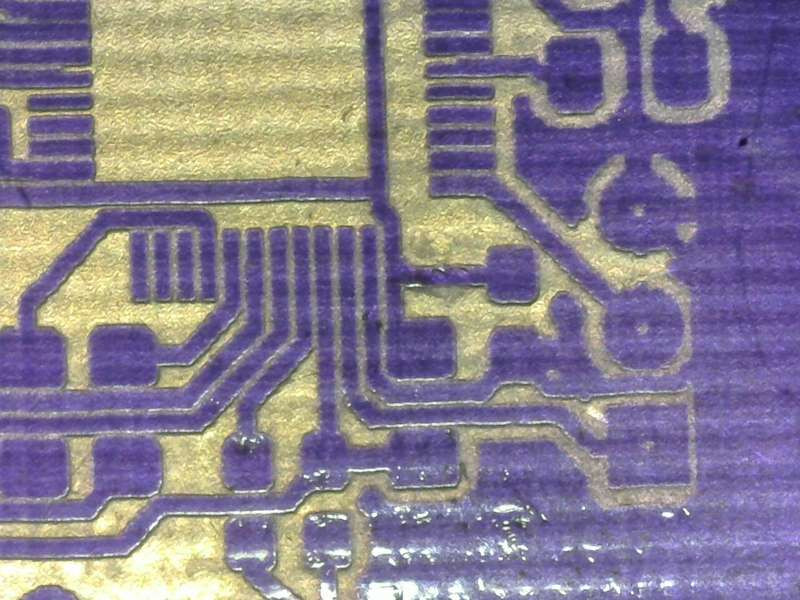
Поиск идеальных форм для фотомаски.
Введение критических примесей в процессе производства полупроводников.
Стандарт интеграции IP в System-on-Chip
Падение напряжения при протекании тока через резистор.
Терминология в ISO 26262
Стандарт безопасности электрических и электронных систем автомобиля
Стандарт для обеспечения правильной работы автомобильных систем ситуационной осведомленности.
Стандарт (в стадии разработки) автомобильной кибербезопасности.
Энергоэффективность компьютеров удваивается примерно каждые 18 месяцев.
Языки используются для создания моделей
Сравнение устройств и соединений между компоновкой и схемой
Ячейки, используемые для согласования напряжений между островами напряжения
Измерение расстояния до объекта импульсными лазерами.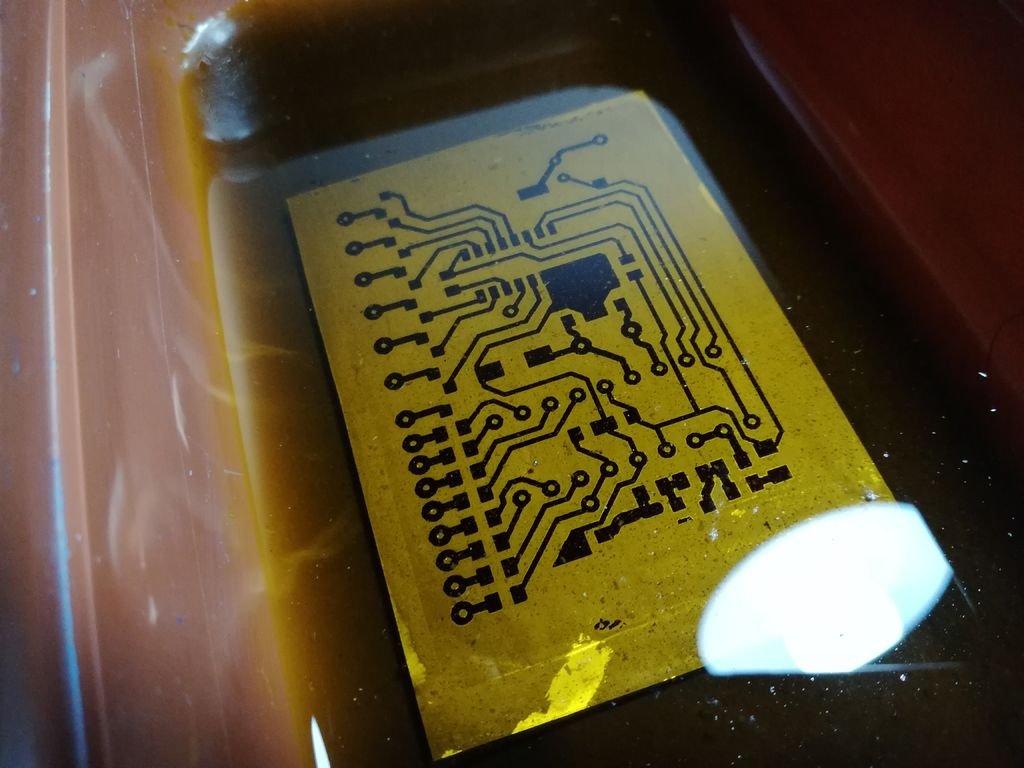
Бюджетный автомобильный автобус
Отклонение края элемента от идеальной формы.
Удаление непереносимого или подозрительного кода
LELE — это форма двойного паттерна
Тип двойного узора.
Свет, используемый для переноса рисунка с фотошаблона на подложку.
Коэффициент, связанный со сложностью процесса литографии
Логические элементы правильного размера
Реструктуризация логики для снижения мощности
Симулятор — это программный процесс, используемый для запуска модели аппаратного обеспечения
Методики, используемые для снижения энергопотребления.
Проверка силовой цепи
Технический стандарт электрических характеристик маломощного дифференциального протокола последовательной связи.
Подход, при котором машины обучаются поддерживать базовое поведение и результаты, а не явно запрограммированы на выполнение определенных задач. Это приводит к оптимизации как аппаратного, так и программного обеспечения для достижения предсказуемого диапазона результатов.
Использует магнитные свойства для хранения данных
Наблюдение за количеством нестандартного и стандартного контента в электронике.
Отслеживание пластины через фабрику.
Источники шума на производстве
Полупроводниковые материалы позволяют создавать электронные схемы.
Полупроводниковое устройство, способное сохранять информацию о состоянии в течение определенного периода времени.
Использование нескольких банков памяти для снижения энергопотребления
Микроэлектромеханические системы представляют собой сплав электротехники и механики и обычно используются для датчиков, усовершенствованных микрофонов и даже динамиков.
Ключевой инструмент для производства светодиодов.
Искусственные материалы, содержащие массивы металлических наноструктур или мегаатомов.
Нестабильное состояние защелки
Наблюдение, согласно которому стоимость сети пропорциональна квадрату пользователей
Описывает процесс создания продукта
Метрология — это наука об измерении и характеристике крошечных структур и материалов.
Интегральная схема, впервые поместившая центральный процессор на один кремниевый чип.
Интеграция аналогового и цифрового.
Модели являются абстракциями устройств
Вариант упаковки среднего класса, который предлагает меньшую плотность, чем веерообразные выходы.
Способ укладки транзисторов внутри одного чипа вместо корпуса.
Наблюдение Гордона Мура, связанное с ростом полупроводников.
Соринка — это микросенсор.
Усовершенствованная форма электронно-лучевой литографии
Ранний подход к объединению нескольких функций в один пакет.
Увеличение количества углов усложняет анализ. Параллельный анализ обещает.
Использование тестера для одновременного тестирования нескольких штампов.
Использование устройств с многопороговым напряжением
Способ изображения конструкций ИС на длине волны 20 нм и ниже.
Прочный и проводящий материал из двумерных неорганических соединений в тонких атомарных слоях.
Литографический процесс горячего тиснения.
Тип полевого транзистора, в котором используются более широкие и толстые провода, чем в боковом нанопроводе.
Оптимизация мощности путем вычисления ниже минимального рабочего напряжения.
Перемещение вычислений ближе к памяти для снижения затрат на доступ.
NBTI представляет собой сдвиг порогового напряжения при приложенном напряжении.
Метод сбора данных из физического мира, имитирующий человеческий мозг.
Вычислительная архитектура, созданная по образцу человеческого мозга.
Случайные колебания напряжения или тока в сигнале.
Программируемая память только для чтения (PROM) и одноразовая программируемая память (OTP) могут быть записаны один раз.
Модель OSI описывает основные передачи данных в сети.
Методология проверки, созданная на основе URM и AVM
Отключение вычисления пути данных, если оно не включено
Метод, используемый для поиска дефектов на пластине.
Способ улучшить пригодность для печати на пластинах путем изменения шаблонов масок.
Компании, занимающиеся упаковкой и тестированием интегральных схем, часто именуемые OSAT
. Способность литографического сканера точно выравнивать и печатать различные слои друг над другом.
Как полупроводники собираются и упаковываются.
Метод высокоскоростного кодирования сигнала.
Обнаружение выбросов для одного измерения, требование для автомобильной электроники.
Патент – это право интеллектуальной собственности, предоставленное изобретателю
Тонкая мембрана, предотвращающая загрязнение фотошаблона.
Память, хранящая информацию в аморфной и кристаллической фазах.
Шаблон того, что будет напечатано на пластине.
Светочувствительный материал, используемый для формирования рисунка на подложке.
Проектирование и реализация микросхемы, учитывающей их физическое размещение, маршрутизацию и артефакты.
PVD — это метод осаждения, который включает высокотемпературное вакуумное испарение и напыление.
Убедитесь, что дизайн-макет работает так, как задумано.
Набор уникальных функций, которые могут быть встроены в чип, но не клонированы.
Небольшая сота, мощность которой немного выше, чем у фемтосоты.
Снижение емкостных нагрузок на логику
Используемый алгоритм ATPG
Язык проверки оборудования, PSS, определен Accellera и используется для моделирования целей проверки при проектировании полупроводников.
Компоненты потребляемой мощности
Выключение и запуск домена питания
Определения терминов, связанных с мощностью
Перемещение энергии вокруг устройства.
Как оценивается энергопотребление
Снижение мощности путем отключения частей конструкции
Специальный флоп или защелка, используемый для сохранения состояния ячейки при отключении ее основного источника питания.
Добавление изоляторов вокруг энергоблоков
Снижение мощности на архитектурном уровне
Обеспечение полной проверки схемы управления питанием
Интегральная схема, которая управляет питанием в электронном устройстве или модуле, включая любое устройство с перезаряжаемой батареей.
Силовой полупроводник, используемый для управления и преобразования электроэнергии.
Силовая ИС используется в качестве переключателя или выпрямителя в силовых приложениях высокого напряжения.
Шум, передаваемый по сети электроснабжения
Контроль мощности для отключения питания
Методы анализа и оптимизации мощности в конструкции
Рекомендации по тестированию маломощных схем
Фундаментальные компромиссы в конструкции полупроводников по мощности, производительности и занимаемой площади.
Проектирование, проверка, сборка и испытание печатных плат
Центры обработки данных и ИТ-инфраструктура для хранения данных и вычислений, которыми владеет компания или на которые она подписана для использования только этой компанией.
методы оптимизации энергопотребления на уровне процессов
Изменчивость процесса производства полупроводников
Измерение количества времени, в течение которого ядра процессора активно используются.
Интегральная схема или часть ИС, выполняющая логическую и математическую обработку.
Язык проверки на основе формальной спецификации поведения
Хранение данных и вычисления выполняются в центре обработки данных с помощью услуги, предлагаемой поставщиком облачных услуг, и доступны через общедоступный Интернет.
Другой способ обработки данных с помощью кубитов.
RF SOI — это радиочастотная версия технологии кремний-на-изоляторе (SOI).
Случайный захват носителей заряда
Процесс быстрого нагрева вафель.
Критические металлы, используемые в электронике.
Из памяти только для чтения (ПЗУ) можно читать, но нельзя записывать.
Искусственная нейронная сеть, которая находит закономерности в данных, используя другие данные, хранящиеся в памяти.
Медно-металлические межсоединения, которые электрически соединяют одну часть корпуса с другой.
Проверка конструкции, которая помогает обеспечить надежность конструкции и снизить вероятность преждевременных или катастрофических электрических сбоев.
Материалы, используемые для изготовления ReRAM
Память с резистивным гистерезисом
Синоним фотомаски.
Предлагаемый стандарт тестовых данных, направленный на снижение нагрузки на инженеров-испытателей и на испытательные операции.
ISA с открытым исходным кодом, используемая при разработке интегральных схем по более низкой цене.
Надежная среда для безопасных функций.
Абстракция для определения цифровых частей проекта
Оптимизация энергопотребления на уровне передачи регистров
Ряд требований, которые необходимо выполнить перед переходом к этапу RTL
Методика проверки на основе Vera
Алгоритм решения задач
Дополнительная логика, которая соединяет регистры в сдвиговый регистр или цепочку сканирования для повышения эффективности тестирования.
Механизм сохранения стимула в тестовом стенде
Поддержка тестового стенда для SystemC
Форма двойного узора.
Предметы, связанные с производством полупроводников
Методы и технологии обеспечения безопасности данных.
Объединение входных данных от нескольких типов датчиков.
Датчики — это мост между аналоговым миром, в котором мы живем, и базовой коммуникационной инфраструктурой.
Система передачи, которая отправляет сигналы по высокоскоростному соединению от приемопередатчика на одном чипе к приемнику на другом. Приемопередатчик преобразует параллельные данные в последовательный поток данных, который повторно преобразуется в параллельный на принимающей стороне.
В процессе разработки полупроводников задачи, которые когда-то выполнялись последовательно, теперь должны выполняться одновременно.
Когда длина канала того же порядка, что и ширина обедненного слоя истока и стока, возникает ряд проблем, влияющих на конструкцию.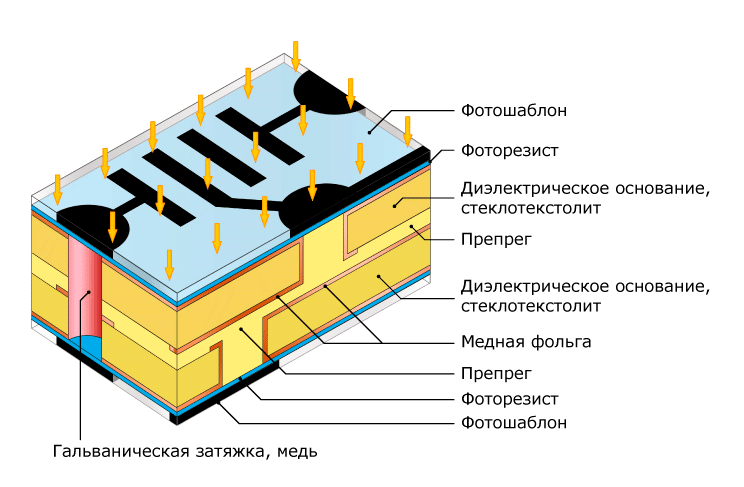
Шум квантования
Класс атак на устройство и его содержимое путем анализа информации с использованием различных методов доступа.
Широкозонная технология, используемая для полевых и полевых МОП-транзисторов для мощных транзисторов.
Интеграция фотонных устройств в кремний
Тренажерные упражнения модели технических средств
Аппаратное обеспечение специального назначения, используемое для ускорения процесса моделирования.
Нарушение напряжения заземления
Однотранзисторная динамическая память
Ячейки беспроводной связи, которые заполняют пробелы в беспроводной инфраструктуре.
Синтезируемый блок IP
Методика проверки с использованием встроенных процессоров
Определяет описание архитектуры, полезное для разработки программного обеспечения
Circuit Simulator, впервые разработанный в 70-х годах
Тип нейронной сети, которая пытается более точно смоделировать мозг.
Тип MRAM с отдельными путями для записи и чтения.
Безопасный метод беспроводной передачи данных.
Патент, который считается необходимым для реализации стандарта.
Наиболее часто используемый формат данных для информации об испытаниях полупроводников.
Стандарты важны в любой отрасли.
SRAM — энергозависимая память, не требующая обновления
Ограничения на вход для управления процессом генерации случайных чисел
Случайные величины, вызывающие появление дефектов на чипах во время литографии EUV.
Усовершенствованный тип MRAM
Использование смещения подложки
Сцепление через подложку.
Сетевые коммутаторы направляют трафик пакетов данных внутри сети.
Тип DRAM с более быстрой передачей
Метод объединения нескольких интегральных схем для совместной работы в качестве одного чипа.
Система на кристалле (SoC) представляет собой интеграцию функций, необходимых для реализации электронной системы на одной подложке и содержит как минимум один процессор
Библиотека классов, созданная на основе языка C++, используемого для моделирования оборудования
Аналоговые и смешанные расширения для SystemC
Стандартный для отрасли язык проектирования и проверки
Разработанный Google процессор ASIC для машинного обучения, который работает с экосистемой TensorFlow.
Программное обеспечение, используемое для функциональной проверки проекта
Шум, связанный с нагревом
Сквозные кремниевые переходы — это технология соединения различных кристаллов в многослойной конфигурации кристаллов.
Базовый строительный блок для аналоговых и цифровых схем.
Минимальное время переключения
Метод мультипаттерна, который потребуется на 10 нм и ниже.
Разрабатываемый тип транзистора, который может заменить finFET в технологических процессах будущего.
Стандарт для анализа безопасности и оценки автономных транспортных средств.
Стандарт совместимости унифицированного покрытия (UCIS) предоставляет интерфейс прикладного программирования (API), который позволяет обмениваться данными о покрытии между программными симуляторами, аппаратными ускорителями, символическим моделированием, формальными инструментами или пользовательскими инструментами проверки.
Унифицированный формат питания Accellera (UPF)
Методика проверки
SystemVerilog версия eRM
Пользовательские интерфейсы — это канал, который человек использует для связи с электронным устройством.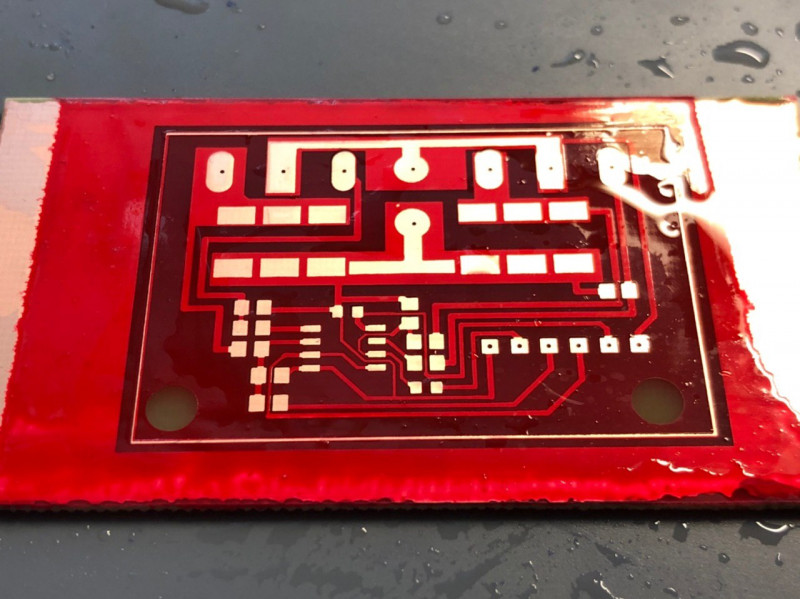
Патент на охрану изобретения
Язык проверки оборудования
Предварительно упакованный набор кода, используемый для проверки.
Стандартизированный способ проверки конструкций интегральных схем.
Документ, определяющий, какая функциональная проверка будет выполняться
Описание оборудования Язык используется с 1984 г.
Процедурный доступ к объектам Verilog
Аналоговые расширения для Verilog
Язык описания оборудования
Абстрактная модель аппаратной системы, обеспечивающая раннее выполнение программного обеспечения.
Методология проверки, разработанная Synopsys
Использование голоса/речи для управления устройством.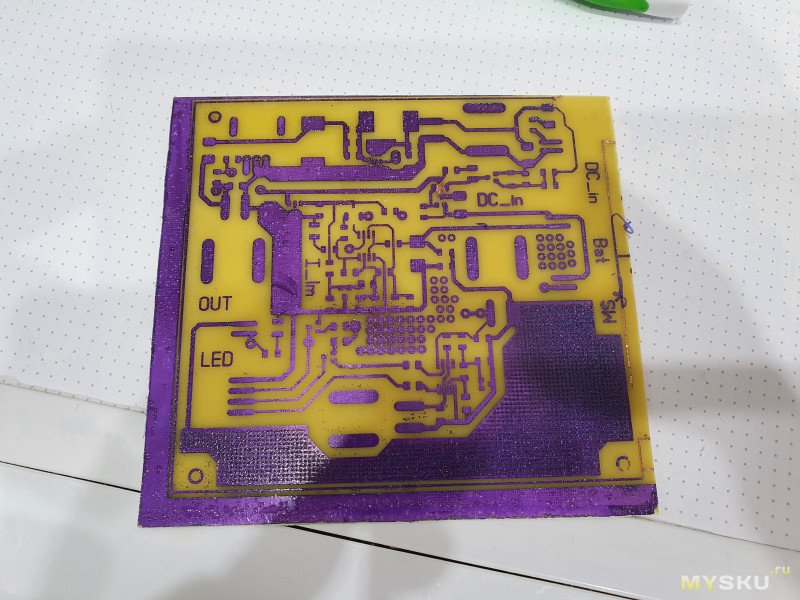
Память, которая теряет способность хранения при отключении питания.
Использование нескольких напряжений для снижения мощности
Базовая архитектура большинства современных вычислений, основанная на том принципе, что данные должны перемещаться между процессором и памятью.
Проверка и тестирование штампов на пластине после изготовления.
Наука обнаружения дефектов на кремниевой пластине.
Стандарт интерфейса памяти 3D
Проводная связь, при которой данные передаются по проводам между устройствами, по-прежнему считается наиболее стабильной формой связи.
Способ перемещения данных без проводов.
Архитектура межсоединений IC
X Распространение вызывает проблемы
Управляемая данными система для мониторинга и повышения производительности и надежности ИС.
Уязвимость в аппаратном или программном обеспечении продукта, обнаруженная исследователями или злоумышленниками, о которой компания-производитель не знает и поэтому еще не имеет исправления.
Управление согласием
Что такое фоторезист? | UniversityWafer, Inc.
Пластины, используемые для фоторезистаТехнология фоторезиста весьма увлекательна, но есть много способов ее использования, и может быть трудно понять, что делает каждый из них.
Фоторезист — это светочувствительный материал, используемый в нескольких процессах, включая фотолитографию, фотогравировку и травление фоторезиста. Каждый из этих процессов имеет свои уникальные преимущества и цели.
Поняв основы технологии фоторезиста, вы сможете лучше понять, как ее можно использовать в вашей отрасли. Наша команда в фоторезисте понимает эту технологию вдоль и поперек, поэтому мы здесь, чтобы помочь вам на каждом этапе пути.
См. пример ниже.
Получите предложение БЫСТРО!
Ваше имя:Компания:
Ваш адрес электронной почты:
Ваше сообщение:
Кварцевые подложки, используемые в фоторезисте
Ученый запросил следующее:
«Если я отправлю вам 4-дюймовую кварцевую пластину толщиной: 625 мкм с рисунком на одной стороне, то можете ли вы уменьшить толщину подложки с обратной стороны примерно до 50 мкм (или меньше) и Также нарежьте его кубиками до ~ 3 мм x 8 мм? Пожалуйста, дайте мне знать об ограничениях процесса утончения, чтобы мы могли соответствующим образом адаптировать наш дизайн. Если это возможно, пришлите мне предложение. Я могу отправить вам коробку с 9 образцами (изображение фиктивная коробка прилагается). Каждый образец представляет собой кварцевую подложку размером 3,5 мм x 7 мм x 625 мкм. На верхней части есть узоры Ti/Cr/Au. Мы хотим сохранить рисунок Au и уменьшить толщину подложки до толщины 50 мкм. Мы можем накрутить немного фоторезиста сверху, чтобы защитить поверхность».
Каждый образец представляет собой кварцевую подложку размером 3,5 мм x 7 мм x 625 мкм. На верхней части есть узоры Ti/Cr/Au. Мы хотим сохранить рисунок Au и уменьшить толщину подложки до толщины 50 мкм. Мы можем накрутить немного фоторезиста сверху, чтобы защитить поверхность».
UniversityWafer, Inc. Цитата:
Мы делаем все возможное, и, пожалуйста, сначала намотайте немного фоторезиста сверху, чтобы защитить поверхность, а затем вы можете отправить их нам, чтобы сделать пробный образец.
Цены указаны по номеру 266573.
Что такое фоторезист? Фоторезист — это светочувствительный материал, используемый в нескольких процессах, включая фотолитографию, фотогравировку и травление фоторезиста. Основное назначение фоторезиста – создание узорчатых покрытий на поверхности. Этот процесс чрезвычайно важен в электронной промышленности. Технология фоторезиста довольно увлекательна, и существует множество способов ее использования. Вот три способа.
Вот три способа.
Первый тип фоторезиста называется отрывным. Этот процесс наносит тонкие пленки на подложки в условиях чистой комнаты. Отрыв происходит перед осаждением и химическим травлением. Шаговый двигатель используется для проецирования изображения схемы на подложку. Свет проецируется через маску для создания негативного изображения. Второй процесс, инвертирование изображения, инвертирует тона позитивных фоторезистов, чтобы выявить основной рисунок.
Другой тип фоторезиста называется жидким фоторезистом. Сухой пленочный фоторезист известен как сухой пленочный фоторезист. Он используется в полупроводниках, плазменных дисплеях и печатных платах. Жидкий фоторезист более гибок, чем стандартная пленка, и лучше подходит для чувствительных приложений. Это универсальный материал, который можно использовать во многих приложениях, включая полупроводники и ЖК-дисплеи.
Фоторезист бывает разных видов в зависимости от области применения. Одни виды изготавливаются из жидкого фоторезиста, другие из тонкой пленки. Первый используется в полупроводниках, плазменных дисплеях и печатных платах, а сухой пленочный фоторезист используется в электронике. Это также распространенный материал в лазерной печати, поскольку он помогает уменьшить количество света, проходящего через подложку.
Первый используется в полупроводниках, плазменных дисплеях и печатных платах, а сухой пленочный фоторезист используется в электронике. Это также распространенный материал в лазерной печати, поскольку он помогает уменьшить количество света, проходящего через подложку.
Наиболее распространенной формой фоторезиста является позитив. Он чувствителен к ультрафиолетовому излучению и меняет свою химическую структуру. Обнаженные участки фоторезиста растворимы, а участки, не подвергавшиеся воздействию УФ-излучения, остаются нерастворимыми. Отрицательный тип используется в производстве полупроводников. Это тип ацетата, который позволяет изготавливать сложные детали. Основной материал изготовлен из кремния. Помимо полупроводников, он также используется для других приложений.
Фоторезисты бывают двух видов: сухие и жидкие. Последний представляет собой тонкую пленку, устойчивую к воздействию УФ-излучения. Жидкая форма используется в полупроводниках, а сухая пленка используется в плазменных дисплеях и печатных платах. Этот тип также используется в производстве электронных устройств. Другими словами, важны оба типа фоторезиста. Итак, что такое фоторезист? Существует множество различных применений этого химического вещества.
Этот тип также используется в производстве электронных устройств. Другими словами, важны оба типа фоторезиста. Итак, что такое фоторезист? Существует множество различных применений этого химического вещества.
Основная функция фоторезиста — сделать его совместимым со светочувствительными поверхностями. На рынке доступны различные типы фоторезистов. Самый распространенный – для формирования печатных плат. Это важно для микропроцессоров, полупроводников и плоских дисплеев. Изображение красной стрелки выполнено на черной части фоторезиста. Напротив, темный цвет фоторезиста виден только в ультрафиолетовом свете.
Позитивный фоторезист — светочувствительный материал. Его использование ограничено количеством возможных субстратов. Светочувствительный материал обычно наносят на поверхность фоторезиста. Для создания фотографии фоторезист должен подходить для желаемой подложки. Он также должен быть совместим с принтером. Однако он должен иметь возможность печатать высококачественное изображение.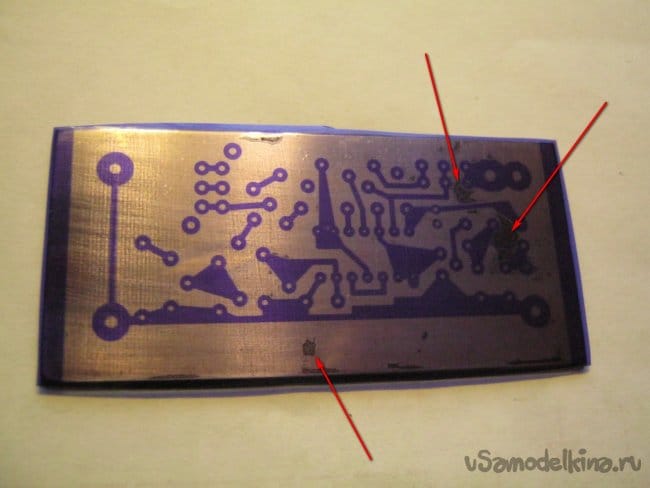
Чувствительность фоторезистов зависит от их чувствительности. Это вещество, которое позволит выявить открытые участки. В процессе очень важно использовать материал, чувствительный к ультрафиолетовому излучению, поскольку он может давать высококачественное изображение. Это важно, потому что он может быть чувствителен к ультрафиолетовому излучению, а это означает, что это тип материала, устойчивого к ультрафиолетовому излучению. На самом деле, единственный способ определить, достаточно ли хороши ваши фоторезисты, — это проверить их качество.
Фоторезисты, используемые в полупроводниках, представляют собой очень светочувствительные полимеры, которые изменяют свою структуру под воздействием излучения. Их прядут на подходящей для экспонирования поверхности. После этого они подвергаются воздействию радиации и могут образовывать тонкие слои. В результате высококачественный фоторезист может помочь в различных процессах обработки полупроводников. Следующие этапы будут использоваться при производстве фоторезистов.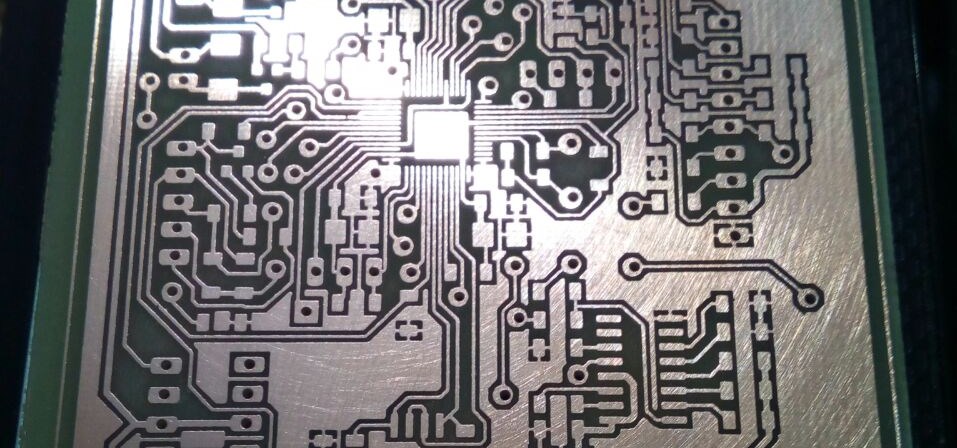
Видео: Фоторезист
Что такое инверсная литография и что она может дать в производстве полупроводников?Что такое инверсионная литография и что она может дать производству полупроводников? Давайте начнем с краткого обзора литографии, которую мы обсудим более подробно чуть позже. Фоторезист и подложки используются в производстве полупроводников. В этой статье мы поговорим о том, как можно использовать фоторезист и подложки в инверсионной литографии.
Что такое обратная литография Обратная литография — это процесс создания узоров на кремниевых чипах, начиная с желаемых элементов на пластине. Затем с помощью компьютерных алгоритмов создается фотошаблон, воспроизводящий эти функции. До недавнего времени этот процесс был непрактичным и слишком трудоемким для продвинутых производителей микросхем. Но с появлением новых технологий это меняется. ILT теперь предлагает решение проблемы маленькой несовершенной маски.
Инверсионная литография основана на методах установки уровней, объединенных с процессом инверсии. Этот метод используется для вставки SRAF там, где они необходимы, не затрагивая целевой шаблон или основной шаблон. Это позволяет полупроводниковым компаниям печатать более сложные и продвинутые микросхемы без необходимости модернизации своего оборудования. Результирующее изображение может содержать бесконечное количество одинаковых контуров резиста.
Литография в производстве полупроводников Технология обратной литографии (ILT) может значительно ускорить процесс изготовления полупроводниковых микросхем. Этот новый метод начинается с желаемых функций на пластине и вычисляет точную форму фотошаблона, необходимую для достижения этих функций. Традиционный литографический метод создания макетов микросхем оказался слишком трудоемким для опытных производителей микросхем. Однако новый метод может сократить время, необходимое для выполнения этого важного шага, до одного дня.
В настоящее время дизайн ИС по-прежнему выполняется с использованием литографии с длиной волны 193 нм. Однако были разработаны новые методы для смягчения изменений процесса, вызванных этой новой технологией. В частности, литографический зазор, вызывающий серьезные искажения из-за оптической дифракции, наносит серьезный ущерб производительности. Следовательно, необходима полная смена парадигмы в дизайне макетов. Но как это можно реализовать?
ПодложкиТехнология обратной литографии (ИЛ) помогает расширить границы литографии, улучшая разрешение и воспроизводимость. Традиционные методы ILT трудоемки и неточны, но новый параллельный метод, ориентированный на плавное слияние, быстр, точен и может учитывать окружающую среду. Это особенно важно для крупносерийного производства в полупроводниковой промышленности. Этот метод также идеально подходит для сложных конструкций устройств, где необходимо оптимизировать размер и сложность отдельных слоев.
Технология обратной литографии основана на применении плазменной обработки поверхности. Этот процесс работает, обеспечивая непрерывное синхронное движение платформы пластины и сетки сетки во время экспонирования пластины. Одна компания, Canon, разработала технологию управления синхронизацией, позволяющую достичь точности позиционирования менее нанометра. В нем используется легкая и жесткая платформа для многократного ускорения платформы сетки со скоростью 12 G, что обеспечивает высокую производительность.
Этот процесс работает, обеспечивая непрерывное синхронное движение платформы пластины и сетки сетки во время экспонирования пластины. Одна компания, Canon, разработала технологию управления синхронизацией, позволяющую достичь точности позиционирования менее нанометра. В нем используется легкая и жесткая платформа для многократного ускорения платформы сетки со скоростью 12 G, что обеспечивает высокую производительность.
Настоящее изобретение относится к многослойному просветляющему покрытию для полупроводникового производства фоторезистов. По мере развития технологий производители полупроводников все чаще ищут новые способы минимизации стоячих волн в фоторезистах. Закон Мура гласит, что количество транзисторов и других электронных устройств на единицу площади удваивается каждые 18-24 месяца. Этот быстрый рост является результатом усовершенствований конструкции, включая уменьшение минимальных размеров элементов. В настоящее время самые маленькие полупроводниковые устройства имеют размер 0,15 микрона или меньше.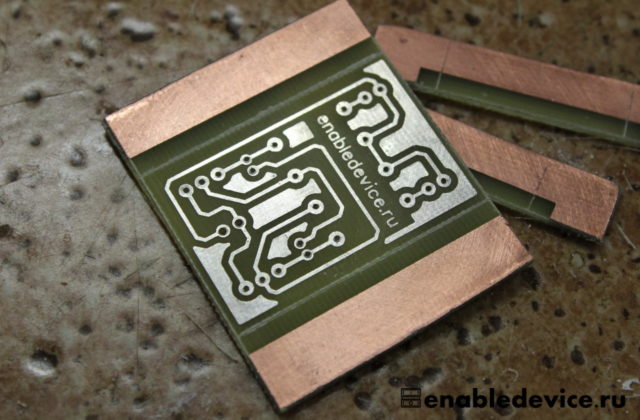
В инверсионной литографии слой фоторезиста 120 содержит тонкий слой полупроводникового материала. Этот слой имеет высокоинтенсивное антибликовое покрытие, которое помогает уменьшить отражения. Этот новый тип покрытия используется при изготовлении высококачественных устройств. Однако важно отметить, что слои фоторезиста трудно удалить после высыхания. 19инструменты 3iPL. Ключ к этому процессу заключается в его способности генерировать почти нулевые отходы, поскольку используется лишь часть объема фоторезиста. Высококачественный мелкосерийный процесс является привлекательным вариантом для производителей полупроводников, и в конечном итоге он принесет пользу существующим компаниям-производителям полупроводников и поставщикам.
Инверсионная литография — одна из самых многообещающих технологий повышения разрешения, поскольку она может довести литографию до предела. Существующие методы ILT трудоемки и неточны, но новый параллельный метод, ориентированный на плавное слияние, быстр и точен и учитывает изменения окружающей среды. Эта технология может произвести революцию в производстве полупроводников. Но это вызов, который нужно преодолеть. Вот некоторые из проблем внедрения технологии:
Эта технология может произвести революцию в производстве полупроводников. Но это вызов, который нужно преодолеть. Вот некоторые из проблем внедрения технологии:
Видео: Технология инверсной литографии
определение фоторезиста в The Free Dictionary
Также найдено в: Thesaurus, Medical, Encyclopedia, Wikipedia.
Связанный с фоторезистом: фотолитография
(ˌfəʊtəʊrɪˈzɪst)n
1. (Ремесла) материал, чувствительный к свету, который используется в промышленных процессах, таких как химическое травление интегральных схем и гравировка (Химия) материал, чувствительный к свету, который используется в промышленных процессах, таких как химическое травление интегральных схем и гравировка. 2003, 2006, 2007, 2009, 2011, 2014
Ссылки в архиве периодических изданий ?
Ведущий поставщик фоторезистов Tokyo Ohka Kogyo (4186.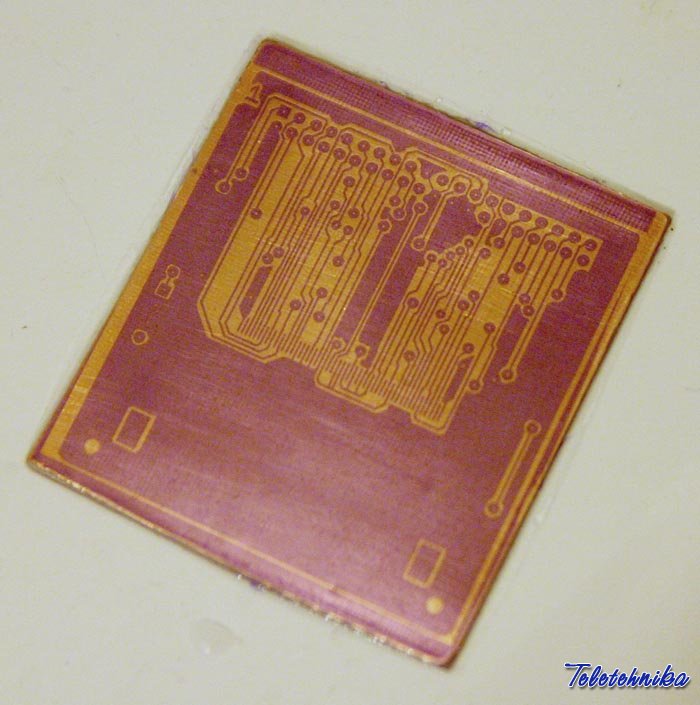 T) говорит, что на разработку новых резистов уходит до двух лет.
T) говорит, что на разработку новых резистов уходит до двух лет.
Японские ограничения на экспорт высокотехнологичных материалов в Южную Корею могут иметь неприятные последствия Вместе в 2018 г.
Глобальный и китайский отчет по индустрии фоторезистов, 2019–2025 гг.: JSR, TOK, DOW и Fujifilm владеют более 70% рынка вместе в 2018 г.
Они включают фторированный полиимид, фоторезист и фтористый водород, SK hynix, дисплей Samsung и дисплей LG.
Технологические компании Южной Кореи стремятся к локализации и диверсификации на фоне обостряющегося торгового спора
Он позволит отображать резист на 300-миллиметровых пластинах с шагом 8 нм, в дополнение к наноразмерным характеристикам сложных материалов с временным разрешением и таким процессам, как радиационная химия фоторезиста , двумерные материалы, наноструктурированные системы и устройства, а также возникающие квантовые материалы.
Промышленное предприятие Imec/KMLabs исследует литографию до шага 8 нм
Заявление было сделано после того, как во вторник местная газета сообщила, что американская химическая корпорация Dow Chemical является поставщиком некачественных фоторезистивных материалов.
Компания TSMC требует компенсации за дефектное сырье.
Каждая точка наносится непосредственно на пластину фоторезиста путем интерференции лазерных лучей, создающих интерференционную картину в каждой точке.
Origination Technologies (Часть 2)
Медные поверхности перфорированной панели обычно покрываются тонким слоем фоторезиста. Каждая сторона затем подвергается воздействию УФ-излучения через фотопленку или фотошаблон, который детализирует оптически негативный рисунок следов, указанный разработчиком для этого слоя.
Основы производства печатных плат, часть II: обзор процесса изготовления многослойных печатных плат позитивного фоторезиста на основе фоточувствительного полиимида, процесс фотолитографии нанесения рисунка BM поверх рисунка PDL будет исключен.
Полиимиды с боковыми цепями в качестве связующих полимеров для фотолитографического формирования рисунка черного пиксельного определяющего слоя для органического светоизлучающего диода
Олбани, штат Нью-Йорк, 20 мая 2017 г.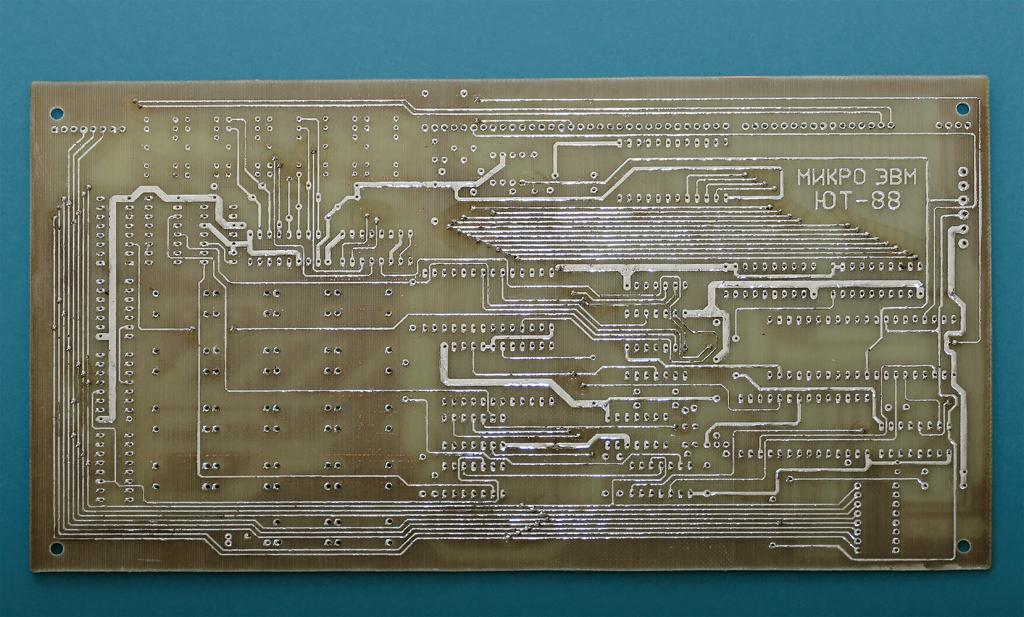 — (PR.com) — В последнее время доходы рынка цветных фоторезистов значительно выросли из-за быстрого роста числа пользователей мобильных телефонов.
— (PR.com) — В последнее время доходы рынка цветных фоторезистов значительно выросли из-за быстрого роста числа пользователей мобильных телефонов.
Мировая индустрия цветных фоторезистов: основные тенденции рынка, развитие и прогноз Обзор до 2021 года
Оборудование для снятия фоторезистов используется для удаления остатков фоторезистов с кремниевых пластин после их травления в процессе изготовления полупроводниковых чипов.
Новый отчет об исследовании рынка: мировой рынок снятия фоторезиста с полупроводников, 2016–2020 гг.
Процесс ручного нанесения фоторезиста методом центрифугирования на такую пластину с использованием стандартного оборудования, установленного в исследовательском центре, может привести к изменению толщины пленки в радиальном направлении.
Быстрое прототипирование нанофлюидных прорезей в двухслойном силиконе
Браузер словарей ?
- ▲
- фотопигмент
- изготовление фотопластинок
- фотоплей
- фотополимер
- фотопозитив
- фотопринт
- photoproduct
- photoproduction
- photopsia
- Photopsy
- photoreaction
- photorealism
- photorealistic
- photoreception
- photoreceptive
- photoreceptor
- photoreceptors
- photoreconnaisance
- photoreconnaissance
- photoreduce
- photoreduction
- photorefractive
- фоторефракционная кератэктомия
- фотоомоложение
- Photorelief
- photoresist
- photoresistor
- photorespiration
- photoretinitis
- Photos
- photoscan
- Photoscope
- Photoscopic
- Photosculpture
- photosensitise
- photosensitive
- photosensitivity
- photosensitization
- photosensitize
- photosensitizer
- фотосенсор
- фотосет
- фотосет
- Обмен фотографиями
- Photoshoot
- Photoshop
- PhotoSphes
- Photospher
- Photostat
- Photostat Machine
- Photosynthate
- ▼ 8
- Photosynthate
- ▼ 68
- ighles Полный браузер ?
Как печатные платы из фоторезиста положительно влияют на производство электроники
Печатные платы из фоторезиста играют решающую роль в производстве электронных устройств.
Что такое фоторезист? Кроме того, фоторезист является важным материалом, используемым в печатных платах. В этой статье мы попытаемся объяснить все, что вам нужно знать о фоторезистивных печатных платах.
Кроме того, фоторезист является важным материалом, используемым в печатных платах. В этой статье мы попытаемся объяснить все, что вам нужно знать о фоторезистивных печатных платах.Фоторезист — важный материал, используемый для изготовления печатных плат. Также этот материал светочувствителен и широко применяется в фотогравюре и фотолитографии. Фоторезист представляет собой базовый материал, состоящий из растворителя, сенсибилизатора и полимера.
Каждый из этих элементов играет решающую роль. Например, растворитель позволяет фоторезисту вращаться и создавать тонкие слои на поверхности. Сенсибилизатор регулирует фотохимическую реакцию на полимерной стадии. Кроме того, полимер изменяет структуру фоторезиста под воздействием излучения.
Кроме того, фоторезист играет важную роль в производстве ИС-устройств. Развитие фоторезиста и фотолитографии позволяет уменьшить размеры схем. Фоторезист служит основным этапом изготовления печатных плат.

Кроме того, это форма покрытия, которая меняется под воздействием УФ-излучения. Кроме того, этот материал выступает в качестве маскирующего слоя при травлении. Кроме того, фоторезист в основном классифицируется как негативный и позитивный.
Негатив фоторезистВ негативном фоторезисте часть фоторезиста, подвергающаяся воздействию света, нерастворима. Проявитель фоторезиста растворяет неэкспонированную часть фоторезиста. В этом типе фоторезиста воздействие УФ-излучения приводит к полимеризации фоторезиста. Следовательно, негативный резист находится на поверхности подложки. Также проявитель фоторезиста устраняет неэкспонированные участки.
Позитивный фоторезистЗдесь полимер ослабляется из-за фотохимической реакции при воздействии света. Следовательно, это делает его более растворимым. Неэкспонированная часть фоторезиста не растворяется в проявителе.
Как негативные, так и позитивные фоторезисты играют решающую роль в производстве печатных плат.
 Негативные фоторезисты имеют более короткое время обработки. Также они имеют хорошую адгезию к силикону. Однако позитивные фоторезисты термически стабильны. Кроме того, они имеют лучшее разрешение.
Негативные фоторезисты имеют более короткое время обработки. Также они имеют хорошую адгезию к силикону. Однако позитивные фоторезисты термически стабильны. Кроме того, они имеют лучшее разрешение.Запросить производство и сборку печатных плат
Что такое фоторезистивная печатная плата?Печатная плата с фоторезистом — это высококачественная печатная плата с фоторезистивным покрытием, идеально подходящая для различных применений. Эта печатная плата идеально подходит для изготовления двусторонних печатных плат. Все материалы, используемые для фоторезистивных печатных плат, высокого качества. При изготовлении фоторезистивных печатных плат используется ультрафиолетовое излучение. Фоторезист на этой печатной плате содержит краситель. Этот краситель обеспечивает хороший контраст с медью. Поэтому светонепроницаемая синяя пленка защищает печатную плату. Следовательно, вы можете гильотинировать, не разрушая фотореист.
Печатная плата с фоторезистом имеет синее пленочное покрытие, обеспечивающее защиту от света.
 Следовательно, это позволяет обрабатывать доску до снятия пленки в течение дня. Плата фоторезиста защищает медь. Печатная плата с фоторезистом покрывается погружением позитивного фоторезиста.
Следовательно, это позволяет обрабатывать доску до снятия пленки в течение дня. Плата фоторезиста защищает медь. Печатная плата с фоторезистом покрывается погружением позитивного фоторезиста.Кроме того, фоторезистивная печатная плата является термически стабильной. Также эта печатная плата имеет хорошую диэлектрическую проницаемость и коэффициент теплового расширения. Таким образом, эта печатная плата обладает отличными электрическими и тепловыми свойствами. Печатная плата с фоторезистом — это светочувствительная печатная плата, идеально подходящая для использования в нескольких приложениях. Кроме того, эта печатная плата имеет большие преимущества.
Процесс изготовления печатной платы из фоторезистаСхематический чертеж
Вам необходимо нарисовать схему печатной платы B. Есть несколько схематических программ, которые могут помочь вам в этом. Нарисовав макет и схему, распечатайте макет. Включите переходы, верхний слой, размер и контактные площадки, чтобы напечатать нужную плату.
 После того, как макет будет готов к печати, убедитесь, что тексты указаны правильно после переноса его на доску.
После того, как макет будет готов к печати, убедитесь, что тексты указаны правильно после переноса его на доску.Воздействие УФ-излучения
Здесь предварительно сенсибилизированная плата должна подвергаться воздействию УФ-излучения. Поместите напечатанную пленку на пластик над светодиодами. Убедитесь, что чернила направлены вверх. Снимите белую пленку с предварительно сенсибилизированной печатной платы. Кроме того, это обнажит фоторезист. После этого поместите печатную плату на прозрачную пленку так, чтобы фоторезист был обращен к светодиодам. Убедитесь, что вы прижимаете фоторезист к чернилам на прозрачной пленке.
Включите УФ-светильник. Такой же вид фоторезист будет иметь после воздействия УФ-излучения. Кроме того, вы не сможете отличить незащищенную плату от открытой.
Подготовка раствора проявителя
Здесь вы подготовите раствор проявителя. Убедитесь, что вы тщательно перемешали раствор, прежде чем поместить плату в раствор.
 Для замешивания раствора рекомендуется использовать водопроводную воду. После этого встряхните печатную плату. Части фоторезиста, подвергшиеся воздействию УФ-излучения, смоются. Не оставляйте плату в растворе слишком долго. Кроме того, в противном случае фоторезист смоется. Поместите плату в холодную воду, чтобы остановить реакцию.
Для замешивания раствора рекомендуется использовать водопроводную воду. После этого встряхните печатную плату. Части фоторезиста, подвергшиеся воздействию УФ-излучения, смоются. Не оставляйте плату в растворе слишком долго. Кроме того, в противном случае фоторезист смоется. Поместите плату в холодную воду, чтобы остановить реакцию.Травление меди
Раствор перекиси водорода и соляной кислоты поможет удалить медь.
Удаление фоторезиста
Используйте ватную палочку и ацетон для удаления фоторезиста. Также легко снимается фоторезист. Используйте ватные палочки, пока они не станут белыми.
Заполнение печатной платы
Здесь вам нужно будет заполнить печатную плату различными компонентами.
Запросить стоимость изготовления и сборки печатных плат сейчас
Химическая структура фоторезистаОднако фоторезисты делятся на три категории в зависимости от их химической структуры.

Фотосшивка
Это фоторезист, который может сшиваться под действием света. Он может образовывать неразрешимую сеть. Также этот вид фоторезиста идеален для негативного фоторезиста.
Фотополимерный
Это фоторезист, который может образовывать свободные радикалы под действием света. Кроме того, он начинает сополимеризацию мономера с образованием полимера. Однако этот тип фоторезиста полезен для негативного фоторезиста.
Фоторазлагающийся
Фоторазлагающийся фоторезист под воздействием света образует гидрофильные продукты. Также этот тип фоторезиста идеален для позитивного фоторезиста. Примером такого фоторезиста является азид хинин.
Часто задаваемые вопросыКак удалить фоторезист?
Фоторезист можно удалить тремя способами. Использование органического растворителя может помочь удалить фоторезист.
 Кроме того, еще один способ удалить его — использовать некоторые неорганические растворители. Здесь органический углерод в фоторезисте окисляется до углекислого газа и удаляется. Последний метод заключается в использовании плазмы для удаления фоторезиста.
Кроме того, еще один способ удалить его — использовать некоторые неорганические растворители. Здесь органический углерод в фоторезисте окисляется до углекислого газа и удаляется. Последний метод заключается в использовании плазмы для удаления фоторезиста.Где фоторезистивная печатная плата идеальна для использования?
Печатная плата с фоторезистом идеальна для использования в различных областях. Эта печатная плата используется в бытовой электронике, медицинских устройствах и многом другом.
ЗаключениеВ этой статье представлена подробная информация о фоторезистивных печатных платах. Обсуждалось, как изготавливать фоторезистивные печатные платы. Кроме того, речь шла о различных видах фоторезиста.
Основы микролитографии
Изготовление интегральной схемы (ИС) требует множества физических и химических процессов, выполняемых на полупроводниковой (например, кремниевой) подложке. В общем, различные процессы, используемые для изготовления ИС, делятся на три категории: осаждение пленки, формирование рисунка и легирование полупроводников.
 Для соединения и изоляции транзисторов и их компонентов используются пленки как проводников (таких как поликремний, алюминий, а в последнее время и меди), так и изоляторов (различные формы диоксида кремния, нитрида кремния и др.). Селективное легирование различных областей кремния позволяет изменять проводимость кремния при приложении напряжения. Создавая структуры из этих различных компонентов, можно построить миллионы транзисторов и соединить их вместе, чтобы сформировать сложную схему современного микроэлектронного устройства. Основой всех этих процессов является литография, т. е. формирование объемных рельефных изображений на подложке для последующего переноса рисунка на подложку.
Для соединения и изоляции транзисторов и их компонентов используются пленки как проводников (таких как поликремний, алюминий, а в последнее время и меди), так и изоляторов (различные формы диоксида кремния, нитрида кремния и др.). Селективное легирование различных областей кремния позволяет изменять проводимость кремния при приложении напряжения. Создавая структуры из этих различных компонентов, можно построить миллионы транзисторов и соединить их вместе, чтобы сформировать сложную схему современного микроэлектронного устройства. Основой всех этих процессов является литография, т. е. формирование объемных рельефных изображений на подложке для последующего переноса рисунка на подложку.Слово литография происходит от греческого lithos , что означает камни, и graphia , что означает писать. Это буквально означает писать на камнях. В случае полупроводниковой литографии (также называемой фотолитографией) наши камни представляют собой кремниевые пластины, а наши узоры пишутся с помощью светочувствительного полимера, называемого фоторезистом.
 Чтобы построить сложные структуры, из которых состоит транзистор, и множество проводов, соединяющих миллионы транзисторов схемы, этапы литографии и переноса шаблона травления повторяются не менее 10 раз, но чаще всего они выполняются от 20 до 30 раз для создания одной схемы. . Каждый рисунок, напечатанный на пластине, выравнивается с ранее сформированными узорами, и медленно формируются проводники, изоляторы и выборочно легированные области для формирования конечного устройства.
Чтобы построить сложные структуры, из которых состоит транзистор, и множество проводов, соединяющих миллионы транзисторов схемы, этапы литографии и переноса шаблона травления повторяются не менее 10 раз, но чаще всего они выполняются от 20 до 30 раз для создания одной схемы. . Каждый рисунок, напечатанный на пластине, выравнивается с ранее сформированными узорами, и медленно формируются проводники, изоляторы и выборочно легированные области для формирования конечного устройства.Важность литографии можно оценить двумя способами. Во-первых, из-за большого количества этапов литографии, необходимых при производстве ИС, на литографию обычно приходится около 30 процентов стоимости производства. Во-вторых, литография, как правило, является техническим ограничителем для дальнейшего прогресса в уменьшении размеров элементов и, следовательно, скорости транзисторов и площади кремния. Очевидно, что при разработке процесса литографии необходимо тщательно понимать компромисс между стоимостью и возможностями.
 Хотя литография, безусловно, не единственный технически важный и сложный процесс в процессе производства ИС, исторически достижения в области литографии ограничивали рост стоимости и производительности ИС.
Хотя литография, безусловно, не единственный технически важный и сложный процесс в процессе производства ИС, исторически достижения в области литографии ограничивали рост стоимости и производительности ИС.Оптическая литография — это в основном фотографический процесс, при котором светочувствительный полимер, называемый фоторезистом, экспонируется и проявляется для формирования трехмерных рельефных изображений на подложке. Как правило, идеальное фоторезистивное изображение имеет точную форму задуманного или предполагаемого рисунка в плоскости подложки с вертикальными стенками, проходящими через толщину резиста. Таким образом, окончательный рисунок резиста является бинарным: части подложки покрыты резистом, а другие части полностью непокрыты. Этот бинарный шаблон необходим для переноса шаблона, поскольку части подложки, покрытые резистом, будут защищены от травления, ионной имплантации или других механизмов переноса шаблона.
Общая последовательность этапов обработки для типичного процесса фотолитографии выглядит следующим образом: подготовка подложки, центрифугирование фоторезиста, предварительный отжиг, экспонирование, отжиг после экспонирования, проявление и последующий отжиг.
 Полоска резиста является последней операцией в литографическом процессе после того, как рисунок резиста был перенесен на нижележащий слой. Эта последовательность схематически показана на рис.0866 литографический кластер . Ниже приводится краткое обсуждение каждого шага с указанием некоторых практических вопросов, связанных с обработкой фоторезиста. Более подробно эти темы будут подробно рассмотрены в последующих главах.
Полоска резиста является последней операцией в литографическом процессе после того, как рисунок резиста был перенесен на нижележащий слой. Эта последовательность схематически показана на рис.0866 литографический кластер . Ниже приводится краткое обсуждение каждого шага с указанием некоторых практических вопросов, связанных с обработкой фоторезиста. Более подробно эти темы будут подробно рассмотрены в последующих главах.1. Подготовка подложки
Подготовка подложки предназначена для улучшения адгезии фоторезистивного материала к подложке. Это достигается одним или несколькими из следующих процессов: очистка подложки для удаления загрязнений, обезвоживание для удаления воды и добавление усилителя адгезии. Загрязнение подложки может иметь форму частиц или пленки и может быть как органическим, так и неорганическим. Частицы приводят к дефектам окончательного рисунка резиста, в то время как загрязнение пленки может вызвать плохую адгезию и последующую потерю контроля над шириной линии.
 Твердые частицы обычно образуются из переносимых по воздуху частиц или загрязненных жидкостей (например, грязный усилитель адгезии). Наиболее эффективным способом контроля загрязнения твердыми частицами является устранение их источника. Поскольку это не всегда практично, для удаления частиц используется химическая/механическая очистка. Органические пленки, такие как масла или полимеры, могут образовываться из вакуумных насосов и другого оборудования, кожных масел и пота, а также из различных полимерных отложений, оставшихся после предыдущих этапов обработки. Эти пленки обычно можно удалить с помощью химической, озоновой или плазменной очистки. Точно так же неорганические пленки, такие как природные оксиды и соли, могут быть удалены с помощью химической или плазменной очистки. Один тип загрязняющих веществ – адсорбированная вода – легче всего удаляется с помощью высокотемпературного процесса, называемого 9.0866 выпечка обезвоживания .
Твердые частицы обычно образуются из переносимых по воздуху частиц или загрязненных жидкостей (например, грязный усилитель адгезии). Наиболее эффективным способом контроля загрязнения твердыми частицами является устранение их источника. Поскольку это не всегда практично, для удаления частиц используется химическая/механическая очистка. Органические пленки, такие как масла или полимеры, могут образовываться из вакуумных насосов и другого оборудования, кожных масел и пота, а также из различных полимерных отложений, оставшихся после предыдущих этапов обработки. Эти пленки обычно можно удалить с помощью химической, озоновой или плазменной очистки. Точно так же неорганические пленки, такие как природные оксиды и соли, могут быть удалены с помощью химической или плазменной очистки. Один тип загрязняющих веществ – адсорбированная вода – легче всего удаляется с помощью высокотемпературного процесса, называемого 9.0866 выпечка обезвоживания .При обезвоживании, как следует из названия, вода удаляется с поверхности субстрата путем запекания при температуре от 200°C до 400°C, обычно в течение 30-60 минут.
 Затем подложке дают остыть (предпочтительно в сухой среде) и как можно скорее наносят покрытие. Важно отметить, что вода будет повторно адсорбироваться на поверхности подложки, если оставить ее во влажной (не сухой) среде. Дегидратация также эффективна для удаления органических загрязнителей и дополнительной очистки субстрата. Часто обычная последовательность этапов обработки включает какой-либо высокотемпературный процесс непосредственно перед нанесением фоторезиста, например, термическое окисление. Если на подложку наносится покрытие сразу же после высокотемпературной стадии, обезвоживания можно избежать. Однако типичная дегидратационная прокалка не полностью удаляет воду с поверхности подложек из диоксида кремния (включая кремний, поликремний, оксид кремния и нитрид кремния). Поверхностные атомы кремния прочно связываются с монослоем воды, образуя силанольные группы (SiOH). Для удаления этого последнего слоя воды требуется температура обжига выше 600°C [1.1]. Кроме того, силанол быстро восстанавливается при охлаждении подложки в несухой среде.
Затем подложке дают остыть (предпочтительно в сухой среде) и как можно скорее наносят покрытие. Важно отметить, что вода будет повторно адсорбироваться на поверхности подложки, если оставить ее во влажной (не сухой) среде. Дегидратация также эффективна для удаления органических загрязнителей и дополнительной очистки субстрата. Часто обычная последовательность этапов обработки включает какой-либо высокотемпературный процесс непосредственно перед нанесением фоторезиста, например, термическое окисление. Если на подложку наносится покрытие сразу же после высокотемпературной стадии, обезвоживания можно избежать. Однако типичная дегидратационная прокалка не полностью удаляет воду с поверхности подложек из диоксида кремния (включая кремний, поликремний, оксид кремния и нитрид кремния). Поверхностные атомы кремния прочно связываются с монослоем воды, образуя силанольные группы (SiOH). Для удаления этого последнего слоя воды требуется температура обжига выше 600°C [1.1]. Кроме того, силанол быстро восстанавливается при охлаждении подложки в несухой среде. Поскольку этот подход нецелесообразен, предпочтительным методом удаления этого силанола являются химические средства.
Поскольку этот подход нецелесообразен, предпочтительным методом удаления этого силанола являются химические средства.Рис. 1-1. Пример типичной последовательности этапов литографической обработки (в данном случае без запекания после экспонирования), проиллюстрированный для положительного резиста.
Усилители адгезии используются для химической реакции с силанолом на поверхности и замены группы -OH на органическую функциональную группу, которая, в отличие от гидроксильной группы, обеспечивает хорошую адгезию к фоторезисту. Для этой цели часто используют силаны, наиболее распространенным из которых является гексаметилдисилизан (ГМДС) [1.2]. (Следует отметить, что усиление адгезии ГМДС было впервые разработано для применений из стекловолокна, где важна адгезия смоляной матрицы к стеклянным волокнам.) ГМДС можно наносить путем прядения разбавленного раствора (10-20% ГМДС в ацетате целлозольва, ксилоле , или фторуглерод) непосредственно на пластину и позволяя HMDS высохнуть (HMDS довольно летуч при комнатной температуре).
 Если HMDS не высохнет должным образом, это приведет к резкой потере адгезии. Хотя прямое прядение легко, оно эффективно только для вытеснения небольшого процента силанольных групп. На сегодняшний день предпочтительным методом нанесения усилителя адгезии является воздействие на подложку паров ГМДС, обычно при повышенных температурах и пониженном давлении. Это обеспечивает хорошее покрытие подложки без избыточного осаждения ГМДС, а более высокие температуры вызывают более полную реакцию с силанольными группами. После правильной обработки ГМДС субстрат можно оставить на несколько дней без существенной повторной адсорбции воды. Выполнение обезвоживания и заправки паром в одной и той же печи обеспечивает оптимальную производительность.
Если HMDS не высохнет должным образом, это приведет к резкой потере адгезии. Хотя прямое прядение легко, оно эффективно только для вытеснения небольшого процента силанольных групп. На сегодняшний день предпочтительным методом нанесения усилителя адгезии является воздействие на подложку паров ГМДС, обычно при повышенных температурах и пониженном давлении. Это обеспечивает хорошее покрытие подложки без избыточного осаждения ГМДС, а более высокие температуры вызывают более полную реакцию с силанольными группами. После правильной обработки ГМДС субстрат можно оставить на несколько дней без существенной повторной адсорбции воды. Выполнение обезвоживания и заправки паром в одной и той же печи обеспечивает оптимальную производительность.2. Покрытие фоторезистом
Тонкое, однородное покрытие фоторезиста определенной, хорошо контролируемой толщины достигается с помощью кажущегося простым процесса покрытия центрифугированием. Фоторезист, переведенный в жидкую форму путем растворения твердых компонентов в растворителе, выливается на пластину, которая затем вращается на поворотном столе с высокой скоростью, создавая желаемую пленку.
 Строгие требования к контролю толщины и однородности, а также низкая плотность дефектов требуют особого внимания к этому процессу, где большое количество параметров может иметь существенное влияние на однородность и контроль толщины фоторезиста. Существует выбор между статической дозировкой (пластина неподвижна, пока дозируется резист) или динамической дозировкой (пластина вращается, пока дозируется резист), скоростью и временем отжима, а также ускорением для каждой из скоростей отжима. Кроме того, объем наносимого резиста и свойства резиста (такие как вязкость, процент твердого вещества и состав растворителя) и подложки (материал подложки и топография) играют важную роль в однородности толщины резиста. Кроме того, практические аспекты операции прядения, такие как вытяжка, контроль температуры и влажности, а также чистота прядильной машины, часто оказывают существенное влияние на резистивную пленку. На рис. 1-2 показан стандартный цикл нанесения фоторезиста методом центрифугирования. В конце этого цикла толстая, богатая растворителем пленка фоторезиста покрывает пластину, готовую к выпеканию после нанесения.
Строгие требования к контролю толщины и однородности, а также низкая плотность дефектов требуют особого внимания к этому процессу, где большое количество параметров может иметь существенное влияние на однородность и контроль толщины фоторезиста. Существует выбор между статической дозировкой (пластина неподвижна, пока дозируется резист) или динамической дозировкой (пластина вращается, пока дозируется резист), скоростью и временем отжима, а также ускорением для каждой из скоростей отжима. Кроме того, объем наносимого резиста и свойства резиста (такие как вязкость, процент твердого вещества и состав растворителя) и подложки (материал подложки и топография) играют важную роль в однородности толщины резиста. Кроме того, практические аспекты операции прядения, такие как вытяжка, контроль температуры и влажности, а также чистота прядильной машины, часто оказывают существенное влияние на резистивную пленку. На рис. 1-2 показан стандартный цикл нанесения фоторезиста методом центрифугирования. В конце этого цикла толстая, богатая растворителем пленка фоторезиста покрывает пластину, готовую к выпеканию после нанесения.
Хотя существует теория, реологически описывающая процесс центрифугирования, на практике изменение толщины и однородности фоторезиста в зависимости от параметров процесса необходимо определять экспериментально. Кривая скорости отжима фоторезиста (рис. 1-3) является важным инструментом для настройки скорости отжима для получения желаемой толщины резиста. Окончательная толщина резиста зависит от квадратного корня из скорости вращения и примерно пропорциональна вязкости жидкого фоторезиста.
Рис. 1-2. Наглядное изображение простого цикла нанесения фоторезиста методом центрифугирования. Если w 1 > 0, дозирование называется динамическим.
Рис. 1-3. Кривые скорости вращения фоторезиста для различных вязкостей резиста, показывающие, как изменяется толщина резиста в зависимости от скорости вращения в степени -1/2.
3. Отверждение после нанесения
После нанесения покрытия резистивная пленка будет содержать от 20 до 40% растворителя по весу.
 Процесс запекания после нанесения, также называемый мягким запеканием или предварительным запеканием, включает сушку фоторезиста после центрифугирования путем удаления избытка растворителя. Основной причиной снижения содержания растворителя является стабилизация пленки резиста. При комнатной температуре необожженная пленка фоторезиста будет терять растворитель в результате испарения, что со временем изменит свойства пленки. При запекании резиста большая часть растворителя удаляется, и пленка становится стабильной при комнатной температуре. Существует четыре основных эффекта удаления растворителя с фоторезистивной пленки: (1) толщина пленки уменьшается, (2) изменяются свойства отверждения и проявления после экспонирования, (3) улучшается адгезия и (4) пленка становится менее липкой. и, следовательно, менее восприимчивы к загрязнению твердыми частицами. Типичные процессы предварительного обжига оставляют от 3 до 8 процентов остаточного растворителя в пленке резиста, что достаточно мало, чтобы сохранить стабильность пленки во время последующей литографической обработки.
Процесс запекания после нанесения, также называемый мягким запеканием или предварительным запеканием, включает сушку фоторезиста после центрифугирования путем удаления избытка растворителя. Основной причиной снижения содержания растворителя является стабилизация пленки резиста. При комнатной температуре необожженная пленка фоторезиста будет терять растворитель в результате испарения, что со временем изменит свойства пленки. При запекании резиста большая часть растворителя удаляется, и пленка становится стабильной при комнатной температуре. Существует четыре основных эффекта удаления растворителя с фоторезистивной пленки: (1) толщина пленки уменьшается, (2) изменяются свойства отверждения и проявления после экспонирования, (3) улучшается адгезия и (4) пленка становится менее липкой. и, следовательно, менее восприимчивы к загрязнению твердыми частицами. Типичные процессы предварительного обжига оставляют от 3 до 8 процентов остаточного растворителя в пленке резиста, что достаточно мало, чтобы сохранить стабильность пленки во время последующей литографической обработки.
К сожалению, есть и другие последствия запекания большинства фоторезистов. При температурах выше примерно 70°C фоточувствительный компонент типичной смеси резистов, называемый фотоактивным соединением (PAC), может начать разлагаться [1.3, 1.4]. Кроме того, смола, еще один компонент резиста, может сшиваться и/или окисляться при повышенных температурах. Оба эти эффекта нежелательны. Таким образом, необходимо искать оптимальные условия предварительного обжига, которые максимизируют преимущества испарения растворителя и минимизируют вред от разложения резиста. Для химически амплифицированных резистов остаточный растворитель может существенно влиять на диффузию и реакционные свойства во время отжига после экспонирования, что требует тщательного контроля над процессом отверждения после нанесения. К счастью, эти современные резисты не страдают от значительного разложения светочувствительных компонентов во время предварительного обжига.
Существует несколько способов запекания фоторезистов.
 Самый очевидный способ – запекание в духовке. Обжиг обычных фоторезистов в конвекционной печи при 90°C в течение 30 минут был типичным явлением в 1970-х и начале 1980-х годов. Хотя когда-то использование конвекционных печей для предварительного обжига фоторезиста было довольно распространенным явлением, в настоящее время наиболее популярным методом обжига является горячая плита. Пластина помещается либо в тесный вакуумный контакт, либо в непосредственной близости от горячей металлической пластины большой массы. Из-за высокой теплопроводности кремния фоторезист быстро нагревается до температуры, близкой к температуре горячей плиты (примерно за 5 секунд для жесткого контакта или около 20 секунд для запекания в непосредственной близости). Самым большим преимуществом этого метода является уменьшение необходимого времени выпекания по сравнению с конвекционными печами на порядок, примерно до одной минуты, и улучшенная однородность выпекания. В общем, выпечка в непосредственной близости предпочтительнее, чтобы уменьшить возможность образования частиц, вызванных контактом с обратной стороной вафли.
Самый очевидный способ – запекание в духовке. Обжиг обычных фоторезистов в конвекционной печи при 90°C в течение 30 минут был типичным явлением в 1970-х и начале 1980-х годов. Хотя когда-то использование конвекционных печей для предварительного обжига фоторезиста было довольно распространенным явлением, в настоящее время наиболее популярным методом обжига является горячая плита. Пластина помещается либо в тесный вакуумный контакт, либо в непосредственной близости от горячей металлической пластины большой массы. Из-за высокой теплопроводности кремния фоторезист быстро нагревается до температуры, близкой к температуре горячей плиты (примерно за 5 секунд для жесткого контакта или около 20 секунд для запекания в непосредственной близости). Самым большим преимуществом этого метода является уменьшение необходимого времени выпекания по сравнению с конвекционными печами на порядок, примерно до одной минуты, и улучшенная однородность выпекания. В общем, выпечка в непосредственной близости предпочтительнее, чтобы уменьшить возможность образования частиц, вызванных контактом с обратной стороной вафли.
Когда вафля снимается с плиты, выпечка продолжается до тех пор, пока вафля горячая. Весь процесс выпекания не может хорошо контролироваться, если также хорошо не контролируется охлаждение вафли. В результате за выпечкой на горячей плите сразу же следует операция на охлаждающей плите, когда вафля контактирует или находится в непосредственной близости от охлаждающей плиты (поддерживается при температуре чуть ниже комнатной). После охлаждения пластина готова к литографическому экспонированию.
4. Выравнивание и экспонирование
Основным принципом работы фоторезиста является изменение растворимости резиста в проявителе под воздействием света (или других видов экспонирующего излучения). В случае стандартного диазонафтохинонового положительного фоторезиста фотоактивное соединение (ПАС), которое не растворяется в проявителе на водной основе, превращается в карбоновую кислоту под воздействием УФ-света в диапазоне 350-450 нм. Карбоновая кислота хорошо растворяется в основном проявителе.
 Таким образом, пространственное изменение энергии света, падающего на фоторезист, вызовет пространственное изменение растворимости резиста в проявителе.
Таким образом, пространственное изменение энергии света, падающего на фоторезист, вызовет пространственное изменение растворимости резиста в проявителе.Контактная и бесконтактная литография — простейшие методы экспонирования фоторезиста через мастер-шаблон, называемый фотошаблоном (рис. 1-4). Контактная литография предлагает высокое разрешение (примерно до длины волны излучения), но практические проблемы, такие как повреждение маски и, как следствие, низкий выход, делают этот процесс непригодным для большинства производственных сред. Бесконтактная печать уменьшает повреждение маски, удерживая маску на заданном расстоянии над пластиной (например, 20 мкм). К сожалению, предел разрешения увеличен до более чем 2–4 мкм, что делает бесконтактную печать недостаточной для современных технологий. На сегодняшний день наиболее распространенным методом экспонирования является проекционная печать.
Рис. 1-4. Литографическая печать в производстве полупроводников эволюционировала от контактной печати (в начале 1960-х) до проекционной печати (с середины 1970-х до наших дней).

Проекционная литография получила свое название из-за того, что изображение маски проецируется на пластину. Проекционная литография стала жизнеспособной альтернативой контактной/бесконтактной печати в середине 1970-х годов, когда появление автоматизированного проектирования линз и улучшенных оптических материалов позволило производить элементы линз достаточного качества для удовлетворения требований полупроводниковой промышленности. На самом деле эти линзы стали настолько совершенными, что дефекты линз, называемые аберрациями, играют лишь небольшую роль в определении качества изображения. Такая оптическая система называется дифракционно-ограниченной, поскольку именно дифракционные эффекты, а не аберрации объектива, по большей части определяют форму изображения.
Существует два основных класса инструментов проекционной литографии – сканирующие и пошаговые системы. Сканирующая проекционная печать, впервые разработанная компанией Perkin-Elmer [1.5], использует отражающую оптику (то есть зеркала, а не линзы) для проецирования щели света от маски на пластину, поскольку маска и пластина одновременно перемещаются по щели.
 Экспозиционная доза определяется интенсивностью света, шириной щели и скоростью сканирования пластины. Эти ранние системы сканирования, в которых используется полихроматический свет от ртутной дуговой лампы, имеют соотношение 1:1, т. е. размеры маски и изображения равны. Камеры с пошаговым повторением (для краткости называемые степперами) экспонируют пластину по одной прямоугольной секции (называемой полем изображения) за раз и могут быть 1: 1 или уменьшением. Эти системы используют преломляющую оптику (то есть линзы) и обычно являются квазимонохроматическими. Оба типа систем (рис. 1-5) способны получать изображения с высоким разрешением, хотя для самых высоких разрешений требуется уменьшение изображений.
Экспозиционная доза определяется интенсивностью света, шириной щели и скоростью сканирования пластины. Эти ранние системы сканирования, в которых используется полихроматический свет от ртутной дуговой лампы, имеют соотношение 1:1, т. е. размеры маски и изображения равны. Камеры с пошаговым повторением (для краткости называемые степперами) экспонируют пластину по одной прямоугольной секции (называемой полем изображения) за раз и могут быть 1: 1 или уменьшением. Эти системы используют преломляющую оптику (то есть линзы) и обычно являются квазимонохроматическими. Оба типа систем (рис. 1-5) способны получать изображения с высоким разрешением, хотя для самых высоких разрешений требуется уменьшение изображений.Сканеры заменили бесконтактную печать к середине семидесятых годов для устройств с геометрией менее 4–5 мкм. К началу 1980-х годов степперы стали доминировать, поскольку конструкция устройств стала меньше 2 мкм. Степперы продолжали доминировать в создании литографических рисунков на протяжении 1990-х годов, когда минимальные размеры элементов достигли уровня 250 нм.
 Однако к началу 1990-х годов компания SVG Lithography, преемница Perkin-Elmer, представила гибридный подход «шаг и сканирование». Подход пошагового сканирования использует часть нормального поля шагового двигателя (например, 25 мм x 8 мм), затем сканирует это поле в одном направлении, чтобы открыть всю маску 4-кратного уменьшения. Затем пластина перемещается в новое место, и сканирование повторяется. Меньшее поле изображения упрощает конструкцию и изготовление объектива, но за счет более сложной сетки и подложки. Технология пошагового сканирования сегодня является предпочтительной технологией для производства с длиной волны менее 250 нм.
Однако к началу 1990-х годов компания SVG Lithography, преемница Perkin-Elmer, представила гибридный подход «шаг и сканирование». Подход пошагового сканирования использует часть нормального поля шагового двигателя (например, 25 мм x 8 мм), затем сканирует это поле в одном направлении, чтобы открыть всю маску 4-кратного уменьшения. Затем пластина перемещается в новое место, и сканирование повторяется. Меньшее поле изображения упрощает конструкцию и изготовление объектива, но за счет более сложной сетки и подложки. Технология пошагового сканирования сегодня является предпочтительной технологией для производства с длиной волны менее 250 нм.Рис. 1-5. Сканеры и степперы используют разные методы для экспонирования большой пластины с небольшим полем изображения.
Разрешение, наименьший элемент, который можно напечатать с надлежащим контролем, имеет два основных ограничения: наименьшее изображение, которое можно спроецировать на пластину, и разрешающая способность фоторезиста использовать это изображение.
 Со стороны проекционного изображения разрешение определяется длиной волны отображающего света (λ) и числовой апертурой ( NA ) проекционного объектива в соответствии с критерием Рэлея:
Со стороны проекционного изображения разрешение определяется длиной волны отображающего света (λ) и числовой апертурой ( NA ) проекционного объектива в соответствии с критерием Рэлея:Системы литографии прошли путь от длин волн синего (436 нм) до УФ (365 нм) и глубокого УФ (248 нм) до сегодняшней основной длины волны высокого разрешения 193 нм. Тем временем числовые апертуры проекционных инструментов выросли с 0,16 для первых сканеров до удивительно высоких систем с числовой апертурой 0,93, которые сегодня производят элементы размером менее 100 нм.
Прежде чем можно будет начать экспонирование фоторезиста с изображением маски, это изображение должно быть совмещено с ранее определенными рисунками на пластине. Это выравнивание и результирующее наложение двух или более литографических шаблонов имеют решающее значение, поскольку более жесткий контроль наложения означает, что элементы схемы могут быть расположены ближе друг к другу. Более плотная упаковка устройств за счет лучшего выравнивания и наложения почти так же важна, как и более мелкие устройства за счет более высокого разрешения в стремлении к большей функциональности на чип.

Другим важным аспектом экспонирования фоторезиста является эффект стоячей волны. Монохроматический свет при проецировании на пластину падает на поверхность фоторезиста под разными углами, приближаясь к плоским волнам. Этот свет проходит вниз через фоторезист и, если подложка отражающая, отражается обратно через резист. Входящий и отраженный свет интерферируют, образуя картину стоячей волны высокой и низкой интенсивности света на разной глубине в фоторезисте. Этот узор повторяется в фоторезисте, вызывая выступы на боковых стенках элемента резиста, как показано на рис. 1-6. По мере того, как размеры шаблона становятся меньше, эти выступы могут существенно повлиять на качество элемента. Интерференция, которая вызывает стоячие волны, также приводит к явлению, называемому кривые качания , синусоидальное изменение ширины линии при изменении толщины резиста. Эти вредные эффекты лучше всего устраняются путем покрытия подложки тонким поглощающим слоем, называемым нижним антиотражающим покрытием (BARC), который может снизить отражательную способность, видимую фоторезистом, до уровня менее 1 процента.

Рис. 1-6. Фоторезистивный рисунок на кремниевой подложке с заметными стоячими волнами.
5. Запекание после экспонирования
Один из методов уменьшения эффекта стоячей волны называется запеканием после экспозиции (PEB) [1.6]. Хотя до сих пор ведутся споры о механизме, считается, что используемые высокие температуры (100°C – 130°C) вызывают диффузию фотоактивного соединения, таким образом сглаживая гребни стоячих волн (рис. 1-7). Важно отметить, что пагубное воздействие высоких температур на фоторезист, обсуждавшееся в связи с предварительным обжигом, также относится и к PEB. Таким образом, становится очень важным оптимизировать условия выпечки. Также было замечено, что скорость диффузии ПАУ зависит от условий перед обжигом [1.7]. Считается, что присутствие растворителя усиливает диффузию во время PEB. Таким образом, низкотемпературный предварительный обжиг приводит к большей диффузии при заданной температуре PEB.
Для обычного резиста основное значение PEB заключается в диффузии для устранения стоячих волн.
 Для другого класса фоторезистов, называемых химически усиленными резистами, РЕВ является неотъемлемой частью химических реакций, которые создают разницу в растворимости между экспонированными и неэкспонированными частями резиста. Для этих резистов при воздействии образуется небольшое количество сильной кислоты, которая сама по себе не изменяет растворимость резиста. Во время сушки после экспонирования эта фотогенерируемая кислота катализирует реакцию, которая изменяет растворимость полимерной смолы в резисте. Контроль PEB чрезвычайно важен для химически амплифицированных резистов.
Для другого класса фоторезистов, называемых химически усиленными резистами, РЕВ является неотъемлемой частью химических реакций, которые создают разницу в растворимости между экспонированными и неэкспонированными частями резиста. Для этих резистов при воздействии образуется небольшое количество сильной кислоты, которая сама по себе не изменяет растворимость резиста. Во время сушки после экспонирования эта фотогенерируемая кислота катализирует реакцию, которая изменяет растворимость полимерной смолы в резисте. Контроль PEB чрезвычайно важен для химически амплифицированных резистов.(a) (b) (c) Диффузия во время запекания после воздействия часто используется для уменьшения стоячих волн. Моделирование профиля фоторезиста в зависимости от длины диффузии PEB: (а) 20 нм, (б) 40 нм и (в) 60 нм.
6. Проявление
После экспонирования фоторезист необходимо проявить.
 Наиболее часто используемые фоторезисты используют водные основы в качестве проявителей. В частности, гидроксид тетраметиламмония (TMAH) используется в концентрациях 0,2–0,26 н. Проявление, несомненно, является одним из наиболее важных этапов процесса фоторезиста. Характеристики взаимодействия резист-проявитель в значительной степени определяют форму профиля фоторезиста и, что более важно, контроль ширины линии.
Наиболее часто используемые фоторезисты используют водные основы в качестве проявителей. В частности, гидроксид тетраметиламмония (TMAH) используется в концентрациях 0,2–0,26 н. Проявление, несомненно, является одним из наиболее важных этапов процесса фоторезиста. Характеристики взаимодействия резист-проявитель в значительной степени определяют форму профиля фоторезиста и, что более важно, контроль ширины линии.Метод нанесения проявителя на фоторезист важен для контроля однородности проявления и широты процесса. В прошлом пакетная разработка была преобладающей техникой разработки. В большом стакане одновременно проявляют лодочку из 10-20 или более пластинок, обычно при некотором перемешивании. Однако с переходом на поточную обработку стали преобладать другие методы. Во время центрифугирования пластины вращаются с использованием оборудования, аналогичного тому, которое используется для центрифугирования, и проявитель выливается на вращающуюся пластину. Пластина также ополаскивается и сушится во время вращения.
 Было показано, что разработка распыления дает хорошие результаты при использовании проявителей, специально разработанных для этого метода дозирования. Используя процесс, идентичный вращению, проявитель распыляется, а не выливается на пластину с помощью сопла, которое создает тонкий туман проявителя над пластиной (рис. 1-8). Этот метод снижает использование разработчиками и обеспечивает более равномерное покрытие разработчиков. Другая поточная стратегия развития называется развитием лужи. Опять же, используя проявители, специально разработанные для этого процесса, проявитель выливают на стационарную пластину, которую затем оставляют неподвижной на время проявки. Затем пластину ополаскивают и сушат. Обратите внимание, что все три поточных процесса могут выполняться на одном и том же оборудовании с небольшими модификациями, и часто используются комбинации этих методов.
Было показано, что разработка распыления дает хорошие результаты при использовании проявителей, специально разработанных для этого метода дозирования. Используя процесс, идентичный вращению, проявитель распыляется, а не выливается на пластину с помощью сопла, которое создает тонкий туман проявителя над пластиной (рис. 1-8). Этот метод снижает использование разработчиками и обеспечивает более равномерное покрытие разработчиков. Другая поточная стратегия развития называется развитием лужи. Опять же, используя проявители, специально разработанные для этого процесса, проявитель выливают на стационарную пластину, которую затем оставляют неподвижной на время проявки. Затем пластину ополаскивают и сушат. Обратите внимание, что все три поточных процесса могут выполняться на одном и том же оборудовании с небольшими модификациями, и часто используются комбинации этих методов.Рисунок 1-8. Обычно используются различные методы разработки приложений.

7. Постобжиг
Постобжиг (не путать с обжигом после экспонирования, который предшествует проявке) используется для упрочнения окончательного изображения резиста, чтобы оно могло выдерживать суровые условия имплантации или травления. Используемые высокие температуры (120°C — 150°C) сшивают полимерную смолу в фоторезисте, делая изображение более термически стабильным. Если используемая температура слишком высока, резист будет течь, что приведет к ухудшению качества изображения. Температура, при которой начинается течение, связана с температурой стеклования и является мерой термической стабильности резиста. В дополнение к сшиванию, постобжиг может удалить остаточный растворитель, воду и газы и обычно улучшает адгезию резиста к подложке.
Были предложены и другие методы для упрочнения фоторезистивного изображения. Воздействие глубокого УФ-излучения высокой интенсивности сшивает смолу на поверхности резиста, образуя прочную оболочку вокруг рисунка [1.8].
 Фоторезист с глубоким УФ-отверждением может выдерживать температуры свыше 200°C без деформации размеров. Хотя обычно считается, что глубокое УФ-излучение непосредственно вызывает реакцию сшивания, есть некоторые свидетельства того, что озон, образующийся при взаимодействии света с атмосферным кислородом, может вызывать (или усиливать) реакцию сшивания [1.9]., 1.10]. Также было показано, что плазменная обработка и бомбардировка электронным лучом эффективно упрочняют фоторезист. В настоящее время доступны и широко используются коммерческие системы глубокого УФ-отверждения.
Фоторезист с глубоким УФ-отверждением может выдерживать температуры свыше 200°C без деформации размеров. Хотя обычно считается, что глубокое УФ-излучение непосредственно вызывает реакцию сшивания, есть некоторые свидетельства того, что озон, образующийся при взаимодействии света с атмосферным кислородом, может вызывать (или усиливать) реакцию сшивания [1.9]., 1.10]. Также было показано, что плазменная обработка и бомбардировка электронным лучом эффективно упрочняют фоторезист. В настоящее время доступны и широко используются коммерческие системы глубокого УФ-отверждения.8. Перенос узора
После литографической печати на фоторезисте небольших узоров эти узоры необходимо перенести на подложку. Существует три основных подхода к переносу рисунка: субтрактивный перенос (травление), аддитивный перенос (селективное осаждение) и легирование примесями (ионная имплантация). Травление является наиболее распространенным методом переноса рисунка. На подложку наносится равномерный слой материала, подлежащего моделированию.
 Затем выполняется литография таким образом, что области, подлежащие травлению, остаются незащищенными (не покрытыми) фоторезистом. Травление выполняется либо с использованием влажных химикатов, таких как кислоты, либо чаще в среде сухой плазмы. Фоторезист «сопротивляется» травлению и защищает материал, покрытый резистом. Когда травление завершено, резист снимается, оставляя желаемый рисунок на нанесенном слое. Аддитивные процессы используются всякий раз, когда рабочие процессы травления недоступны, например, для медных межсоединений. Здесь литографический рисунок используется для открытия областей, где должен быть выращен новый слой (путем гальванического покрытия, в случае меди). После удаления резиста новый материал остается в негативной версии узорчатого фоторезиста. Наконец, легирование включает добавление контролируемых количеств загрязняющих веществ, которые изменяют проводящие свойства полупроводника. Ионная имплантация использует пучок ионов легирующей примеси, ускоренный на подложке с рисунком фоторезиста.
Затем выполняется литография таким образом, что области, подлежащие травлению, остаются незащищенными (не покрытыми) фоторезистом. Травление выполняется либо с использованием влажных химикатов, таких как кислоты, либо чаще в среде сухой плазмы. Фоторезист «сопротивляется» травлению и защищает материал, покрытый резистом. Когда травление завершено, резист снимается, оставляя желаемый рисунок на нанесенном слое. Аддитивные процессы используются всякий раз, когда рабочие процессы травления недоступны, например, для медных межсоединений. Здесь литографический рисунок используется для открытия областей, где должен быть выращен новый слой (путем гальванического покрытия, в случае меди). После удаления резиста новый материал остается в негативной версии узорчатого фоторезиста. Наконец, легирование включает добавление контролируемых количеств загрязняющих веществ, которые изменяют проводящие свойства полупроводника. Ионная имплантация использует пучок ионов легирующей примеси, ускоренный на подложке с рисунком фоторезиста. Резист блокирует ионы, но области, не покрытые резистом, содержат ионы, создавая избирательно легированные области, которые составляют электрическое сердце транзисторов.
Резист блокирует ионы, но области, не покрытые резистом, содержат ионы, создавая избирательно легированные области, которые составляют электрическое сердце транзисторов.9. Лента
После обработки пластины с изображением (например, травления, ионного имплантирования и т. д.) необходимо удалить оставшийся фоторезист. Существует два класса методов удаления резиста: влажное удаление с использованием органических или неорганических растворов и сухое (плазменное) удаление. Простым примером органического стриппера является ацетон. Хотя ацетон обычно используется в лабораторных условиях, он имеет тенденцию оставлять остатки на пластине (накипь) и поэтому неприемлем для обработки полупроводников. Большинство коммерческих органических стриптизерш основаны на феноле и несколько лучше предотвращают образование накипи. Однако наиболее распространенными влажными стрипперами для позитивных фоторезистов являются системы на основе неорганических кислот, используемые при повышенных температурах.

Влажная зачистка связана с рядом проблем. Хотя правильный выбор стриппера для различных применений обычно позволяет устранить сильное образование накипи, практически невозможно удалить окончательный монослой фоторезиста с пластины влажными химическими средствами. Часто необходимо пройти по влажной полосе плазменным осадком, чтобы полностью очистить пластину от остатков резиста. Кроме того, фоторезист, подвергшийся экстенсивному отверждению (например, глубокому УФ-отверждению) и подвергавшийся жестким условиям обработки (например, имплантации высокоэнергетических ионов), почти невозможно удалить химическим путем. По этим причинам плазменная зачистка стала стандартом при обработке полупроводников. Кислородная плазма обладает высокой реакционной способностью по отношению к органическим полимерам, но оставляет нетронутыми большинство неорганических материалов (например, находящиеся под фоторезистом).
Назад к дому литографии.
 ..
..Проявление фоторезиста — Процессы химического измельчения — RD Chemical Company
Проявление фоторезиста
(Или как что-то настолько простое может быть так легко испортить?)
используют негативный рабочий фоторезист для создания изображений, обычно типа сухой пленки. Фоторезист обычно проявляется с использованием разбавленного раствора карбоната натрия или калия. Этот слабощелочной раствор вступает в реакцию с неэкспонированной частью «кислотного» фоторезиста, нейтрализуя его кислотность и делая его растворимым в воде. Открытая часть сшивается под действием УФ-излучения во время воздействия и становится практически нерастворимой для проявителя. Проявление — это один из самых простых химических процессов фотохимического фрезерования, но при этом один из наиболее важных, поскольку он определяет, как деталь/деталь будет выглядеть после обработки. Поскольку проявка, по-видимому, настолько проста, легко упустить из виду ее важность для производства высококачественных (малых размеров) деталей и упустить из виду детали, необходимые для производства высококачественной проявки.
В настоящее время стандартным проявителем является 1% раствор моногидрата карбоната натрия (Na2CO3.h3O) или карбоната калия (K2CO3). Выбор между ними невелик, хотя использование карбоната калия, как сообщается, обеспечивает немного лучшее качество проявки и имеет более широкое окно процесса. Карбонат калия можно приобрести в концентрированной жидкой форме, что обеспечивает удобную подачу и прокачку без больших питающих баков. В те дни, когда 10 mil (250 микрон) были «прекрасной функцией», использование решений разработчика до такой степени, что разработка резко замедлялась, а затем их сбрасывание было приемлемым сценарием. Это было связано с тем, что качество проявления во второй половине проявочной ванны не было проблемой. Сегодня остающаяся при такой схеме использования «нога сопротивления» совершенно неприемлема.
Сегодня автоматическая проявка с подачей и продувкой с контролем pH является нормой и лучшим контролем для проявителей. Использование контроля pH в проявителе — единственный разумный способ управления системой подачи и продувки.
 Другие системы управления нечувствительны к разным количествам фоторезиста для данной работы и будут либо тратить химию впустую, либо давать спорадическое качество при проявлении.
При использовании контроля pH pH, который контролируется проявителем, рекомендуется поставщиком фоторезиста и обычно составляет около 10,5. Это число выбрано лишь частично, потому что это «хороший» pH для проявления фоторезиста. Другая причина выбора (обычно более высокого) pH заключается в том, что более высокий pH способствует большему обороту раствора, что гарантирует, что уровень растворенный фоторезист в резервуаре для проявителя поддерживается на низком уровне. Оказывается, уровень растворенного фоторезиста в ванне проявителя сильно влияет на качество проявки.
Другие системы управления нечувствительны к разным количествам фоторезиста для данной работы и будут либо тратить химию впустую, либо давать спорадическое качество при проявлении.
При использовании контроля pH pH, который контролируется проявителем, рекомендуется поставщиком фоторезиста и обычно составляет около 10,5. Это число выбрано лишь частично, потому что это «хороший» pH для проявления фоторезиста. Другая причина выбора (обычно более высокого) pH заключается в том, что более высокий pH способствует большему обороту раствора, что гарантирует, что уровень растворенный фоторезист в резервуаре для проявителя поддерживается на низком уровне. Оказывается, уровень растворенного фоторезиста в ванне проявителя сильно влияет на качество проявки.Используя рН 10,5 в качестве заданного значения, предполагая, что экспонируемая площадь составляет 50%, и двухстороннее нанесение фоторезиста, типичный сухой пленочный фоторезист толщиной 1,3 мл потребляет около одного галлона 1% раствора карбоната калия или натрия, приготовленного раствор проявителя на квадратный фут ламината.
 Это означает, что на галлон раствора проявителя в отстойнике приходится всего 1,3 мл на квадратный фут фоторезиста.
Это означает, что на галлон раствора проявителя в отстойнике приходится всего 1,3 мл на квадратный фут фоторезиста.Вопрос температуры и линейной скорости нужно упомянуть вскользь. Поставщик фоторезиста указывает оптимальную температуру проявления, но обычно она составляет около 85-9°С.0 F. Скорость линии должна быть установлена такой, чтобы точка останова (точка, где резист, по-видимому, только что исчез, обнажая медь) находилась на или менее 50% пути через камеру проявителя. Что касается конфигурации оборудования, очень важно, чтобы форсунки были установлены так, чтобы струи едва перекрывались. Спреи, которые встречаются слишком далеко от доски, теряют энергию и не будут развиваться. Если струи совсем не перекрывают друг друга, те участки, которых они не касаются, не получат давления распыления, необходимого для хорошего проявления. Обратите внимание, что эта проблема со струей также очень важна при первом полоскании, чтобы облегчить удаление резистивной лапки.
Было много дискуссий о том, какие сопла лучше использовать при проявке: конусные или веерные, и дальнейшее обсуждение никого не изменит.
 Сторонники есть с обеих сторон. Одной из очевидных областей является то, что веерные форсунки имеют больше степеней свободы в регулировке формы распыла (и, следовательно, больше способов запутаться?).
Что ясно, так это то, что в большинстве фотохимических фрезерных мастерских выбор типа сопла для использования становится второстепенной проблемой примерно через месяц после установки модуля проявителя, и модуль проявителя подвергается злоупотреблениям, которые так распространены во время планового обслуживания и очистки. . Один из лучших способов обеспечить высокое качество проявки — убедиться, что люди, ответственные за демонтаж оборудования для проявки по любой причине, четко понимают критическую важность замены форсунок в выбранной конфигурации.
Сторонники есть с обеих сторон. Одной из очевидных областей является то, что веерные форсунки имеют больше степеней свободы в регулировке формы распыла (и, следовательно, больше способов запутаться?).
Что ясно, так это то, что в большинстве фотохимических фрезерных мастерских выбор типа сопла для использования становится второстепенной проблемой примерно через месяц после установки модуля проявителя, и модуль проявителя подвергается злоупотреблениям, которые так распространены во время планового обслуживания и очистки. . Один из лучших способов обеспечить высокое качество проявки — убедиться, что люди, ответственные за демонтаж оборудования для проявки по любой причине, четко понимают критическую важность замены форсунок в выбранной конфигурации.Еще одна проблема, сильно влияющая на качество разработки, — это «приземленная» проблема обслуживания оборудования. Простое поддержание чистоты оборудования для проявителя, по-видимому, настолько просто, что его слишком часто упускают из виду или проводят стандартную очистку с использованием общей химии (каустическая сода и/или кислота).
 Очистка каустической содой и/или кислотой может удалить большие, легко удаляемые отложения, но игнорирует долговременные, прочно связанные остатки, которые накапливаются и в конечном итоге забивают форсунки и коллекторы.
Очистка каустической содой и/или кислотой может удалить большие, легко удаляемые отложения, но игнорирует долговременные, прочно связанные остатки, которые накапливаются и в конечном итоге забивают форсунки и коллекторы.Стандартные химические растворы (разбавленная каустическая сода и/или кислота) не могут полностью очистить рабочую камеру проявителя. Остатки в этих камерах являются продуктом реакции жесткости воды и фоторезиста, возможно, в сочетании с некоторыми пеногасителями. Единственный способ, которым можно удалить такой остаток, — это хелатирование металла из этого остатка. Когда металл удаляется из этих остатков хелатированием, щелочность, оставшаяся в очистителе, легко растворяет остальную часть отложений. (Я лично видел проявителей со стеклянными «смотровыми» окнами, которые были непрозрачными в течение многих лет, хотя проявитель еженедельно очищался каустической содой. Эти окна становятся полностью прозрачными менее чем за минуту, если очистить их хелатным чистящим средством.
 )
)Столь же достойным внимания является первое полоскание после проявителя. Очистка этой камеры и ее сопел может быть такой же сложной или еще более сложной проблемой очистки, как очистка самого проявителя. Хотя уровни карбоната/фоторезиста при первом ополаскивании намного ниже, чем в технологическом отстойнике, жесткость воды выше. Из-за более высокой жесткости воды любые остатки карбоната или фоторезиста, смываемые с панели, имеют большую жесткость воды, с которой можно реагировать, а это означает, что все отложения в первой промывочной камере очень стойкие, и для их удаления требуется хорошая система хелатирования. При использовании этого типа очистителей очень важно понимать, что им требуется только регулировка pH для сброса (здесь требуется правовая оговорка) в соответствии с законами большинства областей (пожалуйста, уточните в местных органах власти). Очистителям нужно только отрегулировать pH, потому что они не содержат тяжелых металлов. Учитывая этот сценарий, крайне важно, чтобы эти отработанные хелатные очистители были сброшены непосредственно после корректировки pH в потоки отходов, выходящие из завода.




 Весь процесс изготовления печатных плат автоматизируется.
Весь процесс изготовления печатных плат автоматизируется.


 90 мкм
90 мкм : 294 мм
: 294 мм  Кроме того, фоторезист является важным материалом, используемым в печатных платах. В этой статье мы попытаемся объяснить все, что вам нужно знать о фоторезистивных печатных платах.
Кроме того, фоторезист является важным материалом, используемым в печатных платах. В этой статье мы попытаемся объяснить все, что вам нужно знать о фоторезистивных печатных платах.
 Негативные фоторезисты имеют более короткое время обработки. Также они имеют хорошую адгезию к силикону. Однако позитивные фоторезисты термически стабильны. Кроме того, они имеют лучшее разрешение.
Негативные фоторезисты имеют более короткое время обработки. Также они имеют хорошую адгезию к силикону. Однако позитивные фоторезисты термически стабильны. Кроме того, они имеют лучшее разрешение. Следовательно, это позволяет обрабатывать доску до снятия пленки в течение дня. Плата фоторезиста защищает медь. Печатная плата с фоторезистом покрывается погружением позитивного фоторезиста.
Следовательно, это позволяет обрабатывать доску до снятия пленки в течение дня. Плата фоторезиста защищает медь. Печатная плата с фоторезистом покрывается погружением позитивного фоторезиста. После того, как макет будет готов к печати, убедитесь, что тексты указаны правильно после переноса его на доску.
После того, как макет будет готов к печати, убедитесь, что тексты указаны правильно после переноса его на доску. Для замешивания раствора рекомендуется использовать водопроводную воду. После этого встряхните печатную плату. Части фоторезиста, подвергшиеся воздействию УФ-излучения, смоются. Не оставляйте плату в растворе слишком долго. Кроме того, в противном случае фоторезист смоется. Поместите плату в холодную воду, чтобы остановить реакцию.
Для замешивания раствора рекомендуется использовать водопроводную воду. После этого встряхните печатную плату. Части фоторезиста, подвергшиеся воздействию УФ-излучения, смоются. Не оставляйте плату в растворе слишком долго. Кроме того, в противном случае фоторезист смоется. Поместите плату в холодную воду, чтобы остановить реакцию.
 Кроме того, еще один способ удалить его — использовать некоторые неорганические растворители. Здесь органический углерод в фоторезисте окисляется до углекислого газа и удаляется. Последний метод заключается в использовании плазмы для удаления фоторезиста.
Кроме того, еще один способ удалить его — использовать некоторые неорганические растворители. Здесь органический углерод в фоторезисте окисляется до углекислого газа и удаляется. Последний метод заключается в использовании плазмы для удаления фоторезиста. Для соединения и изоляции транзисторов и их компонентов используются пленки как проводников (таких как поликремний, алюминий, а в последнее время и меди), так и изоляторов (различные формы диоксида кремния, нитрида кремния и др.). Селективное легирование различных областей кремния позволяет изменять проводимость кремния при приложении напряжения. Создавая структуры из этих различных компонентов, можно построить миллионы транзисторов и соединить их вместе, чтобы сформировать сложную схему современного микроэлектронного устройства. Основой всех этих процессов является литография, т. е. формирование объемных рельефных изображений на подложке для последующего переноса рисунка на подложку.
Для соединения и изоляции транзисторов и их компонентов используются пленки как проводников (таких как поликремний, алюминий, а в последнее время и меди), так и изоляторов (различные формы диоксида кремния, нитрида кремния и др.). Селективное легирование различных областей кремния позволяет изменять проводимость кремния при приложении напряжения. Создавая структуры из этих различных компонентов, можно построить миллионы транзисторов и соединить их вместе, чтобы сформировать сложную схему современного микроэлектронного устройства. Основой всех этих процессов является литография, т. е. формирование объемных рельефных изображений на подложке для последующего переноса рисунка на подложку. Чтобы построить сложные структуры, из которых состоит транзистор, и множество проводов, соединяющих миллионы транзисторов схемы, этапы литографии и переноса шаблона травления повторяются не менее 10 раз, но чаще всего они выполняются от 20 до 30 раз для создания одной схемы. . Каждый рисунок, напечатанный на пластине, выравнивается с ранее сформированными узорами, и медленно формируются проводники, изоляторы и выборочно легированные области для формирования конечного устройства.
Чтобы построить сложные структуры, из которых состоит транзистор, и множество проводов, соединяющих миллионы транзисторов схемы, этапы литографии и переноса шаблона травления повторяются не менее 10 раз, но чаще всего они выполняются от 20 до 30 раз для создания одной схемы. . Каждый рисунок, напечатанный на пластине, выравнивается с ранее сформированными узорами, и медленно формируются проводники, изоляторы и выборочно легированные области для формирования конечного устройства. Хотя литография, безусловно, не единственный технически важный и сложный процесс в процессе производства ИС, исторически достижения в области литографии ограничивали рост стоимости и производительности ИС.
Хотя литография, безусловно, не единственный технически важный и сложный процесс в процессе производства ИС, исторически достижения в области литографии ограничивали рост стоимости и производительности ИС.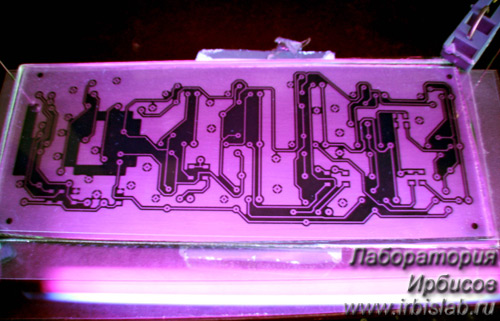 Полоска резиста является последней операцией в литографическом процессе после того, как рисунок резиста был перенесен на нижележащий слой. Эта последовательность схематически показана на рис.0866 литографический кластер . Ниже приводится краткое обсуждение каждого шага с указанием некоторых практических вопросов, связанных с обработкой фоторезиста. Более подробно эти темы будут подробно рассмотрены в последующих главах.
Полоска резиста является последней операцией в литографическом процессе после того, как рисунок резиста был перенесен на нижележащий слой. Эта последовательность схематически показана на рис.0866 литографический кластер . Ниже приводится краткое обсуждение каждого шага с указанием некоторых практических вопросов, связанных с обработкой фоторезиста. Более подробно эти темы будут подробно рассмотрены в последующих главах.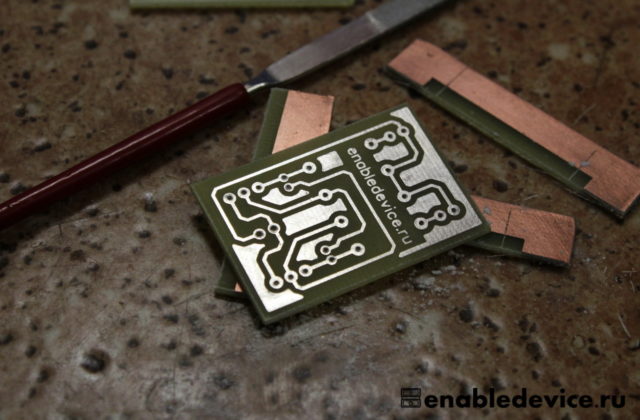 Твердые частицы обычно образуются из переносимых по воздуху частиц или загрязненных жидкостей (например, грязный усилитель адгезии). Наиболее эффективным способом контроля загрязнения твердыми частицами является устранение их источника. Поскольку это не всегда практично, для удаления частиц используется химическая/механическая очистка. Органические пленки, такие как масла или полимеры, могут образовываться из вакуумных насосов и другого оборудования, кожных масел и пота, а также из различных полимерных отложений, оставшихся после предыдущих этапов обработки. Эти пленки обычно можно удалить с помощью химической, озоновой или плазменной очистки. Точно так же неорганические пленки, такие как природные оксиды и соли, могут быть удалены с помощью химической или плазменной очистки. Один тип загрязняющих веществ – адсорбированная вода – легче всего удаляется с помощью высокотемпературного процесса, называемого 9.0866 выпечка обезвоживания .
Твердые частицы обычно образуются из переносимых по воздуху частиц или загрязненных жидкостей (например, грязный усилитель адгезии). Наиболее эффективным способом контроля загрязнения твердыми частицами является устранение их источника. Поскольку это не всегда практично, для удаления частиц используется химическая/механическая очистка. Органические пленки, такие как масла или полимеры, могут образовываться из вакуумных насосов и другого оборудования, кожных масел и пота, а также из различных полимерных отложений, оставшихся после предыдущих этапов обработки. Эти пленки обычно можно удалить с помощью химической, озоновой или плазменной очистки. Точно так же неорганические пленки, такие как природные оксиды и соли, могут быть удалены с помощью химической или плазменной очистки. Один тип загрязняющих веществ – адсорбированная вода – легче всего удаляется с помощью высокотемпературного процесса, называемого 9.0866 выпечка обезвоживания . Затем подложке дают остыть (предпочтительно в сухой среде) и как можно скорее наносят покрытие. Важно отметить, что вода будет повторно адсорбироваться на поверхности подложки, если оставить ее во влажной (не сухой) среде. Дегидратация также эффективна для удаления органических загрязнителей и дополнительной очистки субстрата. Часто обычная последовательность этапов обработки включает какой-либо высокотемпературный процесс непосредственно перед нанесением фоторезиста, например, термическое окисление. Если на подложку наносится покрытие сразу же после высокотемпературной стадии, обезвоживания можно избежать. Однако типичная дегидратационная прокалка не полностью удаляет воду с поверхности подложек из диоксида кремния (включая кремний, поликремний, оксид кремния и нитрид кремния). Поверхностные атомы кремния прочно связываются с монослоем воды, образуя силанольные группы (SiOH). Для удаления этого последнего слоя воды требуется температура обжига выше 600°C [1.1]. Кроме того, силанол быстро восстанавливается при охлаждении подложки в несухой среде.
Затем подложке дают остыть (предпочтительно в сухой среде) и как можно скорее наносят покрытие. Важно отметить, что вода будет повторно адсорбироваться на поверхности подложки, если оставить ее во влажной (не сухой) среде. Дегидратация также эффективна для удаления органических загрязнителей и дополнительной очистки субстрата. Часто обычная последовательность этапов обработки включает какой-либо высокотемпературный процесс непосредственно перед нанесением фоторезиста, например, термическое окисление. Если на подложку наносится покрытие сразу же после высокотемпературной стадии, обезвоживания можно избежать. Однако типичная дегидратационная прокалка не полностью удаляет воду с поверхности подложек из диоксида кремния (включая кремний, поликремний, оксид кремния и нитрид кремния). Поверхностные атомы кремния прочно связываются с монослоем воды, образуя силанольные группы (SiOH). Для удаления этого последнего слоя воды требуется температура обжига выше 600°C [1.1]. Кроме того, силанол быстро восстанавливается при охлаждении подложки в несухой среде. Поскольку этот подход нецелесообразен, предпочтительным методом удаления этого силанола являются химические средства.
Поскольку этот подход нецелесообразен, предпочтительным методом удаления этого силанола являются химические средства. Если HMDS не высохнет должным образом, это приведет к резкой потере адгезии. Хотя прямое прядение легко, оно эффективно только для вытеснения небольшого процента силанольных групп. На сегодняшний день предпочтительным методом нанесения усилителя адгезии является воздействие на подложку паров ГМДС, обычно при повышенных температурах и пониженном давлении. Это обеспечивает хорошее покрытие подложки без избыточного осаждения ГМДС, а более высокие температуры вызывают более полную реакцию с силанольными группами. После правильной обработки ГМДС субстрат можно оставить на несколько дней без существенной повторной адсорбции воды. Выполнение обезвоживания и заправки паром в одной и той же печи обеспечивает оптимальную производительность.
Если HMDS не высохнет должным образом, это приведет к резкой потере адгезии. Хотя прямое прядение легко, оно эффективно только для вытеснения небольшого процента силанольных групп. На сегодняшний день предпочтительным методом нанесения усилителя адгезии является воздействие на подложку паров ГМДС, обычно при повышенных температурах и пониженном давлении. Это обеспечивает хорошее покрытие подложки без избыточного осаждения ГМДС, а более высокие температуры вызывают более полную реакцию с силанольными группами. После правильной обработки ГМДС субстрат можно оставить на несколько дней без существенной повторной адсорбции воды. Выполнение обезвоживания и заправки паром в одной и той же печи обеспечивает оптимальную производительность. Строгие требования к контролю толщины и однородности, а также низкая плотность дефектов требуют особого внимания к этому процессу, где большое количество параметров может иметь существенное влияние на однородность и контроль толщины фоторезиста. Существует выбор между статической дозировкой (пластина неподвижна, пока дозируется резист) или динамической дозировкой (пластина вращается, пока дозируется резист), скоростью и временем отжима, а также ускорением для каждой из скоростей отжима. Кроме того, объем наносимого резиста и свойства резиста (такие как вязкость, процент твердого вещества и состав растворителя) и подложки (материал подложки и топография) играют важную роль в однородности толщины резиста. Кроме того, практические аспекты операции прядения, такие как вытяжка, контроль температуры и влажности, а также чистота прядильной машины, часто оказывают существенное влияние на резистивную пленку. На рис. 1-2 показан стандартный цикл нанесения фоторезиста методом центрифугирования. В конце этого цикла толстая, богатая растворителем пленка фоторезиста покрывает пластину, готовую к выпеканию после нанесения.
Строгие требования к контролю толщины и однородности, а также низкая плотность дефектов требуют особого внимания к этому процессу, где большое количество параметров может иметь существенное влияние на однородность и контроль толщины фоторезиста. Существует выбор между статической дозировкой (пластина неподвижна, пока дозируется резист) или динамической дозировкой (пластина вращается, пока дозируется резист), скоростью и временем отжима, а также ускорением для каждой из скоростей отжима. Кроме того, объем наносимого резиста и свойства резиста (такие как вязкость, процент твердого вещества и состав растворителя) и подложки (материал подложки и топография) играют важную роль в однородности толщины резиста. Кроме того, практические аспекты операции прядения, такие как вытяжка, контроль температуры и влажности, а также чистота прядильной машины, часто оказывают существенное влияние на резистивную пленку. На рис. 1-2 показан стандартный цикл нанесения фоторезиста методом центрифугирования. В конце этого цикла толстая, богатая растворителем пленка фоторезиста покрывает пластину, готовую к выпеканию после нанесения.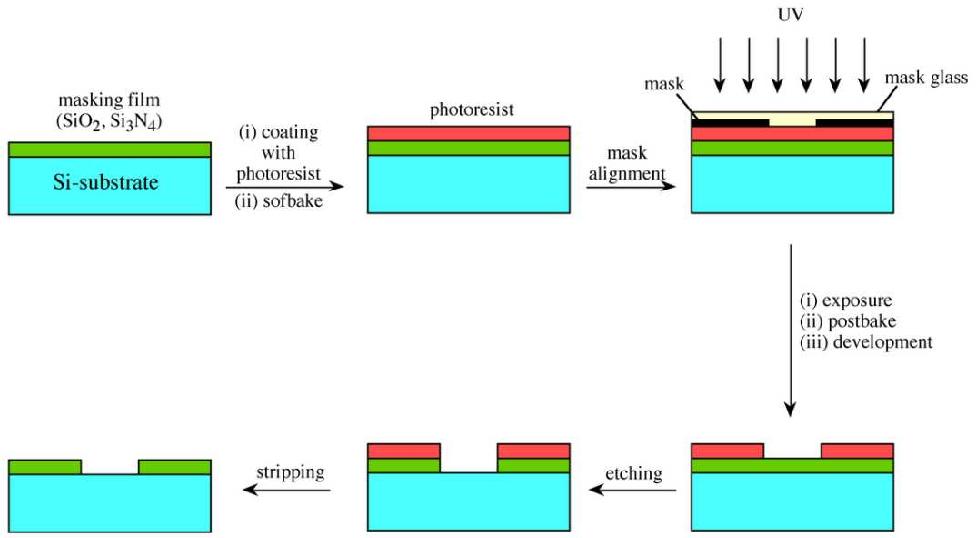
 Процесс запекания после нанесения, также называемый мягким запеканием или предварительным запеканием, включает сушку фоторезиста после центрифугирования путем удаления избытка растворителя. Основной причиной снижения содержания растворителя является стабилизация пленки резиста. При комнатной температуре необожженная пленка фоторезиста будет терять растворитель в результате испарения, что со временем изменит свойства пленки. При запекании резиста большая часть растворителя удаляется, и пленка становится стабильной при комнатной температуре. Существует четыре основных эффекта удаления растворителя с фоторезистивной пленки: (1) толщина пленки уменьшается, (2) изменяются свойства отверждения и проявления после экспонирования, (3) улучшается адгезия и (4) пленка становится менее липкой. и, следовательно, менее восприимчивы к загрязнению твердыми частицами. Типичные процессы предварительного обжига оставляют от 3 до 8 процентов остаточного растворителя в пленке резиста, что достаточно мало, чтобы сохранить стабильность пленки во время последующей литографической обработки.
Процесс запекания после нанесения, также называемый мягким запеканием или предварительным запеканием, включает сушку фоторезиста после центрифугирования путем удаления избытка растворителя. Основной причиной снижения содержания растворителя является стабилизация пленки резиста. При комнатной температуре необожженная пленка фоторезиста будет терять растворитель в результате испарения, что со временем изменит свойства пленки. При запекании резиста большая часть растворителя удаляется, и пленка становится стабильной при комнатной температуре. Существует четыре основных эффекта удаления растворителя с фоторезистивной пленки: (1) толщина пленки уменьшается, (2) изменяются свойства отверждения и проявления после экспонирования, (3) улучшается адгезия и (4) пленка становится менее липкой. и, следовательно, менее восприимчивы к загрязнению твердыми частицами. Типичные процессы предварительного обжига оставляют от 3 до 8 процентов остаточного растворителя в пленке резиста, что достаточно мало, чтобы сохранить стабильность пленки во время последующей литографической обработки.
 Самый очевидный способ – запекание в духовке. Обжиг обычных фоторезистов в конвекционной печи при 90°C в течение 30 минут был типичным явлением в 1970-х и начале 1980-х годов. Хотя когда-то использование конвекционных печей для предварительного обжига фоторезиста было довольно распространенным явлением, в настоящее время наиболее популярным методом обжига является горячая плита. Пластина помещается либо в тесный вакуумный контакт, либо в непосредственной близости от горячей металлической пластины большой массы. Из-за высокой теплопроводности кремния фоторезист быстро нагревается до температуры, близкой к температуре горячей плиты (примерно за 5 секунд для жесткого контакта или около 20 секунд для запекания в непосредственной близости). Самым большим преимуществом этого метода является уменьшение необходимого времени выпекания по сравнению с конвекционными печами на порядок, примерно до одной минуты, и улучшенная однородность выпекания. В общем, выпечка в непосредственной близости предпочтительнее, чтобы уменьшить возможность образования частиц, вызванных контактом с обратной стороной вафли.
Самый очевидный способ – запекание в духовке. Обжиг обычных фоторезистов в конвекционной печи при 90°C в течение 30 минут был типичным явлением в 1970-х и начале 1980-х годов. Хотя когда-то использование конвекционных печей для предварительного обжига фоторезиста было довольно распространенным явлением, в настоящее время наиболее популярным методом обжига является горячая плита. Пластина помещается либо в тесный вакуумный контакт, либо в непосредственной близости от горячей металлической пластины большой массы. Из-за высокой теплопроводности кремния фоторезист быстро нагревается до температуры, близкой к температуре горячей плиты (примерно за 5 секунд для жесткого контакта или около 20 секунд для запекания в непосредственной близости). Самым большим преимуществом этого метода является уменьшение необходимого времени выпекания по сравнению с конвекционными печами на порядок, примерно до одной минуты, и улучшенная однородность выпекания. В общем, выпечка в непосредственной близости предпочтительнее, чтобы уменьшить возможность образования частиц, вызванных контактом с обратной стороной вафли.
 Таким образом, пространственное изменение энергии света, падающего на фоторезист, вызовет пространственное изменение растворимости резиста в проявителе.
Таким образом, пространственное изменение энергии света, падающего на фоторезист, вызовет пространственное изменение растворимости резиста в проявителе.
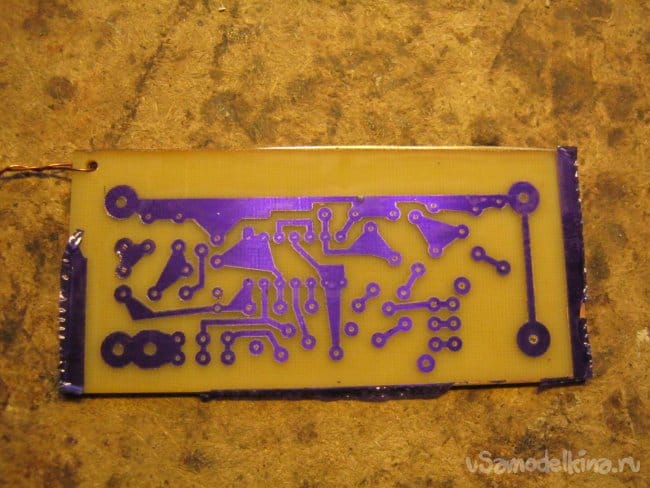 Экспозиционная доза определяется интенсивностью света, шириной щели и скоростью сканирования пластины. Эти ранние системы сканирования, в которых используется полихроматический свет от ртутной дуговой лампы, имеют соотношение 1:1, т. е. размеры маски и изображения равны. Камеры с пошаговым повторением (для краткости называемые степперами) экспонируют пластину по одной прямоугольной секции (называемой полем изображения) за раз и могут быть 1: 1 или уменьшением. Эти системы используют преломляющую оптику (то есть линзы) и обычно являются квазимонохроматическими. Оба типа систем (рис. 1-5) способны получать изображения с высоким разрешением, хотя для самых высоких разрешений требуется уменьшение изображений.
Экспозиционная доза определяется интенсивностью света, шириной щели и скоростью сканирования пластины. Эти ранние системы сканирования, в которых используется полихроматический свет от ртутной дуговой лампы, имеют соотношение 1:1, т. е. размеры маски и изображения равны. Камеры с пошаговым повторением (для краткости называемые степперами) экспонируют пластину по одной прямоугольной секции (называемой полем изображения) за раз и могут быть 1: 1 или уменьшением. Эти системы используют преломляющую оптику (то есть линзы) и обычно являются квазимонохроматическими. Оба типа систем (рис. 1-5) способны получать изображения с высоким разрешением, хотя для самых высоких разрешений требуется уменьшение изображений. Однако к началу 1990-х годов компания SVG Lithography, преемница Perkin-Elmer, представила гибридный подход «шаг и сканирование». Подход пошагового сканирования использует часть нормального поля шагового двигателя (например, 25 мм x 8 мм), затем сканирует это поле в одном направлении, чтобы открыть всю маску 4-кратного уменьшения. Затем пластина перемещается в новое место, и сканирование повторяется. Меньшее поле изображения упрощает конструкцию и изготовление объектива, но за счет более сложной сетки и подложки. Технология пошагового сканирования сегодня является предпочтительной технологией для производства с длиной волны менее 250 нм.
Однако к началу 1990-х годов компания SVG Lithography, преемница Perkin-Elmer, представила гибридный подход «шаг и сканирование». Подход пошагового сканирования использует часть нормального поля шагового двигателя (например, 25 мм x 8 мм), затем сканирует это поле в одном направлении, чтобы открыть всю маску 4-кратного уменьшения. Затем пластина перемещается в новое место, и сканирование повторяется. Меньшее поле изображения упрощает конструкцию и изготовление объектива, но за счет более сложной сетки и подложки. Технология пошагового сканирования сегодня является предпочтительной технологией для производства с длиной волны менее 250 нм.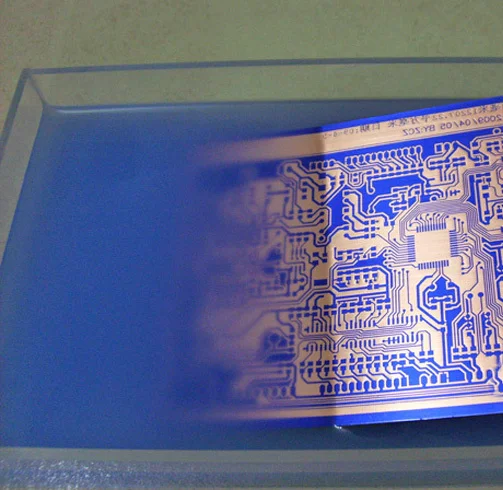 Со стороны проекционного изображения разрешение определяется длиной волны отображающего света (λ) и числовой апертурой ( NA ) проекционного объектива в соответствии с критерием Рэлея:
Со стороны проекционного изображения разрешение определяется длиной волны отображающего света (λ) и числовой апертурой ( NA ) проекционного объектива в соответствии с критерием Рэлея: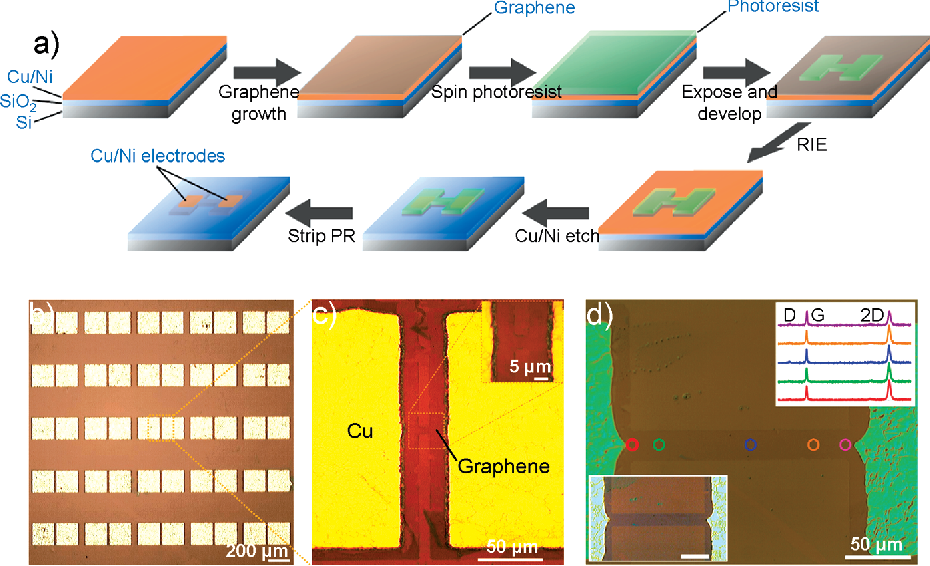

 Для другого класса фоторезистов, называемых химически усиленными резистами, РЕВ является неотъемлемой частью химических реакций, которые создают разницу в растворимости между экспонированными и неэкспонированными частями резиста. Для этих резистов при воздействии образуется небольшое количество сильной кислоты, которая сама по себе не изменяет растворимость резиста. Во время сушки после экспонирования эта фотогенерируемая кислота катализирует реакцию, которая изменяет растворимость полимерной смолы в резисте. Контроль PEB чрезвычайно важен для химически амплифицированных резистов.
Для другого класса фоторезистов, называемых химически усиленными резистами, РЕВ является неотъемлемой частью химических реакций, которые создают разницу в растворимости между экспонированными и неэкспонированными частями резиста. Для этих резистов при воздействии образуется небольшое количество сильной кислоты, которая сама по себе не изменяет растворимость резиста. Во время сушки после экспонирования эта фотогенерируемая кислота катализирует реакцию, которая изменяет растворимость полимерной смолы в резисте. Контроль PEB чрезвычайно важен для химически амплифицированных резистов. Наиболее часто используемые фоторезисты используют водные основы в качестве проявителей. В частности, гидроксид тетраметиламмония (TMAH) используется в концентрациях 0,2–0,26 н. Проявление, несомненно, является одним из наиболее важных этапов процесса фоторезиста. Характеристики взаимодействия резист-проявитель в значительной степени определяют форму профиля фоторезиста и, что более важно, контроль ширины линии.
Наиболее часто используемые фоторезисты используют водные основы в качестве проявителей. В частности, гидроксид тетраметиламмония (TMAH) используется в концентрациях 0,2–0,26 н. Проявление, несомненно, является одним из наиболее важных этапов процесса фоторезиста. Характеристики взаимодействия резист-проявитель в значительной степени определяют форму профиля фоторезиста и, что более важно, контроль ширины линии. Было показано, что разработка распыления дает хорошие результаты при использовании проявителей, специально разработанных для этого метода дозирования. Используя процесс, идентичный вращению, проявитель распыляется, а не выливается на пластину с помощью сопла, которое создает тонкий туман проявителя над пластиной (рис. 1-8). Этот метод снижает использование разработчиками и обеспечивает более равномерное покрытие разработчиков. Другая поточная стратегия развития называется развитием лужи. Опять же, используя проявители, специально разработанные для этого процесса, проявитель выливают на стационарную пластину, которую затем оставляют неподвижной на время проявки. Затем пластину ополаскивают и сушат. Обратите внимание, что все три поточных процесса могут выполняться на одном и том же оборудовании с небольшими модификациями, и часто используются комбинации этих методов.
Было показано, что разработка распыления дает хорошие результаты при использовании проявителей, специально разработанных для этого метода дозирования. Используя процесс, идентичный вращению, проявитель распыляется, а не выливается на пластину с помощью сопла, которое создает тонкий туман проявителя над пластиной (рис. 1-8). Этот метод снижает использование разработчиками и обеспечивает более равномерное покрытие разработчиков. Другая поточная стратегия развития называется развитием лужи. Опять же, используя проявители, специально разработанные для этого процесса, проявитель выливают на стационарную пластину, которую затем оставляют неподвижной на время проявки. Затем пластину ополаскивают и сушат. Обратите внимание, что все три поточных процесса могут выполняться на одном и том же оборудовании с небольшими модификациями, и часто используются комбинации этих методов.
 Фоторезист с глубоким УФ-отверждением может выдерживать температуры свыше 200°C без деформации размеров. Хотя обычно считается, что глубокое УФ-излучение непосредственно вызывает реакцию сшивания, есть некоторые свидетельства того, что озон, образующийся при взаимодействии света с атмосферным кислородом, может вызывать (или усиливать) реакцию сшивания [1.9]., 1.10]. Также было показано, что плазменная обработка и бомбардировка электронным лучом эффективно упрочняют фоторезист. В настоящее время доступны и широко используются коммерческие системы глубокого УФ-отверждения.
Фоторезист с глубоким УФ-отверждением может выдерживать температуры свыше 200°C без деформации размеров. Хотя обычно считается, что глубокое УФ-излучение непосредственно вызывает реакцию сшивания, есть некоторые свидетельства того, что озон, образующийся при взаимодействии света с атмосферным кислородом, может вызывать (или усиливать) реакцию сшивания [1.9]., 1.10]. Также было показано, что плазменная обработка и бомбардировка электронным лучом эффективно упрочняют фоторезист. В настоящее время доступны и широко используются коммерческие системы глубокого УФ-отверждения. Затем выполняется литография таким образом, что области, подлежащие травлению, остаются незащищенными (не покрытыми) фоторезистом. Травление выполняется либо с использованием влажных химикатов, таких как кислоты, либо чаще в среде сухой плазмы. Фоторезист «сопротивляется» травлению и защищает материал, покрытый резистом. Когда травление завершено, резист снимается, оставляя желаемый рисунок на нанесенном слое. Аддитивные процессы используются всякий раз, когда рабочие процессы травления недоступны, например, для медных межсоединений. Здесь литографический рисунок используется для открытия областей, где должен быть выращен новый слой (путем гальванического покрытия, в случае меди). После удаления резиста новый материал остается в негативной версии узорчатого фоторезиста. Наконец, легирование включает добавление контролируемых количеств загрязняющих веществ, которые изменяют проводящие свойства полупроводника. Ионная имплантация использует пучок ионов легирующей примеси, ускоренный на подложке с рисунком фоторезиста.
Затем выполняется литография таким образом, что области, подлежащие травлению, остаются незащищенными (не покрытыми) фоторезистом. Травление выполняется либо с использованием влажных химикатов, таких как кислоты, либо чаще в среде сухой плазмы. Фоторезист «сопротивляется» травлению и защищает материал, покрытый резистом. Когда травление завершено, резист снимается, оставляя желаемый рисунок на нанесенном слое. Аддитивные процессы используются всякий раз, когда рабочие процессы травления недоступны, например, для медных межсоединений. Здесь литографический рисунок используется для открытия областей, где должен быть выращен новый слой (путем гальванического покрытия, в случае меди). После удаления резиста новый материал остается в негативной версии узорчатого фоторезиста. Наконец, легирование включает добавление контролируемых количеств загрязняющих веществ, которые изменяют проводящие свойства полупроводника. Ионная имплантация использует пучок ионов легирующей примеси, ускоренный на подложке с рисунком фоторезиста. Резист блокирует ионы, но области, не покрытые резистом, содержат ионы, создавая избирательно легированные области, которые составляют электрическое сердце транзисторов.
Резист блокирует ионы, но области, не покрытые резистом, содержат ионы, создавая избирательно легированные области, которые составляют электрическое сердце транзисторов.
 ..
..
 Другие системы управления нечувствительны к разным количествам фоторезиста для данной работы и будут либо тратить химию впустую, либо давать спорадическое качество при проявлении.
При использовании контроля pH pH, который контролируется проявителем, рекомендуется поставщиком фоторезиста и обычно составляет около 10,5. Это число выбрано лишь частично, потому что это «хороший» pH для проявления фоторезиста. Другая причина выбора (обычно более высокого) pH заключается в том, что более высокий pH способствует большему обороту раствора, что гарантирует, что уровень растворенный фоторезист в резервуаре для проявителя поддерживается на низком уровне. Оказывается, уровень растворенного фоторезиста в ванне проявителя сильно влияет на качество проявки.
Другие системы управления нечувствительны к разным количествам фоторезиста для данной работы и будут либо тратить химию впустую, либо давать спорадическое качество при проявлении.
При использовании контроля pH pH, который контролируется проявителем, рекомендуется поставщиком фоторезиста и обычно составляет около 10,5. Это число выбрано лишь частично, потому что это «хороший» pH для проявления фоторезиста. Другая причина выбора (обычно более высокого) pH заключается в том, что более высокий pH способствует большему обороту раствора, что гарантирует, что уровень растворенный фоторезист в резервуаре для проявителя поддерживается на низком уровне. Оказывается, уровень растворенного фоторезиста в ванне проявителя сильно влияет на качество проявки.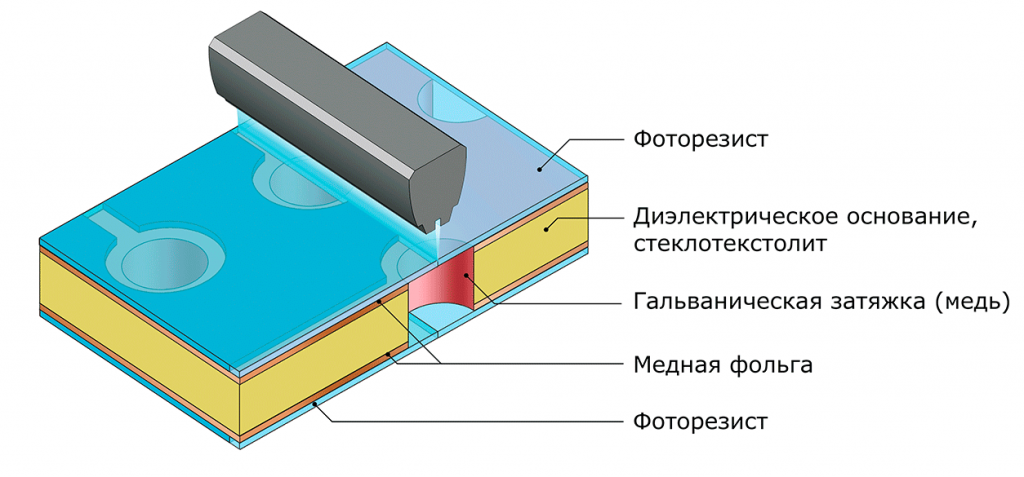 Это означает, что на галлон раствора проявителя в отстойнике приходится всего 1,3 мл на квадратный фут фоторезиста.
Это означает, что на галлон раствора проявителя в отстойнике приходится всего 1,3 мл на квадратный фут фоторезиста. Сторонники есть с обеих сторон. Одной из очевидных областей является то, что веерные форсунки имеют больше степеней свободы в регулировке формы распыла (и, следовательно, больше способов запутаться?).
Что ясно, так это то, что в большинстве фотохимических фрезерных мастерских выбор типа сопла для использования становится второстепенной проблемой примерно через месяц после установки модуля проявителя, и модуль проявителя подвергается злоупотреблениям, которые так распространены во время планового обслуживания и очистки. . Один из лучших способов обеспечить высокое качество проявки — убедиться, что люди, ответственные за демонтаж оборудования для проявки по любой причине, четко понимают критическую важность замены форсунок в выбранной конфигурации.
Сторонники есть с обеих сторон. Одной из очевидных областей является то, что веерные форсунки имеют больше степеней свободы в регулировке формы распыла (и, следовательно, больше способов запутаться?).
Что ясно, так это то, что в большинстве фотохимических фрезерных мастерских выбор типа сопла для использования становится второстепенной проблемой примерно через месяц после установки модуля проявителя, и модуль проявителя подвергается злоупотреблениям, которые так распространены во время планового обслуживания и очистки. . Один из лучших способов обеспечить высокое качество проявки — убедиться, что люди, ответственные за демонтаж оборудования для проявки по любой причине, четко понимают критическую важность замены форсунок в выбранной конфигурации. Очистка каустической содой и/или кислотой может удалить большие, легко удаляемые отложения, но игнорирует долговременные, прочно связанные остатки, которые накапливаются и в конечном итоге забивают форсунки и коллекторы.
Очистка каустической содой и/или кислотой может удалить большие, легко удаляемые отложения, но игнорирует долговременные, прочно связанные остатки, которые накапливаются и в конечном итоге забивают форсунки и коллекторы.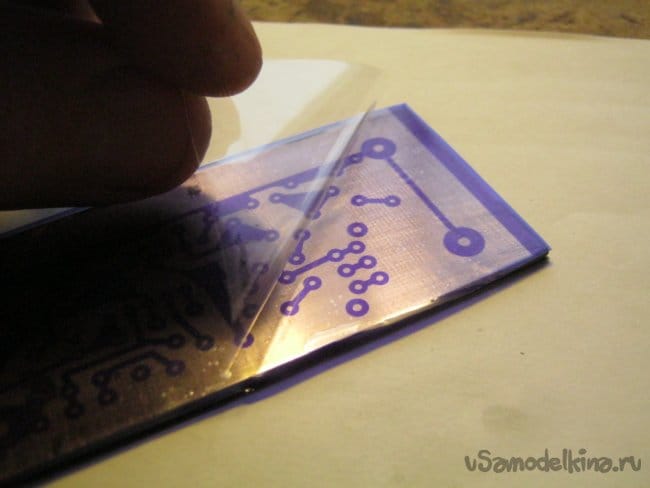 )
)