Фоторезист — Википедия. Что такое Фоторезист
Фоторезист (от фото и англ. resist) — полимерный светочувствительный материал. Наносится на обрабатываемый материал в процессе фотолитографии или фотогравировки с целью получить соответствующее фотошаблону расположение окон для доступа травящих или иных веществ к поверхности обрабатываемого материала.
Тон фоторезистов
Позитивные фоторезисты
В позитивных фоторезистах, проэкспонированные области становятся растворимыми и после проявления разрушаются. Такие фоторезисты, как правило, позволяют получать более высокие разрешения нежели негативные[1][2][3], но стоят дороже[4].

.
Для и фотолитографии при изготовлении микроэлектроники использовались позитивные двухкомпонентные фоторезисты на базе DQN (diazoquinone, DQ и novolac, N)
Распространены[когда?] следующие типы позитивных фоторезистов для g-line (литографы с длиной волны 436 нм, техпроцессы до 0,5 мкм[7][8]): Shipley 1805, Shipley 1813, Shipley 1822 (производитель Microchem[9])
Негативные фоторезисты
В негативных фоторезистах, проэкспонированные области полимеризуются и становятся нерастворимыми, так что после проявления растворяются только не проэкспонированные области. Негативные фоторезисты, как правило, обладают более высокой адгезией по сравнению с позитивными, и более устойчивы к травлению.

В целом, уже к 1972 году были достигнуты пределы классических негативных фоторезистов, и для техпроцессов лучше 2 мкм применялись позитивные фоторезисты[2][10].
Обратимые фоторезисты
Обратимые фоторезисты (image reversal[8]) — это особые фоторезисты, которые после экспонирования ведут себя как позитивные, но могут быть «обращены» посредством термической обработки и последующего экспонирования всего фоторезиста (уже без фотошаблона) ультрафиолетовым излучением. В этом случае, после проявления такие резисты будут вести себя уже как негативные. Основное отличие рисунков полученных таким образом от простого использования позитивного резиста заключается в наклоне стенок фоторезиста; в случае позитивного фоторезиста стенки наклонены наружу, что подходит для процесса травления, а при обращении рисунка фоторезиста, стенки наклонены внутрь, что является преимуществом при процессе обратной литографии.
Длины волн и типы экспонирования
Фоторезистами называют резисты экспонируемые светом (фотонами), в отличие от резистов предназначенных для экспонирования электронами. В последнем случае, фоторезисты называют электронными резистами или резистами для электронной (e-beam) литографии. Фоторезисты различаются по длине волны экспонирования, к которой они чувствительны. Наиболее стандартными длинами волн экспонирования являлись т. н. i-линия (365нм), h-линия (405нм) и g-линия (436нм) спектра излучения паров ртути. Многие фоторезисты могут быть проэкспонированы и широким спектром в УФ диапазоне (интегральное экспонирование), для чего обычно применяется ртутная лампа. Следующее поколение резистов было разработано для эксимерных лазеров KrF, ArF (Средний и Дальний ультрафиолет; 248 нм и 193 нм). Отдельные классы фоторезистов составляют материалы чувствительные к глубокому (Экстремальному) УФ (ГУФ (EUV) литография) и рентгеновскому излучению (Рентгеновская литография). Кроме того, существуют специальные фоторезисты для наноимпринтной (нанопечатной) литографии.
Толщина плёнки фоторезиста
Толщина плёнки фоторезиста является одним из ключевых его параметров. Как правило для получения высокого разрешения требуется толщина плёнки не более чем в два раза превышающая требуемое разрешение. Разрешающая способность фоторезиста определяется как максимальное количество минимальных элементов на единице длины (1мм). R=L/2l, где L — длина участка, мм; l — ширина элемента, мм. И напротив, процессы глубокого травления или обратной литографии, требуют относительно большой толщины плёнки фоторезиста. Толщина плёнки в целом определяется вязкостью фоторезиста, а также методом нанесения. В частности при нанесении центрифугированием, толщина плёнки уменьшается при увеличении скорости вращения.
Нанесение фоторезистов
Перед нанесением фоторезистов на материалы с низкой адгезией, сначала наносят подслой (например HMDS) усиливающий адгезию фоторезиста к поверхности. После нанесения, фоторезист иногда покрывают плёнкой антиотражающего покрытия для повышения эффективности экспонирования. С той же целью антиотражающее покрытие порой наносят и до нанесения фоторезиста. Сами фоторезисты наносятся следующими основными методами:
Центрифугирование
Центрифугирование — это наиболее широко распространённый метод нанесения фоторезистов на поверхность, который позволяет создавать однородную плёнку фоторезиста, и контролировать её толщину скоростью вращения.
Окунание
При использовании не подходящих для центрифугирования поверхностей, используется нанесение окунанием в фоторезист. Недостатками этого метода являются большой расход фоторезиста и неоднородность получаемых плёнок.
Аэрозольное распыление
При необходимости нанести резист на сложные поверхности используется аэрозольное распыление, однако толщина плёнки при таком методе нанесения не является однородной. Для аэрозольного напыления, как правило, используют специально предназначенные фоторезисты.
Применения фоторезистов
Изготовление печатных плат
Фоторезисты используются для получения рисунка на фольгированном диэлектрике при создании печатных плат. Для травления меди при этом используют хлорид железа или персульфат аммония. Различают два основных типа фоторезистов, используемых при производстве печатных плат: Сухой пленочный фоторезист (СПФ) и аэрозольный «POSITIV». СПФ получил более широкое распространение в производстве, так как обеспечивает равномерный слой. Представляет собой трёхслойную структуру — два слоя защитной пленки, и слой фоторезиста между ними. К обрабатываемому материалу приклеивается при помощи ламинатора.
Травление
Фоторезисты наиболее часто используются в качестве маски для процессов травления при производстве полупроводниковых приборов для микроэлектроники, в том числе МЭМС, транзисторов, и другого. Фоторезисты предназначенные для травления, как правило, имеют высокую химическую устойчивость к травителям, высокое соотношение глубины травления к разрешению. Глубина травления во многом зависит от толщины плёнки: чем толще плёнка, тем большей глубины травления можно добиться.
Легирование
Фоторезисты также используются в процессах имплантации легирующих примесей посредством ионной имплантации. Обычно, с помощью фоторезиста создаётся рисунок на оксиде покрывающем поверхность, и далее примеси имплантируются уже через окна, образованные в этом оксиде, легируя таким образом лишь отдельные участки материала.
Обратная фотолитография
В процессах обратной (взрывной литографии), после проявления фоторезиста, на плёнку фоторезиста напыляется тонкая плёнка материала. Далее, оставшиеся после проявления участки фоторезиста удаляются, унося с собой осаждённый материал, таким образом, что плёнки материала остаются только в незащищённых фоторезистом местах. Для процесса обратной литографии толщина плёнки резиста должна быть в два и более раз толще чем толщина плёнки осаждаемого материала. Кроме того, для обратной литографии часто используют двух- и трёхслойные процессы, где наносятся несколько слоёв фоторезиста. При этом нижний фоторезист обладает более высокой скоростью проявления, таким образом как бы подтравливая второй слой фоторезиста на который напылён материал. В этой связи нижний слой фоторезиста должен быть нерастворимым в для второго фоторезиста. Кроме того фоторезисты для обратной литографии должны обладать высокой температурной устойчивостью, необходимой учитывая высокие температуры некоторых видов напыления. Такие фоторезисты называют LOR фоторезистами (англ. lift-of-resist).
Пескоструйная гравировка
Также фоторезисты в виде плёнок используются в качестве маски для пескоструйной обработки.
Герметизация
Некоторые виды резистов, такие как Сyclotene, используются, как полимер для создания диэлектрических, закрывающих и герметизирующих слоёв, что позволяет сократить число технологических операций в процессе кристального производства.
Создание различных структур
Фоторезисты нередко используются и не по прямому назначению, а в качестве материала для создания различных структур для микроэлектроники. Например, специальные резисты применяются для создания полимерных волноводов нужной формы на поверхности подложки. Кроме того, из фоторезиста могут быть получены микролинзы. Для этого из фоторезиста сначала формируют нужную форму основания линзы, а затем с помощью температурной обработки оплавляют резист придавая ему форму линзы.
Химия фоторезистов
Фоторезисты чувствительные к УФ
- Позитивные — сульфо-эфиры ортонафтохинондиазида в качестве светочувствительного вещества и новолачные, феноло- или крезолоформальдегидные смолы в качестве пленкообразователя.
- Негативные — циклоолефиновые каучуки, использующие в качестве сшивающих агентов диазиды; слои поливинилового спирта с солями хромовых кислот или эфирами коричной кислоты; поливинилциннамат.
Фоторезисты чувствительные к ГУФ
Также используются фоторезисты с химическим усилением скрытого изображения, состоящие из светочувствительных ониевых солей и эфиров нафтоловых резольных смол, в которых происходят химические реакции под действием солей.
Электронные резисты и фоторезисты чувствительные к рентгену и ионным потокам
Литература
- Фотолитография и оптика, М. Берлин, 1974; Мазель Е. З., Пресс Ф. П., Планарная технология кремниевых приборов, М., 1974
- У. Моро. Микролитография. В 2-х ч. М., Мир, 1990.
- БСЭ, статья «Фоторезист»
- Photolithography. Theory and Application of Photoresists, Etchants and Solvents. К. Кох и Т. Ринке.
- Валиев К. А., Раков А. А., Физические основы субмикронной литографии в микроэлектронике, M., 1984;
- Светочувствительные полимерные материалы, под ред. А. В. Ельцова, Л., 1985. Г. К. Селиванов.
- Лапшинов Б. А. Технология литографических процессов. Учебное пособие — МИЭМ, 2011
Примечания
- ↑ Positive and Negative Photoresist (англ.). ECE, Georgia Tech. — «Negative resists were popular in the early history of integrated circuit processing, but positive resist gradually became more widely used since they offer better process controllability for small geometry features. Positive resists are now the dominant type of resist used in VLSI fabrication processes.». Проверено 18 декабря 2015.
- ↑ 1 2 Lecture11: Photolithography — I (англ.). “Instability and Patterning of Thin Polymer films”. Indian Institute of Technology. — «Historically, by 1972 the limitations of negative photoresist were reached. Subsequent developments were all based on positive photo resists.». Проверено 18 декабря 2015.
- ↑ Advanced Photoresist Technology / PSU, EE518, 2006: «Positive: exposed regions dissolve (best resolution)»
- ↑ The Photoresist Process and it’s Application to the Semiconductor Industry. CE435 — INTRODUCTION TO POLYMERS. Dept of Chemical and Biological Engineering. State University of New York (19 апреля 2000). — «…positives are more costly to produce. However, images from this resist are extremely accurate, require minimal processing technique, and involve few processing steps.». Проверено 18 декабря 2015.
- ↑ Advanced Photoresist Technology / PSU, EE518, 2006: «Two-component DQN resists: DQN, corresponding to the photo-active compound, diazoquinone (DQ) and resin, novolac (N). Dominant for G-line (436nm) and I- line (365nm) exposure and not suitable for very short wavelength exposures»
- ↑ Advanced Photoresist Technology / PSU, EE518, 2006: «Deep UV Photoresist … Limitation of Novolac based Photoresist: Strongly absorb below 250nm, KrF (248nm) marginally acceptable but not ArF (193nm). Photoresist Solution for Submicron Features…»
- ↑ http://citeseerx.ist.psu.edu/viewdoc/download?doi=10.1.1.459.6517&rep=rep1&type=pdf 2000, PII S 0018-9219(01)02071-0
- ↑ 1 2 http://www.ysu.edu/physics/tnoder/S07-PHYS2536/Notes/Chapter4-Photolithography.pdf
- ↑ Microposit S1800 Series Photo Resists
- ↑ courses.ee.psu.edu/ruzyllo/ee518/EE518_Adv.PR.Tech.S06.ppt
Ссылки
ФОТОРЕЗИСТЫ — это… Что такое ФОТОРЕЗИСТЫ?
— материалы органич. и неорганич. происхождения, чувствительные к оптич. излучению видимого или УФ-диапазона; применяются в фотолитографии для получения рельефного покрытия заданной топологии. Формирование в слое Ф., нанесённого на к.-л. подложку, рельефных областей заданной конфигурации происходит в результате его локального экспонирования и последующего проявления. При локальном экспонировании в Ф. идут физ.-хим. превращения с изменением размера, структуры или полярности молекул, ведущие к изменению свойств покрытий и возможности удаления при проявлении облучённых или необлучённых участков. Если в результате экспонирования хорошо растворимыми становятся облучённые участки и они удаляются в процессе проявления, то Ф. наз. п о з и т и в н ы м; если в процессе проявления удаляются необлучённые участки, Ф. наз. н ег а т и в н ы м. Полученное таким способом рельефное покрытие служит защитой нижележащего рабочего слоя от воздействия травлений.
Ф. используют в виде жидких композиций, к-рые наносят на рабочий слой с помощью центрифуг, валков или пульверизаторов и формируют плёнки толщиной от десятых долей до десятков микрон. Большей разрешающей способностью обладают т. н. вакуумные позитивные и негативные Ф., к-рые представляют собой слои мин. толщины, полученные методом вакуумного напыления. Кроме того, применяются т.
В качестве жидких позитивных Ф. используют составы на основе светочувствит. производных о -диазокетонов и плёнкообразующих фенольных и др.
смол. Из числа негативных жидких Ф.- на основе сенсибилизированного поливинилциннамата, поливинилового спирта и полиизо-преновых циклокаучуков со светочувствит. диазидами. Вакуумные Ф. представляют собой слои красителей, цин-наматов, халькогенидных стёкол и др. В сухих плёночных Ф. в качестве светочувствит. слоя применяют сенсибилизированные фотополимеризующиеся композиции с акрилат-ными мономерами и олигомерами, к-рые резко изменяют свою растворимость под действием УФ- и видимого света вследствие образования пространственно сшитой полимерной структуры.
Ф. чувствительны к излучению в широком спектральном диапазоне УФ- и видимого излучений, но особенно широко используется УФ-излучение ртутных ламп и эксимерных лазеров, что наиб. приемлемо в пром. условиях производства интегральных схем для микроэлектроники. В зависимости от типа Ф. их светочувствительность находится в пределах 2-20 см 2/Дж, а разрешающая способность — 100-1000 мм -1. Микродефектность (число невытравленных точек на проявленных участках после проявления) для лучших Ф. достигает 0,05 см -2.
Жидкие и вакуумные Ф. используют в осн. в микроэлектронике для создания интегральных схем. Кроме того, жидкие Ф. применяют в фототехнологии изготовления элементов голограммной, а также элементов и схем интегральной оптики. Сухие плёночные Ф. используют для изготовления печатных плат.
Лит.: Боков Ю. С., Фото-, электронно- и рентгенорезисты, М., 1982; Светочувствительные полимерные материалы, под ред. А. В. Ельцова, Л., 1985; «Журнал научной и прикладной фотографии и кинематографии», 1991, т. 36, № 3. В. А. Барачевский.
Физическая энциклопедия. В 5-ти томах. — М.: Советская энциклопедия. Главный редактор А. М. Прохоров. 1988.
Фотолитография — Википедия
Фотолитогра́фия — метод получения определённого рисунка на поверхности материала, широко используемый в микроэлектронике и других видах микротехнологий, а также в производстве печатных плат. Один из основных приёмов планарной технологии, используемой в производстве полупроводниковых приборов.
Суть процесса фотолитографии сводится к тому, что вначале на обрабатываемую поверхность наносится тонкая фоточувствительная полимерная плёнка (фоторезист). Затем эта плёнка засвечивается через фотошаблон с заданным рисунком. Далее проэкспонированные участки удаляются в проявителе. Получившийся на фоторезисте рисунок используется для таких технологических этапов планарной технологии, как травление, электроосаждение, вакуумное напыление и другие. После проведения одного из этих процессов оставшийся, не удалённый при проявлении, фоторезист также удаляется.
Принципиальное отличие фотолитографии от других видов литографии заключается в том, что экспонирование производится светом (видимым или ультрафиолетовым), тогда как в других видах литографии для этого используется рентгеновское излучение (рентгеновская литография), поток электронов (электронно-лучевая литография) или ионов (ионно-лучевая литография) и другое.
Наименьшие размеры деталей рисунка, достижимые в фотолитографии (разрешение), определяются: длиной волны используемого излучения, качеством применяемой при экспонировании оптики, свойствами фоторезиста и достигают 100 нм. Применение специальных методов (иммерсионная литография) теоретически позволяет получить разрешение до 11 нм[источник не указан 1548 дней].
Очистка и подготовка поверхности[править | править код]
Первоначально подложка (при производстве монолитных микросхем это обычно пластина из монокристаллического кремния) очищается от загрязнений в ультразвуковой ванне в различных органических растворителях: ацетоне и метаноле и полосканием в изопропаноле. В случае значительных загрязнений поверхности, её обрабатывают смесью серной кислоты и пероксида водорода (H2SO4 + H2O2) с последующим применением процесса RCA очистки.
Различные материалы подложки имеют различное сцепление (адгезию) фоторезиста с ней. Например, такие металлы, как алюминий, хром и титан имеют высокую адгезию, в то время как благородные металлы — золото, серебро или платина — имеют очень плохую адгезию. В случае низкой адгезии перед нанесением фоторезиста рекомендуется наносить тонкий подслой адгезива, увеличивающий сцепление фоторезиста с поверхностью, например, гексаметилдисилазан (ГМДС). Кроме этого, иногда и поверх фоторезиста наносят антиотражающие покрытия.
Нанесение фоторезиста[править | править код]
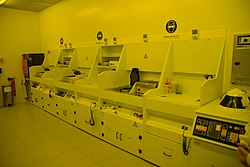 Установки центрифугирования для нанесения фоторезиста
Установки центрифугирования для нанесения фоторезистаНаиболее широко распространённый метод нанесения фоторезистов на поверхность — это центрифугирование. Этот метод позволяет создавать однородную плёнку фоторезиста и контролировать её толщину скоростью вращения пластины (порядка нескольких тысяч оборотов в минуту). Как правило, используется при работе с большими круглыми пластинами.
При использовании не подходящих для центрифугирования поверхностей, например для покрытия небольших поверхностей, используется нанесение погружением в фоторезист. Недостатками этого метода являются большой расход фоторезиста и неоднородность получаемых плёнок.
При необходимости нанести резист на сложные поверхности используется аэрозольное распыление, однако толщина плёнки при таком методе нанесения также не является однородной.
Предварительное задубливание[править | править код]
После нанесения резиста необходимо провести его предварительную сушку (задубливание). Для этого образец выдерживается несколько минут в печи, при температуре 100—120оС. Этот этап необходим для испарения растворителя, содержащегося в фоторезисте, что способствует улучшению адгезии, исключению прилипания к фотошаблону, возможности нанесения второго слоя фоторезиста и имеет положительное влияние в некоторых других аспектах.
Экспонирование[править | править код]
Длины волн экспонирования в литографии Схемы 4х различных видов экспонирования. Показаны контактный метод экспонирования, экспонирование с микрозазором и проекционные методы экспонированияПроцесс экспонирования заключается в засветке фоторезиста через фотошаблон, содержащий желаемый рисунок, светом видимого или ультрафиолетового диапазона, что и отличает процесс фотолитографии от других видов литографии. К примеру, в случае рентгеновской, ионно-лучевой и электронной литографии, для экспонирования используются рентгеновские лучи, ионы и электроны соответственно.
Наиболее стандартными длинами волны экспонирования в фотолитографии являются i-линия (365 нм), h-линия (405 нм) и g-линия (436 нм). Как бы то ни было, большинство фоторезистов могут быть проэкспонированы и широким спектром в ультрафиолетовом диапазоне (интегральное экспонирование), для чего обычно применяется ртутная лампа. В случае фотолитографии в глубоком (жёстком) ультрафиолете используются длины волн около 13,5 нм и специальные фоторезисты. Среди источников излучения, использующихся в фотолитографии, наиболее распространены:
Экспонирование может проводиться как с использованием фотошаблона, так и без него (безмасочная литография). В последнем случае рисунок на фоторезисте формируется непосредственно перемещающимся лазерным или электронным лучом или их группой, сфокусированным на поверхности фоторезиста. В случае же применения фотошаблонов чаще используются проекционные методы экспонирования, когда рисунок с фотошаблона переносится на фоторезист с использованием системы оптических линз. В некоторых вариантах литографии маска может находиться в контакте с фоторезистом, или в непосредственной близости, при наличии микрозазора.
Существуют технологии, позволяющие уменьшить искажения и изготовить микросхемы с меньшими проектными нормами:
При производстве полупроводниковых приборов для экспонирования больших по площади пластин (150, 200, 300 мм в диаметре) используют такие аппараты, как степперы и сканеры, в которых небольшой фотошаблон экспонируется на пластину многократно с помощью перемещения экспонируемой поверхности.
Основными параметрами экспонирования являются длина волны, время экспонирования и мощность источника излучения. Как правило, каждый фоторезист имеет определённое значение дозы (мДж/см2), необходимой для его экспонирования, поэтому важно правильно подобрать параметры экспонирования. При недостаточной дозе могут возникнуть проблемы с проявлением фоторезиста, а чрезмерное экспонирование может вызвать повреждения плёнки фоторезиста. От мощностных параметров зависит производительность фотолитографических установок, измеряемая в пластинах в час (wph).
Дополнительно стоит отметить такой метод фотолитографии, как «выжигание», при котором необходимые окна в полимерном слое выжигаются под воздействием на них мощного светового потока, испаряющего нанесённую на материал плёнку или прожигающего сам материал насквозь. Этот способ применяется для изготовления малотиражных офсетных форм и в некоторых системах ризографии.
Вторичное задубливание[править | править код]
Вторичное задубливание производится непосредственно после экспонирования и не является обязательным шагом. Этот этап требуется лишь в случаях применения химически усиленных фоторезистов, применения обращаемого фоторезиста, потребности в релаксации толстых плёнок фоторезиста и в некоторых других ситуациях.
Проявление[править | править код]
В процессе проявления части фоторезиста удаляются специальной жидкостью — проявителем (например гидроксид тетраметиламмония), формируя окна в плёнке фоторезиста. В случае использования позитивного фоторезиста удаляется проэкспонированная область, а в случае негативного — не проэкспонированная.
Определённые фоторезисты проявляются определённым проявителем и не проявляются другими. Как правило, проявитель разбавляется водой (1:2, 1:4), при этом степень разбавления контролирует скорость проявления, которая также зависит от полученной фоторезистом дозы при экспонировании.
Финальное задубливание[править | править код]
Окончательное задубливание фоторезиста также является не обязательным шагом, хотя нередко помогает улучшить его свойства. В частности, сушка при 130—140оС повышает химическую и температурную устойчивость проявленного фоторезиста для таких последующих этапов, как электроосаждение, сухое и жидкостное травление.
Обработка поверхности[править | править код]
Как правило, фотолитография тесно связана с технологическим этапом, для которого собственно и требуется получаемый из фоторезиста рисунок. Наиболее распространённым процессом на этом этапе является травление, хотя нередко применяются и такие процессы как электроосаждение и напыление при проведении обратной фотолитографии.
Травление[править | править код]
Травление является наиболее часто используемым в совокупности с фотолитографией процессом при производстве печатных плат и полупроводниковых приборов для микроэлектроники. Существуют два основных вида травления: жидкостное (жидкое) и сухое травление. Сухое травление подразделяется на физическое распыление, ионное распыление; газофазное химическое травление; реактивное ионное травление. В зависимости от задач, применяют тот или иной тип травления. Жидкостное травление применяют в основном при изготовлении печатных плат, а также для вытравливания жертвенного слоя при изготовлении МЭМС, и других применений, где требуется изотропное травление (то есть травление во всех направлениях). Плазменное, и в особенности глубокое плазменное травление, применяют когда необходимо протравить структуру относительно глубоко, сохраняя при этом, как можно более вертикальный угол наклона стенок, то есть протравить анизотропно, только в вертикальном направлении. Результат травления тесно связан с параметрами фоторезиста, что во многом и определяет его выбор.
Электроосаждение[править | править код]
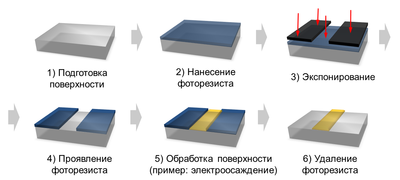 Схема основных этапов процесса фотолитографии
Схема основных этапов процесса фотолитографииВ процессе электроосаждения, окна в фоторезисте используются для осаждения в них материала из электролита.
Напыление. Обратная литография[править | править код]
В случаях, когда требуется получить рисунок из материала плохо подвергающегося травлению, используют процесс обратной (взрывной) литографии. В процессе обратной литографии на нанесённый и проявленный фоторезист напыляется тонкий слой материала (обычно металла), из которого требуется сформировать рисунок. На следующем этапе производится снятие фоторезиста, так что напылённый материал остаётся только в окнах, не защищённых фоторезистом, а плёнка, попавшая на фоторезист, уносится вместе с ним, то есть осуществляется так называемый «взрыв». Для обратной литографии, как правило, используются специальные LOR (lift-of-resist) фоторезисты. Существуют многочисленные модификации этого метода, например, когда используются два или даже три слоя фоторезистов с разной скоростью проявления. В целом, для аккуратного снятия фоторезиста требуется чтобы плёнка фоторезиста была в два и более раз толще, чем плёнка напылённого материала, а также чтобы стенки фоторезиста имели отрицательный наклон, что исключит возможность их покрытия напыляемым материалом.
Снятие фоторезиста[править | править код]
Финальным этапом процесса фотолитографии является снятие фоторезиста. Для удаления фоторезиста с обработанной поверхности используют либо обработку в специальной жидкости — снимателе (например, диметилсульфоксид, N-метилпирролидон, смесь серной кислоты и перекиси водорода), либо обработку в кислородсодержащей плазме. Как правило, определённые сниматели подходят только к определённым группам фоторезистов. В процессах обратной фотолитографии, вместе с фоторезистом удаляется и покрывающая его плёнка материала. Если на предыдущих этапах применялись усилители адгезии или антиотражающие покрытия, они, как правило, также удаляются снимателем.
Фоторезист — Википедия. Что такое Фоторезист
Фоторезист (от фото и англ. resist) — полимерный светочувствительный материал. Наносится на обрабатываемый материал в процессе фотолитографии или фотогравировки с целью получить соответствующее фотошаблону расположение окон для доступа травящих или иных веществ к поверхности обрабатываемого материала.
Тон фоторезистов
Позитивные фоторезисты
В позитивных фоторезистах, проэкспонированные области становятся растворимыми и после проявления разрушаются. Такие фоторезисты, как правило, позволяют получать более высокие разрешения нежели негативные[1][2][3], но стоят дороже[4].

.
Для и фотолитографии при изготовлении микроэлектроники использовались позитивные двухкомпонентные фоторезисты на базе DQN (diazoquinone, DQ и novolac, N)[5]. В дальнейшем, для субмикронных процессов, использующих эксимерные лазеры KrF, ArF, применялись фоторезисты на базе органического стекла, неорганические резисты (Ag + Ge-Se), Polysilyne, двух- и трехслойные резисты (многослойные резисты для техпроцессов 90 нм и более новых)[6].
Распространены[когда?] следующие типы позитивных фоторезистов для g-line (литографы с длиной волны 436 нм, техпроцессы до 0,5 мкм[7][8]): Shipley 1805, Shipley 1813, Shipley 1822 (производитель Microchem[9])
Негативные фоторезисты
В негативных фоторезистах, проэкспонированные области полимеризуются и становятся нерастворимыми, так что после проявления растворяются только не проэкспонированные области. Негативные фоторезисты, как правило, обладают более высокой адгезией по сравнению с позитивными, и более устойчивы к травлению.

В целом, уже к 1972 году были достигнуты пределы классических негативных фоторезистов, и для техпроцессов лучше 2 мкм применялись позитивные фоторезисты[2][10].
Обратимые фоторезисты
Обратимые фоторезисты (image reversal[8]) — это особые фоторезисты, которые после экспонирования ведут себя как позитивные, но могут быть «обращены» посредством термической обработки и последующего экспонирования всего фоторезиста (уже без фотошаблона) ультрафиолетовым излучением. В этом случае, после проявления такие резисты будут вести себя уже как негативные. Основное отличие рисунков полученных таким образом от простого использования позитивного резиста заключается в наклоне стенок фоторезиста; в случае позитивного фоторезиста стенки наклонены наружу, что подходит для процесса травления, а при обращении рисунка фоторезиста, стенки наклонены внутрь, что является преимуществом при процессе обратной литографии.
Длины волн и типы экспонирования
Фоторезистами называют резисты экспонируемые светом (фотонами), в отличие от резистов предназначенных для экспонирования электронами. В последнем случае, фоторезисты называют электронными резистами или резистами для электронной (e-beam) литографии. Фоторезисты различаются по длине волны экспонирования, к которой они чувствительны. Наиболее стандартными длинами волн экспонирования являлись т. н. i-линия (365нм), h-линия (405нм) и g-линия (436нм) спектра излучения паров ртути. Многие фоторезисты могут быть проэкспонированы и широким спектром в УФ диапазоне (интегральное экспонирование), для чего обычно применяется ртутная лампа. Следующее поколение резистов было разработано для эксимерных лазеров KrF, ArF (Средний и Дальний ультрафиолет; 248 нм и 193 нм). Отдельные классы фоторезистов составляют материалы чувствительные к глубокому (Экстремальному) УФ (ГУФ (EUV) литография) и рентгеновскому излучению (Рентгеновская литография). Кроме того, существуют специальные фоторезисты для наноимпринтной (нанопечатной) литографии.
Толщина плёнки фоторезиста
Толщина плёнки фоторезиста является одним из ключевых его параметров. Как правило для получения высокого разрешения требуется толщина плёнки не более чем в два раза превышающая требуемое разрешение. Разрешающая способность фоторезиста определяется как максимальное количество минимальных элементов на единице длины (1мм). R=L/2l, где L — длина участка, мм; l — ширина элемента, мм. И напротив, процессы глубокого травления или обратной литографии, требуют относительно большой толщины плёнки фоторезиста. Толщина плёнки в целом определяется вязкостью фоторезиста, а также методом нанесения. В частности при нанесении центрифугированием, толщина плёнки уменьшается при увеличении скорости вращения.
Нанесение фоторезистов
Перед нанесением фоторезистов на материалы с низкой адгезией, сначала наносят подслой (например HMDS) усиливающий адгезию фоторезиста к поверхности. После нанесения, фоторезист иногда покрывают плёнкой антиотражающего покрытия для повышения эффективности экспонирования. С той же целью антиотражающее покрытие порой наносят и до нанесения фоторезиста. Сами фоторезисты наносятся следующими основными методами:
Центрифугирование
Центрифугирование — это наиболее широко распространённый метод нанесения фоторезистов на поверхность, который позволяет создавать однородную плёнку фоторезиста, и контролировать её толщину скоростью вращения.
Окунание
При использовании не подходящих для центрифугирования поверхностей, используется нанесение окунанием в фоторезист. Недостатками этого метода являются большой расход фоторезиста и неоднородность получаемых плёнок.
Аэрозольное распыление
При необходимости нанести резист на сложные поверхности используется аэрозольное распыление, однако толщина плёнки при таком методе нанесения не является однородной. Для аэрозольного напыления, как правило, используют специально предназначенные фоторезисты.
Применения фоторезистов
Изготовление печатных плат
Фоторезисты используются для получения рисунка на фольгированном диэлектрике при создании печатных плат. Для травления меди при этом используют хлорид железа или персульфат аммония. Различают два основных типа фоторезистов, используемых при производстве печатных плат: Сухой пленочный фоторезист (СПФ) и аэрозольный «POSITIV». СПФ получил более широкое распространение в производстве, так как обеспечивает равномерный слой. Представляет собой трёхслойную структуру — два слоя защитной пленки, и слой фоторезиста между ними. К обрабатываемому материалу приклеивается при помощи ламинатора.
Травление
Фоторезисты наиболее часто используются в качестве маски для процессов травления при производстве полупроводниковых приборов для микроэлектроники, в том числе МЭМС, транзисторов, и другого. Фоторезисты предназначенные для травления, как правило, имеют высокую химическую устойчивость к травителям, высокое соотношение глубины травления к разрешению. Глубина травления во многом зависит от толщины плёнки: чем толще плёнка, тем большей глубины травления можно добиться.
Легирование
Фоторезисты также используются в процессах имплантации легирующих примесей посредством ионной имплантации. Обычно, с помощью фоторезиста создаётся рисунок на оксиде покрывающем поверхность, и далее примеси имплантируются уже через окна, образованные в этом оксиде, легируя таким образом лишь отдельные участки материала.
Обратная фотолитография
В процессах обратной (взрывной литографии), после проявления фоторезиста, на плёнку фоторезиста напыляется тонкая плёнка материала. Далее, оставшиеся после проявления участки фоторезиста удаляются, унося с собой осаждённый материал, таким образом, что плёнки материала остаются только в незащищённых фоторезистом местах. Для процесса обратной литографии толщина плёнки резиста должна быть в два и более раз толще чем толщина плёнки осаждаемого материала. Кроме того, для обратной литографии часто используют двух- и трёхслойные процессы, где наносятся несколько слоёв фоторезиста. При этом нижний фоторезист обладает более высокой скоростью проявления, таким образом как бы подтравливая второй слой фоторезиста на который напылён материал. В этой связи нижний слой фоторезиста должен быть нерастворимым в для второго фоторезиста. Кроме того фоторезисты для обратной литографии должны обладать высокой температурной устойчивостью, необходимой учитывая высокие температуры некоторых видов напыления. Такие фоторезисты называют LOR фоторезистами (англ. lift-of-resist).
Пескоструйная гравировка
Также фоторезисты в виде плёнок используются в качестве маски для пескоструйной обработки.
Герметизация
Некоторые виды резистов, такие как Сyclotene, используются, как полимер для создания диэлектрических, закрывающих и герметизирующих слоёв, что позволяет сократить число технологических операций в процессе кристального производства.
Создание различных структур
Фоторезисты нередко используются и не по прямому назначению, а в качестве материала для создания различных структур для микроэлектроники. Например, специальные резисты применяются для создания полимерных волноводов нужной формы на поверхности подложки. Кроме того, из фоторезиста могут быть получены микролинзы. Для этого из фоторезиста сначала формируют нужную форму основания линзы, а затем с помощью температурной обработки оплавляют резист придавая ему форму линзы.
Химия фоторезистов
Фоторезисты чувствительные к УФ
- Позитивные — сульфо-эфиры ортонафтохинондиазида в качестве светочувствительного вещества и новолачные, феноло- или крезолоформальдегидные смолы в качестве пленкообразователя.
- Негативные — циклоолефиновые каучуки, использующие в качестве сшивающих агентов диазиды; слои поливинилового спирта с солями хромовых кислот или эфирами коричной кислоты; поливинилциннамат.
Фоторезисты чувствительные к ГУФ
Также используются фоторезисты с химическим усилением скрытого изображения, состоящие из светочувствительных ониевых солей и эфиров нафтоловых резольных смол, в которых происходят химические реакции под действием солей.
Электронные резисты и фоторезисты чувствительные к рентгену и ионным потокам
Литература
- Фотолитография и оптика, М. Берлин, 1974; Мазель Е. З., Пресс Ф. П., Планарная технология кремниевых приборов, М., 1974
- У. Моро. Микролитография. В 2-х ч. М., Мир, 1990.
- БСЭ, статья «Фоторезист»
- Photolithography. Theory and Application of Photoresists, Etchants and Solvents. К. Кох и Т. Ринке.
- Валиев К. А., Раков А. А., Физические основы субмикронной литографии в микроэлектронике, M., 1984;
- Светочувствительные полимерные материалы, под ред. А. В. Ельцова, Л., 1985. Г. К. Селиванов.
- Лапшинов Б. А. Технология литографических процессов. Учебное пособие — МИЭМ, 2011
Примечания
- ↑ Positive and Negative Photoresist (англ.). ECE, Georgia Tech. — «Negative resists were popular in the early history of integrated circuit processing, but positive resist gradually became more widely used since they offer better process controllability for small geometry features. Positive resists are now the dominant type of resist used in VLSI fabrication processes.». Проверено 18 декабря 2015.
- ↑ 1 2 Lecture11: Photolithography — I (англ.). “Instability and Patterning of Thin Polymer films”. Indian Institute of Technology. — «Historically, by 1972 the limitations of negative photoresist were reached. Subsequent developments were all based on positive photo resists.». Проверено 18 декабря 2015.
- ↑ Advanced Photoresist Technology / PSU, EE518, 2006: «Positive: exposed regions dissolve (best resolution)»
- ↑ The Photoresist Process and it’s Application to the Semiconductor Industry. CE435 — INTRODUCTION TO POLYMERS. Dept of Chemical and Biological Engineering. State University of New York (19 апреля 2000). — «…positives are more costly to produce. However, images from this resist are extremely accurate, require minimal processing technique, and involve few processing steps.». Проверено 18 декабря 2015.
- ↑ Advanced Photoresist Technology / PSU, EE518, 2006: «Two-component DQN resists: DQN, corresponding to the photo-active compound, diazoquinone (DQ) and resin, novolac (N). Dominant for G-line (436nm) and I- line (365nm) exposure and not suitable for very short wavelength exposures»
- ↑ Advanced Photoresist Technology / PSU, EE518, 2006: «Deep UV Photoresist … Limitation of Novolac based Photoresist: Strongly absorb below 250nm, KrF (248nm) marginally acceptable but not ArF (193nm). Photoresist Solution for Submicron Features…»
- ↑ http://citeseerx.ist.psu.edu/viewdoc/download?doi=10.1.1.459.6517&rep=rep1&type=pdf 2000, PII S 0018-9219(01)02071-0
- ↑ 1 2 http://www.ysu.edu/physics/tnoder/S07-PHYS2536/Notes/Chapter4-Photolithography.pdf
- ↑ Microposit S1800 Series Photo Resists
- ↑ courses.ee.psu.edu/ruzyllo/ee518/EE518_Adv.PR.Tech.S06.ppt
Ссылки
Изготовление платы с помощью фоторезиста
Хочу поделиться своим опытом изготовления печатных плат с помощью пленочного негативного фоторезиста. На этот раз я использовал фоторезист Riston 200.
Первое что нам понадобиться, сделать качественный фотошаблон. Для этого нужно распечатать наш рисунок лазерным принтером на обычной бумаге. Чем тоньше бумага, тем лучше. Далее, для повышения контрастности (если это необходимо), я беру фотошаблон и на доли секунды полностью погружаю его в банку с растворителем (растворитель использую автомобильный 647). Даю ему подсохнуть и потом пропитываю подсолнечным маслом.
В итоге должен получиться такой фотошаблон.

Перед нанесением фоторезиста нужно подготовить поверхность текстолита. Для этого понадобиться чистящий порошок, например, как на фото, и наждачная бумага зернистостью 800-1000.

Берем текстолит, насыпаем на него немного порошка и с помощью наждачки начинаем его чистить. Наждачку при этом нужно смочить водой. Также несколько капель можно капнуть и на порошок.
После такой чистки поверхность текстолита у меня получается полуматовой. Это хорошо для фоторезиста, потому что он будет лучше держаться.
После того как мы почистили плату, порошок нужно тщательно смыть теплой водой. После смывки обратите внимание, как ложиться на текстолит вода. Она должна ложиться ровным слоем, не собираясь в капли. Если этого нет, чистку нужно повторить (можно без наждачки). Когда текстолит отмыт, я сразу бросаю его в миску с водой и накрываю ее, чтобы туда не попал мусор.
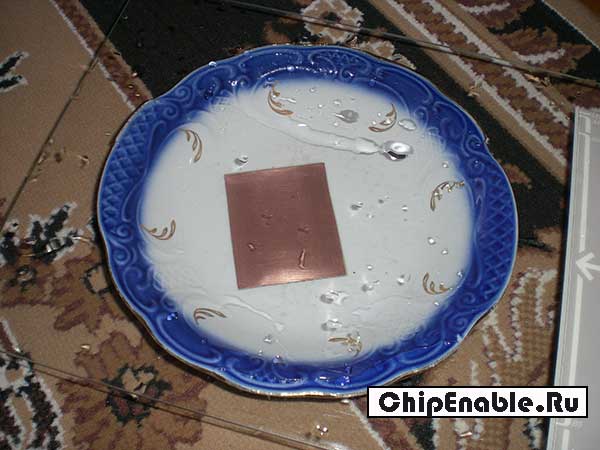
Далее, отрезаем нужный нам кусок фоторезиста с небольшим запасом, берем кусок липкой ленты и одной ее частью приклеиваем к нижней стороне фоторезиста. Другой стороной приклеиваем ленту к какой-нибудь поверхности и начинаем отделять от фоторезиста нижнюю защитную пленку.

Таким способом я только начинаю отделение пленки, а срываю ее полностью только над миской или даже частично в воде, чтобы фоторезист не слипся. После того как мы сняли защитную пленку, опускаем фоторезист на дно и прижимаем его к текстолиту.

Теперь берем все это, аккуратно вытягиваем и вытираем с него воду. Затем берем резиновый валик и начинаем им слегка разглаживать фоторезист, пока не выгоним из под него всю воду. Для этой процедуры я использую валик от старого принтера.

После этого берем фен и с легка нагреваем текстолит. Текстолит нужно греть с обратной стороны текстолита.

После небольшого прогрева берем валик и начинаем катать со всех сторон по фоторезисту. Делаю я так раз 5-6, с каждым разом все сильнее нагревая текстолит, и с каждым разом все сильнее прижимая валик.
Для засветки фоторезиста я использую вот такую ультрафиолетовую лампу.

И такой настольный светильник.

Для засветки также пригодиться стекло. Я использую стекло из старого принтера, потому что где-то читал, что оно лучше пропускает ультрафиолет.
Вот так у меня происходит засветка фоторезиста. Естественно, засветка фоторезистра происходит через фотошаблон.

На расстоянии 20см засветка у меня длится где-то 8-9 минут. Чем старее фоторезист, тем больше времени может понадобиться для его засветки.
После засветки можно наблюдать изменение цвета засвеченных областей.

Важно! Роботу с фоторезистом нужно проводить в затемненной комнате. Если солнце сильно не светит, то мне достаточно просто закрыть шторку, ну а если этого бывает недостаточно, то я на карниз еще вешаю одеяло. После засветки также нельзя допускать попадания на заготовку прямых солнечных лучей и света от ламп, особенно экономок.
Для проявки фоторезиста я использую кальцинированную соду в следующей пропорции: одна чайная ложка с горкой на один литр воды.
Берем посуду, наливаем туда литр теплой воды, кидаем ложку соды, размешиваем.
Затем с фоторезиста нужно снять верхнюю защитную пленку. Она очень хорошо снимается под струей холодной воды, проведите несколько раз пальцем по краю текстолита и она без проблем снимется. После снятия пленки бросаем нашу заготовку в проявитель.

Я делаю так: подержу ее десять секунд в растворе, потом вытягиваю и кисточкой начинаю водить туда сюда. Можно и не вытягивать, но так лучше, потому что видно, что на ней происходит. Проявляется фоторезист у меня в течении одной минуты.
Вот что должно получиться после проявки.

Для травления печатных плат я использую хлорное железо разведенное водой согласно инструкции. Чтобы этот процесс происходил быстрее, я ставлю посуду с хлорным железом в ведро наполненное горячей водой. В свежем растворе травление длиться 15-20 минут.
Вот и результат.
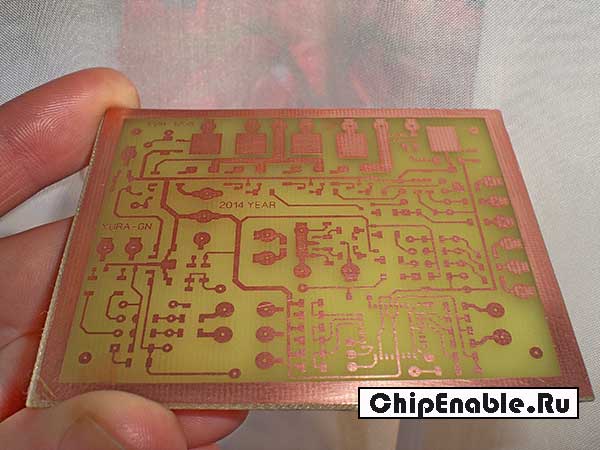
А это уже луженная плата.

Автор статьи: Юрий Гузиенко.
Формирование плёнки фоторезиста1.Режимы формирования плёнки фоторезиста
В фоторезисты введена специальная добавка, обеспечивающая высокую степень однородности пленки по толщине. Локальная разнотолщинность пленки не превышает 10 нм. Номинальное значение толщины пленки фоторезиста, указано в таблице для стандартных условий (скорость вращения центрифуги 3000 об/мин, время вращения 40 сек, 21 оС, влажность 45 % и т.д.). Такая толщина пленки не обязательно будет формироваться в условиях потребителей. Толщина (мкм) = const / (скорость)1/2Величина const определяется одним замером толщины пленки фоторезиста при фиксированной скорости вращения центрифуги для данных условий.Зависимость толщины пленки для фоторезистов ФП-05Ф — ФП-20Ф представлена на графике: 2.Предварительная сушка пленки фоторезиста:
Назначение предварительной сушки — это удаление растворителя и таким образом высушивание резистивной пленки. Из-за высокой точки кипения растворителя (>130 оC) растворитель всегда остается в небольших количествах в высушенной пленке в количествах примерно нескольких процентов (до 10%). Этот остаточный растворитель влияет на скорость растворения экспонированного фоторезиста и, следовательно, на светочувствительность. Поэтому условия предварительной сушки должны хорошо контролироваться для воспроизводимого технологического процесса. Если фоторезист подвергается в течение длительного периода воздействию высоких температур выше 100 оC, то светочувствительный нафтохинондиазид термически разлагается и литографическая эффективность пленки падает. Поэтому температура в конвективном шкафу 90 оC и время сушки 30 минут являются нормальными. Необходимо обратить внимание, что сушильный шкаф должен быть конвективным с принудительной циркуляцией. В противном случае время сушки возрастает на время, необходимое для достижения в шкафу без конвекции стационарной температуры 90 оC. Ситуация меняется, если сушка осуществляется на горячей плите. В этом случае время сушки укорачивается обычно до 40-50 сек. Так как кремний является хорошим проводником тепла, то равновесная температура достигается уже примерно через 10 сек. По этой причине температура сушки на горячей плите обычно на 10-20 оC выше, чем в печи. Приемлемые условия сушки на горячей плите — это 110 оC в течение 45 сек. Экспонирование:
Все позитивные фоторезисты чувствительны к ультрафиолетовому свету, поэтому обычно используются ртутные лампы. Энергия света должна поглощаться фотоактивным соединением — нафтохинондиазидом. При экспонировании нафтохинондиазид превращается в инденкарбоновую кислоту. Эта кислота затем растворяется в щелочном проявителе. Спектральная чувствительность фоторезиста определяется двумя факторами: ниже 310 нм новолачная смола, входящая в состав фоторезиста проявляет сильное поглощение, предотвращая проникновение ультрафиолетового света в пленку фоторезиста, выше 440 нм нафтохинондиазид проявляет слабое поглощение на «хвосте» вплоть до 475 нм, выше этих длин волн фоторезист совершенно прозрачен и не проявляет светочувствительности. Таким образом, все работы с пленкой фоторезиста могут проводиться при желтом освещении. Вышеуказанном диапазоне длин волн есть три максимума эмиссии ртутной лампы при: 365 нм (i-линия), 405 нм (h-линия) и 436 нм (g-линия). Современные проекционные установки используют либо выделенную фильтрами линию длин волн (главным образом g и i -линии), либо две, либо все три линии -широкополосное экспонирование. Во время экспонирования поглощение светочувствительного нафтохинондиазида падает из-за превращения в инденкарбоновую кислоту. Это одна из причин, обеспечивающих высокую разрешающую способность позитивных фоторезистов с практически вертикальными стенками профиля. В начале экспонирования облучаемая зона поверхности пленки становится более прозрачной по сравнению с не экспонируемой зоной. Таким образом, на поверхности пленки формируется виртуальная фотомаска для экспонирования нижележащих слоев, превращение нафтохинондиазида протекает далее в пленке фоторезиста до подложки. Экспонирование позитивного фоторезиста следует выполнять при контролируемых окружающих условиях, особенно относительной влажности и температуры. Это требование вытекает из того, что превращение нафтохинондиазида в проявляемую инденкарбоновую кислоту требует одной молекулы воды на одну молекулу нафтохинондиазида. Если воды нет, то нафтохинондиазид сшивается в нерастворимое соединение, экспонированные зоны пленки не будут проявляться в проявителе. Необходимая для реакции вода не содержится в пленке, а адсорбируется как влага из атмосферы. По этой причине фоточувствительность фоторезиста резко падает при относительной влажности менее 30%. Верхний предел относительной влажности не определяется самим фоторезистом, однако, если относительная влажность выше 60%, на поверхности подложки будет абсорбироваться слишком много воды, что в конечном итоге приводит к потере адгезии фоторезиста. По этой причине можно рекомендовать относительную влажность на уровне 45%. Гигроскопичную поверхность подложки можно обрабатывать HMDS до нанесения фоторезиста. Оптимизация условий экспонирования для фоторезистов ФП-05Ф — ФП -20Ф приведена в разделе оптимизация. Пост — экспозиционная сушка (до проявления).В большинстве случаях нет необходимости в пост — экспозиционной сушке. Экспонированный фоторезист может проявляться немедленно после экспонирования. Однако в некоторых случаях литографическая эффективность может быть улучшена путем применения пост — экспозиционной сушки (после экспонирования и до проявления). Особенно это касается экспонирования монохроматическим светом (степперы g- и i — линии). Энергия света, поглощаемая слоями фоторезиста, меняется по толщине пленки. Эта вариация обусловлена в первую очередь интерференцией падающего и отраженного от подложки света. В результате этого явления образуются так называемые «стоячие волны», видимые вдоль профиля стенки с помощью электронного микроскопа. Так как большинство поверхностей вызывают фазовый сдвиг волны на 1800 для отраженного света, то на поверхности раздела фоторезист- подложка будет наблюдаться минимум интенсивности света. Если поверхностный слой подложки является прозрачным (окись кремния), то становится существенным толщина слоя окиси кремния. В результате этого явления на подложке может оставаться тончайший «налет» слабо экспонированного фоторезиста, который не удаляется при проявлении. Для удаления этого слоя приходится прибегать к существенному переэкспонированию фоторезиста. Стоячие волны являются видимой частью интерференционного эффекта. Этот эффект приводит к значительному изменению дозы экспонирования при изменении толщины пленки вдоль поверхности. Изменение толщины на 65 нм (четверть длины волны g — линии) может привести к 20% изменению дозы экспонирования. Для i-линии и ДУФ-фоторезистов этот эффект еще сильнее. Такие изменения толщины пленки наблюдаются на любой поверхности. Эти эффекты могут быть минимизированы с помощью пост — экспозиционной сушки. Температура для этой сушки должна быть на 20 оС выше температуры предварительной сушки, а время около 45 — 60 сек. В процессе этого нагрева происходит до определенной степени диффузия экспонированного и не экспонированного нафтохинондиазида и в результате наблюдается выравнивание различий в скорости растворения и, таким образом выглаживание профиля фоторезиста. Чем выше разность температур между предварительной сушкой и пост — экспозиционной сушкой, тем быстрее процесс диффузии. Однако температура пост — экспозиционной сушки не должна превышать 130 оС, чтобы избежать значительного термического разложения нафтохинондиазида. Наилучшее решение 110 оС в течении 50 сек. Кроме того введение пост — экспозиционной сушки улучшает адгезию и термическую стабильность профиля фоторезиста.Проявление
Экспонированные области фоторезиста растворяются на стадии проявления. Условия проявления определяются прежде всего типом фоторезиста. Каждая марка фоторезиста имеет оптимальное время проявления. В большинстве случаев время проявления находится в пределах 20 — 50 сек, только фоторезисты большой толщины (> 3 мкм) требуют большего времени проявления. Температура проявления сама по себе не является критической и обычная комнатная температура (20 — 25 оС) является приемлемой, однако для воспроизводимости процесса важно поддерживать температуру проявителя постоянной в пределах +1 оС. Более детально стадия проявление для фоторезистов ФП-05Ф — ФП-20Ф обсуждается в разделе оптимизация фотолитографического процесса. ЗадубливаниеЦель стадии задубливания — это дальнейшая стабилизация пленки фоторезиста перед травлением. Обычная температура 140 оС в течение 30 минут в конвективном шкафу. На стадии задубливания удаляется остаточный растворитель, происходит термическое разложение нафтохинондиазида и структурирование пленки фоторезиста. Эти процессы улучшают адгезию и стойкость пленки к травителям.Необходимо иметь в виду два фактора:
I ступень:110 оС-15 мин II ступень:120 оС-15 мин III ступень:140 оС-15 мин. Оптимизация.На графике приведены кривые проявления фоторезистов ФП-10Ф, ФП-15Ф и ФП-20ФЭкспонирование осуществлялось параллельным, полным светом лампы ДРШ-1000 при освещенности света в плоскости пленки фоторезиста 15.000 — 20.000 люкс. На практике используют ртутные лампы разной мощности, полный или монохроматический свет, освещенность меняется в процессе старения лампы, часть световой энергии поглощается фотошаблоном, люксометры требуют постоянной калибровки. Поэтому возникает важный вопрос об оптимальном времени экспонирования. Время экспонирования и время проявления тесно связаны между собой. Недостаточное время экспонирования требует в последующем перепроявления фоторезиста. Для фоторезистов с небольшим контрастом (малая устойчивость пленки фоторезиста) недостаточное экспонирование можно частично выправить перепроявлением. Однако разрешение фоторезиста при этом падает, профиль стенок фоторезиста становится более пологой. Для высококонтрастных фоторезистов необходима оптимизации времен экспонирования и проявления, при этом достигается практически вертикальность профиля стенок фоторезиста. Фоторезисты ФП-10Ф, ФП-15Ф, ФП-20Ф являются контрастными фоторезистами, требующие оптимального выбора времени экспонирования. Из приведенного выше графика видно, что начиная с определенного для каждого фоторезиста времени экспонирования наблюдается резкое увеличение время проявления. Данная точка является критической. При недостаточном времени экспонирования пленка фоторезиста будет проявляться очень долго. Приведенные графики позволяют оптимизировать время экспонирования, путем фиксирования времени проявления фоторезиста. Таким образом, оптимальные времена проявления составляют: Фоторезист ФП-10Ф — 15-20 сек Фоторезист ФП-15Ф — 30-35 сек Фоторезист ФП-20Ф — 45 -50 сек Исходя из этих данных, подбирают требуемое время экспонирования фоторезиста для конкретных аппаратных условий. Если время экспонирования недостаточно, то пленка будет проявляться более длительное время вне указанных пределов проявления для определенного фоторезиста. Если время экспонирования велико, то время проявление сокращается, но это нежелательно с точки зрения производительности процесса. |

