PhysBook:Электронный учебник физики — PhysBook
Содержание
- 1 Учебники
-
2 Механика
- 2.1 Кинематика
- 2.2 Динамика
- 2.3 Законы сохранения
- 2.4 Статика
- 2.5 Механические колебания и волны
-
3 Термодинамика и МКТ
- 3.1 МКТ
 2 Термодинамика
2 Термодинамика
-
4 Электродинамика
- 4.1 Электростатика
- 4.2 Электрический ток
- 4.3 Магнетизм
- 4.4 Электромагнитные колебания и волны
- 5.1 Геометрическая оптика
- 5.2 Волновая оптика
-
5.
 3 Фотометрия
3 Фотометрия
- 5.4 Квантовая оптика
- 5.5 Излучение и спектры
- 5.6 СТО
-
6 Атомная и ядерная
- 6.1 Атомная физика. Квантовая теория
- 6.2 Ядерная физика
- 7 Общие темы
- 8 Новые страницы
Здесь размещена информация по школьной физике:
- материалы из учебников, лекций, рефератов, журналов;
- разработки уроков, тем;
- flash-анимации, фотографии, рисунки различных физических процессов;
- ссылки на другие сайты
и многое другое.
Каждый зарегистрированный пользователь сайта имеет возможность выкладывать свои материалы (см. справку), обсуждать уже созданные.
Учебники
Формулы по физике – 7 класс – 8 класс – 9 класс – 10 класс – 11 класс –
Механика
Кинематика
Основные понятия кинематики – Прямолинейное движение – Криволинейное движение – Движение в пространстве
Динамика
Законы Ньютона – Силы в механике – Движение под действием нескольких сил
Законы сохранения
Закон сохранения импульса – Закон сохранения энергии
Статика
Статика твердых тел – Динамика твердых тел – Гидростатика – Гидродинамика
Механические колебания и волны
Механические колебания – Механические волны
Термодинамика и МКТ
МКТ
Основы МКТ – Газовые законы – МКТ идеального газа
Термодинамика
Первый закон термодинамики – Второй закон термодинамики – Жидкость-газ – Поверхностное натяжение – Твердые тела – Тепловое расширение
Электродинамика
Электростатика
Электрическое поле и его параметры – Электроемкость
Электрический ток
Постоянный электрический ток – Электрический ток в металлах – Электрический ток в жидкостях – Электрический ток в газах – Электрический ток в вакууме – Электрический ток в полупроводниках
Магнетизм
Магнитное поле – Электромагнитная индукция
Электромагнитные колебания и волны
Электромагнитные колебания – Производство и передача электроэнергии – Электромагнитные волны
Оптика.
 СТО
СТОГеометрическая оптика
Прямолинейное распространение света. Отражение света – Преломление света – Линзы
Волновая оптика
Свет как электромагнитная волна – Интерференция света – Дифракция света
Фотометрия
Фотометрия
Квантовая оптика
Квантовая оптика
Излучение и спектры
Излучение и спектры
СТО
СТО
Атомная и ядерная
Атомная физика. Квантовая теория
Строение атома – Квантовая теория – Излучение атома
Ядерная физика
Атомное ядро – Радиоактивность – Ядерные реакции – Элементарные частицы
Общие темы
Измерения – Методы решения – Развитие науки- Статья- Как писать введение в реферате- Подготовка к ЕГЭ — Репетитор по физике
Новые страницы
Запрос не дал результатов.
Транзистор биполярный — Физическая энциклопедия
ТРАНЗИСТОР БИПОЛЯРНЫЙ (от лат. bi — двойной, двоякий и греч. polos — ось, полюс) — один
из осн. элементов полупроводниковой электроники. Создан в 1948 Дж. Бардином
(J. Bardeen), У. Браттейном (W. Brattain) и У. Шокли (W. Shockley) (Нобелевская
премия по физике, 1956). Представляет собой трёхслойную полупроводниковую структуру
с чередующимися слоями дырочной (р-тип) и электронной (n-тип)
проводимости. Существуют Т. б. как p — n—р— (рис. 1, а),
так и p—p— п-типа (рис. 1,
элементов полупроводниковой электроники. Создан в 1948 Дж. Бардином
(J. Bardeen), У. Браттейном (W. Brattain) и У. Шокли (W. Shockley) (Нобелевская
премия по физике, 1956). Представляет собой трёхслойную полупроводниковую структуру
с чередующимися слоями дырочной (р-тип) и электронной (n-тип)
проводимости. Существуют Т. б. как p — n—р— (рис. 1, а),
так и p—p— п-типа (рис. 1,
Рис. 1. Структура биполярного
транзистора: а-транзистор р- п-р-типа; б
1. Структура биполярного
транзистора: а-транзистор р- п-р-типа; б
Рис. 2. Структура биполярного
транзистора р—п—p-типа; I-эмиттерный р-n-переход;
2 — коллекторный р- n-переход.
Рис. 3. Схема включения
транзистора.
Принципы работы. Обычно
при работе Т. б. к эмиттер-ному переходу приложено напряжение в прямом направлении
(+ на p-эмиттере), а к коллекторному — в обратном направлении (-на p-коллекторе),
В отсутствие внеш. напряжения на границе р— и и-областей существует,
как известно, потенц. барьер, мешающий дыркам переходить из  4, а), высота потенц. барьера понижается.
При этом дырки из эмиттера инжектируются в базу (см. Инжекция носителей заряда), а электроны — из базы в эмиттер (рис. 4, б). В широком диапазоне
токов выполняется соотношение
где p1 — концентрация дырок в базе на границе с эмиттером, n1-концентрация электронов в эмиттере на границе с
базой,
4, а), высота потенц. барьера понижается.
При этом дырки из эмиттера инжектируются в базу (см. Инжекция носителей заряда), а электроны — из базы в эмиттер (рис. 4, б). В широком диапазоне
токов выполняется соотношение
где p1 — концентрация дырок в базе на границе с эмиттером, n1-концентрация электронов в эмиттере на границе с
базой, 
Рис. 4. Протекание тока
через p-n-переход при прямом напряжении: а-эмиттерный p-n-переход; б-распределение носителей
заряда при протекании прямого тока — равновесная
концентрация дырок в p-эмиттере; — равновесная
концентрация электронов в базе; p1 — концентрация
вблизи границы дырок, инжектированных из эмиттера
в базу; n1-концентрация электронов,инжектированных в эмиттер).
Если ширина слаболегированной
области (базы) значительно превышает
Аналогично для электронов
в эмиттере
где х принимает
отрицат. значения. На границе р — и n -областей
полный ток, протекающий через p-n — переход, складывается
из диффузионного тока дырок
и диффузионного тока
электронов
(см.
значения. На границе р — и n -областей
полный ток, протекающий через p-n — переход, складывается
из диффузионного тока дырок
и диффузионного тока
электронов
(см.
Диффузия носителей заряда
в полупроводниках). При этом доля
дырочного тока
Коэф.
называют к о э ф ф и ц и е н т о м и н ж е к ц и и э м и т т е р а. Электрофиз.
параметры эмиттера и базы всегда выбираются такими, чтобы величина gp была по возможности близка к единице, даже с учётом того, что на практике часто
выполняются неравенства
Т. о., на границе эмиттера и базы (х = 0)ток в осн. является
диффузионным током дырок.
Особенности протекания тока. При прямом напряжении на эмиттере через базовый электрод в базу каждую
секунду входят N=I/e электронов со стороны отрицат. полюса источника
питания. Если коэф. инжекции эмиттера g На практике величина gp близка к единице, так что лишь малая доля электронов, вошедших в базу, покидает
её в виде диффузионного потока электронов в эмиттер. Подавляющая часть вошедших
в базу электронов исчезает в базе, рекомбинируя с дырками, инжектированными
эмиттером. Это осн. свойство эмиттер-ного перехода, используемое при получении
транзисторного эффекта — усиления по току.
На практике величина gp близка к единице, так что лишь малая доля электронов, вошедших в базу, покидает
её в виде диффузионного потока электронов в эмиттер. Подавляющая часть вошедших
в базу электронов исчезает в базе, рекомбинируя с дырками, инжектированными
эмиттером. Это осн. свойство эмиттер-ного перехода, используемое при получении
транзисторного эффекта — усиления по току.
Когда к p-n — переходу
приложено обратное напряжение (рис. 5, а), высота потенц. барьера на
границе p-n-перехода повышается. При этом ни дырки из коллектора в базу,
ни электроны из базы в коллектор переходить не могут. Через коллекторный переход
течёт относительно небольшой ток, складывающийся из двух компонентов. Первый
компонент — ток электронов и дырок, возникающих вследствие теплового возбуждения
в области объёмного заряда коллекторного перехода. Природа второго компонента
представляет с точки зрения принципа работы Т. б. наибольший интерес. Электрич.
поле, существующее внутри p-n-перехода, направлено так, что электрон,
попавший в область
перехода, выталкивается в и-область, а дырка — в p-область. Однако для
неосновных носителей (дырок в n-области и электронов в p-области)
поле в переходе, очевидно, направлено так, что оно способствует переходу дырок
из базы в коллектор, а электронов из коллектора в базу. Любая дырка, оказавшаяся
в базе на расстоянии от p-n-перехода, меньшем диффузионной длины Lp, с большой вероятностью попадает в поле p — n-перехода и выбрасывается
из базы в коллектор. Такая же ситуация реализуется и для электронов в коллекторе.
Поток неосновных носителей — дырок из базы и электронов из коллектора — и создаёт
второй компонент тока p—n-перехода при обратном напряжении — т.н.
диффузионный компонент. По обе стороны от коллекторного p — n-перехода
при обратном напряжении возникают области, обеднённые неосновными носителями.
б. наибольший интерес. Электрич.
поле, существующее внутри p-n-перехода, направлено так, что электрон,
попавший в область
перехода, выталкивается в и-область, а дырка — в p-область. Однако для
неосновных носителей (дырок в n-области и электронов в p-области)
поле в переходе, очевидно, направлено так, что оно способствует переходу дырок
из базы в коллектор, а электронов из коллектора в базу. Любая дырка, оказавшаяся
в базе на расстоянии от p-n-перехода, меньшем диффузионной длины Lp, с большой вероятностью попадает в поле p — n-перехода и выбрасывается
из базы в коллектор. Такая же ситуация реализуется и для электронов в коллекторе.
Поток неосновных носителей — дырок из базы и электронов из коллектора — и создаёт
второй компонент тока p—n-перехода при обратном напряжении — т.н.
диффузионный компонент. По обе стороны от коллекторного p — n-перехода
при обратном напряжении возникают области, обеднённые неосновными носителями.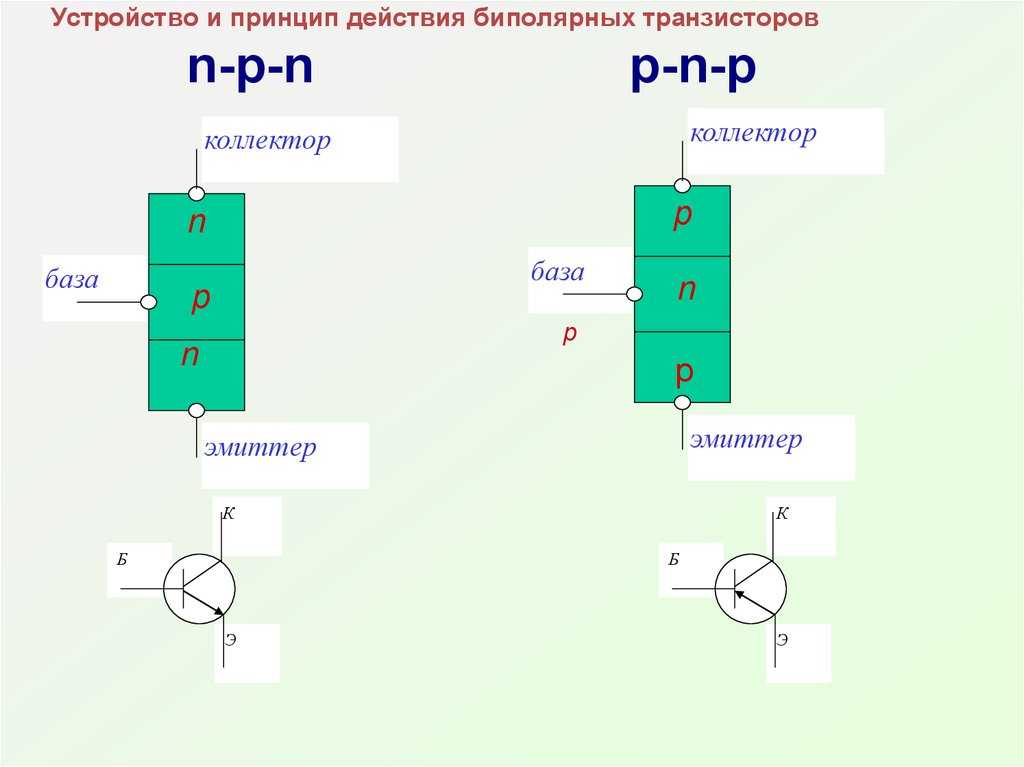 В базе длина этой области равна диффузионной длине дырок Lp, в
эмиттере — равна диффузионной длине электронов Ln (рис. 5, б).
В базе длина этой области равна диффузионной длине дырок Lp, в
эмиттере — равна диффузионной длине электронов Ln (рис. 5, б).
Рис. 5. Протекание тока
через p-n-переход при обратном напряжении: а — коллекторный p-n-переход; б-распределение неосновных носителей заряда в базовой и коллекторной
области перехода (рn-равновесная концентрация дырок в базе; пр-равновесная концентрация электронов в коллекторе).
Осн. свойство коллекторного p—n-перехода, используемое при получении транзисторного эффекта,
состоит в том, что любая дырка, возникающая в n-базе на расстоянии, меньшем,
чем диффузионная длина Lp, с высокой вероятностью попадает
в поле перехода и увлекается в коллектор.
Для реализации эффекта
усиления по току транзисторная структура (рис. 3) изготовляется так, чтобы расстояние
между эмиттерным и коллекторным p-n-переходами, т. е. ширина базы W, было бы значительно меньше диффузионной длины дырок Lp в
базе.
3) изготовляется так, чтобы расстояние
между эмиттерным и коллекторным p-n-переходами, т. е. ширина базы W, было бы значительно меньше диффузионной длины дырок Lp в
базе.
Если в базе транзистора
протекает ток Iб, то в базовую область каждую секунду входят
электронов.
Ни в эмиттер, ни в коллектор электроны из базы практически уйти не могут. Следовательно,
в стационарном состоянии все Ne электронов должны рекомбинировать
в базе. В диоде с длинной базой и с коэф. инжекции дырок p-п-перехода
gp=1 для того, чтобы обеспечить рекомбинацию Ne электронов, из эмиттера должно инжектироваться
дырок. Если же p-n-переход обладает коэф. инжекции
то для обеспечения рекомбинации электронов в базе должно ежесекундно инжектироваться
дырок. Однако в транзисторе с шириной базы W<LP каждая
дырка, инжектированная из эмиттера в базу, оказывается от коллектора на расстоянии,
меньшем Lp. Поэтому она, не успев прорекомбинировать с электроном,
с высокой вероятностью попадает в поле коллекторного перехода и выбрасывается
в коллектор. Долю дырок a, проходящих без рекомбинации из эмиттера в коллектор,
называют коэффициентом переноса. Естественно, эта доля тем больше, чем меньше
отношение W/Lp. Во многих практически важных случаях можно
считать, что
В зависимости от типа и назначения Т. б. отношение W/LP лежит
обычно в пределах от 0,5 до 0,05, а величинасоставляет
от 0,9 до 0,999. Т. о., в транзисторной структуре подавляющая часть инжектированных
эмиттером дырок проходит в коллектор, не прорекомбиниро-вав с электронами в
базе.
Поэтому она, не успев прорекомбинировать с электроном,
с высокой вероятностью попадает в поле коллекторного перехода и выбрасывается
в коллектор. Долю дырок a, проходящих без рекомбинации из эмиттера в коллектор,
называют коэффициентом переноса. Естественно, эта доля тем больше, чем меньше
отношение W/Lp. Во многих практически важных случаях можно
считать, что
В зависимости от типа и назначения Т. б. отношение W/LP лежит
обычно в пределах от 0,5 до 0,05, а величинасоставляет
от 0,9 до 0,999. Т. о., в транзисторной структуре подавляющая часть инжектированных
эмиттером дырок проходит в коллектор, не прорекомбиниро-вав с электронами в
базе.
Доля дырок, инжектированных
эмиттером, идущих на рекомбинацию с поступающими в базу электронами, равна,
очевидно, (1-a). Чтобы обеспечить рекомбинацию всех
электронов, входящих в базу, должно выполняться равенство
Т. о., протекание тока Iб в цепи базы определяет протекание в эмиттерной и коллекторной
цепи Т. б. токов Iэ и во много
раз больших, чем Iб.
б. токов Iэ и во много
раз больших, чем Iб.
Основные параметры. Осн. характеристики Т. б.- коэф. усиления по току и предельная рабочая частота.
Коэф. усиления Т. б. по току
определяется гл. обр. отношением W/LP. Для уменьшения толщины
базы W тех-нол. ограничений почти не существует. Совр. методы эпи-таксии позволяют изготовлять полупроводниковые моноатомные слои. Однако уменьшению
толщины W и, следовательно, увеличению b препятствуют физ. ограничения.
На границах областей эмиттер
— база и база — коллектор существуют области объёмного заряда (ООЗ). Для нормальной
работы транзистора необходимо, чтобы протяжённость этих областей была существенно
меньше W. Грубую оценку мин. значения W можно получить, приняв,
что величина W должна быть много больше ширины ООЗ на границе эмиттер
— база при нулевом смещении на эмит-терном переходе.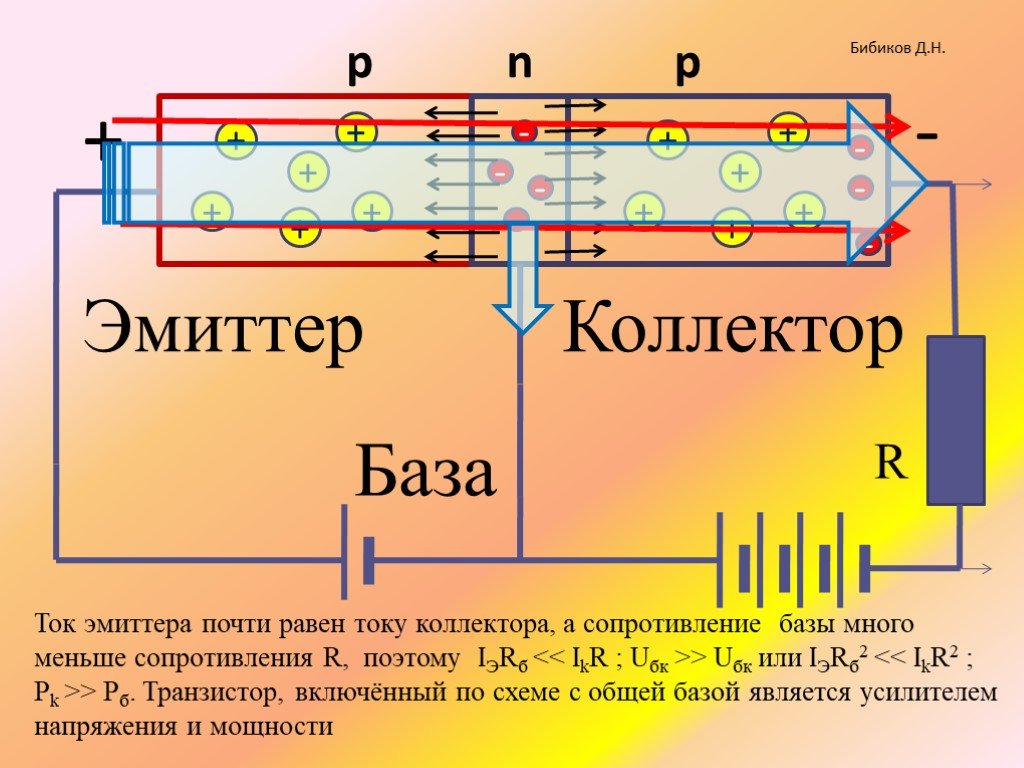 Уровень легирования эмиттера
значительно превышает уровень легирования базы. Поэтому практически вся ООЗ
на эмиттерном переходе лежит в базовой области. Её ширина
Уровень легирования эмиттера
значительно превышает уровень легирования базы. Поэтому практически вся ООЗ
на эмиттерном переходе лежит в базовой области. Её ширина
Диффузионная разность потенциалов Vd может быть оценена как
где-ширина
запрещённой зоны полупроводника. Для
для
т. о.,
Величина Nd практически не может быть больше 5 • 1017 см -3. Уровень
легирования эмиттера
Однако при ,
время жизни носителей становится очень малым. При малом tn коэф. инжекции gp уменьшается [см. (1)]. Снижение gp,
в свою очередь, вызывает уменьшение b.
При
В величина мкм,
что требует ширины базы
мкм. Такой величине W соответствует значение
Коэф. усиления по току
Т. б. составляет обычно неск. десятков, в нек-рых Т. б.- неск. сотен. В Т. б. ,
для изготовления к-рых используются различные гетероструктуры, коэф. усиления-
достигает неск. тысяч.
,
для изготовления к-рых используются различные гетероструктуры, коэф. усиления-
достигает неск. тысяч.
Быстродействие Т. б. принято
характеризовать граничной частотой fг, при к-рой коэф. усиления
по току уменьшается до b=1.
Физ. ограничение величины fг связано со временем переноса носителей через базу
При чисто диффузионном механизме переноса носителей в базе
Величина t может быть несколько уменьшена, если создать в базе электрич. поле,
ускоряющее прохождение носителей от эмиттера к коллектору (т. н. тянущее поле).
Такое поле создаётся в диффузионно-дрейфовых Т. б. неоднородным легированием
базы. Величина т при этом может быть уменьшена приблизительно в 2 раза. Т. о.,
осн. путём повышения быстродействия Т. б. является уменьшение толщины базы W.
Отметим, что уменьшение W приводит к росту входного сопротивления базы rб. При
этом увеличиваются постоянные времени заряда эмиттерной и коллекторной ёмкостей Сэ и Ск через сопротивление rб.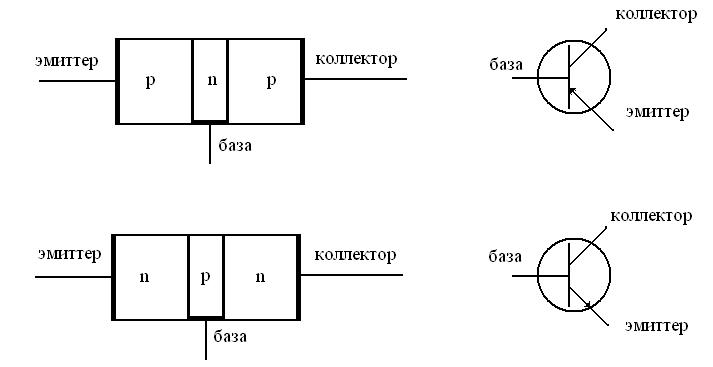 Время заряда этих ёмкостей также ограничивает быстродействие Т. б. Практически
граничная частота обычных Т. б. не превышает 10 ГГц.
Время заряда этих ёмкостей также ограничивает быстродействие Т. б. Практически
граничная частота обычных Т. б. не превышает 10 ГГц.
Предельная рабочая частота
гомоструктурных Т. б. составляет неск. ГГц. Предельная частота гетероструктур-ных
Т. б. превышает 60 ГГц.
Характеристики Т. б. могут
быть существенно улучшены, если в качестве эмиттера (а иногда и коллектора)
использовать материал с шириной запрещённой зоны
большей, чем у материала базы. В таких гетероструктурных
Т. б. чаще всего база изготавливается из GaAs, а эмиттер — из GaAlAs (гетеропереход
GaAs/GaAlAs). Идея гетероструктурных Т. б. сформулирована У. Шокли в 1948, а
созданы они были в кон. 70-х гг. В этих Т. б. коэф. инжекции эмиттера близок
к единице, даже если база легирована значительно сильнее, чем эмиттер (явление
суперинжекции). Это снимает рассмотренные выше ограничения на толщину базы W и уровень легирования базы Nd. Кроме того, снижением уровня
легирования эмиттера может быть существенно уменьшена ёмкость эмиттера Сэ. Созданы гетеротранзисторы с
мкм,
макс. частотой генерации
ГГц и шума коэффициентом (в малошумящих Т. б.) пр.= 2-5 дБ.
Созданы гетеротранзисторы с
мкм,
макс. частотой генерации
ГГц и шума коэффициентом (в малошумящих Т. б.) пр.= 2-5 дБ.
Применение. Круг
применений Т. б. условно можно разбить на 4 осн. части: Т. б. для цифровых устройств
(ЦУ) и интегральных схем (ИС), Т. б. общего применения, СВЧ Т.
б. и мощные Т. б.
Т. б., предназначенные
для работы в ЦУ и ИС, должны обладать малыми габаритами, высокой скоростью и
мин. энергией переключения. Элементную базу наибю быстродействующих (время переключения
пр.= 20 пс) узлов серийных ЭВМ составляют кремниевые Т. б. В качестве наиболее
быстродействующих элементов серийных ИС используются полевые транзисторы на основе GaAs и гетероструктурные Т. б. на основе гетеропары GaAs/GaAlAs.
Осн. требование к СВЧ Т.
б. состоит в достижении макс. мощности и коэф. усиления на предельно высокой
частоте. СВЧ Т. б. изготавливаются в осн. из GaAs, в к-ром баллистич. эффекты,
позволяющие увеличить скорость пролёта носителей через базу, выражены значительно
сильнее, чем в Si. Ведутся интенсивные разработки гетероструктурных СВЧ Т. б.
Предельная частота генерации СВЧ Т. б.~60 ГГц.
эффекты,
позволяющие увеличить скорость пролёта носителей через базу, выражены значительно
сильнее, чем в Si. Ведутся интенсивные разработки гетероструктурных СВЧ Т. б.
Предельная частота генерации СВЧ Т. б.~60 ГГц.
Мощные Т. б. изготавливаются
почти исключительно на основе Si, работают при напряжении коллектор — база до
1500 В и позволяют коммутировать ток ~ 10 А. Физ. особенности высоковольтных
Т. б. обусловлены тем, что коллектор в высоковольтных Т. б. легирован значительно
слабее базы. Благодаря этому широкая область объёмного заряда, возникающая при
большом обратном напряжении, почти целиком расположена в коллекторе. На долю
базы приходится лишь ничтожная часть общей ширины области объёмного заряда,
что позволяет сделать базу достаточно тонкой и сочетать большие коллекторные
напряжения с относительно малым временем переключения (~ 1 мкс).
Рис. 6. Транзистор с
горбообразными барьерами: а — структура
слоев; б-зонная диаграмма.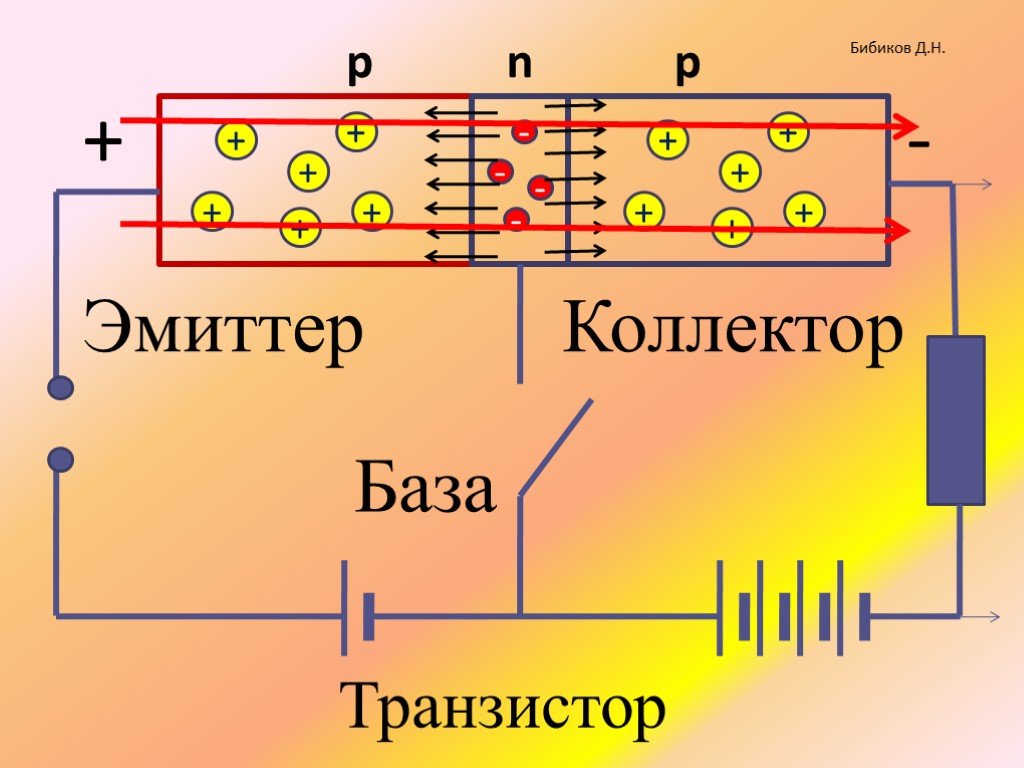
Наиб. перспективными с
точки зрения улучшения частотных свойств являются структуры, в к-рых сочетаются
свойства Т. б. и полевых транзисторов (ПТ). Как и в ПТ, работа таких транзисторов
основывается на использовании носителей заряда только одного знака, однако принцип
управления в таких приборах тот же, что и в Т. б.: инжекция носителей в базу
осуществляется понижением барьера на границе эмиттер — база.
Одна из наиб. перспективных
разновидностей Т. б. схематически показана на рис. 6,а. Соответствующая
зонная диаграмма приведена на рис. 6, б. Чередование легированных по заданному
закону п— и p-областей приводит к образованию на границе эмиттер
— база и база — коллектор двух горбообразных барьеров. К переходу эмиттер —
база прикладывается напряжение, понижающее барьер на границе i—р+. При этом из эмиттера в базу инжектируются электроны с большой энергией,
достаточной для того, чтобы
пройти над барьером (горячие электроны ).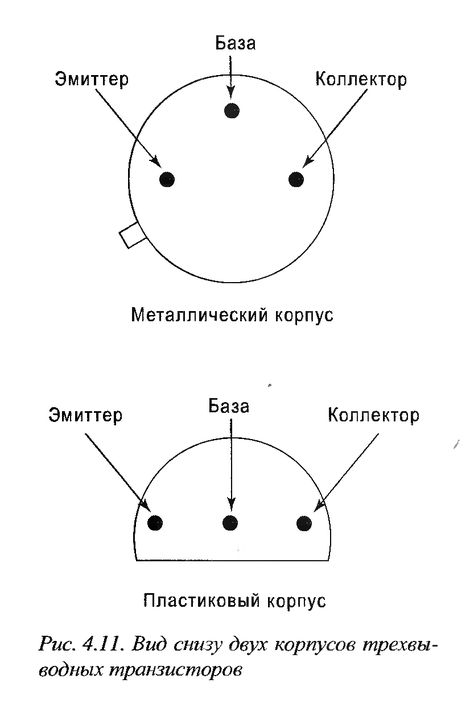 База структуры делается узкой
так что
горячие носители заряда пролетают её практически без столкновений с большой
скоростью и, попадая в поле перехода коллектор — база, втягиваются коллектором.
Предполагается, что такие транзисторы могут иметь граничную частоту, превышающую
300 ГГц.
База структуры делается узкой
так что
горячие носители заряда пролетают её практически без столкновений с большой
скоростью и, попадая в поле перехода коллектор — база, втягиваются коллектором.
Предполагается, что такие транзисторы могут иметь граничную частоту, превышающую
300 ГГц.
Лит.: 1) Зи С. М.,
Физика полупроводниковых приборов, пер. с англ., кн. 1-2, М., 1984; 2) Степаненко
И. П., Основы теории транзисторов и транзисторных схем, 4 изд., М., 1977; 3)
Поже-ла Ю., Юцене В., Физика сверхбыстродействующих транзисторов, Вильнюс, 1985. М. Е. Левинштейн, Г. С. Симин.
Предметный указатель >>
транзисторов. В чем разница между эмиттером и коллектором для биполярных транзисторов?
спросил
Изменено 2 года, 11 месяцев назад
Просмотрено 37 тысяч раз
\$\начало группы\$
(наверняка упрощенная) модель биполярного транзистора, которую преподают в фундаментальном курсе физики, кажется симметричной. — Итак, чем отличается коллектор от эмиттера настоящего биполярного транзистора? Если бы транзистор был симметричным, этого различия не было бы…
— Итак, чем отличается коллектор от эмиттера настоящего биполярного транзистора? Если бы транзистор был симметричным, этого различия не было бы…
Также:
- Имеют ли BJT падение напряжения 0,6 В, как у диодов?
- Являются ли биполярные транзисторы проводящими в обоих направлениях, т. е. E-C и C-E?
Большое спасибо.
- транзисторы
- физика
\$\конечная группа\$
1
\$\начало группы\$
Да, BJT имеют такое же падение напряжения на переходах, как и обычные диоды, то есть от 0,6 до 0,7 В между базой и эмиттером и такое же между базой и коллектором. Поскольку переходы действуют как диоды, они не проводят ток в обоих направлениях, если вы прикладываете напряжение к двум контактам.
Когда вы используете транзистор NPN в качестве транзистора, ток будет проходить от коллектора к эмиттеру через базу, даже если переход база-коллектор смещен в обратном направлении.
Стрелки указывают поток электронов , не обычный поток. Обычный поток идет от положительного к отрицательному и всегда используется при анализе цепей. Но обычный поток не может объяснить детали работы транзистора, поэтому здесь показан поток электронов.
Также обратите внимание, что напряжение коллектора выше, чем напряжение базы.
Основные различия между эмиттером и коллектором заключаются в концентрации примеси и размере. Эмиттер сильно легирован, а коллектор слабо легирован. Вы можете попробовать поменять их местами, но вы получите очень низкий \$H_{FE}\$, возможно, даже меньше 1.
\$\конечная группа\$
5
Зарегистрируйтесь или войдите в систему
Зарегистрируйтесь с помощью Google
Зарегистрироваться через Facebook
Зарегистрируйтесь, используя электронную почту и пароль
Опубликовать как гость
Электронная почта
Требуется, но никогда не отображается
Опубликовать как гость
Электронная почта
Требуется, но не отображается
Нажимая «Опубликовать свой ответ», вы соглашаетесь с нашими условиями обслуживания, политикой конфиденциальности и политикой использования файлов cookie
.
Вопрос Видео: Понимание взаимосвязи между током коллектора и внешним сопротивлением транзистора NPN
Стенограмма видео
Транзистор NPN подключен к источнику питания с напряжением 𝑉 CC. Источник питания с напряжением 𝑉 ВЕ подключен через эмиттер транзистора и базовые клеммы, как показано на схеме. Между 𝑉 CC и выводом коллектора протекает ток 𝐼 C, ток 𝐼 E между 𝑉 BE и выводом эмиттера, а ток 𝐼 B между 𝑉 BE и выводом базовый терминал. Внешнее сопротивление 𝑅 C размещено между 𝑉 CC и выводом коллектора. А внешнее сопротивление 𝑅 B помещается между 𝑉 BE и выводом базы. Разность потенциалов на клеммах коллектора и эмиттера равна 𝑉 CE. Значение 𝑅 B варьируется. Какая цветная линия на показанном графике наиболее точно представляет изменение 𝐼 C с 𝑅 B?
Этот вопрос, по сути, просит нас найти взаимосвязь между текущим
в коллектор, 𝐼 C, и сопротивление резистора на пути к
основание, 𝑅 B. Если мы сможем найти эту связь, то мы сможем определить, какая линия на
график правильный. Начнем с того, что вспомним уравнение для коэффициента усиления по току, которое может помочь нам связать 𝐼 C
и 𝐼 B. Коэффициент усиления по току транзистора 𝛽 sub 𝑒 равен току коллектора
разделить на ток базы.
Если мы сможем найти эту связь, то мы сможем определить, какая линия на
график правильный. Начнем с того, что вспомним уравнение для коэффициента усиления по току, которое может помочь нам связать 𝐼 C
и 𝐼 B. Коэффициент усиления по току транзистора 𝛽 sub 𝑒 равен току коллектора
разделить на ток базы.
Это уравнение выглядит нормально, но нас просят сравнить 𝐼 C, ток, с 𝑅 Б, сопротивление. Если мы используем закон Ома для компонентов базы транзистора, то мы чтобы разность потенциалов источника питания 𝑉 BE была равна произведению 𝐼 B и 𝑅 B. Поскольку 𝑉 BE является постоянным источником питания, разность потенциалов не изменится. Это означает, что увеличение 𝑅 B должно привести к уменьшению 𝐼 B, так что общая разность потенциалов остается неизменной.
Если мы затем посмотрим на уравнение для усиления тока, мы увидим, что уменьшение 𝐼
B также должно приводить к уменьшению 𝐼 C, если коэффициент усиления по току остается постоянным, как
Что ж. Следовательно, увеличение 𝑅 B, а затем уменьшение 𝐼 B приведет к
уменьшение 𝐼 C.
Следовательно, увеличение 𝑅 B, а затем уменьшение 𝐼 B приведет к
уменьшение 𝐼 C.
Оглядываясь назад на график, мы видим, что все пять линий показывают ту или иную форму уменьшается, так что теперь нам просто нужно определить, какой из них правильный. У нас может возникнуть соблазн выбрать красную линию, поскольку взаимосвязь кажется очевидной. Если мы сократим 𝐼 B пополам, то мы должны ожидать, что 𝐼 C также сократится пополам за чтобы сохранить тот же коэффициент усиления по току. Это означало бы, что должна быть более или менее линейная зависимость, т. что показывает красная линия.
Однако на самом деле это не так, поскольку коэффициент усиления по току не всегда
постоянный. В частности, есть два разных сценария, в которых текущий прирост более или менее
постоянный: когда транзистор действует как закрытый переключатель и когда он действует как
открытый переключатель. В противном случае коэффициент усиления по току изменяется в зависимости от значений 𝐼 B и 𝐼 C.
В противном случае коэффициент усиления по току изменяется в зависимости от значений 𝐼 B и 𝐼 C.
Чтобы понять, почему это так, вспомним, что транзистор состоит из трех полупроводники, по-разному обозначаемые как коллектор, база и эмиттер. Чтобы через транзистор протекал ток, все три его части должны разрешить проведение. Тем не менее, база сама по себе не пропустит никакой зарядки. Ток должен подаваться в базу, чтобы граница база-коллектор стать смещенным в прямом направлении, что позволит провести ток через транзистор. Это означает, что у транзистора не может быть тока и, следовательно, нет тока коллектора 𝐼 C при отсутствии тока через базу самостоятельно, 𝐼 B.
Коэффициент усиления по току при этих очень малых значениях 𝐼 B довольно высок, т.е.
увеличение 𝐼 B приведет к значительному увеличению 𝐼 C. Мы видим, что это представлено синими, черными и розовыми линиями на графике здесь. Они имеют острые кривые, указывающие на высокий коэффициент усиления тока в области до
Правильно. Помните, что высокое базовое сопротивление 𝑅 B указывает на низкий базовый ток 𝐼 B. Таким образом, поскольку только эти три линии указывают на правильное изменение коэффициента усиления по току, красная и
зеленые линии не должны быть правильными.
Они имеют острые кривые, указывающие на высокий коэффициент усиления тока в области до
Правильно. Помните, что высокое базовое сопротивление 𝑅 B указывает на низкий базовый ток 𝐼 B. Таким образом, поскольку только эти три линии указывают на правильное изменение коэффициента усиления по току, красная и
зеленые линии не должны быть правильными.
Продолжая смотреть на эти три строки, мы видим, что по мере увеличения 𝐼 B, т.е. скажем, когда 𝑅 B уменьшается, ток коллектора 𝐼 C выравнивается. Это связано с тем, что коэффициент усиления по току становится ниже по мере увеличения 𝐼 B.
Но какая цветная линия правильная? Давайте посмотрим на каждого в отдельности. Синяя линия показывает очень крутой прирост тока на высоких уровнях 𝑅 B, который выравнивается по мере
𝑅В уменьшается. Значение тока коллектора постепенно увеличивается за пределы первоначального резкого увеличения, но
никогда не достигает определенного предела. Затем эта линия не точно отображает то, что происходит с током коллектора.
потому что он действительно достигает текущего предела.
Затем эта линия не точно отображает то, что происходит с током коллектора.
потому что он действительно достигает текущего предела.
В транзисторах существует ограничение выходного тока, называемое насыщением ток, для высоких значений входного тока. Для этой схемы транзистора выходной ток является током коллектора. Входной ток является базовым током, а это означает, что мы должны видеть ограничение тока в этот график здесь. Однако для синей линии он всегда постепенно увеличивается по мере того, как базовый ток увеличивается, что не является фактическим поведением транзисторов.
Таким образом, синяя линия не может быть ею, и розовая линия не может быть правильной, так как мы видим, что
линия очень прямая, с отчетливым изломом, где видимо усиление тока
изменения. Эти прямые линии не отражают поведение, которое мы ожидаем от
транзистор, который включает в себя резкие, но гранулированные изменения усиления по току.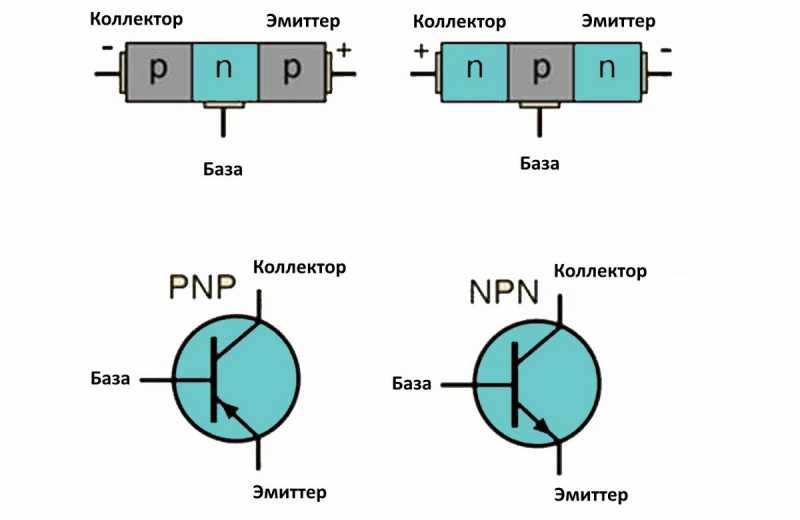


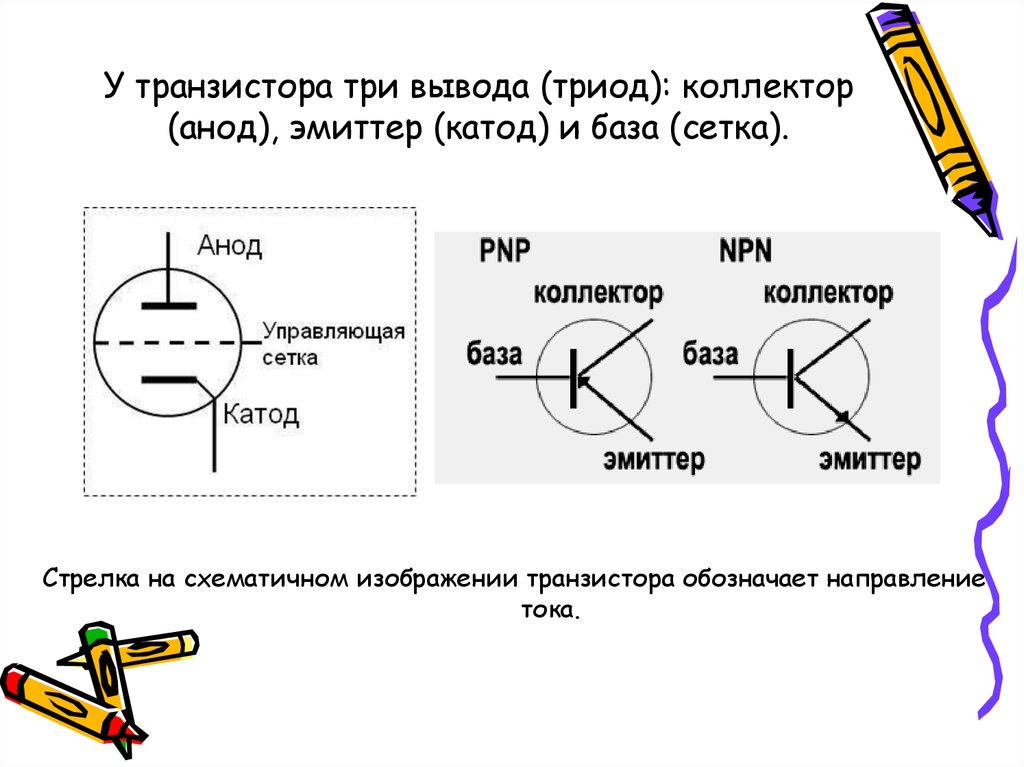 3 Фотометрия
3 Фотометрия